Микроэлектроника, 2021, T. 50, № 3, стр. 175-183
Влияние режима электроформовки на устойчивость переключений мемристоров на основе открытых “сэндвич”-структур в среде кислорода
В. М. Мордвинцев a, *, Е. С. Горлачев a, С. Е. Кудрявцев a
a Ярославский филиал Физико-технологического института им. К. А. Валиева Российской АН
150007 Ярославль, ул. Университетская, 21, Россия
* E-mail: Mordvintsev-Viktor@yandex.ru
Поступила в редакцию 01.06.2020
После доработки 01.06.2020
Принята к публикации 15.10.2020
Аннотация
Объектом исследования были образцы элементов энергонезависимой электрически перепрограммируемой памяти (мемристоров) на основе открытых “сэндвич”-структур TiN–TiO2–SiO2–W, в которых после выполнения электроформовки образуются проводящие наноструктуры с электрически изменяемыми характеристиками. Исследовано влияние давления кислорода и режима электроформовки на переключения элемента памяти. На новом экспериментальном материале подтвержден установленный ранее характер зависимости порогового давления кислорода (Pth) для импульсного “включения” элемента памяти от тока ограничения при переключениях (Ilim). Продемонстрировано наличие сдвига кривой Pth(Ilim) для различных условий выполнения электроформовки, которое может быть объяснено соответствующим изменением размеров проводящей наноструктуры. На основе полученных экспериментальных данных проведена оценка изменения размеров и удельного поверхностного сопротивления материала проводящей среды при изменении тока ограничения при электроформовке Ilimf, которая демонстрирует увеличение “компактности” наноструктуры с его уменьшением. Уточнены ранее предложенные механизмы процессов. Разработана обоснованная методика выбора режимов выполнения электроформовки открытых “сэндвич”-структур.
ВВЕДЕНИЕ
Исследования конструкций, материалов и свойств мемристоров, т.е. элементов энергонезависимой электрически перепрограммируемой памяти, в которой информация кодируется величиной сопротивления, являются перспективным направлением микро- и наноэлектроники [1, 2]. Одним из типов материалов, в которых наблюдаются переключения сопротивления, являются оксиды кремния [3–5]. При этом они используются в виде тонких (порядка нескольких десятков нанометров) пленок в структурах металл–диэлектрик–металл (МДМ), которые подвергаются электроформовке путем подачи на них напряжения амплитудой около десяти вольт, после чего структуры приобретают нетривиальные свойства: N-образные вольтамперные характеристики (ВАХ) и эффекты бистабильности (памяти и переключений с использованием импульсов напряжения) [6, 7].
Для возникновения эффектов бистабильности в МДМ-структурах на основе SiO2 необходимо наличие не просто слоя диэлектрика, а участка его поверхности, открытого в газовую фазу и расположенного между электродами (изолирующей щели), что обеспечивает обмен молекулами кислорода между поверхностью и газовой средой [6, 7]. Проще всего такие, “открытые”, структуры сформировать в обычных (“закрытых”) МДМ-“сэндвич”-структурах путем локального удаления верхнего электрода и диэлектрика. При этом свободный торец слоя диэлектрика, располагающийся между двумя электродами, образует изолирующую щель, ширина которой определяется толщиной слоя диэлектрика [6]. Поскольку ее значения имеют порядок десятков нанометров, при используемых напряжениях между электродами (до 10 В) на поверхности изолирующей щели достигаются высокие электрические поля (около 106 В/см), которые необходимы и для электроформовки, и для переключений между низко- и высокопроводящим состояниями. Механизм процесса электроформовки – образование в изолирующей щели частиц проводящей фазы (ЧПФ), в случае оксидов кремния – это атомы кремния, возникающие за счет деструкции молекул SiO2 при электронном ударе и удаления кислорода в газовую среду. Накопление ЧПФ приводит к формированию связного кластера – проводящей среды, которая отделяется от катода структуры изолирующим зазором с переменной (зависящей от напряжения) нанометровой шириной. Проводящая среда образует наноструктуру, которая вместе с изолирующим зазором определяют сопротивление структуры в целом [8].
Особенностью элементов памяти на электроформованных открытых “сэндвич”-МДМ-структурах является их чувствительность к давлению кислорода над поверхностью изолирующей щели. В работе [9] были представлены результаты по воздействию кислорода на импульсные переключения в структурах TiN–TiO2–SiO2–W после стандартной (ранее используемой) процедуры электроформовки. В данной работе исследуется влияние режима электроформовки на чувствительность таких структур к кислороду.
ПОДГОТОВКА ОБРАЗЦОВ И МЕТОДИКА ИССЛЕДОВАНИЙ
На рис. 1 схематически показана открытая “сэндвич”-структура TiN–TiO2–SiO2–W. Особенности конструкции образцов элементов памяти и технология их изготовления приведены в [9]. Единственным значимым отличием структур была несколько большая толщина пленки диоксида титана, за счет большего давления кислорода при отжиге поверхности титана в кислородной плазме [10]. В [9] он выполнялся при потоке кислорода 7.6 см3/мин, в данном случае – при 9.2 см3/мин. Как и ранее, все исследованные образцы были получены с одной и той же (но другой) кремниевой пластины.
Рис. 1.
Схематическое изображение изолирующей щели открытой “сэндвич”-структуры TiN–TiO2–SiO2–W после выполнения электроформовки. 1 – нижний электрод изолирующей щели (TiN); 2 – слой диэлектрика (TiO2) толщиной 2–3 нм; 3 – слой диэлектрика (SiO2) толщиной 25 нм; 4 – верхний электрод изолирующей щели (W); 5 – проводящая среда (наноструктура) на поверхности открытого торца (изолирующей щели); 6 – изолирующий зазор переменной ширины h.
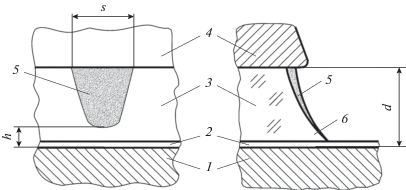
Методика электроформовки по-прежнему включала размещение образцов в вакууме с остаточным давлением порядка 10–2 Па, однако, в отличие от [9], это была вакуумная камера установки с безмасляной откачкой, которая использовалась и в дальнейших экспериментах. Предварительные эксперименты показали, что электроформовка протекала одинаково в масляном и безмасляном вакууме. На структуры подавались треугольные импульсы напряжения амплитудой около 10 В со скоростью изменения 2 В/с, при этом ток искусственно ограничивался на заданном уровне Ilimf. Во всех экспериментах использовалась полярность напряжения с “плюсом” на верхнем вольфрамовом электроде, при которой обеспечивается большая надежность электроформовки и переключений элементов памяти. В частности, это приводило к тому, что проводящая среда в изолирующей щели, которая образуется со стороны анода [6] в результате электроформовки, должна располагаться вблизи пленки вольфрама (рис. 1). Факт успешного выполнения электроформовки фиксировался по появлению характерных N-образных ВАХ [8] и возможности перевода структуры из полученного высоко- в низкопроводящее состояние (“выключение”) коротким импульсом напряжения той же полярности с амплитудой ~8 В и длительностью 100 нс. Обратное переключение (“включение”) происходило при достижении порогового значения напряжения (Uth ≈ 3 В) для процесса образования ЧПФ [9]. Сразу после электроформовки каждый элемент памяти “прирабатывался” с целю достижения более стабильного состояния: на него подавался треугольный импульс напряжения амплитудой около 10 В и длительностью 120 с с тем же ограничением тока Ilimf. Фактически эта процедура была частью операции электроформовки.
Подробное описание экспериментальной установки для исследования влияния газовой среды на процессы переключения элементов памяти, а также методики переключений приведены в [9]. Для переключения из низко- в высокопроводящее состояние (“включения”) применялись прямоугольные импульсы напряжения амплитудой 5 В и длительностью 30 мс, вырабатываемые прибором ИППП-1/2 с ограничением тока на уровне Ilim и измерением среднего значения тока iav за время около 1 мс в конце импульса напряжения. Ток ограничения Ilim мог варьироваться в диапазоне от 1 до 200 мкА. Для последующего контроля состояния элемента памяти фиксировалось значение тока при напряжении 1 В (ток iON “включенного” состояния). “Выключение” элемента проводилось подачей одиночного прямоугольного импульса длительностью 100 нс с амплитудой 6–9 В, схема ограничения тока при этом отключалась. Для каждого исследуемого элемента памяти для каждого значения давления и тока ограничения Ilim выполнялась серия из 30 циклов “включения”/”выключения” в режиме одиночных импульсов. “Включение” считалось успешным, если ток iav был более 0.95Ilim. В противном случае импульс “включения” повторялся. Для каждого цикла фиксировались значения iON и потребовавшееся количество n импульсов “включения”. iON и n могли отличаться для разных циклов в несколько раз, поэтому вычислялись средние по серии значения тока ION “включенного” состояния и числа N потребовавшихся импульсов. Отказ по “включению” элемента памяти фиксировался, если высокопроводящее состояние не появлялось после подачи 200 одиночных импульсов.
МОДИФИКАЦИЯ МЕТОДИКИ ЭЛЕКТРОФОРМОВКИ
В обычной методике электроформовки использовалось ранее эмпирически выбранное значение тока ограничения Ilimf, равное 190 мкА. Однако для образцов элементов памяти с исследуемой в данной работе кремниевой пластины при этом получались нестандартные результаты. На рис. 2 приведены зависимости среднего тока ION “включенного” состояния от Ilim при переключениях в высоком вакууме (до подачи в систему кислорода). Вместо ожидаемого монотонного увеличения ION, стремящегося к насыщению (такая кривая приведена на рис. 5) наблюдались значительные выбросы тока на кривых, которые можно было трактовать как проявления пробойных эффектов. На некоторых образцах, действительно, наблюдались заметные разрушения структур даже в оптическом микроскопе. В принципе, такие результаты могут быть связаны с повышенной толщиной слоя диоксида титана (см. выше), что и должно приводить к большей нестабильности при прохождении тока через пленку TiO2. В любом случае, пробойные эффекты должны были быть устранены, что можно обеспечить путем уменьшения значения тока ограничения Ilimf при электроформовке, которое не должно превышаться и при последующих переключениях элемента памяти.
Рис. 2.
Зависимости среднего тока ION “включенного” состояния (зачерненные фигуры) и среднего числа N, необходимых для “включения” импульсов (полые фигуры) от тока ограничения Ilim при переключениях для двух образцов в высоком вакууме. Ток ограничения при электроформовке Ilimf = 190 мкА.
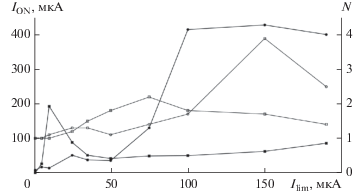
Эти соображения привели к несколько иной, более обоснованной, методике электроформовки. Она состояла в том, чтобы постепенно уменьшать значение тока Ilimf и, снимая кривые зависимости ION(Ilim) при переключениях, остановиться на том значении Ilimf, при котором исчезают значительные выбросы тока на этих кривых. Результат использования такой методики иллюстрирует рис. 3. Ilimf и максимальное значение тока ограничения Ilim постепенно уменьшались от 190 до 60 мкА. Как видно, электроформовка при Ilimf = = 75 мкА еще дает резкий скачок тока на зависимости ION(Ilim) при максимальном его значении. При электроформовке же следующих двух элементов памяти с ограничением по току 60 мкА на соответствующих кривых выбросы тока отсутствуют. Аналогичным образом ведет себя среднее число N потребовавшихся импульсов “включения”. Это явилось обоснованием использования 60 мкА в качестве максимального значения тока ограничения (и при электроформовке, и при переключениях) для всех элементов памяти с исследуемой в данной работе кремниевой пластины.
Рис. 3.
Типичные зависимости среднего тока ION “включенного” состояния (зачерненные фигуры) и среднего числа N, необходимых для “включения” импульсов (полые фигуры) от тока ограничения Ilim при переключениях в высоком вакууме для трех образцов с различными токами ограничения при электроформовке Ilimf: 1 – 75 мкА, 2 и 3 – 60 мкА.

Значительное уменьшение тока Ilimf (со 190 до 60 мкА) по сравнению с ранее использовавшимся значением потребовало отдельного исследования стабильности высокопроводящего состояния структур, возникающего после электроформовки в таком режиме. С этой целью были выполнены эксперименты, включающие измерение тока “включенного” состояния в процессе “хранения” отформованных структур в течение большого времени в камере вакуумной установки. Типичные данные представлены на рис. 4. Ток ION уменьшается приблизительно на 10% за два месяца хранения, что не отличается от данных для прежних стандартных режимов электроформовки. Поскольку в течение этого времени за счет натекания в вакуумную камеру увеличивалось и давление воздуха в ней, встал вопрос о разделении воздействия двух возможных факторов, которые могут вести к уменьшению проводимости наноструктуры: времени хранения и парциального давления кислорода воздуха. С этой целью после 53 дней хранения давление кислорода было резко увеличено путем искусственного его напуска в вакуумную камеру (рис. 4). Как видно, это дало эффект несколько превышающий ожидаемый от просто “хранения”, но и он оказался незначительным. Полученные результаты позволяет утверждать, что на уменьшение тока ION сказываются оба фактора: и время “хранения” и давление кислорода, – однако первый из них имеет основное значение. При дальнейшей выдержке в тех же условиях проводимость “включенного” состояния стабилизируется. В целом, уменьшение ION не превышает 10%, что не должно сказаться на функционировании элементов памяти.
Рис. 4.
Типичные зависимости среднего тока ION “включенного” состояния (зачерненные кружки) и остаточного давления P0 в вакуумной камере (полые кружки) от времени t хранения “включенного” элемента.

Рис. 5.
Усредненные зависимости среднего тока ION “включенного” состояния от тока ограничения Ilim при переключениях в высоком вакууме для образцов с разных кремниевых пластин и различных токов ограничения при электроформовке Ilimf: 1 – первая пластина и 190 мкА [9], 2 – вторая пластина и 60 мкА, получена усреднением по 4 образцам.

В последующих экспериментах использовалась описанная выше модифицированная и, тем самым, более обоснованная методика выполнения электроформовки.
РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
На рис. 5 приведены усредненные по четырем элементам памяти зависимости ION(Ilim), снятой в ходе их переключений в высоком вакууме (порядка 10–2 Па), для тока ограничения Ilimf при электроформовке 60 мкА. Для сравнения показана аналогичная кривая для образцов с другой кремниевой пластины при прежней методике электроформовки – с ограничением тока на уровне 190 мкА [9]. Видно, что уменьшение тока ограничения приводит к двум принципиальным эффектам. Во-первых, существенно уменьшаются токи ION “включенного” состояния. Это означает, что образующиеся в ходе электроформовки наноструктуры имеют меньшую проводимость. Во-вторых, при Ilim до 60 мкА мы находимся на линейном участке зависимости. Замедление роста ION, очевидное для бóльших токов, здесь еще не начинается. Это означает, что накопление ЧПФ, активируемое электронным ударом [11], т.е. самим током, при образовании проводящей среды еще не ограничивается внутренними процессами в наноструктуре [9]. Отмеченное качество кривой ION(Ilim) можно рассматривать как еще один, дополнительный, и более жесткий, критерий правильности методики электроформовки: ток ограничения при ее выполнении должен уменьшаться до таких значений, когда зависимость ION(Ilim), снятая в ходе переключений элемента памяти, перестанет отклоняться от линейной в области больших Ilim.
Для данных при электроформовке с током ограничения 60 мкА более четко видна еще одна особенность кривой ION(Ilim) – она заметно отклоняется от линейной зависимости при малых значениях Ilim. ION почти перестает зависеть от тока ограничения и превышает Ilim, при этом, для больших значений Ilim выполняется обратное их соотношение. Этот эффект связан с тем, что как показано в [9], процесс “включения” структуры при постоянном напряжении (длительности импульсов 30 мс) ~5 В фактически представляет собой серию самопроизвольных наносекундных импульсов “включения”-“выключения”, постепенно выводящих ее на высокое значение проводимости. Механизм ограничения тока работает следующим образом. Если в результате самопроизвольного наносекундного импульса из-за роста проводимости структуры (накопления проводящей среды) мгновенное значение тока i превысило установленное значение Ilim, напряжение на структуре падает, пока не начнет выполняться обратное соотношение: i < Ilim, – после чего напряжение восстанавливается до 5 В и процесс “включения” продолжается. Но если значения Ilim малы, то уже первые самопроизвольные импульсы приводят к уменьшению напряжения до значений меньше порогового (Uth ≈ 3 В), когда становятся невозможными образование и выгорание ЧПФ, причем напряжение сохраняется на этом уровне. Тогда проводящее состояние структуры может фиксироваться при условии ION > Ilim.
Было исследовано влияние давления P кислорода на процессы переключения элемента памяти с использованием различных значений Ilim, которые изменялись при переходе от одного образца к другому. В то же время, для каждого из них давление кислорода менялось от минимального (вакуум на уровне 10–2 Па) до значения, при котором “включение” переставало происходить. На рис. 6 показаны типичные изменения тока ION “включенного” состояния и среднего числа N импульсов, необходимых для “включения”, с ростом давления кислорода для трех образцов с разными токами ограничения. Отсутствие экспериментальных точек для каждой кривой при бóльших давлениях означает, что на следующем значении давления “включение” оказалось невозможным, что фиксирует пороговое давление Pth для процесса “включения”. В целом, характер кривых не отличался от данных приведенных в [9]. В частности видно, что перед приближением к значению Pth увеличивается необходимое число N импульсов “включения”, которое до этого, при малых P, было близко к 1, т.е. вероятность “включения” заметно уменьшается уже при подходе к пороговому давлению, и становится равной 0 после его достижения.
Рис. 6.
Зависимости среднего тока ION “включенного” состояния (зачерненные фигуры) и среднего числа N необходимых для “включения” импульсов (полые фигуры) от давления P кислорода. Ток ограничения при электроформовке Ilimf = 60 мкА. Ток ограничения Ilim при переключениях (в мкА) для трех образцов: кружки – 5, треугольники – 20, квадраты – 50.

В то же время, зависимости порогового давления Pth от тока Ilim ограничения при переключениях значительно отличаются для разных токов Ilimf ограничения при электроформовке (рис. 7). Для Ilimf = 60 мкА по сравнению со значением 190 мкА [9], кривая сдвигается влево и вверх. Кроме того, показанная на рисунке “полочка” при малых Ilim для экспериментальных данных при Ilimf = 60 мкА отражает только тот факт, что пороговые давления Pth в этом диапазоне выше значения 105 Па, поскольку используемое оборудование не приспособлено для работы при избыточном (более 1 атмосферы) давлении в рабочей камере. Элементы памяти успешно функционируют и при атмосферном давлении кислорода, а фактически кривая должна идти выше отмеченных экспериментальных точек, поэтому они показаны полыми треугольниками, а кривая выполнена пунктиром.
Рис. 7.
Зависимости порогового давления Pth, при котором элемент памяти перестает “включаться”, от тока ограничения Ilim при переключениях для образцов с разных кремниевых пластин и различных токов ограничения при электроформовке Ilimf: 1 – первая пластина и 190 мкА [9], 2 (с экспериментальными точками) – вторая пластина и 60 мкА.
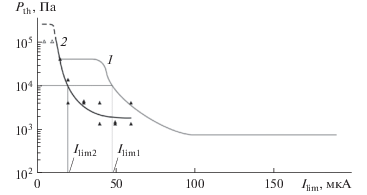
Смысл диаграммы рис. 7 состоит в том, что для точек, определяемых значениями давления P кислорода и тока Ilim, лежащих ниже кривой Pth(Ilim), процесс “включения” элемента памяти происходит успешно, а выше ее – он становится невозможным. В [9] экспериментальная кривая Pth(Ilim) в диапазоне изменения давления Pth объяснялась совместным действием трех факторов. Во-первых, это скорость поступления молекул кислорода на поверхность изолирующей щели, пропорциональная давлению P. Во-вторых, это линейная зависимость локальной температуры T поверхности изолирующей щели (и наноструктуры), на которой образуются ЧПФ (атомы кремния), от среднего тока ION через структуру (считается, что поверхность разогревается за счет джоулева тепла, а напряжение на структуре поддерживается постоянным), который пропорционален току Ilim (рис. 5). В-третьих, это экспоненциальная зависимость Pth от обратной температуры T поверхности изолирующей щели:
(1)
${{P}_{{th}}} = C{\kern 1pt} \exp \left( {\frac{E}{{\kappa T}}} \right) = C{\kern 1pt} \exp \left( {\frac{E}{{B{{I}_{{\lim }}}}}} \right),$Смещение кривой Pth(Ilim) влево при уменьшении Ilimf означает, что соответствующие условию (1) температуры T поверхности изолирующей щели достигаются при меньших значениях Ilim, т.е. токи ION, которым пропорциональна температура T, при этом должны быть больше. Но как видно из рис. 5, ION, наоборот, заметно падает при уменьшении Ilimf от 190 до 60 мкА, т. е. должно бы было наблюдаться обратное смещение кривой Pth(Ilim) – вправо. Отмеченное противоречие может быть устранено, если предположить, что при разных значениях Ilimf при выполнении электроформовки образуются проводящие наноструктуры с различными характеристиками. Прежде всего, надо ввести фактор формы наноструктур. Фактически это можно сделать путем учета различной их ширины s (рис. 1). Температура поверхности изолирующей щели (и наноструктуры) пропорциональна плотности рассеиваемой на ней мощности, которая отводится в слой диэлектрика за счет теплопроводности. Мы считаем, что все джоулево тепло выделяется в проводящей наноструктуре, поскольку удельная проводимость ее материала значительно меньше проводимости подводящих металлических электродов. Поэтому длина источника тепла (наноструктуры) для образцов с одинаковой толщиной d слоя диэлектрика всегда одна и та же, а площадь зависит только от ширины s. Если при меньших значениях тока ION температура оказывается выше, это означает, что больше должна быть плотность тока (она пропорциональна ION/s), т.е. меньше ширина s проводящей наноструктуры. Соответствующий фактор формы должен быть введен в выражение (1):
где A и D – константы, а ширина s проводящей наноструктуры определяется условиями при выполнении электроформовки. Выражение (2) дает правильное смещение кривой Pth(Ilim) при изменении параметра s, с его уменьшением она сдвигается влево.Наличие экспериментальных зависимостей порогового давления Pth от тока ограничения Ilim при переключениях позволяет получить определенную информацию о характеристиках проводящих наноструктур, образующихся в различных условиях электроформовки – при токах Ilimf 190 и 60 мкА. Отношение размеров наноструктур можно оценить из следующих соображений. Одно и то же значение Pth, для определенности возьмем 104 Па (рис. 7), должно достигаться при одной и той же температуре поверхности наноструктуры, которая, в первом приближении, задается условием одинаковой плотности рассеиваемой мощности. Последняя величина пропорциональна току ION включенного состояния и обратно пропорциональна ширине s наноструктуры. Тогда должно выполняться условие ION1/s1 = ION2/s2, где индекс 1 относится к случаю Ilimf = 190 мкА, а 2 – к случаю Ilimf = 60 мкА. Поскольку предполагается пропорциональная зависимость между ION и Ilim, можно записать ION = kIlim, однако коэффициент k должен быть различным для разных случаев. Из данных рис. 5 видно, что, приблизительно, выполняется соотношение kl = 2k2. Тогда отношение размеров наноструктур
Полученный результат одновременно означает и то, что удельное поверхностное сопротивление материала наноструктуры в случае электроформовки с током Ilimf = 60 мкА в несколько раз ниже, чем с током Ilimf = 190 мкА. Действительно, в обоих случаях токи ION измерялись при одинаковом напряжении на структуре (1 В). В первом случае токи “включенного” состояния были в 2 раза меньше (рис. 5), т.е. сопротивление наноструктуры – в 2 раза больше, но ширина s наноструктуры – в 5 раз меньше. Отсюда следует, что удельное поверхностное сопротивление должно быть в 2.5 раза выше.
Уточнения требуют представления о причине образования полочки на кривых Pth(Ilim) при больших значениях тока ограничения (рис. 7). В [9] для Ilimf = 190 мкА она объяснялась выходом на полочку при Ilim > 100 мкА зависимости ION(Ilim), однако для случая Ilimf = 60 мкА эта зависимость остается линейной и при больших значениях Ilim (рис. 5). В то же время, наличие полочки на кривой Pth(Ilim) и во втором случае вполне очевидно. Поэтому нужен другой, более общий механизм, объясняющий эту особенность. Она может быть связана с тем, что кинетика процесса исчезновения ЧПФ при реакции с кислородом предполагает, как минимум, две последовательные стадии: поступление молекул кислорода на поверхность наноструктуры (оно зависит от давления кислорода в газовой фазе) и собственно реакция ЧПФ с молекулой кислорода (она зависит от температуры поверхности). С ростом Ilim растет температура, а значит, и скорость второй стадии. Это приводит к тому, что при некоторой температуре скорость процесса в целом перестает зависеть от второй стадии и целиком лимитируется стадией первой, т.е. давлением кислорода. Но это и означает постоянство значения Pth и отсутствие его зависимости от Ilim в соответствующем диапазоне токов ограничения. Такой механизм может объяснить и сдвиг полочки на кривой Pth(Ilim) в сторону больших давлений при изменении режима электроформовки от Ilimf = 190 мкА к Ilimf = 60 мкА. Как показано выше, в последнем случае достигаются более высокие температуры поверхности наноструктур, поэтому скорость второй стадии оказывается выше, а значит, при более высоком значении давления происходит переход к режиму лимитирования процесса поступлением кислорода.
Изменилась форма кривой Pth(Ilim) и при низких значениях Ilim. Наличие полочки для Ilimf = = 190 мкА объяснялось механизмом действия наносекундных импульсов тока при “включении” элемента памяти [9]. В случае Ilimf = 60 мкА такая полочка, если и присутствует (пунктирная линия на рис. 7), то расположена при заметно бóльших давлениях кислорода (экспериментальные точки, обозначенные полыми треугольниками на рис. 7, обусловлены невозможностью в эксперименте подать давления, превышающие 1 атмосферу). Но механизм действия наносекундных импульсов является универсальным. С чем тогда может быть связано увеличение Pth выше значения полочки для Ilimf = 190 мкА при низких значениях Ilim? Можно предложить два возможных механизма этого эффекта. Во-первых, как показано выше, средняя плотность тока через наноструктуру для Ilimf = = 60 мкА в несколько раз выше, чем для Ilimf = = 190 мкА. Но тогда естественно предположить, что скорость увеличения проводимости наноструктуры (“включения”), пропорциональная скорости накопления ЧПФ, которая, в свою очередь, пропорциональна плотности тока, должна быть больше. Значит, меньше должна быть длительность наносекундных импульсов тока, поэтому требуются большие давления кислорода, чтобы вероятность окисления ЧПФ за один такой импульс оставалась близкой к 1 (это и есть условие образования полочки [9]). В то же время, экспериментально не удалось уловить уменьшение длительности этих импульсов с помощью измерения осцилограммы, аналогичной приведенной в [9]. Впрочем, это может быть связано просто с тем, что соответствующая методика работает на пределе своего временнóго разрешения. Вторым потенциальным механизмом увеличения Pth является возможное расположение ЧПФ не только в первом монослое на поверхности проводящей наноструктуры, но и во втором, в глубине материала. На это указывает в несколько раз бóльшая удельная поверхностная проводимость ее материала. Тогда бóльшие давления кислорода требуются, чтобы компенсировать затруднение его проникновения ко второму монослою.
В целом, можно констатировать, что уменьшение тока ограничения Ilimf при электроформовке повышает чувствительность переключений элементов памяти к кислороду в диапазоне средних значений Ilim и понижает ее при низких значениях Ilim.
ЗАКЛЮЧЕНИЕ
Предложена обоснованная методика выбора режимов выполнения электроформовки открытых “сэндвич”-структур TiN–TiO2–SiO2–W. Продемонстрирована возможность использования электроформованных структур в качестве мемристоров – элементов памяти, в которых информация кодируется их проводимостью. Исследовано влияние давления кислорода и режима электроформовки на переключения элемента памяти.
На дополнительном экспериментальном материале подтвержден установленный ранее характер зависимости порогового давления кислорода (Pth) для импульсного “включения” элемента памяти от тока ограничения при переключениях (Ilim). Показано наличие сдвига кривой Pth(Ilim) для различных условий выполнения электроформовки. Причем, уменьшение тока ограничения при электроформовке (Ilimf) сдвигает эту кривую влево и вверх, что возможно только при соответствующем уменьшении размеров проводящей наноструктуры, образующейся в ходе электроформовки. Уточнены ранее предложенные механизмы процессов, приводящих к наблюдаемой форме кривой Pth(Ilim). На основе полученных экспериментальных данных проведена оценка изменения размеров и удельного поверхностного сопротивления материала проводящей среды при изменении тока Ilimf, которая демонстрирует увеличение “компактности” наноструктуры с его уменьшением.
Авторы выражают признательность за участие в изготовлении экспериментальных образцов В.В. Наумову, Ю.В. Поздняковой, Л.В. Левиной, Д.Н. Сергушову, А.А. Хребтюгову, А.И. Якубинской, а также за участие в подготовке экспериментальной установки для исследования влияния газовой среды на процессы переключения элементов памяти – В.Л. Левину.
Работа выполнена в рамках Государственного задания Федерального государственного бюджетного учреждения науки Физико-технологического института имени К.А. Валиева Российской академии наук Министерства образования и науки Российской Федерации по теме № 0066-2019-0003.
Список литературы
Abunahla H., Mohammad B. Memristor Device Overview. In: Memristor Technology: Synthesis and Modeling for Sensing and Security Applications. Analog Circuits and Signal Processing. Cham: Springer, 2018. 106 p.
Белов А.Н., Перевалов А.А., Шевяков В.И. Мемристорные структуры для микро- и наноэлектроники. Физика и технология // Изв. Вузов. Электроника. 2017. Т. 22. № 4. С. 305–321.
Mehonic A., Munde M.S., Ng W.H., Buckwell M., Montesi L., Bosman M., Shluger A.L., Kenyon A.J. Intrinsic resistance switching in amorphous silicon oxide for high performance SiOx ReRAM devices // Microelectronic Engineering. 2017. V. 178. P. 98–103.
Тихов C.B., Горшков О.Н., Антонов И.Н., Касаткин А.П., Королев Д.С., Белов А.И., Михайлов А.Н., Тетельбаум Д.И. Изменение иммитанса при электроформовке и резистивном переключении в мемристивных структурах “металл–диэлектрик–металл” на основе SiOx // ЖТФ. 2016. Т. 86. Вып. 5. С. 107–111.
Захаров П.С., Итальянцев А.Г. Эффект переключения электрической проводимости в структурах металл–диэлектрик–металл на основе нестехиометрического оксида кремния // Труды МФТИ. 2015. Т. 7. № 2. С. 113–118.
Мордвинцев В.М., Кудрявцев С.Е., Левин В.Л. Электроформовка как процесс самоформирования проводящих наноструктур для элементов энергонезависимой электрически перепрограммируемой памяти // Российские нанотехнологии. 2009. Т. 4. № 1–2. С. 174–182.
Chang Y.F., Fowler B., Zhou F., Chen Y.-C., Lee J.C. Study of self-compliance behaviors and internal filament characteristics in intrinsic SiOx-based resistive switching memory // Appl. Phys. Lett. 2016. V. 108. 033 504.
Мордвинцев В.М., Кудрявцев С.Е., Левин В.Л. Высокостабильная энергонезависимая электрически перепрограммируемая память на самоформирующихся проводящих наноструктурах // Российские нанотехнологии. 2009. Т. 4. № 1–2. С. 183–191.
Мордвинцев В.М., Горлачев Е.С., Кудрявцев С.Е., Левин В.Л. Влияние давления кислорода на переключения мемристоров на основе электроформованных открытых “сэндвич”-структур // Микроэлектроника. 2020. Т. 49. № 4.
Мордвинцев В.М., Наумов В.В., Симакин С.Г. Влияние давления кислорода на процесс окисления поверхности нитрида титана в плазме // Микроэлектроника. 2019. Т. 48. № 6. С. 460–466.
Мордвинцев В.М., Кудрявцев С.Е., Левин В.Л. Влияние толщины слоя диоксида кремния на процесс электроформовки в открытых “сэндвич”-структурах TiN–SiO2–W // ЖТФ. 2018. Т. 88. Вып. 11. С. 1681–1688.
Дополнительные материалы отсутствуют.
Инструменты
Микроэлектроника


