Микроэлектроника, 2022, T. 51, № 2, стр. 101-109
Температурно-частотное исследование мемристоров на основе селенида германия с самоформирующимся токопроводящим каналом
А. Н. Алёшин a, *, О. А. Рубан a, **
a Институт сверхвысокочастотной полупроводниковой электроники
им. В.Г. Мокерова Российской АН
117105 Москва, Нагорный проезд, д. 7., стр. 5, Россия
* E-mail: a.n.aleshin@mail.ru
** E-mail: myx.05@mail.ru
Поступила в редакцию 24.08.2021
После доработки 19.09.2021
Принята к публикации 18.10.2021
- EDN: JWMAPW
- DOI: 10.31857/S0544126922020028
Аннотация
Приведены экспериментальные данные по измерению сопротивления и электропроводности в низкоомном режиме работы мемристора на основе селенида германия с самоформирующимся токопроводящим каналом в диапазоне частот переключения и температур. В частотном эксперименте влияние частоты переключения проводилось при комнатной температуре в диапазоне 1–10 000 Гц. Эксперимент по изучению воздействия температуры на сопротивление и электропроводность проводился в интервале температур – 10–65°С при частоте переключения 10 Гц. Конечной целью работы явилось определение энергии активации образования токопроводящего канала. Показано, что в диапазоне температур 22–65°С электропроводность подчиняется закону Аррениуса с энергией активации, равной 0.19 эВ; при температурах ниже комнатной величина электропроводности малочувствительна к изменению температуры. Причины малой величины энергии активации обсуждаются.
1. ВВЕДЕНИЕ
В настоящее время активно ведутся разработки новых компьютерных технологий таких как квантовые компьютеры и нейроморфные системы. Нейроморфная система представляет собой искусственный объект, который имитирует работу человеческого мозга. Принцип действия подобной системы заключается в “запоминании” новой информации путем изменения проводимости контактов между искусственными нейронами (синапсами) [1‒3]. Одним из вариантов реализации подобной системы может явиться массив мемристоров. Мемристоры – это активные элементы, которые способны изменять свою электропроводность в зависимости от приложенного к ним напряжения. В процессе работы мемристора происходит переключение режима его работы из высокоомного состояния HRS (HRS – high resistance state) в низкоомное состояние LRS (LRS – low resistance state) и обратно. Принцип переключения режима работы мемристора реализуется за счет образования и разрушения в его рабочем теле токопроводящих каналов (ТК), представляющих собой области повышенной электропроводности в виде либо кластеров положительно заряженных кислородных вакансий со специфическими механизмами переноса электрических зарядов [4] (ТК такого типа образуются в мемристорах на основе оксидов переходных металлов [5]), либо металлических нитей, формирующихся в твердых электролитах (As–S, Ge–Se, Ge–S) при использовании их в качестве электролитических ячеек (ЭЯ) с активным (Ag, Au, Cu) и пассивным(W, Pt) электродами [6–8], которые квалифицируются как мемристоры с проводящими мостиками, ПМ-мемристоры. Вольтамперная характеристика (ВАХ) биполярного мемристора образует петлю гистерезиса, что лежит в основе использования данного электротехнического устройства в качестве ячейки с резистивной памятью. Разные ветви ВАХ соответствуют двум разным режимам работы мемристора: LRS и HRS.
Мемристоры в виде ЭЯ, несмотря на ряд их достоинств (в этих мемристорах, например, удается реализовать комплементарный тип переключения [9], что важно при создании пассивных структур памяти), характеризуются определенной неустойчивостью в работе, так как процесс образования и разрушения металлической нити не отличается стабильностью и не всегда воспроизводится. В [10] была описана конструкция тонкопленочного многослойного ЭЯ мемристора на основе Ge2Se3 (в химическом отношении данный мемристор может быть описан формулой Ag/Ge2Se3/W), позволяющая реализовать иной механизм изменения сопротивления ТК при работе мемристора, основанный не на процессах консолидации и растворения непрерывной металлической нити в результате дрейфа ионов активного электрода, как это имеет место в ПМ-мемристорах, а на процессе образования агломераций ионов серебра (кластеризации ионов), плотность которых при работе мемристора меняется. Такой тип мемристора его разработчики [10] назвали мемристором с самоформирующимся каналом (СФК-мемристором), так как его использование не требует технологической операции электроформовки.
Несмотря на то, что СФК-мемристоры изготавливаются мелкосерийными партиями (фирмой Knowm In, США) и доступны на рынке, в статьях, посвященным вопросам возможности их создания и особенностям работы [11–14], отсутствуют какие-либо данные, количественно характеризующие процесс формирования ТК. В то же время любой физико-химический процесс, связанный с кластеризацией (например, в виде агломераций имплантированных ионов углерода в кремний [15] или медь [16], а также в виде ассоциатов в границах зерен в металлах [17]), должен характеризоваться набором кинетических констант, описывающих развитие процесса во времени, что особенно важно, учитывая проблему быстродействия мемристоров. В СФК-мемристоре к таким константам относится в первую очередь энергия активации процесса образования агломерационных областей, как основного процесса, ответственного за формирование ТК. Важность определения этой величины, как некой характеристики работы СФК-мемристора, связана с тем, что для ее определения необходимо выполнить исследования в интервале температур, что напрямую связано со стабильностью работы прибора. Поскольку нейроморфные системы на основе мемристоров предполагается использовать в изделиях микроэлектроники, которые по сути являются по отношению к мемристору внешними источниками тепла, то изучение влияния температуры на электрофизические параметры мемристора является вдвойне актуальным.
Цель работы заключалась в определении характера зависимостей электрофизических параметров СФК-мемристорав режиме LRS от частоты электрического сигнала (частоты переключения) и температуры, а также в определении величины энергии активации формирования ТК. Подход, при котором влияние температуры и частоты переключения на работу мемристора рассматривается с единых позиций, позволяет увязать временные и температурные характеристики в единое целое и дополнить один тип исследования другим.
2. ЭКСПЕРИМЕНТАЛЬНАЯ ЧАСТЬ
2.1. Описание исследуемого мемристора
Конструкция биполярного СФК-мемристора представляет собой многослойную тонкопленочную композицию, состоящую из активного и вспомогательных слоев (рис. 1). Согласно [10] в СФК-мемристоре ТК, образующийся при подаче на серебряный анод положительного напряжения, состоит из перекрывающихся между собой агломерационных областей ионов серебра, плотность которых в процессе работы мемристора изменяется. В СФК-мемристорах используемый в качестве твердого электролита Ge2Se3 находится в аморфном состоянии с достаточно высокой температурой стеклования, равной 350°С [10], что позволяет его использовать при повышенных температурах. Агломерационные области ионов серебра (рис. 2) образуются вокруг изначально существующих в аморфной матрице димеров Ge–Ge, двух атомов Ge, образующих устойчивую и повторяющуюся в пространстве кристалла связь. Процессу образования агломераций ионов серебра способствует два обстоятельства:
Рис. 1.
Последовательность слоев и их функциональное назначение в мемристоре на основе Ge2Se3 с самоформирующимся токопроводящим каналом.
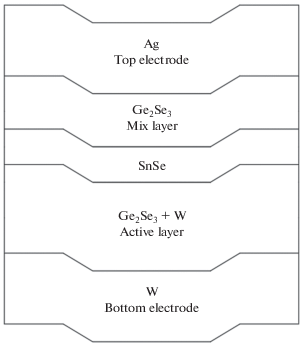
Рис. 2.
Начальные стадии процесса агломерации ионов Ag+ в аморфной матрице Ge2Se3: а – невозмущенный ближний порядок аморфной матрицы; б – образование нанополости вследствие замещения атома Ge на атом Ag в одном из димеров Ge–Ge; в – скопление ионов Ag+ вокруг нанополости. Рисунок создан авторами статьи на основе [10].

1) способность к быстрой миграции ионов Ag+ в аморфной матрице Ge2Se3 за счет определенной дефектности ее строения – наличия областей, разделяющих структурные фрагменты ближнего порядка в аморфной матрице (рис. 2а), что приближает механизм диффузии Ag+ к межузельному механизму диффузии в кристаллической решетке,
2) присутствие в активном слое мемристора ионов Sn+, попадающих в него благодаря создаваемому в мемристоре дополнительному вспомогательному слою SnSe. При приложении положительного потенциала к верхнему серебряному электроду ионы Sn+ в силу законов дрейфа ионов в электрическом поле перемещаются из слоя SnSe в активный слой Ge2Se3, в котором происходит их нейтрализация электронами, попадающими в твердый электролит из катода. Атомы Sn, располагающиеся в межатомных позициях аморфной матрицы, играют роль катализатора [13], способствуя протеканию энергетически выгодной реакции замещения атомов Ge в димерах Ge–Ge на атомы Ag, что из-за больших размеров последних приводит к локальному образованию в аморфной матрице нанополостей (рис. 2б), которые в дальнейшем обеспечивают доступ к данному участку Ag–Ge другим ионам Ag+ (рис. 2в). Конечной стадией формирования ТК является стадия, при которой агломерационные области из-за увеличения их размеров перекрываются, образуя в пространстве непрерывную металлическую нить. Таким образом, формирование ТК идет через образование агломерационных областей, расположенных в ряд по направлению вектора напряженности электрического поля, увеличение их размеров, а также увеличение плотности ионов Ag+ в агломерационных скоплениях. Добавление или удаление ионов Ag+ из мест агломерации изменяет сопротивление устройства. Полностью сформированный ТК соединяет верхний и нижний электроды, что позволяет протекать электрическому току. Сопротивление ТК будет прямо зависеть от количества ионов серебра, перенесенных в нанополости аморфной матрицы из верхнего (активного) электрода. При увеличении времени рабочего цикла СФК-мемристора ограничение длины ТК (15 нм [18]) будет способствовать увеличению его поперечного размера, а в случае ТК цилиндрической формы – росту площади поперечного сечения.
2.2. Описание эксперимента
Исследуемые в работе СФК-мемристоры были закуплены у фирмы Knowm Inc., США. Исследование мемрмисторов проводилось на автоматизированном измерительном стенде, созданном в ИСВЧПЭ РАН, который состоит из: 1) шасси NI PXI – 1078, 2) источника-измерителя NI PXIe – 4140 и 3) компьютера для управления измерительными приборами и обработки результатов. Такая установка позволяет проводить многократные и непрерывные измерения ВАХ мемристора, при различных частотах и температурах. В частотном эксперименте измерения ВАХ СФК-мемристора проводились при комнатной температуре на частотах 1, 10, 100, 1000 и 10 000 Гц с амплитудой сигнала 2 В. Изучение влияния внешней температуры на работу мемристора проводили в камере климатической установки СМ-60/150 80 ТХ, позволяющей варьировать температуру от –70 до 150°С. В данном исследовании температура варьировалась в интервале от –10 до 65°С, поскольку именно в этом интервале температур измеренные ВАХ отличались высокой стабильностью и воспроизводимостью. Измерения ВАХ СФК-мемристора в температурном эксперименте проводились при частоте 10 Гц. При измерении ВАХ на верхний электрод мемристора подавалось напряжение, изменяющееся во времени по двухполярному треугольному профилю.
3. РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
На рис. 3 приведены ВАХ (зависимости тока I от напряжения U), полученные при комнатной температуре на частотах 1, 100 и 10000 Гц. Видно, что с увеличением частоты форма ВАХ меняется: ветвь ВАХ, соответствующая нахождению мемристора в режиме LRS, становится более пологой, что указывает на увеличение сопротивления ТК мемристора. Результаты частотного эксперимента наиболее полно отражает рис. 4, на котором в полулогарифмических осях представлены выявленные зависимости между временем рабочего цикла мемристора $\tau $ – величиной, обратной частоте переключения, и сопротивлением (рис. 4а), а также электропроводностью (рис. 4б). Видно, что между величиной электропроводности $\sigma $ и $\lg {\kern 1pt} \tau $ существует линейное соотношение. На основании полученных экспериментальных данных и приписывая ТК форму металлического цилиндра, связь между электропроводностью $\sigma $ и временем рабочего цикла мемристора $\tau $ можно описать выражением
(1)
$\Delta \sigma = \frac{{{{\sigma }_{0}}}}{l}\frac{{dS}}{{dt}}\Delta {\kern 1pt} \lg {\kern 1pt} \tau ,$Рис. 3.
Изменение формы ВАХ СФК-мемристора, работающего при комнатной температуре, по мере изменения частоты переключения: а – 1; б – 100 ; в – 10 000 Гц. Показанная ВАХ соответствует одному рабочему циклу мемристора – а; ВАХ, показанные на б и в – 10 рабочим циклам мемристора.

Рис. 4.
Результаты частотного эксперимента, представленные в полулогарифмических осях, в виде зависимостей между временем рабочего цикла мемристора и а – сопротивлением и б – электропроводностью при работе СФК-мемристора в режиме LRS.

Рис. 5.
Изменение площади поперечного сечения ТК цилиндрической формы с увеличением времени $\tau $ для случая, когда значения ${{\tau }_{i}}$ (на рисунке ${{\tau }_{1}}$, ${{\tau }_{2}}$ и ${{\tau }_{3}}$) представляют собой последовательность чисел, каждый член которой в десять раз больше предыдущего.

Представление о существовании кинетической константы ${{dS} \mathord{\left/ {\vphantom {{dS} {dt}}} \right. \kern-0em} {dt}}$, ответственной за изменение площади поперечного сечения ТК во времени, позволяет привлечь к описанию характера формирования ТК в СФК-мемристоре закон Аррениуса [19], в основе которого лежит утверждение, что элементарный акт процессов физико-химической кинетики (в первоначальном виде закон Аррениуса был сформулирован для постоянной скорости химической реакции) связан с преодолением некоего энергетического барьера, численно равного энергии активации – минимальной работе, которую необходимо затратить для протекания процесса. Математическое выражение, описывающее закон Аррениуса для кинетической константы ${{dS} \mathord{\left/ {\vphantom {{dS} {dt}}} \right. \kern-0em} {dt}}$, имеет вид
(2)
$\frac{{d{\kern 1pt} \ln \left( {{{dS} \mathord{\left/ {\vphantom {{dS} {dt}}} \right. \kern-0em} {dt}}} \right)}}{{dT}} = \frac{E}{{R{{T}^{2}}}},$Рис. 6.
Изменение формы ВАХ СФК-мемристора, работающего с частотой переключения 10 Гц, по мере увеличения температуры в климатической камере: а – 22; б – 35, в – 65°C. Показанная ВАХ соответствует 10 рабочим циклам мемристора.
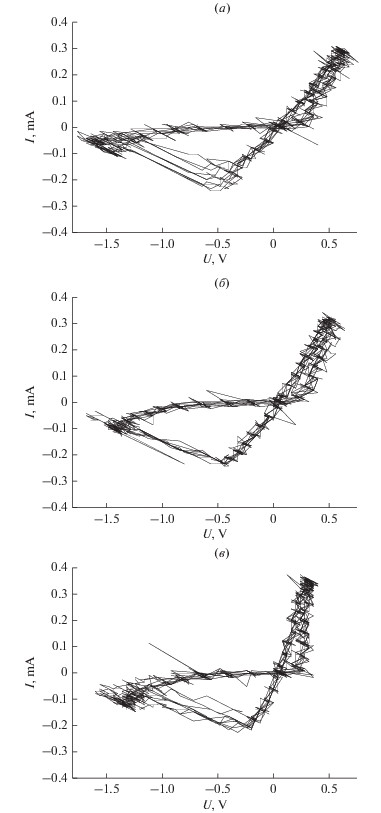
Рис. 7.
Температурные зависимости: а – сопротивления; б – электропроводности СФК-мемристора в режиме LRS в диапазоне температур –10–65°С при частоте переключения 10 Гц.

Более точному определению энергии активации формирования ТК в СФК-мемристоре (считая, что эта величина определяется исключительно изменением кинетической константы ${{dS} \mathord{\left/ {\vphantom {{dS} {dt}}} \right. \kern-0em} {dt}}$) способствует введение поправки к измеряемой величине $\sigma $, связанную с влиянием температуры на величину ${{\sigma }_{0}}$. За реперную точку принимали величину $\sigma $ при комнатной температуре. Вводимая поправка учитывала как снижение величины ${{\sigma }_{0}}$, вызванное увеличением температуры (распространяя данную закономерность на $\sigma $), так и увеличение объема ТК цилиндрической формы, вызванное ростом площади поперечного сечения, используя для этой цели экспериментальные данные по изменению величины $\sigma $ с температурой по отношению к реперной величине. Результаты измерения электропроводности (с учетом температурной поправки) в координатах Аррениуса в интервале температур 22–65°С показаны на рис. 8. Видно, что в указанном интервале температур данный закон выполняется. Энергия активации E формирования ТК равна 0.19 эВ. Малая величина энергии активации указывает на способность СФК-мемристора к быстрому переключению режимов его работы (что является необходимым условием его функционирования) и обусловлена, по-видимому, наличием сильных электрических полей [20], возникновению которых способствуют наноразмеры данного электротехнического устройства.
ЗАКЛЮЧЕНИЕ
В работе выполнены измерения сопротивления и электропроводности в биполярном мемристоре на основе Ge2Se3 с самоформирующимся токопроводящим каналом, консолидация и распад которого происходят за счет изменения плотности ионов Ag+ в агломерационных скоплениях, образующихся при работе СФК-мемристора. Образование агломерационных областей ионов Ag+ происходит за счет имеющихся в аморфной Ge2Se3 матрице нанополостей, образованию которых способствуют присутствующие активном слое мемристора атомы Sn, что обеспечивается конструкцией мемристора. Установлено, что в полулогарифмических осях электропроводность СФК-мемристора линейным образом связана с временем рабочего цикла мемристора, что позволило ввести кинетическую константу, определяющую скорость изменения площади поперечного сечения токопроводящего канала. Наличие такой кинетической константы предполагает выполнение закона Аррениуса для электропроводности. Изучение влияния температуры на электропроводность канала СФК-мемристора при частоте переключения 10 Гц показало, что закон Аррениуса выполняется в интервале температур 22–65°С с энергией активации, равной 0.19 эВ. При более низких температурах вплоть до температуры –10°С электропроводность мемристора оказалась малочувствительна к изменению (понижению) температуры, оставаясь практически величиной постоянной.
Работа была выполнена при финансовой поддержке Российского фонда фундаментальных исследований, грант № 19-29-03003 МК.
Авторы заявляют об отсутствии конфликта интересов между ними.
Список литературы
Chua L.O. Memristor – missing circuit element // IEEE Trans. Circuit Theory. 1971. V. 18. № 5. P. 507–519.
Chua L.O., Kang S.M. Memristive devices and systems // Proceedings of the IEEE. 1976. V. 64. P. 209–223.
Yang J.J., Strukov D.B., Stewart D.R. Memristive devices for computing // Nature Nanotechnology. 2013. V. 8. № 1. P. 13–24.
Bersuker G., Gilmer D.C., Veksler D., Kirsch P., Vandelli L., Padovani A., Larcher L., McKenna K., Shluger A., Iglesias V., Porti M., Nafrıa M. Metal oxide resistive memory switching mechanism based on conductive filament properties // J. Appl. Phys. 2011. V. 110. P. 124518.
Kim K.M., Jeong D.S., Hwang C.S. Nanofilamentary resistive switching in binary oxide system; a review on the present status and outlook // Nanotechnology. 2011. V. 22. P. 254002.
Waser R., Aono M. Nanoionics-based resistive switching memories // Nature Materials. 2007. V. 6. № 11. P. 833–840.
Waser R., Dittmann R., Staikov G., Szot K. Redox-Based Resistive Switching Memories – Nanoionic Mechanisms, Prospects, and Challenges // Adv. Mater. 2009. V. 21. P. 2632–2663.
Valov I., Waser R., Jameson J.R., Kozicki M.N. Electrochemical metallization memories – fundamentals, applications, prospects // Nanotechnology. 2011. V. 22. P. 254003.
Linn E., Rosezin R., Kuegeler C., Waser R. Complementary resistive switches for passive nanocrossbar memories // Nature Materials. 2010. V. 9. P. 403–406.
Campbell K.A. Self-directed channel memristor for high temperature operation // Microelectronics Journal. 2017. V. 59. P. 10–14.
Campbell K.A., Anderson C.M. Phase-change memory devices with stacked Ge-chalcogenide/Sn-chalcogenide layers // Microelectronics Journal. 2007. V. 38. P. 52–59.
Edwards A.H., Campbell K.A., Pineda A.C. Self-trapping of single and paired electrons in Ge2Se3 // J. Phys.: Condens. Matter. 2012. V. 24. № 19. P. 195801.
Devasia A., Kurinec S., Campbell K.A., Raoux S. Influence of Sn migration on phase transition in GeTe and Ge2Se3 thin films// Appl. Phys. Lett. 2010. V. 96. P. 141908.
Jarvis K., Carpenter R.W., Davis M., Campbell K.A. An investigation of amorphous Ge2Se3structure for phase change memory devices using fluctuation electron microscopy // J. Appl. Phys. 2009. V. 106. P. 083507.
Aleshin A.N., Enisherlova K.L. Physicochemical fundamentals of phase formation in silicon layers implanted with oxygen and carbon // Modern Electronic Materials. 2019. V. 5. № 2. P. 77–85.
Abe H., Yamamoto S., Miyashita A., Siskafus K.E. Formation mechanism for carbon onions and nanocapsules in C+-ions implanted copper // J. Appl. Phys. 2001. V. 90. № 7. P. 3353–3358.
Есин В.Я. Влияние ассоциатов в границах зерен на параметры зернограничной диффузии // Автореф. дис. … канд. физ.-мат. наук., М.: НИТУ МИСиС, 2011. 25 с.
Campbell K.A., Moore J.T. “Silver-selenide/chalcogenide glass stack for resistance variable memory.” US Patent 7,151,273, issued December 19, 2006.
Бокштейн Б.С., Менделев М.И. Краткий курс физической химии. М.: ЧеРо, 1999. 232 с.
Strukov D.B., Williams R.S. Exponential ionic drift: fast switching and low volatility of thin-film memristors // Appl. Phys. A. 2009. V. 94. P. 515–519.
Дополнительные материалы отсутствуют.
Инструменты
Микроэлектроника



