Российские нанотехнологии, 2021, T. 16, № 6, стр. 825-832
ГЕТЕРОСЛОЕВЫЕ МЕМРИСТИВНЫЕ КОМПОЗИЦИИ ДЛЯ МНОГОУРОВНЕВОЙ МЕМРИСТОРНОЙ ЛОГИКИ. РОЛЬ “РЕЗЕРВУАРА” КИСЛОРОДНЫХ ВАКАНСИЙ
Н. В. Андреева 1, *, А. А. Романов 1, Д. С. Мазинг 1, Д. А. Чигирев 1, Е. Н. Севостьянов 1, М. И. Герасимова 1, В. В. Трушлякова 1, В. В. Лучинин 1
1 Санкт-Петербургский государственный электротехнический университет “ЛЭТИ” им. В.И. Ульянова (Ленина)
Санкт-Петербург, Россия
* E-mail: nvandr@gmail.com
Поступила в редакцию 24.06.2021
После доработки 16.07.2021
Принята к публикации 16.07.2021
Аннотация
Проведено исследование гетерослоевых мемристивных композиций с функциональным слоем оксида алюминия, полученным методом молекулярного наслаивания. Представлен способ организации резервуара кислородных вакансий, обеспечивающий создание широкого окна памяти. В основе предложенного способа лежит использование газопроницаемых по кислороду платиновых электродов в сочетании с адсорбционным слоем аморфного диоксида кремния, сформированного методом плазмохимического осаждения под нижним электродом структуры. Показано, что при определенных условиях слой аморфного диоксида кремния может играть роль резервуара кислородных вакансий для функционального слоя, обеспечивая обратимое изменение концентрации молекулярного кислорода в граничных с электродами областях и обратимую перестройку сопротивления структуры в диапазоне семи порядков по величине.
ВВЕДЕНИЕ
В существующих нейрокомпьютерных системах для обработки данных используются глубокие нейронные сети. Основной проблемой использования глубоких архитектур в таких системах является необходимость распараллеливания потока входных данных для повышения скорости обработки. Возможности распараллеливания потока ограничены шириной шины памяти, а использование графических процессоров приводит к существенному повышению энергопотребления (до 250 Вт на вычислительную плату). Более того, асинхронная активация элементов входных датчиков и непрерывность потока данных затрудняют использование программных алгоритмов нейронных сетей на существующей компьютерной архитектуре, ограничивая быстродействие нейрокомпьютерных систем. Имеющиеся в настоящее время нейроморфные процессоры (Neurogrid [1], TrueNorth [2], DYNAPs [3], SpiNNaker [4], Loihi [5], Braindrop [6]), как правило, работают на существующей электронной компонентной базе. В то же время процесс увеличения степени сложности нейрокомпьютерных систем обусловливает потребность в разработке и использовании современной компонентной базы микро- и наноэлектроники, вытекающей из необходимости снижения энергопотребления по мере дальнейшего масштабирования комплементарной металл–оксид–полупроводник (КМОП)-технологии.
Одним из перспективных подходов к созданию новой компонентной базы является использование структур на основе тонкопленочных мемристивных композиций. Интеграция таких структур в сверхбольшие интегральные схемы, совместимых с КМОП-технологией, как правило, осуществляется посредством активных и пассивных кроссбар-массивов. Данный подход позволяет не только перейти к аппаратной реализации символических вычислений (за счет организации матрично-векторного умножения на базе кроссбар-массивов с мультибитными мемристорами), но и имплементировать основные известные модели обучения и памяти в архитектуру нейронных сетей на аппаратном уровне (при использовании мультибитных мемристоров в качестве электронных эквивалентов синапсов) в автономных нейрокомпьютерных системах. Так, в [7] было продемонстрировано, что использование блоков матрично-векторного умножения на базе мемристивных кроссбар-массивов в архитектуре универсальных ускорителей (PUMA, a programmable ultra-efficient memristor-based accelerator for machine learning interface) позволяет в 2446 раз повысить энергоэффективность и в 66 раз снизить латентность по сравнению с самыми современными графическими ускорителями (state-of-the-art GPU) при решении таких задач искусственного интеллекта, как распознавание изображения, речи и машинный перевод. Аппаратная реализация архитектуры сверточной нейронной сети на базе кроссбар-массивов с мультибитными мемристорами в структуре полностью автономного нейроморфного модуля, предназначенного для распознавания изображения, превзошла аналогичные системы на базе state-of-the-art GPU по энергоэффективности более чем на 2 порядка при сравнимой точности распознавания [8].
Ключевым аспектом использования мемристивных композиций при аппаратной реализации нейроморфных процессоров является возможность создания многоуровневых энергонезависимых состояний за счет аналоговой или цифровой перестройки уровня сопротивления мемристивной структуры. Например, согласно результатам исследований, аппаратная реализация многослойных нейронных сетей на базе мемристорной логики обеспечивает точность распознавания на уровне 92% (сравнимую с программно-реализуемыми алгоритмами нейронных сетей) при наличии 256 уровней сопротивления мемристивной структуры (8-битная мемристорная ячейка). При использовании мемристивных структур с 64 уровнями по сопротивлению (6-битная ячейка) точность распознавания снижается до ⁓86% [9]. В этом случае вопрос о целесообразности аппаратной реализации нейронных сетей может являться весьма спорным, поскольку такие системы будут существенно проигрывать программно-реализуемым алгоритмам нейронных сетей, обеспечивающим точность распознавания на уровне 90–99%.
В настоящее время успешная аппаратная реализация нейроморфных систем на основе мультибитных мемристивных элементов для решения задач искусственного интеллекта была продемонстрирована с использованием металлооксидных тонкопленочных композиций в TiN/TaOx/HfOx/TiN (до 32 уровней по сопротивлению) [10] и Pt/AlxOy/TiO2/Pt (до 92 уровней по сопротивлению) [11] структурах. В основе работы таких мемристивных структур лежит использование характеристик рабочего слоя (HfOx или AlxOy толщиной несколько нанометров), обеспечивающего изменение уровня сопротивления структуры в сочетании с “резервуаром кислородных вакансий” – слоя толщиной до нескольких десятков нанометров, роль которого играет TaOx или TiO2 –x соответственно. Отметим, что в ряде случаев для контролируемого изменения концентрации кислородных вакансий в рабочем слое мемристивной структуры может использоваться управляемое подачей внешнего напряжения окисление одного из электродов устройства. Так, в мемристивной структуре нa основе композиции Ta/HfO2/Pt [12] 64 промежуточных резистивных состояния реализуются за счет окисления тантала на границе “оксид гафния/верхний танталовый электрод” при подаче внешнего напряжения на структуру, вследствие чего происходит электромиграция катионов тантала в слой оксида гафния и анионов кислорода к танталовому электроду, что приводит к образованию кислородных вакансий в активном переключающемся слое. В данном случае тантал играет роль легирующий примеси для слоя оксида гафния, при увеличении концентрации которой происходит образование проводящего канала между электродами структуры. Промежуточные резистивные состояния образуются за счет изменения соотношения ионов тантала и кислородных вакансий в сформированном проводящем канале, а переключение между резистивными состояниями достигается вариацией уровня ограничения по току или количества приложенных к структуре импульсов напряжения.
Как правило, промежуточные по сопротивлению уровни в описанных выше структурах наблюдаются в диапазоне одного–двух порядков по величине. При таком рабочем диапазоне мемристивной структуры возникает проблема дифференциации резистивных состояний, а также существенно повышается вероятность ошибки при считывании/записи информации, что при аппаратной реализации приводит к снижению точности работы нейроморфных систем в целом и, как следствие, необходимости уменьшения количества используемых на практике промежуточных резистивных состояний. Уменьшение разрядности мемристивной ячейки [7], в свою очередь, ограничивает выбор возможных для аппаратной реализации архитектур нейронных сетей.
В [13–16] были разработаны мемристивные системы с многоуровневым резистивным переключением на основе тонкопленочных гетерогенных структур Pt/TiO2/Al2O3/Pt, в которых за счет сочетания особенностей электронного характера биполярного переключения с изменением концентрации кислородных вакансий в активном слое оксида алюминия достигалась аналоговая (многоуровневая) перестройка резистивного состояния в диапазоне семи порядков по величине, а роль резервуара кислородных вакансий играл слой диоксида титана. Поскольку перестройка уровня сопротивления в рассматриваемых структурах обеспечивается тонким, толщиной 5 нм, слоем оксида алюминия, дополнительных исследований требуют вопросы, связанные с влиянием материала верхнего электрода, а также материала “резервуара” кислородных вакансий (роль которого в первом приближении может играть не только диоксид титана) на диапазон и характер изменения резистивного состояния тонких слоев оксида алюминия.
В работе представлены результаты исследования, призванного подтвердить ключевую роль слоя оксида алюминия, определяющего диапазон перестройки сопротивления и наличие многоуровневых резистивных состояний в двухслойных металлооксидных структурах на базе последовательности слоев TiO2/Al2O3. С этой целью предложен альтернативный способ организации резервуара кислородных вакансий, подразумевающий уход от использования слоя диоксида титана в композициях с многоуровневым переключением сопротивления и обеспечивающий обратимую перестройку сопротивления функционального слоя оксида алюминия. Дополнительно для подтверждения роли кислородных вакансий в перестройке резистивного состояния металлооксидных структур было проведено исследование влияния химической активности электродов на проявление резистивных эффектов.
МАТЕРИАЛЫ И МЕТОДЫ
В двухслойных структурах Pt/TiO2(30 нм)/ Al2O3(5 нм)/Pt роль резервуара кислородных вакансий играет слой диоксида титана. Учитывая проницаемость платины по кислороду, резервуар кислородных вакансий, расположенный под нижним электродом, также должен оказывать влияние на изменение резистивного состояния тонких слоев оксида алюминия. В качестве такого резервуара использовался слой аморфного диоксида кремния, который выполнял роль адсорбционного слоя (далее адсорбционный слой). Для определения влияния организованного таким образом резервуара кислородных вакансий на характер и диапазон перестройки резистивного состояния были изготовлены структуры с аналогичным по толщине и параметрам синтеза функциональным слоем оксида алюминия, но без адсорбционного слоя под нижним электродом.
Для синтеза структур без резервуара кислородных вакансий (рис. 1) использовали подложки монокристаллического кремния, на которых методом термического окисления формировали барьерный слой SiO2. Далее методом магнетронного распыления наносили адгезионный слой металлического титана толщиной 10 нм, после чего методом триодного вакуумного напыления формировали “нижний” платиновый электрод толщиной 50 нм.
Рис. 1.
Схематичное изображение исследуемых тонкопленочных структур: a – Si/SiO2/Ti/Pt/Al2O3/Pt, б – Si/аморфный SiO2/Pt/Al2O3/Pt, в – Si/аморфный SiO2/Pt/Al2O3/V.

В композициях с резервуаром кислородных вакансий (рис. 1б, 1в) роль адсорбционного слоя играл аморфный диоксид кремния толщиной 200 нм, сформированный методом плазмохимического осаждения (PE-CVD) на поверхности монокристаллического кремния. “Нижний” Pt-электрод в структурах с адсорбционным слоем формировали методом триодного вакуумного напыления без использования адгезионного подслоя титана.
Синтез функционального слоя оксида алюминия Al2O3 толщиной 10 нм осуществляли методом молекулярного наслаивания (МН, Atomic Layer Deposition (ALD)) с использованием триметил-алюминия и деионизованной воды в качестве прекурсоров при температуре 150°С.
Платина, используемая в [13–16] в качестве материала верхнего электрода в ранее разработанных структурах Pt/TiO2(30 нм)/Al2O3(5 нм)/Pt с многоуровневым переключением сопротивления, обладает двумя свойствами, которые могут оказывать существенное влияние на их работу: это – проницаемость по кислороду и ее каталитическая активность. Учитывая тот факт, что создание многоуровневых резистивных состояний обусловлено изменением концентрации кислородных вакансий, проницаемость верхнего электрода по кислороду может вносить огромный вклад в характер перестройки сопротивления мемристивной структуры в целом. Таким образом, роль кислорода можно косвенно установить, если заменить материал одного из электродов структуры на легко окисляющийся. В этом случае при исключении из структуры резервуара кислородных вакансий перестройка сопротивления слоя оксида алюминия будет сопровождаться выделением кислорода на одном из электродов и может приводить к его окислению. Наличие оксида материала верхнего электрода в определенных случаях можно установить по особенностям вольт-амперных характеристик (ВАХ) структуры. Так, ванадий обладает целым рядом оксидов, в которых при подаче внешнего управляющего напряжения происходит фазовый переход “полупроводник–металл”, сопровождающийся изменением сопротивления [17]. Следовательно, если в качестве материала одного из электродов использовать ванадий, его окисление может сопровождаться появлением “сигнатуры” фазового перехода оксида ванадия на ВАХ структуры.
С целью определения роли кислородных вакансий в изменении резистивного состояния функционального слоя для “верхних” электродов структур были выбраны два материала: платина, обладающая нейтральной химической активностью по отношению к атмосфере, и легко окисляющийся ванадий. Создание конденсаторной структуры завершали формированием “верхних” контактных площадок методом магнетронного напыления металла через теневую маску с диаметром отверстий 350 мкм. Толщина “верхних” Pt-электродов составляла 50 нм. Измерения ВАХ, а также динамики резистивного состояния структуры во времени под действием приложенного напряжения проводили с применением многофункционального модульного характериографа Keithley 4200-SCS (Keithley Instruments, США).
Исследование топографии слоев оксида алюминия проводили методом атомно-силовой микроскопии (АСМ) (Veeco Dimension 3100, США) при комнатной температуре. Метод позволяет исследовать локальные особенности топографии поверхности с разрешением <10 нм. Измерения проводили в полуконтактном режиме с использованием стандартных кремниевых зондов NCG10 (NT-MDT SI, Россия) со средними значениями постоянной жесткости и резонансной частоты 11.8 Н/м и 240 кГц соответственно. Толщину нижнего Pt-электрода контролировали по “свидетелю” из монокристаллического кремния с атомарно-гладкой поверхностью. Для этого на его поверхность наносили фоторезист со сформированным методом фотолитографии рисунком. После нанесения Pt-пленок “свидетель” помещался в диметилформамид, где происходило удаление фоторезиста (“взрывная” фотолитография). Толщину Pt-пленок определяли методом АСМ по рельефу, оценивали перепад высот между поверхностью кремния и поверхностью Pt-пленки.
РЕЗУЛЬТАТЫ
Особенности топографии поверхности синтезированных слоев оксида алюминия анализировали с использованием пакета ПО Gwyddion [18]. Сравнение топографии поверхности функциональных слоев структур Si/SiO2/Ti/Pt/Al2O3 (без резервуара кислородных вакансий) и Si/аморфный SiO2/Pt/Al2O3 (с резервуаром кислородных вакансий) с топографией поверхности оксида алюминия, сформированного в том же ALD-процессе на “свидетеле” из монокристаллического кремния с атомарно-гладкой поверхностью, позволило сделать вывод об аморфной структуре синтезированных слоев оксида алюминия с рельефом, повторяющим рельеф нижнего Pt-электрода.
Исследование динамики резистивного состояния структур Si/SiO2/Ti/Pt/Al2O3/Pt под действием внешнего напряжения показало возможность необратимого изменения сопротивления слоя оксида алюминия на 3 порядка по величине, которое наблюдается при подаче напряжения отрицательной полярности на верхний электрод структуры (UTE). Зависимости тока, протекающего через структуру, от времени, в течение которого к структуре прикладывалось напряжение, приведены на рис. 2а (для удобства зависимости приведены в двойном логарифмическом масштабе). Существенным является то, что изменение резистивного состояния слоя оксида алюминия наблюдается только при определенной величине прикладываемого к структуре напряжения отрицательной полярности (для слоев оксида алюминия толщиной 10 нм UTE = –5.8 В). Как видно из приведенных на рис. 2а зависимостей, подача напряжения положительной полярности той же величины не приводит к изменению уровня сопротивления структуры, а при ее увеличении наблюдается пробой структуры. При этом как в исходном состоянии, так и в состоянии, наблюдаемом после перестройки уровня сопротивления, ВАХ тонких пленок Al2O3 остаются нелинейными и симметричными (рис. 2б).
Рис. 2.
Особенности перестройки резистивного состояния структуры Si/SiO2/Ti/Pt/Al2O3/Pt: а – динамика резистивного состояния структуры при подаче внешнего напряжения между электродами структуры положительной и отрицательной полярности; б – ВАХ структуры в исходном состоянии и после долговременной (в течение 600 с) подачи напряжения отрицательной полярности.
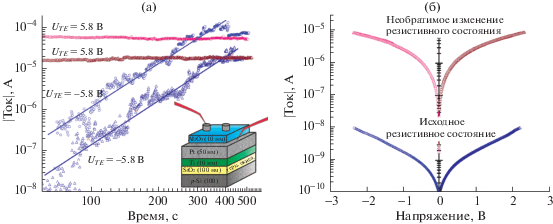
Обратимая перестройка резистивного состояния в диапазоне семи порядков по величине наблюдается в структурах Pt/Al2O3/Pt с адсорбционным слоем аморфного диоксида кремния, расположенным под нижним платиновым электродом (рис. 3а). Исходное состояние таких структур является низкоомным, а ВАХ – нелинейными и симметричными. Обратимое изменение уровня сопротивления достигается только в том случае, если первое переключение структуры в высокоомное состояние происходит при подаче напряжения положительной полярности на верхний электрод. Для переключения в низкоомное состояние требуются более низкие величины напряжения (UTE < 0.4 В). При этом существенную роль в обратном переключении играет время, в течение которого к структуре прикладывается напряжение. Как правило, для воспроизводимого переключения в исходное низкоомное состояние требуется время порядка нескольких секунд. При меньших временах переключения структуры в низкоомное состояние не наблюдается. Более того, если амплитуда напряжения, прикладываемого к структуре в высокоомном состоянии, превосходит величину, равную 0.6 В, происходит неконтролируемый переход в промежуточное (между самым высокоомным и самым низкоомным) по сопротивлению состояние. Промежуточные резистивные состояния наблюдаются во всем диапазоне изменения сопротивления структуры, однако алгоритм перехода между ними пока остается невоспроизводимым. Также из промежуточного состояния часто наблюдается резкий переход в самое высокоомное состояние структуры, сопротивление в котором на 1–2 порядка по величине превышает ограничивающий обратимое переключение высокоомный уровень. Такое состояние структуры характеризуется стабильностью во времени, отсутствием возможности перестройки внешним напряжением, а также высокими величинами напряжения пробоя (~25 В для используемых толщин тонких слоев оксида алюминия). Отметим, что наблюдаемая перестройка сопротивления в диапазоне семи порядков по величине в структурах Pt/Al2O3/Pt с адсорбционным слоем аморфного диоксида кремния происходит только при определенных толщинах нижнего Pt-электрода, не превышающих 100 нм.
Рис. 3.
Особенности перестройки резистивного состояния структур, в которых в качестве резервуара ионных групп использовался аморфный диоксид кремния. Цифрами обозначена последовательность изменения состояния сопротивления структур; а – структуры с Pt-электродами: 0 и 1 – исходное состояние структуры, 2 – переключение в высокоомное состояние, 3 и 4 – высокоомное состояние структуры, 5 – переключение в низкоомное состояние, 6 – низкоомное состояние структуры. Приведены ВАХ для трех последовательных переключений из низкоомного в высокоомное состояние (пунктирная линия) и двух переключений из высокоомного в низкоомное состояние (сплошная линия). Структуры с ванадиевыми электродами (б). Приведены 10 последовательно измеренных ВАХ, девять ВАХ изображены серым цветом, и по одной ВАХ для каждой полярности выделены пунктирной линией на фоне серых кривых.
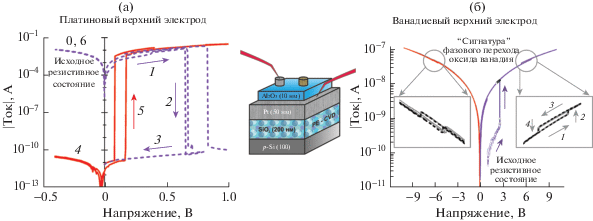
Исходное состояние структур с адсорбционным слоем аморфного диоксида кремния и верхними ванадиевыми электродами является высокоомным (рис. 3б), ВАХ – нелинейные и симметричные. Обращает на себя внимание то, что уровни сопротивления структур Si/аморфный SiO2/Pt/Al2O3/V и Si/SiO2/Ti/Pt/Al2O3/Pt в исходном состоянии сопоставимы по порядку величины. В независимости от полярности прикладываемого к структуре напряжения наблюдается незначительное (в пределах одного порядка по величине) изменение исходного резистивного состояния структур Si/аморфный SiO2/Pt/Al2O3/V. При этом происходит изменение характера ВАХ, которые, оставаясь нелинейными и симметричными, демонстрируют “сигнатуру” переключения одного из оксидов ванадия в диапазоне величин напряжений ~5.5–6.5 В (вставка на рис. 3б). Особенности ВАХ, ассоциируемые с переключением сопротивления оксида ванадия [17], заключаются в появлении скачкообразного изменения сопротивления структуры на прямой ветви ВАХ при |UTE| ≈ 6.5 В, которое на обратной ветви ВАХ также скачком возвращается к своему исходному состоянию при |UTE| ≈ 5.5 В. Данная особенность наблюдается в области как отрицательных, так и положительных напряжений и с большой точностью воспроизводится при многократном последовательном повторении (циклировании) измерений ВАХ.
ОБСУЖДЕНИЕ
Необратимое изменение сопротивления тонкого слоя оксида алюминия под действием внешнего напряжения определенной полярности, наблюдаемое в структурах Si/SiO2/Ti/Pt/Al2O3/Pt без резервуара кислородных вакансий, заставляет предположить возможное влияние дополнительных факторов на процесс многоуровневой аналоговой перестройки резистивного состояния в тонкопленочных металлооксидных структурах. Анализ полученных результатов был проведен с учетом особенностей технологии молекулярного наслаивания функциональных тонкопленочных слоев. Согласно [19] поверхность слоев ALD-Al2O3 сильно гидроксилирована, т.е. при проведении синтеза при заданных условиях в объеме функционального слоя структуры будут присутствовать как химически связанные, так и адсорбированные ОН-группы. В ряде случаев каждый гидроксид может быть связан с одним или несколькими катионами алюминия, что может приводить к формированию нестабильных алюмокислородных конфигураций, в которых положение катиона Al3+ не сбалансировано [20]. При подаче отрицательного напряжения могут наблюдаться миграция катионов алюминия к верхнему электроду и накопление отрицательно заряженных ОН-групп на границе “нижний платиновый электрод–оксид алюминия”. Группы ОН– на нижнем электроде могут встраиваться в структуру платины или приводить к образованию протонов [21]. В отличие от жидкостей протоны в твердых телах сильно связаны с анионами кислорода (${\text{OH}}_{{\text{O}}}^{\centerdot }$), их миграция в этом случае происходит скачками по позициям кислорода и сопровождается образованием и разрывом O–H-связей. Таким образом, дополнительно с миграцией катионов алюминия к верхнему электроду возможна миграция протонов к верхнему электроду. Однако при адсорбционно-каталитической активности платины по отношению к водороду на границе с нижним платиновым электродом будет наблюдаться выделение газообразного водорода в соответствии с реакцией (в обозначениях Крегера–Винка):
Образующийся в данной реакции кислород может приводить к окислению нижнего Pt-электрода с образованием положительно заряженных кислородных вакансий, которые также будут мигрировать в направлении верхнего электрода, играющего роль катода:
При газопроницаемости верхнего электрода, при обратной полярности прикладываемого напряжения наиболее вероятно будет происходить выделение газообразного кислорода, не сопровождающееся изменением концентрации кислородных вакансий в структуре тонкой пленки аморфного оксида алюминия.
В пользу данной гипотезы свидетельствует тот факт, что в ряде случаев формовка мемристивных структур с Pt-электродами может сопровождаться нарушением их целостности с характерным для процессов газовыделения образованием цилиндрических каналов в структуре и обусловленным адсорбционно-каталитической активностью платины по отношению к водороду [21].
Дополнительное подтверждение роли гидроксильных групп в необратимой перестройке сопротивления структур Si/SiO2/Ti/Pt/Al2O3/Pt было получено при исследовании аналогичных структур, температура ALD-синтеза функциональных слоев которых была увеличена на 50°С. Так, в структурах с более высокотемпературным оксидом алюминия изменения резистивного состояния не происходило вплоть до напряжений, соответствующих пробою. Данное обстоятельство можно объяснить уменьшением количества ОН-групп в объеме слоя оксида алюминия при увеличении температуры синтеза.
Прежде чем перейти к анализу результатов, полученных при исследовании структур с адсорбционным слоем аморфного диоксида кремния, хотелось бы обратить внимание на то, что, согласно данным [22], энергия образования кислородной вакансии в кристаллическом оксиде алюминия довольно велика и, например, для α-Al2O3 составляет ~8 эВ. Аморфная фаза оксида алюминия характеризуется меньшими значениями плотности 3.1–3.3 г/см3, ширины запрещенной зоны 6.2–6.5 эВ и координационными числами алюминия (4) и кислорода (2.67) [23], что, однако, не приводит к существенному снижению энергии образования кислородной вакансии. Тем не менее в ряде работ было показано, что при контакте аморфного оксида алюминия со слоем, играющим роль “резервуара” кислородных вакансий (в качестве которого часто рассматриваются нестехиометрические слои оксидов гафния, тантала и титана), энергии образования кислородной вакансии в аморфном оксиде алюминия могут уменьшаться [22].
Помимо нестехиометрических слоев оксидов переходных металлов наличие слоя аморфного оксида кремния может приводить к увеличению концентрации кислородных вакансий в рабочем слое Al2O3 за счет геттерных свойств по кислороду. Интересно, что исходное состояние синтезированных структур Si/аморфный SiO2/Pt/Al2O3/Pt является низкоомным. Данное обстоятельство указывает на максимально возможное содержание кислородных вакансий в структуре Al2O3 с верхним Pt-электродом в исходном состоянии, положительный заряд которых должен быть скомпенсирован отрицательно заряженными ОН-группами. Предположительно, низкоомное состояние структур Si/аморфный SiO2/Pt/Al2O3/Pt обусловлено особенностями их синтеза. При приложении напряжения положительной полярности к верхнему электроду наиболее вероятными реакциями, исходя из величин окислительно-восстановительных потенциалов, будут:
– на границе с верхним электродом области –
4OH– ↔ 2H2O + O2 + 4e– (окислительно-восстановительный потенциал +0.4 В);
– на границе с нижним электродом области –
O2 + 4e– ↔ 2O2– (окислительно-восстановительный потенциал –1.2 В).
Образование анионов кислорода в области нижнего электрода становится возможным в силу того, что платина является газопроницаемой, а расположенный под ней слой аморфного оксида кремния в такой структуре содержит достаточное количество адсорбированной воды и молекулярного кислорода. Образование анионов кислорода приводит к уменьшению количества кислородных вакансий в тонком слое оксида алюминия и переключению структуры в высокоомное состояние. Обратное переключение может происходить при той же полярности прикладываемого к структуре напряжения за счет сдвига химического равновесия, участвующего в процессе реакций.
Ключевая роль кислородных вакансий в перестройке резистивного состояния функциональных слоев Al2O3 подтверждается и результатами исследований структур с адсорбционным слоем оксида кремния, в которых верхний Pt-электрод заменялся ванадиевым, что приводило к кардинальному изменению их рабочих характеристик. Появление особенностей ВАХ, свидетельствующих о происходящем в структуре фазовом переходе “полупроводник–металл” оксида ванадия [17], свидетельствует об образовании слоя оксида ванадия при окислении верхнего электрода на границе с оксидом алюминия, происходящего, по всей видимости, вследствие выделения молекулярного кислорода в реакциях с участием ОН-групп. Постепенное “расходование” ОН-групп и образование анионов кислорода на границе с нижним электродом (при снижении вероятности генерации кислородных вакансий на границе с нижним Pt-электродом вследствие наличия адсорбционного слоя оксида кремния) будет приводить к тому, что моногидроксиоксид алюминия, теряя гидроксильную группу, перейдет в стехиометрическую структуру оксида.
ЗАКЛЮЧЕНИЕ
Предложен подход к организации мемристивных структур с широким окном памяти (в диапазоне семи порядков по величине) за счет использования слоев, обладающих геттерными свойствами по кислороду. Суть подхода сводится к использованию определенных в [16] ранее закономерностей многоуровневого переключения сопротивления в структурах на основе последовательности тонких слоев оксидов титана и алюминия, в которых функциональным слоем является слой оксида алюминия, а роль резервуара кислородных вакансий отводится слою диоксида титана.
В исследованных мемристивных композициях Si/аморфный SiO2/Pt/Al2O3/Pt с функциональным слоем оксида алюминия резервуаром кислородных вакансий служит слой аморфного диоксида кремния, расположенный под нижним проницаемым по кислороду Pt-электродом. Наблюдаемый диапазон перестройки резистивного состояния таких структур совпадает по величине с диапазоном ранее разработанных структур [16] на основе последовательности слоев TiO2/Al2O3, что является дополнительным подтверждением выдвинутых предположений о функциональном назначении слоев в двухслойных мемристивных структурах с многоуровневым переключением сопротивления [13, 14].
Согласно полученным результатам управляемое изменение концентрации кислородных вакансий в мемристивных структурах Si/аморфный SiO2/Pt/Al2O3/Pt происходит за счет сочетания особенностей реакций, протекающих с участием ОН-групп и наличия “резервуара”, позволяющего обратимо изменять концентрацию молекулярного кислорода в граничных с электродами структуры областях. Предложенный подход позволяет рассчитывать на уменьшение величин рабочих напряжений параметров мемристивных ячеек с многоуровневой перестройкой резистивного состояния в широком диапазоне сопротивлений.
Работа выполнена при финансовой поддержке Министерства науки и высшего образования Российской Федерации; государственное задание в области научной деятельности FSEE-2020-0013.
Список литературы
Benjamin B.V., Gao P., McQuinn E. et al. // Proc. IEEE. 2014. V. 102. № 5. P. 699.
Merolla P.A., Arthur J.V., Alvarez-Icaza R. et al. // Science. 2014. V. 345. № 6197. P. 668.
Morandi S., Qiao N., Stefanin F. et al. // IEEE Trans. Biomed. Circuits Syst. 2018. V. 12. № 1. P. 106.
Painkras E., Plana L.A., Garside J. // IEEE J. Solid-State Circuits. 2013. V. 48. № 8. P. 1943.
Davies M., Srinivasa N., Lin T.-H. // IEEE Micro. 2018. V. 38. № 1. P. 82.
Neckar A., Stewart T.C., Benjamin B.V. et al. // IEEE International Symposium on Circuits and System (ISCAS). 2018. P. 1.
Ankit A., Hajj I.EI., Chalamalasetti S.R. et al. // ASPLOS’19: Proceedings of the Twenty-Fourth International Conference on Architectural Support for Programming Languages and Operating Systems. 2019. P. 715.
Yao P., Wu H., Gao B. et al. // Nature. 2020. V. 577. P. 641.
Shi Y., Nguyen L., Oh S. et al. // Nat. Commun. 2018. V. 9. P. 5312.
Liu Q., Gao B., Yao P. et al. “33.2 A fully integrated analog ReRAM based 78.4 TOPS/W compute-in-memory chip with fully parallel MAC computing,” in 2020 IEEE International Solid-State Circuits Conference-(ISSCC), 2020. P. 500.
Stathopoulos S., Khiat A., Trapatseli M. et al. // Sci Rep. 2017. V. 7. P. 17532. https://doi.org/10.1038/s41598-017-17785-1
“Memristor device”, patent US 10186660B2 (USA). 2019.
Andreeva N., Ivanov A., Petrov A. // AIP Adv. 2018. V. 8. P. 025208.
Alekseeva L., Nabatame T., Chikyow T. et al // Jpn. J. Appl. Phys. 2016. V. 55. P. 08PB02.
Петров А., Алексеева Л., Иванов А. и др. // Наноиндустрия. 2016. № 1. С. 63.
Андреева Н.В., Лучинин В.В., Рындин Е.А. Мемристивный синапс. Патент 202461 (Россия). 2021.
Andreeva N.V., Turalchuk P.A., Chigirev D.A. et al. // Chaos, Solitons Fractals. 2021. V. 142. P. 110503. https://doi.org/10.1016/j.chaos.2020.110503
Nečas D., Klapetek P. // Cent. Eur. J. Phys. 2012. V. 10 (1). P. 181. http://gwyddion.net/.
Goldstein D.N., McCormick J.A. // J. Phys. Chem. 2008. V. 112. P. 19530.
Чукин Г.Д. Строение оксида алюминия и катализаторов гидрообессеривания. Механизмы реакций. М.: Типография Паладин, 2010. 288 с.
Lübben M., Wiefels S., Waser R., Valov I. // Adv. Electron. Mater. 2017. P. 1700458. https://doi.org/10.1002/aelm.201700458
Yang M.Y., Kamiya K., Magyari-Kope B. et al. // Appl. Phys. Lett. 2013. V. 103 (9). P. 093504.
Liu D., Clark S.J., Robertson J. // Appl. Phys. Lett. 2010. V. 96. P. 032905. https://doi.org/10.1063/1.3293440
Дополнительные материалы отсутствуют.
Инструменты
Российские нанотехнологии


