Российские нанотехнологии, 2021, T. 16, № 6, стр. 751-760
ЗАПОМИНАЮЩИЕ СВОЙСТВА МЕМРИСТОРОВ НА ОСНОВЕ ОКСИДА И НИТРИДА КРЕМНИЯ
В. А. Гриценко 1, 2, 3, А. А. Гисматулин 1, *, О. М. Орлов 4
1 Институт физики полупроводников им. А.В. Ржанова СО РАН
Новосибирск, Россия
2 Новосибирский государственный университет
Новосибирск, Россия
3 Новосибирский государственный технический университет
Новосибирск, Россия
4 Научно-исследовательский институт молекулярной электроники
Москва, Россия
* E-mail: aagismatulin@isp.nsc.ru
Поступила в редакцию 21.06.2021
После доработки 12.07.2021
Принята к публикации 12.07.2021
Аннотация
Оксид и нитрид кремния являются двумя ключевыми диэлектриками в современных кремниевых приборах. Рассмотрены запоминающие свойства мемристоров на основе SiNx и SiOx, полученных плазмохимическим осаждением, методом пиролиза и высокочастотным реактивным распылением. Нитриды, полученные высокочастотным реактивным распылением, обладают наилучшими запоминающими свойствами: окно памяти 102, количество циклов перепрограммирования до 109 при сохранении окна памяти, окно памяти не меняется за время хранения 105 с.
ОГЛАВЛЕНИЕ
Введение
1. Методы получения мемристоров
2. Результаты и их обсуждение
2.1. Запоминающие свойства мемристоров на основе пиролитического нитрида кремния
2.2. Запоминающие свойства мемристоров на основе плазмохимического и физически осажденного нитрида кремния
2.3. Запоминающие свойства мемристоров на основе плазмохимического оксида кремния
Заключение
ВВЕДЕНИЕ
Развитие и реализация концепции искусственного интеллекта (ИИ) являются приоритетными направлениями научно-технического прогресса [1]. Одной из задач, на решение которых ориентирована разработка ИИ, является обработка больших массивов данных для облачных вычислений (Big Data) [2, 3]. Кроме того, ИИ и искусственные нейронные сети необходимы для машинного обучения и самообучения, компьютерного зрения и распознавания голоса [4]. Это задачи огромной трудности для современных компьютеров фон-неймановской архитектуры, где память и обработка информации физически разделены, тогда как человеческий мозг решает их за доли секунды, причем с энергозатратами на 5–6 порядков меньше [4].
Развитие ИИ осуществляется в трех направлениях. Во-первых, разработка элементов памяти с многоуровневым (мультибитным) переключением как искусственных аналогов синапсов в нейронных сетях [5, 6]. Во-вторых, разработка быстродействующей энергонезависимой, энергоэкономной флэш-памяти терабитного масштаба, сохраняющей информацию в течениe 10 лет при 85°С [7, 8]. В-третьих, разработка универсальной памяти, сочетающей в себе высокое быстродействие и неограниченное число циклов перепрограммирования оперативной памяти, энергонезависимость флэш-памяти, высокую информационную емкость и низкую стоимость магнитных жестких дисков [9]. Компьютер с использованием универсальной памяти не надо будет “загружать”: сразу после включения он будет готов продолжить работу с того самого места, на котором она была прервана. Быстродействие и информационная емкость компьютеров на основе универсальной памяти будут гигантскими.
Многообещающим кандидатом на память, обладающей перечисленными характеристиками, является мемристорная, т.е. резистивная память (Resistive Random-Access Memory – ReRAM). Эта память основана на обратимом переходе тонкой диэлектрической пленки между состояниями с различным сопротивлением при протекании импульса тока. Ключевой проблемой на пути разработки ReRAM большой емкости и мультибитных мемристоров являются понимание физики резистивного переключения тонких диэлектрических пленок, свойств различных резистивных состояний, а также поиск материалов, наиболее подходящих для разработки такой памяти [10, 11].
В настоящее время мемристорная память разрабатывается на основе широкого класса материалов. Это диэлектрики с высокой диэлектрической проницаемостью, такие как TaOx [12], HfOx [13], ZrOx [14], TiOx [15, 16], AlOx [17], NbOx [18], SiOx [19], SiNx [20, 21], GeOx [22], перовскиты [23, 24], органические пленки [25].
С точки зрения механизма переключения мемристора между высокоомным и низкоомным состояниями в настоящее время доминирует филаментарная модель. Согласно этой модели переход из высокоомного (high resistive state – HRS) в низкоомное (low resistive state – LRS) состояние осуществляется за счет образования проводящего металлического или полупроводникового мостика. Диаметр филамента лежит в диапазоне 1–10 нм.
Аморфные оксид (стехиометрический SiO2, нестехиометрический SiOx) и нитрид кремния (стехиометрический Si3N4, нестехиометрический SiNx) являются двумя ключевыми диэлектриками в современных кремниевых приборах. Термический оксид кремния SiO2 не содержит ловушек и обеспечивает качественную границу с кремнием. Нитрид кремния, наоборот, имеет высокую концентрацию (1019–1021 см–3) электронных и дырочных ловушек [26].
Нитрид кремния обладает эффектом памяти, способностью локализовать инжектированные в него электроны и дырки с гигантским временем жизни локализованных электронов, 10 лет при 85°С. Эффект памяти в нитриде кремния используется в приборах современной флэш-памяти терабитного масштаба [27].
Преимуществом мемристорной памяти на основе оксида и нитрида кремния является то, что технология этих материалов детально разработана в современных кремниевых приборах. Цель настоящей работы – краткий обзор запоминающих свойств мемристоров на основе оксида и нитрида кремния.
1. МЕТОДЫ ПОЛУЧЕНИЯ МЕМРИСТОРОВ
Существует несколько основных технологий синтеза оксидных и нитридных пленок для кремниевых приборов. Ключевой технологией синтеза стехиометрического оксида кремния SiO2 является термическое окисление кремния в кислороде. Однако такие пленки непригодны в качестве активной среды мемристора, так как активная среда мемристора должна содержать вакансии кислорода, которые выступают в качестве прекурсоров филамента. В мемристорах на основе оксидных диэлектриков активная диэлектрическая среда должна быть нестехиометрической, содержать высокую концентрацию вакансий кислорода [28].
В [29] показано, что обработка термического SiO2 в водородной плазме приводит к обогащению оксида избыточным кремнием, благодаря чему он может демонстрировать мемристивные свойства.
Другим способом получения нестехиометрического оксида кремния, обогащенного кремнием SiOx, является плазмохимическое осаждение (ПХО) путем окисления силана в плазме.
Почти стехиометрический нитрид кремния Si3N4 с высокой концентрацией Si–Si-связей [30] получают методом пиролиза в реакторе пониженного давления при температурах в диапазоне 700–800°С смеси дихлорсилана SiH2Cl2 и аммиака NH3.
Нестехиометрический нитрид кремния SiNx, обогащенный избыточным кремнием, получают ПХО из смеси силана SiH4 и аммиака NH3 при температурах в диапазоне 200–400°С. В отличие от пиролитического нитрида кремния плазмохимический нитрид содержит высокую концентрацию водородных Si–H- и N–H-связей. В настоящей работе рассмотрены запоминающие свойства мемристоров на основе SiNx и SiOx, полученных по разным технологиям.
2. РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
2.1. Запоминающие свойства мемристоров на основе пиролитического нитрида кремния
Запоминающие свойства мемристоров на основе пиролитического нитрида кремния изучались в [31–35]. На рис. 1 представлена петля гистерезиса металл–нитрид–оксид–полупроводник (МНОП) мемристора структуры Si/SiO2(2 нм)/Si3N4(5 нм)/Ni c тонким подслоем SiO2 после нескольких циклов переключения при комнатной температуре [31]. Окно памяти такого мемристора около трех порядков.
На рис. 2 представлена зависимость окна мемристора от числа циклов перепрограммирования при комнатной температуре, на рис. 3 – зависимость окна памяти мемристора Si/SiO2(2 нм)/Si3N4(5 нм)/Ni от времени при 85°С. Окно памяти не уменьшается со временем.
Рис. 2.
Циклирование в МНОП-мемристоре при комнатной температуре. Длительность импульса 50 мс, напряжение включения Vset = 4.5 В, напряжение выключения Vreset = –3.5 В, напряжение чтения Vread = = 0.5 В [31, 32].
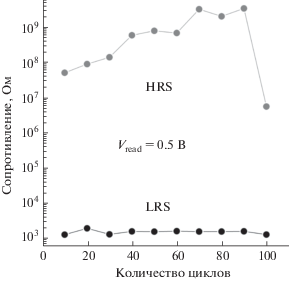
Был изучен механизм транспорта заряда мемристора Si/SiO2(2 нм)/Si3N4(5 нм)/Ni при трех температурах в HRS- и LRS-состояниях. Количественный анализ показал, что эффект Френкеля не описывает перенос заряда мемристора в HRS- и LRS-состояниях. В связи с этим был проанализирован механизм токов, ограниченных пространственным зарядом (ТОПЗ). Теория ТОПЗ между плоскими параллельными электродами представлена в [36].
Основные уравнения модели ТОПЗ:
(1)
$I = {{I}_{{{\text{Ом}}}}} + {{I}_{{{\text{ТОПЗ}}}}} = Se{{\mu }}n\frac{U}{d} + S\frac{9}{8}{{\mu \varepsilon }}{{{{\varepsilon }}}_{0}}{{\theta }}\frac{{{{U}^{2}}}}{{{{d}^{3}}}},$(2)
$\begin{gathered} n = \frac{{2{{N}_{d}}}}{{1 + \sqrt {1 + \frac{{4g{{N}_{d}}}}{{{{N}_{c}}}}\exp \left( {\frac{{{{E}_{a}}}}{{kT}}} \right)} }},\quad {{N}_{c}} = 2{{\left( {\frac{{2\pi m{\text{*}}kT}}{{{{h}^{2}}}}} \right)}^{{3/2}}}, \\ {{\theta }} = \frac{1}{{1 + \frac{{{{N}_{t}}}}{{{{N}_{c}}}}\exp \left( {\frac{{{{W}_{t}}}}{{kT}}} \right)}}, \\ \end{gathered} $На рис. 4 представлены экспериментальные вольт-амперные характеристики (ВАХ) в HRS-состоянии при трех температурах и соответствующие расчеты по модели ТОПЗ. Наблюдается хорошее согласие эксперимента и теории при величинах параметров, указанных на рисунке.
Рис. 4.
Вольтамперные характеристики ReRAM Si/SiO2/Si3N4/Ni в HRS-состоянии и кривые моделирования на основе модели ТОПЗ [31, 32].

На рис. 5 представлены эксперимент и расчет для транспорта заряда мемристора в LRS-состоянии.
Рис. 5.
Вольтамперные характеристики ReRAM Si/SiO2/Si3N4/Ni в LRS-состоянии и кривые моделирования на основе модели ТОПЗ [31, 32].

Модель ТОПЗ имеет много параметров. Чтобы уменьшить количество переменных параметров, некоторые параметры взяты из опубликованных данных. Значения эффективной массы (m* = = 0.5 me) и статической диэлектрической проницаемости (ε = 7) взяты из типичных значений для Si3N4 [37–39]. Поскольку эксперимент показал, что МНОП-мемристор без формовки, в состоянии HRS принимаем параметр S в качестве всего контакта (r = 100 мкм). Предполагаем модель проводимости филамента в структуре МНОП в LRS, где филамент представляет собой аморфный кремний. Поэтому для случая LRS взяли подвижность, равную подвижности в аморфном кремнии (μ = 1 см2/(В с)). Концентрация доноров определяет теоретический наклон кривой в модели ТОПЗ при низких напряжениях, а концентрация ловушек – наклон при высоких напряжениях. Вольтамперные характеристики мемристора МНОП в HRS хорошо описываются моделью ТОПЗ с концентрацией доноров Nd = 1 × 1019 см–3, энергией активации Ea = 0.91 эВ, концентрацией ловушек Nt = 5 × 1018 см–3 и энергией ловушки Wt = 0.5 эВ (рис. 6). Перенос заряда проходит через всю площадь контакта, и подвижность, полученная из модели ТОПЗ, равна μ = 2.5 × × 10–4 см2/(В с). Похожее значение подвижности получено в [40].
Энергия активации доноров из модели ТОПЗ довольно велика. Все это указывает на то, что перенос заряда происходит через нитрид кремния. Вольт-амперные характеристики МНОП мемристора в состоянии LRS слабо зависят от температуры, поэтому степень заполнения ловушек θ = 1 (рис. 5), хотя с ростом температуры ток на омическом участке ВАХ увеличивается, это указывает на то, что природа филамента ближе к полупроводнику, чем к металлу. При сравнении с экспериментом модель ТОПЗ дает следующие параметры: концентрация доноров Nd = 1 × 1020 см–3 и энергия активации Ea = 0.06 эВ. Если взять параметр подвижности как для аморфного кремния, то эффективный радиус такого филамента, согласно модели ТОПЗ, будет r = 50 нм. Механизм переноса заряда и свойства накопления заряда в мемристоре сильно зависят от технологии изготовления активного слоя мемристора. Толщина оксида и нитрида кремния сопоставима с МНОП из [41].
Изученные МНОП-мемристоры не требуют процедуры формовки.
2.2. Запоминающие свойства мемристоров на основе плазмохимического и физически осажденного нитрида кремния
Запоминающие свойства мемристоров на основе плазмохимического и физически осажденного нитрида кремния изучались в [42–45]. На рис. 6 представлены ВАХ мемристора при циклировании на основе плазмохимического нитрида кремния p++-Si/SiNx(33 нм)/Ni. Окно памяти мемристора на основе плазмохимического нитрида составляет около одного порядка. На рис. 7 представлены циклирование при комнатной температуре (а) и хранение информации при 85°С (б). Мемристор выдерживает до 104 циклов перепрограммирования и может хранить информацию до 10 лет при 85°С.
Рис. 7.
Циклирование (а) и хранение информации при 85°С мемристора на основе плазмохимического нитрида кремния p++–Si/SiNx(3.3 нм)/Ni [45].

На рис. 8 показаны ВАХ мемристора на основе плазмохимического нитрида кремния в двойном логарифмическом масштабе, измеренные при разных температурах в различных состояниях мемристора [45]. По данным модели ТОПЗ энергия ловушек в различных состояниях мемристора: 0.057 эВ в исходном, 0.05 эВ в низкоомном, 0.095 эВ в промежуточном, 0.09 эВ в высокоомном. Для сравнения отметим, что энергия электронных и дырочных ловушек в пиролитическом нитриде кремния, который используется в качестве запоминающей среды в современной флэш-памяти, составляет величину 1.4 эВ [32].
Рис. 8.
ВАХ мемристора в двойном логарифмическом масштабе на основе плазмохимического нитрида кремния, измеренные при разных температурах в различных состояниях мемристора; точки – эксперимент, штриховые линии –моделирование на основе модели ТОПЗ [45]. Исходное состояние (virgin state – VS) (а), низкоомное состояние (LRS) (б), промежуточное состояние (intermediate state – IRS) (в), высокоомное состояние (HRS) (г) мемристора на основе плазмохимического нитрида кремния, транспорт заряда описывается моделью ТОПЗ с различными параметрами.

В [44] сравнивались запоминающие свойства мемристоров на основе плазмохимического нитрида кремния и нитрида кремния, полученного распылением мишени из нитрида кремния (рис. 9). Величина окна памяти последнего больше и более стабильна по сравнению с аналогичными данными для мемристора на основе плазмохимического нитрида кремния. Это связано с тем, что в плазмохимическом нитриде кремния содержится большое количество водорода. Из-за большого количества связей водорода с азотом и кремнием, образованных при получении плазмохимическим методом, деградация мемристора на основе плазмохимического SiNx наступает быстрее, чем нитрида кремния, полученного распылением мишени из нитрида кремния, где в технологии получения водород отсутствует.
Рис. 9.
Хранение информации, зависимость окна памяти от времени при 85°С для мемристоров на основе плазмохимического нитрида кремния и нитрида кремния, полученного распылением мишени из нитрида кремния. Измеряемая структура p+–Si/SiNx(25 нм)/n+–Si [44].
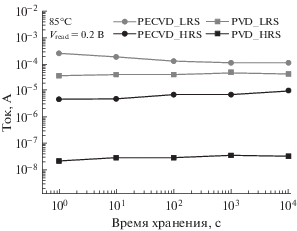
Из рис. 10 следует, что мемристор на основе плазмохимического нитрида кремния выдерживает 103 циклов перепрограммирования. Мемристор на основе нитрида кремния, полученного распылением мишени из нитрида кремния, выдерживает по крайней мере 105 циклов перепрограммирования.
Рис. 10.
Зависимость окна памяти от числа циклов для мемристоров на основе плазмохимического нитрида кремния и нитрида кремния, полученного распылением мишени из нитрида кремния в структуре p+–Si/SiNx(25 нм)/n+–Si [44].
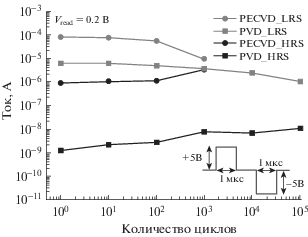
Хорошие запоминающие свойства мемристора на основе нитрида кремния, полученного высокочастотным реактивным распылением, продемонстрированы в [46] (рис. 11). Мемристор выдерживает по крайней мере 109 циклов перепрограммирования без заметной деградации и стабильное хранение информации при 25 и 85°С.
2.3. Запоминающие свойства мемристоров на основе плазмохимического оксида кремния
Запоминающие свойства мемристоров на основе плазмохимического оксида кремния изучались в [47]. На рис. 12а представлено изображение пленки плазмохимического SiO1.1 толщиной 130 нм, полученное с помощью высокоразрешающей просвечивающей электронной микроскопии. Режимы синтеза для SiO1.1-пленки и мемристора на основе SiO1.1 одни и те же. На рисунке чередующиеся темные и светлые полосы являются проводящими каналами, которые получаются на стадии синтеза. ВАХ на рис. 12б подтверждает наличие проводящих каналов, так как исходное состояние мемристора является сильно проводящим.
Рис. 12.
Структура и запоминающие свойства мемристора на основе плазмохимического оксида кремния p++–Si/SiO1.1(40 нм)/Ni: a – сечение запоминающей среды SiO1.1 (толщина 130 нм), выращенной в тех же режимах, что и мемристор на основе SiO1.1; б – ВАХ мемристора на основе SiO1.1 [47].

Энергия ловушки в различных состояниях мемристора на основе SiO1.1 лежит в диапазоне 0.05–0.42 эВ (рис. 13). Для сравнения отметим, что энергии электронных [48] и дырочных [49] ловушек в диоксиде кремния равны 1.6 эВ.
Рис. 13.
Структура Si/SiO1.1(40 нм)/Ni-мемристора (а), ВАХ мемристора при комнатной температуре в различных состояниях (б): исходное состояние (virgin state VS), низкоомное (LRS), промежуточное (intermediate state – IRS), высокоомное (HRS). ВАХ при различных температурах, в разных состояниях: в – исходное, г – низкоомное, д – промежуточное, е – высокоомное [47].

Для сравнения запоминающих свойств мемристоров на основе SiOx разного состава были измерены ВАХ для первых циклов переключения (рис. 14). Нестехиометрические пленки SiOx проявляют мемристорные свойства в диапазоне x = = 0.7–1.8.
Рис. 14.
ВАХ мемристора на основе SiO0.4 (а), SiO0.6 (б), SiO0.7 (в), SiO1.1 (г), SiO1.2 (д), SiO1.8 (е).

Измерения хранения заряда при 85°C для HRS и LRS были выполнены для четырех составов (рис. 15а–15г). По наклону кривой хранения заряда кривые были аппроксимированы до 10 лет. Наилучшими свойствами хранения заряда обладает мемристор на основе SiO1.1.
Рис. 15.
Хранение заряда для мемристора на основе SiO0.7 (а), SiO1.1 (б), SiO1.2 (в), SiO1.8 (г) при напряжении чтения –1 В. Циклирование мемристоров на основе SiO0.7 (д), SiO1.1 (е), SiO1.8 (ж) при напряжении чтения –1 В и при напряжениях переключения +12 и –12 В.

Измерения циклов включения/выключения также проводились для четырех составов (рис. 15д–15ж). Мемристор на основе SiO1.2 не имел окна памяти в импульсном режиме. Мемристоры на основе SiO0.7 и SiO1.8 выдерживают ~102 циклов переключений. Наилучшими запоминающими свойствами обладает мемристор на основе плазмохимического SiOx состава x = 1.1.
Наилучшим составом для мемристора является состав х = 1.1, с учетом погрешности определения состава в 10% х = 1.1 ± 0.1. Если состав меньше х < 1, то сопротивление в HRS-состоянии за счет сильного обогащения кремнием больше, чем при составах x > 1, т.е. если состав х < 1, то окно памяти мемристора около порядка (SiO0.6) или быстро становится около одного порядка (SiO0.7). Если состав х > 1, то окно памяти для плазмохимического мемристора на основе SiOx составляет около двух порядков. Состав х = 1.1 ± 0.1 является оптимальным по соотношению кремния к кислороду. При уменьшении Si в пленках SiOx уменьшается ресурс циклов записи/чтения. По-видимому, это связано с уменьшением количества дефектов за счет обеднения Si пленок SiOx.
ЗАКЛЮЧЕНИЕ
Рассмотрены запоминающие свойства и механизмы транспорта заряда мемристоров на основе нитрида и оксида кремния. Такие мемристоры обеспечивают приемлемое окно памяти, хранение информации и число циклов перепрограммирования. Отметим, что мемристоры на основе нитрида кремния, полученные методом физического осаждения, по сравнению с мемристорами на основе пиролитического и плазмохимического нитрида кремния имеют число циклов переключения (109), существенно более высокое, чем число циклов перепрограммирования современной флэш-памяти (104).
Транспорт заряда в мемристорах на основе нитрида и оксида кремния описывается моделью токов, ограниченных пространственным зарядом. Энергии ловушек, ответственных за транспорт заряда, лежат в диапазоне 0.05–0.5 эВ, что существенно меньше энергий ловушек в нитриде 1.4 эВ и оксиде кремния 1.6 эВ.
Работа выполнена при поддержке Российского фонда фундаментальных исследований (грант № 19-29-03018 (мемристоры на основе SiOx)) и Российским научным фондом (грант № 19-19-00286 (мемристоры на основе SiNx)).
Список литературы
Пройдаков Э.М. // Цифровая экономика. 2018. Т. 3. № 3. С. 50.
Hu H., Wen Y., Chua T.-S., Li X. // IEEE Access. 2014. V. 2. P. 652.
Zakir J., Seymour T., Berg K. // Issues in Information Systems. 2015. V. 16. P. 81.
Гафаров Ф.М. Искусственные нейронные сети и приложения. Казань: Казан, 2018.
Абгарян К.К., Гаврилов Е.С. // Информатика и ее применения. 2020. Т. 14. № 2. С. 104.
Теплов Г.С., Горнев Е.С. // Микроэлектроника. 2019. Т. 3. № 2. С. 163.
Бобков С.Г., Басаев А.С. Методы и средства аппаратного обеспечения высокопроизводительных микропроцессорных систем. М.: Техносфера, 2021.
Ермаков И.В., Шелепин H.A. // Изв. вузов. Электроника. 2014. Т. 106. № 2. С. 31.
Meena J.S., Sze S.M., Chand U., Tseng T.-Y. // Nanoscale Res. Lett. 2014. V. 9. P. 256.
Zidan M.A., Strachan J.P., Lu W.D. // Nat. Electron. 2018. V. 1. P. 22.
Strukov D.B., Snider G.S., Stewart D.R., Williams R.S. // Nature. 2008. V. 453. P. 80.
Miao F., Strachan J.P., Yang J.J. et al. // Adv. Mater. 2011. V. 23. № 47. P. 5633.
Lee H.Y., Chen P.S., Wu T.Y. et al. // IEEE International Electron Devices Meeting. 2008. P. 297.
Chang W.Y., Lai Y.C., Wu T.B. et al. // Appl. Phys. Lett. 2008. V. 92. P. 022110.
Argall F. // Solid State Electron. 1968. V. 11. № 5. P. 535.
Jeong D.S., Schroeder H., Waser R. // Electrochem. Solid State Lett. 2007. V. 10. P. 51.
Molina-Reyes J., Hernandez-Martinez L. // Complexity. 2017. V. 10. P. 8263904.
Kundozerova T.V., Grishin A.M., Stefanovich G.B., Velichko A.A. // IEEE Trans. Electron Devices. 2012. V. 59. № 4. P. 1144.
Mehonic A., Shluger A.L., Gao D. et al. // Adv. Mater. 2018. V. 30. P. 1801187.
Kim S., Kim H., Hwang S., Kim M.H. // ACS Appl. Mater. Interfaces. 2017. V. 9. P. 40420–7.
Koryazhkina M.N., Tikhov S.V., Mikhaylov A.N. et al. // J. Phys. Conf. Ser. 2018. V. 993. P. 012028.
Shaposhnikov A.V., Perevalov T.V., Gritsenko V.A. et al. // Appl. Phys. Lett. 2012. V. 100. P. 243506.
Tang M.H., Wang Z.P., Li J.C. et al. // Semicond. Sci. Technol. 2011. V. 26. P. 075019.
Sun X., Li G., Zhang X. et al. // J. Phys. D: Appl. Phys. 2011. V. 44. P. 125404.
Minnekhanov A.A., Emelyanov A.V., Lapkin D.A. et al. // Sci. Rep. 2019. V. 9. P. 10800.
Насыров К.А., Гриценко В.А. // Успехи физ. наук. 2013. Т. 183. № 10. С. 1099.
Gritsenko V.A. // Silicon Nitride on Si: Electronic Structure for Flash Memory Devices / Thin Films on Si: Electronic and Photonic Applications / Eds. Narayanan V. et al. Singapore: World Scientific Press, 2016. P. 273. https://doi.org/10.1142/9789814740487_0006
Гриценко В.А., Алиев В.Ш., Исламов Д.Р., Воронковский В.А. Способ изготовления активного слоя для универсальной памяти на основе резистивного эффекта. Пат. 2611580 (Россия). 2017.
Voronkovskii V.A., Perevalov T.V., Iskhakzay R.M.H. et al. // J. Non-Cryst. Solids. 2020. V. 546. P. 120256. https://doi.org/10.1016/j.jnoncrysol.2020.120256
Gritsenko V.A., Perevalov T.V., Orlov O.M., Krasnikov G.Ya. // Appl. Phys. Lett. 2016. V. 109. P. 06294. https://doi.org/10.1063/1.4959830
Орлов О.М., Гисматулин А.А., Гриценко В.А., Мизгинов Д.С. // Микроэлектроника. 2020. Т. 49. № 5. С. 395. https://doi.org/10.31857/S0544126920050075
Gismatulin A.A., Orlov O.M., Gritsenko V.A. et al. // Appl. Phys. Lett. 2020. V. 116. № 20. P. 203502. https://doi.org/10.1063/5.0001950
Gismatulin A.A., Orlov O.M., Gritsenko V.A., Krasnikov G.Y. // Chaos, Solitons Fractals. 2021. V. 142. P. 110458. https://doi.org/10.1016/j.chaos.2020.110458
Kim S., Cho S., Park B.-G. // AIP Adv. 2016. V. 6. P. 015021. https://doi.org/10.1063/1.4941364
Tikhov S.V., Mikhaylov A.N., Belov A.I. et al. // Microelectron. Eng. 2018. V. 187–188. P. 134. https://doi.org/10.1016/j.mee.2017.11.002
Lampert M.A., Mark P. Current injection in solids. New York: Academic Press, 1970.
Shaposhnikov A.V., Petrov I.P., Gritsenko V.A., Kim C.W. // Phys. Solid State. 2007. V. 9. № 49. P. 1628. https://doi.org/10.1134/S1063783407090041
Гриценко В.А. // Успехи фи. наук. 2012. Т. 5. № 55. С. 498. https://doi.org/10.3367/UFNr.0182.201205d.0531
Gritsenko V.A., Meerson E.E., Morokov Y.N. // Phys. Rev. 1998. V. 4. № 57. P. 2081. https://doi.org/10.1103/PhysRevB.57.R2081
Hattori R., Shirafuji J. // Appl. Phys. Lett. 1989. V. 12. № 54. P. 1118. https://doi.org/10.1063/1.101478
Jiang X.F., Ma Z.Y., Xu J. et al. // Sci. Rep. 2015. V. 5. P. 15762. https://doi.org/10.1038/srep15762
Kim H.-D., An H.-M., Kim T.G. // Microelectron. Eng. 2012. V. 98. P. 351. https://doi.org/10.1016/j.mee.2012.07.052
Kim H.-D., An H.-M., Kim T.G. // J. Appl. Phys. 2011. V. 109. P. 016105. https://doi.org/10.1063/1.3525991
Yen T.J., Chin A., Gritsenko V.A. // Sci. Rep. 2020. V. 10. № 1. P. 2807. https://doi.org/10.1038/s41598-020-59838-y
Gismatulin A.A., Kamaev G.N., Kruchinin V.N. et al. // Sci. Rep. 2021. V. 11. P. 2417. https://doi.org/10.1038/s41598-021-82159-7
Kim H.-D., An H.-M., Hong S.M., Kim T.G. // Phys. Status Solidi A. 2013. V. 210. № 9. P. 1822. https://doi.org/10.1002/pssa.201329021
Gismatulin A.A., Voronkovskii V.A., Kamaev G.N. et al. // Nanotechnology. 2020. V. 31. P. 505704. https://doi.org/10.1088/1361-6528/abb505
Islamov D.R., Gritsenko V.A., Perevalov T.V. et al. // Appl. Phys. Lett. 2016. V. 109. P. 052901. https://doi.org/10.1063/1.4960156
Gritsenko V.A., Wong H. // Crit. Rev. Solid State Mater. Sci. 2011. V. 36. P. 129. https://doi.org/10.1080/10408436.2011.592622
Дополнительные материалы отсутствуют.
Инструменты
Российские нанотехнологии