Российские нанотехнологии, 2021, T. 16, № 6, стр. 767-775
БЕСФОРМОВОЧНОЕ НЕФИЛАМЕНТАРНОЕ РЕЗИСТИВНОЕ ПЕРЕКЛЮЧЕНИЕ В СТРУКТУРАХ W/WO3 – x/HfO2/Pd
А. А. Королева 1, М. Г. Козодаев 1, Ю. Ю. Лебединский 1, А. М. Маркеев 1, *
1 Московский физико-технический институт (Национальный исследовательский университет)
Долгопрудный, Россия
* E-mail: markeev.am@mipt.ru
Поступила в редакцию 16.06.2021
После доработки 29.06.2021
Принята к публикации 29.06.2021
Аннотация
Исследован эффект резистивного переключения в структурах W/WO3 –х/HfO2/Pd. Показано, что процесс переключения происходит по всей площади контакта и не требует электроформовки, что свидетельствует о нефиламентарном механизме переключения. Методом рентгеновской фотоэлектронной спектроскопии подтверждено наличие кислородных вакансий в оксиде вольфрама в результате его нагрева при пониженном давлении в атмосфере азота, которые сохраняются после нанесения оксида гафния и играют ключевую роль в процессе переключения. Продемонстрированы аналоговые свойства структуры W/WO3 –х/HfO2/Pd, что делает ее перспективной для использования в нейроморфных системах.
ВВЕДЕНИЕ
Структуры металл–изолятор–металл, демонстрирующие эффект резистивного переключения (РП) в оксидах переходных металлов, являются одними из перспективных кандидатов для нового поколения энергонезависимой памяти. В основе данного эффекта лежит способность устройства переключаться между двумя различными состояниями сопротивления: из состояния с высоким сопротивлением (high resistance state (HRS)) в состояние с низким сопротивлением (low resistance state (LRS)) под воздействием внешнего электрического поля. К настоящему моменту эффект РП продемонстрирован во множестве различных структур [1–12]. Среди известных материалов РП в структурах на основе WO3 [13–15] показало ряд интересных свойств, в числе которых большое окно памяти (отношение сопротивлений в состояниях HRS и LRS), стабильность логических состояний и высокий ресурс устройств по числу циклов перепрограммирования. Кроме того, структуры на основе WO3 обладают аналоговыми свойствами, что позволяет рассматривать их как материалы для нейроморфных устройств [13, 15]. Однако из-за низкого удельного сопротивления WO3 в большинстве устройств на его основе толщина диэлектрического слоя составляет более 200 нм, что значительно уступает по масштабируемости HfO2 (5–10 нм) [8, 10] и Ta2O5 (10–20 нм) [16–18]. Для снижения токов утечек к пленкам оксида вольфрама с небольшой толщиной (20–30 нм) предлагается добавлять дополнительный слой из диэлектрика с более низкой проводимостью [19, 20].
Однако в большинстве указанных структур основным механизмом, лежащим в основе РП, являeтся образование и разрыв проводящего канала (филамента), состоящего из кислородных вакансий. Для инициации эффекта РП в филаментарных структурах, как правило, требуется процесс электроформовки, представляющий собой подачу на структуру напряжения, амплитуда которого превышает номинальную рабочую величину, с контролем уровня протекающего тока. Необходимость этой процедуры создает ряд сложностей при изготовлении реальных ячеек памяти [21]. Увеличение длительности процесса тестирования [22], а также стохастическая сущность данного процесса, которая обусловливает значительный разброс свойств номинально идентичных ячеек вплоть до вывода их из строя, негативно влияют на выход годных устройств. Кроме того, при резком возрастании тока в ячейке может происходить эффект овершутинга (overshooting current) [23], создающий дополнительный джоулев нагрев, что приводит к значительному снижению ресурса переключений. По этим причинам устройства, не требующие этапа формовки для РП, представляют повышенный интерес [24, 25].
Среди резистивно-переключаемых оксидных структур известны также нефиламентарные устройства, в которых РП происходит по всей площади контакта [26, 27] и не требует этапа формовки для инициации переключения. Переключение сопротивления в нефиламентарных структурах может происходить за счет заполнения/освобождения ловушек (дефектов) [27, 28] или обратимого смещения ионов кислорода из одной части стека (stack) в другую под действием внешнего электрического поля, так как оба явления способны приводить к изменению высоты и ширины барьера Шоттки/треугольного барьера на границе раздела металл–диэлектрик [29]. Благодаря отсутствию ярко выраженного момента включения и выключения нефиламентарные структуры демонстрируют высокую плавность РП, что позволяет получать множество последовательных логических состояний. За счет этого эффекта появляется возможность использования данных устройств в роли электрических синапсов в нейроморфных системах [30]. Однако такие устройства зачастую демонстрируют сниженную длительность хранения логического состояния [18, 31].
По-видимому, наибольший интерес представляет исследование РП в структурах W/WOх/HfO2/Pd [20]. В [20] продемонстрированы высокий ресурс таких устройств и высокая стабильность переключения. Вместе с тем среди результатов не приведены зависимости сопротивления HRS и LRS от площади структур, которые являются ключевым свидетельством нефиламентарного РП. Также, несмотря на общую тенденцию перспективности нефиламентарных структур для использования в нейроморфных системах, вопрос их аналоговых свойств не рассмотрен. Кроме того, функциональные свойства слоя WOx во многом определяются способом его получения, например температурой и давлением во время процесса окисления, что делает необходимым его характеризацию в каждом отдельном случае [32].
В настоящей работе продемонстрировано нефиламентарное РП в структурах W/WO3 –х/HfO2/Pd. Исследованы аналоговые и синаптические свойства структуры W/WO3 –х/HfO2/Pd. С помощью метода in situ рентгеновской фотоэлектронной спектроскопии (РФЭС) показано наличие дефицита кислорода в оксиде вольфрама в области его границы раздела с оксидом гафния.
ОБЪЕКТЫ И МЕТОДЫ ИССЛЕДОВАНИЯ
В качестве подложек для осаждения всех слоев конденсаторов использовали кремниевые пластины диаметром 100 мм марки КДБ12 ориентации (100). На пластине методом магнетронного распыления с использованием магнетронной системы Torr MagSput-DC-RF (Torr Instruments, США) из вольфрамовой мишени в атмосфере аргона при комнатной температуре была получена пленка W толщиной 100 нм (давление в процессе поддерживалось равным 1.5 × 10–3 Торр).
Слой WO3 –х был получен термическим окислением пластины Si/W в атмосфере кислорода (P = 760 Торр) при температуре 400°С в течение 300 с. Для отжига использовали систему быстрой термической обработки Jipelec JetFirst 200 (Jipelec, США). Толщину оксидного слоя определяли при помощи спектральной эллипсометрии, она составила ~20 нм.
Непосредственно после окисления пленку WO3 подвергли анализу методом РФЭС в условиях сверхвысокого вакуума (P ~ 2 × 10–9 Торр) в спектрометре Theta Probe (Thermo Fisher scientific, США) с использованием монохроматического рентгеновского излучения AlKα (E = 1486.6 эВ). Для оценки влияния предварительного прогрева в инертной среде на химический состав пленки WO3 –x использовали in situ-перегрузку с помощью шлюзовой камеры между реактором атомно-слоевого осаждения (АСО) и камерой спектрометра, поддерживаемой при давлении не ниже 1.0 × 10–5 Торр.
Слой диэлектрика HfO2 для структур W/WO3 –х/HfO2/Pd толщиной 3 нм был выращен методом АСО в реакторе Sunale R-150 (Picosun, Финляндия) при температуре 240°С с использованием реагента TEMAH ((CH3)(C2H5N))4Hf и паров воды. В качестве газа-носителя в камере АСО использовался азот высокой чистоты (99.995%). Верхний электрод из Pd был изготовлен методом электронно-лучевого напыления через теневую маску фоторезиста с круглыми отверстиями (D = 20, 50, 100 и 150 мкм), после чего проводили удаление резиста в н-метилпирролидоне при 150°С. Изображение поперечного сечения структуры W/WO3 –х/HfO2/Pd, полученное с помощью просвечивающей электронной микроскопии (ПЭМ), приведено на рис. 1.
Электрические измерения сформированных структур проводили на зондовой станции Cascade Microtech Summit 11000M (Cascade Microtech, США) с использованием источника-измерителя Agilent B1500A (Keysight Technologies, США) при комнатной температуре. Во всех измерениях напряжение подавали на верхний электрод, в то время как нижний электрод был заземлен. Измерения на постоянном токе, а также исследования аналоговых свойств и ресурса переключений устройств были проведены на контактных площадках диаметром 20 мкм. Исследование времени хранения логического состояния осуществлялось на контактных площадках большего размера (D = 100 мкм) из-за ограничений измерительного программного кода при регистрации токового отклика слабее 1 мкА.
РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
Для структур РП, основанных на двуслойных диэлектриках, большую роль играют процессы на границах раздела двух слоев диэлектриков. Особенно важно оценить процент содержания кислорода в пленке, так как существующие дефекты в виде кислородных вакансий играют ключевую роль как в ионных, так и в электронных механизмах проводимости. Для анализа явлений на границе раздела WO3 –x/HfO2 поверхность исходной пленки оксида вольфрама исследовали методом РФЭС (рис. 2а, 2б). Линия W4f описывается одиночным дублетом с положением энергии связи Есв= 36.1 эВ (рис. 2а), что соответствует оксиду вольфрама(VI). Рассчитанное с использованием факторов элементной чувствительности линий W4f и O1s отношение O/W составило ~3.0, т.е. до проведения АСО-процесса HfO2 пленка оксида стехиометрична. Поскольку АСО-рост HfO2 происходит при повышенной температуре (240°С) и пониженном давлении (~1 Торр) в среде азота [33], на первых циклах осаждения пленка WO3 может претерпевать частичное восстановление [34, 35]. Для подтверждения данного факта исходную пленку WO3 выдерживали при этих условиях в течение 30 мин, а затем без нарушений условий вакуума (in situ) перемещали в камеру РФЭС.
Рис. 2.
РФЭС-спектры линий W4f и O1s для WO3 –х до нагрева в реакторе (а, б) и после выдержки в АСО-реакторе при температуре 240°С в течение 30 мин (в, г).

На рис. 2в, 2г представлены измеренные спектры линий W4f и O1s после выдержки в АСО-реакторе. В данном случае спектр линии W4f описывается двумя дублетами: помимо дублета, соответствующего WO3, в разложении присутствует вторая компонента с Есв= 34.9 эВ, характерная для состояния W5+. Для оценки толщины восстановленного слоя были дополнительно измерены спектры линии W4f с угловым разрешением в диапазоне θ = 25°–75° (отсчет от нормали). Согласно полученным данным соотношение интенсивностей дублетов W5+/W6+ остается равным ~0.144 ± 0.009 во всем угловом диапазоне собираемых фотоэлектронов, что свидетельствует о равномерном восстановлении слоя в пределах глубины РФЭС-анализа. По оценке, основанной на длине свободного пробега фотоэлектронов W4f в слое WO3 –x (~2.4 нм), толщина восстановленного слоя составляет не менее 5 нм. Следовательно, на границе раздела WO3 –x/HfO2 во время осаждения HfO2 может происходить образование кислородных вакансий, о появлении которых также свидетельствует увеличение интенсивности пика нерешеточного кислорода (NLO) на спектре линии O1s (рис. 2г).
Для дополнительного подтверждения наличия кислородных вакансий в приповерхностном слое оксида вольфрама был проанализирован спектр валентной зоны. Как видно из рис. 3, на спектре можно различить два участка: пик с высокой интенсивностью, образованный линиями W5d и O2p (3–12 эВ над уровнем Ферми), и зону с низкой интенсивностью, соответствующую запрещенной зоне стехиометричного WO3. На спектре, полученном с исходной пленки WO3, данные состояния не наблюдаются. Выдержка в АСО-реакторе приводит к появлению разрешенных состояний в запрещенной зоне, что говорит об образовании в пленке кислородных вакансий [36]. Отметим, что аналогичный эксперимент, проведенный после осаждения пленки HfO2 толщиной ~1 нм, позволил выявить сохранение вакансий в приповерхностном слое WO3 –x.
Рис. 3.
РФЭС-спектры валентной зоны для WO3 –x, измеренные до (1) и после выдержки (2) в АСО-реакторе при температуре 240°С в течение 30 мин, а также после 10 циклов АСО HfO2 (3). Вставка: пик состояний в запрещенной зоне в увеличенном масштабе.

На рис. 4а показана вольт-амперная характеристика (ВАХ) структуры W/WO3 –х/HfO2/Pd для первого и второго циклов переключения. Изначально данная структура находится в промежуточном состоянии между низким и высоким сопротивлением (участок 1). После подачи развертки напряжения 0 → –3 → 0 В структура переходит в стабильное высокоомное состояние (участок 2). После обратной развертки напряжения 0 → 3 → 0 В структура переходит в низкоомное состояние (участки 3 и 4). Видно, что для РП в структурах W/WO3 –х/HfO2/Pd не требуются формовка и, как следствие, режим внешнего ограничения по току. Кроме того, структура демонстрирует зависимость сопротивления от площади верхнего электрода как в низкоомном, так и в высокоомном состоянии (рис. 4б), что свидетельствует о протекании РП по всей площади контакта, т.е. о нефиламентарном механизме переключения.
Рис. 4.
ВАХ структуры W/WO3 –х/HfO2/Pd для первого (пунктирная линия) и второго (сплошная линия) цикла переключения (диаметр контактной площадки 20 мкм) (а); зависимость сопротивлений структуры W/WO3 –х /HfO2/Pd в низкоомном (1) и высокоомном (2) состояниях от диаметра контакта (Uчт = 1 В, статистика собрана по 15 контактам для каждой точки) (б).

Одной из основных проблем устройств, основанных на эффекте РП, является разброс рабочих параметров переключения, таких как сопротивление в низкоомном и высокоомном состояниях, а также напряжение включения и выключения. Зачастую большой разброс параметров переключения связан со стохастической природой образования и разрыва проводящего канала под воздействием внешнего электрического поля. На рис. 5а представлена усредненная по первым 50 циклам переключения ВАХ структуры W/WO3 –х/HfO2/Pd (Uвыкл = –4 В, Uвкл = 3 В). Поскольку переключение в данной структуре имеет нефиламентарный характер, при фиксированных напряжениях включения и выключения структура демонстрирует большую стабильность состояний Rвкл и Rвыкл. Как видно из рис. 5б, для состояний LRS (μ = 13 МОм) и HRS (μ = 550 МОм) относительные среднеквадратичные отклонения составляют 25 и 22% соответственно. При Uвыкл = = –4 В и Uвкл = 3 В структура имеет отношение сопротивлений Rвыкл/Rвкл ≈ 42.
Рис. 5.
ВАХ структуры W/WO3 –х/HfO2/Pd со 2 по 50 цикл переключения (диаметр контакта 20 мкм) (а); кумулятивное распределение сопротивления структуры W/WO3 –х /HfO2/Pd в низкоомном (1) и высокоомном (2) состояниях (Uчт = 1 В) (б).
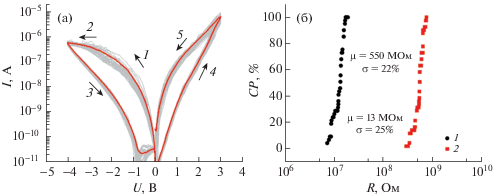
Другим важным свойством нефиламентарных структур W/WO3 –х/HfO2/Pd является наличие множества дискретных состояний сопротивления, которые можно наблюдать как при переключении на постоянном токе, так и в импульсном режиме. Одним из способов получения различных состояний сопротивления является изменение напряжения выключения Uвыкл. На рис. 6а представлены полные ВАХ структур W/WO3 –х/HfO2/Pd при разных значениях Uвыкл и при одинаковом напряжении включения Uвкл. Видно, что плавное изменение выключающего напряжения в диапазоне –3…–5 В позволяет регулировать сопротивление в состоянии HRS. Набор состояний сопротивления во время процесса выключения можно получить также с помощью поэтапного увеличения Uвыкл, т.е. с использованием развертки вида 0 → Uвыкл1 → 0 В → Uвыкл2 → 0…→ 0 → UвыклN → 0, а также с использованием различного уровня ограничения по току во время процесса включения. Так, на рис. 6б представлены ВАХ низкоомного состояния, полученные последовательным приложением возрастающего напряжения Uвыкл= = –2.7…–4 В на отрицательной полярности и последовательным увеличением ограничения по току с Icc = 1 мкА до Icc = 1 мA на положительной полярности. Данный способ позволяет получить 16 различных состояний сопротивления.
Рис. 6.
Аналоговые свойства структуры W/WO3 –х/HfO2/Pd: а – полная кривая ВАХ с различным напряжением Uвыкл (диаметр верхнего контакта 20 мкм), б – ВАХ низкоомного состояния, полученные последовательным приложением возрастающего напряжения на отрицательной полярности и последовательным увеличением ограничения по току на положительной полярности (диаметр верхнего контакта 100 мкм).

С практической точки зрения особенно важны параметры РП, получаемые с помощью импульсного программирования, поскольку именно этот режим приближен к условиям работы реальной памяти. На рис. 7а представлена зависимость сопротивления структуры W/WO3 –х/HfO2/Pd в низкоомном и высокоомном состояниях от количества циклов перезаписи. При проведении данных измерений использовали режим increment step pulse programming (ISPP), пошагово подбирающий напряжение для достижения заданного значения сопротивления, с длительностью переключающих импульсов 100 мкс. Напряжение переключения варьировалось в пределах Uвыкл= –2.9…–4.1 В и Uвкл= 2.4–3.2 В. Напряжение чтения Uчт было зафиксировано равным –0.8 В. В таких условиях структура демонстрирует ~5 × 105 циклов перезаписи до необратимого пробоя.
Рис. 7.
Ресурс переключений структуры W/WO3 –х/HfO2/Pd с диаметром контакта 20 мкм в низкоомном (1) и высокоомном (2) состояниях (Uвкл = 2.4–3.2 В, Uвыкл= –2.9…–4.1 В, Uчт = –0.8 В) (а), величины сопротивлений в низкоомном (1) и высокоомном (2) состояниях структуры W/WO3 –х/HfO2/Pd как функции времени, измеренные на контакте диаметром 100 мкм (Uвкл= 3.3 В, Uвыкл= –3.5 В, Uчт = = –0.8 В) (б).

Иным важным параметром устройств памяти является длительность хранения логических состояний. На рис. 7б представлены зависимости сопротивлений в состояниях HRS и LRS от времени, измеренные при комнатной температуре. Видно, что с течением времени сопротивление структуры стремится вернуться в изначальное состояние (до переключения). Исходя из полученных данных, спустя ~3 ч выдержки состояния HRS и LRS становятся неразличимы. Отметим, что временная динамика сопротивления устройств W/WO3 –х/HfO2/Pd напоминает принцип работы кратковременной памяти человеческого мозга [15]. Данное свойство используется при построении нейроморфных массивов [37–39].
В импульсном режиме также исследовали синаптические свойства структуры W/WO3 –х/HfO2/Pd. Для этих целей использовали два вида тестов. Первый тест заключается в подаче последовательности импульсов заданной длительности, но с различной амплитудой напряжения (рис. 8а). На рис. 8б представлен отклик структуры на такое воздействие, т.е. зависимость проводимости структуры W/WO3 –х/HfO2/Pd от амплитуды напряжения (приращение амплитуды составляет 0.05 В). Во время процесса включения проводимость, начиная с Uвкл≈ 3 В, возрастает в 10 раз. Процесс выключения начинается раньше (Uвыкл≈ ≈ 2 В), приводя к снижению проводимости с 12 до 1 нСм, причем темп падения проводимости снижается при амплитудах импульсов более 4.5 В. Из этого можно сделать вывод, что дальнейшее увеличение напряжения выключения не приведет к значительному уменьшению проводимости структуры. При использовании тестов с одинаковой амплитудой импульсов (рис. 8в) можно оценить, как сопротивление структуры меняется от времени. На рис. 8г представлена зависимость проводимости структуры от количества импульсов потенциации и депрессии. В данном тесте использовалось 200 последовательных импульсов длительностью 3 мкс с различной заданной амплитудой напряжения депрессии. Во время процесса потенциации с заданной амплитудой 3.3 В проводимость структуры постепенно увеличивается, выходя на насыщение после ~100 импульсов на уровне ~10 нСм. Изменение амплитуды напряжения депрессии в данном тесте приводит к изменению уровня насыщения, а также количества циклов, необходимого для достижения насыщения. Так, при амплитуде –4 В проводимость структуры выходит на насыщение на уровне ~1 нСм после 50 импульсов, в то время как при амплитуде –3 В уровень проводимости не достигает насыщения даже после 200 поданных импульсов. Также была определена стабильность состояний, полученных в ходе данного теста. Рисунок 8д демонстрирует характеристику потенциации и депрессии при последовательных импульсах программирования: 3.0 В/3 мкс и –3.5 В/3 мкс. После четырех циклов потенциации и депрессии уровень насыщения в обоих процессах поддерживается в пределах 3 нСм для потенциации и 1 нСм для депрессии, что говорит о высокой стабильности данных уровней насыщения.
Рис. 8.
Синаптические свойства структуры W/WO3 –х/HfO2/Pd: а – схема подачи импульсов для оценки синаптической пластичности структуры с различной амплитудой напряжения, б – зависимость проводимости структуры от абсолютной величины приложенного напряжения для процессов постепенного включения и выключения (длительность импульса 3 мкс), в – схема подачи импульсов для оценки синаптической пластичности структуры с одинаковой амплитудой напряжения, г – зависимость проводимости структуры от числа импульсов с различными амплитудами напряжения депрессии (длительность импульса 3 мкс), д – характеристика потенциации и депрессии при последовательных импульсах программирования: 3 В/3 мкс и –3.5 В/3 мкс. Во всех описанных случаях напряжение чтения Uчт = –0.8 В.

ЗАКЛЮЧЕНИЕ
Продемонстрирован подход по управлению химическим составом и электронной структурой границы раздела двух диэлектриков WO3/HfO2. Методами in situ РФЭС показано, что слой WO3, получаемый методом термического окисления металлического W, претерпевает существенные изменения в своей молекулярной и электронной структуре в процессе АСО HfO2, а именно теряет часть кислорода, что приводит к образованию кислородных вакансий в оксиде вольфрама. Как следствие, структура W/WO3 –х/HfO2/Pd демонстрирует нефиламентарное резистивное переключение, о чем свидетельствует отсутствие процесса формовки, а также зависимость сопротивлений в низкоомном и высокоомном состоянии от площади контакта. Кроме того, показаны аналоговые свойства структуры W/WO3 –х/HfO2/Pd, что делает ее перспективной для дальнейших исследований с целью интеграции в нейроморфные массивы.
Работа выполнена при финансовой поддержке Российского фонда фундаментальных исследований (проект № 19-29-03038). Все эксперименты в работе проведены с использованием оборудования Центра коллективного пользования уникальным научным оборудованием в области нанотехнологий Московского физико-технического института (национального исследовательского университета).
Список литературы
Alekhin A.P., Chouprik A.A., Gudkova S.A. et al. // J. Vac. Sci. Technol. B. 2011. V. 29. № 1. P. 01A302. https://doi.org/10.1116/1.3533763
Egorov K.V., Lebedinskii Y.Y., Markeev A.M., Orlov O.M. // Appl. Surf. Sci. 2015. V. 356. P. 454. https://doi.org/10.1016/j.apsusc.2015.07.217
Butcher B., Koveshnikov S., Gilmer D.C. et al. // Conf. Proc. “2011 IEEE International Integrated Reliability Workshop Final Report”. 2011. P. 146. https://doi.org/10.1109/IIRW.2011.6142611
Koveshnikov S., Matthews K., Min K. et al. // Conf. Proc. “2012 International Electron Devices Meeting”. 2012. P. 20.4.1. https://doi.org/10.1109/IEDM.2012.6479080
Inoue I.H., Sawa A. // Functional Metal Oxides. Weinheim, Germany: Wiley-VCH Verlag GmbH & Co. KGaA, 2013. V. 11. № 6. P. 443. https://doi.org/10.1002/9783527654864.ch16
Minnekhanov A.A., Emelyanov A.V., Lapkin D.A. et al. // Sci. Rep. 2019. V. 9. № 1. P. 1. https://doi.org/10.1038/s41598-019-47263-9
Emelyanov A.V., Nikiruy K.E., Demin V.A. et al. // Microelectron. Eng. 2019. V. 215. P. 110988. https://doi.org/10.1016/j.mee.2019.110988
Martyshov M.N., Emelyanov A.V., Demin V.A. et al. // Phys. Rev. Appl. 2020. V. 14. № 3. P. 1. https://doi.org/10.1103/PhysRevApplied.14.034016
Levanov V.A., Emel’yanov A.V., Demin V.A. et al. // J. Commun. Technol. Electron. 2018. V. 63. № 5. P. 491. https://doi.org/10.1134/S1064226918050078
Matveyev Y., Kirtaev R., Fetisova A. et al. // Nanoscale Res. Lett. 2016. V. 11. № 1. P. 147. https://doi.org/10.1186/s11671-016-1360-6
Matveyev Y., Egorov K., Markeev A., Zenkevich A. // J. Appl. Phys. 2015. V. 117. № 4. P. 044901. https://doi.org/10.1063/1.4905792
Kruchinin V.N., Aliev V.S., Perevalov T.V. et al. // Microelectron. Eng. 2015. V. 147. P. 165. https://doi.org/10.1016/j.mee.2015.04.091
Choi W., Gi S.-G., Lee D. et al. // IEEE Trans. Nanotechnol. 2020. V. 19. P. 594. https://doi.org/10.1109/TNANO.2020.3010070
Biju K.P., Liu X., Siddik M. et al. // J. Appl. Phys. 2011. V. 110. № 6. P. 064505. https://doi.org/10.1063/1.3633227
Chang T., Jo S.H., Lu W. // ACS Nano. 2011. V. 5. № 9. P. 7669. https://doi.org/10.1021/nn202983n
Kuzmichev D.S., Lebedinskii Y.Y., Hwang C.S., Markeev A.M. // Phys. Status Solidi Rapid Res. Lett. 2018. V. 12. № 12. P. 1800429. https://doi.org/10.1002/pssr.201800429
Koroleva A.A., Chernikova A.G., Chouprik A.A. et al. // ACS Appl. Mater. Interfaces. 2020. V. 12. № 49. P. 55331. https://doi.org/10.1021/acsami.0c14810
Kuzmichev D.S., Chernikova A.G., Kozodaev M.G., Markeev A.M. // Phys. Status Solidi. 2020. V. 217. № 18. P. 1900952. https://doi.org/10.1002/pssa.201900952
Tsai T.-L., Lin Y.-H., Tseng T.-Y. // IEEE Electron Device Lett. 2015. V. 36. № 7. P. 675. https://doi.org/10.1109/LED.2015.2428719
Luo Q., Zhang X., Hu Y. et al. // IEEE Electron Device Lett. 2018. V. 39. № 5. P. 664. https://doi.org/10.1109/LED.2018.2821162
Gilmer D.C., Koveshnikov S., Butcher B. et al. // Conf. Proc. “Proceedings of Technical Program of 2012 VLSI Technology, System and Application”. 2012. P. 1. https://doi.org/10.1109/VLSI-TSA.2012.6210102
Kawai K., Kawahara A., Yasuhara R. et al. // Conf. Proc. “2014 IEEE International Conference on IC Design & Technology”. 2014. P. 1. https://doi.org/10.1109/ICICDT.2014.6838600
Gilmer D.C., Bersuker G., Park H.-Y. et al. // Conf. Proc. “2011 3rd IEEE International Memory Workshop (IMW)”. 2011. P. 1. https://doi.org/10.1109/IMW.2011.5873225
Nikiruy K.E., Surazhevsky I.A., Demin V.A., Emelyanov A.V. // Phys. Status Solidi. 2020. V. 217. № 18. P. 1900938. https://doi.org/10.1002/pssa.201900938
Nikiruy K.E., Emelyanov A.V., Demin V.A. et al. // AIP Adv. 2019. V. 9. № 6. P. 065116. https://doi.org/10.1063/1.5111083
Luo Q., Xu X., Gong T. et al. // 2017 Conf. Proc. “IEEE International Electron Devices Meeting (IEDM)”. 2017. V. 2. P. 2.7.1. https://doi.org/10.1109/IEDM.2017.8268315
Ma H., Zhang X., Wu F. et al. // IEEE Trans. Electron Devices. 2019. V. 66. № 2. P. 924. https://doi.org/10.1109/TED.2018.2883192
Kim Y., Kwon Y.J., Kwon D.E. et al. // Adv. Mater. 2018. V. 1704320. P. 1. https://doi.org/10.1002/adma.201704320
Kim K.M., Zhang J., Graves C. et al. // Nano Lett. 2016. V. 16. № 11. P. 6724. https://doi.org/10.1021/acs.nanolett.6b01781
Wang Y.-F., Lin Y.-C., Wang I.-T. et al. // Sci. Rep. 2015. V. 5. № 1. P. 10150. https://doi.org/10.1038/srep10150
Hsu C.-W., Wang Y.-F., Wan C.-C. et al. // Nanotechnology. 2014. V. 25. № 16. P. 165202. https://doi.org/10.1088/0957-4484/25/16/165202
Sohal R., Walczyk C., Zaumseil P. et al. // Thin Solid Films. 2009. V. 517. № 16. P. 4534. https://doi.org/10.1016/j.tsf.2008.12.036
Puurunen R.L. // J. Appl. Phys. 2005. V. 97. № 12. P. 121301. https://doi.org/10.1063/1.1940727
Fukushi D., Sasaki A., Hirabayashi H., Kitano M. // Microelectron. Reliab. 2017. V. 79. P. 1. https://doi.org/10.1016/j.microrel.2017.09.025
Li W., Sasaki A., Oozu H. et al. // Microelectron. Reliab. 2015. V. 55. № 2. P. 402. https://doi.org/10.1016/j.microrel.2014.11.002
Romanov R.I., Kozodaev M.G., Lebedinskii Y.Y. et al. // J. Phys. Chem. C. 2020. V. 124. № 33. P. 18156. https://doi.org/10.1021/acs.jpcc.0c05446
Zhu X., Wang Q., Lu W.D. // Nat. Commun. 2020. V. 11. № 1. P. 2439. https://doi.org/10.1038/s41467-020-16261-1
Du C., Cai F., Zidan M.A. et al. // Nat. Commun. 2017. V. 8. № 1. P. 2204. https://doi.org/10.1038/s41467-017-02337-y
Wang Z., Joshi S., Savel’ev S.E. et al. // Nat. Mater. 2017. V. 16. № 1. P. 101. https://doi.org/10.1038/nmat4756
Дополнительные материалы отсутствуют.
Инструменты
Российские нанотехнологии



