Российские нанотехнологии, 2022, T. 17, № 1, стр. 98-105
ЭЛЕКТРОФИЗИЧЕСКИЕ СВОЙСТВА МЕМРИСТОРОВ НА ОСНОВЕ НИТРИДА КРЕМНИЯ НА ПОДЛОЖКАХ “КРЕМНИЙ-НА-ИЗОЛЯТОРЕ”
М. Н. Коряжкина 1, Д. О. Филатов 1, С. В. Тихов 1, А. И. Белов 1, Д. С. Королев 1, А. В. Круглов 1, Р. Н. Крюков 1, С. Ю. Зубков 1, В. А. Воронцов 1, Д. А. Павлов 1, Д. И. Тетельбаум 1, А. Н. Михайлов 1, *, С. Ким 2
1 Нижегородский государственный университет им. Н.И. Лобачевского
Нижний Новгород, Россия
2 Отделение электроники и электротехники, Университет Донгук
Сеул, Южная Корея
* E-mail: mian@nifti.unn.ru
Поступила в редакцию 07.07.2021
После доработки 16.07.2021
Принята к публикации 30.07.2021
Аннотация
Мемристоры вызывают особый интерес исследователей и инженеров в связи с перспективами создания новых информационно-вычислительных систем на их основе. В первую очередь это относится к мемристивным устройствам на основе эффекта резистивного переключения (РП), которые в большинстве случаев изготавливаются в виде структур “металл–диэлектрик–металл”. В то же время требование совместимости с базовым технологическим процессом изготовления комплементарных структур “металл–оксид–полупроводник” делает весьма привлекательным изготовление мемристивных устройств непосредственно на подложке кремния или подложке “кремний-на-изоляторе” (англ.: “silicon-on-insulator”, SOI) с применением стандартных диэлектрических слоев, таких как нитрид кремния. Изучены электрофизические характеристики и РП мемристоров на основе тонких пленок SiNx, сформированных на подложках SOI. Исследуемые мемристоры не требовали электроформовки и демонстрировали “синаптический” характер РП. Впервые показана возможность улучшения параметров РП мемристоров на основе SiNx на подложках SOI с помощью лазерной обработки.
ВВЕДЕНИЕ
Мемристор – двухэлектродный элемент наноэлектроники, который изменяет и запоминает свое сопротивление в зависимости от приложенного напряжения и протекшего через него заряда. Его основным отличием от полупроводниковых элементов памяти, реализующих двоичный код и два устойчивых состояния, является многоуровневый синаптический характер переключения проводимости [1]. Считается, что это позволит создавать на основе мемристоров компьютеры нового поколения (с архитектурой, отличной от фон Неймановской), а также нейроморфные системы искусственного интеллекта [2–4]. Основными недостатками мемристоров, созданных как в виде структур “металл–диэлектрик–металл”, так и в виде структур “металл–диэлектрик–полупроводник”, являются в совокупности недостаточная для практического применения воспроизводимость (стохастичность) параметров резистивного переключения (РП), высокие значения напряжений РП и сложность интеграции в стандартный процесс изготовления комплементарных структур “металл–оксид–полупроводник” (КМОП). В настоящее время развивается ряд подходов к решению этих проблем: применение новых материалов и различных интерфейсов [5–8], применение переключающих сигналов специальной формы [9, 10], использование оптического излучения [11–13] или шума [14–17] в качестве параметров, управляющих динамикой переключения, программированием величин и длительностей переключающих импульсов [18–20] и др.
Перспективными диэлектрическими материалами считаются оксиды переходных металлов (например, HfOx, TaOx, ZrOx), а также SiOx и GeOx. Также интенсивно ведутся исследования мемристивных структур на основе SiNx [21–25], что представляет практический интерес в связи с их совместимостью со стандартной технологией создания современных интегральных схем.
Использование полупроводника в качестве одного из электродов мемристивной структуры актуально и с точки зрения интеграции мемристоров в стандартный КМОП-процесс [26–28]. В указанных работах использовались подложки объемного кремния. Однако при производстве большинства полупроводниковых приборов и микросхем предпочтение отдается подложкам “кремний-на-изоляторе” (“silicon-on-insulator”, SOI) за счет ряда важнейших преимуществ по сравнению с объемным кремнием: меньшая потребляемая мощность, большее быстродействие и плотность элементов [29]. Поэтому наиболее целесообразной является реализация мемристивных структур именно на подложках SOI. Несмотря на значительное количество опубликованных исследований мемристивных структур с электродом из объемного кремния, структуры на подложках SOI необходимо изучать самостоятельно из-за особенностей морфологии и структуры последних. Таким образом, разработка и исследование мемристивных структур, в которых подложка SOI выступает в качестве электрода, имеют значительный теоретический и практический интерес. Однако в литературе такие данные практически отсутствуют. Имеется несколько работ по использованию SOI в мемристивных устройствах (например, [30–33]).
Несмотря на практические преимущества использования полупроводника в качестве электрода мемристивной структуры, не стоит забывать о нежелательном наличии поверхностных состояний (ПС) на границе раздела диэлектрик/полупроводник, которые вносят значительный вклад в сопротивление структуры и тем самым увеличивают напряжения РП. Лазерная обработка (ЛО) может быть использована в качестве метода борьбы с такими дефектами. Эффект достигается за счет разогрева подложки вследствие поглощения в ней лазерного излучения. Кроме того, ЛО используется для модификации зарядового состояния диэлектрика во Flash-памяти, что применяется для полного удаления информации с элементов памяти [34]. Поэтому ЛО может быть эффективно использована для изменения электрофизических характеристик мемристивных структур.
В настоящей работе предлагается подход по улучшению параметров РП, а именно, увеличения отношения сопротивлений в крайних резистивных состояниях мемристивных структур на основе перспективных и доступных диэлектрических слоев – SiNx, сформированных в промышленных условиях на КМОП-совместимых подложках SOI. Данный подход основан не только на использовании стандартных для КМОП-процесса материалов, но и на применении ЛО, используемой в микроэлектронной промышленности для управления электрофизическими параметрами устройств. Кроме того, проведенное в данной работе исследование частотных зависимостей электрофизических характеристик мемристивных структур позволяет получить необходимую детальную информацию о процессах, происходящих в диэлектрической пленке, и о состоянии границ раздела диэлектрик/электрод в разных резистивных состояниях [35].
Насколько известно, комплексного исследования мемристивных структур на основе пленок SiNx на SOI-подложках, в том числе выявления влияния ЛО на их электрофизические характеристики (определяющие параметры РП), проведено не было.
МЕТОДИКА ЭКСПЕРИМЕНТА
Пленки SiNx (номинальной толщиной 13 нм) наносили на коммерческие подложки SOI с толщиной приборного слоя 360 нм методом плазмо-активированного химического осаждения из паровой фазы (Plasma-Enhanced Chemical Vapor Deposition) с использованием 5%-ной SiH4/N2 (800 стандартных см3/мин), NH3 (10 стандартных см3/мин) и N2 (1200 стандартных см3/мин) при давлении 580 мТорр, высокочастотной мощности 60 Вт со скоростью осаждения 100 Å/мин. На поверхность пленки методом магнетронного распыления при температуре 473 K наносили верхние электроды из Au (20 нм) с подслоем Zr (8 нм) площадью S ~ 10–2 см2. Схематическое изображение полученных структур представлено на рис. 1.
Рис. 1.
Схематическое изображение мемристоров на основе SiNx и простейшая эквивалентная RC-схема конденсатора.
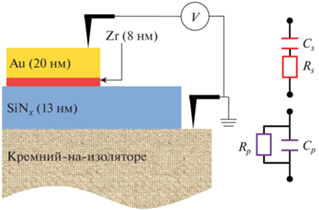
Электрофизические характеристики измеряли на анализаторе полупроводниковых приборов Agilent В1500А. Знак напряжения на структурах соответствовал потенциалу верхнего электрода относительно потенциала нижнего электрода. Для исследований использовали прижимные электроды из фосфористой бронзы. Измеряли вольт-амперные характеристики (ВАХ) и малосигнальные C–f-, G–f- и R–f-характеристики мемристоров в параллельной и последовательной схемах замещения конденсатора [36] в интервале частот 103…2 × 106 Гц. Определяли величины параллельной емкости (Cp), параллельной проводимости, приведенной к круговой частоте, (Gp/ω), тангенса угла диэлектрических потерь (tgδ), последовательного (Rs) и параллельного (Rp) сопротивления. Параметры параллельной эквивалентной схемы определяются электронными явлениями в диэлектрике, а параметры последовательной эквивалентной схемы – сопротивлением электродов и переходного слоя между электродом и диэлектриком [36]. Кроме того, проводили измерения вольт-фарадных характеристик в параллельной схеме замещения конденсатора на частоте малого тестирующего сигнала 100 кГц.
Как было сказано выше, ЛО может быть использована с целью изменения электрофизических характеристик мемристивных структур, определяющих параметры РП. Предполагается, что ЛО позволит уменьшить величину встроенного заряда в диэлектрических пленках и понизить плотность ПС на границе раздела диэлектрик/полупроводник в мемристивных структурах. Поэтому часть мемристивных структур подвергали ЛО. Для этого использовали полупроводниковый лазер непрерывного излучения мощностью 1.5 Вт с длиной волны излучения 460 нм, что соответствует энергии фотона 2.7 эВ. Облучение проводили через верхний электрод в течение 10 мин. Отметим, что верхние электроды из Au толщиной 20 нм являлись полупрозрачными для используемой длины волны лазерного излучения [37]. Также отметим, что при воздействии лазерного излучения происходил разогрев структуры до ~473 K.
Структурные исследования пленок SiNx и мемристивных структур на их основе в данной работе выполнены методами атомно-силовой микроскопии (АСМ), рентгеновской фотоэлектронной спектроскопии (РФЭС) и просвечивающей электронной микроскопии (ПЭМ).
РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
По данным АСМ среднеквадратичная шероховатость пленки SiNx составляла 1.9 нм.
На рис. 2 приведены данные РФЭС исходных и отожженных при 550 К пленок SiNx. Показано, что стехиометрические индексы исходных и отожженных пленок SiNx практически не различаются и составляют x ≈ 1.25. Следует обратить внимание на наличие переходного слоя на границе SiNx/SOI, толщина которого составляет ~18 нм.
Рис. 2.
Профили распределения элементов по глубине в исходных и отожженных пленках SiNx. Начало координат по оси абсцисс совмещено с границей раздела SiNx/SOI.
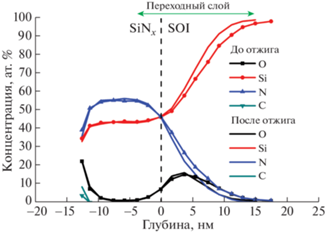
На рис. 3 приведены ПЭМ-изображения поперечного среза мемристивных структур на основе SiNx после ЛО. Пленка SiNx, согласно рис. 3, имеет аморфную структуру. В то же время внутри аморфного SiNx выявлено наличие нанокристаллитов ZrN (участки 1, 3, 5–7) и Si (участок 4). В подслое Zr и на границе раздела с диэлектриком обнаружены нанокристаллиты ZrO2 (участок 2), ZrO (участок 8) и ZrN (участок 9). Следует также отметить наличие нанокристаллитов Si3N4 (участок 10). Структуру обнаруженных нанокристаллитов определяли путем сравнения межплоскостных расстояний на ПЭМ-изображениях с литературными данными.
Рис. 3.
ПЭМ-изображения высокого разрешения двух участков поперечного среза мемристивной структуры на основе SiNx после ЛО.

Структуры на основе SiNx имеют исходно проводящее состояние и изначально (до ЛО) не демонстрируют РП (рис. 4).
Рис. 4.
ВАХ мемристивной структуры на основе SiNx до (сплошная линия) и после (точечная линия) ЛО. Направление развертки напряжения показано стрелками. Цифрами показана последовательность приложения напряжения при измерении ВАХ структур после ЛО.

На рис. 5 приведены частотные зависимости параметров эквивалентной схемы мемристивной структуры до ЛО. Последовательное сопротивление в структуре на высокой частоте, определяющееся сопротивлением электродов мемристора, составляет ~110 Ω.
Рис. 5.
Частотные зависимости Cp, Gp/ω и tgδ (а), Rs и Rp (б), полученные для мемристивной структуры до ЛО.

Значение 1/C2 (рис. 6) увеличивается с ростом отрицательного напряжения (по модулю), что свидетельствует об n-типе проводимости полупроводниковой пленки Si. Нелинейность этой зависимости может быть следствием ее неоднородного легирования. Значение оценочной концентрации доноров (ND) может быть получено с помощью угла наклона прямой, экстраполирующей данные на рис. 6, с использованием уравнения [38]:
Рис. 6.
Зависимость неравновесной емкости от напряжения в координатах 1/C2 – V, полученная для мемристивной структуры до ЛО.

Частотные зависимости параметров эквивалентной схемы практически не обнаруживали изменений при измерениях в темноте и кратковременном освещении лазером, что говорит о наличии обогащенного электронами слоя на границе раздела диэлектрик/полупроводник. Поэтому мемристивные структуры были подвергнуты ЛО на воздухе с целью изменения зарядового состояния ловушек в SiNx. На рис. 4 представлены ВАХ, демонстрирующие значительное увеличение петли гистерезиса (изменение величины токов на ~3 порядка величины) после проведения ЛО структур. Отметим, что структуры также проявляли синаптический характер переключения (кривые 2 и 3 на рис. 4). Мемристивные структуры, прошедшие ЛО, демонстрировали увеличенное значение относительной диэлектрической проницаемости (до ЛО оно составляло 4, а после – 4.85). Это значение было рассчитано по формуле для плоского конденсатора на частоте 1 кГц. Такое поведение свидетельствует о вкладе области пространственного заряда в полупроводниковом электроде в емкость конденсатора до ЛО.
Результаты влияния ЛО на электрофизические характеристики мемристивной структуры также представлены на рис. 7. Показаны частотные зависимости параметров эквивалентной схемы структуры, прошедшей ЛО и находящейся в состоянии с низким (low-resistance state, LRS) (т.е. после кривой 1 на рис. 4) и в состоянии с высоким сопротивлением (high-resistance state, HRS) (после кривой 3 на рис. 4). Следует отметить наличие больших потерь в структурах после переключения в LRS напряжением –5 В, что, вероятно, связано с наличием филаментов; в то же время потери в структуре значительно уменьшаются (на низкой частоте до 2 порядков величины) после переключения в HRS напряжением +4 В. Однако полного выключения филаментов не происходит, так как на частоте <104 Гц наблюдаются потери, характерные для потерь сквозной проводимости на низких частотах [39]. Также на низкой частоте в HRS увеличивается параллельное сопротивление (до 2 порядков величины), шунтирующее конденсатор. При этом практически не изменяется сопротивление кремниевого электрода. Оно остается почти таким же, как и до ЛО.
Рис. 7.
Частотные зависимости Cp (1, 4), Gp/ω (2, 5) и tgδ (3, 6) (а), Rs (7, 9) и Rp (8, 10) (б), полученные после ЛО мемристивной структуры после переключения в LRS напряжением –5 В (4, 5, 6, 9, 10) и после переключения в HRS напряжением +4 B (1, 2, 3, 7, 8).

Информация о релаксационных процессах в диэлектрике была получена с помощью анализа диаграмм Коула–Коула [39] (рис. 8). Данные получены из частотных зависимостей Gp/ω и Cp мемристивной структуры до ЛО (рис. 5a) и после ЛО (рис. 7a). Следует обратить внимание, что мемристивная структура не демонстрировала резистивного переключения до ЛО, поэтому диаграмма в этом случае была получена в исходном высоко проводящем состоянии мемристивной структуры. В то же время после ЛО стали различимы два резистивных состояния мемристивной структуры, поэтому диаграмма во втором случае была получена в условиях HRS мемристивной структуры. В первом случае (до ЛО) диаграмма имеет форму одной дуги окружности, что указывает на равномерный спектр ПС на границе раздела диэлектрик/полупроводник. Анализ диаграмм Коула–Коула позволяет оценить эффективную плотность ПС на уровне Ферми (Nss). В случае непрерывного спектра ПС для такой оценки использовали уравнение [38]:
где [Gp/ω]max – максимальное значение параллельной проводимости, приведенной к круговой частоте. Значение Nss до ЛО структур равно 1.6 × × 1012 см–2 эВ–1. Поверхностные состояния с таким высоким значением плотности могут снижать быстродействие и препятствовать постоянству значений напряжения РП. Резкий рост Gp/ω в области высоких значений Cp обусловлен наличием каналов проводимости (вставка на рис. 8). Во втором случае (после ЛО) форма диаграммы близка к полуокружности, что свидетельствует о наличии моноуровня ПС. В случае моноуровня ПС для оценки величины Nss использовали уравнение [38]: где k – постоянная Больцмана, T – температура. Значение Nss после ЛО структур составило 1.5 × × 1011 cм–2, что на порядок меньше, чем до ЛО.Рис. 8.
Диаграммы Коула–Коула, полученные для мемристивных структур на основе SiNx. Данные получены до и после ЛО. На вставке та же диаграмма Коула–Коула, что и до ЛО, но в полном масштабе.

На рис. 9 представлены результаты статистического исследования для десяти ВАХ мемристивных структур после ЛО. Видно, что токи через структуру в LRS и HRS различаются минимум в 8 раз (рис. 9a), а напряжения для процессов RESET (переключение из LRS в HRS) и SET (переключение из HRS в LRS) имеют значение в выделенных диапазонах (рис. 9б).
Рис. 9.
Зависимости токов (при напряжении чтения –0.5 В) мемристивной структуры в LRS (черным) и HRS (серым) после ЛО от числа циклов РП (а). Распределение напряжений процессов SET (черным) и RESET (серым) мемристивной структуры после ЛО (б).

Следовательно, ЛО приводит к изменению спектра ПС на границе SiNx/SOI. Вероятно, это связано с существенным влиянием ЛО на зарядовое состояние ловушек в SiNx, определяющих его проводимость с оптической энергией активации (для SiNx< 4/3 это значение составляет 2.6 эВ [40]). В [41] сообщалось, что эти ловушки способны оказывать определяющее влияние на восстановление и разрыв филаментов при переключениях в мемристорах на основе SiNx. Поэтому ЛО является эффективным методом изменения параметров РП в мемристивных структурах металл/SiNx/полупроводник.
ЗАКЛЮЧЕНИЕ
Продемонстрирован мемристивный эффект в структурах на основе перспективных и доступных диэлектрических слоев SiNx, сформированных на КМОП-совместимых подложках SOI.
Показано, что лазерная обработка приводит к существенному уширению петли гистерезиса на вольт-амперных характеристиках мемристивных структур Au/Zr/SiNx/SOI. Эффект достигается за счет положительной зарядки ловушек в диэлектрике и понижения величины плотности поверхностных состояний на границе раздела диэлектрик/полупроводник (на порядок величины).
Работа выполнена при частичной поддержке Российского фонда фундаментальных исследований (грант № 18-29-23001) и Правительства РФ (Соглашение № 074-02-2018-330 (2)). Исследования выполнены с использованием оборудования Центра коллективного пользования Научно-образовательного центра “Физика твердотельных наноструктур” Нижегородского государственного университета им. Н.И. Лобачевского.
Список литературы
Zhang W., Gao B., Tang J. et al. // Phys. Status Solidi – Rapid Res. Lett. 2019. V. 13. P. 1900204. https://doi.org/10.1002/pssr.201900204
Emelyanov A.V., Nikiruy K.E., Demin V.A. et al. // Microelectron. Eng. 2019. V. 215. P. 110988. https://doi.org/10.1016/J.MEE.2019.110988
Mehonic A., Sebastian A., Rajendran B. et al. // Adv. Intell. Syst. 2020. V. 2. P. 2000085. https://doi.org/10.1002/aisy.202000085
Demin V.A., Nekhaev D.V., Surazhevsky I.A. et al. // Neural Netw. 2021. V. 134. P. 64. https://doi.org/10.1016/J.NEUNET.2020.11.005
Mikhaylov A., Belov A., Korolev D. et al. // Adv. Mater. Technol. 2020. V. 5. P. 1900607. https://doi.org/10.1002/admt.201900607
Nikiruy K.E., Iliasov A.I., Emelyanov A.V. et al. // Phys. Solid State. 2020. V. 62. P. 1732. https://doi.org/10.1134/S1063783420090218
Matsukatova A.N., Emelyanov A.V., Minnekhanov A.A. et al. // Tech. Phys. Lett. 2020. V. 46. P. 73. https://doi.org/10.1134/S1063785020010277
Sun K., Chen J., Yan X. // Adv. Funct. Mater. 2021. V. 31. P. 2006773. https://doi.org/10.1002/adfm.202006773
La Torre C., Fleck K., Starschich S. et al. // Phys. Status Solidi. A. 2016. V. 213. P. 316. https://doi.org/10.1002/pssa.201532375
Ryabova M.A., Filatov D.O., Koriazhkina M.N. et al. // J. Phys.: Conf. Ser. 2021. V. 1851. P. 012003. https://doi.org/10.1088/1742-6596/1851/1/012003
Ungureanu M., Zazpe R., Golmar F. et al. // Adv. Mater. 2012. V. 24. P. 2496. https://doi.org/10.1002/adma.201200382
Tikhov S.V., Gorshkov O.N., Koryazhkina M.N. et al. // Tech. Phys. Lett. 2016. V. 42. P. 536. https://doi.org/10.1134/S1063785016050308
Mehonic A., Gerard T., Kenyon A.J. // Appl. Phys. Lett. 2017. V. 111. P. 233502. https://doi.org/10.1063/1.5009069
Patterson G.A., Fierens P.I., Grosz D.F. // Appl. Phys. Lett. 2013. V. 103. P. 074102. https://doi.org/10.1063/1.4819018
Ntinas V., Rubio A., Sirakoulis G.C. et al. // IEEE Transactions on Circuits and Systems II: Express Briefs. 2021. V. 68. P. 1378. https://doi.org/10.1109/TCSII.2020.3026950
Mikhaylov A.N., Guseinov D.V., Belov A.I. et al. // Chaos, Solitons Fractals. 2021. V. 144. P. 110723. https://doi.org/10.1016/j.chaos.2021.110723
Surazhevsky I.A., Demin V.A., Ilyasov A.I. et al. // Chaos, Solitons Fractals. 2021. V. 146. P. 110890. https://doi.org/10.1016/J.CHAOS.2021.110890
Ielmini D., Nardi F., Cagli C. // Appl. Phys. Lett. 2010. V. 96. P. 053503. https://doi.org/10.1063/1.3304167
Mikhaylov A.N., Belov A.I., Guseinov D.V. et al. // Mater. Sci. Eng. B. 2015. V. 194. P. 48. https://doi.org/10.1016/j.mseb.2014.12.029
Marchewka A., Waser R., Menzel S. // International Conference on Simulation of Semiconductor Processes and Devices (SISPAD). 2015. P. 297. https://doi.org/10.1109/SISPAD.2015.7292318
Kim S., Kim H., Hwang S. et al. // ACS Appl. Mater. Interfaces. 2017. V. 9. P. 40420. https://doi.org/10.1021/acsami.7b11191
Tikhov S.V., Mikhaylov A.N., Belov A.I. et al. // Microelectron. Eng. 2018. V. 187–188. P. 134. https://doi.org/10.1016/j.mee.2017.11.002
Vasileiadis N., Karakolis P., Mandylas P. et al. // IEEE Trans. Nanotechnol. 2021. V. 20. P. 356. https://doi.org/10.1109/tnano.2021.3072974
Vasileiadis N., Ntinas V., Fyrigos I.-A. et al. // IEEE International Symposium on Circuits and Systems (ISCAS). 2021. P. 1. https://doi.org/10.1109/ISCAS51556.2021.9401586
Yen T.J., Chin A., Gritsenko V. // Nanomaterials. 2021. V. 11. P. 1401. https://doi.org/10.3390/nano11061401
Tikhov S.V., Gorshkov O.N., Antonov I.N. et al. // Tech. Phys. Lett. 2014. V. 40. P. 837. https://doi.org/10.1134/S1063785014100137
Islamov D.R., Gritsenko V.A., Chin A. // Optoelectronics, Instrumentation and Data Processing. 2017. V. 53. P. 184. https://doi.org/10.3103/S8756699017020121
Gismatulin A.A., Orlov O.M., Gritsenko V.A. et al. // Appl. Phys. Lett. 2020. V. 116. P. 203502. https://doi.org/10.1063/5.0001950
Popov V.P., Antonova A.I., Frantsuzov A.A. et al. // Semiconductors. 2001. V. 35. P. 1030. https://doi.org/10.1134/1.1403567
Hoessbacher C., Fedoryshyn Y., Emboras A. et al. // Optica. 2014. V. 1. P. 198. https://doi.org/10.1364/optica.1.000198
Puppo F., Doucey M.A., Di Ventra M. et al. // IEEE International Symposium on Circuits and Systems. 2014. P. 2257. https://doi.org/10.1109/ISCAS.2014.6865620
Li C., Han L., Jiang H. et al. // Nature Commun. 2017. V. 8. P. 1. https://doi.org/10.1038/ncomms15666
Pragnya P., Pinkowitz A., Hull R., Gall D. // APL Mater. 2019. V. 7. P. 101121. https://doi.org/10.1063/1.5110889
Skorobogatov S. // IEEE International Workshop on Hardware-Oriented Security and Trust (HOST 2009). 2009. P. 1. https://doi.org/10.1109/HST.2009.5225028
Kärkkänen I., Shkabko A., Heikkilä M. et al. // Phys. Status Solidi. A. 2015. V. 212. P. 751. https://doi.org/10.1002/pssa.201431489
Эпштейн С.Л. Измерение характеристик конденсаторов. М.; Л.: Энергия, 1965. 236 с.
Antipov A., Arakelian S., Vartanyan T. et al. // Opt. Spectrosc. 2016. V. 121. P. 765. https://doi.org/10.1134/S0030400X16110035
Овсюк В.Н. Электронные процессы в полупроводниках с областями пространственного заряда. Новосибирск: Наука (Сибирское отделение), 1984. 254 с.
Орешкин П.Т. Физика полупроводников и диэлектриков. М.: Высшая школа, 1977. 448 с.
Nasyrov K.A., Shaǐmeev S.S., Gritsenko V.A. et al. // J. Exp. Theor. Phys. 2006. V. 102. P. 810. https://doi.org/10.1134/S106377610605013X
Gismatulin A.A., Gritsenko V.A., Yen T.J., Chin A. // Appl. Phys. Lett. 2019. V. 115. P. 253502. https://doi.org/10.1063/1.5127039
Дополнительные материалы отсутствуют.
Инструменты
Российские нанотехнологии




