Российские нанотехнологии, 2022, T. 17, № 6, стр. 807-810
ТРАНЗИСТОРЫ С ВЫСОКОЙ ПОДВИЖНОСТЬЮ ЭЛЕКТРОНОВ НА ОСНОВЕ ГЕТЕРОСТРУКТУР НИТРИДА ГАЛЛИЯ ДЛЯ МИЛЛИМЕТРОВОГО ДИАПАЗОНА ДЛИН ВОЛН
И. С. Езубченко 1, *, Е. М. Колобкова 1, А. А. Андреев 1, М. Я. Черных 1, Ю. В. Грищенко 1, П. А. Перминов 1, И. А. Черных 1, М. Л. Занавескин 1
1 Национальный исследовательский центр “Курчатовский институт”
Москва, Россия
* E-mail: ezivan9@gmail.com
Поступила в редакцию 12.05.2022
После доработки 12.05.2022
Принята к публикации 28.05.2022
Аннотация
На AlN/GaN-гетероструктурах на подложках кремния созданы и исследованы сверхвысокочастотные транзисторы. Максимальный удельный ток насыщения составил более 1 А/мм, крутизна стоко-затворной характеристики – 444 мСм/мм. Предельные частоты усиления по току ft и мощности fmax составили 124 и 161 ГГц соответственно. Коэффициент усиления по мощности равен 13.7 дБ на частоте 30 ГГц.
ВВЕДЕНИЕ
Транзисторы с высокой подвижностью электронов (ТВПЭ) и монолитные интегральные схемы на основе гетероструктур нитрида галлия являются востребованными компонентами твердотельной сверхвысокочастотной (СВЧ) микроэлектроники. Актуальной задачей является создание монолитных интегральных схем (МИС) миллиметрового диапазона частот (30–100 ГГц) для применения в средствах связи, радиолокации и радиоэлектронной борьбы [1]. Переход к более высоким частотам приводит к появлению новых требований, предъявляемых к гетероструктурам и технологии формирования ТВПЭ [2].
Во-первых, повышение рабочих частот ТВПЭ может быть достигнуто за счет уменьшения длины затвора и увеличения подвижности электронов в канале. Однако для стандартных гетероструктур AlGaN/GaN уменьшение длины затвора приводит к возникновению короткоканальных эффектов [3]. Как было показано в [4], эффекты не проявляются при отношении длины затвора к расстоянию от затвора до канала транзистора выше 15. Таким образом, классические гетероструктуры с барьерным слоем AlGaN толщиной 20–25 нм становятся неприменимы для затворов длиной менее 100–125 нм и частот 30 ГГц и выше. Решением является либо утонение барьерного слоя гетероструктуры AlGaN с увеличением мольной доли алюминия, либо переход на барьерный слой из AlN. Исследования показывают, что AlN малой толщины в качестве барьерного слоя обеспечивает высокую плотность носителей двумерного электронного газа (ДЭГ) при низком слоевом сопротивлении, повышает холловскую подвижность носителей ДЭГ, а также снижает подзатворные утечки тока [5, 6].
Во-вторых, необходимо обеспечить минимальное сопротивление транзистора в открытом состоянии Ron, что достигается уменьшением сопротивления омических контактов стока и истока, а также уменьшением расстояния между ними. Наиболее распространенный метод создания омических контактов на основе быстрого термического отжига не позволяет достичь низких значений сопротивления для гетероструктур с барьерным слоем из AlN или с тонкими слоями AlGaN с высокой мольной долей алюминия [7]. Омические контакты на основе доращивания сильнолегированного GaN являются практически единственно возможными элементами для создания транзисторов миллиметрового диапазона, так как обеспечивают низкие значения контактного сопротивления контактов и их воспроизводимость [8–11].
В-третьих, для достижения высоких рабочих частот необходимо уменьшить паразитные емкости затвор–исток и затвор–сток, а также активное сопротивление затвора. Это может быть достигнуто путем использования отдельно стоящих “грибообразных” затворов с тонкой конформной пассивацией [12]. Таким образом, для создания СВЧ-транзисторов миллиметрового диапазона частот требуются разработка и внедрение новых материалов и подходов к их изготовлению. В работе созданы транзисторы на подложках кремния, исследованы их статические и частотные характеристики.
РЕЗУЛЬТАТЫ
Статические характеристики транзисторов 2 × 100 мкм с длиной затвора 100 нм (рис. 1), измеренные зондовым методом, представлены на рис. 2. Измерения проводили в режиме постоянного тока. Максимальный удельный ток насыщения транзистора составил более 1 А/мм при напряжении сток–исток Vds = 3.2 В (рис. 2а), максимальная крутизна транзистора составила 444 мСм/мм при напряжении на затворе Vg = = ‒1.5 В (рис. 2б), напряжение отсечки VGS(off) = = ‒2.5 В. Утечка затвора по стоку при Vg = –5 В не превышала 85 мкА (0.425 мА/мм) вплоть до Vds = = 70 В (рис. 2в).
Рис. 2.
Выходные статические характеристики транзисторов: а – вольт-амперная характеристика транзистора (напряжение на затворе Vg = –2.5…+0.5 В с шагом 0.5 В), б – стоко-затворная характеристика транзистора, в – утечка затвора по стоку при Vg = –5 В.

СВЧ-характеристики транзисторов. Измерение S-параметров транзисторов проводили с помощью векторного анализатора в диапазоне частот от 0.1 до 40 ГГц. По S-параметрам строили частотные зависимости модуля коэффициента передачи по току |h21|, максимально достижимого/стабильного коэффициента усиления по мощности (MAG/MSG) и коэффициента усиления Масона U.
Предельные частоты усиления по току ft и мощности fmax определяли методом линейной экстраполяции к более высоким частотам зависимостей |h21|, MAG/MSG и U, построенных в логарифмическом масштабе, они составили 124 и 161 ГГц соответственно (рис. 3).
Рис. 3.
Частотные зависимости: а – модуля коэффициента передачи по току |h21|, б – коэффициента усиления по мощности MSG/MAG, в – коэффициента усиления Масона U. Напряжение смещения сток–исток +5 В, напряжение на затворе Vg = –1 В.
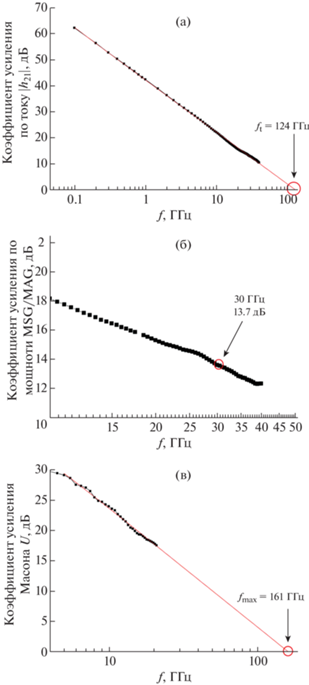
Как видно из рис. 3б, положение точки перехода MSG в MAG для данных транзисторов находится за пределами исследуемого диапазона частот (более 40 ГГц). Коэффициент усиления по мощности на частоте 30 ГГц составил 13.7 дБ.
Измерения статических параметров проводили на зондовой станции Cascade PM5 (Cascade Microtech GmbH, США) с помощью двухканального источника-измерителя Keithley 2636B (Keithley, Китай) при комнатной температуре в режиме постоянного тока. Измерения малосигнальных СВЧ-характеристик осуществляли на зондовой станции с зондами модели Z-probe 67GHz и сетевом анализаторе Agilent E8361C (Keysight Technologies, США).
ОБСУЖДЕНИЕ
На данный момент одной из ведущих мировых компаний по созданию МИС миллиметрового диапазона GaN на кремнии является OMMIC (Франция), которая работает по принципу открытого “фаундри”. Одним из базовых транзисторов данной компании для создания МИС миллиметрового диапазона частот является транзистор с длиной и шириной затвора 100 нм и 4 × 50 мкм соответственно и расстоянием исток–сток 1 мкм. В табл. 1 приведено сравнение параметров транзисторов, полученных в данной работе, с транзисторами OMMIC [14].
Таблица 1.
Сравнение измеренных параметров транзисторов с параметрами транзистора OMMIC
| Параметры | Транзистор OMMIC | Транзистор НИЦ “КИ” |
|---|---|---|
| Коэффициент усиления по мощности на 30 ГГц, дБ | 13 | 13.7 |
| Предельная частота усиления по току ft, ГГц | 110 | 124 |
| Предельная частота усиления по мощности, fmax, ГГц | 180 | 161 |
| Пробивное напряжение, В | 36 | >70 |
| Расстояние исток–сток, мкм | 1 | 3 |
| Напряжение отсечки, В | –2 | –2.5 |
| Максимальная крутизна стоко-затворной характеристики gm, мСм/мм | 800 | 444 |
| Максимальная плотность тока стока, А/мм | 1.2 | >1 |
Сопоставление результатов из табл. 1 свидетельствует о практически идентичных частотных характеристиках транзисторов, созданных по технологии OMMIC и по технологии НИЦ “Курчатовский институт”. Однако статические характеристики существенно различаются. Отметим, что в обоих случаях используется технология доращиваемых контактов. Компания OMMIC использует гетероструктуры с более тонким барьерным слоем, о чем свидетельствует меньшее напряжение отсечки (–2 В) по сравнению с –2.5 В у наших ТВПЭ. Сближение контактов транзистора до расстояния 1 мкм позволило увеличить плотность тока насыщения до 1.2 А/мм и крутизну стоко-затворной характеристики до рекордного уровня 800 мСм/мм. В данном случае расстояние исток–сток 3 мкм позволило уменьшить напряжение насыщения тока стока до 3 В, при этом максимальная крутизна стоко-затворной характеристики gm составила 444 мСм/мм при напряжении на затворе Vg = –1.43 В, в то же время gm > > 400 мСм/мм в диапазоне напряжений на затворе –1.67…–1.07 В. Также следует отметить высокое пробивное напряжение, которое составило более 70 В.
Полученные результаты находятся на высоком мировом уровне и имеют высокий потенциал дальнейшего развития.
ЗАКЛЮЧЕНИЕ
Исследованы частотные характеристики двухпальцевых ТВПЭ 2 ×100 мкм с длиной затвора 100 нм на гетероструктурах AlN/GaN. В результате измерений S-параметров определены предельные частоты усиления по току ft и мощности fmax, которые составили 124 и 161 ГГц соответственно. Максимальная крутизна транзисторов составила 444 мСм/мм при высоком пробивном напряжении свыше 70 В, что делает эти транзисторы перспективными для создания МИС для использования в системах связи, радиолокации и радиоэлектронной борьбы миллиметрового диапазона длин волн (30–100 ГГц).
Работа выполнена при финансовой поддержке Национального исследовательского центра “Курчатовский институт” (приказ от 28.10.2021 № 2753).
Список литературы
Mayeda J., Lie D., Lopez J. // Texas Symposium on Wireless and Microwave Circuits and Systems (WMCS). WACO, TX, USA. 2017. P. 1. https://doi.org/10.1109/WMCAS.2017.8070699
Мокеров В.Г., Кузнецов А.Л., Фёдоров Ю.В. и др. // Физика и техника полупроводников. 2009. Т. 49. № 4. С. 561. https://doi.org/10.1134/S1063782609040253
Breitschädel O., Kley L., Gräbeldinger H. et al. // Mater. Sci. Eng. B. 2001. V. 82. P. 238. https://doi.org/10.1016/S0921-5107(00)00747-9
Jessen G.H., Fitch R.C., Gillespie J.K. et al. // IEEE Trans. Electron. Dev. 2007. V. 54. № 10. P. 2589. https://doi.org/10.1109/TED.2007.904476
Xia Y., Zhu Y., Liu Ch. et al. // Mater. Res. Express. 2020. V. 7. P. 065902. https://doi.org/10.1088/2053-1591/AB96F5
Cao Y., Jena D. // Appl. Phys. Lett. 2007. V. 90. P. 182112. https://doi.org/10.1063/1.2736207
Zimmermann T., Deen D., Cao Y. et al. // Phys. Status Solidi. C. 2008. V. 5. № 6. P. 2030. https://doi.org/10.1002/pssc.200778724
Saunier P., Schuette M.L., Chou T.M. et al. // IEEE Trans. Electron. Dev. 2013. V. 60. № 10. P. 3099. https://doi.org/10.1109/TED.2013.2277772
Tang Y., Shinohara K., Regan D. et al. // IEEE Electron Device Lett. 2015. L. V. 36. № 6. P. 549. https://doi.org/10.1109/LED.2015.2421311
Guo H.-Y., Lv Y.-J., Gu G.-D. et al. // Chinese Phys. Lett. 2015. V. 32. № 11. P. 118501. https://doi.org/10.1088/0256-307x/32/11/118501
Huang T., Liu C., Bergsten J. et al. // Proc. 2016 Compound Semiconductor Week (CSW). Toyama, Japan. 2016. P. 1. https://doi.org/10.1109/ICIPRM.2016.7528722
Zhang X.W., Jia K.J., Wang Y.G. et al. // Appl. Mech. Mater. 2013. P. 1790. DOI: 10.4028/www.scientific.net/AMM.347-350.1790
Lev L.L., Maiboroda I.O., Husanu M.A. et al. // Nature Commun. 2018. V. 9. P. 2653. https://doi.org/10.1038/s41467-018-04354-x
Colangeli S., Ciccognani W., Longhi P.E. et al. // Electronics. 2021. V. 10. P. 134. https://doi.org/10.3390/electronics10020134
Дополнительные материалы отсутствуют.
Инструменты
Российские нанотехнологии