Российские нанотехнологии, 2024, T. 19, № 1, стр. 121-126
Электронно-лучевое напыление для синтеза мемристивных структур на основе оксида гафния
Б. С. Швецов 1, 2, *, А. Н. Мацукатова 1, 2, М. Н. Мартышов 2, Д. М. Жигунов 3, А. С. Ильин 2, Т. П. Савчук 2, 4, П. А. Форш 2, П. К. Кашкаров 1, 2
1 Национальный исследовательский центр “Курчатовский институт”
Москва, Россия
2 Московский государственный университет им. М.В. Ломоносова
Москва, Россия
3 Сколковский институт науки и технологий
Москва, Россия
4 Национальный исследовательский университет электронной техники – МИЭТ
Зеленоград, Россия
* E-mail: b.shvetsov15@physics.msu.ru
Поступила в редакцию 24.11.2023
После доработки 24.11.2023
Принята к публикации 04.12.2023
Аннотация
Оксид гафния в настоящее время рассматривается как один из самых перспективных металлооксидных материалов для создания мемристивных структур. Мемристивные структуры находят свое применение во многих областях науки и техники, например с их помощью возможна биоподобная эмуляция синапсов в нейроморфных вычислительных системах. Одним из важных препятствий для промышленного использования мемристоров представляется вариативность резистивных переключений (РП). Нестехиометричность в структуре мемристора может стать важным инструментом для контроля над РП. Мемристоры на основе оксида гафния в сэндвич-структуре металл–диэлектрик–металл синтезировались электронно-лучевым напылением, позволяющим создавать нестехиометрические пленки. Исследовался эффект РП в зависимости от материала верхнего электрода и толщины слоя оксида гафния. Определены параметры синтеза для достижения баланса между основными мемристивными характеристиками.
ВВЕДЕНИЕ
В связи с ограничениями стандартной вычислительной архитектуры фон Неймана в последнее время существенно вырос интерес к разработке и созданию биоподобных нейроморфных вычислительных систем (НВС). Такие системы, состоящие из многочисленных нейронов и синапсов, уже реализованы на основе транзисторов и показывают высокую вычислительную эффективность и низкое энергопотребление [1]. Однако для реализации одного синапса требуются как минимум шесть транзисторов. Для дальнейшего увеличения вычислительной мощности с учетом сохранения размеров вычислительных систем необходимо сокращение количества составных элементов. Перспективно использование так называемых мемристоров – структур, демонстрирующих эффект обратимого резистивного переключения (РП). Обычно мемристор представляет собой конденсаторную структуру металл–диэлектрик–металл (МДМ), в которой РП происходит в слое диэлектрика или на его контакте с металлом. Уже были продемонстрированы мемристоры на основе различных материалов: неорганических (оксидов металлов и нанокомпозитов [2–4]), органических (полианилина или поли-п-ксилилена [5–7]), а также гибридных (полимер–металл [8]). Сопротивление мемристора изменяется в некотором окне между высокоомным (Roff) и низкоомным (Ron) состоянием в зависимости от приложенного напряжения и/или протекшего через мемристор электрического заряда, а также сохраняется в течение длительного времени в отсутствие внешнего воздействия, поэтому оно может играть роль синаптического веса. В отличие от НВС на основе транзисторов всего одного мемристора достаточно для эмуляции синапса [9]. Отметим, что мемристоры особенно интересны для НВС, так как с их помощью можно повторить нетривиальное биоподобное поведение синапсов (такое как дофаминоподобное обучение или биоподобные эффекты второго порядка [10, 11]).
Оксид гафния является одним из самых перспективных металлооксидных материалов для создания мемристивных систем, которые полностью совместимы с комплементарной логикой на транзисторах металл–оксид–полупроводник (КМОП-технологией) [12]. Для большинства мемристоров на основе HfO2 эффект РП связан с образованием/разрывом проводящего мостика (филамента) из кислородных вакансий или ионов металлов, если в структуре используется активный верхний электрод (Cu, Ag) [12]. Одним из наиболее часто используемых методов изготовления мемристоров на основе HfO2 является химическое осаждение из газовой фазы, а именно атомно-слоевое осаждение (АСО) [13–15]. Данный метод позволяет точно контролировать синтез ультратонких пленок, с его помощью успешно продемонстрированы различные мемристивные структуры. Однако для создания тонких пленок методом АСО требуются повышенные температуры (~250°С и выше), более того, данным методом сложно получать нестехиометрические пленки [13, 15, 16]. С другой стороны, нестехиометричность пленки может быть полезным инструментом для контроля процесса формирования филамента, а следовательно, и для подавления вариативности РП, что является важнейшей задачей для дальнейшего промышленного использования мемристоров [17, 18].
В связи с изложенным выше перспективно использование электронно-лучевого напыления (electron-beam deposition), которое не требует нагрева подложки, позволяет варьировать стехиометрию пленки, однако чрезвычайно редко используется для изготовления HfO2-мемристоров [12, 19]. Поэтому целью данной работы стало выявление особенностей изготовления HfO2-мемристоров методом электронно-лучевого напыления, а также подбор оптимальных параметров таких мемристивных структур (толщины слоя HfO2 и материала верхних контактов) для нейроморфных применений.
МАТЕРИАЛЫ И МЕТОДЫ
Многослойные структуры Me/HfOx/Au/Ti/с-Si (рис. 1а), исследованные с помощью растровой электронной микроскопии (РЭМ), были получены на подложке монокристаллического кремния c-Si методом электронно-лучевого напыления с использованием напылительной системы Angstrom Nexdep. Сначала на подложку наносили слой титана, который необходим для адгезии последующего слоя золота (Au) толщиной 50 нм, выступающего в роли нижнего электрода. На нижний электрод наносили диэлектрический слой оксида гафния (HfOx) толщиной от 20 до 62 нм. Сверху на слой HfOx через теневую маску наносили металлические контакты размером 0.2 × 0.5 мм2. В качестве материала верхних контактов использовали такие металлы, как Au и Ti (рис. 1б).
Рис. 1.
РЭМ-изображение мемристивной структуры (а), схематическое представление мемристивной структуры Ti/HfOx/Au/Ti/с-Si (б).
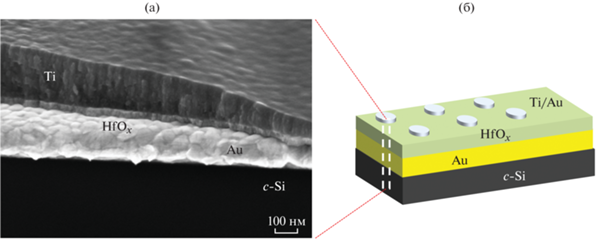
Мемристивные характеристики структур Me/HfOx/Au/Ti/с-Si (напряжения переключений Uset, Ureset, сопротивления низкоомного и высокоомного состояний Ron и Roff, времена удержания резистивных состояний и количество резистивных состояний) были изучены с помощью аналитической зондовой станции Economic 4” Probe Station (EPS4). Импульсы напряжения подавали на верхний электрод при заземленном нижнем электроде от источника-измерителя Keithley 2636B, запрограммированного в LabVIEW. Все измерения проводили при комнатной температуре.
РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
На рис. 2a представлены вольт-амперные характеристики (ВАХ) в логарифмическом масштабе для структур Au/HfOx/Au/Ti/с-Si с толщиной HfOx 20 нм. Каждый цикл ВАХ измеряли путем приложения к образцу напряжения U в следующей последовательности: линейное по времени увеличение напряжения от нуля до предельного положительного значения U+ с шагом 0.1 В, затем его уменьшение до предельного отрицательного значения U– и последующее повышение до нуля. Ток был ограничен в пределах от ‒50 до 1 мА, чтобы предотвратить перегрев и деградацию структуры. На этих структурах получено 18 циклов РП, которые были усреднены и показаны жирной кривой. Выявлено, что структуры Au/HfOx/Au/Ti/с-Si не обладают высоким выходом годных устройств на одной подложке, поэтому дальнейшие эксперименты с такими структурами не проводили. Можно предположить, что нестабильность РП связана с симметричностью структуры (два электрода из одного материала).
Рис. 2.
Последовательные ВАХ с указанием средней и медианной кривой для образцов Au/HfOx/Au/Ti/с-Si с толщиной HfOx 20 нм (a) и Ti/HfOx/Au/Ti/с-Si с толщиной HfOx 20 (б), 32 (в), 42 (г), 55 (д) и 62 нм (е).

На рис. 2б–2е представлены ВАХ в логарифмическом масштабе для структур Ti/HfOx/Au/Ti/с-Si с толщиной HfOx 20, 32, 42, 55 и 62 нм соответственно. Можно видеть, что структуры различаются по виду ВАХ в зависимости от варьируемых параметров. Так, для структуры с толщиной HfOx 20 нм было получено 15 циклов, для 32–99, для 42 – тоже 99, для 55–13, для 62–85. Можно сделать вывод, что наиболее стабильными переключениями обладают структуры с толщиной HfOx 32 и 42 нм. Хотя для образцов с толщиной 62 нм наблюдается большее количество переключений, чем для образцов с 55 нм, они не демонстрируют воспроизводимость от цикла к циклу (наблюдается большой разброс напряжений Uset и Ureset без четкого окна Ron/Roff). Следовательно, оптимальны образцы с толщиной 20 и 32 нм и верхним электродом Ti.
Были показаны многоуровневые РП, т.е. пластичность мемристивных структур. Для получения стабильного резистивного состояния на структуру подавили импульсы длительностью 100 мс, амплитуда напряжения которых возрастала с шагом 0.1 В до тех пор, пока не происходило переключение в заданное состояние. После получения нужного резистивного состояния один раз в секунду подавали считывающий импульс с напряжением чтения 0.1 В, который давал информацию о сопротивлении образца. На рис. 3a показаны девять стабильных резистивных состояний, полученных на структуре Ti/HfOx/Au/Ti/с-Si с толщиной HfOx 20 нм. На рис. 3б показаны 16 стабильных резистивных состояний, полученных на структуре Ti/HfOx/Au/Ti/с-Si с толщиной HfOx 32 нм. Отметим, что для других исследованных в работе структур не удалось обнаружить более восьми стабильных резистивных состояний. Это может быть связано с тем, что в более толстом слое HfOx филамент не может долго оставаться в одной конфигурации, из-за чего стабильность получается низкой.
Рис. 3.
Стабильные резистивные состояния для структуры Ti/HfOx/Au/Ti/с-Si с толщиной HfOx 20 (а) и 32 нм (б).
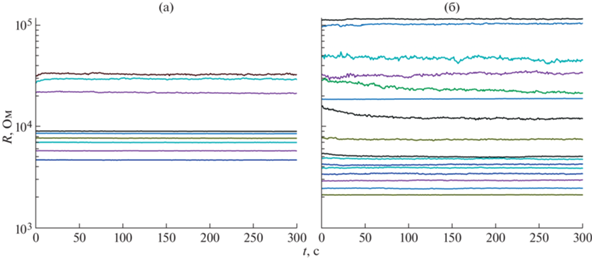
Не менее важной характеристикой является способность мемристивной структуры выдерживать циклические переключения из Roff в Ron и обратно под действием импульсов одинаковой длительности и амплитуды (различающихся только знаком). На рис. 4а показана такая характеристика для структур Ti/HfOx/Au/Ti/с-Si с толщиной HfOx 32 нм, а на рис. 4б для структур с толщиной HfOx 62 нм. Данные графики, как показательные, выбраны для демонстрации увеличения выносливости с увеличением толщины HfOx. Это может быть связано с тем, что со временем стехиометрия образцов меняется так, что окно сопротивлений уменьшается до единицы. При этом чем толще образец, тем дольше может держаться окно сопротивлений, что и наблюдается в эксперименте.
Согласно полученным результатам создание мемристивной структуры, которая будет демонстрировать все идеальные характеристики, затруднительно. Изменяя параметр осаждения, улучшаем одну характеристику, но ухудшаем другую. В данном случае структура Ti/HfOx/Au/Ti/с-Si с толщиной HfOx 20 нм лучшая по окну Roff/Ron в ВАХ, c толщиной 62 нм – по выносливости, с 32 нм – по пластичности, с 42 нм – по стабильности РП. Для решения этой проблемы можно предложить два пути: создавать структуры с одной лучшей характеристикой для решения определенных задач или держать баланс между характеристиками, варьируя параметры. В проведенном исследовании структура, для которой удалось получить баланс между характеристиками – Ti/HfOx/Au/Ti/с-Si с толщиной HfOx 32 нм.
Одним из способов улучшения характеристик и стабилизации РП является добавление дополнительных слоев оксидов или металлов. Также для улучшения характеристик используют добавление дефектов в структуры [17, 20] или шероховатости на поверхностях. Такие изменения позволяют локализовывать образование филаментов и контролировать их рост, изменение и разрушение.
ЗАКЛЮЧЕНИЕ
В работе исследованы мемристивные структуры Ме/HfOx/Au/Ti/с-Si. Изучено влияние на мемристивные характеристики таких параметров, как материал верхнего электрода и толщина диэлектрического слоя HfOx. Обнаружена зависимость выносливости, стабильности РП и пластичности от толщины HfOx и верхнего контакта. Сделан вывод о том, что структура с толщиной HfOx 32 нм и верхними электродами Ti демонстрирует баланс между основными мемристивными характеристиками.
Авторы выражают благодарность К.Н. Гарбузову за помощь в изготовлении образцов и А.В. Емельянову за плодотворное обсуждение работы.
Исследование выполнено при поддержке Российского научного фонда (грант № 23-19-00268), https://rscf.ru/project/23-19-00268/. Измерения выполнены с использованием оборудования Ресурсных центров при поддержке НИЦ “Курчатовский институт”.
Список литературы
Akopyan F., Sawada J., Cassidy A. et al. // IEEE Trans. Comput. – Aided Des. Integr. Circuits Syst. 2015. V. 34. № 10. P. 1537. https://doi.org/10.1109/TCAD.2015.2474396
Ielmini D. // Semicond. Sci. Technol. 2016. V. 31. № 6. P. 063002. https://doi.org/10.1088/0268-1242/31/6/063002
Martyshov M.N., Emelyanov A.V., Demin V.A. et al. // Phys. Rev. Appl. 2020. V. 14. P. 034016. https://doi.org/10.1103/PhysRevApplied.14.034016
Ilyasov A.I., Nikiruy K.E., Emelyanov A.V. et al. // Nanobiotechnology Reports. 2022. V. 17. P. 118. https://doi.org/10.1134/S2635167622010050
Shvetsov B.S., Matsukatova A.N., Minnekhanov A.A. et al. // Tech. Phys. Lett. 2019. V. 45. P. 1103. https://doi.org/10.1134/S1063785019110130
Shvetsov B.S., Minnekhanov A.A., Emelyanov A.V. et al. // Nanotechnology. 2022. V. 33. № 25. P. 255201. https://doi.org/10.1088/1361-6528/ac5cfe
Matsukatova A.N., Prudnikov N.V., Kulagin V.A. et al. // Adv. Intell. Syst. 2023. V. 5. № 6. P. 2200407. https://doi.org/10.1002/aisy.202200407
Matsukatova A.N., Vdovichenko A.Y., Patsaev T.D. et al. // Nano. Res. 2023 V. 16. P. 3207. https://doi.org/10.1007/s12274-022-5027-6
Zhang Y., Wang Z., Zhu J. et al. // Appl. Phys. Rev. 2020. V. 7. № 1. P. 011308. https://doi.org/10.1063/1.5124027
Matsukatova A.N., Emelyanov A.V., Minnekhanov A.A. et al. // Appl. Phys. Lett. 2020. V. 117. P. 243501. https://doi.org/10.1063/5.0030069
Minnekhanov A.A., Shvetsov B.S., Emelyanov A.V. et al. // J. Phys. D. 2021. V. 54. P. 484002. https://doi.org/10.1088/1361-6463/ac203c
Banerjee W., Kashir A., Kamba S. // Small. 2022. V. 18. № 23. P. 2107575. https://doi.org/10.1002/smll.202107575
Matveyev Yu., Egorov K., Markeev A., Zenkevich A. // J. Appl. Phys. 2015. V. 117. P. 044901. https://doi.org/10.1063/1.4905792
Koroleva A.A., Kozodaev M.G., Lebedinskii Yu.Y., Markeev A.M. // J. Phys. D. 2021. V. 54. P. 504004. https://doi.org/10.1088/1361-6463/ac26f6
Kwon O., Kim S., Agudov N. et al. // Chaos Solit. Fractals. 2022. V. 162. P. 112480. https://doi.org/10.1016/j.chaos.2022.112480
Lee S., Banerjee W., Lee S. et al. // Adv. Electron. Mater. 2021. V. 7. № 2. P. 2000869. https://doi.org/10.1002/aelm.202000869
Banerjee W., Liu Q., Hwang H. // J. Appl. Phys. 2020. V.127. № 5. P. 051101. https://doi.org/10.1063/1.5136264
Roldán J.B., Miranda E., Maldonado D. et al. // Adv. Intell. Syst. 2023. V. 5. P. 2200338. https://doi.org/10.1002/aisy.202200338
Arun N., Prabana J., Kumar K.V. et al. // AIP Conf. Proc. 2019. V. 2115. P. 030216. https://doi.org/10.1063/1.5113055
Gorshkov O., Antonov I., Filatov D. et al. // Adv. Mater. Sci. Eng. V. 2017. P. 1759469. https://doi.org/10.1155/2017/1759469
Дополнительные материалы отсутствуют.
Инструменты
Российские нанотехнологии



