Неорганические материалы, 2019, T. 55, № 9, стр. 946-951
Дислокационный магнетизм полупроводника GaSb〈Mn〉
В. П. Саныгин 1, *, А. Д. Изотов 1, О. Н. Пашкова 1
1 Институт общей и неорганической химии им. Н.С. Курнакова Российской академии наук
119991 Москва, Ленинский пр., 31, Россия
* E-mail: sanygin@igic.ras.ru
Поступила в редакцию 07.02.2019
После доработки 19.04.2019
Принята к публикации 22.04.2019
Аннотация
В изучении магнитного полупроводника GaSb〈Mn〉 применен подход, заключающийся в визуализации и анализе электронно-микроскопических изображений исследуемого объекта, широко используемый в практике при создании сверхсильных постоянных магнитов на основе металлических сплавов. При этом роль магнитных столбчатых кристаллитов отводилась дислокациям, декорированным марганцем, а роль немагнитной матрицы – полупроводниковому соединению GaSb. Проведены исследования полученного образца методами рентгеновской дифрактометрии, сканирующей электронной микроскопии и магнитометрии. Проанализирована зависимость намагниченности поперечного металлографического шлифа GaSb〈Mn〉 от угла его поворота к направлению магнитного потока в температурном интервале 4–300 К.
ВВЕДЕНИЕ
Изначально ожидалось, что при внедрении материалов спиновой электроники в полупроводниковые микроэлектронные устройства основную роль будут играть идеальные твердые растворы d- и f-элементов в полупроводниковых матрицах – разбавленные магнитные полупроводники (РМП) [1]. Однако на практике число РМП оказалось ограниченным, а их температуры Кюри, как правило, были ниже комнатной. Например, в случае РМП на основе полупроводникового соединения группы АIIIВV InSb, легированного d-элементом марганцем, пленки (In,Mn)Sb толщиной 2300 Å, синтезированные методом высокотемпературной молекулярно-лучевой эпитаксии на подложках CdTe/GaAs, имели температуру Кюри 8.5 K [2–4], а пленки толщиной 300 Å – 20 К [5]. В тонких слоях твердых растворов Ga1–xMnxSb, полученных методом молекулярно-лучевой эпитаксии при низкой температуре, температура Кюри изменялась от 20 до 40 К [6].
В основном же полупроводниковые соединения группы АIIIВV, легированные марганцем, с температурой Кюри, равной комнатной и выше, оказались магнитными полупроводниками, свойства которых были обусловлены кластеризацией марганца в виде магнитных соединений Mn–BV.
Поворотным пунктом в направлении дальнейших исследований стали результаты работы [7], в которой, по данным электронно-зондового микроанализа закаленных образцов InSb〈Mn〉, было установлено, что большая часть марганца расходуется на декорирование дислокаций в полупроводнике. Дислокации в InSb, декорированные марганцем, в основном определяют магнитные и электрические свойства образцов при комнатной температуре и выше. При этом, согласно результатам магнитных исследований, происходит образование нескольких магнитных фаз.
Активное участие дислокаций в кластеризации примеси нашло продолжение в работе [8], в которой свойство дислокаций притягивать к себе атомы примеси было рассмотрено с точки зрения возможности формирования линейно протяженных магнитных структур в диамагнитных матрицах полупроводниковых соединений AIIIBV. Там же была предложена концепция примесного магнетизма для соединений AIIIBV, легированных d‑элементами. В этой связи представлял интерес результат применения предложенной концепции к другому соединению AIIIBV – GaSb, легированному d-элементом марганцем.
Известно, что в кристаллическом антимониде галлия при атмосферном давлении может растворяться значительное количество атомов Mn, при этом полученные сплавы обладают ферромагнитными свойствами [9–12]. В дальнейшем было установлено, что магнитные свойства Ga1 – xMnxSb зависят не только от содержания марганца, но и от способа получения материала. Например, тонкие слои, выращенные методом молекулярно-лучевой эпитаксии при температурах от 600 до 720 К, были ферромагнитными при комнатной температуре и предположительно содержали кластеры MnSb [13–15]. В тонкой пленке GaSb〈Mn〉, полученной на подложке GaAs (100) методом осаждения из лазерной плазмы в потоке водорода при температуре 673 К, образуются ферромагнитные (или ферримагнитные) включения GaMn [16], а объемные монокристаллы Ga1 – xMnxSb (0.03 < x < < 0.14), выращенные методом Бриджмена, имели температуру Кюри, равную ~540 К [17].
В данной работе к изучению природы магнетизма GaSb〈Mn〉 был применен микроструктурный подход, широко используемый в практике создания сверхсильных постоянных магнитов на основе металлических сплавов.
ЭКСПЕРИМЕНТАЛЬНАЯ ЧАСТЬ
В работе [18] был исследован ферромагнетизм сплава полупроводникового соединения GaSb с 2% Mn. В качестве исходных компонентов для получения объемных образцов GaSb〈Mn〉 использовали антимонид галлия p-типа с концентрацией носителей p = 2.1 × 1016 см–3 и подвижностью 2.5 × 103 см2/(В с) и чистый Mn (99.99%).
Смесь нагревали в вакуумированной кварцевой ампуле со скоростью 200 К/ч до Т = 1200 К и выдерживали при этой температуре 24 ч. Закалку сплава проводили в воду со льдом при вертикальном положении кварцевой ампулы.
Для исследований методом рентгенофазового анализа (РФА) из слитка изготавливали порошки и поперечные металлографические шлифы со средними размерами 2 × 2 × 5 мм.
РФА образцов выполняли при комнатной температуре на дифрактометре Bruker в режиме пошагового сканирования. Интервал углов 2θ 10°–80°, шаг сканирования Δ2θ = 0.02°. Использовали CuKα-излучение (Ni-фильтр, λ = 1.5418 Å), которое в дальнейшем при обработке спектров раскладывалось на Kα1- и Kα2-составляющие.
Магнитные свойства образцов GaSb(2%Mn) при Т = 4 К и Т = 300 К и магнитном поле до Н = = 50 кЭ изучали на автоматизированном комплексе PPMS_9 (Quantum Design). Абсолютная чувствительность при измерении DC-намагниченности ±2.5 × 10–5 Гс см3.
РЕЗУЛЬТАТЫ И ОБСУЖДЕНИЕ
На рис. 1а представлена дифрактограмма порошка GaSb с 2% Mn [18]. Уменьшение параметра кристаллической решетки а GaSb〈Mn〉 на 0.016 Å может быть связано с появлением как ограниченного твердого раствора замещения Ga1 – xMnxSb, так и сжимающих напряжений, возникающих при закалке. Кроме этого, на дифрактограмме присутствуют три слабых дополнительных рефлекса, которые проиндицированы как рефлексы фазы Mn1.1Sb, имеющей гексагональную структуру с параметрами ячейки a = 4.157, c = = 5.757 Å (ICDD PDF № 01-077-8198). Температурная зависимость намагниченности образца подтверждает факт образования ферромагнитной фазы Mn1.1Sb с температурой Кюри ТС ≈ 560 К.
Дифрактограмма на рис 1б получена от поперечного кристаллографического шлифа, изготовленного из цилиндрической части вертикально закаленного слитка, и характерна для текстурированного поликристалла с ориентацией поверхности в кристаллографической плоскости (111).
Согласно [19], структура сфалерита образуется плоскостями легкого раскалывания типа (110) в результате образования сидячих дислокаций Ломера–Коттрелла.
Таким образом, установлено, что при легировании дислокаций GaSb атомами марганца структура сфалерита с плоскостями легкого раскалывания типа (110) приобретает свойства структуры алмаза с плоскостями легкого раскалывания типа (111). Обнаруженное явление макроскопического уровня – ротации плоскостей легкого раскалывания в результате микроскопического воздействия – декорирования дефектов кристаллической решетки, до этого не было отмечено в мировой литературе.
Согласно [20, 21], образование сидячей дислокации Ломера–Коттрелла является сложным процессом, состоящим из следующих явлений или состояний материала:
– образование 60-градусных дислокаций в пересекающихся кристаллографических плоскостях (рис. 2а);
Рис. 2.
60-градусная дислокация (а) и образование сидячей дислокации Ломера (б–г) с линиями дислокаций, расположенными вдоль кристаллографических направлений 〈110〉 относительно плоскости (111) GaSb (д).

– их расщепление на 30- и 90-градусные дислокации, соединенные слоем дефектов упаковки, и движение двух дефектов упаковки до встречи на линии пересечения плоскостей (рис. 2б, 2в);
– образование сидячей дислокации (рис. 2г).
Вероятность последовательного и полного выполнения всех актов процесса образования сидячей дислокации невелика, и очевидно, что материал, полученный методом закалки расплава, скорее всего, представляет собой скопление нерасщепленных, расщепленных и сидячих дислокаций Ломера–Коттрелла с преобладанием последних. Вместе с тем из рис. 2 д следует, что и 60-, и 30-, и 90-градусные, и, наконец, сама сидячая дислокация имеют одно и то же кристаллографическое направление 〈110〉.
Следовательно, в местах выхода всех перечисленных дислокаций на поверхность образца в результате травления будут образовываться одинаковые ямки травления.
Согласно [22], практически все твердые тела содержат структурные дефекты, которые можно считать внутренней поверхностью раздела. Следовательно, дефекты могут оказывать каталитическое воздействие на образование зародышей новой фазы. При этом скорость их образования в значительной степени зависит от свободной энтальпии процесса диффузии, а дальнейшее развитие зародышей лимитируется скоростями диффузии примеси к дефектам.
В этой связи следует подчеркнуть, что рост монокристаллов происходит в условиях, максимально приближенных к равновесным, его скорость постоянна и на несколько порядков ниже скорости диффузионных процессов. Образование сидячих дислокаций Ломера–Коттрелла и последующая преципитация на них атомов примеси за время выращивания происходят гарантированно полностью.
Закалка расплавов происходит быстро и с неравномерно понижающейся скоростью. Неравномерное понижение температуры приводит к изменению как скорости образования дислокаций, так и скорости диффузии примеси к дислокациям. Более того, в процессе закалки диффундирующие к дислокациям атомы примеси, в отличие от равновесного процесса, встречают на своем пути поверхностные (в виде границ зерен) и объемные (в виде микротрещин) дефекты кристаллической решетки матрицы.
Перечисленные явления приводят к тому, что образование второй фазы в процессе закалки происходит при бóльших концентрациях марганца, чем это наблюдается при выращивании монокристаллов InSb〈Mn〉 в условиях, максимально приближенных к равновесным.
Исследование поверхности поперечного металлографического шлифа GaSb〈Mn〉 методом сканирующей электронной микроскопии показало, что закалка расплава GaSb〈Mn〉 приводит к образованию кристаллографической текстуры (111) [23], а легирующий марганец располагается на линиях дислокаций 〈110〉 межзеренных границ в виде кластеров на основе ферримагнитного Mn2Sb и ферромагнитного MnSb [24] (рис. 3).
Рис. 3.
Данные сканирующей электронной микроскопии поверхности образца GaSb〈Mn〉: а – электронная микрофотография; б – микрофотография в рентгеновском излучении MnKα (скопления дислокаций сопровождаются скоплениями легирующего марганца).
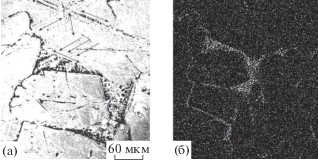
Из данных сканирующей электронной микроскопии (рис. 3а) следует, что поверхность магнитного полупроводника GaSb〈Mn〉 состоит из микроскопических неоднородностей, являющихся ямками травления выходов дислокаций на поверхность образца. В верхней части рис. 3а видно, что дислокации скапливаются в плоскостях скольжения и при одновременном пересечении трех полос скольжения дислокаций, углы между ними близки к углам сечения плоскости (111) тремя плоскостями (110), равными 60°.
Если области одновременного пересечения трех плоскостей скольжения являются линейными накопителями дислокаций, то сами плоскости скольжения – линейными “путепроводами” дислокаций при их движении по кристаллу. В центре рис. 3а отчетливо видны движения дислокаций по плоскостям скольжения к блокам треугольной формы (указаны стрелками). В этом случае дислокации останавливают встречные полосы скольжения и треугольные блоки становятся объемными накопителями дислокаций (рис. 3б).
Как следует из рис. 3а, вершины треугольных блоков являются либо точками соприкосновения с соседними блоками, либо началами микротрещин. Зарождение микротрещин является коллективным эффектом в дислокационных структурах, сопровождающимся их перестройкой с превращением запасенной в них энергии в поверхностную энергию микротрещин. Наблюдение микротрещин на множестве дислокаций высокой плотности (рис. 3а) позволяет заключить, что их зарождение и развитие происходят либо по безбарьерному (Коттрелла), либо по барьерному (Стро) дислокационным механизмам разрушения кристалла.
На основании проведенных исследований делается вывод о том, что возникновение и движение дислокаций являются основными механизмами формирования микроструктуры магнитного полупроводника GaSb〈Mn〉.
Исследования при Т = 4 К показали зависимость намагниченности поперечного металлографического шлифа GaSb〈Mn〉 от угла его поворота к направлению магнитного потока и ее практическое отсутствие при Т = 300 К (рис. 4).
Рис. 4.
Полевые зависимости намагниченности образца GaSb〈Mn〉 при различных углах между полированной поверхностью шлифа и магнитным потоком.

По данным рис. 4 делается вывод о том, что при низких температурах кристаллографическая анизотропия образца сопровождается его магнитной анизотропией, вызванной упорядоченным размещением магнитных кластеров на дислокациях по кристаллографическим направлениям 〈110〉. Уменьшение магнитной анизотропии образца с ростом температуры связывается с разрушением ферромагнетизма кластеров малых размеров тепловыми колебаниями атомов по мере приближения к суперпарамагнитному состоянию.
Измерение магнитных свойств показало, что при Т = 300 К образец GaSb〈Mn〉 еще сохраняет свойства ферромагнетика с коэрцитивной силой магнитомягкого материала Нс ≈ 10 Э (рис. 5) и сферические кластеры на дислокациях могут быть использованы как биты информации компьютерной оперативной памяти.
Рис. 5.
Коэрцитивная сила поперечного металлографического шлифа GaSb〈Mn〉 в зависимости от угла поворота при Т = 4 (а) и 300 К (б) .

На рис. 6 показаны участок поверхности образца с горизонтальным выходом на поверхность смешанной линейно-винтовой дислокации с несколькими сферическими кластерами и схема прямоугольной петли гистерезиса бита информации на одном из них.
Рис. 6.
Сферические кластеры на горизонтальном выходе дислокации на поверхность образца GaSb〈Mn〉 и схема петли гистерезиса бита информации на одном из них.

Варьируя структурные параметры полупроводников, концентрацию легирующего элемента и условия получения, можно создавать на дислокациях базовые элементы магниторезистивной оперативной памяти (MRAM) различных размеров и плотности.
ЗАКЛЮЧЕНИЕ
В результате проведенных исследований определено, что
– синтез образцов GaSb〈Mn〉 в неравновесных условиях приводит к образованию текстурированных поликристаллов, зерна которых образованы стенками дислокаций, декорированных марганцем;
– кристаллографическая анизотропия образца GaSb〈Mn〉 порождает его низкотемпературную магнитную анизотропию, обусловленную расположением магнитных кластеров на дислокациях, ориентированных в одинаковых кристаллографических направлениях;
– магнитные кластеры на дислокациях являются ферромагнетиками с коэрцитивной силой магнитомягкого материала и могут быть использованы как биты информации компьютерной оперативной памяти.
Список литературы
Иванов В.А., Аминов Т.Г., Новоторцев В.М., Калинников В.Т. Спинтроника и спинтронные материалы // Изв. РАН. Сер. хим. 2004. № 11. С. 2255–2303.
Wojtowicz T., Cywinski G., Lim W.L. et al. In1 – xMnxSb – a Narrow-Gap Ferromagnetic Semiconductor // Appl. Phys. Lett. 2003. V. 82. № 24. P. 4310-1-3. https://doi.org/10.1063/1.1583142
Wojtowicz T., Lim W.L., Liu X. et al. Growth and Properties of Ferromagnetic In1–xMnxSb Alloys // Physica E: Low-Dimens. Syst. Nanostruct. 2004. V. 20. Iss. 3–4. P. 325–332. https://doi.org/10.1016/j.physe.2003.08.028
Csontos M., Wojtowicz T., Liu X. et al. Magnetic Scattering of Spin Polarized Carriers in (In,Mn)Sb Dilute Magnetic Semiconductor // Phys. Rev. Lett. 2005. V. 95. № 22. P. 227203-1-4. https://doi.org/10.1103/PhysRevLett.95.269902
Yanagi S., Kuga K., Slupinski T., Munekata H. Carrier-Induced Ferromagnetic Order in the Narrow Gap III–V Magnetic Alloy Semiconductor (In,Mn) Sb // Physica E. 2004. V. 20. № 3–4. P. 333–337. https://doi.org/10.1016/j.physe.2003.08.029
Matsukura F., Abe E., Ohno H. Magnetotransport Properties of (Ga, Mn)Sb // J. Appl. Phys. 2000. V. 87. P. 6442–6444. https://doi.org/10.1063/1.372732
Саныгин. В.П., Филатов А.В., Изотов А.Д., Пашкова О.Н. Дислокации в InSb, легированном марганцем // Неорган. материалы. 2012. Т. 48. № 10. С. 1103–1109.
Саныгин В.П., Тищенко Э.А., Дау Хьеу Ши, Изотов А.Д. Концепция примесного дислокационного магнетизма в полупроводниковых соединениях AIIIBV // Неорган. материалы. 2013. Т. 49. № 1. С. 8–16.
Алиев М.И., Сафаралиев Г.И., Гулиев А.Н., Дадашев И.Ш., Мардахаев Б.Н. Диаграмма состояния и физические свойства сплавов системы GaSb–MnSb // Изв. АН СССР. Неорган. материалы. 1974. Т. 10. № 10. С. 1778–1782.
Basu S., Adhikari T. Bulk Growth, Composition and Morphology of Gallium Manganese Antimonide – a New Ternary Alloy System // J. Alloys Compd. 1994. V. 205. № 1–2. P. 81–85. https://doi.org/10.1016/0925-8388(94)90770-6
Munekata H., Ohno H., S. von Molnar, Chang L.L., Esaki L. Diluted Magnetic III–V Semiconductors // Phys. Rev. Lett. 1989. V. 63. № 17. P. 1849–1852. https://doi.org/10.1103/PhysRevLett.63.1849
Дадашев И.Ш., Сафаралиев Г.И. Физико-химические свойства твердых растворов Ga1 – xMnxSb (х ≥ 0.95) // Неорган. материалы. 1990. Т. 26. № 6. С. 1157–1159.
Chen X., Na M., Cheon M., Wang S., Luo H., McCombe B.D., Liu X., Sasaki Y., Wojtowicz T., Furdyna J.K., Potashnik S.J., Schiffer P. Above-Room-Temperature Ferromagnetism in GaSb/Mn Digital Alloes // Appl. Phys. Lett. 2002. V. 81. № 3. P. 511–513. https://doi.org/10.1063/1.1481184
Matsukura F., Abe E., Ohno Y., Ohno H. Molecular Beam Epitaxy of GaSb with High Concentration of Mn // J. Appl. Surf. Sci. 2000. V. 159. P. 265–269. https://doi.org/10.1016/S0169-4332(00)00108-2
Romanowski P., Bak-Misiuk J., Dynowska E., Domagala J.Z., Sadowski J. et al. Defect Structure of High-Temperature-Grown GaMnSb/GaSb // Acta Phys. Polonica A. 2010. V. 117. № 2. P. 341–343. https://doi.org/10.12693/APhysPolA.117.341
Бобров А.И., Павлова Е.Д., Кудрин А.В., Малехонова Н.В. Исследования структуры ферромагнитного слоя GaMnSb // Физика и техника полупроводников. 2013. Т. 47. № 12. С. 1613–1616.
Ganesan K., Bhat H.L. Magnetic and Magnetotransport Properties of Diluted Magnetic Semiconductor (Ga,Mn)Sb Crystals // J. Supercond. Nov. Magn. 2008. № 21. P. 391–397. https://doi.org/10.1007/s10948-008-0341-0
Пашкова О.Н., Изотов А.Д., Саныгин В.П., Филатов А.В. Ферромагнетизм сплава GaSb(2% Mn) // Журн. неорган. химии. 2014. Т. 59. № 11. С. 1570–1573. https://doi.org/10.7868/S0044457X1411018X
Халл Д. Введение в дислокации. М.: Атомиздат, 1968. 280 с.
Осипьян Ю.А. Электронные свойства дислокаций в полупроводниках. М.: Эдиториал УРСС, 2000. 314 с.
Мейер К. Физико-химическая кристаллография. М.: Металлургия, 1972. 480 с.
Маделунг О. Физика полупроводниковых соединений элементов III–V групп. М.: Мир, 1967. 480 с.
Саныгин В.П., Изотов А.Д., Пашкова О.Н. и др. Топографический анализ поверхности магнитного полупроводника GaSb〈Mn〉 // Неорган. материалы. 2016. Т. 52. № 9. С. 931–937. https://doi.org/10.7868/S0002337X16090153
Саныгин В.П., Изотов А.Д., Пашкова О.Н. Строение и химический состав дислокаций GaSb, легированных марганцем // Журн. неорган. химии. 2018. Т. 63. № 9. С. 1123–1130. https://doi.org/10.1134/S0044457X18090155
Дополнительные материалы отсутствуют.
Инструменты
Неорганические материалы



