Неорганические материалы, 2021, T. 57, № 3, стр. 235-242
Механизмы атомно-молекулярных процессов кристаллизации нитевидных нанокристаллов Si и GaAs
В. А. Небольсин 1, *, Н. Свайкат 1, В. В. Корнеева 1
1 Воронежский государственный технический университет
394026 Воронеж, Московский пр., 14, Россия
* E-mail: vcmsao13@mail.ru
Поступила в редакцию 26.03.2020
После доработки 25.09.2020
Принята к публикации 01.11.2020
Аннотация
Проанализированы атомно-молекулярные процессы кристаллизации нитевидных нанокристаллов (ННК) Si и GaAs. Показано, что атомная структура фазовой границы кристалл/жидкость приводит к худшей смачиваемости каплями металла-катализатора граней (111) Si и $\left( {\bar {1}\bar {1}\bar {1}} \right)$В GaAs, росту ННК Si и GaAs в направлениях 〈111〉 и $\left\langle {\bar {1}\bar {1}\bar {1}} \right\rangle $В, образованию арсенидных кристаллов с кубической и гексагональной решетками.
ВВЕДЕНИЕ
В работах [1–3] впервые показано, что в стационарных условиях роста нитевидных нанокристаллов (ННК) Si и других полупроводников по механизму пар → жидкая капля → кристалл (ПЖК) нуклеация осуществляется на тройной границе раздела фаз. Недавно in situ в формате видеосъемки продемонстрировано, что при росте ННК GaAs по методу ПЖК источником моноатомных ступеней выступает трехфазная линия (ТЛ) по периметру смачивания капли [4]. Зарождением новых слоев на ТЛ обусловлены не только особая морфология образующихся ННК [1], но и наблюдаемые изменения кристаллической структуры (например, переход от кубической структуры (CUB) типа цинковой обманки (ZB) к гексагональной (HEX) вюртцитной (WZ) для кристаллов GaAs [2] и др.). Однако в литературе [1–6] рост ННК описан лишь с макроскопических позиций и практически не рассматриваются атомно-молекулярные процессы кристаллизации, без которых невозможно правильное понимание механизма квазиодномерного роста, поскольку сам рост кристаллов представляет собой пример проявления атомной природы вещества. Цель настоящей работы – анализ механизмов атомно-молекулярных процессов кристаллизации ННК Si и GaAs, протекающих вблизи ТЛ и обеспечивающих присоединение частиц к энергетически выгодным позициям на торцевой грани кристалла.
МЕТОДИКА ЭКСПЕРИМЕНТА
Выращивание ННК Si осуществляли в системе SiCl4 + Н2 с участием каталитических частиц Au, Pt, Cu, Ni с размерами 50–250 нм по методике [1]. Молярное соотношение [SiCl4]/[Н2] задавалось в интервале от 0.05 до 0.10. Температура роста варьировалась от 1270 до 1370 К.
Морфология и структура выращенных кристаллов изучалась методами просвечивающей и растровой электронной микроскопии (РЭМ). Структурные характеристики ННК GaAs анализировались по литературным источникам.
РЕЗУЛЬТАТЫ И ОБСУЖДЕНИЕ
ННК Si и GaAs, находящиеся в контакте с насыщенными растворами жидких капель металла (М)-катализатора (Au, Pt, Ni, Cu, Ga и др.), обладают гладкими поверхностями раздела кристалл/жидкость, чаще всего представленными поперечной гранью семейства {111} [1, 5, 6]. При этом характерной особенностью роста ННК является стремление сохранить сингулярность фронта кристаллизации [5, 6]. Например, ННК Si со структурой алмазной кубической решетки обычно имеют ориентацию оси роста 〈111〉 (рис. 1а, 1б). Наиболее часто наблюдаемым направлением роста нанопроволок GaAs с CUB-структурой является направление $\left\langle {\bar {1}\bar {1}\bar {1}} \right\rangle $В, а фронт кристаллизации представлен в основном плоскими гранями $\left( {\bar {1}\bar {1}\bar {1}} \right)$В (рис. 1в) и редко гранями (111)А с ориентацией оси роста 〈111〉А [3–5]. ННК GaAs с WZ-структурой преимущественно имеют поперечную плотноупакованную грань $\left( {000\bar {1}} \right)$ и ориентацию оси кристалла $\left\langle {000\bar {1}} \right\rangle $ (рис. 1г) [5, 6].
Другой важной особенностью ННК Si и GaAs является ярко выраженный послойный характер их роста, причем кристаллы вырастают совершенными по структуре и морфологии (рис. 2а) [1, 5, 6]. Однако если граница раздела фаз не сингулярная, то ННК растут в других направлениях. В этом случае вырастают ННК, имеющие боковую огранку (рис. 2б, 2г), изгибы и ответвления (рис. 2в) [1, 5, 6].
Рост ННК GaAs ZB-структуры с полярными торцевыми гранями (111)А и $\left( {\bar {1}\bar {1}\bar {1}} \right)$В дает яркий пример влияния атомного строения поверхности раздела кристалл/жидкость на ее морфологию. Когда ННК GaAs вырастают вдоль направления $\left\langle {\bar {1}\bar {1}\bar {1}} \right\rangle $В, то имеют поверхность фронта кристаллизации, образуемую атомами мышьяка. При росте “мышьяковой гранью” $\left( {\bar {1}\bar {1}\bar {1}} \right)$В ННК получаются более совершенными, чем при росте “галлиевой гранью” (111)А. Рост ННК в направлении 〈111〉 с торцевой гранью (111)А, образуемой атомами Ga, реализуется гораздо реже. Рост галлиевой поверхности часто дает двойники (рис. 2д), приводит к ветвлению ННК и росту паразитных кристаллов на боковой поверхности основного [3, 5].
Удивительным также является тот факт, что у ННК со структурой алмаза и сфалерита быстро развивающиеся вершинные грани {111} – гладкие, следовательно, нуждающиеся в образовании двумерных зародышей и медленнорастущие, в то время как боковые грани {211}, {100} или {110}, наоборот, ступенчатые, образующиеся цепочечным механизмом, а поэтому быстрорастущие, – заметно не разрастаются [1, 5, 6]. Причем в случае ННК Si быстрее растут (и поэтому выклиниваются) боковые грани {110} и {100}, а у кристаллов GaAs грани {110} в сравнении с {211} более устойчивы [5, 6].
Повышение температуры роста с 1273 до 1473 K для ННК Si и с 773 до 1223 K для ННК GaAs приводит либо к образованию коротких тупоконечных кристаллов, либо к нарастанию по всей подложке толстой эпитаксиальной пленки и отсутствию кристаллов [1, 5].
Рассмотрим каплю жидкости, находящуюся в равновесии со своим паром на вершине ННК Si при температуре роста (рис. 3а, 3б). В квазихимическом приближении примем, что энергия перехода твердой фазы в жидкую (или наоборот), приходящаяся на один атом, пропорциональна числу оборванных (или образованных) кристаллических связей (КС). При растворении КС заменяются более слабыми связями в капле жидкости, а при кристаллизации, наоборот, в ННК появляются сильные связи.
Рис. 3.
Схема процесса образования (а) и роста (б) двумерного зародыша, примыкающего к ТЛ, и схема образования sp3-гибридных химических связей в кристаллах Si (в) (R – радиус капли катализатора, r – радиус ННК, φ – угол между касательной к поверхности капли в точке на периметре смачивания [2] и осью ННК, H – высота мениска, αGL и αGS – удельная свободная поверхностная энергия жидкой и твердой фаз, αLS – удельная свободная межфазная энергия границы кристалл/жидкость).

На внешней оболочке атомов Si имеются 4 электрона (3s23p2). Для формирования устойчивой 8-электронной конфигурации им недостает 4 электронов. Этот недостаток атомы пополняют путем обмена электронами с 4 ближайшими соседями, устанавливая с ними прочную ковалентную связь. Образующиеся химические sp3-связи – гибридные тетраэдрические (рис. 3в). Ковалентные связи ориентированы вдоль направления 〈111〉. Поэтому каждый атом в ННК Si имеет по 4 связи с ближайшими соседями, каждая из которых принадлежит двум атомам. Таким образом, число связей превышает число атомов в два раза (без учета поверхностных атомов). Следовательно, приходящаяся на каждый атом избыточная энергия, равная скрытой теплоте растворения, эквивалентна работе, которую надо совершить при разрыве двух связей, т.е. равна энергии двух связей. Но при растворении Si в жидкой капле связи разрушаются не полностью и требуется лишь часть общего количества энергии. Процесс растворения можно разбить на два: плавление и смешение двух жидкостей. С целью упрощения, как для идеальных растворов, будем считать тепловой эффект смешения двух жидкостей равным нулю, а растворение Si будем представлять как плавление. Таким образом, атомная теплота плавления Si соответствует энергии, необходимой для уменьшения числа КС на два, а теплота, необходимая для расплавления кристалла, эквивалентна энергии двух связей, приходящихся на каждый атом.
Рассмотрим атомы на идеальной торцевой грани {111} Si на вершине ННК (рис. 4а). Атом на Si-поверхности имеет 3 соседних атома в твердой фазе и образует три связи типа твердое–твердое (Т–Т) и одну связь твердое–жидкость (Т–Ж). Энергия атома Si на поверхности больше энергии атома в объеме (внутри решетки) на 1/4 величины скрытой теплоты плавления. Чтобы удалить такой атом с поверхности надо разорвать 3 связи Т–Т, т.е. сообщить 3/4 скрытой теплоты плавления. Это уменьшает число ближайших соседних атомов у каждого из 3 примыкающих к нему атомов Si на единицу, т.е. на долю каждого из них приходится по 1/4 скрытой теплоты плавления (3/4 : : 3 = 1/4). Таким образом, 3/4 скрытой теплоты плавления распределяется поровну между соседними атомами, остающимися на поверхности после удаления атома с поверхности, а общий расход энергии составит 3/4 L (L – атомная удельная теплота плавления), и энергия поверхности должна увеличиться на 1/2 L.
Рис. 4.
Схема химических связей атома Si, расположенного на структурной границе раздела кристалл/жидкость ННК: (111) (а) и (100) (б).

В процессе кристаллизации, наоборот, каждый атом Si, выделяющийся из раствора, образует химические связи с 3 поверхностными атомами плотноупакованной атомно-гладкой грани {111}. Следовательно, свободная энергия на каждый атом в этом случае уменьшается на 1/2 удельной теплоты плавления, в результате чего выделяется энергия кристаллизации.
Если рассмотреть грань {100} ННК Si, то на ней каждый атом верхнего слоя связан двумя гибридизированными связями с атомами второго слоя и имеет 2 свободные (оборванные или слабонасыщенные) связи (рис. 4б), а следовательно, приходящаяся на атом энергия составляет 1/2 скрытой теплоты. Однако в этом случае число атомов Si, приходящихся на единичную площадь, меньше по сравнению с гранью {111}, соотношение составляет 1 : 1.154 [10]. Отсюда следует, что отношение удельных поверхностных энергий граней {100} и {111} составляет (1.154 × 1/4) : (1 × 1/2) ≈ 1 : : 0.58, т.е. удельная свободная энергия грани {111} Si меньше, чем свободная энергия грани {100}. Таким образом, каждый атом на торцевой грани {111} ННК Si, обладающий тремя связями Т–Т и одной связью Т–Ж, будет иметь меньшую величину избыточной энергии, чем атом, расположенный на грани {100} и имеющий по две связи Т–Т и Т–Ж [10].
С другой стороны, атом Si, находящийся в капле раствора и в контакте с торцевой гранью {111} ННК, может образовать только одну связь Т–Ж в направлении нормали к грани {111} и его избыточная энергия (относительно энергии атомов в объеме капли) будет больше той же величины для грани {100} Si, где атом расплава может замкнуть две свободные связи, компенсируя тем самым большую часть избыточной энергии [10].
Следовательно, твердая поверхность {111} Si будет более стабильна в контакте с раствором М-катализатора по сравнению с гранью {100} [10]. Жидкий же слой Si в растворе М-катализатора, прилегающий к грани {111} ННК, менее устойчив, чем у грани {100}, и будет легче выделяться из капли [10]. Поэтому можно считать, что граница раздела кристалл/жидкость с гранью {111} Si со стороны твердой фазы должна быть резкой, тогда как граница раздела кристалл/жидкость у грани {100} должна быть более размытой в сторону твердой фазы. Поэтому отделить каплю катализатора от грани {111} ННК путем отрыва легче, чем от грани {100} [10]. Поскольку “прилипание” (связь) капли к грани {111} ННК слабее [10], чем к другим граням, следует ожидать как преимущественного роста кристаллов Si в направлении 〈111〉, так и худшей смачиваемости грани {111} каплями М‑катализатора по сравнению с другими гранями [11]. Плохая смачиваемость торцевой грани {111} ННК каплями М-катализатора обуславливает высокие энергетические барьеры для нуклеации.
Таким образом, повышенные энергетические барьеры зародышеобразования на торцевой грани {111} ННК Si, обусловленные слабой адгезией капли катализатора к этой грани, приводят к нуклеации на ТЛ и преимущественному росту ННК наиболее плотноупакованной гранью {111}. С повышением температуры выращивания смачиваемость граней ННК каплями М-катализатора улучшается, что приводит к потере устойчивости роста.
Для выяснения механизмов преимущественного роста ННК GaAs с ZB-структурой в направлении $\left\langle {\bar {1}\bar {1}\bar {1}} \right\rangle $В рассмотрим атомно-молекулярные процессы в предположении, что поверхностные связи на грани $\left( {\bar {1}\bar {1}\bar {1}} \right)$В близки к sp3-гибридным, а на грани (111)А – к sp2-гибридным (рис. 3).
Данное предположение можно обосновать следующими соображениями. Если граница кристалл/жидкость представлена плоскостью (111)А GaAs, то атомы As образуют одну ковалентную связь с одним соседним атомом в твердой фазе и три связи Т–Ж. Такая конфигурация энергетически нестабильна. Если же граница представлена плоскостью $\left( {\bar {1}\bar {1}\bar {1}} \right)$В GaAs, то атомы As, наоборот, образуют три связи с тремя соседними атомами в твердой фазе и одну связь Т–Ж. Поэтому отделить каплю катализатора от грани $\left( {\bar {1}\bar {1}\bar {1}} \right)$В легче, чем от грани (111)А. Следовательно, должна наблюдаться худшая смачиваемость грани $\left( {\bar {1}\bar {1}\bar {1}} \right)$В жидкостью и преимущественный рост ННК GaAs в направлении $\left\langle {\bar {1}\bar {1}\bar {1}} \right\rangle $B.
Известно, что в ННК GaAs наряду с ковалентной химической связью присутствует некоторая доля ионной составляющей связи. Возникновение ионной связи в GaAs обусловлено разностью электроотрицательностей атомов Ga и As [9]. Торцевая грань $\left( {\bar {1}\bar {1}\bar {1}} \right)$В ННК GaAs с ZB-структурой образована более крупными анионами мышьяка (радиус иона As– равен ~0.167 нм). Расположенные на грани $\left( {\bar {1}\bar {1}\bar {1}} \right)$В анионы As– и катионы Ga+, имеющие меньший размер, смещаются в глубь двойной кристаллической фазы. Благодаря различию размеров и поляризуемости ионов As– и Ga+ их смещение неодинаково. Поляризуемость катиона Ga+ меньше поляризуемости аниона As–. Это в сочетании с большими размерами As– приводит к меньшему смещению иона As– под воздействием поля кристалла.
Поскольку ионы Ga+ поверхностного слоя ННК претерпевают большее смещение в направлении, перпендикулярном поверхности, на грани (111)А структура “уплотняется” по сравнению с объемом, а на грани$\left( {\bar {1}\bar {1}\bar {1}} \right)$В – разрыхляется [12]. При этом на грани (111)А ионы Ga+ немного опускаются, занимая промежуточное положение между sp3- и sp2-конфигурациями связей, т.е. поверхностный атом будет проявлять тенденцию к sр2-гибридизации [12]. Установлено, что уплотнение на грани (111)А составляет ∼16%, а на грани $\left( {\bar {1}\bar {1}\bar {1}} \right)$В “разрыхление” составляет ∼3%, причем смещение атомов на грани $\left( {\bar {1}\bar {1}\bar {1}} \right)$В в 1.5–2.5 раза больше, чем на грани (111)А [12]. Регибридизация sp3-связей на грани (111)А приводит к различиям в электронной структуре полярных граней (111)А и $\left( {\bar {1}\bar {1}\bar {1}} \right)$В ННК GaAs. Следовательно, работа выхода электронов и сродство к электрону на этих гранях должны быть различны.
Из схемы рис. 5а видно, что поверхностные связи на торцевой грани $\left( {\bar {1}\bar {1}\bar {1}} \right)$В ННК готовы к присоединению двухатомного комплекса, поэтому их активация и присоединение пары Ga−As осуществляются легко. При росте грани (111)А поверхностные связи не подготовлены к присоединению комплекса, поэтому при приближении пары Ga−As к месту присоединения происходит активация связей (sp2 → sp3), а затем присоединение двухатомного комплекса к грани, причем это осуществляется за счет валентных электронов комплекса (рис. 5б). Оба указанных акта требуют преодоления бóльших энергетических барьеров, чем в случае роста ННК в направлении $\left\langle {\bar {1}\bar {1}\bar {1}} \right\rangle $В.
Рис. 5.
Схема роста ННК кубического GaAs в полярных направлениях: $\left\langle {\bar {1}\bar {1}\bar {1}} \right\rangle $В (а), 〈111〉A (б) (стрелками показаны направления роста кристалла).
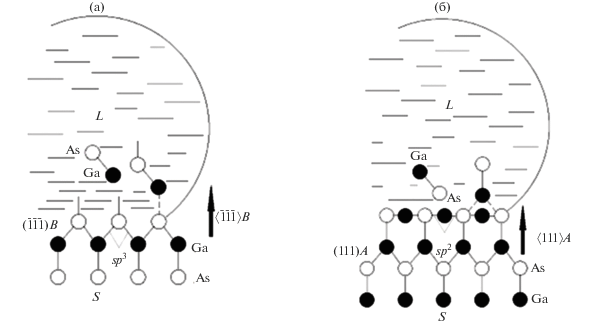
Итак, ступени роста на противоположных гранях ННК GaAs совершенно различны. На галлиевой стороне ступеньки зазубрены, а на мышьяковой они прямые и имеют гораздо более правильную форму. Зазубренные ступеньки Ga-стороны наклонены таким образом, что они фактически образуют мышьяковые грани. Поэтому атомы As стабилизируют границу кристалл/жидкость и рост ННК. При этом скорость роста ННК GaAs с поперечной гранью $\left( {\bar {1}\bar {1}\bar {1}} \right)$В выше, чем с гранью (111)А.
Образование sp3-гибридных связей при кристаллизации ННК GaAs может быть представлено формальной схемой (рис. 6), которая иллюстрирует механизм возникновения эффективных зарядов Ga– и As+.
Ковалентная связь в GaAs, в отличие от Si, не является “чистой”, т. к. здесь присутствует ионная составляющая. Следовательно, величина энергетических барьеров в случае роста ННК в направлении 〈111〉A, связанного с sp3-гибридизацией атомных орбиталей, очевидно, должна возрастать с увеличением доли ионной составляющей связи в кристаллах. И, наоборот, возрастание доли ионной связи может приводить не только к преимущественному росту ННК с кристаллографической ориентацией $\left\langle {\bar {1}\bar {1}\bar {1}} \right\rangle $В [2], но и к возникновению WZ-структуры ННК GaAs [2] (рис. 7). Наличие доли ионной связи в кристаллах GaAs с ZB-структурой приводит к возникновению кулоновских сил притяжения между соседними плоскостями {111} [2], построенными из атомов разного сорта, и отталкивания между гранями {110}, построенными из равного количества атомов Ga и As [2].
Рис. 7.
Схема присоединения двухатомных комплексов Ga−As в процессе роста гексагонального ННК GaAs в направлении $\left\langle {000\bar {1}} \right\rangle .$

Поэтому вблизи ТЛ за счет дополнительного кулоновского взаимодействия могут начаться образование комплексов с sp3-гибридными связями и перестройка атомной решетки ZB-кристалла GaAs в двойниковую WZ-решетку [2]. Двойниковая WZ-структура ННК стабилизируется электростатическими силами, поскольку в такой структуре, в отличие от CUB, анионы и катионы симметрично располагаются относительно плоскости двойникования [2]. При этом у ННК GaAs с WZ-структурой в перпендикулярном к плоскости роста направлении (обычно (0001)А или $\left( {000\bar {1}} \right)$В) понижается свободная поверхностная энергия αGS в сравнении с ZB-кристаллом [2]. При этом полярные плоскости {111}A и $\left\{ {\bar {1}\bar {1}\bar {1}} \right\}$В в ZB-структуре адекватны плоскостям {0001}A и $\left\{ {000\bar {1}} \right\}$В WZ-структуры.
Таким образом, энергетические затруднения для роста ННК GaAs в направлении 〈111〉A, связанные с перестройкой sp2 → sp3 атомных орбиталей, должны возрастать с увеличением доли ионной связи. Большая доля ионной связи в ННК GaAs приводит как к их преимущественному росту в направлении $\left\langle {\bar {1}\bar {1}\bar {1}} \right\rangle $В, так и к возникновению WZ-структуры.
ЗАКЛЮЧЕНИЕ
Показано, что атомная структура границы раздела кристалл/жидкость влияет на рост и морфологию ННК Si и GaAs. Рост ННК Si с большими скоростями плотноупакованной гранью {111} можно объяснить слабой адгезией М-катализатора к граням {111} кристалла и, как следствие, пониженными энергетическими барьерами нуклеации на ТЛ. Рост ННК GaAs CUB-структуры гранью $\left( {\bar {1}\bar {1}\bar {1}} \right)$В связан с облегчением присоединения комплексов Ga−As к торцевой поверхности ННК за счет уже имеющихся на грани sp3-гибридных химических связей, в то время как для грани (111)A требуется затрата энергии для активации связей (sp2 → sp3). Установлено, что возрастание доли ионной связи в ННК GaAs может приводить к возникновению WZ-структуры.
Список литературы
Небольсин В.А., Щетинин А.А. Рост нитевидных кристаллов. Воронеж: ВГУ, 2003. 620 с.
Небольсин В.А., Щетинин А.А. Развитие представлений о квазиодномерном росте нитевидных кристаллов // Альтерн. энерг. и экол. 2015. № 3. С. 62–78.
Glas F., Harmand J.C., Patriarche G. Why does Wurtzite form in Nanowires of III-V ZB Semiconductors? // Phys. Rev. Lett. 2007. № 14. P. 146101–146106.
Harmand J.-C., Patriarche G., Glas F., Panciera F., Florea I., Maurice J.-L., Travers L., Ollivier Y. Atomic Step Flow on a Nanofacet // Phys. Rev. Lett. 2018. № 16. P. 166101–166109.
Dubrovskii V.G. Nucleation Theory and Growth Nanostructures. Berlin, Heidelberg, Berlin: Springer-Verlag, 2014. 601 p.
Wagner R.S., Ellis W.C. Vapor-Liquid-Solid Mechanism of Single Crystal Growth // Appl. Phys. Lett. 1964. V. 4. № 5. P. 89–95.
Panciera F. et al. Phase Selection in Self-Catalysed GaAs Nanowires // Nano Lett. 2020. V. 20. № 3. P. 1669–1675.
Gas K. et al. Structural and Optical Properties of self-catalytic GaAs:Mn Nanowires Grown by Molecular Beam Epitaxy on Silicon Substrates // Nanoscale. 2013. V. 5. P. 7410–7418.
Burgess T. et al. Twinning Superlattice Formation in GaAs Nanowires // ACS Nano. 2013. V. 7. № 9. P. 8105–8114.
Nebol’sin V.A., Dolgachev A.A., Spiridonov B.A., Zo-tova E.V. Effect of Interfacial Free Energy Anisotropy on Silicon Whisker Growth // Inorg. Mater. 2012. V. 48. № 8. P. 757–762.
Nebol’sin V.A., Vorob’ev A.Yu., Swaikat N. A New Understanding of the Vapor–Liquid–Solid Mechanism of Nanowire Growth // Inorg. Mater. 2020. V. 56. № 4. P. 346–352.
Блиев А.П., Наконечников А.В. Электронная структура полярных граней арсенида галлия // Изв. вузов., Сев.-Кав. регион. 2005. № 5. С. 27–35.
Дополнительные материалы отсутствуют.
Инструменты
Неорганические материалы