Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2019, № 1, стр. 104-112
МД-моделирование физического распыления пористых Si-содержащих материалов ионами Ar низких энергий
А. А. Сычева 1, 2, *, Е. Н. Воронина 1, 2, Т. В. Рахимова 2
1 Московский государственный университет им. М.В. Ломоносова,
119991 Москва, Россия
2 Московский государственный университет им. М.В. Ломоносова,
НИИ ядерной физики им. Д.В. Скобельцына,
119991 Москва, Россия
* E-mail: sycheva.phys@gmail.com
Поступила в редакцию 17.01.2018
После доработки 22.03.2018
Принята к публикации 15.03.2018
Аннотация
Проведено моделирование методом молекулярной динамики процесса физического распыления поверхности (001) сплошного и пористого кристаллического кремния ионами Ar с энергией 100 и 200 эВ. Выявлены особенности протекания процесса в пористых материалах. Получены зависимости коэффициента распыления от дозы и энергии налетающих ионов. Описаны структурные изменения, происходящие под действием ионов. Продемонстрировано несходство механизмов распыления для материалов, различающихся радиусами пор и степенью пористости.
ВВЕДЕНИЕ
В настоящее время совершенствование технологии производства сверхбольших интегральных схем и уменьшение размеров элементов, входящих в их состав, – наиболее актуальные проблемы современной микроэлектроники. Использование нанопористых SiOCH-материалов с низкой диэлектрической проницаемостью в рабочем диапазоне частот (low-κ материалы, κ – диэлектрическая константа) [1] для межслойной изоляции интегральной схемы позволяет увеличить ее быстродействие, снизить диссипацию энергии, повысить скорость распространения сигнала. Существующие технологии изготовления сверхбольших интегральных схем используют плазму на многих этапах обработки материалов. Важной задачей в рамках исследований механизмов плазменного травления low-κ диэлектриков является изучение механизмов физического распыления ионами инертных газов низкой энергии (до 200 эВ). Поскольку значение диэлектрической константы современных low-κ пленок зависит от размера пор, исследование влияния пористости на интенсивность распыления материала и на его структуру может указать на возможные механизмы изменения химических и физических свойств SiOCH-пленок. Начальным этапом исследования является численное моделирование процесса распыления структурных аналогов low-κ диэлектриков, обладающих более простым химическим составом, и сопоставление полученных результатов с данными для сплошного материала.
К настоящему моменту одним из наиболее изученных материалов является кристаллический кремний, физическое распыление которого было исследовано экспериментально и теоретически в широком диапазоне значений энергии (25–1000 эВ) ионов Ar при различных углах падения [2–4]. В качестве основного инструмента численного моделирования использовался метод молекулярной динамики (МД), основанный на временном интегрировании классических уравнений движения атомов. Как показали выполненные расчеты, такой подход позволяет получить корректные оценки коэффициента физического распыления для различных условий облучения поверхности кремния [5]. Например, в [6] значение коэффициента при нормальном падении ионов Ar с энергией 500 эВ, полученное в результате МД-моделирования, равно 0.59 и близко к экспериментальному (0.6). Однако результаты ряда других исследований с использованием метода МД [2] свидетельствуют о некотором занижении вероятности распыления кремния по сравнению с экспериментальными значениями, что особенно заметно при низких энергиях Ar. В работе [3] коэффициент физического распыления кремния при нормальном падении ионов Ar с энергией 200 эВ, полученный с использованием метода МД, находится в диапазоне 0.17–0.23, однако его экспериментальное значение составляет 0.33 [4]. Таким образом, данный подход позволяет получить представление о механизмах изучаемых процессов, но при этом имеется ряд особенностей, которые определяют результаты моделирования.
Одна из наиболее важных проблем при использовании метода МД – выбор потенциала, определяющего взаимодействие частиц системы. В ряде исследований [3, 6, 7] притяжение/отталкивание между атомами Si определяется трехчастичным потенциалом Stillinger–Weber [8], который не совсем корректно описывает взаимодействие атомов на малых расстояниях, поэтому для моделирования воздействия ионов с энергией более 200–300 эВ дополнительно используют парные потенциалы Мольера или ZBL (Zigler−Biersack−Littmark), учитывающие кулоновское экранирование [9]. Также в некоторых работах используют потенциал MEAM (МЕАМ – Modified Embedded Atom Method) [10], в основе которого лежит модель погруженного атома [11], или потенциалы, рассчитанные методом теории функционала плотности [6].
Другой существенной трудностью при МД-моделировании является корректный учет перераспределения энергии между налетающей частицей и поверхностью материала. Один из способов решения указанной проблемы – отвод тепловой энергии путем искусственного охлаждения области материала, расположенной над нижними неподвижными слоями атомов [12]. Также применяют термостат, воздействующий на моделируемую систему с определенной периодичностью. В результате стабилизация температуры системы происходит в фиксированные промежутки времени [10].
В настоящей работе проведено моделирование методом МД физического распыления ионами Ar (энергия 100 и 200 эВ, нормальное падение) поверхности кристаллического сплошного/пористого кремния и детально проанализирована морфология полученных пористых структур.
МЕТОДИКА МОДЕЛИРОВАНИЯ
Для изучения процессов физического распыления low-κ диэлектриков использовали две модели пористых структур, которые аналогичны структуре применяемых в современном технологическом процессе SiOCH-пленок [13, 14]: CVD 2.5 (радиус пор Rpore = 0.8 нм, максимальный радиус отверстия между порами Rint = 0.7 нм, пористость P = 22%; модель 1); SOG 2.0 (Rpore = 2.8 нм, Rint = 2.1 нм, P = 40%; модель 2).
Модели нанопористых структур были созданы на основе модели сплошной поверхности кристаллического кремния размером 10.9 × 10.9 × 16.3 нм, что соответствует пространству 20 × 20 × 30 элементарных ячеек кристаллической решетки Si. Исходная модель была построена таким образом, чтобы поверхность (001) располагалась перпендикулярно оси Z под зазором высотой 10 элементарных ячеек. Вдоль осей X и Y накладывали граничные условия с целью имитации бесконечно большой поверхности материала и минимизации краевых эффектов. Нижний слой атомов толщиной 2.7 нм был зафиксирован в течение всего процесса моделирования. В двух построенных моделях с различной степенью пористости (табл. 1) кремний содержал сферические поры примерно одного радиуса: 0.8 (модель 1) и 2.7 нм (модель 2). Число пор в модели определяли на основании степени пористости материала и радиуса пор, а координаты их центров выбирали таким образом, чтобы расстояние между центрами d удовлетворяло следующему условию:
Таблица 1.
Основные параметры исходных моделей кристаллического кремния
| Модель | Структурный low-κ аналог | P, % | Rpore, нм | Rint, нм | Число атомов в модели | Площадь полной поверхности, нм2 |
|---|---|---|---|---|---|---|
| Сплошной материал | – | 0 | 0 | 0 | 64 000 | 118 |
| Модель 1 | CVD 2.5 | 22 | 0.8 | 0.7 | 49 600 | 1183 |
| Модель 2 | SOG 2.0 | 40 | 2.8 | 2.1 | 38 400 | 539 |
Рис. 1.
Модели 1 (а) и 2 (б) кремния с различной пористостью (табл. 1): поверхности пор выделены цветом (области визуального наложения поверхностей пор темные); точки – атомы кремния в узлах кристаллической решетки.

Взаимодействие между атомами Si описывали с помощью трехчастичного потенциала Stillinger–Weber [8], а между Ar и Si – с использованием парного отталкивающего потенциала Мольера (постоянную экранирования рассчитывали по модели Фирсова) [9].
Моделирование процесса физического распыления методом МД проводили для энергии налетающих ионов Ar 100, 200 и 500 эВ (нормальное падение) следующим образом. Каждые 7 пс в верхней части ячейки создавали ион Ar со случайными координатами и с заданной скоростью, направленной перпендикулярно поверхности. Если воздействие приводило к вылету атома Si или Ar с поверхности, то такой атом считали распыленным (для Si) или отразившимся (для Ar) и удаляли из системы в момент, когда расстояние между ним и поверхностью превышало 1 нм. Временной шаг интегрирования был выбран достаточно малым – 0.1 фс. Перегрев материала подавляли благодаря периодическому воздействию на систему внешнего термостата в соответствии со следующим алгоритмом [10]: первые 3.5 пс с момента генерации иона Ar термостат не использовали, а во второй половине цикла к системе применяли термостат Берендсена при температуре 300 К и параметре релаксации 18 фс, для того чтобы охладить структуру до указанной температуры. Полученную в конце цикла структуру рассматривали как исходную поверхность для следующего удара, и процесс повторяли до достижения необходимой дозы. Таким образом, в отличие от ряда исследований [2], в настоящей работе МД‑моделирование проводили с накоплением повреждений, как, например, в [12]. Использование такого подхода обусловлено необходимостью исследования изменения морфологии пористых структур под действием ионов. Моделирование воздействия ионов Ar с энергией 100 и 200 эВ на пористый кремний было выполнено для 3000 последовательных ударов, что соответствует дозе (интегральному по времени потоку ионов на единицу площади поверхности) 2.5 × 1015 см–2.
Вычисления выполняли с помощью свободного программного пакета LAMMPS для классической молекулярной динамики, разработанного для расчетов в рамках больших ансамблей атомов (до 10 000 000) [15] с использованием ресурсов суперкомпьютерного комплекса МГУ имени М.В. Ломоносова [16]. Вычислительные мощности, необходимые для моделирования воздействия 100 ионов аргона на кремний в моделях 1 и 2 (доза 8 × 1013 см–2), составили 5000 процессор-час. Визуализацию моделей и анализ структурных изменений осуществляли с использованием пакета OVITO [17].
РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
Результаты МД‑моделирования процесса распыления поверхности сплошного кремния, полученные при нормальном падении ионов Ar с энергией 100, 200 и 500 эВ, хорошо согласуются с расчетными данными [2, 3]. Воздействие ионов приводит к разрыву поверхностных связей в материале мишени и вылету отдельных атомов Si. По мере возрастания числа ударов на поверхности образуется аморфный слой, толщина которого зависит от энергии налетающих ионов и составляет 1.0, 1.5 и 2.0 нм для 100, 200 и 500 эВ соответственно, что совпадает с данными других работ: например, в [7] толщина аморфного слоя составила 0.9 нм при энергии 100 эВ. Налетающие ионы Ar могут рассеиваться поверхностью кремния или проникать в верхние слои на среднюю глубину 0.7, 0.9 и 1.3 нм при энергии 100, 200 и 500 эВ соответственно. При достижении дозы 1015 см–2 доля атомов Ar, оставшихся в системе, составляет 10–30% в зависимости от энергии.
Одной из наиболее важных количественных характеристик процесса распыления является коэффициент физического распыления Y, равный отношению количества распыленных атомов материала к числу налетающих ионов. Рассчитанные зависимости Y от дозы ионов при энергии 100 и 200 эВ (рис. 2) показывают, что при достаточно больших дозах (~1015 см–2) интенсивность распыления достигает насыщения, что свидетельствует о завершении процесса формирования аморфного слоя и установлении в системе динамического равновесия. Дальнейшее возрастание числа падающих ионов не приводит к заметным изменениям толщины этого слоя и значения Y. Как видно из рисунка, при максимальной дозе, полученной в настоящей работе (~2.5 × 1015 см–2), коэффициент распыления равен 0.06 при энергии ионов 100 эВ и 0.18 при 200 эВ, а для энергии 500 эВ насыщение наступало при меньшей дозе, и значение Y было равно 0.45. Экспериментальные значения Y при нормальном падении ионов низких энергий составили: 0.07 [18] и 0.08 [19] для 100 эВ, 0.18 для 200 эВ [18] и 0.48 для 500 эВ [19], что хорошо согласуется с результатами МД-моделирования. Дополнительно были определены коэффициенты распыления при падении ионов под углом 60°: 0.61 (100 эВ) и 1.31 (200 эВ).
Рис. 2.
Зависимость коэффициента распыления Y материала при энергии налетающих ионов 100 (1–3) и 200 эВ (4–6) от дозы для: сплошного кристаллического Si (1, 4); модели 1 (2, 5), модели 2 (3, 6).
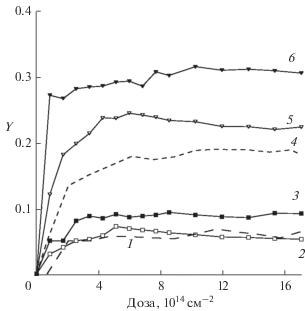
Аналогичные зависимости коэффициента распыления были рассчитаны для исследуемых пористых моделей при тех же значениях энергии падающих ионов (рис. 2). Как видно из рисунка, при энергии ионов Ar 200 эВ наличие пор в структуре приводит к повышению Y Si в 1.7 раз в случае модели 2 (пористость 40%) и в 1.2 раза в случае модели 1 (пористость 22%) по сравнению со сплошным материалом (табл. 2). Данный результат можно объяснить наличием пор на поверхности, благодаря которым взаимодействие приповерхностных атомов Si с ионами Ar происходит под разными углами, а не только под углом 0°.
Таблица 2.
Значения Y и толщины аморфного слоя h на поверхности в исследуемых моделях при различной энергии налетающих ионов Ar (при 100 и 200 эВ доза 2 × 1015 см–2, при 500 эВ доза 8 × 1014 см–2)
| Y | h, нм | |||||
|---|---|---|---|---|---|---|
| 100 эВ | 200 эВ | 500 эВ | 100 эВ | 200 эВ | 500 эВ | |
| Сплошной материал | 0.06 | 0.18 | 0.45 | 1.0 | 1.5 | 2.0 |
| Модель 1 | 0.05 | 0.22 | 0.52 | 1.3 | 1.5 | 2.9 |
| Модель 2 | 0.09 | 0.30 | 0.81 | – | – | – |
Важной особенностью процесса распыления поверхности кремния в модели 1 при энергии 200 эВ (рис. 2, кривая 5) является немонотонный характер зависимости коэффициента распыления Y от дозы: по мере увеличения числа ионов Ar, падающих на поверхность, сначала наблюдается быстрый рост Y примерно до 6 × 1014 см–2, а затем постепенное снижение. Такое поведение величины Y свидетельствует о протекании дополнительных процессов, вызываемых налетающими ионами в модели 1 (низкая пористость и малый радиус пор). В то же время в случае модели 2 (высокая пористость и большой радиус пор) и модели сплошного материала зависимость Y от дозы является монотонной и достигает насыщения при дозах ~1015 см–2. При более низкой энергии ионов (100 эВ) наблюдаются аналогичные особенности: в случае модели 2 и сплошного материала коэффициенты распыления монотонно возрастают и стремятся к насыщению, в случае модели 1 Y после достижения максимального значения начинает убывать и при дозе ~1015 см–2 становится близким к коэффициенту распыления сплошного материала.
Результаты моделирования показали, что облучение пористого материала ионами различной энергии может приводить не только к его распылению, но и к существенным изменениям морфологии приповерхностных слоев. На рис. 3 приведены модели пористых структур после облучения ионами Ar с энергией 200 эВ при дозе 2 × 1015 см–2. Сравнение с исходными моделями (рис. 1) показывает, что воздействие налетающих ионов в модели 1 вызывает значительные изменения структуры верхних слоев пористого материала и приводит к образованию сплошного аморфного слоя, толщина которого зависит от энергии Ar (1.3 нм для 100 эВ, 1.5 нм для 200 эВ (табл. 2)). В отличие от модели 1, процесс аморфизации верхних слоев в модели 2 не приводит к уменьшению числа пор, однако наблюдается их существенная деформация за счет физического распыления. Следует отметить, что схлопывание пор малого радиуса не связано с используемой методикой моделирования: при применении к системе геометрического термостата, описанного в [12], в течение промежутка времени между ударами ионов (7 пс) были получены аналогичные результаты.
Рис. 3.
Модели 1 (а) и 2 (б) кремния после облучения ионами Ar с энергией 200 эВ при дозе 2.5 × 1015 см–2: поверхности пор выделены цветом (области визуального наложения поверхностей пор темные); точки – атомы кремния в узлах кристаллической решетки.

Структурные изменения в материале обычно анализируют при помощи построения парной корреляционной функции частиц системы, или радиальной функции распределения. Данная зависимость отражает наличие/отсутствие периодичности структуры в пространстве и рассчитывается в соответствии со следующей формулой:
На рис. 4 приведены радиальные функции распределения приповерхностного слоя толщиной 1 нм в исследуемых моделях до и после воздействия ионов Ar с энергией 200 эВ при дозе 2.5 × × 1015 см–2. Для идеальной кристаллической структуры график функций представляет последовательность узких пиков. В случае пористых структур возникают искажения (сдвиги, уширения пиков), вызванные реструктуризацией на границе пор. Дальнейшее воздействие ионов Ar приводит к нарушению упорядоченности расположения атомов, что отражается в заметном сглаживании пиков. Как видно из рис. 4, в случае модели 1 ярко выражена аморфизация приповерхностного слоя, в то время как в случае модели 2 характерные пики проявляются даже при максимальной дозе.
Рис. 4.
Рассчитанные радиальные функции распределения для приповерхностного слоя толщиной 1 нм, расположенного на глубине 1 нм, до (1) и после воздействия ионов Ar с энергией 200 эВ и дозой 2.5 × 1015 см–2 (2): а – модель 1; б – модель 2.

Количественная оценка изменения числа и размера пор в материале может быть сделана на основе удельной площади поверхности пористой структуры A, численно равной отношению полной поверхности с учетом пор S к объему V, занимаемому сплошным материалом. Эта величина зависит от размера пор и степени пористости. Ее значения равны 1.14 и 0.73 нм–1 для моделей 1 и 2 соответственно, поэтому при дальнейшем сравнении моделей будем анализировать относительные изменения A, происходящие под воздействием ионов. Зависимости A от дозы в моделях 1 и 2 (рис. 5а и 6) свидетельствуют об уменьшении объема пор, однако интенсивность данного процесса зависит от ряда факторов. В случае модели 1 значение A существенно изменяется в основном при малых дозах, что указывает на интенсивное сжимание и схлопывание пор вблизи поверхности на начальном этапе распыления (рис. 3а). Наиболее ярко этот эффект проявляется при облучении ионами с энергией 500 эВ: значение A снижается на 40% при дозе ~2 × 1014 см–2. При энергии ионов 100 и 200 эВ даже при максимальной дозе 2.5 × × 1015 см–2 ее относительное уменьшение заметно ниже (15 и 30% соответственно), что объясняется различной толщиной образующихся аморфных слоев (табл. 2). Из рис. 3а хорошо видно, что кривые имеют разный наклон в области малых доз, т.е. скорость формирования этого слоя в существенной степени зависит от энергии ионов. Поведение удельной площади поверхности при больших дозах свидетельствует о том, что процесс сжимания пор замедляется в результате образования указанного слоя, поскольку он затрудняет проникновение ионов Ar на необходимую глубину. Схлопывание пор и аморфизация приповерхностных слоев материала приводят к выравниванию поверхности, вследствие чего коэффициент распыления в модели 1 при больших дозах приближается к значениям, полученным для сплошного материала при той же энергии (рис. 2). В модели 2 (рис. 6) поры большого радиуса сжимаются менее интенсивно, и их полное схлопывание не происходит даже при дозе ~1015 см–2, поэтому удельная площадь поверхности уменьшается более равномерно.
Рис. 5.
Зависимость относительного изменения удельной площади поверхности А для моделей 1 (а) и 2 (б) от дозы ионов Ar с энергией: 100 (1); 200 (2); 500 эВ (3).

Рис. 6.
Взаимосвязь между коэффициентом распыления Y и удельной площадью поверхности А для моделей 1 (а) и 2 (б) при энергии ионов Ar 100 (1) и 200 эВ (2).

На основании представленного выше анализа можно сделать вывод, что структурные изменения в исследуемых материалах обусловлены двумя механизмами: непосредственно физическим распылением приповерхностных слоев и схлопыванием пор в объеме материала. Первый процесс характеризуется коэффициентом распыления Y, который тесно связан с локальной кривизной поверхности материала (рис. 2), а второй влияет на величину удельной площади поверхности, описывающую структуру модели во всем объеме. Поэтому рис. 6, который отражает взаимосвязь между Y и удельной площадью поверхности при одних и тех же дозах ионов, может служить дополнительной иллюстрацией роли каждого механизма в изменении структуры моделей с различной пористостью. На рис. 6а хорошо видно, что в модели 1 указанные зависимости при любой энергии ионов носят немонотонный характер. После заметного роста на ранних стадиях облучения кривые достигают максимума при значениях удельной площади поверхности 0.75–0.8, после чего начинается медленное уменьшение Y. Зависимости двух данных величин от дозы для модели 1 (рис. 2 и 5а), приведенные ранее, свидетельствуют об их значительном изменении при малых дозах (~1014 см–2), что указывает на структурные изменения поверхности, которые сопровождаются интенсивным распылением кремния на начальных этапах облучения вследствие локальности кривизны поверхности пористого материала. После достижения максимального значения Y начинает уменьшаться по мере снижения удельной площади поверхности (и, следовательно, при больших дозах), что обусловлено выравниванием поверхности пористого материала за счет образования аморфного слоя. В модели 2 (рис. 6б) удельная площадь меняется равномерно в течение всего времени моделирования, коэффициент распыления существенно не изменяется, т.е. процесс сжимания пор не оказывает заметного влияния на процесс распыления.
В отличие от физического распыления, которое обусловлено в первую очередь столкновительными эффектами, процесс схлопывания пор в результате воздействия ионов связан с изменениями термодинамических параметров системы. Хорошо известно, что для наноразмерных частиц и пор характерна избыточная поверхностная энергия [20]. С уменьшением диаметра наночастиц резко возрастает доля поверхностных атомов, и, как принято считать, поверхностное натяжение для таких объектов увеличивается обратно пропорционально радиусу частицы R [21, 22]. На основании данных табл. 1 была проведена оценка избыточной энергии в пористых моделях по сравнению со сплошным материалом, имеющим аналогичное число атомов. Избыточная потенциальная энергия, приходящаяся на 1 нм3, в случае модели 1 (Rpore = 0.8 нм, P = 22%) составила 2.4 эВ/нм3, а в случае модели 2 (Rpore = 2.8 нм, P = = 22%) – 0.9 эВ/нм3. Полученные значения свидетельствуют о значительной избыточной энергии в системе с порами малого радиуса, которая может высвобождаться при воздействии ионов Ar и вызывать эффекты схлопывания пор. В то же время для модели 2 эта энергия в 2.5 раза меньше, поэтому в материале с большой пористостью аналогичные эффекты не наблюдались.
ВЫВОДЫ
В работе методом молекулярной динамики были исследованы процессы физического распыления нанопористого материала на примере кристаллического кремния. Результаты проведенного моделирования свидетельствуют об особенностях механизмов распыления и аморфизации приповерхностных слоев моделей с различными радиусами пор и степенью пористости.
Полученные результаты позволяют сделать вывод, что наличие наноразмерных пор в материале приводит к повышению интенсивности распыления: коэффициент распыления в модели с радиусом пор 2.8 нм и степенью пористости 40% оказался в 1.4 раза выше, чем для сплошного материала. Такое возрастание интенсивности распыления можно объяснить локальной кривизной поверхности вследствие наличия на ней открытых пор, и данный эффект проявляется ярче для материала с крупными порами. По мере увеличения дозы налетающих ионов в модели с порами малого радиуса происходят значительные структурные изменения, приводящие к схлопыванию расположенных вблизи поверхности пор и формированию сплошного аморфного слоя толщиной 1.0–1.5 нм для ионов с энергией 100 и 200 эВ. Наличие на поверхности аморфного слоя обуслoвливает снижение интенсивности распыления при больших дозах. В случае модели с порами большего радиуса и высокой пористостью аналогичные изменения в структуре не наблюдаются даже при энергии ионов, равной 500 эВ, поэтому процесс физического распыления данной поверхности характеризуется одной и той же интенсивностью при различных дозах.
Список литературы
Baklanov M.R., de Marneffe J.-F., Shamiryan D. et al. // J. Appl. Phys. 2013. V. 113. № 4. P. 041101. doi 10.1063/1.4765297
Prskabo A.-P., Schmauder S., Ziebert C. et al. // Comput. Mater. Sci. 2011. V. 50. № 4. P. 1320. doi 10.1016/ j.commatsci.2010.08.006
Kubota N.A., Economou D.J., Plimpton S.J. // J. Appl. Phys. 1998. V. 83. № 8. P. 4055. doi 10.1063/1.367225
Zalm P.C. // J. Appl. Phys. 1983. V. 54. № 5. P. 2660. doi 10.1063/1.332340
Graves D.B., Brault P. // J. Phys. D: Appl. Phys. 2009. V. 42. № 19. P. 194011. doi 10.1088/022-3727/42/19/194011
Hossain M.Z., Freund J.B., Johnson H.T. // Nucl. Instrum. Methods Phys. Res. B. 2009. V. 257. № 7. P. 1061. doi 10.1016/j.nimb.2009.01.137
Humbird D., Graves D.B. // Pure Appl. Chem. 2002. V. 74. № 3. P. 419. doi 10.1351/pac200274030419
Stillinger F.H., Weber T.A. // Phys. Rev. B. 1985. V. 31. № 8. P. 5262. doi 10.1103/PhysRevB.31.5262
Smith R. Atomic and Ion Collisions in Solids and at Surfaces: Theory, Simulation and Applications. New York: Cambridge University Press, 2005. 310 p.
Timonova M., Lee B.-J., Thijsse B.J. // Nucl. Instrum. Methods Phys. Res. B. 2007. V. 225. № 1. P. 195. doi 10.1016/j.nimb.2006.11.023
Baskes M.I. // Phys. Rev. B. 1992. V. 46. № 5. P. 2727. doi 10.1103/PhysRevB.46.2727
Moore M.C., Kalyanasundaram N., Freund J.B., Johnson H.T. // Nucl. Instrum. Methods Phys. Res. B. 2004. V. 225. № 3. P. 241. doi 10.1016/j.nimb.2004.04.175
Rakhimova T.V., Lopaev D.V., Mankelevich Yu.A. et al. // J. Phys. D: Appl. Phys. 2015. V. 48. № 17. P. 175203. doi 10.1088/0022-3727/48/17/175203
Palov A.P., Voronina E.N., Rakhimova T.V. et al. // J. Vac. Sci. Technol. B. 2016. V. 33. № 2. P. 020603. doi 10.1116/1.4906816
Plimpton S. // J. Comp. Phys. 1995. V. 117. P. 1. doi 10.1006/jcph.1995.1039
Sadovnichy V., Tikhonravov A., Voevodin Vl., Opanasenko Vl. // Contemporary High Performance Computing: From Petascale to Exacsale. / Ed. Vetter J.S. Chapman and Hall/CRC, 2013. P. 283.
Stukovski A. // Modelling Simul. Mater. Sci. Engin. 2010. V. 18. № 1. P. 015012. doi 10.1088/0965-0393/ 18/1/015012
Laegreid N., Wehner G.K. // J. Appl. Phys. 1961. V. 32. № 3. P. 365. doi 10.1063/1.1736012
Coburn J.W., Winters H.F., Chuang T.J. // J. Appl. Phys. 1977 V. 48. № 8. P. 3532. doi 10.1063/1.324150
Kelsall R.W., Hamley I.W., Geoghegan M. Nanoscale Science and Technology. Chichester: John Wiley & Sons, 2005. 473 p.
Summ B.D., Ivanova N.I. // Russ. Chem. Rev. 2000. V. 69. № 11. P. 911. doi 10.1070/ RC2000v069n11ABEH000616
Tolman R.C. // J. Chem. Phys. 1949. V. 17. № 3. P. 333. doi 10.1063/1.1747247
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования


