Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2019, № 1, стр. 98-103
Идентификация диффузионной длины в нитриде галлия катодолюминесцентным методом в случаях экситонной рекомбинации и примесной рекомбинации неравновесных носителей заряда
Н. Н. Михеев 1, Н. А. Никифорова 2, *, М. А. Степович 2, 3
1 Лаборатория Космического материаловедения ИК РАН – “Федеральный научно-исследовательский центр “Кристаллография и фотоника “РАН”,
248640 Калуга, Россия
2 Калужский государственный университет им. К.Э. Циолковского,
248023 Калуга, Россия
3 Ивановский государственный университет,
153025 Иваново, Россия
* E-mail: nadya@gmail.com
Поступила в редакцию 15.03.2018
После доработки 20.03.2018
Принята к публикации 15.03.2018
Аннотация
Показан ряд возможностей модели количественной катодолюминесценции прямозонных материалов, базирующейся на использовании зависимости интенсивности монохроматической катодолюминесценции от энергии электронов пучка при постоянном уровне генерации электронно-дырочных пар. По результатам экспериментальных исследований монокристаллического n-GaN с помощью данной модели получены оценки величины диффузионной длины и времени жизни неосновных носителей заряда для участка спектра, соответствующего примесной рекомбинации, а также оценки величины диффузионной длины и времени жизни связанных экситонов.
ВВЕДЕНИЕ
Диагностика диффузионной длины является важным направлением в катодолюминесцентных (КЛ) исследованиях, поскольку она в значительной степени определяет параметры приборов микро- и наноэлектроники. В работах [1–4] показано, что определить значения диффузионной длины, а также значения других электрофизических параметров полупроводникового материала (время жизни, скорость поверхностной рекомбинации, спектральная зависимость коэффициента поглощения краевого излучения) можно, анализируя зависимость интенсивности КЛ от энергии электронов пучка растрового электронного микроскопа (РЭМ). Искомые параметры материала, например время жизни, диффузионную длину, и др. получают из сравнения теории и эксперимента, при этом корректность получаемых результатов во многом зависит от используемой математической модели исследуемого явления.
Несмотря на большое количество работ, посвященных исследованиям свойств GaN, работы по определению электрофизических параметров данного материала из анализа зависимости интенсивности КЛ от энергии электронов пучка по-прежнему немногочисленны. В продолжение работы [5] нами были рассмотрены возможности применения методики расчета диффузионной длины и времени жизни, связанных на нейтральных донорах экситонов и неосновных носителей заряда (ННЗ) в GaN по зависимости интенсивности монохроматической КЛ от энергии широкого электронного пучка при постоянном уровне генерации носителей заряда. Данная методика ранее была успешно использована на ряде прямозонных полупроводниковых соединений и подробно изложена в [4, 6–13].
ОБОРУДОВАНИЕ И ОБРАЗЦЫ
Были проведены исследования нелегированного монокристаллического GaN n-типа проводимости с концентрацией фоновой примеси порядка 1016 см–3, выращенного методом HVPE. Процесс и технология роста данных образцов подробно изложены в [14].
Экспериментальные исследования проводились на модифицированной установке серийного РЭМ [15], оборудованной приставкой для регистрации и анализа спектров в широком диапазоне температур образца (от 295 до ≈ 6 К), а также позволяющей контролировать ток и ускоряющее напряжение пучка электронов. Принципиальная схема данной установки показана на рис. 1. Поддержание постоянной скорости генерации электронно-дырочных пар для всех приложенных ускоряющих напряжений обеспечивалось коррекцией величины тока пучка электронов в каждом измерении. Коррекцию проводили таким образом, чтобы мощность G-источника носителей заряда (число электронно-дырочных пар, генерируемых в единицу времени), определяемое по формуле $G = {{i{{E}_{0}}\left[ {1 - \eta (1 - {{Z}^{{ - {1 \mathord{\left/ {\vphantom {1 3}} \right. \kern-0em} 3}}}})} \right]} \mathord{\left/ {\vphantom {{i{{E}_{0}}\left[ {1 - \eta (1 - {{Z}^{{ - {1 \mathord{\left/ {\vphantom {1 3}} \right. \kern-0em} 3}}}})} \right]} {q\varepsilon }}} \right. \kern-0em} {q\varepsilon }},$ оставалась постоянной. Здесь i – ток пучка, E0 – энергия электронов пучка, η – коэффициент обратного рассеяния первичных электронов, Z – средний атомный номер образца, q – заряд электрона, $\varepsilon $ – энергия образования одной электронно-дырочной пары.
Рис. 1.
Принципиальная схема экспериментальной установки [15]: 1 – вакуумная система, 2 – электронная пушка, 3 – электростатические отклоняющие головки, 4 – образец, 5 – держатель образцов, 6 – криостат, 7 – окно, 8 – люминесцентное излучение, 9 –параболическое зеркало, 10 – плоское зеркало, 11 – сфокусированный пучок, 12 –монохроматор, 13 – CCD-камера.

Были выполнены серии измерений при низких ускоряющих напряжениях 3–12 кВ и различных температурах (6 К и комнатной). Регистрировалось КЛ-излучение, обусловленное экситонной рекомбинацией, и КЛ-излучение, связанное с примесной рекомбинацией неравновесных носителей заряда. Выбор диапазона низких ускоряющих напряжений был ограничен почти отсутствующим сигналом КЛ ниже 3 кэВ, а также обусловлен желанием уменьшить влияние самопоглощения излучения на регистрируемый сигнал КЛ (коэффициент самопоглощения α ≈ (3–6) × × 105 см–1 [16]).
ТЕОРЕТИЧЕСКАЯ МОДЕЛЬ
Для нахождения величин диффузионной длины L в данной работе была применена методика, основанная на изучении зависимости интенсивности КЛ-излучения от энергии электронов пучка, согласно которой искомый электрофизический параметр полупроводника определяется из сравнения расчетных и экспериментальных зависимостей интенсивности катодолюминесцентного излучения IКЛ (Е0, L, S, α) от энергии электронов зонда РЭМЕ0 при конкретных значениях остальных параметров (приведенной скорости поверхностной рекомбинации S и коэффициента самопоглощения краевого излучения α).
Описание зависимости интенсивности IКЛ в полупроводнике с известными электрофизическими параметрами от величины энергии пучка электронов Е0 было выполнено ранее в [1, 2]. Сложность теоретического описания этой зависимости была связана с необходимостью учитывать влияние поверхностной рекомбинации ННЗ на интенсивность сигнала КЛ. Учет влияния поверхности был выполнен в [1, 2] на основе подхода, предложенного Ван-Русбреком для случая поверхностной рекомбинации электронно-дырочных пар [17]. Однако приближение, описанное в [1, 2], имело существенное ограничение для материалов группы А3В5: уже при низких значениях энергии пучка Е0 размеры области генерации ННЗ оказываются соизмеримыми с величиной диффузионной длины L, что может существенно сказаться на величинах L и S, идентифицируемых из экспериментальных распределений сигнала.
В работе [17] для описания воздействия поверхности полупроводника был предложен новый подход, учитывающий объемный характер генерации электронно-дырочных пар. Предложенную в [17] методику отличают две характерные особенности. Во-первых, данная методика определяет диффузионную длину именно тех ННЗ, которые участвуют в формировании катодолюминесценции конкретного канала излучательной рекомбинации в полупроводнике. В нашем случае это рекомбинация связанных на нейтральных донорах экситонов и примесная рекомбинация ННЗ (в отличие, например от метода наведенного тока в цепи короткозамкнутого диода [18], в котором этот параметр определяется одновременным действием всех каналов рекомбинации, а в действительности – самым короткоживущим). Во-вторых, согласно данному подходу влияние поверхности на генерируемые ННЗ учитывается через центр тяжести области генерации zc, введение которого позволяет описать IКЛ в условиях, когда по мере увеличения энергии Е0 линейные размеры области генерации ННЗ превышают величину L и стандартная модель независимых источников становится неприменимой [9]:
(1)
${{z}_{{\text{c}}}} = {{\int\limits_0^\infty {z\rho (z)dz} } \mathord{\left/ {\vphantom {{\int\limits_0^\infty {z\rho (z)dz} } {\int\limits_0^\infty {\rho (z)dz} }}} \right. \kern-0em} {\int\limits_0^\infty {\rho (z)dz} }},$Учитывая соотношение (1), выражение для интенсивности монохроматической КЛ в одномерном приближении (широкий электронный пучок) имеет вид:
(2)
${{I}_{{{\text{К Л }}}}}({{E}_{0}}) \sim \left( {1 - \frac{s}{{s - 1}}\exp \left( {\frac{{ - {{z}_{{\text{c}}}}}}{L}} \right)} \right)\exp ( - \alpha {{z}_{{\text{c}}}}).$Здесь S = vsL/D – приведенная скорость поверхностной рекомбинации ННЗ; vs – скорость поверхностной рекомбинации ННЗ, диффундирующих к области, обедненной основными носителями; D – коэффициент диффузии [17]; zc – центр тяжести области генерации; L – диффузионная длина ННЗ; α – коэффициент поглощения излучения.
В работах [7–9, 11, 12] этот подход был использован для определения диффузионных длин L, времени жизни τ, скорости поверхностной рекомбинации S ННЗ, спектральной зависимости коэффициента поглощения α(λ) краевого излучения в прямозонных полупроводниках и структурах оптоэлектроники.
В случае высокого уровня возбуждения и широкого электронного пучка, как показано в работе [6], зависимость интенсивности монохроматической КЛ (IКЛ) от энергии электронов пучка Е0 становится квадратичной и может быть описана в виде:
(3)
${{I}_{{{\text{К Л }}}}}({{E}_{0}}) \sim {{\left\{ {1 - \frac{{s - 1}}{{s + 1}}\exp \left( { - \frac{{2{{z}_{{\text{c}}}}}}{L}} \right)} \right\}}^{2}}{\text{Ф (}}{{z}_{{\text{c}}}},L).$Здесь параметры для ННЗ (приведенная скорость поверхностной рекомбинации, L – диффузионная длина), zc – центр тяжести области генерации. В выражение (3) для IКЛ(Е0) входит поправочная функция Φ(zc, L), учитывающая снижение интенсивности КЛ из-за уменьшения спектральной плотности излучения в области генерации ННЗ при zc> 1.5L; она может быть представлена в виде:
(4)
${\text{Ф (}}{{z}_{{\text{c}}}},L) = {{e}^{{ - {\beta (}{{{{z}_{{\text{c}}}}} \mathord{\left/ {\vphantom {{{{z}_{{\text{c}}}}} {L - 1.5}}} \right. \kern-0em} {L - 1.5}})}}},$Если zc ≤ 1.5L, то все ННЗ рекомбинируют в узкой пространственной области у поверхности полупроводника, где спектральная плотность излучения оказывается достаточно высокой и превышает пороговую во всей области генерации, в этом случае можно считать Φ(zc, L) = 1.
РЕЗУЛЬТАТЫ И ОБСУЖДЕНИЕ
В полученных спектрах при энергии электронов Е0 ∈ 3–12 кэВ регистрировалось КЛ-излучение, обусловленное рекомбинацией связанных на нейтральных донорах экситонов, и КЛ-излучение, связанное с примесной рекомбинацией неравновесных носителей заряда [19, 20]. На рис. 2а, б изображены КЛ-спектры образца GaN, полученные при комнатной температуре и температуре 6 К с энергией электронов пучка 7 кэВ.
Рис. 2.
Спектры КЛ, полученные при исследовании образца GaN при различных температурах, (энергия электронов пучка 7 кэВ): а – при температуре 6 К, б – при комнатной температуре.

Ранее в работе [5], где описывалась зависимость интенсивности монохроматической КЛ от энергии пучка электронов, нами были определены значения диффузионной длины и времени жизни свободных экситонов в GaN. На рис. 3 представлены КЛ-спектры, полученные при исследовании образцов GaN при комнатной температуре и энергии электронов пучка 7 кэВ. Спектр КЛ (1), полученный нами в настоящей работе, обусловлен рекомбинацией связанных экситонов. Для сравнения приведен спектр КЛ (2) из работы [21], связанный с рекомбинацией свободных экситонов.
Рис. 3.
Спектры КЛ, полученные при исследовании образцов GaN при комнатной температуре и энергии электронов пучка 7 кэВ. Регистрировалось КЛ-излучение (1), обусловленное рекомбинацией связанных на нейтральных донорах экситонов. Для сравнения приведен спектр КЛ (2) из работы [21], вызванный рекомбинацией свободных экситонов.

Из сравнения экспериментальных данных и соответствующих им расчетных кривых IКЛ(Е0) было определено значение диффузионной длины связанных экситонов L. Для комнатной температуры это значение составило 0.3 ± 0.05 мкм.
На рис. 4 показаны зависимости интенсивности КЛ-излучения IКЛ от энергии электронов пучка Е0 при комнатной температуре и диффузионной длине связанных экситонов L = 0.3 ± 0.05 мкм для различных участков спектра GaN с энергиями Е = 3.35, 3.38, 3.4 эВ. Точками отмечены полученные экспериментальные данные, сплошными кривыми – оптимальные расчетные зависимости IКЛ(Е0). Кривые (рис. 4) характеризуются монотонным возрастанием интенсивности КЛ при увеличении энергии пучка электронов, а учет самопоглощения согласно формуле (2) приводит к появлению на кривых максимумов. Для расчета зависимостей IКЛ(Е0) значение коэффициента самопоглощения α принималось равным ≈105 см–1 (коэффициент самопоглощения α ≈ (3–6) × 105 см–1 [16]), значения скорости поверхностной рекомбинации полагались равными $S = \infty ,\quad$ что практически выполняется при S ≥ 50 [1]. Расчет глубины центра тяжести области генерации zc был выполнен и подробно изложен в работе [5].
Рис. 4.
Зависимости интенсивности КЛ-излучения I от энергии электронов пучка Е0 при комнатной температуре и диффузионной длине связанных экситонов L = 0.3 ± 0.05 мкм для различных участков спектра GaN с энергией Е = 3.35 эВ (1), Е = 3.38 эВ (2), Е = = 3.4 эВ (3). Точки – эксперимент, сплошные кривые – оптимальные расчетные зависимости I(Е0).

В отличие от кривых, показанных на рис. 4, а также опытных зависимостей, полученных в работе [5], для графиков зависимостей IКЛ(Е0) (рис. 5, рис. 6) характерно наличие максимумов, не связанных с влиянием самопоглощения. Это можно объяснить реализацией случая квадратичной рекомбинации, когда при увеличении области генерации ННЗ с увеличением энергии электронов пучка падает интенсивность КЛ-излучения. Расчет зависимостей IКЛ(Е0), показанных на рис. 5 и рис. 6, производился согласно (3), значение параметра β = 0.25 [6], а значения скорости поверхностной рекомбинации S и глубины центра тяжести области генерации zc полагались теми же, что и для рис. 4.
Рис. 5.
Зависимости интенсивности КЛ-излучения I от энергии электронов пучка Е0 при комнатной температуре и диффузионной длине ННЗ L = 0.069 ± ± 0.005 мкм для различных участков спектра GaN с энергией Е = 1.9 эВ (1), Е = 2.2 эВ (2), Е = 2.3 эВ (3). Точки – эксперимент, сплошные кривые – оптимальные расчетные зависимости I(Е0).

Рис. 6.
Зависимости интенсивности КЛ-излучения I от энергии электронов пучка Е0 при температуре 6 К и диффузионной длине ННЗ L = 0.099 ± 0.005 мкм для различных участков спектра GaN с энергией Е = = 1.9 эВ (1), Е = 2.2 эВ (2), Е = 2.3 эВ (3). Точки – эксперимент, сплошные кривые – оптимальные расчетные зависимости I(Е0).
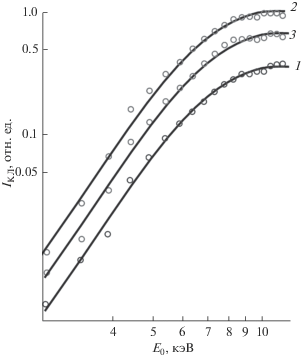
Из сравнения экспериментальных данных и оптимальных для них расчетных зависимостей IКЛ(Е0) было определено значение диффузионной длинны ННЗ L для участка спектра, соответствующего примесной рекомбинации. Для комнатной температуры значение L составило 0.069 ± ± 0.005 мкм, а для температуры 6 К – 0.099 ± ± 0.005 мкм. Соответствующие расчетные зависимости IКЛ(Е0) и экспериментальные точки для комнатной температуры и температуры 6 К для участков спектра Е = 1.9, 2.2, 2.3 эВ приведены на рис. 5 и рис. 6 соответственно.
Исходя из этих значений, были проведены оценки времени жизни τ связанных экситонов и ННЗ. Основная проблема в определении времени жизни τ из измерений L состояла в выборе коэффициента диффузии D, поскольку данные о коэффициенте диффузии существенно различаются в работах других авторов. Если предположить, что коэффициент диффузии слабо зависит от температуры и равен 1–2 cм2/с, то тогда время жизни связанных экситонов будет составлять 450–900 пс при комнатной температуре, а время жизни ННЗ, обусловленных примесной рекомбинацией, будет равно 24–48 пс при комнатной температуре и 49–98 пс при температуре 6 К. Полученные величины L и τ в целом соответствуют результатам измерений этого параметра другими методами, например в работах [18, 19, 22].
ЗАКЛЮЧЕНИЕ
Методом КЛ-микроскопии проведено экспериментальное исследование образцов n-GaN. Рассмотрены возможности применения методики определения диффузионной длины связанных экситонов и ННЗ в GaN при использовании зависимости интенсивности КЛ-излучения от энергии пучка электронов зонда РЭМ. Получены значения диффузионной длины и времени жизни для участков спектра экситонной и примесной рекомбинации. Определено, что полученные значения электрофизических параметров в целом соответствуют результатам измерений этих параметров другими методами. Определено, что для КЛ-излучения, обусловленного примесной рекомбинацией, с понижением температуры наблюдается увеличение диффузионной длины и времени жизни ННЗ. Для КЛ-излучения, связанного с рекомбинацией связанных на нейтральных донорах экситонов, при комнатной температуре значение диффузионной длины оказалось примерно в 4–5 раз выше, чем значение диффузионной длины ННЗ, относящихся к примесной рекомбинации.
Список литературы
Wittry D.B., Kyser D.F. // J. Appl. Phys. 1967. V. 38. № 1. P. 375.
Rao-Sahib T.S., Wittry D.B. // J. Appl. Phys. 1969. V. 40. № 9. P. 3745.
Михеев Н.Н. // ФТП, 1987. Т. 21. № 2. С. 370.
Михеев Н.Н., Никоноров И.М., Петров В.И., Степович М.А. // Изв. АН СССР. Сер. физ. 1990. Т. 54. № 2. С. 274.
Никифорова Н.А., Степович М.А., Михеев Н.Н. и др. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2015. № 8. С. 1.
Михеев Н.Н., Никоноров И.М., Петров В.И. и др. // Изв. АН СССР. Сер. физ. 1990. Т. 54. № 2. С.267.
Михеев Н.Н., Никоноров И.М., Петров В.М., Степович М.А. // Известия АН СССР. Сер. физ. 1990. Т. 54. № 2. С. 332.
Михеев Н.Н., Никоноров И.М., Петров В.И. и др. // Известия АН СССР. Сер. физ., 1990. Т. 54. № 2. С. 362.
Гареев А.Ф., Михеев Н.Н., Петров В.И., Степович М.А. // Известия РАН. Сер. физ. 1992. Т. 56. № 3. С. 90.
Михеев Н.Н., Петров В.И., Степович М.А. // Изв. РАН. Сер. физ. 1992. Т. 56. № 3. С. 176.
Михеев Н.Н., Петров В.И., Созонтов Е.А. и др. // Известия РАН. Сер. физ. 1996. Т. 60. № 2. С. 14.
Михеев Н.Н., Петров В.И., Степович М.А., Невструева Е.В. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2000. № 2. С. 75.
Поляков А.Н., Noltemeyer M., Hempel T. и др. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2012. № 11. С.35.
Hertkorn J., Brückner P., Thapa S.B. et al. // J. Cryst. Growth. 2007. V. 308. № 1. P. 30.
Prinz G.M., Ladenburger A., Schirra M. et al. // J. Appl. Phys. 2007. V. 101. № 2. P. 023511.
Muth J.F., Lee J.H., Shmagin I.K. et al. // Appl. Phys. Lett. 1997. V. 71. № 18. P. 2572.
Михеев Н.Н., Дорогова Ю.Г. // Электронная техника. Материалы. 1988. № 4. С. 44.
Шмидт Н.М., Якимов Е.Б. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2006. № 9. С. 61.
Reshchikov M.A., Morkoç H. // J. Appl. Phys. 2005. V. 97. № 6. P. 061301.
Zhang W., Meyer B.K. // Phys. Stat. Sol. (C). 2003. V. 0. № 6. P. 1571.
Monemar B., Paskov P.P., Bergman J.P. et al. // Phys. Stat. Sol. (B). 2008. V. 245. № 9. P. 1723.
Hocker M., Maier P., Jerg L. et al. // J. Appl. Phys. 2016. V. 120. № 8. P. 085703.
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования


