Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2019, № 1, стр. 21-27
Микроструктура и плотность пленок Mo в многослойных зеркалах Mo/Si
Ю. А. Вайнер 1, С. А. Гарахин 1, *, В. Н. Полковников 1, Н. Н. Салащенко 1, М. В. Свечников 1, Н. И. Чхало 1, П. А. Юнин 1
1 Институт физики микроструктур РАН,
607680 Нижний, Новгород, Россия
* E-mail: garakhins@yandex.ru
Поступила в редакцию 24.04.2018
После доработки 24.04.2018
Принята к публикации 24.04.2018
Аннотация
С использованием методов малоугловой рентгеновской дифракции и дифракции в области больших углов получена зависимость плотности Мо от толщины слоя в периодических рентгеновских зеркалах Mo/Si, синтезированных методом магнетронного распыления в атмосфере аргона. На примере смоделированного апериодического многослойного зеркала Mo/Si продемонстрирована необходимость учета реальной плотности Мо и некорректность использования ее табличных значений.
ВВЕДЕНИЕ
Апериодические многослойные зеркала (АМЗ), состоящие из чередующихся тонких слоев материалов с разной диэлектрической проницаемостью, имеют более высокую интегральную отражательную способность, чем их периодические аналоги (ПМЗ). Для ПМЗ характерен коэффициент отражения резонансного типа, определяемый уравнением Вульфа–Брэгга, т.е. 2d sin θ = mλ, где d – период структуры, θ – угол дифракции, отсчитываемый от поверхности зеркала, m – порядок дифракции и λ – длина волны.
Апериодические многослойные зеркала широко используются в научных исследованиях: в солнечной астрономии (являются рабочим элементом спектрогелиографов [1]), в спектроскопии лабораторной плазмы [2] (благодаря высокому интегральному и равномерно распределенному по спектру коэффициенту отражения позволяют собрать на порядок больше информации от исследуемого объекта). В последнее время в связи с прогрессом в развитии мощных фемтосекундных лазеров наблюдается повышенный интерес к генерации (суб)фемтосекундных и аттосекундных импульсов электромагнитного излучения. Для успешного решения этих задач необходимо управлять такими импульсами (проблема транспортировки пучков, коллимации и фокусировки, спектрального анализа, управления спектром). Наиболее эффективными оптическими элементами для решения этих задач являются АМЗ, способные отразить короткий импульс, характеризующийся широким спектром, что невозможно для периодических структур, отражающих в гораздо более узком спектральном диапазоне [3].
Инжиниринг АМЗ – сложная многопараметрическая задача, требующая применения оптимизационных методик. Решением задачи является оптимальный набор толщин слоев материалов, составляющих структуру АМЗ. Однако для соблюдения достаточной точности необходимо на самом первом этапе процедуры оптимизации задавать реальные параметры моделируемых структур: учитывать случайный разброс толщин при напылении, шероховатость и отличие плотности материалов от табличных значений. В противном случае, как показано в [4, 5], форма спектральной зависимости коэффициента отражения будет заметно отличаться от расчетной.
Таким образом, в качестве параметров в уравнения оптимизации должны входить индивидуальные для каждого слоя шероховатость и плотность. Обычно в АМЗ количество слоев может достигать сотен штук, а их толщины даже в одной структуре варьируются в довольно широких пределах (по порядку величины от 1 до 10 нм). Можно ожидать, что состояния пленок, в разы или даже на порядок различающихся по толщине, также будут различными. По крайней мере, степень кристаллизации металлических слоев должна существенно зависеть от их толщины, что, в свою очередь, влияет на плотность таких пленок и на состояние их поверхности, т.е. на шероховатость. В настоящей работе эти вопросы рассматриваются применительно к тонким пленкам молибдена в многослойных структурах типа Mo/Si.
Для описания характера изменения плотности Мо необходимо понимание условий роста и кристаллографической ориентации, особенно нескольких первых атомных слоев Мо. При помощи просвечивающей электронной микроскопии было показано [6], что слои Mo и Si разделены прослойками силицидов, состоящих из смеси Mo и Si разной конфигурации, что влияет на рост Мо. Силициды нужно учитывать также, потому что характер границ раздела способен уменьшить отражательную способность на несколько процентов и исказить профиль коэффициента отражения [7]. Это недопустимо, особенно когда требуется, чтобы кривая отражения повторяла форму какого-либо целевого спектра. Так, например, предпринимались попытки создать АМЗ-структуру, коэффициент отражения для которой повторял бы форму спектра ксеноновой плазмы [8].
В литературе приводится достаточно противоречивая информация о пороге кристаллизации молибдена в структурах типа Mo/Si, которая сильно зависит от условий роста структур и их конкретной конфигурации. Определенные вопросы вызывает и зависимость плотности пленок Mo от толщины, приведенная, например, в [9], где исследовали структуры, состоящие лишь из трех слоев молибдена и кремния. Применительно к данной задаче целесообразно рассматривать лишь структуры, состоящие из нескольких десятков слоев.
В [10] аморфно-кристаллический переход в слое Mo идентифицирован при толщинах слоев 2.8 нм, тогда как в [11] авторы сообщают о значении около 2 нм в случае метода магнетронного распыления и чуть больше в случае ионно-лучевого метода. Другие исследования представляют данные о значениях критической толщины 2.3 нм [12], 2.5 нм [13]. Согласно исследованию, проведенному в [14], специальные сглаживающие прослойки, например B4C, значительно изменяют толщину перехода – от 2 до 2.8 нм.
В наибольшей степени эта проблема исследована для зеркал Mo/Si, предназначенных для спектральной области в окрестности 13.5 нм. Однако эти исследования проведены в узком диапазоне толщин пленок молибдена. Для АМЗ диапазон толщин существенно шире. Это обстоятельство требует дополнительных исследований влияния толщины пленок молибдена на величину межслоевых шероховатостей и плотность молибдена в многослойных структурах Mo/Si. В дальнейшем предполагается использование этих функций при оптимизации состава АМЗ Mo/Si. В заключении на примере решения прямой задачи иллюстрируется влияние зависимости плотности от толщины на спектральную зависимость коэффициента отражения АМЗ Mo/Si.
ЭКСПЕРИМЕНТАЛЬНЫЕ МЕТОДЫ
Для изучения изменения структурных характеристик Mo была изготовлена серия ПМЗ Mo/Si с изменяемыми в диапазоне 1.6–6.9 нм толщинами слоя Mo и относительно небольшими (3.3–4.3 нм) вариациями толщин слоя Si. Образцы изготавливали методом магнетронного распыления в атмосфере аргона при давлении 10–3 Торр. Подробнее об условиях нанесения многослойных структур написано в [15]. Условия синтеза для всех образцов были одинаковыми, количество слоев структур также оставалось неизменным и равным 40. Образцы отличались только временем осаждения молибдена. В качестве подложек использовали кремниевые пластины для микроэлектронной промышленности с эффективной шероховатостью в диапазоне пространственных частот 0.024–65 мкм–1 σeff = 0.3 нм, измеренной методами атомно-силовой микроскопии и малоуглового отражения рентгеновского излучения с использованием оборудования и методов, описанных в [16].
Основные характеристики ПМЗ Mo/Si, такие как период d, толщины пленок кремния hSi и молибдена hMo, межслоевые шероховатости на границах изучали методом малоугловой дифракции рентгеновских лучей. Измерения проводили в диапазоне углов падения излучения на образец θ = 0°–5° с использованием четырехкристального высокоразрешающего дифрактометра PANalitycal X’Pert Pro на длине волны 0.154 нм. Для подгонки кривых отражения использовали программное обеспечение IMD [17] и собственную модель [18]. Особенностью модели является то, что переходные слои представляются в виде линейной комбинации простейших функций, включая функцию ошибок, наилучшими образом описывающую шероховатость, и ступенчатую функцию, описывающую стехиометрические слои в переходной области, например, силицид молибдена в случае многослойного зеркала Mo/Si.
Для уменьшения числа параметров и, соответственно, повышения точности подгонки из вида кривой отражения для дальнейшей обработки отбирали образцы, у которых отсутствовали флуктуации и систематические изменения периода (образцы отбирали по отсутствию уширения брэгговских пиков отражения). В программе IMD параметрами подгонки выступали период, толщины пленок в периоде hSi и hMo, межслоевые шероховатости на различных границах и плотность молибдена. Плотность кремния оставалась табличной.
Для определения межплоскостных расстояний Мо и степени кристалличности его структуры применяли рентгеновскую дифракцию в области больших углов с использованием дифрактометра Bruker D8 Discover [19]. Съемку дифрактограмм проводили в геометрии скользящего падения. Угол падения излучения на образец был фиксирован и составлял 2°. На первичном пучке использовали параболическое зеркало Гебеля и щель шириной 0.6 мм. Дифрактограммы записывали с помощью детектора с щелью Соллера (апертура 0.2°) при сканировании по углу дифракции 2θ. Шаг сканирования 0.15°, время накопления в точке 6 с.
Наиболее часто применяемым методом определения параметров наноструктуры является анализ интегральной ширины дифракционных линий. В общем случае отдельно взятого пика заранее не ясно, чем вызвано его уширение, так как к увеличению ширины линии могут приводить либо микродеформации кристаллической решетки, либо уменьшение областей когерентного рассеяния (ОКР). Разделять эти эффекты можно, опираясь на различную зависимость интегральной ширины пиков (или полуширины) от угла отражения: интегральные ширины дифракционных пиков при малых размерах ОКР увеличиваются при возрастании угла отражения обратно пропорционально cos θ, а при наличии микродеформаций уширение растет прямо пропорционально $\quad{tg\theta }$.
В настоящей работе использован метод построения Вильямсона–Холла [20], достоинствами которого являются простота, а также возможность получать усредненные значения размеров ОКР и микродеформаций по формуле:
где β – уширение дифракционного максимума, λ – длина волны используемого излучения, D – размер ОКР, θ – брэгговский угол, ε – величина микроискажений кристаллической решетки. Для более точного анализа ширины линий использовали процедуру аппроксимации аналитическими функциями с подгоняемыми параметрами (функцию псевдо-Войта), чтобы наилучшим образом описать индивидуальные профили.Если провести прямую через экспериментальные значения, то угол наклона будет пропорционален величине ε, а пересечение графика с осью ординат – обратно пропорционально D. Однако на практике такое построение не всегда возможно – иногда удается идентифицировать лишь один характерный максимум. В таком случае возникает вынужденная необходимость использовать формулу Шеррера:
где D – эффективный размер кристаллита, который зависит от его формы и направления [hkl] и связан с истинным размером через константу, β – интегральная ширина линии.ЭКСПЕРИМЕНТАЛЬНЫЕ РЕЗУЛЬТАТЫ
Малоугловая рентгеновская дифракция. В работе были исследованы 11 образцов. Число периодов для всех структур N = 40. На рис. 1 приведен пример подгонки для ПМЗ Mo/Si SG-123. Сплошная линия соответствует теоретическому расчету для модельной структуры, символы – экспериментальные точки, результат малоугловой рентгеновской дифракции. Обращает на себя внимание высокая степень соответствия теории и эксперимента.
Рис. 1.
Пример измерений и подгонки результата малоугловой рентгеновской дифракции для образца SG-123ПМЗ Mo/Si: точки – экспериментальные данные; прямая линия – результат теоретического моделирования.
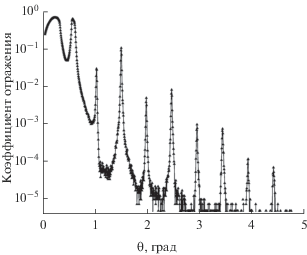
В табл. 1 приведены полученные по данным малоугловой дифракции основные параметры зеркал. Как видно из рис. 2, до толщины молибдена hMo = 2.9 нм наблюдается резкий рост плотности – до 0.9 от табличного значения, который затем плавно изменяется и выходит на асимптотику (1).
Таблица 1.
Основные параметры исследуемых структур Mo/Si, полученные методом подгонки результатов малоугловой рентгеновской дифракции
| Образец | hMo, нм | hSi, нм | d, нм | ρMo, г/см3 |
|---|---|---|---|---|
| SG-89 | 1.65 | 3.85 | 5.5 | 8.07 |
| SG-96 | 1.90 | 3.96 | 5.86 | 8.18 |
| SG-92 | 2.20 | 3.65 | 5.89 | 8.27 |
| SG-93 | 2.40 | 4.1 | 6.5 | 8.38 |
| SG-90 | 2.60 | 3.85 | 6.45 | 8.78 |
| SG-94 | 2.75 | 3.96 | 6.71 | 8.99 |
| SG-91 | 3.55 | 3.95 | 7.5 | 9.40 |
| SG-122 | 4.05 | 3.7 | 7.75 | 9.61 |
| SG-123 | 4.70 | 4.3 | 9 | 9.81 |
| SG-124 | 5.40 | 3.95 | 9.35 | 10.02 |
| SG-127 | 6.90 | 3.36 | 10.26 | 10.07 |
Рентгеновская дифракция в области больших углов. Полученная зависимость плотности свидетельствует об изменении микроструктуры пленок Mo по мере увеличения их толщины. Микроструктуру пленок молибдена и переходных областей изучали с помощью рентгеновской дифракции в области больших углов. На рис. 3 представлен результат таких измерений для образца Mo/Si с толщинами слоев молибдена и кремния 3.55 и 3.95 нм соответственно. Отметим хорошо разрешимые пики, соответствующие поликристаллической фазе Mo, они хорошо совпадают с табличными значениями. Из построения Вильямсона–Холла (рис. 4) следует, что существенных деформаций элементарной ячейки нет.
Рис. 3.
Участок дифрактограммы 2θ = 35°–80° для многослойной структуры Mo/Si (толщина пленки Mo 3.55 нм, Si – 3.95 нм).

Рис. 4.
Построение Вильямсона–Холла (штриховая линия) для многослойной структуры Mo/Si (толщина пленки Mo 3.55 нм, Si – 3.95 нм); точки – эксперимент; D = 3.32 нм, ε = 2.383 × 10–3%.

На рис. 5а представлена эволюция пиков для рассматриваемых образцов. Следует заметить, что начиная с толщин Мо около 2.4–2.5 нм наблюдается резкий рост пика при 40.5° и появление нового при 73.6° – Мо 211. Для большей наглядности на рис. 5б продемонстрированы характерные изменения дифрактограммы, соответствующие толщинам слоев молибдена 1.65 и 3.55 нм. При достаточно большой толщине слоя Мо ясно различимы три пика, соответствующие Мо 110, Мо 200 и Мо 211, свидетельствующие о большой доли кристаллического Мо. Из-за недостаточного разрешения невозможно явно выделить пики, соответствующие отдельным силицидам, однако можно сделать вывод о сложном характере переходного слоя, состоящем из смеси Mo и Si разной концентрации. При малой толщине слоя Мо наблюдается лишь один слабый пик Мо 110, сильно размытый, указывающий на больший вклад силицидов.
Рис. 5.
Участок дифрактограммы 2θ = 35°–80° для многослойной структуры Mo/Si (а) и сравнение дифракционных пиков Мо (б) для пленок Мо толщиной 1.65 (1) и 3.55 нм (2).

Дифрактограммы показывают, что нанокристаллы Мо начинают расти с преимущественной ориентацией [110]. Размеры зерен (определены по уравнению Шеррера) чуть больше ширины переходной области и очень близки к толщине слоя Мо. Оценка размеров ОКР (размеров кристаллитов) по ширине дифракционных пиков (по построению Вильямсона–Холла и формуле Шеррера) дает результаты, приведенные на рис. 6.
Рис. 6.
Оценка размеров ОКР по построению Вильямсона–Холла (кружки) и формуле Шеррера (квадраты) для многослойных структур Mo/Si (толщина пленки Si 4 нм, Mo – 1.65–6.9 нм).

Полученные данные хорошо коррелируют с результатами более ранних работ, в частности [11], где сообщается о существовании сложного силицида молибдена при толщине слоя менее 2.5 нм.
ОБСУЖДЕНИЕ РЕЗУЛЬТАТОВ И ВЫВОДЫ
В настоящей работе проведено исследование влияние толщины пленок молибдена в ПМЗ Mo/Si на их плотность в широком диапазоне толщин. Методами дифракции в области больших углов прослежены изменения как микроструктуры пленок молибдена, так и фазового состава переходных областей. В целом, при характерных толщинах пленок 1–4 нм наблюдаемые основные физические процессы хорошо коррелируют с литературными данными. Новизной данного исследования стало то, что эти исследования расширены в область больших толщин пленок Mo. Оказалось, что и в этой области наблюдаются изменения микроструктуры пленок и границ раздела. В частности, монотонно увеличивается размер кристаллитов, на границе раздела формируется стехиометрический силицид MoSi2.
Основным результатом настоящего исследования, имеющим непосредственное отношение к расчету и изготовлению АМЗ, является полученная зависимость плотности пленок молибдена от их толщины. На рис. 7 приведены толщины слоев оптимизированного для максимальной равномерности апериодического многослойного зеркала Mo/Si. Данное зеркало предназначено для обсерватории “Кортес” [21] и обеспечивает равномерное отражение в интервале 24–29 нм. Следует заметить, что данная структура содержит слои Мо толщиной как ниже, так и выше уровня аморфно-кристаллического перехода, что должно сказываться на виде отражательной способности.
Для демонстрации этого эффекта структура описанного выше АМЗ Mo/Si была скорректирована – табличное значение плотности Мо было заменено на установленные экспериментально значения, соответственно, для толщины каждого слоя индивидуально. Как результат, заметное ухудшение равномерности отражательной способности и уменьшение ее абсолютного значения (рис. 8).
Рис. 8.
Искажение целевого профиля коэффициента отражения АМЗ из-за отличия реальных плотностей пленок (1) Мо от табличных значений (2) для объемного материала.
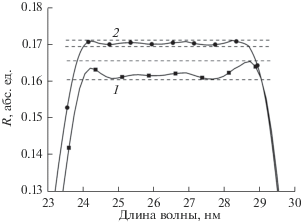
Таким образом, в работе показана необходимость учета реальных плотностей пленок и межслоевых шероховатостей, зависящих от толщины пленок в АМЗ при их оптимизации. Поэтому программы оптимизации АМЗ должны иметь такой дополнительный функционал. Для примера, упомянутая выше программа IMD не имеет такой возможности.
Список литературы
Shestov V., Ulyanov S., Vishnyakov E. // Proceed. SPIE. 2002. V. 9144. P. 91443G1.
Yulin S. // Proceed. SPIE. 2002. V. 4782. P. 196.
Вишняков Е.А., Каменец Ф.Ф., Кондратенко В.В. // Квантовая электроника. 2012. Т. 42. № 2. С. 143.
Гайкович П.К., Полковников В.Н., Салащенко Н.Н. и др. // Квантовая электроника. 2016. Т. 45. № 6. С. 406.
Гарахин С.А., Мельчаков Е.Н., Полковников В.Н. и др. // Квантовая электроника. 2017. Т. 47. № 4. С. 378.
Zoethout E., Louis E. // J. Appl. Phys. 2016. V. 120. P. 115 303.
Aquila A.L., Salmassi F., Dollar F. // Opt. Express. 2006. V. 14. P. 21.
Kuhlmann T., Yulin S., Feigl T. // Proceed. SPIE. 2002. V. 4782. P. 1075.
Lohmann M., Klabunde F., Blasing J. // Thin Solid Films. 1999. V. 342. P. 127.
Krause B., Abadias G., Michel A. // ACS Appl. Mater. Interfaces. 2016. V. 8. P. 34888.
Bajt S., Stearns D., Kearney P. // J. App. Phys. 2001. V. 90. P. 2.
Yulin S., Feigl T., Kuhlmann T. // J. Appl. Phys. 2001. V. 92. P. 1216.
Zoethout E., Louis E., Bijkerk F. // J. Appl. Phys. 2016. V. 120. P. 115303.
Patelli A., Rigato V., Salmaso G. // Surf. Coat. Tech. 2006. V. 201. P. 143.
Andreev S.S., Akhsakhalyan A.D., Bibishkin M.A. et al. // Centr. Eur. J. Phys. 2003. V. 1. P. 191.
Барышева М.М., Вайнер Ю.А., Грибков Б.А. и др. // Изв. РАН. Сер. физ. 2011. Т. 75. № 1. С. 71.
Windt D.L. // Computers in Physics. 1998. V. 12. № 4. P. 360.
Svechnikov M., Pariev D., Nechay A. et al. // J. Appl. Cryst. 2017. V. 50. P. 1428.
Юнин П.А., Дроздов Ю.Н., Дроздов М.Н. и др. // ФТП. 2013. V. 47. № 12. P. 1580.
Williamson G., Hall W. // Acta Metall. 1953. V. 1. P. 22.
Shestov S.V., Ulyanov A.S., Vishnyakov E.A. et al. // Proceed. SPIE. 2014. V. 9144. P. 91443G.
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования




