Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2019, № 10, стр. 94-101
Особенности формирования изображений в РЭМ в режиме вторичных медленных электронов. 2. Структуры с трапециевидным профилем и малыми углами наклона боковых стенок
Ю. А. Новиков *
Институт общей физики им. А.М. Прохорова РАН
119991 Москва, Россия
* E-mail: nya@kapella.gpi.ru
Поступила в редакцию 14.01.2019
После доработки 20.02.2019
Принята к публикации 23.02.2019
Аннотация
Проведено исследование формирования изображений кремниевых микроструктур в растровом электронном микроскопе, работающем в режимах сбора вторичных медленных электронов (ВМЭ) и обратно рассеянных электронов (ОРЭ). В качестве исследуемого объекта использовались канавки в электронном кремнии с трапециевидным профилем и малыми углами наклона боковых стенок с номинальной шириной 1 мкм и глубиной 300 нм. Показано, что из четырех механизмов формирования ОРЭ-изображений, известных в настоящее время, вклад в формирование ВМЭ-изображений дают только два механизма, учитывающие формирование изображения зондом первичных электронов и многократно рассеянными первичными и вторичными электронами, выходящими из поверхности твердого тела. Многократно рассеянные вторичные электроны, двигающиеся по направлению движения электронов зонда, дающие основной вклад в формирование ОРЭ-изображения, вклад в формирование ВМЭ-изображения не дают.
ВВЕДЕНИЕ
Растровая электронная микроскопия является одним из самых распространенных методов диагностики нанообъектов и наноструктур. Это обусловлено тем, что растровый электронный микроскоп (РЭМ) определяет основные характеристики наноструктур и наноматериалов: форму и размеры элементов рельефа поверхности [1–7]. Для измерения этих характеристик разработаны тест-объекты [8–13] для калибровки РЭМ и методы калибровки РЭМ [8, 14–16], доведенные до российских национальных стандартов (ГОСТ Р) [17, 18]. Были созданы методы измерения линейных размеров [8, 11, 19–25] в микрометровом (1–1000 мкм) и нанометровом (1–1000 нм) диапазонах, обеспеченные прослеживаемостью измерений от Первичного эталона длины – метра, до измеряемого размера [24, 25]. Кроме того, современная промышленность выпускает высококачественные растровые электронные микроскопы высокого разрешения [26, 27], на которых реализовано большое количество [1, 6, 7] современных методов нанодиагностики.
Растровые электронные микроскопы могут работать в нескольких диапазонах энергий электронов зонда: низковольтном (НВ) – энергия электронов E ≤ 2 кэВ, и двух высоковольтных (E > > 2 кэВ) при регистрации вторичных медленных электронов (ВМЭ) и обратно рассеянных электронов (ОРЭ). Однако только два из них получили широкое распространение: низковольтный режим и высоковольтный режим при регистрации ВМЭ [8–27]. Это обусловлено тем, что для этих режимов разработаны методы калибровки РЭМ [8, 14–16] и измерения на нем линейных размеров микро- и наноструктур [8, 11, 19–25]. Режим регистрации обратно рассеянных электронов не получил широкого распространения из-за слабой изученности механизмов формирования изображения в режиме ОРЭ [28–30].
Недавно удалось решить трудности режима ОРЭ и создать хорошо работающую модель формирования РЭМ-изображений в режиме сбора обратно рассеянных электронов [31–35]. Однако, это поставило новые вопросы уже для режима регистрации вторичных медленных электронов [36].
Настоящая работа является продолжением работы [36] и посвящена особенностям формирования ВМЭ-изображений рельефных трапециевидных структур с малыми углами наклона боковых стенок, которые обусловлены результатами работ [31–35], и связи этих особенностей с моделями формирования изображения, изложенными в работах [1, 36].
ФОРМИРОВАНИЕ ВМЭ-ИЗОБРАЖЕНИЯ
Спектр электронов, испущенных назад по отношению к направлению движения первичных электронов, можно представить схемой, изображенной на рис. 1 [37]. Область спектра, обозначенная 1, соответствует однократному упругому рассеянию назад первичных электронов. Область 2 представляет электроны (первичные и вторичные), испытавшие многократное упругое и неупругое рассеяние. В область 3 попадают медленные электроны, которые образованы в тонком поверхностном слое исследуемого образца, толщина которого определяется [37] формулой
(1)
${{z}_{{\text{S}}}} = 1.9{{A{{Z}^{{ - 0.6}}}} \mathord{\left/ {\vphantom {{A{{Z}^{{ - 0.6}}}} \rho }} \right. \kern-0em} \rho },$Рис. 1.
Схема распределения по энергиям электронов, испущенных назад по отношению к первичным электронам.
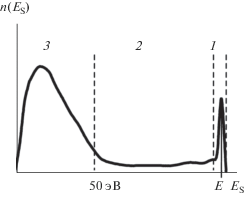
В область 3 попадают также электроны, испущенные из поверхностных электронных состояний [38] под действием первичных электронов. Этот эффект назван “стряхиванием” [38] поверхностных электронов. Он обладает удивительным свойством – анизотропией относительно движения налетающих электронов. Стряхивание поверхностных электронов осуществляется только в том случае, если первичный электрон пересекает поверхность из вакуума в твердое тело. В противном случае стряхивание электронов не происходит. Подробнее с этим эффектом и его свойствами можно ознакомиться в работе [38].
В растровом электронном микроскопе спектральный анализ электронов не производится. Детекторы РЭМ регистрируют электроны двух типов. К первому типу, названному обратно рассеянные электроны, относятся электроны, входящие в области 1 и 2 (рис. 1). Ко второму типу, названному вторичные медленные электроны, принадлежат электроны, попадающие в область 3 (рис. 1). Отметим, что в низковольтном режиме работы РЭМ регистрирует электроны из области 3. Каждый тип электронов регистрируется своим особым детектором [1, 6]. Необходимо отметить, что в силу конструкции современных детекторов ОРЭ они регистрируют электроны с энергиями более 2 кэВ. Поэтому часть диапазона ОРЭ (от 50 эВ до 2 кэВ) не участвует в формировании РЭМ-изображений.
На рис. 2 приведены схемы, поясняющие образование вторичных медленных электронов. Тонкий приповерхностный слой, толщиной zS, пересекают первичные электроны 1 и обратно рассеянные электроны 2. Они генерируют в этом слое вторичные медленные электроны 3. Кроме того, первичные электроны 1 облучают поверхность образца и стряхивают поверхностные электроны 4, которые тоже дают вклад во вторичные медленные электроны. Необходимо отметить, что обратно рассеянные электроны 2 (рис. 2) не осуществляют стряхивание поверхностных электронов. Более подробно описание формирования вторичных медленных электронов с помощью этих эффектов приведено в работе [38].
Рис. 2.
Схема формирования вторичных медленных электронов первичными электронами 1 и обратно рассеянными электронами 2 за счет образования медленных электронов 3 в тонком приповерхностном слое и электронов 4 за счет эффекта стряхивания поверхностных электронов.

Таким образом, ВМЭ-сигнал VSSE должен формироваться двумя сигналами: сигналом VBSE, полученным в результате регистрации обратно рассеянных электронов, и сигналом VLE, полученным в низковольтном режиме работы РЭМ,
(2)
${{V}_{{{\text{SSE}}}}}\left( t \right) = {{A}_{{{\text{BSE}}}}}{{V}_{{{\text{BSE}}}}}\left( t \right) + {{A}_{{{\text{LE}}}}}{{V}_{{{\text{LE}}}}}\left( t \right),$Правильность формулы (2) было подтверждено в работе [36], в которой исследовались особенности формирования ВМЭ-изображений рельефных структур с трапециевидным профилем и большими углами наклона боковых стенок. Однако, в отличие от работы [1], величины вкладов обратно рассеянных электронов и электронов низковольтного режима РЭМ различны [36] для рельефной и безрельефной поверхностей.
МОДЕЛИ ФОРМИРОВАНИЯ РЭМ-ИЗОБРАЖЕНИЙ
В работах [34, 35] описана модель формирования изображения в режиме регистрации обратно рассеянных электронов. Согласно этой модели, вклад в ОРЭ-сигнал дают 4 механизма формирования изображения:
(3)
${{V}_{{{\text{BSE}}}}}\left( t \right) = {{A}_{1}}{{V}_{1}}\left( t \right) + {{A}_{2}}{{V}_{2}}\left( t \right) + {{A}_{3}}{{V}_{3}}\left( t \right) - {{A}_{4}}{{V}_{4}}\left( t \right),$Здесь i = 1, 2, 3, 4 – номер механизма, S(x, y) – функция, описывающая рельеф поверхности, t – координата сканирования электронным зондом РЭМ, Fi(x, y, t) – характеризует плотность распределения электронов в зонде, который формирует изображение данного механизма. В модели принята гауссовская форма зондов:
(5)
${{F}_{i}}\left( {x,y,t} \right) = \frac{1}{{d_{i}^{{\text{2}}}}}\exp \left( { - \frac{{{{{\left( {x - t} \right)}}^{2}} + {{y}^{2}}}}{{{{d_{i}^{{\text{2}}}} \mathord{\left/ {\vphantom {{d_{i}^{{\text{2}}}} \pi }} \right. \kern-0em} \pi }}}} \right),$Для структур с трапециевидным профилем и малыми углами наклона боковых стенок [33, 35], выполненных из электронного кремния, вклад в ОРЭ-сигнал дают только первый, третий и четвертый механизмы [33, 35]:
(6)
${{V}_{{{\text{BSE}}}}}\left( t \right) = {{A}_{1}}{{V}_{1}}\left( t \right) + {{A}_{3}}{{V}_{3}}\left( t \right) - {{A}_{4}}{{V}_{4}}\left( t \right).$Причина отсутствия второго механизма будет приведена ниже.
Сигнал низковольтного РЭМ согласно работам [41, 42] можно описать выражением
(7)
${{V}_{{{\text{LE}}}}}\left( t \right) = \int {\left| {gradS\left( {x,y} \right)} \right|F\left( {x,y,t} \right)dxdy} ,$где F(x, y, t) – плотность распределения электронов в зонде РЭМ. Необходимо отметить, что плотность распределения электронов в зонде низковольтного РЭМ F(x, y, t) совпадает с плотностью F1(x, y, t) и описывается [43] одним гауссом в фокусе или несколькими гауссами, сдвинутыми относительно друг друга, при дефокусировке. При моделировании будем считать, что зонд сфокусирован.
Таким образом, все основные механизмы формирования изображения в РЭМ в режиме сбора вторичных медленных электронов в настоящее время достаточно хорошо изучены экспериментально и описаны теоретическими моделями.
ЭКСПЕРИМЕНТАЛЬНАЯ АППАРАТУРА И ИССЛЕДУЕМЫЕ ОБЪЕКТЫ
На рис. 3 приведена схема канавки с трапециевидным профилем и обозначены параметры, определяющие ее форму. Малыми углами φ наклона боковых стенок являются углы, удовлетворяющие условию [9, 44, 45]:
(8)
${{{{\varphi }_{{\text{d}}}}} \mathord{\left/ {\vphantom {{{{\varphi }_{{\text{d}}}}} 2}} \right. \kern-0em} 2} < \varphi \leqslant arctg\left( {{d \mathord{\left/ {\vphantom {d h}} \right. \kern-0em} h}} \right),$Рис. 4.
Схема вертикального профиля электронного зонда РЭМ в области фокусировки с углом сходимости-расходимости φd, глубиной фокусировки hf, диаметром зонда в фокусе df (минимальный диаметр зонда) и действующим диаметром зонда d (диаметр зонда на уровне плоскости исследуемого образца).

Более удобно верхнюю границу угла φ в выражении (8) представить в виде следующего выражения:
которое указывает на то, что для трапециевидной структуры с малыми углами наклона боковых стенок электронный зонд может полностью накрыть боковую стенку структуры. Таким образом, малость угла наклона является характеристикой не только самой структуры, но и характеристикой РЭМ (определяется диаметром электронного зонда).В качестве структур с малыми углами наклона в данной работе используются канавки, сделанные в электронном кремнии [21, 33, 35], с номинальными шириной 1 мкм и глубиной 300 нм. На рис. 5 приведены изображения канавки в режиме сбора ОРЭ (рис. 5а) и ВМЭ (рис. 5б) при энергии электронов зонда 25 кэВ. Формы сигналов, из которых состоят изображения на рис. 5, показаны на рис. 6 в режиме регистрации ОРЭ (сигнал 1) и ВМЭ (сигнал 2).
Рис. 5.
РЭМ-изображения трапециевидной канавки с номинальной шириной 1 мкм и глубиной 300 нм в режимах сбора ОРЭ (а) и ВМЭ (б).
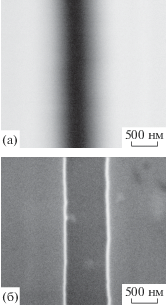
Рис. 6.
Формы сигналов, полученных при сканировании трапециевидной канавки с номинальной шириной 1 мкм и глубиной 300 нм в режиме регистрации ОРЭ (сигнал 1) и ВМЭ (сигнал 2).

Профиль канавок был измерен в специальных экспериментах [21] на РЭМ в режиме сбора ВМЭ. При этом были получены размер верхнего основания u = 1017 ± 7 нм, размер нижнего основания b = 903 ± 5 нм, проекция боковой наклонной стенки s = 57 нм, углы наклона боковых стенок φ = 10.8°. На рис. 7 показан измеренный профиль канавок. Видно, что номинальное значение ширины канавки соответствует верхнему основанию трапециевидной формы канавки. Такой профиль характерен для технологии микроэлектроники, с помощью которой были сделаны исследуемые структуры.
Рис. 7.
Форма профиля трапециевидной канавки с номинальной шириной 1 мкм и глубиной 0.3 мкм. Штриховые вертикальные линии соответствуют номинальным границам рельефной структуры.

Эксперименты проводились на РЭМ CamScan CS-44 при энергии электронов зонда 25 кэВ. Более подробно с экспериментами можно ознакомиться в работе [21]. Калибровка РЭМ (определение размера пикселя m и диаметра зонда d) осуществлялась с помощью рельефных прямоугольных структур в кремнии [9, 47, 48 ] по методу, изложенному в работах [14, 48 ] . Результаты калибровки составили:
Сравнивая величину проекции боковой наклонной стенки канавки, приведенную выше, с диаметром электронного зонда, видим, что условие (9) – малость угла наклона боковых стенок трапециевидной канавки, хорошо выполняется.
ОБСУЖДЕНИЕ РЕЗУЛЬТАТОВ
РЭМ-изображения трапециевидной канавки с номинальной шириной 1 мкм в режимах сбора ОРЭ и ВМЭ приведены на рис. 5а и 5б соответственно. Сигналы, из которых состоят эти изображения, показаны на рис. 6. Хорошо видно, что ОРЭ и ВМЭ-сигналы различаются принципиально. ОРЭ-сигнал имеет треугольную форму дна сигнала, которая определяется многократным рассеянием вторичных электронов – электронов проводимости [32, 33, 35]. В то же время ВМЭ-сигнал имеет плоское дно.
Моделирование ВМЭ-сигналов осуществлялось с помощью выражений (2), (6) и (7). Вклады соответствующих механизмов приведены в табл. 1. Результаты моделирования показаны на рис. 8. Сигнал 1 демонстрирует, что, если использовать предположение об одинаковом ОРЭ и НВ-вкладе в ВМЭ-сигнал, то получим, что модельный сигнал 1 имеет форму, которая полностью противоречит экспериментальному сигналу 2 на рис. 6. Если использовать предположение о 100-кратном превышении НВ-вклада над ОРЭ, то получим сигнал 2 на рис. 8, который достаточно сильно отличается от реального сигнала 2 на рис. 6 вне канавки.
Рис. 8.
Модельные ВМЭ-сигналы, полученные для канавки с номинальной шириной 1 мкм глубиной 300 нм при разных параметрах моделирования.

Таким образом, становится ясно, что ОРЭ-сигнал, описываемый выражением (6), нельзя использовать для генерации ВМЭ-сигнала с помощью выражений (2), (6) и (7): невозможно превратить треугольную форму дна ОРЭ-сигнала в плоскую форму дна ВМЭ-сигнала.
Сделаем другое предположение: из четырех механизмов формирования изображения в режиме регистрации ОРЭ [33, 35] не все механизмы дают вклад в формирование ВМЭ-изображения.
Отсутствие вклада второго механизма формирования ОРЭ-сигнала в формирование ВМЭ (и ОРЭ)-изображения легко объяснимо [33, 35]. Зонд первичных многократно рассеянных электронов, ответственный за это формирование, не задевает канавку (рис. 9а) с глубиной 300 нм, которая используется в данном эксперименте. Если бы канавка была глубиной 500 нм, то вклад 2-го механизма был бы (рис. 9б). Более подробно об этом изложено в работах [33, 35].
Рис. 9.
Схемы взаимодействия зонда многократно рассеянных первичных электронов с трапециевидными канавками с малыми углами наклона боковых стенок с номинальной шириной 1 мкм и глубинами 300 нм (а) и 500 нм (б).
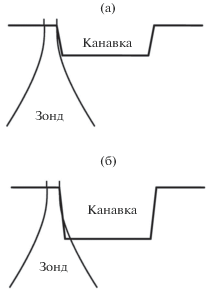
Если из формулы (6) убрать третий механизм формирования ОРЭ-сигнала, то получим для ОРЭ-сигнала, входящего в формирование ВМЭ-изображения, описываемого формулой (2), следующее выражение:
(10)
${{V}_{{{\text{BSE}}}}}\left( t \right) = {{A}_{1}}{{V}_{1}}\left( t \right) - {{A}_{4}}{{V}_{4}}\left( t \right).$Рис. 10.
Реальные ОРЭ (а) и ВМЭ (б) сигналы, полученные при сканировании канавки с номинальной шириной 1 мкм и глубиной 300 нм, и модельные сигналы, описывающие реальные сигналы, наложенные на реальные сигналы.

Однако, для ОРЭ-изображений требуется [33, 35] использовать выражение (6). На рис. 10б на реальный ОРЭ-сигнал наложен отнормированный по амплитуде модельный сигнал, созданный с использованием выражения (6) и наиболее хорошо описывающий экспериментальный сигнал (параметры моделирования приведены в табл. 1). Более подробно об этом можно прочитать в работах [33, 35]. Видно очень хорошее совпадение модельного и экспериментального ОРЭ-сигналов.
Отсутствие вклада третьего механизма формирования ОРЭ-сигнала, за который отвечают вторичные электроны [33, 35], в формирование ВМЭ-сигнала непонятно. Необходимо отметить, что вклад третьего механизма формирования ОРЭ-сигнала [33, 35] в создание ОРЭ-изображения в 80 раз превышает вклад первого механизма, а в формирование ВМЭ-сигнала третий механизм вклада не дает.
Подчеркнем особенность формирования ВМЭ-сигнала трапециевидных структур с малыми углами наклона боковых стенок, выполненных из электронного кремния. В формирование ОРЭ-изображения дают вклад 3 механизма (выражение (6)) формирования ОРЭ-сигнала. В то же время в формирование ВМЭ-изображения дают вклад только 2 механизма (выражение (10)) формирования ОРЭ-сигнала и сигнал (7) низковольтного РЭМ. Причем вклад четвертого механизма формирования ОРЭ-сигнала при формировании ВМЭ-сигнала резко (в 20 раз) уменьшился.
Все это указывает на то, что выражение (2) в чистом виде не работает: не все механизмы формирования ОРЭ изображения дают вклад в формирование ВМЭ-изображения. Для объяснения наблюдаемых явлений необходимы дополнительные исследования.
ЗАКЛЮЧЕНИЕ
Представлены результаты исследования формирования изображений канавок в кремнии, имеющих трапециевидный профиль и малые углы наклона боковых стенок, в РЭМ, работающем в режимах сбора вторичных медленных и обратно рассеянных электронов. Показано, что из четырех механизмов формирования ОРЭ-изображений, известных в настоящее время, вклад в формирование ВМЭ-изображений дают только два механизма – первый и четвертый.
Таким образом, формирование ВМЭ-сигналов имеeт особенности как для трапециевидных структур с большими углами наклона боковых стенок [36], так и для структур с малыми углами наклона боковых стенок. Это указывает на недостаточную изученность взаимодействия электронов с рельефной поверхностью.
Таблица 1.
Величины модельных параметров ОРЭ и ВМЭ-сигналов
| Параметрымодели | ОРЭсигнал | ВМЭ-сигналы (рис. 8) | ||
|---|---|---|---|---|
| сигнал 1 | сигнал 2 | сигнал 3 | ||
| d1, нм | 130 | 130 | 130 | 130 |
| A1 | 1 | 1 | 1 | 1 |
| d3, нм | 1500 | 1500 | 1500 | – |
| A3 | 80 | 80 | 80 | – |
| d4, нм | 5000 | 5000 | 5000 | 5000 |
| A4 | 20 | 20 | 20 | 1 |
| ABSE | – | 1 | 1 | 1 |
| ALE | – | 1 | 100 | 1 |
В следующей работе этого цикла будут рассмотрены особенности формирования ВМЭ-изображений структур с прямоугольным профилем.
Список литературы
Reimer L. Scanning Electron Microscopy: Physics of Image Formation and Microanalysis. / Ed. Springer-Verlag. Berlin, Heidelberg, N.Y., 1998.
Marchman H.M., Griffith J.E., Guo J.Z.Y., Frackoviak J., Celler G.K. // J. Vac. Sci. Technol. 1994. V. B12. № 6. P. 3585.
Новиков Ю.А., Раков А.В. // Микроэлектроника. 1996. Т. 25. № 6. С. 417.
Новиков Ю.А., Раков А.В. // Измерительная техника. 1999. № 1. С. 14.
Postek M.T., Vladar A.E. Handbook of Silicon Semiconductor Metrology / Ed. Diebold A.C. N.Y.–Basel: Marcel Dekker Inc., 2001. P. 295.
Криштал М.М., Ясников И.С., Полунин В.И., Филатов А.М., Ульяненков А.Г. Сканирующая электронная микроскопия и рентгеноспектральный микроанализ в примерах практического применения. М.: Техносфера, 2009. 208 с.
Растровая электронная микроскопия для нанотехнологий. Методы и применение / Под ред. У. Жу и Ж.Л. Уанга. Пер. с англ. М.: БИНОМ. Лаборатория знаний, 2013. 582 с.
Волк Ч.П., Горнев Е.С., Новиков Ю.А., Озерин Ю.В., Плотников Ю.И., Прохоров А.М., Раков А.В. // Микроэлектроника. 2002. Т. 31. № 4. С. 243.
Novikov Yu.A., Gavrilenko V.P., Rakov A.V., Todua P.A. // Proc. SPIE. 2008. V. 7042. P. 704208. https://doi.org/10.1117/12.794834
Gavrilenko V.P., Mityukhlyaev V.B., Novikov Yu.A., Ozerin Yu.V., Rakov A.V., Todua P.A. // Measurement Science and Technology. 2009. V. 20. P. 20. https://doi.org/10.1088/0957-0233/20/8/084022
Frase C.G., Hassler-Grohne W., Dai G., Bosse H., Novikov Yu.A., Rakov A.V. // Measurement Science and Technology. 2007. V. 18. P. 439. https://doi.org/10.1088/0957-0233/18/2/S16
Новиков Ю.А. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2017. Т. 46. № 11. С. 77. https://doi.org/10.7868/S0207352817110105
Новиков Ю.А. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2018. № 12. С. 86. https://doi.org/10.1134/S0207352818120144
Новиков Ю.А., Стеколин И.Ю. // Труды ИОФАН. 1995. Т. 49. С. 41.
Волк Ч.П., Горнев Е.С., Новиков Ю.А., Озерин Ю.В., Плотников Ю.И., Раков А.В. // Микроэлектроника. 2004. Т. 33. № 6. С. 419.
Gavrilenko V.P., Novikov Yu.A., Rakov A.V., Todua P.A., Volk Ch.P. // Proc. SPIE. 2009. V. 7272. P. 72720Z. https://doi.org/10.1117/12.813514
Гавриленко В.П., Лесновский Е.Н., Новиков Ю.А., Раков А.В., Тодуа П.А., Филиппов М.Н. // Известия РАН. Серия Физическая. 2009. Т. 73. № 4. С. 454.
Gavrilenko V.P., Filippov M.N., Novikov Yu.A., Rakov A.V., Todua P.A. // Proc. SPIE. 2009. V. 7378. P. 737812. https://doi.org/10.1117/12.821760
Gavrilenko V.P., Kalnov V.A., Novikov Yu.A., Orlikovsky A.A., Rakov A.V., Todua P.A., Valiev K.A., Zhikharev E.N. // Proc. SPIE. 2009. V. 7272. P. 727227. https://doi.org/10.1117/12.814062
Данилова М.А., Митюхляев В.Б., Новиков Ю.А., Озерин Ю.В., Раков А.В., Тодуа П.А. // Измерительная техника. 2008. № 8. С. 20.
Новиков Ю.А., Раков А.В., Филиппов М.Н. // Известия РАН. Серия Физическая. 1998. Т. 62. № 3. С. 543.
Filippov M.N., Novikov Yu.A., Rakov A.V., Todua P.A. // Proc. SPIE. 2010. V. 7521. P. 752116. https://doi.org/10.1117/12.854696
Novikov Yu.A., Rakov A.V., Todua P.A. // Proc. SPIE. 2006. V. 6260. P. 626015. https://doi.org/10.1117/12.683401
Гавриленко В., Новиков Ю., Раков А., Тодуа П. // Наноиндустрия. 2009. № 4. С. 36.
Gavrilenko V.P., Novikov Yu.A., Rakov A.V., Todua P.A. // Proc. SPIE. 2009. V. 7405. P. 740504. https://doi.org/10.1117/12.826164
Новиков Ю.А. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2013. № 5. С. 105. https://doi.org/10.7868/S0207352813050107
Новиков Ю.А. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2013. № 8. С. 105. https://doi.org/10.7868/S0207352813080131
Новиков Ю.А., Раков А.В., Филиппов М.Н. // Труды ИОФАН. 1998. Т. 55. С. 100.
Новиков Ю.А., Раков А.В., Филиппов М.Н. // Известия вузов. Электроника. 1998. № 1. С. 91.
Новиков Ю.А. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2011. № 10. С. 5.
Новиков Ю.А. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2014. № 8. С. 46. https://doi.org/10.7868/S0207352814080101
Новиков Ю.А. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2015. № 5. С. 78. https://doi.org/10.7868/S0207352815050091
Новиков Ю.А. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2015. № 10. С. 59. https://doi.org/10.7868/S0207352815100170
Новиков Ю.А. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2016. № 2. С. 66. https://doi.org/10.7868/S0207352816020086
Новиков Ю.А. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2016. № 9. С. 12. https://doi.org/10.7868/S0207352816090110
Новиков Ю.А. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2019. № 8. (P. 64).
Новиков Ю.А., Раков А.В. // Труды ИОФАН. 1998. Т. 55. С. 3.
Новиков Ю.А., Раков А.В. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 1999. № 8. С. 24.
Волк Ч.П., Горнев Е.С., Новиков Ю.А., Плотников Ю.И., Раков А.В., Тодуа П.А. // Труды ИОФАН. 2006. Т. 62. С. 77.
Gavrilenko V.P., Novikov Yu.A., Rakov A.V., Todua P.A. // Proc. SPIE. 2008. V. 7042. P. 70420C. https://doi.org/10.1117/12.794891
Новиков Ю.А. // Микроэлектроника. 2014. Т. 43. № 4. С. 263. https://doi.org/10.7868/S0544126914040073
Новиков Ю.А. // Микроэлектроника. 2014. Т. 43. № 6. С. 456. https://doi.org/10.7868/S0544126914060076
Новиков Ю.А. // Микроэлектроника. 2014. Т. 43. № 5. С. 373. https://doi.org/10.7868/S0544126914050068
Новиков Ю.А., Раков А.В., Тодуа П.А. // Измерительная техника. 2009. № 2. С. 22.
Gavrilenko V.P., Novikov Yu.A., Rakov A.V., Todua P.A. // Proc. SPIE. 2010. V. 7718. P. 77180Y. https://doi.org/10.1117/12.853892
Новиков Ю.А., Раков А.В., Стеколин И.Ю. // Измерительная техника. 1996. № 12. С. 26.
Новиков Ю.А., Пешехонов С.В., Стрижков И.Б. // Труды ИОФАН. 1995. Т. 49. С. 20.
Новиков Ю.А., Пешехонов С.В., Раков А.В., Седов С.В., Симонов А.Н., Стеколин И.Ю., Стрижков И.Б. // Известия РАН. Серия Физическая. 1993. Т. 57. № 8. С. 84.
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования