Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2019, № 10, стр. 82-87
Электронно-микроскопические исследования влияния отжига на тонкие пленки Ge–Sb–Te, полученные методом вакуумно-термического испарения
Ю. С. Зыбина 1, *, Н. И. Боргардт 1, П. И. Лазаренко 1, В. С. Парсегова 1, А. С. Приходько 1, А. А. Шерченков 1
1 Национальный исследовательский университет
“Московский институт электронной техники”
124498 Москва, Россия
* E-mail: julia3ybina@gmail.com
Поступила в редакцию 29.11.2018
После доработки 16.01.2019
Принята к публикации 11.02.2019
Аннотация
Методами просвечивающей электронной микроскопии показано, что отжиг осажденных методом вакуумно-термического испарения аморфных пленок Ge2Sb2Te5 при температуре 250°C приводит к формированию в них гексагональной фазы с характерной блочной структурой. При этом на их поверхности образуются островковые дефекты, представляющие собой кубическую модификацию Sb2O3. Размеры этих дефектов и доля занимаемой ими площади оценены с использованием изображений растровой электронной микроскопии. Фактором, способствующим появлению кристаллитов оксида сурьмы, является возникающее при формировании исходной пленки обогащение ее поверхностной области сурьмой, которая окисляется во время отжига. Благодаря формированию дефектов состав пленки в локальных областях в их окрестности изменяется и становится близким к стехиометрическим значениям для соединения Ge3Sb2Te6.
ВВЕДЕНИЕ
Фазовая память (ФП) на основе халькогенидных полупроводников системы Ge–Sb–Te (GST) входит в число перспективных видов запоминающих устройств [1]. Принцип двоичной логики в них реализуется на основе различных фазовых состояний материала (аморфного и кристаллического), переход между которыми осуществляется под воздействием оптического или электрического импульса. Среди соединений системы GST материал Ge2Sb2Te5 (GST225) представляет наибольший интерес благодаря совокупности функционально значимых характеристик: времени фазового перехода, количеству циклов перезаписи, температуре плавления, определяющей потребляемую мощность [2].
К числу наиболее распространенных методов получения пленок GST относятся магнетронное распыление [3], вакуумно-термическое испарение (ВТИ) [4], осаждение из газовой фазы [5], а также молекулярно-лучевая эпитаксия [6]. Эпитаксиальные методы, позволяющие формировать слои GST с совершенной кристаллической решеткой, открывают широкие возможности для изучения фундаментальных процессов, протекающих при фазовых переходах в материалах ФП. Достоинствами вакуумно-термического испарения являются относительная простота технологии и экономичность, а также возможность варьирования химического состава напыляемой пленки, что определяет интерес к использованию этого метода для получения пленок GST, особенно на стадии отработки технологии.
Среди методов исследования тонких пленок GST особую роль играют просвечивающая электронная микроскопия (ПЭМ) [7, 8] и рентгеноспектральный микроанализ (РСМА) [9], которые позволяют изучать локальные изменения структуры и состава, происходящие при кристаллизации материала, в том числе формирование различных фаз [9–11]. С их помощью выявлено, что возможной причиной описанного разделения фаз является увеличение плотности материала GST на 7–9% при кристаллизации и, соответственно, снижение объема ячейки [12]. Релаксация возникающих при этом напряжений приводит к эффектам сегрегации [9].
Методами растровой и просвечивающей электронной микроскопии, а также атомно-силовой микроскопии в халькогенидных системах были выявлены поверхностные образования (дефекты) [5, 6, 13], причины формирования которых практически не изучены. Такие дефекты в форме усеченных тетраэдров с размерами, достигающими сотен нанометров, могут приводить к деградации устройств ФП. Следует отметить, что исследованные в работах [5, 6, 13] тонкие пленки были выращены эпитаксиальными методами, в то время как для пленок, полученных методом ВТИ, подобные дефекты ранее не изучались.
Настоящая работа посвящена структурным и аналитическим исследованиям влияния отжига при температуре 250°C на полученные методом ВТИ тонкие пленки GST225, термообработка которых приводила к их фазовому переходу из аморфного состояния в кристаллическое. Методами ПЭМ и РСМА изучались структура и химический состав пленок GST, а также поверхностных дефектов, образовавшихся после отжига. Средние размеры этих дефектов и доля занимаемой ими площади поверхности пленки определялись на основе цифровой обработки изображений растровой электронной микроскопии (РЭМ).
ФОРМИРОВАНИЕ ТОНКИХ ПЛЕНОК И ЭКСПЕРИМЕНТАЛЬНОЕ ОБОРУДОВАНИЕ
Формирование тонких пленок GST225
Исходный поликристаллический порошок Ge2Sb2Te5 синтезировали методом сплавления материалов соответствующих элементов в вакуумированных кварцевых ампулах [11]. Тонкие пленки формировались на термически-окисленных кремниевых подложках методом вакуумно-термического испарения синтезированного порошка при остаточном давлении в камере менее 4 × 10–5 мм рт. ст. В качестве испарителя использовался кварцевый тигель с зауженным горлышком, по периметру которого располагалась нагревательная спираль. При испарении применялся двухэтапный режим нагрева. На первом этапе для дегазации испаряемого порошка осуществлялся нагрев от комнатной температуры до 300°С со средней скоростью 25°C/мин и последующая выдержка в течение 10 мин. Во время второго этапа электрический ток, протекающий через нагревательный элемент, резко увеличивался, в результате чего температура в кварцевой ампуле поднималась выше 750°С. Синтезированный порошок испарялся в так называемом “взрывном” режиме. Температура подложки во время процесса осаждения не превышала 50°C, что позволило получить тонкие пленки в аморфном состоянии. Толщина пленок контролировалась по образцам-спутникам с помощью стилусного профилометра Alpha-Step D-120 и приблизительно равнялась 150 нм. Отжиг аморфных пленок проводился в печи конвекционного нагрева ПЛ-20 при температуре 250°C в течение 15 мин, равномерный нагрев до этой температуры со скоростью 15°C/мин обеспечивался пропорционально-интегрально-дифференцирующим регулятором. Охлаждение подложек осуществлялось в конвекционной печи по мере ее остывания после выключения.
Экспериментальное оборудование
Исследования структуры и состава тонких пленок GST проводились при ускоряющем напряжении 200 кВ в просвечивающем электронном микроскопе Titan Themis 200, оснащенном энергодисперсионным спектрометром Super-X. Тонкие фольги для ПЭМ приготавливались с помощью фокусированного ионного пучка по стандартной методике In-Situ Lift-Out [14, 15] в электронно-ионном микроскопе Helios NanoLab 650, оснащенном инжектором металлоорганического соединения C9H10Pt для локального осаждения платины и микроманипулятором Kleindiek MM3A‑EM [16]. Исследования морфологии поверхности пленок GST выполнялись с использованием электронной колонны микроскопа при ускоряющем напряжении 1 кВ и токе пучка 100 пА. Для достижения наилучшего разрешения на изображениях во вторичных электронах применялся иммерсионный режим работы объективной линзы. Цифровая обработка экспериментальных микрофотографий проводилась с помощью программного пакета Matlab.
РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
Исходная пленка GST
Исследования методом ПЭМ поперечного сечения выращенной пленки показали, что ее структура является однородной и в направлении роста вдоль оси z, и в латеральном направлении (рис. 1). Об аморфном состоянии пленки свидетельствовала дифракционная картина, сформированная с использованием селекторной апертуры для получения структурных данных только для области GST, которая выделена пунктирной окружностью на ПЭМ-изображении (рис. 1).
Рис. 1.
ПЭМ-изображение исходной пленки GST и дифракционная картина (на вставке) от показанной пунктиром области, свидетельствующая об ее аморфной структуре. Защитные слои платины, осажденные при приготовлении тонкой фольги с помощью электронного и ионного пучков, обозначены как Ptel и Pti. Осью $z$ показано направление роста пленки.
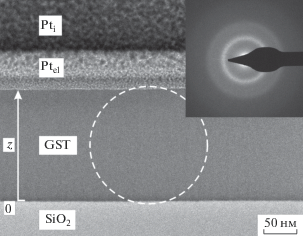
Полученные методом РСМА значения концентраций германия, сурьмы и теллура, усредненные по всей толщине пленки GST, отклонялись не более чем на 2 ат. % от стехиометрических значений для соединения GST225. Вместе с тем, профили концентраций элементов в направлении роста, найденные путем усреднения их двумерных распределений, свидетельствовали о существенном градиенте концентраций Sb и Te в материале GST. Как видно из рис. 2а, по мере выращивания слоя содержание сурьмы возрастало примерно от 6 до 60 ат. %, а доля теллура снижалась от 75 до 30 ат. %, при этом концентрация Ge изменялась меньше и находилась в пределах 12–26 ат. %.
Рис. 2.
Профили концентраций для Ge (сплошная линия), Sb (пунктирная линия), Te (точечная линия) для исходной (а) и подвергнутой отжигу (б) пленок вдоль направления роста. Горизонтальные прямые соответствуют стехиометрическим значениям концентраций Ge и Sb (22.2 ат. %), а также Te (55.6 ат. %) для соединения GST225.

Исследования морфологии поверхности пленки, выполненные методом РЭМ перед приготовлением образца поперечного сечения для ПЭМ, показали, что поверхность пленки является достаточно гладкой (без каких-либо заметных дефектов).
Вероятной причиной выявленной неоднородности химического состава пленки GST является существенная разница в давлениях паров Sb [17], Te [18] и фракций GeTe [19] и Sb2Te3 [20], которые могут образовываться при температуре испарения в результате разложения GST225. Поэтому при испарении синтезированного порошка составы паровой фазы и, соответственно, растущей пленки менялись во времени. Первоначально преимущественно осаждалась фракция, обладающая большим давлением паров, которая обогащена Te. Фракция, обогащенная Sb и имеющая наименьшее давление паров, в большей степени осаждалась на конечном этапе роста пленки.
Структура и состав пленки GST после отжига
Электронно-микроскопические исследования подвергнутой термообработке пленки GST225 показали, что отжиг при температуре 250°C приводит к фазовому переходу из аморфного в кристаллическое состояние, так как это следует из рис. 3, где представлено электронно-микроскопическое изображение высокого разрешения (ВРЭМ). Согласно работам [7, 8, 21] визуализируемая блочная структура характерна для гексагональной фазы GST, при этом блоки разделяются так называемыми щелями Ван-дер-Ваальса, которые формируются в плоскостях (0001). Расстояние между двумя соседними щелями определяет параметр решетки $c$ конкретного соединения GST. Максимальный размер блоков достигает 3 нм, при этом между двумя соседними щелями располагается 17 атомных плоскостей [21]. Состав GST в пределах блока подчиняется общей формуле GexSb2Te3 + x, причем в направлении [0001] атомные плоскости теллура чередуются с плоскостями, заполненными атомами германия и сурьмы в различных пропорциях [8].
Рис. 3.
ВРЭМ-изображение пленки GST после отжига с характерной кристаллической блочной структурой, один из блоков которой отмечен белым прямоугольником.
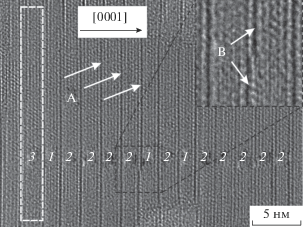
На ВРЭМ-изображении отожженной пленки GST (рис. 3) щели Ван-дер-Ваальса, показанные стрелками, имеют темный контраст. Определенные при анализе изображения размеры блоков GST, равные параметру решетки c, для большей части блоков были равны 2 нм, что соответствует соединению Ge3Sb2Te6 (GST326) (блоки с цифрой 2 на рис. 3). Также были выявлены соединения с параметрами решетки 1.7 и 2.4 нм (цифры 1 и 3 на рис. 3), которые могут соответствовать GST225 и Ge4Sb2Te7. Характерной особенностью являются изменения размера блока в плоскости (0001), приводящие к локальному смещению щели Ван-дер-Ваальса, как показано на вставке рис. 3.
Химический состав в локальной области пленки определяется набором составляющих ее блоков GST, что позволило оценить произошедшие при отжиге пленки изменения. Формирование большого количества блоков GST326 в пленке, имевшей в исходном аморфном состоянии стехиометрию, близкую к GST225, свидетельствует о тенденции к уменьшению концентрации сурьмы в пленке под воздействием отжига.
Результаты ВРЭМ коррелируют с данными РСМА, согласно которым в локальных областях пленки, расположенных вблизи поверхностных дефектов (см. ниже), были получены значения концентраций: 28.9 ат. % для Ge, 17.6 ат. % для Sb и 53.5 ат. % для Te, что близко к теоретическим значениям для GST326. В других областях отжиг не привел к изменениям среднего химического состава пленки, значения концентраций элементов по-прежнему соответствовали стехиометрии соединения GST225.
Градиент в средних распределениях Sb и Te вдоль направления роста, выявленный в исходной аморфной пленке, сохранялся после отжига, хотя различия в значениях концентраций сурьмы и теллура в нижней и верхней областях слоя GST уменьшились (рис. 2б).
Поверхностные дефекты
Отжиг пленки GST привел также к существенным изменениям морфологии ее поверхности, выявленным методом РЭМ (рис. 4). На ней образовались дефекты в виде произвольным образом расположенных островковых образований, которые имели сложную форму, во многих случаях близкую к усеченным тетраэдрам и октаэдрам. Их латеральные размеры варьировались в пределах 0.3–1.4 мкм, некоторые дефекты отмечены стрелками на рис. 4.
Рис. 4.
РЭМ-изображение пленки GST после отжига с показанными стрелками поверхностными дефектами. На вставке приведено ПЭМ-изображение образца поперечного сечения пленки с дефектами А и B, приготовленного вдоль штрихпунктирной прямой. Буквой C показана полость между дефектами.
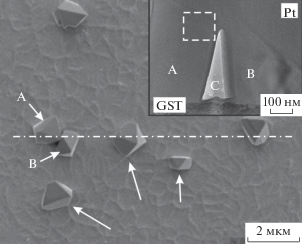
Для оценки средней площади поверхностных дефектов и занимаемой ими доли поверхности пленки GST проводилась цифровая обработка РЭМ-изображений в программном пакете Matlab. На первом этапе осуществлялась процедура бинаризации экспериментальных микрофотографий с применением гистограммы распределения интенсивности, анализ которой позволил установить диапазон значений интенсивности, соответствующий поверхностным дефектам. На следующем этапе, на полученном бинарном изображении выделялись контуры отдельных дефектов методом связных компонент с критерием связности по восьми соседям [22] и затем вычислялись их площади. На последнем этапе на основе выборки, включавшей около 650 дефектов, было установлено, что среднее значение их площади равно 0.1 мкм2, а доля занимаемой ими поверхности составляет около 1%.
Для изучения структуры и химического состава поверхностных дефектов с применением методики In-Situ Lift-Out приготавливался электронно-микроскопический образец, позволивший на одной тонкой фольге получить поперечное сечение нескольких дефектов вдоль направления, которое показано на рис. 4 штрихпунктирной линией. Благодаря такому подходу оказалось возможным сопоставить РЭМ- и ПЭМ-изображения отдельных дефектов (показаны буквами A и B на рис. 4) и установить, что высота поверхностных образований, которая могла достигать нескольких сотен нанометров, соизмерима с их латеральными размерами и существенно превышает толщину пленки GST.
Для выявления структуры дефектов были получены ВРЭМ-изображения и выполнен их фурье-анализ. Пример такого изображения для дефекта в ориентации (110) показан на рис. 5 с соответствующим фурье-образом на вставке, из которого следует, что дефект обладает кубической решеткой с параметром $a = 1.11$ нм. Химический анализ в области, показанной на вставке рис. 4, выявил, что в дефектах содержится примерно 41 ат. % сурьмы и 59 ат. % кислорода, соотношение которых соответствует стехиометрии оксида сурьмы Sb2O3. Отсутствие в дефектах германия и теллура свидетельствует о том, что они не являются материалом GST.
Рис. 5.
ВРЭМ-изображение выделенной пунктиром на рис. 4 области дефекта A в ориентации (110) и его фурье-образ (на вставке).

Результаты анализа ВРЭМ-изображений и данные РСМА позволяют заключить, что образовавшиеся после отжига поверхностные образования представляют собой кристаллиты сенармонтита Sb2O3 с кубической решеткой [23, 24]. Они аналогичны описанным в [23, 25] кристаллам Sb2O3 в кубической модификации, возникающим на поверхности оксида сурьмы после термического воздействия и имеющим близкую к тетраэдру или октаэдру форму.
Возможной причиной формирования выявленных кристаллитов Sb2O3 могло являться неравномерное распределение химических элементов в пленке GST, верхняя часть которой обогащена сурьмой. В результате окисления во время отжига на ее поверхности образуются дефекты, содержащие Sb [26]. При этом концентрация сурьмы в объеме слоя GST снижается, что соответствует данным ПЭМ и РСМА, согласно которым его средний состав в локальных областях в окрестности поверхностных дефектов становится близок к стехиометрическим значениям для GST326 с меньшей концентрацией сурьмы, по сравнению с исходной аморфной пленкой, соответствующей в среднем соединению GST225.
ЗАКЛЮЧЕНИЕ
Методами растровой и просвечивающей электронной микроскопии, а также рентгеноспектрального микроанализа исследованы структура и состав как исходных, так и отожженных при температуре 250°C тонких пленок Ge–Sb–Te. Выявлено, что исходная пленка GST находилась в аморфном состоянии, ее средний состав отвечал соединению GST225, однако в направлении роста для нее характерно существенное увеличение концентрации Sb и уменьшение концентрации Te, что обусловлено особенностями формирования пленок методом вакуумно-термического испарения. При отжиге происходила кристаллизация материала пленки с образованием блочной структуры, характерной для гексагональной фазы GST, на ее поверхности формировались дефекты в форме, близкой к усеченному тетраэдру или октаэдру, а средний химический состав в локальных областях, смежных с дефектами, изменялся и соответствовал GST326.
С применением цифровой обработки изображений растровой электронной микроскопии установлено, что размеры поверхностных дефектов варьировались в пределах 0.3–1.4 мкм, их средняя площадь составила около 0.1 мкм2, а доля занимаемой ими поверхности – 1%. При использовании электронно-микроскопических изображений высокого разрешения и рентгеновского микроанализа впервые показано, что такие дефекты являются кристаллитами сенармонтита – кубической модификации оксида сурьмы Sb2O3 с параметром решетки $a = 1.11$ нм. Вероятной причиной их возникновения является обогащение поверхностного слоя исходной аморфной пленки сурьмой, окисление которой под действием отжига приводит к формированию содержащих Sb островковых образований и изменению среднего химического состава пленки.
Список литературы
Redaelli A. Phase Change Memory. Springer International Publishing AG, 2018. 330 p. https://doi.org/10.1007/978-3-319-69053-7
Козюхин С.А., Шерченков А.А., Новоторцев В.М., Тимошенков С.П. // РН. 2011. Т. 6. № 3. С. 50
Jeong T.H., Kim M.R., Seo H. et al. // J. Appl. Phys. 1999. V. 86. № 2. P. 774. https://doi.org/10.1063/1.370803
Kumar P., Tripathi S.K., Sharma I. // J. Alloys Comp. 2018. V. 755. P. 108. https://doi.org/10.1016/j.jallcom.2018.04.316
Schuck M., Ries S., Schreiber M. et al. // J. Cryst. Growth. 2015. V. 420. P. 37. .https://doi.org/10.1016./j.jcrysgro.2015.03.034
Boschker J.E., Calarco R. // Adv. Phys. X. 2017. V. 2. № 3. P. 675. https://doi.org/10.1080/23746149.2017.1346483
Park Y.J., Lee J.Y., Kim Y.T. // Appl. Surf. Sci. 2006. V. 253. № 2. P. 714. https://doi.org/10.1016/j.apsusc.2005.12.158
Kooi B.J., De Hosson J.T.M. // J. Appl. Phys. 2002. V. 92. № 7. P. 3584. https://doi.org/10.1063/1.1502915
Krusin-Elbaum L., Cabral C.J., Chen K.N. et al. // Appl. Phys. Lett. 2007. V. 90. № 14. P. 141902. https://doi.org/10.1063/1.2719148
Privitera S., Rimini E. // J. Appl. Phys. 2003. V. 94. № 7. P. 4409. https://doi.org/10.1063/1.1604458
Sherchenkov A., Kozyukhin S., Borgardt N. et al. // J. Non-Cryst. Solids. V. 501. P. 101. https://doi.org/10.1016/j.jnoncrysol.2017.12.023
Njoroge W.K., Wöltgens H.W., Wuttig M. // J. Vac. Sci. Technol. A. 2002. V. 20. № 1. P. 230. https://doi.org/10.1116/1.1430249
Hilmi I., Thelander E., Schumacher P. et al. // Thin Solid Films. 2016. V. 619. P. 81. https://doi.org/10.1016/j.tsf.2016.10.028
Волков Р.Л., Боргардт Н.И., Кукин В.Н. и др. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2011. № 9. С. 94
Гришина Я.С. Боргардт Н.И., Волков Р.Л. и др. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2017. № 2. С. 51. https://doi.org/10.7868/S020735281702007X
Алехова Т.А., Шкловер В.Я., Загустина Н.А. и др. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2010. № 9. С. 49.
Rossenblatt G.M., Birchenall C.E. // J. Chem. Phys. 1961. V. 35. № 3. P. 788. https://doi.org/10.1063/1.1701217
Ubelis A.P. // J. Eng. Phys. 1982. V. 42. № 3. P. 309.
Hirayama C. // J. Phys. Chem. 1962. V. 66. № 8. P. 1563. https://doi.org/10.1021/j100814a519
Piacente V., Scardala P., Ferro D. // J. Alloys Comp. 1992. V. 178. № 1–2. P. 101. https://doi.org/10.1016/0925-8388(92)90251-4
Mio A.M., Privitera S.M.S., Bragaglia V. et al. // Nanotechnology. 2017. V. 28. P. 065706. https://doi.org/10.1088/1361-6528/28/6/065706
Гонсалес Р., Вудс Р. Цифровая обработка изображений. Москва: Техносфера, 2005. 1072 с.
Zhang R.L., Tang S.Z. // Ultrason. Sonochem. 2015. V. 22. P. 155. https://doi.org/10.1016/j.ultsonch.2014.06.021
Tigau N., Ciupina V., Prodan G. et al. // J. Cryst. Growth. 2004. V. 269. P. 392. https://doi.org/10.1016/j.jcrysgro.2004.05.052
Cebriano T., Mendez B., Piqueras J. // CrystEngComm. 2016. V. 18. № 14. P. 2541. https://doi.org/10.1039/C6CE00287K
Wang X., He M., Xi J., Lu X. // Microchem. J. 2011. V. 97. P. 4. https://doi.org/10.1016/j.microc.2010.05.011
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования


