Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2019, № 11, стр. 85-89
Поверхностная сегрегация состава в пленках нитрида галлия
Ю. Я. Томашпольский 1, *, В. М. Матюк 1, Н. В. Садовская 1
1 Научно-исследовательский физико-химический институт
им. Л.Я. Карпова
105064 Москва, Россия
* E-mail: tomashpols@yandex.ru
Поступила в редакцию 24.10.2018
После доработки 22.12.2018
Принята к публикации 14.01.2019
Аннотация
Исследованы микро- и наноморфология, локальный состав пленок нитрида галлия GaN, синтезированных по технологии MOCVD, с целью обнаружения сегрегационных явлений. В результате установлена сложная картина автосегрегации. В основной толстой (~15 мкм) пленке нитрида галлия выявлена поверхностная нестехиометрия химического состава (дефицит галлия), степень нестехиометрии (отклонение отношения ат. % Ga/ат. % N от единицы) составляет ~0.13, тогда как в глубине отклонение значительно меньше и составляет от 0.02 до 0.10. В то же время, в тонкой (~1 мкм) пленке наблюдается значительный избыток галлия, вплоть до отдельных нанокристаллитов металлического галлия. Обсуждается механизм сегрегации, который предположительно связан с селективной диффузией атомов азота либо галлия к поверхности и склонностью к коагуляции наноразмерных капель жидкого галлия.
ВВЕДЕНИЕ
Поверхностная автосегрегация химического и фазового состава многокомпонентных соединений, вызванная влиянием таких факторов как температура, давление, атмосфера, облучение и характер химических связей обусловливает изменения функциональных свойств на поверхности в сравнении с глубиной. В настоящее время стала очевидной важная роль в сегрегации поверхностных процессов, таких как диссоциация компонентов и их диффузия к поверхности, латеральная миграция, возгонка, адсорбция инородных атомов, в оптимизации условий синтеза материалов и их термической обработки, а также при эксплуатации готовых изделий [1]. Нитрид галлия, наряду с арсенидом галлия, используется в создании нового поколения светоизлучающих приборов и фотоприемников в видимой (белый, синий и фиолетовый цвета) и ближней УФ-области спектра, а также мощных высокочастотных высокотемпературных радиационно-стойких транзисторов [2–4]. При этом нитрид галлия находит широкое применение в виде пленок, свойства которых зависят от поверхностного состава и структуры.
Для всех наиболее распространенных методов получения пленок нитрида галлия характерным является высокотемпературное воздействие при синтезе (~1000°С), последующие отжиги (~700°С) и наличие газовой (азотной, аммиачной, металлоорганической) атмосферы, что служит существенным фактором для стимулирования процессов поверхностной автосегрегации, определяющей химический состав формирующихся пленок. Это также относится к методу химического осаждения из газовой фазы металлоорганических соединений (MOCVD) [5, 6]. Между тем в публикациях по технологиям получения пленок нитрида галлия систематические сведения о нестехиометрии химического состава, вызванной автосегрегацией в процессе синтеза и последующего термического и газового воздействий, практически отсутствуют.
Для получения качественных эпитаксиальных пленок нитрида галлия на инородных (например, кремниевых) подложках широко применяются буферные слои, обеспечивающие кристаллографическое согласование решеток. В качестве буферного промежуточного слоя применяются более тонкие (чем основная пленка) слои нитрида галлия. Представляют интерес возможные сегрегационные явления в таких слоях, которые могут оказывать влияние как на кристаллографические параметры буфера, так и на его физико-химические характеристики.
В данной работе проведены исследования локального состава и микро- и наноморфологии пленок нитрида галлия, полученных по технологии MOCVD с буферным слоем, с целью обнаружения сегрегационных явлений.
МЕТОДИЧЕСКАЯ ЧАСТЬ
Получение пленок GaN
Эпитаксиальные пленки нитрида галлия толщиной до 15 мкм выращены на химически очищенных монокристаллических кремниевых подложках (полированные срезы) c ориентацией {100}Si методом MOCVD при ростовой температуре 1000−1050°С. Реакционную смесь создавали в камере для выращивания, смесь содержит компонент металла группы (III), способный к реакционному взаимодействию с азотным компонентом таким образом, чтобы сформировать пленку нитрида металла группы (III) на нагретом объекте. Состав газовой фазы: триметилгаллий Ga(CH3)3 + аммиак NH3. Предварительно с целью формирования зародышевого слоя как части буфера, служащего матрицей для роста толстой целевой пленки, наносили буферный слой GaN толщиной порядка 1 мкм.
Скорость нанесения слоев: несколько мкм/ч. Полученные пленки подвергались отжигу при 760°С в атмосфере азота.
Методы характеризации
Элементный состав поверхностных микрослоев измеряли методом рентгеноспектрального микроанализа (РСМА) с помощью рентгеноспектральной приставки INCA в растровом электронном микроскопе JSM 7500F фирмы JEOL с модернизированной программой расчета поправок ZAF при энергии зонда 20 кэВ. Такая энергия обусловливает проникновение зонда в слои нитрида галлия на глубину 1−2 мкм, что составляет значение разрешения по толщине. Основой для анализа служили рентгеноспектральные пики GaK, NK, AsL, SiK, CK, OK.
При использовании энергодисперсионного анализатора на рентгеновские лучи в методе РСМА при значительном поверхностном загрязнении углеродом может возникать проблема энергетического разрешения пиков спектра NK и CK. Как правило, эти соседние пики в той или иной степени наложены друг на друга. Данная программа успешно выявляет азот на фоне углерода, при этом сама процедура формирования аналитического сигнала из интегральной интенсивности пиков рентгеновских спектров, в том числе их разделение при наложении, является ноу-хау фирмы-производителя, и в деталях аналитику неизвестна. Программа показывает уже обработанные после ZAF-поправок и итераций данные в виде таблиц весовых (массовых) и атомных концентраций определяемых элементов с указанием пропущенных (если таковые имеются). В целях дополнительной верификации фазового состава результаты измерения содержания азота мы сопоставляли с морфологическими формами фаз, визуализированными растровой электронной микроскопией. Для уменьшения погрешности применялся количественный метод РСМА, спектр CoKα металлического кобальта использовали в целях повышения точности измерений путем контроля тока зонда и энергетического смещения спектра. Практически дрейф тока не превышал 1% за 4−6 ч работы.
Концентрации элементов измеряли в мас. % и ат. %. Известно, что относительная погрешность определения концентрации методом РСМА в благоприятных случаях не превышает 1%, абсолютная погрешность целочисленного значения концентрации практически составляет 1−2 знака после запятой. Этой погрешности соответствуют данные по концентрациям, выдаваемые программой. Из этих значений рассчитывали отношение атомных концентраций составляющих элементов, далее по известным формулам находили погрешности для отношений.
Стехиометрию химического состава пленок GaN определяли как отношение атомных концентраций Ga/N. Точность анализа для отношения концентраций на морфологически гомогенной поверхности составляла ±0.01−0.1. Для морфологически гетерогенной поверхности производили локальные измерения. Площадь локальных участков измерений на кристаллах составляла от 1 × 1 до 250 × 250 мкм. В случае размеров выделений частиц поверхностных фаз, сравнимых или меньших диаметра электронного зонда (несколько мкм), значения отношения Ga/N носили оценочный характер, точность составляла ±0.1–1. Морфологию поверхности полированных срезов кристаллов изучали в растровом электронном микроскопе высокого разрешения JSM-7500F фирмы JEOL, обеспечивающего предельное разрешение до нескольких нм (метод ВРЭМ) при использовании катода с холодной полевой эмиссией. Энергия зонда составляла до 20 кэВ. Для морфологических исследований также использован оптический цифровой инвертированный металлографический микроскоп Eclipce MA100 фирмы NIKON (метод ОЦМ) с разрешением до 0.3 мкм, работающий в режиме отражения.
ЭКСПЕРИМЕНТАЛЬНЫЕ РЕЗУЛЬТАТЫ
Микро- и наноморфология поверхности пленок нитрида галлия, полученных на кремниевой подложке, показана на рис. 1. Пленки характеризуются относительно гладкой поверхностью, на которой наблюдаются в различной степени выраженные границы плотноупакованных параллельных микроблоков, составляющих основную пленку (область 1). В отдельных местах пленки находятся дефектные участки, представляющие собой выкрошенные вследствие растрескивания микроблоков, под которыми визуализируется буферный слой (область 2). Растрескивание вызвано релаксацией микронапряжений в результате окончательного отжига. В дефектных участках хорошо видны границы параллельных микроблоков и огранка их торцов, а также отдельные ограненные микрокристаллиты из внутренних участков пленки. Исследование этих кристаллитов и торцов блоков методом РСМА дало возможность оценки состава внутренних областей основной пленки, в то время как состав поверхностных слоев рассчитывали по рентгеновским спектрам от поверхности микроблоков. Толщина микроблоков, составляющих пленку, равная толщине основной пленки, определенная методом ОЦМ с применением дефокусировки, составляет ~15 мкм, ширина микроблоков ~15−30 мкм, а длина лимитирована размером подложки и протяженностью дефектных участков. На рис. 2 показана поверхность буферного слоя пленки. Анализ контраста тонкой структуры буферного слоя показывает наличие сплошной поверхности с включениями микронного и субмикронного размеров, имеющими вид микрокристаллитов с правильными гексагональными формами. Состав поверхности (ат. % Ga/ат. % N) основной и буферной пленок, полученных по технологии MOCVD, на участках размером 1 × 1, 2 × 2, 5 × 5, 14 × 14, 50 × 50 и 250 × × 250 мкм (глубина анализа 1−2 мкм) представлен в табл. 1.
Рис. 1.
Морфология поверхности основной пленки нитрида галлия, полученной по технологии MOCVD (область 1). Дефектный участок, визуализация буферного слоя (область 2). Метод ВРЭМ, линейный масштаб 10 мкм.
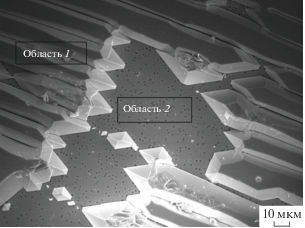
Рис. 2.
Растровая микрофотография поверхности пленки нитрида галлия (метод ВРЭМ, линейный масштаб 7 мкм), полученной по технологии MOCVD, с выделенными участками для элементного анализа (метод РСМА).
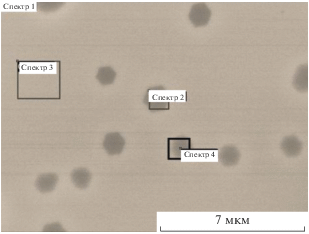
Таблица 1.
Локальный состав и морфология пленки нитрида галлия на кремниевой подложке
| № п/п участка |
Место анализируемых участков (метод ВРЭМ) | Количество анализируемых участков: их размер, мкм | Характеризация состава, ат. % Ga/ат. % N (метод РСМА) |
|---|---|---|---|
| Основная пленка, область 1 | |||
| 1 | Поверхность отдельного микрокристаллического блока | Два участка анализа: 50 × 50 и 250 × 250 | 0.87 ± 0.04 (усреднение по двум участкам анализа) |
| 2 | Отдельный микрокристалл из внутреннего слоя | Участок: 5 × 5 | 0.90 |
| 3 | Грани торцов микроблоков | Два участка: 5 × 5 | 0.98 ± 0.06 (усреднение по двум участкам анализа) |
| Буферная пленка, область 2 | |||
| 1 | Поверхность буферной пленки (спектр 1) | Участок: 14 × 14 | 5.53, следы Si |
| 2 | Поверхность буферной пленки (спектр 3) | Участок: 2 × 2 | 6.7, следы Si |
| 3 | Отдельный микрокристалл в буферной пленке (спектр 2) | Участок: 1 × 1 | 36.4, следы Si |
| 4 | Отдельный микрокристалл в буферной пленке (спектр 4) | Участок: 1 × 1 | 100% Ga |
Как следует из данных методов ВРЭМ и РСМА, пленки GaN, полученные методом MOCVD, имеют сложную двухслойную морфологию с качественно различными видами нестехиометрии. Основная пленка имеет среднюю толщину до 15 мкм и состоит из монокристаллических параллельных микроблоков с визуализируемыми границами. Состав поверхности основной пленки имеет заметный дефицит галлия (отношение Ga/N ~ 0.8), при этом во внутренних слоях дефицит уменьшен: отношение Ga/N составляет 0.90−0.98. Иная картина наблюдается в буферном слое, тотальный состав которого характеризуется значительным избытком галлия, а локальный состав гексагональных микрокристаллов содержит до 100% галлия. Кроме того, вследствие малой толщины буферной пленки (~1 мкм) методом РСМА выявляется элемент подложки (кремний).
ОБСУЖДЕНИЕ РЕЗУЛЬТАТОВ
Сравним поверхностный состав арсенида галлия, изменяющийся в результате термостимулированной сегрегации в воздушной или азотной атмосфере [7, 8] с поверхностной сегрегацией в нитриде галлия. Независимо от газовой среды, начиная с температуры отжига 500°С, на поверхности арсенида галлия активируются процессы диссоциации арсенида галлия, диффузии мышьяка к поверхности и его возгонка, вследствие чего после отжига на поверхности арсенида галлия появляются ориентированные индивидуальные частицы размером порядка 10 нм, идентифицируемые как фаза галлия (отношение Ga/As = = 1.10 ± 0.03 для гетерофазной поверхности галлий-арсенид галлия). После отжига при температуре 600°С происходит разориентация и увеличение размера частиц галлия до ~30 нм (отношение Ga/As = 1.5 ± 0.1). После отжига при 750°С размер частиц галлия увеличивается до ~200 нм (отношение Ga/As = 2.4 ± 0.1), при этом плотность заполнения поверхности частицами галлия возрастает. В воздушной среде параллельно начинается окисление фазы галлия, о чем свидетельствует рост концентрации связанного кислорода по данным РСМА, появление частиц более светлого контраста по данным ВРЭМ, а также визуально наблюдаемое окрашивание поверхности монокристалла в белый цвет. При более высоких температурах отжига проходят процессы рекристаллизации и дальнейшего окисления галлия. После отжига при 950°С из индивидуальных изотропных наночастиц образуется новая поверхностная структура в виде сплошного морфологически гомогенного слоя, состоящего из пластинчатых кристаллитов оксида галлия с латеральным размером пластин до 5 мкм и толщиной менее 1 мкм (отношение Ga/As = 5.40 ± 0.04). Наконец, отжиг при 1050°С радикально реконструирует поверхность арсенида галлия, формируя слой толще 1 мкм, имеющий морфологически гомогенную цепочечную структуру ограненных кристаллитов оксида галлия с размером 100−500 нм (отношение Ga/As > 150 ± 1).
В азотной газовой среде процессы проходят аналогично, за исключением масштабного окисления. В итоге поверхность арсенида галлия покрыта пленкой жидкого галлия, при остывании происходит кристаллизация галлия и образование тонкого сплошного слоя галлия с отдельными включениями частиц оксида галлия за счет остаточного кислорода. Таким образом, при термостимулированной автосегрегации на поверхности арсенида галлия формируется слой металлического галлия.
Рассмотрим поверхностную сегрегацию в нитриде галлия. Как видно из табл. 1, в слоях толщиной до 15 мкм выявлена поверхностная нестехиометрия химического состава (дефицит галлия), степень нестехиометрии (отклонение ат. % Ga/ ат. % N от единицы) составляет ~0.13. В глубине нестехиометрия заметно меньше и составляет от 0.02 до 0.1. Механизм сегрегации предположительно связан с двумя факторами: преимущественной селективной диффузией атомов азота к поверхности и адсорбцией азота в результате термической постобработки.
Иная картина наблюдается в тонком (порядка мкм) буферном слое нитрида галлия, тотальный состав которого характеризуется значительным избытком галлия, а локальный состав гексагональных микрокристаллитов содержит до 100% галлия. Механизм такого поведения нитрида галлия может быть объяснен по аналогии с сегрегацией в арсениде галлия. При умеренных для нитрида галлия температурах начинается преимущественная диффузия атомов азота к поверхности (радиус атома азота вдвое меньше, чем галлия), что, наряду с адсорбцией азота, обусловливает поверхностный дефицит галлия в толстом слое нитрида галлия. Однако в более тонких слоях вследствие более “рыхлой” дефектной структуры диффузия атомов галлия при прочих равных условиях становится сравнимой с диффузией атомов азота, а склонность наноразмерных капель жидкого галлия к коагуляции в капли жидкости (Тплавл ~ 30°C) приводит после охлаждения к кристаллизации слоя, обогащенного галлием, вплоть до формирования отдельных кристаллитов галлия, подобно процессу в арсениде галлия. Тот же эффект следует ожидать и в толстых слоях нитрида галлия при более высоких температурах.
ЗАКЛЮЧЕНИЕ
В пленках нитрида галлия GaN, синтезированных по технологии MOCVD, обнаружена сложная картина автосегрегации. В толстой пленке нитрида галлия (~15 мкм) выявлена поверхностная нестехиометрия химического состава (дефицит галлия), степень нестехиометрии составляет ~0.13, тогда как в глубине пленки отклонение от стехиометрии значительно меньше и составляет от 0.02 до 0.10. В тонкой (~1 мкм) пленке имеется значительный избыток галлия вплоть до отдельных нанокристаллитов металлического галлия. Механизм сегрегации предположительно связан с селективной диффузией атомов азота либо галлия к поверхности и склонностью к коагуляции наноразмерных капель жидкого галлия.
Список литературы
Томашпольский Ю.Я. Поверхностная автосегрегация в химических соединениях. М.: Научный мир, 2013. 208 с.
Акчурин Р.Х., Мармалюк А.А. // Материаловедение. 1999. № 9. С. 950.
Okumura H. // Jpn. J. Appl. Phys. 2006. P. 7565.
Khanna S.M., Webb J., Tang H., Houdayer A.J., Carlone C. // IEEE Trans. Nucl. Sci. 2000. V. 47. P. 2322.
Pierson H.O. Handbook of Chemical Vapor Deposition (CVD): Properties, Technology and Applicatioons. N.Y., 1992. 235 p.
Matlox Donald M. Handbook of Physical Vapor Deposition (PVD): Processing Film Formation, Adhesion, Surface Preparation and Contamination Control. Westwood, N.J.: NoyesPublication. 1998. 943 p.
Томашпольский Ю.Я., Садовская Н.В., Григорьева Г.А. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2013. № 9. С. 95. https://doi.org/10.7868/S0207352815060219
Томашпольский Ю.Я., Матюк В.М., Садовская Н.В. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2015. № 6. С. 60. https://doi.org/10.7868/S0207352813090175
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования


