Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2019, № 12, стр. 20-24
Зависимость кинетики радиационного дефектообразования от энергии, поглощенной в Si и SiC, при воздействии быстрых заряженных частиц
В. В. Козловский 1, *, А. Э. Васильев 1, **, В. В. Емцев 2, ***, Г. А. Оганесян 2, ****, А. А. Лебедев 2, *****
1 Санкт-Петербургский политехнический университет Петра Великого
195251 Санкт-Петербург, Россия
2 Физико-технический институт им. А.Ф. Иоффе Российской академии наук
194021 Санкт-Петербург, Россия
* E-mail: kozlovski@physics.spbstu.ru
** E-mail: electronych@mail.ru
*** E-mail: emtsev@mail.ioffe.ru
**** E-mail: gagik.oganesyan@mail.ioffe.ru
***** E-mail: shura.lebe@mail.ioffe.ru
Поступила в редакцию 18.12.2018
После доработки 04.03.2019
Принята к публикации 15.03.2019
Аннотация
Проанализирована кинетика образования радиационных дефектов в кремнии и карбиде кремния как функция поглощенной энергии. Экспериментально изучена дозная зависимость концентрации электронов проводимости в n-Si и n-SiC при облучении электронами с энергией 0.9 МэВ и протонами с энергией 15 МэВ. Обсуждаются преимущества и недостатки использования в качестве кинетических параметров интегрального потока (флуенса) и поглощенной энергии. В ходе проведенных исследований было установлено, что представление кинетики радиационного дефектообразования как функции флуенса облучающих частиц нагляднее для табулирования требований стойкости аппаратуры в соответствующих условиях. Для изучения физических процессов, лежащих в основе радиационного дефектообразования в полупроводниках, удобнее использовать зависимости наблюдаемых при облучении эффектов, как функции поглощенной энергии.
ВВЕДЕНИЕ
Процессы образования радиационных дефектов в полупроводниках в последнее время изучаются очень интенсивно. Это связано как с необходимостью функционирования приборов в экстремальных условиях [1–3], так и с развитием полупроводниковых технологий, непосредственно использующих радиационные дефекты [4–6]. Кинетические зависимости наблюдаемых эффектов, как правило, описываются дозными кривыми. Здесь могут использоваться интегральный поток или флуенс Φ, измеряемый в частицах, попавших на единицу поверхности образца. Может использоваться и поглощенная доза D, измеряемая в единицах энергии, поглощенной единичной массой вещества. В известных нам работах по образованию радиационных дефектов в кремнии и карбиде кремния при облучении электронами и протонами использовались либо один вид доз, либо другой [7–11].
В настоящей работе нами предпринята попытка представить кинетические характеристики как функции обоих видов доз облучения, а также провести сравнительный анализ преимуществ и недостатков каждого вида представлений.
Для анализа в качестве облучающих частиц использовались электроны с энергией 0.9 МэВ и протоны с энергией 15 МэВ. Выбор частиц и энергий обусловлен возможностью экспериментальной проверки расчетных данных на ускорителях СПбПУ Петра Великого. Результаты по кремнию дополнительно анализировались для пучка гамма-квантов со средней энергией 1.25 МэВ, источником которых являлись атомы 60Co (гамма-установка К-120000).
ОЦЕНКА ЭФФЕКТИВНОСТИ ПОГЛОЩЕННОЙ ЭНЕРГИИ ДЛЯ РАЗЛИЧНЫХ ВИДОВ ИЗЛУЧЕНИЙ
Электронное облучение
Кремний. Сначала оценим связь между флуенсом и поглощенной дозой облучения для элементарного полупроводника – кремния. В качестве модельного образца возьмем квадратную пластинку со стороной 1 см и стандартной (для кремниевой электроники) толщиной 250 мкм. Приведенные (или массовые) тормозные потери энергии (1/ρ)( dE/dx) электронов с энергий 0.9 МэВ в кремнии составляют 1.65 МэВ/(г/см2) [12], линейные тормозные потери dE/dx (при известной плотности кремния ρ = 2.33 г/см3) равны 0.38 кэВ/мкм. При прохождении пластины электроны теряют ~10% своей энергии (96 кэВ) и на выходе из пластины имеют энергию ~0.8 МэВ. Масса кремниевого образца вышеуказанных размеров составляет 0.0575 г. Тогда поглощенная доза составит 96 кэВ/0.0575 г = 2.6 × 10–10 Дж/кг. На практике вместо сравнительно новой единицы Грэй (Гр), равной 1 Дж/кг, чаще используется единица 1 Мега рад (Мрад), равная 10 кГр.
Таким образом, один электрон с энергией 0.9 МэВ передает пластине кремния энергию равную 2.6 × 10–14 Мрад. Чтобы получить в кремнии дозу, равную 1 Мрад, необходим флуенс, равный 3.8 × 1013 см–2. Заметим, что это соотношение слабо зависит от энергии электронов. Так, при увеличении энергии в 5 раз, флуенс уменьшается всего на 10%. Значительно сильнее влияет толщина используемых образцов. Рассмотрим это на примере образцов, толщина которых сравнима с экстраполированным пробегом электронов (максимальной глубине проникновения). Для кремния, как и для алюминия, массовый пробег электронов [(1/ρ)(R)] можно оценить, используя эмпирическую формулу [13]:
(1)
$({1 \mathord{\left/ {\vphantom {1 \rho }} \right. \kern-0em} \rho })R({{{\text{мг}}} \mathord{\left/ {\vphantom {{{\text{мг}}} {{\text{с}}{{{\text{м}}}^{2}}}}} \right. \kern-0em} {{\text{с}}{{{\text{м}}}^{2}}}}) = 526Е({\text{МэВ}}) - 94.$Согласно этой формуле для энергии электронов 0.9 МэВ массовый пробег составляет 380 мг/см2, а линейный пробег R = 1.6 мм. Увеличение толщины образца примерно в 6 раз приводит к увеличению поглощенной энергии на порядок. Таким образом, флуенс, необходимый для получения поглощенной дозы в 1 Мрад в толстых образцах кремния, уменьшается в 1.5 раза до величины 2.6 × 1013 см–2.
Карбид кремния. В том случае, когда тормозящая среда представляет собой химическое соединение нескольких элементов, справедливо правило Брэгга. Согласно этому правилу, тормозная способность сложного вещества равна взвешенной сумме тормозных способностей составляющих элементов. Для карбида кремния приведенные тормозные способности обоих элементов (углерода и кремния) близки и составляют величину порядка 1.65 МэВ/(г/см2). Очевидно, что и для карбида кремния можно принимать эту величину. Равенство тормозных способностей двух полупроводников приводит и к одинаковому критерию связи флуенса и поглощенной дозы. Или, чтобы получить поглощенную дозу в карбиде кремния, равную 1 Мрад, необходима экспозиционная доза (флуенс), равная 3.8 × 1013 см–2.
Оценим экстраполированный пробег электронов с энергией 0.9 МэВ в карбиде кремния. Вначале определим R в углероде. В силу слабой зависимости массового пробега от вещества, используется следующая формула:
(2)
${{{{R}_{{\text{C}}}}} \mathord{\left/ {\vphantom {{{{R}_{{\text{C}}}}} {{{\rho }_{{\text{C}}}}}}} \right. \kern-0em} {{{\rho }_{{\text{C}}}}}} = ({{{{R}_{{{\text{Al}}}}}} \mathord{\left/ {\vphantom {{{{R}_{{{\text{Al}}}}}} {{{\rho }_{{{\text{Al}}}}}}}} \right. \kern-0em} {{{\rho }_{{{\text{Al}}}}}}}){\text{ }}{{({Z \mathord{\left/ {\vphantom {Z A}} \right. \kern-0em} A})}_{{{\text{Al}}}}}{{({Z \mathord{\left/ {\vphantom {Z A}} \right. \kern-0em} A})}_{{\text{C}}}}.$Согласно этой формуле, массовый пробег в углероде с большой точностью совпадает с пробегом в алюминии и кремнии и составляет 380 мг/см2. При расчетах пробегов в сложных полупроводниковых соединениях обычно используется формула [13]:
(3)
$\begin{gathered} {1 \mathord{\left/ {\vphantom {1 {({R \mathord{\left/ {\vphantom {R \rho }} \right. \kern-0em} \rho })}}} \right. \kern-0em} {({R \mathord{\left/ {\vphantom {R \rho }} \right. \kern-0em} \rho })}} = {{{{\omega }_{1}}} \mathord{\left/ {\vphantom {{{{\omega }_{1}}} {({{{{R}_{1}}} \mathord{\left/ {\vphantom {{{{R}_{1}}} {{{\rho }_{1}}}}} \right. \kern-0em} {{{\rho }_{1}}}})}}} \right. \kern-0em} {({{{{R}_{1}}} \mathord{\left/ {\vphantom {{{{R}_{1}}} {{{\rho }_{1}}}}} \right. \kern-0em} {{{\rho }_{1}}}})}} + \\ + \,\,{{{{\omega }_{2}}} \mathord{\left/ {\vphantom {{{{\omega }_{2}}} {({{{{R}_{2}}} \mathord{\left/ {\vphantom {{{{R}_{2}}} {{{\rho }_{2}}}}} \right. \kern-0em} {{{\rho }_{2}}}})}}} \right. \kern-0em} {({{{{R}_{2}}} \mathord{\left/ {\vphantom {{{{R}_{2}}} {{{\rho }_{2}}}}} \right. \kern-0em} {{{\rho }_{2}}}})}} + ... + {{{{\omega }_{n}}} \mathord{\left/ {\vphantom {{{{\omega }_{n}}} {({{{{R}_{n}}} \mathord{\left/ {\vphantom {{{{R}_{n}}} {{{\rho }_{n}}}}} \right. \kern-0em} {{{\rho }_{n}}}})}}} \right. \kern-0em} {({{{{R}_{n}}} \mathord{\left/ {\vphantom {{{{R}_{n}}} {{{\rho }_{n}}}}} \right. \kern-0em} {{{\rho }_{n}}}})}}, \\ \end{gathered} $где (R/ρ) − массовый пробег в химическом соединении; (R1/ρ1), (R2/ρ2) … (Rn/ρn) – массовые пробеги в отдельных элементах, входящих в состав сложного вещества; ω1, ω2, … ωn − относительные доли элементов в соединении (по массе). Поскольку в нашем случае пробеги в массовых единицах совпадают, то можно утверждать, что массовый пробег и в карбиде кремния составляет 380 мг/см2. Учитывая плотность карбида кремния (3.22 г/см3), можно сосчитать и экстраполированный линейный пробег электронов с энергией 0.9 МэВ в SiC: он составил 1.2 мм.
Протонное облучение
Кремний. Проведем вычисления для протонов с энергией 15 МэВ. Здесь точнее использовать численные расчеты с применением известного пакета программ TRIM [14]. Согласно этим расчетам, приведенные тормозные потери энергии протонов в кремнии составляют 25.4 МэВ/(г/см2), а линейные потери – 5.9 кэВ/мкм. При прохождении пластины протоны потеряют энергию, равную 1500 кэВ, и на выходе из пластины имеют энергию 13.5 МэВ. Тогда поглощенная доза составит 1500 кэВ/0.0575 г = 4.1 × 10–9 Дж/кг. Таким образом, один протон с энергией 15 МэВ передает пластине кремния энергию, равную 4.1 × 10–13 Мрад. Или, чтобы получить дозу, равную 1 Мрад, необходим флуенс протонов, равный 2.5 × 1012 см–2. В табл. 1 представлены коэффициенты для пересчета поглощенной дозы во флуенс, линейные тормозные потери энергии и экстраполированные линейные пробеги частиц для случая облучения Si и SiC различными частицами.
Таблица 1.
Коэффициенты для пересчета поглощенной дозы во флуенс, линейные тормозные потери энергии и экстраполированные линейные пробеги частиц для случая облучения Si и SiC различными частицами
| Кремний | Карбид кремния | ||||
|---|---|---|---|---|---|
| Бомбардирующие частицы |
dE/dx, кэВ/мкм | Rp, мм | F/D, см–2/Мрад | dE/dx, кэВ/мкм | Rp, мм |
| Протоны, 15 МэВ | 5.9 | 1.44 | 2.5 × 1012 | 8.6 | 0.98 |
| Электроны, 0.9 МэВ | 0.38 | 1.6 | 3.8 × 1013 | 0.53 | 1.2 |
| Гамма-кванты, 1.25 МэВ | − | − | 1.8 × 1015 | − | − |
Карбид кремния. Согласно расчетам, приведенные тормозные потери энергии протонов в карбиде кремния составляют 26.2 МэВ/(г/см2), а линейные потери – 8.6 кэВ/мкм. Равенство приведенных тормозных способностей двух полупроводников приводит и к одинаковому критерию связи флуенса и поглощенной дозы. Или, чтобы получить поглощенную дозу в карбиде кремния, равную 1 Мрад, необходим флуенс протонов, равный 2.5 × 1012 см–2.
Гамма-облучение
Как известно, изменение интенсивности потока гамма-квантов от J0 до J при прохождении через вещество толщиной x подчиняется закону Бугера−Ламберта−Бера:
где μ − коэффициент ослабления (или точнее, линейный коэффициент поглощения).
В элементарных актах взаимодействия гамма-квантов с веществом часть энергии первичного излучения преобразуется в кинетическую энергию электронов, а часть – в энергию вторичного фотонного излучения. Это позволяет полный коэффициент ослабления представить в виде суммы двух коэффициентов:
где τ и σ − соответственно части коэффициента ослабления, определяющие преобразование энергии фотонов в кинетическую энергию электронов и вторичного фотонного излучения (характеристическое излучение, рассеянные фотоны, аннигиляционное излучение). Коэффициент τ называют коэффициентом поглощения энергии излучения. Он определяет долю энергии гамма-квантов, передаваемую электронам в слое вещества толщиной 1 см. В справочниках чаще приводятся значения массовых коэффициентов поглощения (τ/ρ). Так, в известном обзоре [15] для кремния приводится значение (τ/ρ) = 0.027 см2/г. При малых толщинах вещества экспоненту в формуле (4) можно разложить в ряд. Так, что относительная доля поглощенной энергии становится равной произведению τx. Для наших образцов, толщиной 250 мкм, относительная доля поглощенной энергии составит всего 0.16%. Таким образом, 1 квант с энергией 1.25 МэВ оставит в образце 2 ×103 эВ или 3.2 × 10–16 Дж. Поглощенная доза от 1 кванта в нашем образце массой 0.0575 г составит 5.6 × 10–12 Гр или 5.6 × 10–16 Мрад. Чтобы получить дозу, равную 1 Мрад, необходим флуенс гамма-квантов, равный 1.8 × 1015 см–2. Для карбида кремния массовый коэффициент поглощения, рассчитанный по правилу Брэгга, оказался близок к значению для кремния, так как значения (τ/ρ) для углерода и кремния близки и составляют величину порядка 0.03 см2/г [16].
ЭКСПЕРИМЕНТАЛЬНЫЕ РЕЗУЛЬТАТЫ И ОБСУЖДЕНИЕ
Слиток кремния, из которого изготовлялись образцы, был выращен по методу бестигельной зонной плавки. Остаточное содержание кислорода не превышало 4 × 1016 см–3. Основной легирующей примесью, обеспечивающей электронный тип проводимости, являлся фосфор, концентрация которого составляла (6−8) × 1015 см–3. Образцы квадратной формы вырезались из пластин толщиной 250 мкм. В качестве образцов карбида кремния использовались диоды Шоттки на основе 4H-SiC производства фирмы CREE (США) [17] с напряжениями пробоя 600 В. Концентрация не скомпенсированной донорной примеси (Nd – Na) в исходных приборах до облучения составляла (6.5–7.5) × 1015 см–3. Условия облучения и методика измерения электрофизических параметров образцов, использованные в настоящей работе, подробно описаны в работах [18–20]. На рис. 1 представлена зависимость концентрации электронов проводимости в кремнии в зависимости от дозы облучения (irradiation dose) электронами, протонами и гамма-квантами. На рис. 2 аналогичная зависимость представлена для карбида кремния. Уменьшение концентрации электронов проводимости обусловлено образованием точечных радиационных дефектов, создающих глубокие центры. Концентрация удаленных носителей заряда непосредственно коррелирует с концентрацией созданных радиационных дефектов. Оценим из начальных участков дозных зависимостей скорость удаления электронов проводимости:
(5)
${{\eta }_{D}} = {{({{N}_{0}}--N)} \mathord{\left/ {\vphantom {{({{N}_{0}}--N)} D}} \right. \kern-0em} D},$Рис. 1.
Зависимость концентрации носителей заряда в n-Si от дозы поглощенной энергии для протонного (1) − кружки, электронного (2) – квадраты и гамма-облучения (2) − треугольники.
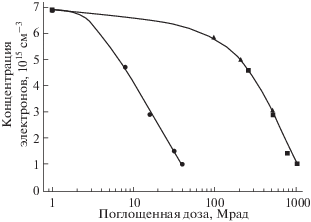
Рис. 2.
Зависимость концентрации носителей заряда в n-4H–SiC от дозы поглощенной энергии для протонного (1) и электронного (2) облучения.
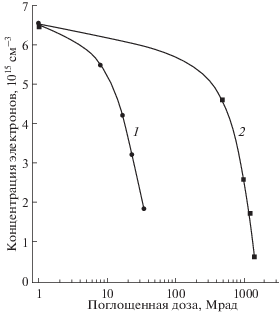
где N0 и N – концентрации носителей заряда в эпитаксиальном слое до и после облучения, D – доза облучения. В табл. 2 приведены полученные значения ηD для кремния и карбида кремния. Для сравнения в табл. 2 приведены аналогичные скорости ηF, рассчитанные на одну падающую частицу (при таком расчете в знаменателе формулы (5) находится флуенс бомбардирующих частиц) Ф.
Таблица 2.
Значения скоростей удаления электронов проводимости в кремнии и карбиде кремния при облучении различными частицами
| Кремний | Карбид кремния | |||
|---|---|---|---|---|
| Бомбардирующие частицы |
ηD, см–3/Мрад | ηF, см–1 | ηD, см–3/Мрад | ηF, см–1 |
| Протоны, 15 МэВ | 2.75 × 1014 | 110 | 1.4 × 1014 | 50−60 |
| Электроны, 0.9 МэВ | 0.87 × 1013 | 0.23 | 0.4 × 1013 | 0.1 |
| Гамма-кванты, 1.25 МэВ | 0.90 × 1013 | 5.2 × 10–3 | − | − |
Используя данные табл. 2, попробуем ответить на вопросы:
1) насколько 1 протон эффективнее 1 электрона;
2) насколько 1 Джоуль от протонного облучения эффективнее 1 Джоуля от электронного облучения.
Используя данные для ηF, приведенные во второй и четвертой колонке табл. 2, можно утверждать, что для обоих полупроводников протонное облучение эффективнее электронного примерно в 500 раз. Эти цифры нагляднее для расчета стойкости соответствующей аппаратуры. Однако для оценки физики радиационного дефектообразования более правильно использовать значения ηD. Согласно данным первой и третьей колонки табл. 2, при одинаковом энерговыделении протонный пучок эффективнее электронного всего в 30 раз. Наши расчеты, проведенные для протонов по программе TRIM [14], показали, что упругие (ядерные) потери энергии в кремнии составляют 1.24 × 10–2 МэВ/(г/см2), а неупругие (электронные) в 2000 раз больше: 25.4 МэВ/(г/см2). Для электронного облучения, судя по данным табл. 2, это соотношение увеличивается еще в 30 раз.
Интересно сравнить эффективность электронного и гамма-излучений. Действие гамма-квантов 60Co, имеющих энергии 1.17 и 1.33 МэВ (средняя энергия 1.25 МэВ) практически полностью сводится к созданию комптон-электронов. Согласно данным табл. 2 (колонка 2), электроны по флуенсу эффективнее гамма-квантов примерно в 50 раз. Однако, сравнивая радиационное дефектообразование при одинаковом энерговыделении (колонка 1), можно сказать, что эффективности гамма-квантов и электронов совпадают с большой точностью. Причиной такого совпадения является средняя энергия комптон-электронов. Максимальная энергия комптон-электронов при использовании изотопа 60Co составляет 0.96 МэВ. Однако таких высокоэнергичных электронов в спектре комптон-электронов совсем немного. Максимум же распределения комптон-электронов по энергии приходится на энергию 660 кэВ [21, 22]. Поскольку сечение радиационного дефектообразования в интервале энергий электронов 600–900 кэВ практически не меняется, то облучение комптон-электронами со средней энергией 660 кэВ и моноэнергетичный электронами с энергией 900 кэВ можно считать идентичными.
ЗАКЛЮЧЕНИЕ
В ходе проведенных исследований было установлено, что представление кинетики радиационного дефектообразования как функции флуенса облучающих частиц нагляднее для табулирования требований стойкости аппаратуры в соответствующих условиях. Для изучения физических процессов, лежащих в основе радиационного дефектообразования в полупроводниках, удобнее использовать зависимости наблюдаемых при облучении эффектов, как функции поглощенной энергии.
Список литературы
Lebedev A.A. Radiation Effects in Silicon Carbide, Material Research Forum LLC, Millersville, PA 17551, USA, V. 6 (2017).
Clays C., Simon E. Radiation Effects in Advanced Semiconductor Materials and Devices. Berlin: Springer–Verlag, 2002. 401 p.
Strel'chuk A.M., Kozlovski V.V., Savkina N.S. et al. // Mater. Sci. Engin. B. 1999. V. 61–62. P. 441. https://doi.org/10.1016/S0921-5107(98)00551-0
Radiation Defect Engineering. Selected Topics in Electronics and Systems. V. 37. / Ed. Kozlovski V., Abrosimova V. Singapore: World Scientific Publ., 2005. 264 p.
Lutz J., Schlangenotto H., Scheuermann U., Rik De Doncker. Semiconductor Power Devices Physics. Characteristics, Reliability. Berlin Heidelberg: Springer-Verlag, 2011. P. 58.
Strokan N.B., Ivanov A.M., Savkina N.S. et al. // Semiconductors. 2004. V. 38. P. 807.
Козловский В.В., Васильев А.Э., Лебедев А.А. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2015. № 3. С. 22. (Kozlovski V.V., Vasil’ev A.E., Lebedev A.A. // J. Surf. Invest.: X-ray, Synchrotron Neutron Tech. 2015. V. 9. № 2. P. 231.) https://doi.org/10.1134/S102745101502012310, https://doi.org/7868/S0207352815030129
Castaldini A., Cavallini A., Rigutti L. et al. // Appl. Phys. Lett. 2004. V. 85. P. 3780.
Lebedev A.A., Veinger A.I., Davydov D.V. et al. // Semiconductors. 2000. V. 34. № 8. P. 861. https://doi.org/10.1134/1.1188089
Vobecký J., Pavel Hazdra P., Popelka S., Sharma K.R. // IEEE Transaction on Electron Devices. 2015. V. 62. № 6. P. 1964.
Козловский В.В., Васильев А.Э., Емцев В.В., Лебедев А.А. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2014. № 9. С. 101. (Kozlovski V.V., Vasil’ev A.E., Emtsev V.V., Lebedev A.A. // J. Surf. Invest.: X-ray, Synchrotron Neutron Tech. 2014. V. 8. № 2. P. 950.) https://doi.org/10.1134/S102745101405010310, https://doi.org/7868/S0207352814090108
Corbett J.W., Bourgoin J.C. In: Point Defects in Solids, V. 2. Semiconductors and Molecular Crystals / Ed. Crawford J.H., Slifkin L.M. New York and London: Plenum Press, 1975. P. 1.
Interaction of radiation with solids and elementary defect production: By Chrhr. Lehmann, Amsterdam: North-Holland, 1977. 341 p.
Ziegler J.F., Biersack J.P., Littmark U. The Stopping and Range of Ions in Solids. New York: Pergamon, 1985. 342 p.
Beringer J., Arguin J.-F., Barnett R.M et al. (Particle Data Group) // Phys. Rev. D. 2012. V. 86. P. 010001.
Kuchling H. Physik. Nachschlagebucher fur Grundlagenfacher. Leipzig: VEB Fachbuchverlag, 1980. P. 482.
http://cree.com/
Zakharenkov L.F., Kozlovski V.V., Shustrov B.A. // Phys. Stat. Sol. A. 1990. V. 117. № 1. P. 85. https://doi.org/10.1002/pssa.2211170107
Davydov D.V., Lebedev A.A., Kozlovski V.V. et al. // Physica B. Condensed Matterials. 2001. V. 308. P. 641.
Lebedev A.A., Veinger A.I., Davydov D.V. et al. // Semiconductors. 2000. V. 34. № 9. P. 1016.
Van Lint V.A.J. Mechanisms of Radiation Effects in Electronic Materials. N.Y.: John Wiley & Sons Inc., 1980. 359 p.
Kozlovski V.V., Lebedev A.A., Bogdanova E.V. // J. Appl. Phys. 2015. V. 117. P. 155702.
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования


