Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2019, № 2, стр. 42-48
Исследование протяженных электрически активных дефектов в гетероструктурах на основе соединений (Ga,Mn)As/(In,Ga)As методами наведенного тока и релаксационной спектроскопии глубоких уровней
О. А. Солтанович 1, *, В. А. Ковальский 1, П. С. Вергелес 1, М. В. Дорохин 2, Ю. А. Данилов 2
1 Институт проблем технологии микроэлектроники РАН,
142432 Черноголовка, Россия
2 Научно-исследовательский физико-технический институт
Нижегородского государственного университета им. Н.И. Лобачевского,
603950 Нижний, Новгород, Россия
* E-mail: solt@iptm.ru
Поступила в редакцию 20.02.2018
После доработки 20.02.2018
Принята к публикации 20.02.2018
Аннотация
Методами наведенного тока и релаксационной спектроскопии глубоких уровней исследованы электрически активные дефекты в гетероэпитаксиальных структурах (Ga,Mn)As/(In,Ga)As/GaAs – как в эпитаксиальных слоях GaAs и InGaAs, так и вблизи границ раздела. На изображениях, полученных методом наведенного тока, наблюдаются протяженные дефекты не только вблизи границы раздела GaAs–InGaAs, но и во всем объеме слоя InGaAs, практически до его верхней границы. В исследованных структурах выявлены два глубоких уровня в нижней половине запрещенной зоны (EV +0.50 и +0.65 эВ), которые могут быть связаны с протяженными дефектами. Обсуждается возможная связь глубоких уровней с протяженными рекомбинационно-активными дефектами, обнаруженными методом наведенного тока.
ВВЕДЕНИЕ
Большинство приборов современной микро- и наноэлектроники разрабатывается на основе гетероэпитаксиальных структур, которые часто представляют собой системы с малым рассогласованием параметров кристаллических решеток. Одной из таких систем является пара соединений типа A3B5 – GaAs/(In,Ga)As, входящая в состав многих приборных структур, и в частности структур, актуальных для приложений магнитооптики и спинтроники. Рассогласование параметров решеток приводит, как правило, к формированию на поверхности гетероструктур регулярных неоднородностей, обозначаемых как перекрестно-штриховая морфология [1, 2]. Формирующийся рельеф поверхности, с одной стороны, может обусловливать неоднородность оптических и магнитных свойств и существенно сказываться на параметрах получаемых приборов, их стабильности и воспроизводимости. С другой стороны, понимание и управление механизмами формирования перекрестно-штриховой морфологии в перспективе может позволить регулировать ее возникновение на поверхности структуры, либо направленно использовать ее для создания виртуальных искусственных подложек с контролируемыми упругими напряжениями для задач стрейнтроники.
На настоящий момент существует несколько предположений о природе перекрестно-штриховой морфологии и возможных механизмах ее формирования [3–6], однако полностью удовлетворительного объяснения пока не предложено. Большинство работ предполагает корреляцию перекрестно-штриховой морфологии с дислокациями несоответствия, возникающими на границе раздела между слоями GaAs и InGaAs гетероструктуры при частичной релаксации напряжений сжатия в растущем слое InGaAs. Так, например, в [7] на образцах GaAs/InGaAs была показана корреляция (практически “один в один”) между сеткой ортогональных линий, наблюдаемой в растровом электронном микроскопе (РЭМ) в режиме наведенного тока, и рельефом поверхности, полученным методом атомно-силовой микроскопии (АСМ). Авторы однозначно приписывают наблюдаемый в режиме наведенного тока контраст дислокациям несоответствия на границе раздела слоев структуры. В то же время недавно [8] было показано, что в гетероструктурах (Ga,Mn)As/(In,Ga)As/GaAs особенности контраста сигнала наведенного тока в виде сетки характерных, расположенных вдоль направлений 〈110〉 линий, которые соответствуют протяженным рекомбинационно-активным дефектам, наблюдаются не только вблизи границы раздела GaAs–InGaAs, но и по всей толщине буферного слоя InGaAs.
Несомненно, обнаруженные электрически активные дефекты требуют тщательного изучения и анализа, поскольку могут играть важную роль для понимания процессов, происходящих в буферных слоях гетероструктуры, и механизмов формирования перекрестно-штриховой морфологии на поверхности слоев. Особенно эффективным представляется комплексное использование нескольких методов, например, методов наведенного тока и релаксационной спектроскопии глубоких уровней. Метод наведенного тока позволяет визуализировать дефекты и оценить их рекомбинационную активность, а метод релаксационной спектроскопии глубоких уровней – определить их параметры, такие как энергия активации глубокого уровня, эффективное сечение захвата носителей, что существенно для идентификации наблюдаемых дефектов.
В настоящей работе представлены результаты исследования электрически активных дефектов в гетероэпитаксиальных структурах (Ga,Mn)As/ (In,Ga)As/GaAs методами наведенного тока и релаксационной спектроскопии глубоких уровней. Подобные структуры представляют интерес для приложений спинтроники и активно изучаются в настоящее время. Были исследованы образцы с эпитаксиальными слоями разного типа и уровня легирования, что позволило выявить дефекты с глубокими уровнями в верхней и нижней половинах запрещенной зоны, а также в различных локальных областях структуры – как в буферных слоях GaAs и InGaAs, так и вблизи границ раздела слоев. Показано, что некоторые из обнаруженных глубоких уровней в буферных слоях InGaAs являются протяженными дефектами и могут быть связаны с рекомбинационно-активными дефектами, наблюдаемыми методом наведенного тока.
ИССЛЕДУЕМЫЕ ОБРАЗЦЫ
В работе исследовали ферромагнитные гетероструктуры (Ga,Mn)As/(In,Ga)As/GaAs, которые были выращены на подложке n+-GaAs (концентрация электронов n ~ 1.5 × 1018 см–3) и содержали буферные слои GaAs (толщина d ~150–350 нм) и InxGa1 – xAs (d ~1.0–1.8 мкм, содержание индия x ~ 7 ат. %), нелегированный спейсер InGaAs толщиной 40 нм и верхний слой p+-(Ga,Mn)As (толщина от 5 до 100 нм, содержание Mn около 13 ат. %, концентрация дырок p ~ 1019 см–3). Все слои InGaAs были получены методом газофазной эпитаксии при температуре 650°С, слой GaMnAs – методом осаждения из лазерной плазмы [9] при 330°С. Были также изготовлены образцы без верхнего ферромагнитного слоя. Для электрофизических измерений на гетероструктурах вытравливали мезу диаметром 600 мкм, на которую методом термического распыления наносили металлический контакт из золота диаметром 500 мкм. Омический контакт с обратной стороны структуры формировали вжиганием оловянной фольги электроискровым методом.
Выращенные структуры были двух видов: с буферными слоями InGaAs/GaAs n- и p-типов. В первом случае p–n-переход был в верхней части структуры между слоями InGaAs и GaMnAs, а во втором – между подложкой и эпитаксиальным слоем GaAs p-типа. Уровень легирования в слоях n-типа варьировался от 5 × 1015 до 1017 см–3, в слоях p-типа – от 2 × 1015 до 1016 см–3. Такая конфигурация образцов позволяла исследовать электрически активные дефекты в различных областях структуры.
ЭКСПЕРИМЕНТАЛЬНЫЕ РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
Метод наведенного тока. Исследования в РЭМ в режиме наведенного тока проводили в микроскопе JEOL JSM-840A при энергии пучка от 5 до 38 кэВ с использованием усилителя тока Keithley 428. Диффузионную длину неосновных носителей в исследуемых структурах определяли по известной методике [10] из экспериментальной зависимости эффективности собирания носителей заряда от энергии пучка. Сканирование по глубине при исследовании рекомбинационно-активных дефектов методом наведенного тока осуществляли, варьируя как энергию пучка, так и обратное напряжение смещения на структуре. Ширину области пространственного заряда при различных напряжениях смещения на структуре определяли из вольт-фарадных характеристик, измеренных на частоте 1 МГц.
На рис. 1 представлены РЭМ-изображения двух структур с буферными слоями GaAs/InGaAs n-типа (рис. 1a, 1б) и p-типа (рис. 1в, 1г), полученные в режиме наведенного тока при энергии пучка 15 кэВ. Обе структуры содержали слои GaAs и InGaAs толщиной, соответственно, 350 и 1500 нм, концентрация электронов в слое InGaAs структуры n-типа составляла ~8 × 1016 см–3, а концентрация дырок в слоях GaAs и InGaAs структуры p-типа – (2–5) × 1015 см–3. Для наглядности представлены изображения при разных увеличениях.
Рис. 1.
Изображения протяженных дефектов в буферных слоях (In,Ga)As в режиме наведенного тока в гетероструктурах с буферными слоями n- (a, б) и p-типов (в, г) при различных увеличениях и обратных смещениях, приложенных к структуре.
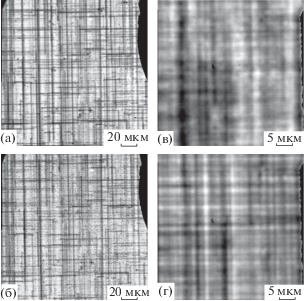
Изображения, полученные в режиме наведенного тока, демонстрируют характерную ортогональную сетку протяженных дефектов в направлениях [110] и [1$\bar {1}$0]. Глубина проникновения первичных электронов пучка составляла 1.8 мкм при энергии 15 кэВ и, как следствие, собирание основного сигнала осуществлялось из буферных слоев GaAs и InGaAs. Положение границы области пространственного заряда, на которой происходит собирание диффундирующих неосновных носителей заряда, задавалось обратным смещением на p–n-переходе, металлургическая граница которого находилась в верхней части структуры между слоями InGaAs и GaMnAs в структуре n-типа либо в нижней части структуры между подложкой n+-GaAs и эпитаксиальным слоем p-GaAs в структуре p-типа.
Для рассматриваемой структуры n-типа (рис. 1a, 1б) ширина области пространственного заряда составляла 130 нм при нулевом смещении и 290 нм при обратном смещении UR = –4 В. При диффузионной длине неосновных носителей заряда (дырок) в буферном слое InGaAs данной структуры LP ~ 0.25 мкм особенности контраста на изображениях, полученных в режиме наведенного тока, определялись электрической активностью рекомбинационных центров, расположенных на глубинах 130–380 нм от верхней границы слоя InGaAs при UR = 0 (рис. 1a) и 290–540 нм при UR = –4 В (рис. 1б), т.е. на расстоянии как минимум 0.9 мкм от границы радела GaAs–InGaAs.
В структурах p-типа металлургическая граница p–n-перехода находилась внизу между подложкой n+-GaAs и эпитаксиальным слоем p-GaAs, а граница области пространственного заряда при приложении обратного смещения сдвигалась вверх – от границы раздела GaAs–InGaAs к поверхности структуры. Для структуры, представленной на рис. 1в, 1г, ширина области пространственного заряда при нулевом смещении составляла ~0.3 мкм, а при обратном смещении UR = –3 В – ~0.8 мкм. Диффузионная длина неосновных носителей заряда (электронов) в буферном слое InGaAs данной структуры была Le ~ ~ 0.6 мкм. Поскольку граница раздела GaAs–InGaAs находится на расстоянии 0.35 мкм от границы p–n-перехода, наблюдаемые при нулевом смещении (рис. 1в) особенности контраста на изображении, полученном в режиме наведенного тока, определяются электрической активностью рекомбинационных центров, локализованных как вблизи границы раздела GaAs–InGaAs (сетка дислокаций несоответствия), так и в объеме буферного слоя InGaAs на расстоянии, ограниченном диффузионной длиной неосновных носителей заряда (~0.9 мкм от границы p–n-перехода и, соответственно, 0.55 мкм от границы раздела GaAs–InGaAs). Для обратного смещения UR = = ‒3.0 В (рис. 1г) особенности контраста определяются в основном электрической активностью рекомбинационных центров, расположенных только в буферном слое InGaAs на расстоянии 0.8 мкм от границы p–n-перехода (0.45 мкм от границы раздела GaAs–InGaAs) и выше, практически вплоть до верхней границы слоя InGaAs.
Таким образом, изображения, полученные методом наведенного тока, демонстрируют протяженные электрически активные дефекты в исследуемых структурах не только вблизи границы раздела GaAs–InGaAs, но и во всем объеме буферного слоя InGaAs. Следует отметить, что наблюдаемые дефекты проявляются так же, как дефекты, исследованные ранее в сходных структурах [8], т.е. может изменяться их длина, ширина, интенсивность. Сегменты линий могут появляться и исчезать при сканировании по глубине, однако они сохраняют кристаллографическую ориентацию, совпадающую с перекрестно-штриховой морфологией на поверхности структур.
Спектры глубоких уровней. Обсуждение результатов. Измерения спектров глубоких уровней проводили на автоматизированной установке релаксационной спектроскопии, собранной на основе емкостного моста Sanwa MI-325 и фазочувствительного усилителя EG&G 9503-SC, в диапазоне температур от 100 до 400 К. В качестве стандартных условий измерения (если не указано иное) использовали следующие параметры: анализируемую скорость эмиссии (“временнóе окно”) 156 с–1 и длительность заполняющего импульса tP = 1 мс.
В образцах с буферными слоями n-типа (рис. 2) наблюдается только один пик, соответствующий глубокому уровню EC (–0.8 эВ), который можно идентифицировать как известный глубокий центр EL2. Уровней, связанных с протяженными дефектами, выявить не удалось.
Рис. 2.
Спектры глубоких уровней, полученные для структур (Ga,Mn)As/(In,Ga)As/GaAs с буферными слоями GaAs и InGaAs n-типа с разным уровнем легирования n и значениями UR/UP: 1 – n ~ 7 × 1015 см–3, UR/UP = –1.3 В/0.5 В; 2 – n ~ 6 × 1016 см–3, UR/UP = = –3.5 В/2.0 В.

В образцах с буферными слоями p-типа (рис. 3) спектр глубоких уровней представлен несколькими пиками, которые могут быть связаны с протяженными дефектами в слое InGaAs и вблизи границы раздела GaAs–InGaAs. Наиболее значительный пик обнаруживается вблизи температуры 295 К. Еще один пик, проявляющийся чаще всего как плечо большого пика, наблюдается вблизи 220 К. По зависимости температурного положения пика от анализируемой скорости эмиссии (“временнóго окна”) с помощью кривой Аррениуса можно определить энергию активации и эффективное сечение захвата носителей для доминирующего пика. Она составила 0.65 эВ относительно потолка валентной зоны (EV + 0.65 эВ) при эффективном сечении захвата порядка 10–13 см2.
Рис. 3.
Спектры глубоких уровней в структуре (Ga,Mn)As/(In,Ga)As/GaAs с буферными слоями GaAs и InGaAs p-типа при различных значениях UR/UP: –2.5 В/1.0 В (1); –5.5 В/2.0 В (2); –7.5 В/2.5 В (3).

Энергию активации второго пика удалось определить при малых длительностях заполняющего импульса, поскольку при исследовании зависимостей от длительности импульса было обнаружено, что пик при 295 К практически пропадает при tP < 1 мкс, что позволяет применить стандартную процедуру определения энергии активации с помощью кривой Аррениуса по температурному положению пика. Полученная величина энергии активации составила 0.50 эВ, эффективное сечение захвата порядка 2 × 10–13 см2.
Было проведено исследование кинетики заполнения глубокого уровня EV +0.65 эВ по зависимости амплитуды доминирующего пика A от длительности заполняющего импульса. Обнаружено, что заполнение уровня практически линейно зависит от логарифма длительности заполняющего импульса tP (A ~ lg(tP)) при изменении tP более чем на четыре порядка (рис. 4). Такой характер зависимости свидетельствует о том, что глубокий уровень EV + 0.65 эВ связан с протяженным дефектом [11].
Рис. 4.
Зависимость амплитуды пика А глубокого уровня EV + 0.65 эВ от длительности заполняющего импульса tP в структуре с эпитаксиальными слоями GaAs и InGaAs p-типа.
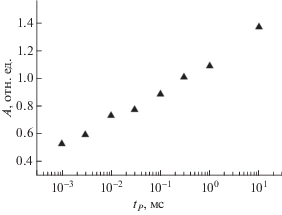
Аналогичное исследование глубокого уровня EV + 0.50 эВ не представляется возможным, поскольку, как указывалось выше, соответствующий ему пик можно выделить только при коротких заполняющих импульсах. Другая возможность подобного исследования – разделение пиков путем подгонки с помощью нескольких стандартных пиков – тоже не дает надежного результата, поскольку наблюдаемые пики сильно уширены. Отметим, что уширение пиков само по себе свидетельствует в пользу того, что наблюдаемые глубокие уровни связаны с протяженными дефектами [12]. Однако из-за того, что уширение пиков в спектрах исследуемых структур может быть вызвано одновременно несколькими причинами (неоднородность состава тройного соединения [13, 14], распределенный глубокий уровень в виде зоны разрешенных состояний [15, 16]), а также из-за того, что наблюдаемые пики могут включать более одного уровня, от моделирования трудно ожидать надежных результатов из-за большого количества задаваемых параметров.
Исследование методом релаксационной спектроскопии глубоких уровней разных областей структуры по глубине достигалось варьированием величин обратного смещения на структуре UR и импульса прямого напряжения UP , заполняющего ловушки. На рис. 3 приведены спектры глубоких уровней, измеренные при различных обратных смещениях, для структуры со слоями GaAs и InGaAs p-типа толщиной, соответственно, 350 и 1500 нм и концентрацией дырок в слое InGaAs p ~ 2 × 1015 см–3. Напомним, что в этих структурах p–n-переход располагается внизу между подложкой и эпитаксиальным слоем p-GaAs, граница раздела GaAs–InGaAs находится на расстоянии примерно 350 нм от границы p–n-перехода, а граница области пространственного заряда при увеличении обратного смещения движется вверх от границы раздела GaAs–InGaAs к верхней границе слоя InGaAs. Для данной структуры кривая 1 (UR/UP = –2.5 В/1.0 В) соответствует области вблизи границы раздела GaAs–InGaAs, кривая 2 (UR/UP = –5.5 В/2.0 В) – области на расстоянии 0.7–0.9 мкм от границы p–n-перехода, а кривая 3 (UR/UP = –7.5 В/2.5 В) – области на расстоянии 1.2–1.5 мкм от границы p–n-перехода. Видно, что хотя концентрация дефектов с глубокими уровнями EV +0.65 и +0.50 эВ заметно уменьшается, тем не менее, дефекты регистрируются практически во всем объеме слоя InGaAs.
Таким образом, обнаружены глубокие уровни в эпитаксиальных слоях InGaAs и вблизи границы раздела GaAs–InGaAs, связанные с протяженными дефектами в нижней половине запрещенной зоны, а в верхней половине запрещенной зоны такие уровни не выявлены. Если сопоставить полученные результаты с литературными данными [11, 16–20], то следует отметить, что возникновение акцепторных состояний в нижней половине запрещенной зоны, связанных с дислокациями, отмечалось неоднократно в кристаллах объемного GaAs после пластической деформации по измерениям эффекта Холла и проводимости (например, [17]). Методом релаксационной спектроскопии глубоких уровней в объемном GaAs были зафиксированы уровни с энергией активации около 0.4 эВ (EV +0.37 эВ [19] и +0.45 эВ [17]), предположительно, связанные с введенными дислокациями. В гетероструктурах InGaAs/GaAs с частично релаксированными слоями p-InGaAs было обнаружено несколько глубоких уровней [16, 20]. Некоторые из них близки по параметрам к выявленному в настоящей работе глубокому уровню EV +0.65 эВ (уровни с энергией активации 0.67 эВ [16] и 0.67–0.73 эВ [20]). Уровня, близкого по параметрам к уровню EV +0.50 эВ, в известной литературе найдено не было.
Однако авторы [16, 20] традиционно связывают глубокие уровни, обнаруженные в гетероструктурах с рассогласованием параметров решеток, с дислокациями несоответствия на границе раздела GaAs–InGaAs. В настоящей работе измерения спектров глубоких уровней регистрируют сигнал от ловушек EV +0.65 и +0.50 эВ в буферном слое InGaAs на расстоянии ~0.4 мкм от границы раздела GaAs–InGaAs (рис. 3, кривая 2) UR/UP = = –5.5 В/2.0 В. Оценка концентрации дефектов с глубоким уровнем EV +0.65 эВ дает ~(0.3–1.0) × × 1014 см–3, что составляет довольно значительную величину (1.5–5%) относительно концентрации легирующей примеси. Таким образом, эти глубокие уровни должны быть связаны с протяженными дефектами, расположенными в буферном слое InGaAs, например, с пронизывающими дислокациями в слое InGaAs либо со следами за дислокациями [21–24] или с какими-либо другими дефектами, которые могут формироваться в плоскостях скольжения дислокаций в процессе релаксации упругих напряжений. Возможно, обнаруженные глубокие уровни связаны с рекомбинационно-активными дефектами, проявляющимися на изображениях, полученных методом наведенного тока. Установить более выраженную корреляцию между электрически активными дефектами, выявленными методами наведенного тока и релаксационной спектроскопии глубоких уровней, можно с помощью более детального исследования распределения дефектов по глубине обоими методами, что требует дополнительных измерений и моделирования сигнала в конкретных структурах.
В кристаллах n-GaAs и гетероструктурах со слоями InGaAs n-типа, согласно литературным данным, проявлялся только один глубокий уровень, связываемый с дислокациями или с релаксацией упругих напряжений в слоях InGaAs. Его энергия активации 0.68 эВ (пик ED1 [11, 16]) либо 0.58 эВ (пик С [18]), и он может накладываться в спектрах глубоких уровней на пик известного глубокого центра EL2. В рассматриваемых структурах подобных уровней обнаружено не было.
ЗАКЛЮЧЕНИЕ
В работе исследованы дефекты в эпитаксиальных слоях ферромагнитных гетероструктур (Ga,Mn)As/(In,Ga)As/GaAs методами наведенного тока и релаксационной спектроскопии глубоких уровней. На изображениях, полученных методом наведенного тока, наблюдаются электрически активные протяженные дефекты не только вблизи границы раздела GaAs–InGaAs, но и во всем объеме буферного слоя InGaAs. Методом релаксационной спектроскопии исследованы дефекты с глубокими уровнями в структурах (Ga,Mn)As/(In,Ga)As/GaAs с буферными слоями n- и p-типов. В структурах с буферными слоями p-типа выявлены два уровня в нижней половине запрещенной зоны (EV +0.50 и +0.65 эВ), которые могут быть связаны с протяженными дефектами. Кинетика заполнения дефекта с глубоким уровнем EV +0.65 эВ, уширенная форма пика в спектре и оценки распределения его концентрации свидетельствуют о том, что дефект с глубоким уровнем EV +0.65 эВ является протяженным дефектом, находящимся в слое InGaAs и вблизи границы раздела GaAs–InGaAs. Весьма вероятно, что он связан с сеткой протяженных дефектов в слое InGaAs, наблюдаемой в режиме наведенного тока и коррелирующей с перекрестно-штриховой морфологией на поверхности структур. Более выраженная корреляция между электрически активными дефектами, выявленными методами наведенного тока и релаксационной спектроскопии глубоких уровней, и также идентификация другого дырочного глубокого уровня EV +0.50 эВ требуют дальнейших исследований.
Список литературы
Chang K.H., Gibala R., Srolovitz D.J. et al. // J. Appl. Phys. 1990. V. 67. № 9. P. 4093. doi 10.1063/1.344968
Yastrubchak O., Wosinski T., Domagala J.Z. et al. // J. Phys.: Condens. Matter. 2004. V. 16. № 2. P. S1. doi 10.1088/0953-8984/16/2/001
Fitzgerald E.A., Xie Y.-H., Monroe D. et al. // J. Vac. Sci. Technol. B. 1992. V. 10. № 4. P. 1807. doi 10.1116/ 1.586204
Albrecht M., Christiansen S., Michler J. et al. // Appl. Phys. Lett. 1995. V. 67. № 9. P. 1232. doi 10.1063/1.115017
Lutz M.A., Feenstra R.M., LeGoues F.K. et al. // Appl. Phys. Lett. 1995. V. 66. № 6. P. 724. doi 10.1063/1.114112
Andrews A.M., Speck J.S., Romanov A.E. et al. // J. Appl. Phys. 2002. V. 91. № 4. P. 1933. doi 10.1063/1.1428091
Yastrubchak O., Wosinski T., Lusakowska E. et al. // Microchim. Acta. 2004. V. 145. № 1. P. 267. doi 10.1007/ s00604-003-0165-3
Kovalskiy V.A., Vergeles P.S., Eremenko V.G. et al. // Appl. Phys. Lett. 2014. V. 105. № 23. P. 231608. doi 10.1063/1.4904343
Звонков Б.Н., Вихрова О.В., Данилов Ю.А. и др. // Оптич. журн. 2008. Т. 75. № 6. С. 56.
Якимов Е.Б. // Заводская лаборатория. 2002. Т. 68. № 1. С. 63.
Wosinski T. // J. Appl. Phys. 1989. V. 65. № 4. P. 1566. doi 10.1063/1.342974
Figielski T. // Phys. Stat. Sol. A. 1990. V. 121. № 1. P. 187. doi 10.1002/pssa.2211210122
Omling P., Samuelson L., Grimmeiss H.G. // J. Appl. Phys. 1983. V. 54. № 9. P. 5117. doi 10.1063/1.332733
Soltanovich O.A., Yakimov E.B., Yarykin N.A. // Phys. Stat. Sol. A. 1993. V. 136. № 2. P. 455. doi 10.1002/pssa.2211360219
Riedel F., Schroeter W. // Phys. Rev. B. 2000. V. 62. № 11. P. 7150. doi 10.1103/PhysRevB.62.7150
Yastrubchak O., Wosinski T., Makosa A. et al. // Physica B. 2001. V. 308–310. P. 757. doi 10.1016/S0921-4526(01)00828-6
Skowronski M., Lagowski J., Milshtein M. et al. // J. Appl. Phys. 1987. V. 62. № 9. P. 3791. doi 10.1063/1.339218
Watson G.P., Ast D.G., Anderson T.J. et al. // J. Appl. Phys. 1992. V. 71. № 7. P. 3399. doi 10.1063/1.350936
Wosinski T., Figielski T. // Acta Physica Polonica. A. 1993 V. 83. № 1. P. 51. doi 10.12693/APhysPolA.83.51
Du A.Y., Li M.F., Chong T.C. et al. // Appl. Phys. Lett. 1996. V. 69. № 19. P. 2849. doi 10.1063/1.117339
Zhang R., Rozgonyi G.A., Yakimov E. et al. // J. Appl. Phys. 2008. V. 103. № 10. P. 103 506. doi 10.1063/ 1.2930998
Eremenko V., Yakimov E., Abrosimov N. // Phys. Stat. Sol. C. 2007. V. 4. № 8. P. 3100. doi 10.1002/ pssc.200675462
Eremenko V., Demenet J.L., Rabier J. // Phys. Stat. Sol. C. 2009. V. 6. № 8. P. 1801. doi 10.1002/pssc.200881464
Feklisova O.V., Yakimov E.B., Yarykin N. // Physica B. 2003. V. 340–342. P. 1005. doi 10.1016/j.physb.2003.09.196
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования


