Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2019, № 3, стр. 74-82
Тонкие пленки SiC, полученные методом импульсного лазерного осаждения на Al2O3: морфология и структура
Н. И. Каргин 1, А. С. Гусев 1, С. М. Рындя 1, *, А. А. Тимофеев 1, М. М. Грехов 1, Н. В. Сигловая 1, С. В. Антоненко 1
1 Национальный исследовательский ядерный университет “МИФИ”
115409 Москва, Россия
* E-mail: smryndya@mephi.ru
Поступила в редакцию 14.06.2018
После доработки 14.07.2018
Принята к публикации 14.07.2018
Аннотация
Методом импульсного лазерного осаждения из керамической мишени в вакууме получены тонкие субмикронные пленки SiC на подложках α-Al2O3 (0001). Методами растровой и просвечивающей электронной микроскопии, сканирующей зондовой микроскопии, рентгеновской дифрактометрии, ИК фурье-спектрометрии, спектроскопии комбинационного рассеяния света исследовано влияние температуры подложки на состав, структуру и морфологию поверхности экспериментальных образцов. Показано, что при температуре подложки Tподл = 1000°C наблюдается гетероэпитаксиальный рост 3С–SiC со следующей преимущественной ориентацией относительно подложки: [$0001$]Al2O3||[111]SiС и [$2\bar {1}\bar {1}0$]Al2O3||[$2\bar {1}\bar {1}$]SiС, [$1\bar {1}00$]Al2O3||[$1\bar {1}0$]SiС. Форма рефлексов от плоскостей семейств {011} и {131} 3С–SiC на микроэлектронограмме говорит о наличии в пленке локальных областей, повернутых на углы до ±7.5° вокруг оси роста. Таким образом, установлено, что пленка 3С–SiC, полученная на α-Al2O3 при температуре подложки 1000°C, имеет мозаичную структуру, частично компенсирующую механические напряжения, возникающие из-за рассогласования параметров решеток и температурных коэффициентов расширения в плоскости спайности.
ВВЕДЕНИЕ
Карбид кремния, обладая набором уникальных свойств таких, как большая ширина запрещенной зоны (2.3–3.3 эВ для различных политипных форм), высокое критическое поле лавинного пробоя (2–5 МВ/см), теплопроводность (3–5 Вт/см ⋅ K), превосходящая при комнатной температуре теплопроводность меди, химическая и радиационная стойкость (за счет высокой энергии дефектообразования 25–35 эВ), является перспективным материалом для применения в различных областях современной электроники. Структуры на его основе обладают стабильными временными характеристиками, широким диапазоном рабочих температур (вплоть до 900°С) и могут быть использованы при конструировании приборов СВЧ-, мощной и сильноточной электроники, полупроводниковых детекторов ядерных частиц, фотоэлектропреобразователей УФ-излучения и др. [1–3].
Традиционным методом получения тонких эпитаксиальных пленок карбида кремния является метод химического осаждения из газовой фазы (СVD) [4] в смесях силана (SiH4, Si2H6) и углеводородов (СН4, С2Н4, С3Н8), а также различных кремнийорганических соединений в потоке водорода. Однако рост производства приборов на основе карбида кремния стимулирует поиск более экономичных и безопасных способов формирования тонкопленочных структур на его основе [5–7]. Одним из таких способов может стать импульсное лазерное осаждение (ИЛО) в вакууме. ИЛО исключает применение химически агрессивных, взрывоопасных газов и позволяет формировать тонкие сплошные покрытия, начиная с единиц нанометров.
В предыдущих работах [8, 9] нами были представлены результаты экспериментальных исследований влияния температуры и кристаллической ориентации подложки на состав, структурное совершенство и морфологию поверхности субмикронных пленок 3C–SiC, полученных методом ИЛО на монокристаллическом кремнии. Свое практическое применение подобные структуры находят в области фотовольтаики и микросистемной техники [10, 11]. Вместе с тем, относительно низкая температура плавления подложки (1414°С) накладывает некоторые технологические ограничения на применение Si/SiC-гетерокомпозиций, например, при получении графена методом термической диссоциации SiC [12]. Поэтому целью данной работы было изучение возможности выращивания тонких эпитаксиальных пленок карбида кремния методом ИЛО на подложках α-Al2O3.
ЭКСПЕРИМЕНТАЛЬНАЯ ЧАСТЬ
Рост слоев SiC проводили методом ИЛО из керамической мишени α-SiC стехиометрического состава. Условия эксперимента были следующие: длина волны 1.06 мкм (YAG:Nd лазер), частота повторения 45 Гц, длительность лазерного импульса 10–8 с, энергия импульса 100 мДж, плотность мощности 109 Вт/см2, размер пятна фокусировки ∼1 мм2. Процесс осуществляли при различных температурах подложки (Tподл = 100–1000°С) в условиях высокого вакуума P ∼ 10–5 Па. В качестве подложек использовались пластины монокристаллического α-Al2O3 размером 1.5 × 1.5 см2 с кристаллической ориентацией (0001). Перечень синтезированных образцов представлен в табл. 1.
Таблица 1.
Перечень экспериментальных образцов и их параметры
| № серии образцов |
Условия получения | Толщина, нм | Скорость роста, нм/имп. (×10–3) | Состав по данным РОР | |||||
|---|---|---|---|---|---|---|---|---|---|
| Tподл, °C | Число импульсов | Частота следования имп., Гц | Энергия в импульсе, мДж | РОР, нм |
Эллипсо-метрия, нм |
ПЭМ, нм |
|||
| 1 | 100 | 70 000 | 45 | 100 | 368 ± 10 | 363 ± 10 | – | 5.3 | Si1.0C0.88 |
| 2 | 500 | 65 000 | 45 | 100 | – | 275 ± 10 | – | 4.2 | – |
| 3 | 750 | 70 000 | 45 | 100 | 267 ± 10 | 266 ± 10 | 270 ± 5 | 3.8 | Si1.0C0.91 |
| 4 | 1000 | 30 000 | 45 | 100 | 100 ± 10 | 95 ± 10 | 98 ± 5 | 3.3 | Si1.0C1.09 |
Влияние условий роста на морфологию поверхности и динамику структурных изменений в тонких пленках SiC исследовалось методами рентгеновской дифрактометрии, растровой (РЭМ) и просвечивающей (ПЭМ) электронной микроскопии, а также методом сканирующей зондовой микроскопии (СЗМ).
Рентгенофазовый анализ проводился на дифрактометре “Ultima IV”(Rigaku) с использованием CuKα-излучения (λ = 0.15406 нм) по двухкристальной схеме. Съемка осуществлялась в геометрии 2θ/ω, шаг съемки 0.05° с экспозицией 10 с в каждой точке.
Морфологию поверхности экспериментальных образцов исследовали методом РЭМ, при этом использовали растровый электронный микроскоп “Raith 150 TWO”. Измерения проводили при ускоряющем напряжении до 10 кВ в режиме регистрации вторичных электронов. Пробоподготовку для ПЭМ осуществляли при помощи сфокусированного ионного пучка (ФИП): выполнялся поперечный срез и последующее утонение фольги до толщины ≈100 нм с целью обеспечения достаточной прозрачности. Параметры ФИП были следующие: энергия пучка составляла 30 кэВ, ионный ток варьировался от 2 нА до 10 пА при тонкой обработке.
Для расчета среднеквадратичной шероховатости поверхности экспериментальных образцов использовались данные сканирующей зондовой микроскопии (СЗМ). Все СЗМ-измерения проводились в полуконтактном режиме микроскопа “SolverNext” (НТ-МДТ). Применялись кантилеверы марки NSG01 (длина балки 125 мкм с коэффициентом жесткости 5.1 Н/м, резонансная частота 87–230 кГц, типичный радиус кривизны острия 10 нм). В связи с большой локальностью метода количественный анализ топологии каждого образца проводился для нескольких различных участков его поверхности (размер окон сканирования составлял 6 × 6 мкм). Затем значения шероховатости выбранных участков усреднялись.
Для изучения оптических свойств образцов в ИК-диапазоне использовался спектрометр “FTIR 8400S” (Shimadzu) с приставкой зеркального отражения “SMR 8000”. Измерение спектров отражения проводилось по стандартной методике с разрешением 2 см–1. Комбинационное рассеяние света в экспериментальных структурах исследовали с помощью рамановского спектрометра “InVia Reflex” (Renishaw). Источником света служил аргоновый лазер с длиной волны 514 нм. Все измерения выполняли при комнатной температуре.
Контроль стехиометрии экспериментальных образцов производили методом спектроскопии резерфордовского обратного рассеяния (РОР). В качестве примера на рис. 1а представлен спектр РОР образца, осажденного при Tподл = 1000°С, и результат его аппроксимации, исходя из которой определялся состав и толщина пленки. Из анализа данных РОР (табл. 1) следует, что образцы при низких температурах синтеза (Tподл = 100 и 750°С) имеют элементный состав, заметно отличающийся от стехиометрического (на 8–12%). Как отмечалась нами ранее в работе [8], наблюдаемое отклонение от стехиометрии может быть вызвано процессом вторичного распыления конденсата под действием высокоэнергетических частиц факела продуктов лазерной абляции.
Толщины пленок SiC контролировали с помощью спектроскопического эллипсометра “SE-800” (Sentech) и исходя из анализа данных ПЭМ. Эллипсометрические измерения выполнялись в диапазоне длин волн 350–750 нм при угле падения света 70°. Для аппроксимации полученных спектральных зависимостей величин ∆ и Ψ использовалась модель дисперсии Коши [13]. При моделировании учитывались значения шероховатости поверхности структур. Для определения импульсной скорости роста пленок значения толщин, полученных разными методами, усреднялись. Как видно из рис. 1б, при Tподл = 100°С импульсная скорость осаждения (Vg) максимальна (5.3 × 10–3 нм/имп. или 0.23 нм/с) и определяется главным образом массопереносом материала распыляемой мишени на подложку. Продвижение в область высоких температур роста влечет за собой падение параметра Vg до 1.6 раза (для Tподл = 1000°С), что свидетельствует о смене механизма формирования пленок. Заметную роль здесь, очевидно, начинает играть кинетика процессов взаимодействия адатомов с ростовой поверхностью. Это предположение подтверждается наблюдаемым изменением состава экспериментальных образцов, т.е. изменением соотношения C/Si по данным РОР (табл. 1). Уменьшение содержания кремния в пленках с увеличением параметра Tподл объясняется непропорциональной десорбцией компонентов с поверхности роста. Следует отметить, что в интервале температур подложки между 750 и 1000°C соотношение углерода и кремния в тонких пленках SiC приближается к стехиометрическому. Таким образом, происходит самостабилизация элементного состава, которая, по всей вероятности, является отражением процессов упорядочения кристаллической структуры.
РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
На рис. 2 представлены РЭМ-изображения поверхности пленок SiC, полученных на подложке α-Al2O3 (0001) при Tподл = 100°С (рис. 2а), 750°С (рис. 2б) и 1000°С (рис. 2в). Характерной особенностью морфологии образцов на микроуровне является наличие квазисферических частиц (микрокапель), средний диаметр которых составляет 100–300 нм, а концентрация может достигать 107–108 см–2 . Анализ литературных данных показывает, что присутствие микрокапель типично для образцов, сформированных методом ИЛО [14, 15]. В качестве возможных причин их появления обычно рассматривают всплески расплавленного слоя поверхности мишени при его закипании, разбрызгивание жидкой фазы под действием ударных волн [11].
Рис. 2.
РЭМ-изображения поверхности экспериментальных образцов, полученных на α-Al2O3 (0001) при различных температурах подложки Tподл: а – 100°С, б – 750°С, в – 1000°С и г – изменение среднеквадратичной шероховатости поверхности (RMS) экспериментальных образцов.

В свободных от микрокапель областях поверхность образца № 1 (Tподл = 100°С) является гладкой (ее среднеквадратичная шероховатость (RMS) по данным СЗМ не более 0.5 нм). При повышении Tподл до 500°С параметр RMS растет незначительно (до 3.6 нм), что указывает на формирование в рассматриваемом температурном диапазоне аморфных пленок. Данные рентгеновской дифрактометрии (рис. 3) подтверждают преимущественно аморфный характер материала пленочного покрытия, синтезированного при Tподл до 500°С. На рентгенодифракционном спектре образца № 2 на фоне узких интенсивных линий при 2θ = 41.7°, 90.8°, соответствующих дифракционному отражению от подложки, при этом пики, соответствующие карбиду кремния, практически не разрешаются.
Рис. 3.
Рентгенодифракционные спектры экспериментальных образцов, полученных при различной температуре подложки.

RMS поверхности экспериментальной структуры № 3, полученной при Tподл = 750°С, возрастает до 13.6 нм. Такое резкое изменение топологии говорит о начале процесса кристаллизации. О присутствии нанокристаллической фазы карбида кремния в образце № 3 свидетельствуют уширенные пики низкой интенсивности при 2θ = 35.5°, 59.8° и 89.75° на дифрактограмме. Они (согласно ICDD 01-073-1665) могут соответствовать дифракционному отражению от кристаллографических плоскостей (111), (220) и (400) 3С–SiC. Средний размер кристаллитов, рассчитанный по формуле Шеррера, для данного образца не превышает 10 нм.
В свою очередь, рентгенодифракционный спектр образца № 4 (Tподл = 1000°С) помимо пиков подложки содержит узкую интенсивную линию от плоскостей 3С–SiC семейства (111), что указывает на ориентированный рост слоя карбида кремния вдоль соответствующего направления. Прямым доказательством этому являются данные просвечивающей электронной микроскопии высокого разрешения (рис. 4а), где на поперечном срезе пленки в области гетерограницы SiC/Al2O3 наблюдаются атомные слои, параллельные поверхности подложки, а также данные микродифракции электронов (рис. 4б). На приведенной электронограмме хорошо видны точечные рефлексы, соответствующие монокристаллической подложке сапфира и рефлексы, принадлежащие карбиду кремния, причем [$0001$]Al2O3||[111]SiС. Результаты сравнения экспериментальных значений межплоскостных расстояний и углов, полученных при анализе микроэлектронограммы, с расчетными для β-SiC значениями представлены в табл. 2.
Рис. 4.
Результаты просвечивающей электронной микроскопии для образца № 4, полученного при температуре 1000°С: а − ПЭМ-изображение высокого разрешения гетерограницы пленка/подложка; б − микродифракционная картина от выбранного участка структуры.

Таблица 2.
Межплоскостные расстояния и углы, полученные при анализе микроэлектронограммы экспериментального образца № 4 (рис. 4б)
| Значения межплоскостных расстояний | |||||||
|---|---|---|---|---|---|---|---|
| H | K | L | d(hkl), нм, расчетное (для параметра решетки а = 0.43596 нм [16]) | d(hkl), нм (эксперимент) | |||
| 1 | 1 | 1 | 0.2517016 | 0.252 | |||
| 1 | 3 | –1 | 0.1314469 | 0.131 | |||
| 0 | 2 | –2 | 0.1541351 | 0.153 | |||
| –1 | –1 | –1 | 0.2517016 | 0.253 | |||
| –1 | –3 | 1 | 0.1314469 | 0.132 | |||
| 0 | –2 | 2 | 0.1541351 | 0.152 | |||
| Значения углов между плоскостями (h1k1l1) и (h2k2l2) | |||||||
| H1 | K1 | L1 | H2 | K2 | L2 | φ, град (расчетный) | φ, град (эксперимент) |
| 1 | 1 | 1 | 1 | 3 | –1 | 58.52 | 58.5 |
| 1 | 1 | 1 | 0 | 2 | –2 | 90.00 | 90.0 |
| 1 | 3 | –1 | 0 | 2 | –2 | 31.48 | 31.5 |
| 1 | 1 | 1 | –1 | –1 | –1 | 180.00 | 180.0 |
Из рис. 4 следует, что кристалл β-SiC (решетка типа алмаза) растет вдоль направления [111] на подложке (0001) α-Al2O3 (решетка типа корунда). Структурно-геометрическое согласование кристаллических решеток при этом достигается за счет гексагональной симметрии плоскостей семейства {111} карбида кремния. Иными словами, атомы β-SiC расположены в виде правильных шестиугольников с межатомным расстоянием r = = 0.3082 нм. Такой же мотив расположения атомов имеет и плоскость (0001) α-Al2O3 (период решетки а = 0.4758 нм). Предполагая, что [$0001$]Al2O3||[111]SiС и [$2\bar {1}\bar {1}0$]Al2O3||[$2\bar {1}\bar {1}$]SiС, [$1\bar {1}00$]Al2O3||[$1\bar {1}0$]SiС, можно изобразить схему расположения атомов в плоскости спайности (рис. 5). Здесь кремний (черные шары) занимает на поверхности места, которые принадлежат атомам алюминия при продолжении решетки сапфира. Несоответствие периода решетки α-Al2O3 и межатомного расстояния в эпитаксиальном слое вдоль направлений [$2\bar {1}\bar {1}0$] и [$1\bar {1}00$] (Δа/a, где Δа = a – r$\sqrt 3 $) в плоскости срастания составляет 12.2%, что и обеспечивает возможность эпитаксиального роста 3С–SiC на α-Al2O3.
Рис. 5.
Схема расположения атомов в плоскости спайности решеток α-Al2O3 и β-SiC (сплошной линией выделена проекция элементарной ячейки α‑Al2O3, коротким пунктиром – гексагональная симметрия плоскости (111) 3С−SiC).
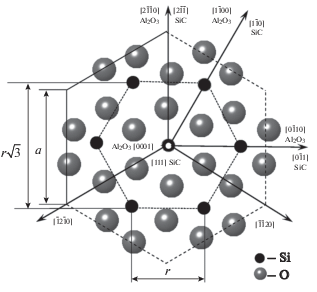
Дифракционные отражения от плоскостей семейств {011} и {131} фазы β-SiC заметно уширены по азимуту. Такая форма рефлексов говорит наличии в пленке SiC локальных областей, повернутых на углы до ±7.5° вокруг оси ее роста (направление [$0001$]Al2O3||[111]SiС), что может быть связано с компенсацией механических напряжений, возникающих ввиду несоответствия периодов решеток и температурных коэффициентов расширения карбида кремния и сапфира в плоскости их спайности.
Чтобы оценить состав и структурные особенности тонких пленок β-SiC, для всех экспериментальных образцов были получены спектры ИК-отражения и комбинационного рассеяния света (КРС) в диапазоне, близком к колебательным модам связи Si–C (рис. 6, 7, соответственно). Следует отметить, что линии, наблюдаемые при 485, 630 см–1 на рис. 6, относятся к ИК-активным фононным модам сапфира [17]. Полоса однофононного поглощения (область остаточных лучей) экспериментальных структур расположена в спектральном диапазоне 800–1100 см–1. Причем для образца № 4 длинноволновый край данной полосы, ограниченный, по всей видимости, частотой поперечного (ТO) оптического фонона в решетке SiC, приходится на волновое число ωТO ≈ 810 см–1, а коротковолновый край, ограниченный частотой продольного (LO) фонона и свойствами подложки, лежит в интервале ωLO ≈ 980–1020 см–1. Полученные значения ωТO и ωLO достаточно хорошо согласуются с данными спектроскопии КРС (рис. 7): 810 и 980 см–1, соответственно, для образца, выращенного при Tподл = 1000°С. Уменьшение параметра Tподл влечет за собой смещение всей полосы остаточных лучей в сторону меньших волновых чисел. Похожим образом ведут себя фононные моды ωLO, ωТO карбида кремния и на спектрах КРС (рис. 7). Наблюдаемый сдвиг полос может быть связан с уменьшением средних размеров зерна вплоть до формирования аморфных слоев и со снижением упругих напряжений в пленках, полученных при низких температурах подложки [18].
Рис. 6.
Спектры ИК-отражения экспериментальных образцов, полученных на α-Al2O3 (0001) при различных температурах подложки.

Рис. 7.
Спектры КРС экспериментальных образцов, полученных на α-Al2O3 (0001) при различных температурах подложки (500, 750 и 1000°С). Для сравнения приведен спектр комбинационного рассеяния от исходной подложки α-Al2O3.
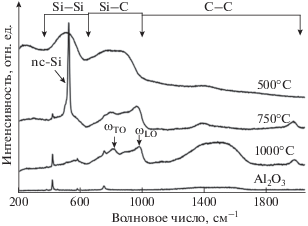
Помимо спектрального диапазона 800–100 см–1, в котором активно проявляют себя связи Si–C, на рис. 7 необходимо рассмотреть еще две области, обусловленные колебаниями связей Si–Si (ω < < 800 см–1) и С–С (ω > 1100 см–1) [18]. Так, широкая полоса комбинационного рассеяния света на спектре образца № 2 (Tподл = 500°С) в диапазоне 400–600 см–1 принадлежит аморфному кремнию (α-Si) [19, 20]. Эта полоса с ростом температуры подложки Tподл до 750°С трансформируется в узкий интенсивный пик с ωmax = 524 см–1. Согласно работам [21, 22], появление пика при ω ≈ 520 см–1 свидетельствует о формировании нанокристаллического кремния (nc-Si) со средним размером кристаллитов более 10 нм в объеме растущей пленки. Анализ данных ПЭМ подтвердил наличие в объеме пленки (для образца № 3) кристаллитов двух различных фаз, оценка межплоскостных расстояний для которых приводит к значениям dhkl ≈ 0.26 и 0.31 нм, близким к расчетным для семейств плоскостей {111} 3C–SiC (0.2517 нм, табл. 2) и {111} Si (0.3135 нм [16]).Следует отметить, что оценка межплоскостных расстояний выполнялась для кристаллитов расположенных вблизи гетерограницы и ориентированных относительно подложки. Анализ данных ПЭМ проводился с помощью программы обработки изображений “Image” путем построения профилей линий (графиков распределения пикселей по яркости), перпендикулярных наблюдаемым атомным плоскостям.
Как было отмечено выше, набор полос КРС в области 1100–1000 см–1 свидетельствует о наличии в матрице пленочного покрытия связей между атомами углерода с различным типом гибридизации (sp3, sp2 и sp1). У пленки, осажденной при Tподл = 500°С, полосы в указанном спектральном диапазоне выражены слабо. Полоса при ωmax ≈ 1380 см–1 на спектре КСР образца № 3 (Tподл = 500°С) вызвана, вероятно, присутствием фазы аморфного алмазоподобного углерода (α-С) [19]. Суперпозиция D-пика с пиком при ωmax ≈ 1580 см–1 (так называемый G‑пик, углерод в sp2-гибридизации [23, 24]) дает широкую полосу комбинационного рассеяния в диапазоне 1200–1700 см–1, причиной возникновения которой является графитизация поверхности структуры при высокой температуре подложки (1000°С) в условиях вакуума. Этот вывод подтверждается присутствием в образце углерода, избыточного над стехиометрическим составом по данным РОР (табл. 1). В свою очередь, максимум при ω ≈ 1980 см–1 связан с углеродом в состоянии sp1-гибридизации [25].
ЗАКЛЮЧЕНИЕ
Импульсным лазерным осаждением из керамической мишени в вакууме получены субмикронные пленки β-SiC на подложках α-Al2O3 (0001). Методами растровой и просвечивающей электронной микроскопии, сканирующей зондовой микроскопии, рентгеновской дифрактометрии, ИК Фурье- и рамановской спектрометрии исследовано влияние температуры подложки (в диапазоне от 100 до 1000°C) на состав, структуру и морфологию поверхности экспериментальных образцов.
Изучена кинетика формирования тонких пленок β-SiC методом ИЛО. Установлено, что при низких температурах подложки импульсная скорость осаждения Vg максимальна и определяется главным образом массопереносом материала распыляемой мишени на подложку. Продвижение в область высоких температур роста влечет за собой падение параметра Vg в 1.6 раза (для Tподл = 1000°С), что свидетельствует о смене механизма формирования пленок. Заметную роль здесь, очевидно, начинают играть процессы взаимодействия адатомов с ростовой поверхностью. Это предположение подтверждается наблюдаемым изменением состава экспериментальных образцов, т.е. изменением соотношения C/Si по данным РОР. Уменьшение содержания кремния в пленках с увеличением параметра Tподл объясняется не пропорциональной десорбцией компонентов с поверхности роста. Следует отметить, что в интервале температур подложки между 750 и 1000°C соотношение углерода и кремния в тонких пленках SiC приближается к стехиометрическому.
Показано, что пленка, выращенная при температуре подложки Tподл = 750°C, содержит фазу нанокристаллического карбида кремния со средним размером кристаллитов около 10 нм, а также нанокластеры кремния. О присутствии фазы нанокристаллического кремния в образце свидетельствует узкий интенсивный пик с ωmax = 524 см–1 на спектре КРС экспериментального образца № 3, а также данные просвечивающей электронной микроскопии высокого разрешения.
При температуре подложки Tподл = 1000°C наблюдается гетероэпитаксиальный рост пленки 3С–SiC со следующей преимущественной ориентацией относительно подложки: [$0001$]Al2O3||[111]SiС и [$2\bar {1}\bar {1}0$]Al2O3||[$2\bar {1}\bar {1}$]SiС, [$1\bar {1}00$]Al2O3||[$1\bar {1}0$]SiС. Однако рефлексы от плоскостей семейств {011} и {131} фазы β-SiC на микроэлектронограмме образца № 4 заметно уширены по азимуту. Такая форма рефлексов говорит о наличии в пленке локальных областей, повернутых на углы до ±7.5° вокруг оси ее роста. Таким образом, установлено, что пленка 3С–SiC, выращенная на подложке α-Al2O3 при температуре подложки 1000°C, имеет мозаичную структуру, частично компенсирующую механические напряжения, возникающие из-за рассогласования параметров решеток и температурных коэффициентов расширения в плоскости спайности.
О присутствии механических напряжений в образце № 4 свидетельствует сдвиг полос, соответствующих модам поперечного (ωТO ≈ 810 см–1) и продольного (ωLO ≈ 980 см–1) оптических фононов на спектрах комбинационного рассеяния и ИК-отражения относительно значений характерных для монокристалла (ωТO = 796 см–1 и ωLO = = 972 см–1 [26]).
Список литературы
Friedrichs P., Kimoto T., Ley L., Pensl G. (eds.) SiliconCarbide. Volume 2: Power Devices and Sensors, WILEY-VCH Verlag Gmb H & Co. KGaA, 2009. 520 p. ISBN: 978-3-527-40997-6.
Lebedev A.A., Savkina N.S., Ivanov A.M. et al. // Semiconductors. 2000. V. 34. № 2. P. 243. doi 10.1134/1.1187940
Blank T.V., Gol’dberg Yu.A. // Semiconductors. 2003. V. 37. № 9. P. 999. doi 10.1134/1.1610111
Nishino S., Powell J., Will H. // Appl. Phys. Lett. 1983. V. 42. № 5. P. 460. doi 10.1063/1.93970
Fissel A., Kaiser U., Schröter B. et al. // Thin Solid Films. 2000. V. 380. P. 89. doi 10.1016/S0040-6090(00)01475-9
Kukushkin S.A., Osipov A.V. // Phys. Solid State. 2008. V. 50. № 7. P. 1238. doi 10.1134/S1063783408070081
Ramazanov S.M., Kurbanov M.K., Safaraliev G.K. et al. // Tech. Phys. Lett. 2014. V. 40. № 4. P. 300. doi 10.1134/S1063785014040099
Gusev A.S., Ryndya S.M., Kargin N.I. et al. // J. Synch. Investig. 2014. V. 8. № 6. P. 1221. doi 10.1134/S1027451014060287
Gusev A.S., Ryndya S.M., Kargin N.I. et al. // J. Synch. Investig. 2010. V. 4. № 3. P. 374. doi 10.1134/S1027451010030031
Rao M.S.R., Okada T. (eds.) ZnO Nanocrystals and Allied Materials. Springer Series in Materials Science 180, Springer India, 2014. doi 10.1007/978-81-322-1160-0
Vendan M., Molian P., Bastawros A., Anderegg J. // Mater. Sci. Semicond. Process. 2005. V. 8. № 6. P. 630. doi 10.1016/j.mssp.2006.02.002
Jeonghyun Hwang, Moonkyung Kim, Virgil B. Shields, Michael G. Spencer // J. Cryst. Growth. 2013. V. 366. P. 26. doi 10.1016/j.jcrysgro.2012.12.136
Tompkins H.G., Irene E.A. (eds.) Handbook of ellipsometry. William Andrew. Publishing, Springer, 2005. 870 p.
Ghica C., Ristoscu C., Socol G. et al. // Appl. Surf. Sci. 2006. V. 252. № 13. P. 467. doi 10.1016/j.apsusc.2005.07.087
Ristoscu C., Socol G., Ghica C. et al. // Appl. Surf. Sci. 2006. V. 252. № 13. P. 4857. doi 10.1016/j.apsusc.2005.07.099
http://www.matprop.ru/SiC_thermal.
Barker A.S. // Phys. Rev. 1963. V. 132. № 4. P. 1474. doi 10.1103/Phys.Rev.132.1474.
Mukaida H., Okumura H., Lee J.H. et al. // J. Appl. Phys. 1987. V. 62. № 1. P. 254. doi 10.1063/1.339191
Dengyuan Song, Eun-Chel Cho, Young-Hyun Cho et al. // Thin Solid Films. 2008. V. 516. P. 3824. doi 10.1016/j.tsf.2007.06.150
Ward Y., Young R.J., Shatwell R.A. // J. Mater. Sci. 2004. V. 39. P. 6781. doi 10.1023/B:JMSC.0000045606.60263.27
Mavilla N.R., Solanki C.S., Vasi J. // Physica E. 2013. V. 52. P. 59. doi 10.1016/j.physe.2013.03.019
Weiwei Ke, Xue Feng, Yidong Huang // J. Appl. Phys. 2011. V. 109. P. 083526. doi 10.1063/1.3569888
Ferrari A.C., Robertson J. // Phys. Rev. B. 2001. V. 64. P. 075414. doi 10.1103/PhysRevB.64.075414
Hodkiewicz J., Wall M. Introduction to Raman spectroscopy as a characterization tool for carbon nanotubes, graphene, and other carbon nanostructures // Technical Proceedings of the 2011 NSTI Nanotechnology Conference and Expo, NSTI-Nanotech 2011. V. 1. P. 167.
Ravagnan L., Siviero F., Lenardi C. et al. // Phys. Rev. Lett. 2002. V. 89. № 28. P. 285506. doi 10.1103/PhysRevLett.89.285506
López-Honorato E., Meadows P.J., Tan J. et al. // J. Mater. Res. 2008. V. 23. № 6. P. 1785. doi 10.1557/JMR.2008.0220
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования