Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2019, № 7, стр. 17-26
Оценка кристаллической структуры буферных слоев гетероструктур AlGaN/GaN методом симметричных и асимметричных рентгеновских схем
А. В. Лютцау 1, Э. М. Темпер 1, К. Л. Енишерлова 1, *
1 АО “НПП “Пульсар”
105187 Москва, Россия
* E-mail: enisherlova@pulsarnpp.ru
Поступила в редакцию 28.01.2018
После доработки 15.03.2018
Принята к публикации 20.03.2018
Аннотация
Рассмотрены возможности использования симметричных и асимметричных рентгеновских схем на однокристальном дифрактометре XMD-300 для оценки кристаллической структуры буферных слоев гетероструктур AlGaN/GaN. Разработанный алгоритм расчета углов падения рентгеновского первичного пучка и выхода дифрагированного пучка по отношению к поверхности гетероструктуры AlN/GaN/Al2O3, а также углов дифракции для определенных кристаллографических плоскостей этих материалов позволил получить отражения от плоскостей $(10\bar {1}4),$ $\quad(10\bar {1}3),$ $(11\bar {2}2),$ лежащих под углами к поверхности. Исследование отражения $11\bar {2}2$ показало, что кристаллическая решетка переходного слоя между подложкой Al2O3 и массивным буферным слоем GaN повернута относительно нормали к базисной плоскости на азимутальный угол 30°. Введение С и Fe в буферный слой GaN при выборе определенного технологического процесса выращивания приводит к изменению кристаллической структуры GaN, а именно к заполнению вакантных тетрапор, через которые проходит плоскость $(10\bar {1}3).$
ВВЕДЕНИЕ
Гетероструктуры на основе нитрида галлия в настоящее время являются важнейшими после кремния полупроводниковыми материалами, применяемыми в современных приборах микроэлектроники. Благодаря высокой радиационной стойкости и возможности работы при повышенных температурах эти материалы незаменимы в космической аппаратуре, в лазерах, они используются в высокомощных операционных усилителях, на их основе формируются полевые СВЧ-транзисторы с высокой подвижностью электронов (High-Electron-Mobility Transistor – HEMT) – подвижность при комнатных температурах в этих материалах может достигать 1900–2500 см2/(В · с). [1, 2]. Именно использование гетероструктур на основе широкозонных материалов позволило резко расширить диапазон рабочих частот СВЧ-транзисторов до десятков и сотен ГГц. Нитридные материалы находят широкое применение благодаря исключительным оптическим и электрическим свойствам. Использование нитридных гетероструктур в приборных разработках привело к тому, что только в Европе начиная с 2006 г. было запущено несколько интернациональных проектов по производству исходных материалов и приборов на их основе, а в настоящее время уже налажен промышленный выпуск НЕМТ-транзисторов на основе AlGaN/GaN/SiC для различных диапазонов частот. В Государственной программе развития технологии США и Японии также предусмотрены определенные финансовые вложения в разработку СВЧ-элементов на основе этих материалов [3]. Однако финансовая сторона производств и программ требует обеспечения высокого процента выхода годных приборов и обеспечения стабильности и надежности их работы. Поэтому на первый план выходят проблемы контроля, как качества исходных материалов, так и технологических процессов производства приборов, а также проведение работ по изучению возможной трансформации электрических свойств и кристаллической структуры слоев гетероструктур в процессе изготовления приборов. Необходимо учитывать, что нитридные гетероструктуры – это многокомпонентные слоистые системы монокристаллических нитридных материалов разного строения, в разном деформированном состоянии, в которых основные рабочие слои имеют нанометровую толщину. Необходимо также учитывать, что концентрация и подвижность носителей заряда в канале двумерного газа нитридных гетероструктур определяются не только структурным совершенством слоев, но и упругими деформациями в этих слоях, которые влияют на величину пьезоэлектрического заряда и, как следствие, на концентрацию носителей заряда в канале. Поэтому так важна оценка состояния и совершенства кристаллической структуры отдельных слоев, нитридных гетероструктур, а также возможность отслеживания изменения напряженно-деформированного состояния этих слоев в процессе проведения различных технологических операций. Для этой цели необходима разработка способов измерения отражений как от плоскостей, параллельных поверхности гетероструктуры, так и от плоскостей, лежащих под углом к поверхности. Для контроля изменения кристаллической структуры слоев гетероструктур при различных воздействиях целесообразно использовать наиболее простое оборудование.
Объективным способом оценки напряженно-деформированного состояния кристаллической решетки многослойных гетероструктур является определение изменений расстояний между кристаллографическими плоскостями, расположенными под углами к направлениям действующих упругих деформаций.
Цель работы – найти возможности оценки структуры и напряженно-деформированного состояния различных кристаллографических плоскостей отдельных слоев, нитридных гетероструктур, лежащих под углом к поверхности, при использовании однокристального дифрактометра XMD-300.
ОБЪЕКТ И МЕТОДИКА ИССЛЕДОВАНИЯ
Прежде всего, необходимо было идентифицировать кристаллографические плоскости, позволяющие оценивать упругие деформации в системе. В псевдодвумерной структуре, какой является буферный слой–подложка, например, в GaN-сапфире (два размера значительно превышают третий), происходящие структурные изменения не оказывают существенного влияния на упругую деформацию кристаллической решетки по толщине слоя. Упругие деформации решетки в псевдодвумерной структуре вюрцита могут легко релаксировать по оси роста кристаллов при прохождении основной ростовой винтовой дислокации. Релаксация же в других направлениях резко затруднена не только из-за значительного превышения размеров слоя в этих направлениях по сравнению с направлением, ортогональным базовой плоскости, но и из-за возможных дислокационных ступеней при пересечении кристаллографических систем скольжения дислокаций. Поэтому контролировать степень несовершенства кристаллических псевдодвумерных структур имеет смысл только по полученным при асимметричных съемках картинам дифракции на плоскостях, находящихся под углом к базовой плоскости. Как известно, относительное изменение периода кристаллической решетки зависит от угла дифракции: Δd/d = –Δθ ctg θ, т.е. чем больше угол дифракции, тем точнее измерения. С другой стороны, увеличение угла наклона отражающей плоскости к базовой уменьшает интерполяцию при определении упругих деформаций кристаллической решетки вюрцита. В этой ситуации нужно искать компромиссное решение. В связи с этим картины дифракции на кристаллографических плоскостях, лежащих под углом к базисной плоскости, могут дать большую информацию о кристаллической структуре слоя, чем картины дифракции, полученные при измерении по обычной схеме рентгеновской съемки (θ–2θ-сканирование). Чем больше угол наклона плоскости к базисной плоскости и чем больше угол дифракции, тем более точным будет измерение центра тяжести кривой отражения. Для возможности выхода дифрагированного луча из измеряемого слоя необходимо согласовать угол падения α с углом дифракции ${\theta }$. Заметим, что в случае обычных схем дифракции эти нюансы не фиксируются в принципе, так как все повороты проходят непосредственно в базовой плоскости слоев гетероструктуры. Таким образом, получение рефлексов от такого рода плоскостей возможно только в случае применения рентгеновских асимметричных схем измерений.
Конструкция используемого при измерениях дифрактометра XMD-300 дает возможность наклонять дугу гониометра с расположенными на ней рентгеновской трубкой и детектором на угол от 0° до 45° с шагом 0.1°, и позволяет вывести в отражающее положение любую кристаллографическую плоскость, нормаль к которой находится в широтной зоне гномостереографических проекций от 0° (полюс) до 45° (45 широта). Угловые положения линейного координатного детектора и рентгеновской трубки с рентгенооптическим поликапиллярным коллиматором произвольны в своем квадранте [4].
Для исследования была выбрана гетероструктура AlGaN/GaN/Al2O3, которая наиболее широко используется в производстве НЕМТ-транзисторов. Для получения информации об отдельных слоях гетероструктуры AlGaN/GaN/Al2O3 изучали экспериментальные двухслойные структуры GaN/Al2O3 с толщиной слоя GaN 3 мкм и AlN/Al2O3 с толщиной слоя AlN 2 мкм.
Предварительно анализировали картину дифракции на базовых кристаллографических плоскостях – исследовали отражения $0002$, $0004$ и $0006$ от слоев AlN, GaN и Al2O3. Разработанный алгоритм расчета углов падения рентгеновского первичного пучка и выхода дифрагированного пучка по отношению к поверхности гетероструктуры AlN/GaN/Al2O3, а также углов дифракции для определенных кристаллографических плоскостей этих материалов позволил получить отражения от плоскостей $(10\bar {1}4),$ $(10\bar {1}3),$ $(11\bar {2}2),$ лежащих под углом к поверхности гетероструктуры (базисная плоскость $\left( {0001} \right)$), и оценить структурные изменения этих плоскостей по соответствующим им рефлексам.
Для исследования особенностей кристаллической структуры слоев непосредственно гетероструктуры AlGaN/GaN/Al2O3 с переходным слоем AlN между подложкой и буферным слоем в соответствии со сказанным выше были выбраны плоскости $(10\bar {1}3),$ и $(10\bar {1}4),$ лежащие под углом к базисной плоскости и перпендикулярные плоскости дифракции. Угол дифракции для более “крутой” по отношению к поверхности GaN плоскости $(10\bar {1}3),$ соответствует 35.64° при угле падения первичного рентгеновского пучка на поверхность гетероструктуры α = 51.65°. Угол дифракции для плоскости $(10\bar {1}3)$ AlN соответствует 36.70° при α = 55.75°. Для оценки степени совершенства кристаллической решетки слоев GaN и AlN, т.е. величины отклонения ее от идеальной решетки монокристалла, выбран метод пошагового (шаг 0.2°) наклона плоскости дифракции. В этом случае характер пошагового изменения интенсивности рефлексов будет определять отличие от распределения интенсивности в идеальном кристалле.
ЭКСПЕРИМЕНТАЛЬНЫЕ РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
Экспериментальные результаты, полученные при асимметричных съемках гетероструктур GaN/Al2O3 и AlN/Al2O3. Экспериментальные результаты, полученные при асимметричных съемках структур GaN/Al2O3 и AlN/Al2O3, представлены на рис. 1. На рис. 1а показаны рефлексы $10\bar {1}4,$ снятые при последовательных наклонах плоскости дифракции с шагом 0.2°. Видно, что наклон не приводит к перераспределению интенсивности между двумя пиками, а просто уменьшает интенсивность каждого. Вероятно, два максимума соответствуют двум областям когерентного рассеяния (ОКР) в GaN с малым различием межплоскостных расстояний. Расщепление рефлекса AlN, полученного при таких же наклонах плоскости дифракции (рис. 1б), отсутствует, что свидетельствует о большей равномерности периода решетки.
Рис. 1.
Изменение профилей дифракционных отражений $10\bar {1}4$ (а, б) и $10\bar {1}3$ (в, г) в GaN (а, в) и AlN (б, г) при последовательных пошаговых наклонах плоскости дифракции.

Угловое расстояние между рефлексами $10\bar {1}3\quad$ от ОКР GaN равно 0.07° (237″) (рис. 1в). Пошаговый наклон (шаг 0.2°, число экспозиций 8) плоскости дифракции $(10\bar {1}3)$ (относительно нормали к поверхности гетероструктуры $\left( {0001} \right)$) приводит лишь к постепенному выходу ОКР из отражающего положения (на последних двух шагах интенсивность отражений сливается с фоном). Общее соотношение интенсивностей отражения от двух ОКР сохраняется.
Наиболее отчетливо проявляется расщепление именно рефлекса $10\bar {1}3$ (рис. 1в). Следует отметить, что угловое расстояние между максимумами на рис. 1в в два раза меньше углового расстояния между максимумами Kα дублета (CuKα1–CuKα2) для этого угла дифракции. Следовательно, наблюдаемое расщепление рефлекса связано с наличием двух ОКР. Для рефлекса $10\bar {1}3$ AlN величина расщепления находится в пределах ошибки измерения (рис. 1г). Таким образом, наблюдается расщепление отражений от обеих плоскостей слоя GaN. Рассмотрим возможные причины расщепления рефлекса (рис. 2).
Рис. 2.
Схема расщепления рефлексов, связанного с небольшим различием межплоскостных расстояний в ОКР (а) и с разориентацией ОКР с одинаковыми межплоскостными расстояниями (б).

На облучаемом участке (размер 0.2 × 6 мм) могут находиться одна или две ОКР с одной и той же базисной плоскостью, но по-разному ориентированные относительно нормали к этой плоскости. На отражение от базисной плоскости это не повлияет (в случае симметричной съемки), однако при использовании асимметричных схем съемки отражение от плоскостей, лежащих под углом к базисной плоскости, наступает лишь при равенстве угла падения на них первичного рентгеновского пучка и угла дифракции для этого семейства плоскостей.
В случае, когда на облучаемом участке находятся две ОКР с различными межплоскостными расстояниями (рис. 2а) (они могут быть рядом, или одна под другой), каждая из этих ОКР в пределах угловой сходимости первичного рентгеновского пучка (±12 угл. мин) формирует свой дифракционный максимум, т.е. происходит расщепление рефлекса. Отражение происходит непосредственно в плоскости дифракции, поэтому ее последовательные наклоны приводят лишь к равномерному уменьшению интенсивности всех рефлексов.
В случае, когда две ОКР с одинаковыми межплоскостными расстояниями разориентированы на небольшой угол (менее 15°) (рис. 2б), наклон плоскости дифракции будет приводить либо к расхождению, либо к сближению рефлексов (в зависимости от знака изгиба решетки), а также к перераспределению интенсивности между рефлексами. Именно это и позволяет определить угловую величину границы между ОКР путем поворота самой гетероструктуры вокруг нормали к ее поверхности.
Следует отметить, что гипотетически в случае прохождения малоугловой границы между двумя ОКР (рис. 2б) одинаково равномерное уменьшение интенсивности отражения от каждой ОКР при пошаговом наклоне плоскости дифракции возможно только в том случае, когда наклон осуществляется вдоль биссектрисы угла между одноименными кристаллографическими плоскостями двух ОКР. Такая ситуация крайне маловероятна в кристаллографической практике. В связи с этим полученные экспериментальные результаты пошагового наклона плоскости дифракции дают основание предположить, что дифракционная картина (рис. 1а, 1в) сформирована двумя близко расположенными ОКР с различными межплоскостными расстояниями, и ни о какой малоугловой границе между ними речи не идет.
Из рис. 1б и 1г следует, что в массиве AlN при росте на подложке сапфира не формируется структура с двумя ОКР, так как не наблюдается раздвоение рефлексов $10\bar {1}4$ и $10\bar {1}3$. Более того, при первых шести последовательных наклонах плоскости дифракции в AlN интенсивность отражения не уменьшается вследствие наличия набора близких межплоскостных расстояний, в то время как в GaN на шестом шаге наклона интенсивность падает почти до нулевой отметки.
Переходный слой на границе раздела структур GaN/Al2O3 и AlN/Al2O3. При проведении асимметричных съемок структур GaN/Al2O3 было получено отражение малой интенсивности $\quad11\bar {2}2.$ Угол установки трубки при появлении этого рефлекса соответствовал углу дифракции для плоскости $\left( {11\bar {2}2} \right)$ (рис. 3а, интенсивность близка к нулю). Это не должно было бы наблюдаться в структурах исследуемых материалов при положении плоскости дифракции с нормалью $[10\overline {1\quad} 0]$ на гномостереографической проекции выхода нормалей к отражающим плоскостям в случае гексогональной системы с осью проекции $\left[ {0001} \right],$ так как это отражение лежит на меридиане $[11\overline {2\quad} 0]$ (рис. 4а). Это наблюдение позволило предположить, что часть плоскостей ($11\overline {2\quad} 2)$ не соответствует общему пространственному расположению семейств плоскостей $\{ 11\bar {2}2\} ,$ т.е. меридиан выхода направлений $[11\overline {2\quad} 0]$ для некоторых плоскостей $\left( {11\bar {2}2} \right)$ занимает положение $[10\overline {1\quad} 0]\quad$ (рис. 4а).
Рис. 3.
Кривые дифракционных отражений $11\bar {2}2\quad$ при последовательных пошаговых наклонах плоскости дифракции в GaN (а) и при повороте гетероструктуры GaN/Al2O3 на азимутальный угол: 10° (б); 30° (в).

Рис. 4.
Схема расположения узлов обратной гексагональной плотноупакованной решетки с полюсом проекции $\left[ {0001} \right]$ (а) и соотношение между периодами решеток Al2O3 и AlN при взаимном повороте базовых плоскостей на азимутальный угол 30° (б).

Поворот всей гетероструктуры вокруг нормали к базисной плоскости $\left( {0002} \right)$ (на рис. 4а $\left( {0001} \right)$) на азимутальный угол 10° приводит к увеличению интенсивности первого отражения (до начала наклонов плоскости дифракции) (рис. 3б) и показывает, что азимутальный поворот всей гетероструктуры следует продолжить до фиксации максимальной интенсивности отражения без наклонов плоскости дифракции. Максимальная интенсивность отражения наблюдается при повороте гетероструктуры на азимутальный угол 30° (рис. 3в), что соответствует половине периодического угла (минимального угла поворота кристаллической решетки вокруг нормали к базисной плоскости, при котором все узлы решетки вновь совпадают) для гексагональной решетки GaN, т.е. наблюдается как бы поворот гексагональной решетки GaN относительно гексагональной решетки Al2O3 на половину периодического угла (рис. 4б).
Разделение двух ОКР малоугловой границей приводит при наклонах к совершенно иному распределению интенсивностей отражений от этих областей, чем в отсутствие малоугловой границы и при различии межплоскостных расстояний в этих ОКР. На рис. 3а, 3б показано, как с изменением угла наклона плоскости дифракции рефлексы от двух ОКР с одинаковым межплоскостным расстоянием и проходящей между ними границей расходятся относительно друг друга.
Максимальная интенсивность рефлекса $11\bar {2}2$ наблюдалась при повороте образца на азимутальный угол 30°. Она на два порядка больше, чем до поворота, но соответствует интенсивности отражения от других плоскостей, ортогональных плоскости дифракции (рис. 3в).
Это свидетельствует о том, что в исследуемых структурах, очевидно, существует переходный слой между подложкой Al2O3 и массивным эпитаксиальным слоем, кристаллическая решетка которого повернута на азимутальный угол 30° относительно нормали к базисной плоскости.
В переходном слое, очевидно, присутствуют как малоугловые границы между ОКР, так и ОКР с разными межплоскостными расстояниями (рис. 3а). Как видно из сравнения кривых дифракционных отражений (рис. 3а, 3б), поворот гетероструктуры на азимутальный угол 10° резко изменяет картину распределения интенсивностей отражений от плоскостей $\left( {11\bar {2}2} \right)$ переходного слоя между GaN и Al2O3 при пошаговом изменении угла наклона плоскости дифракции. Если в отсутствие азимутального поворота интенсивность отражения увеличивается на первых трех шагах, а затем на последующих шагах уменьшается (рис. 3а), то после поворота структуры на 10° интенсивность отражения монотонно возрастает с увеличением угла наклона плоскости дифракции (рис. 3б). В обоих случаях с увеличением угла наклона изменяется угол, соответствующий максимуму интенсивности отражения. Это является подтверждением того, что в переходном слое наблюдаются несколько ОКР, разделенных малоугловыми границами.
При переходе к отражению от плоскостей $\left( {11\bar {2}2} \right)$ массива GaN (поворот структуры на азимутальный угол 30°) и малоугловые границы, и неравномерность распределения межплоскостных расстояний исчезают (рис. 3в). Толщина переходного слоя в структуре GaN/Al2O3, определенная по отношению интенсивностей отражений $11\bar {2}2$ в массиве GaN и переходном слое, составила ≈0.025 мкм.
Полученные экспериментальные результаты подтверждают теоретическую модель Трамперта [5], в которой эпитаксиальный слой GaN, выращенный на сапфире $\left( {0001} \right),$ должен расти с разворотом на 30° по отношению к подложке, что приводит к значительному уменьшению несоответствия параметров решеток от 33 до 15%.
Таким образом, экспериментально показано формирование зародышевого слоя AlN на границе раздела GaN–Al2O3 в технологическом процессе эпитаксиального роста слоя GaN на сапфировой подложке.
Предложенная теоретическая модель роста AlN показывает, что при аномально большой величине несоответствия параметров решеток в базовых плоскостях AlN $\left( {0001} \right)$ и сапфира $\left( {0001} \right),$ равной 0.35, рост AlN на сапфире возможен, если его решетка поворачивается вокруг нормали к базовым плоскостям на 30° по отношению к сапфиру, что приводит к определенному расположению кристаллографических плоскостей: AlN$\left( {0001} \right)$ || || Al2O3$\left( {0001} \right)$ и AlN$\left( {2\bar {1}\quad\bar {1}0} \right)$ || Al2O3$\left( {1\bar {1}00} \right)\quad$ (рис. 4б) [5].
Асимметричные съемки гетероструктуры AlN/Al2O3 дали возможность, так же как и в случае GaN, обнаружить отражение $11\bar {2}2,$ индуцированное переходным слоем между сапфиром и нитридом алюминия, и то же отражение при повороте на азимутальный угол 30°, связанное с массивом слоя AlN.
Оценку кристаллической структуры буферных слоев гетероструктур, используемых в производстве HEMT-транзисторов, проводили на образцах, в которых буферные слои были принудительно легированы примесями углерода и железа.
Экспериментальные результаты, полученные при использовании симметричной и асимметричной схем измерения гетероструктур AlGaN/GaN с буферными слоями GaN(C) и GaN(Fe). Известно, что для увеличения сопротивления буферного слоя GaN в технологическом процессе эпитаксиального выращивания структур AlGaN/GaN/Al2O3 и AlGaN/GaN/SiC его легируют углеродом (С) и железом (Fe), которые являются акцепторами в GaN и могут компенсировать остаточные доноры в этом слое [6–11]. Поэтому актуально выявить особенности кристаллической структуры GaN, в которую внедрены атомы этих примесей. Для оценки влияния углерода, вводимого в буферный слой GaN, были исследованы гетероструктуры: iGaN/iAlGaN/iGaN/iGaN(C)/α-Al2O3 с двухслойным буферным слоем GaN, легированным С в концентрации ~3 × 1018 см–3 (толщина 2 мкм) и не легированным (толщина 0.3 мкм). Для оценки влияния железа, вводимого в буферный слой GaN, изучали гетероструктуру GaN/AlGaN/ GaN(Fe)/GaN/α-Al2O3; буферный слой GaN(Fe) толщиной 2 мкм c концентрацией Fe, близкой к концентрации С.
На рис. 5 приведены кривые дифракционных отражений 0002, 0004, 0006, полученные в симметричной схеме съемки гетероструктуры с двойным буферным слоем (слои GaN толщиной 0.3 мкм и GaN(С) толщиной 2 мкм). Введение углерода в кристаллическую решетку GaN приводит к незначительному увеличению периода решетки, хорошо различимому лишь в случае отражения шестого порядка.
Рис. 5.
Кривые дифракционных отражений второго (а), четвертого (б) и шестого (в) порядков от базовой плоскости $\left( {0001} \right)$ слоя GaN, нелегированного (1) и легированного углеродом (2). Величина углового расщепления рефлекса 0006 составляет 0.23°.

Элементарная ячейка вюрцита представляет собой три ряда тетрапор со следующим отношением размеров по оси z: два ряда заполненных тетрапор 5/8z и один ряд незаполненных тетрапор 3/8z. Центры тетрапор в двух рядах заселены атомами Ga или N, а в третьем ряду они вакантны (рис. 6). Согласно литературным данным [8] С занимает в кристаллической решетке GaN (вюрцит) центры тетрапор. Плоскость $\left( {10\bar {1}3} \right)$ проходит непосредственно через расположенный в тетрапоре атом С (рис. 6). Изменение кристаллической структуры GaN, связанное с внедрением углерода, оценивали, сравнивая картины отражения от кристаллографических плоскостей в буферных слоях GaN с атомами углерода и без них. Согласование углов падения и дифракции ${\theta }$ позволяет провести съемку с использованием асимметричной рентгеновской схемы при скользящем дифрагированном пучке.
Рис. 6.
Кристаллическая структура буферного слоя GaN, легированного углеродом. Отмечен атом углерода, через который проходит плоскость $\left( {10\bar {1}3} \right).$

Вид профилей отражений $10\bar {1}3$ свидетельствует о том, что в нелегированном слое GaN формируется кристаллическая структура с четко выраженными разделенными ОКР (рис. 7а), легирование углеродом приводит к формированию одноблочной структуры (рис. 7б). Наклоны плоскости дифракции приводят к прогнозируемому уменьшению интенсивности отражения в соответствии с гауссовым распределением ориентации ОКР (рис. 7а, 7б), на что указывает неизменность положения центра тяжести максимума при наклонах плоскости дифракции.
Рис. 7.
Кривые дифракционных отражений $10\bar {1}3,$ (а, б) и $10\bar {1}4$ (в, г) нелегированного GaN (а, в) и легированного углеродом (б, г) при последовательных пошаговых наклонах плоскости дифракции.

Профиль отражения от плоскости $\left( {10\bar {1}4} \right)$, близко лежащей к плоскости $\left( {10\bar {1}3} \right)$ гексагональной решетки слоя GaN, не легированного углеродом (рис. 7в), частично повторяет профиль отражения от плоскости $\left( {10\bar {1}3} \right).$ Легирование углеродом, занимающим в кристаллической решетке GaN нижний ряд вакантных тетрапор, приводит к возникновению одного рефлекса $10\bar {1}3$, что свидетельствует об упорядочении структуры в данной плоскости. Однако при внедрении углерода профиль рефлекса $10\bar {1}4$ уширяется (рис. 7г), т.е. упорядочение близлежащей плоскости $\left( {10\bar {1}3} \right)$ вызывает дополнительные нарушения в плоскости $\left( {10\bar {1}4} \right).$
Таким образом, полученные при асимметричной съемке результаты показывают, что введение углерода в GaN при определенном технологическом процессе выращивания приводит к изменению структуры GaN, а именно к заполнению вакантных тетрапор в кристаллической решетке и появлению одного рефлекса $10\bar {1}3$ на дифракционной картине.
При введении Fe в буферный слой GaN гетероструктур AlGaN/GaN необходимо учитывать особенности атомов железа – их низкое сродство к атомам Ga и высокое сродство друг к другу, приводящее к формированию конгломератов. Естественно, что из тетрапор, образованных четырьмя атомами Ga, железо будет вытесняться в центры тетрапор, образуемых атомами азота. Данная ситуация может привести к тому, что в некоторых элементарных ячейках третий ряд тетрапор, формируемых атомами азота, будет заполняться атомами Fe, и такие ряды, ввиду высокого сродства Fe друг к другу, будут стремиться к воссоединению. Нарушится естественное чередование заряженных слоев азота и галлия в элементарных ячейках, обеспечивающее электростатический баланс. Для сохранения электронейтральности необходим будет больший период. Это обязательно должно отразиться на профиле отражения от GaN при больших углах дифракции – на кривой должен появиться дополнительный пик в области меньших углов, так как заполнение пустой тетрапоры ионом Fe увеличит период решетки в направлении, ортогональном базису (рис. 8). Это изменение угла дифракции столь мало, что проявляется в расщеплении рефлекса только шестого порядка и составляет менее половины углового расстояния между максимумами Kα1–Kα2. Такое расщепление рефлекса 0006, причем на ту же самую величину 0.23° (рис. 8), наблюдалось на кривой дифракционного отражения GaN, легированного С.
Рис. 8.
Кривые дифракционных отражений шестого порядка от базовой плоскости (0001) слоя GaN (1) и слоя GaN, легированного Fe (2), при последовательных пошаговых наклонах плоскости дифракции. Величина углового расщепления рефлекса 0006 составляет 0.23°.
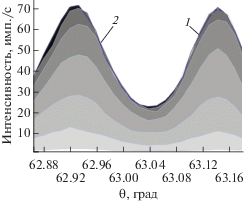
Кристаллическая решетка GaN принимает в свои свободные тетрапоры атомы Fe. Из-за большего по сравнению с Ga и N ионного радиуса железа одна из связей (обычно не лежащая в плоскости, параллельной базисной плоскости) становится длиннее и изменяет межплоскостные расстояния в слоях, параллельных базисной плоскости [12]. Асимметричные съемки гетероструктуры со слоем GaN, легированным железом, проводили только для плоскости $\left( {10\bar {1}3} \right),$ так как она проходит через тетрапоры, в которых, как правило, находятся атомы примесей. Результаты показали полную идентичность отражений от этой плоскости для гетероструктур с буферными слоями GaN(Fe) и GaN(C). Идентичность дифракционных картин, полученных с использованием симметричной и асимметричной схем измерений для гетероструктур с буферными слоями GaN(Fe) и GaN(C) (рис. 5в, 8), дает основание предположить, что легирование железом приводит к таким же изменениям кристаллической решетки GaN, как и легирование углеродом.
ВЫВОДЫ
Использование асимметричных схем съемок на однокристальном дифрактометре XMD-300 для тестовых структур нитридов на сапфире позволило получить отражения от плоскостей, лежащих под большим углом к поверхности и наиболее подверженных упругим деформациям. Экспериментальные исследования отражений $10\bar {1}4$ и $10\bar {1}3$ выявили в буферном слое GaN два блока (ОКР), разориентированных на угол 0.07°.
Анализ отражения $11\bar {2}2$ позволил обнаружить на границе раздела GaN–сапфир переходный слой, базисная плоскость которого повернута на азимутальный угол 30° относительно базисной плоскости сапфира. По отношению интенсивностей отражений от переходного слоя и массива GaN оценена толщина переходного слоя, составляющая 0.025 мкм. Экспериментально подтверждена теоретическая модель роста слоев AlN и GaN на Al2O3, предложенная Трампертом с соавторами.
Асимметричная съемка показала, что введение углерода и железа в GaN при определенном технологическом процессе выращивания приводит к изменению структуры GaN, а именно к заполнению вакантных тетрапор в кристаллической решетке, через которые проходит плоскость $\left( {10\bar {1}3} \right).$ Профиль отражения от этой плоскости в GaN, легированном углеродом, не расщеплен, в отличие от расщепленного рефлекса, соответствующего ОКР в нелегированном слое GaN. Плоскости $\left( {10\bar {1}3} \right)$ гексагональной решетки буферного слоя GaN, легированного углеродом и железом, становятся плотнее упакованными, т.е. плоскостями наилучшего скольжения. В дальнейшем они могут служить основными путями релаксации упругих деформаций кристаллической решетки слоя GaN, легированного этими примесями.
Список литературы
Васильев А.Г., Колковский Ю.В., Концевой Ю.А. СВЧ приборы и устройства на широкозонных полупроводниках. М.: Техносфера, 2011. 415 с.
Gallium Nitride (GaN): Physics, Devices and Technology / Ed. Medjdoub F., Iniewski K. Boca Raton–London–New York: CRC Press Taylor & Francis Group, 2016. 373 p.
Japan Eyes Communication Networks with Record-Breaking Transistors // Compound Semiconductor. 2006. V. 12. № 11. P. 31.
Енишерлова К.Л., Лютцау А.В., Темпер Э.М. Однокристальная рентгеновская дифрактометрия гетероструктур. М.: Юлис, 2016. 144 с.
Trampert A., Brandt O., Ploog K.H. // Semiconductors and Semimetals. V. 50. Ch. 7. New York: Academic Press, 1998. P. 167.
Lipski F. // Ann. Rep. Institute of Optoelectronics Ulm University, 2010. P. 63.
Chen J.-T., Forsberg U., Janzén E. // Appl. Phys. Lett. 2013. V. 102. Iss. 19. P. 193506.
Agrawal M., Singh Sh.P., Chaturvedi N. // Int. J. ChemTech Res. 2014–2015. V. 7. № 2. P. 921.
Kim D.-S., Won Ch.-H., Kang H.-S. et al. // Semicond. Sci. Tech. 2015. V. 30. P. 035010.
Lei C., Haibo Y., Lijuan J. et al. // J. Semicond. 2015. V. 36. № 10. P. 103002.
Fariza A., Lesnic A., Neugebauer S. et al. // J. Appl. Phys. 2017. V. 122. P. 025704.
Окишев К.Ю. Кристаллохимия и дефекты кристаллического строения. Челябинск: Изд-во ЮУрГУ, 2007. 97 с.
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования


