Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2019, № 9, стр. 54-66
Определение толщин тонких пленок методами растровой электронной микроскопии и энергодисперсионного рентгеновского анализа (обзор)
С. А. Соколов 1, 2, *, Р. А. Милованов 2, 3, Л. Н. Сидоров 1
1 Московский государственный университет им. М.В. Ломоносова
119991 Москва, Россия
2 Институт нанотехнологий микроэлектроники РАН
119991 Москва, Россия
3 Московский технологический университет
119454 Москва, Россия
* E-mail: sokolovsa48@gmail.com
Поступила в редакцию 16.12.2018
После доработки 17.01.2019
Принята к публикации 20.01.2019
Аннотация
Обзор посвящен современным методикам неразрушающего определения толщин тонких пленок методами растровой электронной микроскопии и энергодисперсионного рентгеновского анализа. Описан общий подход к определению толщин тонких пленок этими методами. Подробно рассматриваются конкретные методики определения толщин тонких пленок, их преимущества и недостатки.
I. ВВЕДЕНИЕ
Твердые тонкие пленки применяются во многих областях науки и техники: в оптике (просветляющих, светоотражающих и защитных покрытиях), машино- и приборостроении (функциональных покрытиях, увеличивающих прочность и износостойкость изделий), медицине (в качестве основы биосенсоров), микроэлектронике (в качестве диэлектрических слоев, слоев проводников), как магнитные покрытия в носителях данных (жестких дисках, магнитных лентах), при изготовлении фотовольтаических батарей (тонкопленочных солнечных батарей на основе смешанных халькогенидов металлов) [1–3]. Для всех перечисленных областей науки и техники важно развитие методов надежного и быстрого контроля качества наносимых твердых тонких пленок. Их механические свойства наряду с химическим составом решающим образом зависят от толщины и распределения элементного состава по толщине и по поверхности пленки. Например, электрическое сопротивление твердых тонких пленок (при равномерном распределении элементов в пленке) прямо пропорционально их толщине [4], а для ряда бинарных систем зависимость состав–свойства является немонотонной [5].
В большинстве случаев для определения основных структурных характеристик твердых тонких пленок (состава, толщины и плотности) требуются неразрушающие методы анализа, т.е. пленка должна сохранять свои свойства после анализа. Существует ряд неразрушающих методов определения толщин твердых тонких пленок: эллипсометрия, лазерная интерферометрия, энергодисперсионный рентгеновский анализ и растровая электронная микроскопия. Методы эллипсометрии и интерферометрии не дают полной информации об анализируемой тонкой пленке и имеют ряд ограничений на типы анализируемых объектов [6]. В частности, при разработке методов расчета и контроля толщины пленок основой служит модель идеальной пленки, аналогичной плоскопараллельной пластинке из однородного, непоглощающего вещества. Однако экспериментально полученные пленки заметно отклоняются от простой модели. Кроме того, в зависимости от условий формирования пленки могут быть получены различные модификации одного и того же вещества, отличающиеся показателем преломления, который необходимо знать для точного определения толщины пленки [6]. В отличие от оптических методов (эллипсометрии и интерферометрии) применение растровой электронной микроскопии (РЭМ) и энергодисперсионного рентгеновского анализа (ЭДРА) позволяет получать бóльшее число данных об исследуемом образце. В современной литературе описан ряд методик, позволяющих определять толщины твердых тонких пленок с использованием методов РЭМ–ЭДРА [7–13]. Ключевую роль в данном случае играет метод ЭДРА, а РЭМ используется только в качестве источника сфокусированного пучка электронов, возбуждающего характеристическое рентгеновское излучение в анализируемом образце.
Настоящая работа посвящена обзору существующих методик ЭДРА определения толщин твердых тонких пленок, их преимуществ и недостатков. Помимо методик, основанных на использовании в качестве основного инструментального метода ЭДРА, существуют методики, основанные на использовании одновременно двух и более инструментальных методов [14–17]. Однако ввиду их трудоемкости и малой распространенности их рассмотрение в настоящем обзоре не предусмотрено. За последние 10 лет опубликован ряд обзоров, посвященных развитию метода ЭДРА, совершенствованию его технологической базы и решению отдельных теоретических вопросов [18–21]. Обзоры, посвященные определению толщин твердых тонких пленок методом ЭДРА, отсутствуют.
II. ОСНОВНЫЕ ТРЕБОВАНИЯ К ОБРАЗЦАМ ДЛЯ ОПРЕДЕЛЕНИЯ ТОЛЩИН ТВЕРДЫХ ТОНКИХ ПЛЕНОК С ПОМОЩЬЮ ЭДРА
Определение толщин твердых тонких пленок с использованием метода ЭДРА основывается на анализе спектра рентгеновского излучения, испускаемого при взаимодействии пучка электронов с образцом (ХРИ и ТРИ). Анализ интенсивностей ХРИ и ТРИ позволяет получать данные о количественном составе анализируемого образца. На интенсивность ХРИ могут оказывать влияние несколько основных групп факторов (геометрические размеры образца, однородность его состава и устойчивость к действию пучка электронов).
К первой группе таких факторов относят геометрические параметры и состояние поверхности анализируемого образца пленки. Если толщина анализируемой пленки меньше глубины генерации ХРИ (dпленки < dХРИ) (рис. 1а), интенсивность ХРИ будет также зависеть от среднего атомного номера нижележащего материала (более подробно данный случай рассмотрен в разделе V). Если толщина пленки превышает размер области генерации ХРИ (dпленки > dХРИ) (рис. 1б), а ее поверхность плоская и гладкая, то геометрические параметры пленки не оказывают влияния на интенсивность рентгеновского излучения.
Рис. 1.
Сравнение областей генерации ХРИ в случае пленки (со средним атомным номером Z1) на подложке (со средним атомным номером Z1 ≈ Z2): а – тонкая пленка, глубина генерации ХРИ больше толщины пленки; б – объемный образец, глубина генерации ХРИ меньше толщины пленки.

Следующим фактором, влияющим на интенсивность ХРИ, является однородность образца. Поскольку ХРИ различных элементов требует разной энергии возбуждения и генерируется с различной интенсивностью внутри объема взаимодействия с электронным пучком, важно, чтобы образец имел однородный состав по всему указанному объему. В случае, когда на поверхности образца присутствует тонкая пленка, отличающаяся по составу от объемного материала, или в самом объемном материале формируется градиентное распределение одного или нескольких элементов, данная неоднородность анализируемого объекта не может быть должным образом учтена в классической процедуре ZAF-коррекции [22].
К последней группе факторов относится устойчивость анализируемого образца к действию электронного пучка. Под устойчивостью подразумевается отсутствие деформации, повреждения или модификации поверхности, сопровождающейся изменением области взаимодействия пучка электронов с анализируемым образцом. Например, биологические и полимерные образцы подвергаются заметной деградации в процессе облучения пучком электронов с типичными для РЭМ параметрами (ток пучка 1 пА–1 мкА, ускоряющее напряжение 1–30 кВ), т.е. изменяется область взаимодействия пучка электронов с анализируемым образцом.
Учет вышеописанных факторов является трудоемкой и в большинстве случаев нерешаемой задачей. Для устранения влияния данных факторов к анализируемым методом РЭМ–ЭДРА пленкам предъявляют следующие требования: образец должен быть устойчив к действию пучка электронов (при токах 1 пА–1 мкА и ускоряющих напряжениях 1–30 кэВ), пленка должна быть однородной по составу в области генерации ХРИ, ее поверхность – плоской и гладкой, а геометрические параметры должны превышать размеры области генерации ХРИ.
В случае тонкой пленки на подложке толщина анализируемого объекта меньше или равна области генерации рентгеновского излучения (рис. 1а), а продольные размеры пленки намного больше соответствующих размеров области генерации рентгеновского излучения. В этом случае рентгеновское излучение будет генерироваться и в пленке, и в подложке. Если рентгеновское излучение подложки не полностью поглощается при прохождении через пленку, в итоговом спектре ХРИ будут присутствовать сигналы как от пленки, так и от подложки.
Для определения толщин и составов тонких пленок существует ряд подходов [7–13], включающих в себя: теоретически обоснованные экспериментальные методы; эмпирические методы, основанные на экспериментальных данных; теоретические методы, основанные на моделировании области генерации рентгеновского излучения в анализируемом образце в зависимости от параметров электронного пучка, возбуждающего рентгеновское излучение, и заранее известных данных об анализируемом образце.
III. ПЕРЕХОД ОТ АНАЛИЗА ТОНКОЙ ПЛЕНКИ К АНАЛИЗУ ОБЪЕМНОГО ОБЪЕКТА
При анализе тонких пленок влияние геометрического фактора является существенным и не всегда может быть учтено. Первый и наиболее простой подход к определению толщин тонких пленок заключается в переходе от анализа “пленки на подложке” (рис. 1а) к анализу “объемного” объекта (рис. 1б). Такой переход возможен из-за зависимости (уравнение Андерсона–Хеслера [23]) глубины генерации ХРИ от энергии возбуждающего его электронного пучка:
(1)
${{R}_{x}} = K\left( {E_{0}^{{{5 \mathord{\left/ {\vphantom {5 3}} \right. \kern-0em} 3}}} - E_{{\text{c}}}^{{{5 \mathord{\left/ {\vphantom {5 3}} \right. \kern-0em} 3}}}} \right),$Из уравнения Андерсона–Хеслера следует, что существуют значения энергии пучка электронов, при которых область генерации ХРИ находится строго в пределах анализируемой пленки, т.е. при указанных условиях можно рассматривать объект “пленка на подложке” как “объемный” (рис. 1б). В случае объемного объекта энергия пучка электронов, генерирующего ХРИ, должна быть достаточной для возбуждения всех интересующих характеристических переходов. Это означает, что для возбуждения характеристических переходов необходима величина перенапряжения (отношение энергии электронов пучка к энергии характеристического перехода) U > 1. В большинстве случаев (массовая доля основных компонентов в анализируемом образце ω > 0.1, а минорные компоненты отсутствуют) для проведения достоверного количественного анализа достаточно перенапряжение U > 1.25. Использование малых перенапряжений (U ≈ 1.25) приводит к значительным погрешностям при детектировании компонентов с массовой долей ω < 0.1.
Еще одним недостатком перехода к анализу объемного объекта при малых значениях перенапряжения является необходимость выбора характеристических переходов с меньшей энергией в элементах, используемых для количественного анализа. Например, при анализе пленки, состоящей из алюминия и цинка, для количественного анализа необходимо использовать Kα-линию Al (EK = 1.56 кэВ) и Lα-линию Zn (EL = 1.02 кэВ), а не Kα-линию Al и Kα-линию Zn (EK = 9.66 кэВ), так как такой выбор характеристических переходов позволит применять для возбуждения рентгеновского излучения пучок электронов со значительно меньшей энергией (энергия пучка 2.5 кэВ создаст необходимое перенапряжение $U > 1.25$).
Изменение области генерации ХРИ при фиксированной энергии пучка электронов также возможно за счет изменения угла наклона образца относительно пучка электронов. При наклоне образца на угол θ ≥ 60° проникновение электронного пучка вглубь образца снижается примерно на cos θ, т.е. на ~50% при θ = 60°. По этой причине при анализе стандартных и неизвестных образцов угол наклона образца относительно электронного пучка и угол наклона детектора рентгеновского излучения относительно образца должны быть постоянными.
Переход к анализу объемного объекта является одним из наиболее простых методов ЭДРА тонких пленок, позволяет определять состав анализируемой пленки и оценивать ее толщину на основе уравнения Андерсона–Хеслера. Точность и воспроизводимость результатов, получаемых при использовании данного подхода, во многом зависит от состава и толщины анализируемой пленки, а также от соблюдения условий эксперимента.
IV. АНАЛИЗ ТОНКИХ ПЛЕНОК НА ОСНОВЕ ФУНКЦИИ φ(ρz)
Определение толщин тонких пленок в общем случае основывается на данных о функции распределения интенсивности ХРИ по глубине образца φ(ρz) [24–29]. Данные о функции φ(ρz) позволяют оценивать локальность проводимых измерений и выбирать условия генерации рентгеновского излучения (энергию Е0 первичных электронов), также они необходимы для проведения ZAF-коррекции результатов измерений интенсивностей рентгеновских характеристических линий при количественном анализе. Можно выделить три основные группы методов, позволяющие определять или оценивать функцию φ(ρz) с различной степенью точности: оценочные – на основе упрощенных и нестрогих выражений, используемых при классической ZAF-коррекции [30]; аналитические выражения, использующие относительно сложные функции и учитывающие бóльшее число параметров [31]; на основе результатов математического моделирования методом Монте-Карло [32].
Вне зависимости от способа описания функции φ(ρz) данные о толщине анализируемой тонкой пленки могут быть получены методом k-факторов – по отношению интегральной интенсивности ХРИ пленки заданной толщины к интенсивности ХРИ всей области генерации. На рис. 2 представлена функция φ(ρz) для плоской объемной мишени из чистого алюминия, полученная моделированием методом Монте-Карло. Интегральная площадь под кривой φ(ρz) представляет собой интенсивность всего ХРИ, генерируемого Al при конкретном значении энергии электронного пучка, а после коррекции на поглощение эта интегральная величина соответствует интенсивности всего ХРИ, испущенного Al.
Рис. 2.
Пример функции φ(ρz) для “объемного” образца Al, полученной моделированием методом Монте-Карло при энергии возбуждающего пучка электронов 15 кэВ.

Рассмотрим образец, состоящий из пленки Al толщиной t на подложке из Al (для такого образца отсутствует граница между пленкой и подложкой). На рис. 2 пленка представлена заштрихованной областью. Площадь под этой частью кривой φ(ρz) представляет собой интенсивность ХРИ, генерированного пленкой, а после коррекции на поглощение – интенсивность ХРИ, излучаемого пленкой. По отношению интенсивностей ХРИ, испущенного пленкой и всем образцом, может быть определено значение kfilm-фактора, используемого для определения толщины тонкой пленки:
(2)
${{k}_{{{\text{film}}}}} = {{\int\limits_0^{\rho t} {\phi (\rho z)\exp \left( { - \frac{\mu }{\rho }cosec(\psi )\rho z} \right)d\rho z} } \mathord{\left/ {\vphantom {{\int\limits_0^{\rho t} {\phi (\rho z)\exp \left( { - \frac{\mu }{\rho }cosec(\psi )\rho z} \right)d\rho z} } {\int\limits_0^{\rho {{z}_{{\max }}}} {\phi (\rho z)\exp \left( { - \frac{\mu }{\rho }cosec(\psi )\rho z} \right)d\rho z} }}} \right. \kern-0em} {\int\limits_0^{\rho {{z}_{{\max }}}} {\phi (\rho z)\exp \left( { - \frac{\mu }{\rho }cosec(\psi )\rho z} \right)d\rho z} }}.$Вышеописанный случай определения k-факторов тонких пленок является модельным, поскольку невозможно отличить излучение гипотетического слоя от излучения основного объема материала, так как материал пленки и объемного образца один и тот же. В реальной ситуации тонкая пленка имеет состав, отличный от состава подложки, что приводит к резкому разрыву на кривой φ(ρz) на глубине t, равной толщине тонкой пленки. Не исключается, что один или несколько элементов могут содержаться как в материале тонкой пленки, так и в материале подложки. В этом случае для данных элементов будет наблюдаться не резкий разрыв на кривой φ(ρz), а изменение угла наклона на границе между тонкой пленкой и подложкой (рис. 3), связанное с различным рассеянием электронов на разных материалах подложки и поглощением рентгеновского излучения материалом тонкой пленки и подложки. На рис. 3 представлены фрагменты кривых φ(ρz), полученные моделированием методом Монте-Карло для пленки Al толщиной 300 нм на различных подложках при энергии пучка электронов 15 кэВ (энергия, достаточная для генерации рентгеновского излучения как в пленке, так и в материале подложки).
Рис. 3.
Функции φ(ρz) для ХРИ Al, полученные моделированием методом Монте-Карло при энергии пучка электронов 15 кэВ для пленки Al толщиной 300 нм на подложках: Al_C (1); Al_Cu (2); Al_Au (3); Al_Al (4).
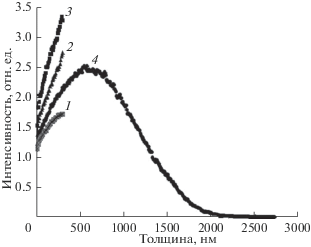
Из представленных на рис. 3 данных видно, что интенсивность ХРИ Al увеличивается с увеличением атомного номера материала подложки. Такую зависимость можно интерпретировать при рассмотрении обратного рассеяния электронов, которое происходит в области под тонкой пленкой при Zsubstrate > Zfilm. Поток обратно рассеянных электронов, проходящих через пленку, генерирует дополнительное рентгеновское излучение по сравнению со случаем, когда атомные номера пленки и подложки близки. При Zsubstrate < Zfilm уменьшение обратного рассеяния электронов приводит к более низкой интенсивности генерации рентгеновского излучения в пленке по сравнению со случаем близких атомных номеров материала пленки и подложки. Для описания функции φ(ρz) в области тонкой пленки необходимо модифицировать функцию φ(ρz) для “объемного” чистого элемента, учитывая изменение обратного рассеяния электронов на границе раздела. При проникновении пучка электронов через пленку в подложку происходит генерация ХРИ и в пленке, и в подложке. Соответственно, можно измерить два различных k-фактора (если излучение подложки не поглощается полностью пленкой): k-фактор пленки (kfilm) и k-фактор подложки (ksubstrate), причем оба k-фактора рассчитываются относительно чистых элементов пленки или подложки. После этого для толстой подложки может быть рассчитана модифицированная функция φ(ρz), учитывающая рассеяние электронов в вышележащей тонкой пленке. При расчете ХРИ подложки необходимо принимать во внимание не только поглощение рентгеновского излучения в подложке, но и поглощение в вышележащей пленке, состав которой отличается от подложки.
Расчет вышеуказанных k-факторов для пленки и подложки, определенных относительно стандартных чистых элементов (а в случае сложных соединений измеренные стандартные интенсивности пересчитываются в эквивалентную интенсивность чистого элемента), составляет основу количественного анализа тонких пленок на основе функции φ(ρz). В случае сложных многослойных структур или при наличии одинаковых элементов в пленке и подложке необходимо строить экспериментальные зависимости k-факторов от энергии электронного пучка. Постепенно увеличивая энергию электронного пучка, а, следовательно, постепенно изменяя соотношение интенсивностей сигналов от пленки и подложки, накапливают информацию и формируют базу данных о k-факторах. Полученные величины k-факторов можно сравнить с теоретически рассчитанными значениями, основанными на предполагаемых моделях толщины, состава пленки и состава подложки, для нахождения оптимальной аппроксимации итоговой функции φ(ρz).
V. ВВЕДЕНИЕ “ЭФФЕКТИВНОЙ” ФУНКЦИИ φ(ρz)
Определение структурных характеристик тонких пленок на основе функций φ(ρz), как было отмечено выше, требует большого количества поправок и наличия широкой базы данных о значениях k-факторов всех составляющих анализируемую структуру элементов, а при переходе к многослойным структурам со сложным составом слоев точность такого анализа понижается. В качестве альтернативного решения указанных проблем в [8, 9] предложена методика определения толщин двух- и трехслойных структур, основанная на введении эффективной функции распределения интенсивности ХРИ по глубине φ(ρz). Для определения вида эффективной функции φ(ρz) используется функция потерь энергии электронов от глубины их проникновения в образец ${{dE} \mathord{\left/ {\vphantom {{dE} {dx}}} \right. \kern-0em} {dx}}$ (полученная из экспериментов по рассеянию электронов на образцах тонких пленок на объемной подложке) [33].
В зависимости от соотношения энергии E0 электронного пучка и критической энергии возбуждения ХРИ EJ электронный пучок генерирует характеристическое рентгеновское излучение с энергетического уровня XJ в i-ом слое при E0> EJ. Постепенно увеличивая энергию пучка электронов, подбирают такое значение E0, при котором в итоговом спектре ХРИ одновременно присутствуют переходы XJ для всех присутствующих N-элементов (попадающих в область генерации рентгеновского излучения при данной энергии электронного пучка E0). Учитывая данные об энергии E0 и глубинах проникновения электронов в образец, можно получить информацию о профиле анализируемой слоистой структуры на основе спектра ХРИ. Так, если элемент с характеристическим переходом XJ находится на глубине di, сигнал в спектре от перехода XJ появится при энергии электронного пучка, для которой глубина проникновения в образец R(E0, Ei) ≥ di. Для упрощения интерпретации спектров ХРИ в [6] предлагается заменить функцию распределения интенсивности генерации рентгеновского излучения φ(x, E0, Zi, di) многослойной мишени, имеющую резкие разрывы, гладкой функцией для гомогенного (эффективного) материала, обладающего близкими рассеивающими свойствами. На рис. 4 проиллюстрирован принцип введения эффективного слоя – показана замена слоев Cu, Au и Al толщиной d1, d2 и d3 эквивалентным слоем, состоящим из материала с атомным номером ZD и толщиной эффективного слоя deff [8].
Рис. 4.
Функция распределения интенсивности генерации рентгеновского излучения по глубине х в реальной трехслойной мишени (а) и гипотетическом эффективном гомогенном слое (б) [9].

Рассеивающие свойства гомогенного слоя могут быть описаны с помощью коэффициента проникновения первичных электронов ${{\eta }_{T}}$ и функции энергетических потерь пучка электронов при нормальном падении на образец [34]. Последняя величина может быть описана с помощью энергетического фактора $C\left( {{{E}_{0}}} \right)$ (величина потерь энергии электронного пучка) и размерного фактора $F\left( {x,R} \right)$ (величина нормализованной толщины):
где ${x \mathord{\left/ {\vphantom {x R}} \right. \kern-0em} R}$ – нормализованная толщина – отношение переменной толщины x к максимальной глубине проникновения первичного электронного пучка R. Оба фактора F и C зависят от энергии первичного электронного пучка:(4)
$R = {{R}_{1}}{{\left( {\frac{{{{E}_{0}}}}{{{\text{кэВ}}}}} \right)}^{{1.3}}},\,\,\,\,C = {{C}_{1}}{{\left( {\frac{{{{E}_{0}}}}{{{\text{кэВ}}}}} \right)}^{{0.3}}},$Распределение потерь энергии электронного пучка при нормальном падении на образец описывается функцией Гаусса, график которой (рис. 5) смещен на х0 и искажен за счет поправочного коэффициента k1 в выражении для расчета размерного фактора F:
(5)
$F = \exp \left[ { - B{{{\left( {\frac{{x - {{x}_{0}}}}{{R\left( {E{}_{0}} \right)}}} \right)}}^{2}}} \right] + {{k}_{1}}\exp \left[ { - {{k}_{2}}\left| {\frac{{x - {{x}_{k}}}}{{R\left( {E{}_{0}} \right)}}} \right|} \right].$Рис. 5.
Функции потерь энергии электронов при нормальном падении пучка для Au (1), Cu (2), Al (3), Be (4) в зависимости от нормированной толщины x/R [9].

Подставляя выражения (4) и (5) в уравнение (3) и учитывая, что для Al (Z = 13), Si (Z = 14), SiO2 ($\bar {Z} \cong $ 10) и Al2O3 ($\bar {Z} \cong $ 9) поправочный коэффициент в выражении (5) близок к нулю (${{k}_{1}} \cong 0$), получаем аналитическое выражение (6) для функции потерь энергии электронного пучка, используемой для расчета функции φ(x, E0, Z) искомого эффективного гомогенного слоя:
(6)
$\begin{gathered} \frac{{dE}}{{dx}}\left( {x,{{E}_{0}},\bar {Z} \approx 13} \right) = 1.544\frac{{{{E}_{0}}}}{{R({{E}_{0}})}} \times \\ \times \,\,\exp \left[ { - 7.5{{{\left( {\frac{x}{{R\left( {E{}_{0}} \right)}} - 0.3} \right)}}^{2}}} \right]. \\ \end{gathered} $Функция потерь энергии электронного пучка dE/dx в многослойной мишени непрерывна и не имеет разрывов на границах между слоями, но для ее описания нет простого математического выражения. Теоретическая гомогенизация исследуемой многослойной структуры позволяет обойти наличие границ между слоями. В этом случае толщина слоя xi заменяется эффективной толщиной xi,eff. Замена осуществляется таким образом, чтобы функция потерь энергии электронного пучка dE/dx в слое толщиной xi,eff была наиболее приближена к реальной функции.
В общем случае количество электронов, а также их энергия должны сохраняться при входе в эффективный слой толщиной xi,eff. Для этого должны быть выполнены три условия.
1. Равенство нормализованных толщин x1/R1= = xeff/Reff.
В данном равенстве нормализованная толщина образца определена на основе максимальной глубины $R\left( {{{E}_{0}}} \right)$ проникновения первичных электронов в материал с плотностью ρ, рассчитанной по степенному закону [35]:
(7)
$R = 90\,\,{\text{нм}}\left( {\frac{\rho }{{{\text{г}} \cdot {\text{с}}{{{\text{м}}}^{{ - {\text{3}}}}}}}} \right){{\left( {\frac{{{{E}_{0}}}}{{{\text{кэВ}}}}} \right)}^{{1.3}}}.$2. Равенство коэффициентов проникновения первичных электронов: ${{{\eta }}_{{T1}}} = {{{\eta }}_{{T,{\text{eff}}}}}.$
Коэффициент проникновения первичных электронов также зависит от нормализованной толщины [35]:
(8)
$\begin{gathered} {{{\eta }}_{{T1}}} = \exp \left[ { - 4.605{{{\left( {\frac{{{{x}_{1}}}}{{{{R}_{1}}}}} \right)}}^{{{{p}_{1}}}}}} \right] = \\ = \exp \left[ { - 4.605{{{\left( {\frac{{{{x}_{{{\text{eff}}}}}}}{{{{R}_{{{\text{eff}}}}}}}} \right)}}^{{{{p}_{{{\text{eff}}}}}}}}} \right] = {{{\eta }}_{{T,{\text{eff}}}}}. \\ \end{gathered} $Показатели степени р1 и рeff зависят от среднего атомного номера $\bar {Z}$ анализируемого материала [36, 37]. Преобразовав выражение (8), получаем модифицированное степенное уравнение, определяющее равенство коэффициентов проникновения первичных электронов:
(9)
$\left( {\frac{{{{x}_{1}}}}{{{{R}_{1}}}}} \right) = {{\left( {\frac{{{{x}_{{{\text{eff}}}}}}}{{{{R}_{{{\text{eff}}}}}}}} \right)}^{{{{{{p}_{{_{{{\text{eff}}}}}}}} \mathord{\left/ {\vphantom {{{{p}_{{_{{{\text{eff}}}}}}}} {{{p}_{1}}}}} \right. \kern-0em} {{{p}_{1}}}}}}}.$3. Равенство средних значений энергии первичных электронов с учетом коэффициентов проникновения ${{{\eta }}_{{T1}}}{{\bar {E}}_{1}}$ = ${{{\eta }}_{{T,{\text{eff}}}}}{{\bar {E}}_{{{\text{eff}}}}}.$
Данное равенство позволяет учитывать не только долю электронов ${{{\eta }}_{T}},$ проникших на определенную глубину в образец, но и их среднюю энергию $\bar {E}.$ Подставляя выражения для соответствующих величин в вышеуказанное равенство, получаем:
(10)
$\begin{gathered} \exp \left[ { - 4.605{{{\left( {\frac{{{{x}_{1}}}}{{{{R}_{1}}}}} \right)}}^{{{{p}_{1}}}}}} \right]0.92{{E}_{0}}\exp \left[ { - \left( {\frac{{{{x}_{1}}}}{{{{R}_{1}}}}} \right)} \right] = \\ = \exp \left[ { - 4.605{{{\left( {\frac{{{{x}_{{{\text{eff}}}}}}}{{{{R}_{{{\text{eff}}}}}}}} \right)}}^{{{{p}_{{{\text{eff}}}}}}}}} \right]0.92{{E}_{0}}\exp \left[ { - \left( {\frac{{{{x}_{{{\text{eff}}}}}}}{{{{R}_{{{\text{eff}}}}}}}} \right)} \right], \\ \end{gathered} $где зависимость средней энергии $\bar {E}$ от нормализованной толщины x/R может быть одинакова для элементов с различными атомными номерами Z [38]. Решение уравнение (10) позволяет определить “эффективную” толщину материала с нужным средним атомным номером $\bar {Z},$ заменяющего слой толщиной х1 с атомным номером Z1. С другой стороны, сокращая одинаковые множители в правой и левой частях выражения (10) и логарифмируя оставшееся выражение, получаем уравнение (11):
(11)
$\begin{gathered} c = 4.605{{\left( {\frac{{{{x}_{{{\text{eff}}}}}}}{{{{R}_{{{\text{eff}}}}}}}} \right)}^{{{{P}_{{{\text{eff}}}}}}}} + \frac{{{{x}_{{{\text{eff}}}}}}}{{{{R}_{{{\text{eff}}}}}}} = \\ = 4.605{{\left( {\frac{{{{x}_{1}}}}{{{{R}_{1}}}}} \right)}^{{{{P}_{{{\kern 1pt} 1}}}}}} + \frac{{{{x}_{1}}}}{{{{R}_{1}}}} = {\text{const}}{\text{.}} \\ \end{gathered} $В графической форме уравнение (11) позволяет переходить от нормализованной толщины исходного слоя к нормализованной толщине искомого эффективного слоя. На рис. 6 представлен переход от нормализованной толщины слоя Au к эффективной толщине слоя Al, обладающего аналогичными рассеивающими свойствами.
Рис. 6.
Нормализованные толщины слоев с различных материалов, полученные с использованием уравнения (11) [7], цифрами возле кривых указаны показатели степени р (для Au – 1.3, Ag – 1.5, Cu – 1.6, Al – 2.0).

Результаты применения метода “эффективного” слоя описаны в [8, 9]. В одном случае авторы указывают на успешное применение данного подхода [8], в другом – на отрицательный результат ввиду большого разброса полученных этим методом результатов [9]. Однако авторы [9] связывают неудовлетворительные результаты с уменьшением разрешения (т.е. с увеличением разброса данных) при увеличении глубины генерации рентгеновского излучения.
VI. МЕТОДИКИ НА ОСНОВЕ УРАВНЕНИЯ БЕТЕ
Пытаясь упростить определение толщины тонких одноэлементных пленок, авторы [10] предложили подход, основанный на использовании математической модели Канайи–Окаямы [22] для расчета глубины проникновения электронного пучка и глубины генерации рентгеновского излучения, определенной Бете как
(12)
${{R}_{{{\text{Bethe}}}}} = {{27.6AE_{0}^{{1.67}}} \mathord{\left/ {\vphantom {{27.6AE_{0}^{{1.67}}} {\rho {{Z}^{{0.89}}}}}} \right. \kern-0em} {\rho {{Z}^{{0.89}}}}}.$В [10] определяли толщины пленок Al, Ni и Au на подложке из Si. Для экспериментального определения RBethe использовали электронный пучок с энергией, при которой происходило детектирование 5 ат. % Si вне зависимости от толщины вышележащей пленки. На рис. 7 представлены для сравнения экспериментальные данные для RBethe пленок Al, Ni и Au и теоретически рассчитанные значения.
Рис. 7.
Зависимости RBethe от $E_{0}^{{1.67}}$ для пленок Al (треугольники), Ni (квадраты) и Au (ромбы): рассчитанные с использованием уравнения (12) (пунктирные линии); экспериментально определенные (сплошные линии) [10].
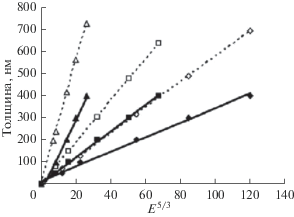
Сравнение экспериментальных величин RBethe для трех разных металлических пленок с теоретическими показывает, что экспериментальные данные почти в два раза меньше теоретических при одних и тех же значениях энергии электронного пучка (в 1.82, 1.59 и 1.72 раза для пленок Al, Ni и Au соответственно). Такие систематические отклонения экспериментальных результатов от теоретических авторы связывают с тем, что теоретическая величина RBethe, определенная в рамках математической модели Канайи–Окаямы, соответствует максимальной глубине проникновения электронного пучка в твердое тело, а не максимальной глубине генерации ХРИ. Потеря энергии электронов через неупругие взаимодействия и обратное рассеяние электронов через упругие взаимодействия с твердым телом являются двумя факторами, ограничивающими размеры и форму области взаимодействия электронов с образцом, а, следовательно, – область генерации ХРИ. Это означает, что глубина генерации ХРИ меньше максимальной глубины проникновения электронного пучка в твердое тело.
Используя тот же подход, авторы [10] проанлизировали четырехслойную структуру, состоящую из слоев Au, Ni и Al равной толщины на кремниевой подложке. Была построена зависимость содержания каждого из четырех элементов от энергии электронного зонда, генерирующего рентгеновское излучение (рис. 8). Как видно из рисунка, при малой энергии электронного пучка (менее 6 кэВ) в спектре рентгеновского излучения детектируется только Au. При достижении энергии электронного пучка 6.5 кэВ в составе анализируемой структуры появляется Ni, а дальнейшее увеличении энергии электронного пучка приводит к уменьшению доли Au и увеличению доли Ni. При энергии электронного пучка 9.7 и 11 кэВ определяются Al и Si соответственно. Дальнейшее увеличение энергии электронного пучка приводит к увеличению мольной доли Si. Для пленок Ni и Al мольные доли достигают максимальных значений 14.08 и 10.52% при энергии электронного пучка 14 и 17 кэВ соответственно, а затем уменьшаются.
Рис. 8.
Элементный состав структуры Au/Ni/Al/Si (100 нм/100 нм/100 нм/массивная подложка) как функция энергии электронного зонда [10].

Сравнение результатов анализа четырехслойной и двухслойной структур [10] показывает, что связь толщины пленки с энергией электронного зонда практически не зависит от материала подложки. Так, при анализе слоя Au толщиной 100 нм на кремниевой подложке 5 ат. % Si детектировали при энергии электронного зонда 6.4 кэВ, а при анализе аналогичного слоя Au, но на никелевой подложке (т.е. в случае четырехслойной структуры два верхних слоя можно рассматривать в качестве тонкой пленки и подложки соответственно) 5 ат. % Ni детектировали при энергии электронного пучка 6.5 кэВ. Разница в 0.1 кэВ находится на уровне погрешности определения энергии пучка электронов. Для дальнейшего проникновения электронного пучка после слоя Au толщиной 100 нм через следующие 100 нм Ni требуется большая энергия электронного пучка (9.7 кэВ), чем для проникновения через пленку Ni толщиной 200 нм (8 кэВ). Похожие результаты получены при сравнении энергии электронного пучка, необходимой для прохождения через структуру Au/Ni/Al (100/100/100 нм, 11 кэВ) и пленку из Al толщиной 300 нм (6 кэВ).
Аналогичный подход описан в [11], где определяли толщину пленок Ag на подложке из Cu. В отличие от [10], когда полученные результаты проверяли моделированием области генерации рентгеновского излучения методом Монте-Карло, в [11] проводили проверку, анализируя поперечные сечения исследуемых образцов с помощью ФИП. В этом случае также отмечаются заниженные экспериментальные значения RBethe по сравнению с теоретически рассчитанными величинами.
Описанный в [10, 11] подход позволяет определять толщины одноэлементных металлических пленок при отклонении от реальных значений менее 10%. Однако в теоретическом обосновании выбранных величин для построения их зависимостей от энергии электронного зонда, используемого для возбуждения рентгеновского излучения, содержится неточность. Авторы рассматривают величину RBethe, описывающую глубину генерации ТРИ, которая действительно практически полностью совпадает с глубиной проникновения электронного пучка в образец. Экспериментально RBethe определяли, используя сигнал ХРИ, глубина генерации которого почти в два раза меньше глубины генерации ТРИ [7]. Соответственно, все отклонения теоретических параметров от экспериментальных связаны не с неточностью выполнения эксперимента и используемых теоретических моделей, а с неверным выбором фундаментальной величины, связанной с энергией электронного зонда.
VII. МЕТОДИКИ НА ОСНОВЕ СООТНОШЕНИЯ КОНЦЕНТРАЦИЙ МАТЕРИАЛА ПЛЕНКИ И ПОДЛОЖКИ
При анализе пленок, материал которых обладает малой плотностью, можно использовать подход, основанный на построении градуировочных зависимостей отношения концентраций элементов, присутствующих в пленке, к концентрации элементов, присутствующих в подложке. Так, в [12] определяли толщину пленки из органических веществ (ОЗП – органическое защитное покрытие) на медной подложке. На рис. 9 представлена схема, поясняющая суть использованной методики.
Рис. 9.
Схема методики определения толщины пленки ОЗП по изменению соотношения концентраций материала пленки и подложки [12]: а – тонкое покрытие; б – толстое покрытие.
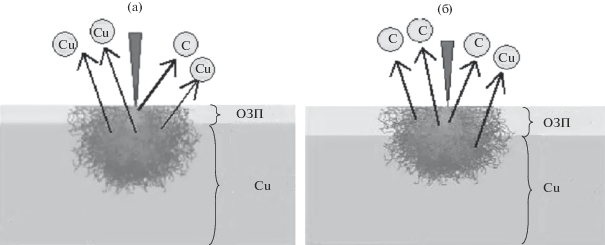
Взаимодействие электронного зонда с образцом приводит к генерации ХРИ атомов C из слоя ОЗП и/или атомов Cu из нижележащего слоя меди. Если слой ОЗП настолько тонкий, что пучок электронов проникает через него в слой Cu, то при количественном анализе зарегистрированного спектра рентгеновского излучения будет обнаружено большое (более 50 ат. %) содержание меди и малое – углерода. Увеличение толщины пленки при сохранении энергии электронного зонда должно привести к увеличению доли углерода и уменьшению доли меди [12].
В [12] авторы также рассмотрели возможность использования различных источников электронов для формирования электронного зонда и генерации рентгеновского излучения. Проводили сравнение вольфрамового катода и катода с полевой эмиссией. Для выбора источника электронов авторами был проведен количественный анализ пленок ОЗП различной толщины на медной подложке при одинаковых значениях энергии электронного зонда. Ввиду того, что при использовании вольфрамового катода в качестве источника электронов не было получено характерной зависимости содержания углерода от толщины анализируемой пленки, для проведения дальнейших исследований был выбран источник с полевой эмиссией. Сразу стоит отметить, что в обеих сериях экспериментов использовали один и тот же детектор рентгеновского излучения, а в [12] не приведены зарегистрированные спектры рентгеновского излучения. Поэтому сделать обоснованной вывод о причине отсутствия выраженной зависимости содержания углерода от толщины пленки ОЗП при использовании вольфрамового катода затруднительно.
В рамках описанного выше подхода авторами были проанализированы зависимости от толщины пленки ОЗП как содержания углерода, так и отношения концентраций углерода и меди. Несмотря на то, что оба варианта показали схожие результаты, в дальнейшем толщины пленок ОЗП определяли по зависимостям отношения концентраций углерода и меди. На рис. 10 представлена итоговая зависимость отношений, определенных при энергии электронного зонда 15 кэВ. Она описана полиномом второй степени, отличается хорошим значением R2 (0.996) и максимальным отклонением определяемой толщины 23 нм.
Рис. 10.
Зависимость отношений концентраций углерода к меди от толщины пленки ОЗП, уравнение аппроксимирующего полинома y = –0.024 + 0.34199x – – 0.02498x2, R2 = 0.996412 [12].

Несмотря на продемонстрированную возможность определения толщин углеродных пленок с высокой степенью точностью, в [12] не представлено никакого общего уравнения, позволяющего учитывать состав и плотность анализируемых пленок.
VIII. МЕТОДИКА НА ОСНОВЕ УРАВНЕНИЯ СЬЮЭЛЛА
Применение всех вышеописанных методов с хорошей степенью точности возможно только для определения толщин одноэлементных пленок. В случае анализа многокомпонентных пленок и при наличии одного или нескольких элементов как в пленке, так и в подложке, эти методы приводят к значительным погрешностям (более 10%). Кроме того, при определении критической энергии электронного зонда Ef (энергия электронного зонда, при которой глубина генерации ХРИ полностью совпадает с толщиной анализируемой пленки и не выходит за ее пределы [13]) на основе отношений интенсивностей излучения элементов пленки и подложки возможны значительные ошибки, так как при полученном значении Ef генерировать ХРИ будет только материал пленки [39]. Эта погрешность связана с тем, что по мере увеличения толщины анализируемой пленки увеличивается количество фотонов рентгеновского излучения, генерируемых в материале пленки, и усиливаются матричные эффекты [7]. Увеличение толщины пленки приводит к бóльшему поглощению и ослаблению рентгеновского излучения, испускаемого подложкой и проходящего через вышележащую пленку. Такие эффекты уникальны тем, что при рассмотрении двух линий ХРИ (одна линия от элемента пленки, вторая – от элемента подложки) изменение их интенсивностей противоположно. Это увеличивает чувствительность метода, так как небольшие изменения толщины анализируемой пленки приводят к значительным изменениям отношения интенсивностей ХРИ.
В [13] предложен иной подход к определению толщины тонкой многокомпонентной пленки. При увеличении энергии электронного зонда выше некоторого значения происходит генерация рентгеновского излучения как в пленке, так и в подложке, что фиксируется по возникновению пиков от элементов подложки в спектре ХРИ. Относительная интенсивность линий ХРИ будет зависеть от объемов тонкой пленки и подложки, в которых происходит генерация излучения [40]. На основе измеренных интенсивностей ХРИ в пленке If и подложке Is строится зависимость отношения Is/If от энергии электронного зонда, при которой зарегистрированы данные интенсивности, для разных толщин тонких пленок. Полученная зависимость аппроксимируется полиномом. Производная позволяет рассчитать значение критической энергии электронного зонда Ef, при которой мгновенные скорости изменения отношения Is/If для объемного стандарта и тонкой пленки одинаковы. Определенное таким образом значение Ef непосредственно связано с толщиной анализируемой пленки. Для определения толщины многокомпонентной тонкой пленки проводили расчет глубины генерации ХРИ для каждого элемента пленки с использованием стехиометрического состава по формуле Сьюэлла [41–44]:
(14)
$\begin{gathered} \overline {\rho z} = \\ = \frac{{\rho {{z}_{m}}(0.49269 - 1.0987\eta + 078557{{\eta }^{2}})\ln ({{{{E}_{0}}} \mathord{\left/ {\vphantom {{{{E}_{0}}} {{{E}_{{\text{c}}}}}}} \right. \kern-0em} {{{E}_{{\text{c}}}}}})}}{{0.70256 - 1.09865\eta + 1.0046{{\eta }^{2}} + \ln ({{{{E}_{0}}} \mathord{\left/ {\vphantom {{{{E}_{0}}} {{{E}_{{\text{c}}}}}}} \right. \kern-0em} {{{E}_{{\text{c}}}}}})}}, \\ \end{gathered} $(15)
$K = 2.68 + 4.4\exp ( - 0.725({{{{E}_{0}}} \mathord{\left/ {\vphantom {{{{E}_{0}}} {{{E}_{{\text{c}}}}}}} \right. \kern-0em} {{{E}_{{\text{c}}}}}})),$(16)
$\rho {\kern 1pt} {{z}_{m}} = {A \mathord{\left/ {\vphantom {A Z}} \right. \kern-0em} Z}\left( {0.78 \times {{{10}}^{{ - 5}}}{{J}^{{0.5}}}E_{0}^{{1.5}} + 0.735 \times {{{10}}^{{ - 6}}}E_{0}^{2}} \right),$В [13] вышеописанный подход был применен для определения толщины пленок FeCoSiB на подложке из стекла (точный состав используемых подложек в [13] не приведен). На рис. 11 представлен спектр ХРИ, полученный при анализе пленки FeCoSiB толщиной 200 нм, нанесенной на стекло, при энергии электронного зонда 20 кэВ. Как видно из рисунка, в спектре присутствуют сигналы как от элементов пленки, так и от элементов подложки, а именно пики, относящиеся к переходам BKα, OKα, NaKα, CaKα, SiKα, CoLα, CoKα, FeLα и FeKα, с энергией 0.185, 0.523, 1.04, 3.691, 1.74, 0.76, 6.929, 0.705 и 6.403 кэВ соответственно. Так как кремний присутствует и в материале пленки, и в материале подложки, по спектру напрямую невозможно определить, какая доля сигнала приходится на материал подложки.
Рис. 11.
Спектр ХРИ пленки FeCoSiB толщиной 200 нм на стекле (энергия электронного зонда 20 кэВ) [13].
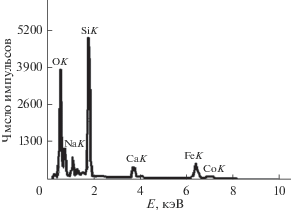
Для измерения толщин пленок FeCoSiB в [13] было выбрано соотношение интенсивностей характеристических переходов SiKα и FeLα. При малых энергиях электронного зонда (~5 кэВ) в случае тонких пленок (менее 200 нм) используемого перенапряжения оказывается достаточно для возбуждения данных переходов в материале пленки и подложки. На рис. 12 представлены зависимости соотношений интенсивностей переходов SiKα к FeLα для разных толщин пленок FeCoSiB от энергии электронного зонда. Из рисунка видно, что отношение интенсивностей SiKα к FeLα уменьшается при уменьшении энергии электронного зонда, данная зависимость не является линейной, но наблюдается для всех толщин пленок. Кроме того, чем толще пленка, тем меньше угол наклона полученных кривых, а при переходе к объемному стандартному образцу зависимость становится линейной. Представленные на рис. 12 зависимости были аппроксимированы полиномами, а из равенства значений производных были найдены величины Ef. После подстановки рассчитанных таким образом величин Ef в уравнения (13)–(16) были определены толщины пленок FeCoSiB. Достоверность полученных результатов в [13] проверяли методом стилусной профилометрии, максимальное отклонение полученных толщин составило менее 7.5%.
Рис. 12.
Зависимость отношения интенсивностей переходов SiKα и FeLα от энергии электронного зонда для пленок толщиной [13]: 151 (1); 328 (2); 514 нм (3); объемного стандарта (4).

К основным недостаткам определения толщин пленок на основе уравнения Сьюэлла можно отнести необходимость в данных о плотности анализируемой пленки, точном составе (состав, определенный методом рентгеноспектрального микроанализа, не учитывает элементы легче В), а также наличие объемного стандарта материала анализируемой пленки. Используемая в уравнении Сьюэлла аппроксимационная модель функции распределения ХРИ по глубине, тем не менее, может быть заменена рядом других аналогичных моделей [19], что делает метод более универсальным, хотя и более трудоемким.
IX. ЗАКЛЮЧЕНИЕ
Широкое применение тонких твердых пленок в современных технологиях при изготовлении изделий и материалов с заданными свойствами привело к созданию и развитию неразрушающих методов определения их толщин в диапазоне от долей нанометров до десятков микрометров. Наиболее эффективным и информативным методом среди них является РЭМ–ЭДРА. Современные методики на основе этого подхода весьма разноплановые и позволяют определять толщины пленок различной природы – органических и неорганических, диэлектрических и проводящих, однослойных и многослойных. Точность определения толщины зависит от выбранной методики и количества известных данных об анализируемом объекте. Так, определение толщин одноэлементных проводящих пленок является тривиальной задачей, однако при переходе к многослойным структурам возрастает погрешность определения толщин нижележащих слоев. При переходе к анализу многокомпонентных пленок применение классических методик на основе функции φ(ρz) оказывается затруднительным ввиду малого количества данных об анализируемой пленке, в связи с чем наиболее эффективными становятся полуэмпирические методики на основе уравнения Бете или соотношения интенсивностей ХРИ элементов пленки и подложки (особенно при анализе органических пленок). Таким образом, выбор той или иной методики должен основываться на количестве известных данных об анализируемом объекте.
СПИСОК ОБОЗНАЧЕНИЙ И СОКРАЩЕНИЙ
Е0 – энергия первичного электронного
пучка, кэВ;
Ес – критическая энергия возбуждения
характеристического рентгеновского
излучения, кэВ;
Rx – максимальная глубина генерации
характеристического рентгеновского
излучения с энергией Ес, нм;
$U = {{{{E}_{0}}} \mathord{\left/ {\vphantom {{{{E}_{0}}} {{{E}_{{\text{c}}}}}}} \right. \kern-0em} {{{E}_{{\text{c}}}}}}$ – перенапряжение;
φ(ρz) – функция распределения интенсивности
характеристического рентгеновского излучения
по глубине;
ρ – плотность, г · см–3;
${\mu \mathord{\left/ {\vphantom {\mu \rho }} \right. \kern-0em} \rho }$ – массовый коэффициент поглощения, см2 · г–1;
$\psi $ – угол сбора рентгеновского излучения
детектором;
$\rho z$ – массовая глубина, г · см–2;
$\rho {{z}_{{\max }}}$ – максимальная массовая глубина,
с которой происходит эмиссия рентгеновского
излучения, г · см–2;
$\overline {\rho z} $ – средняя массовая глубина испускания
характеристического рентгеновского
излучения, г · см–2;
$\rho {{z}_{m}}$ – максимум функции φ(ρz), г · см–2;
${{dE} \mathord{\left/ {\vphantom {{dE} {dx}}} \right. \kern-0em} {dx}}$ – функция потерь энергии электронов
от глубины их проникновения в образец;
${{\eta }_{T}}$ – коэффициент проникновения первичных
электронов, т.е. доля электронов первичного
пучка, проникших на определенную глубину;
η – коэффициент обратного рассеяния электронов;
A – атомная масса элемента, составляющего
анализируемую пленку, г/моль;
Z – атомный номер элемента, составляющего
анализируемую пленку;
RBethe – глубина генерации рентгеновского
излучения в определении Бете, нм;
J – средний потенциал ионизации, эВ;
ФИП – фокусируемый ионный пучок;
РЭМ – растровая электронная микроскопия;
ЭДРА – энергодисперсионный
рентгеновский анализ;
ХРИ – характеристическое
рентгеновское излучение;
ТРИ – тормозное рентгеновское излучение;
ZAF-коррекция – поправка интенсивность
и ХРИ на атомный номер, поглощение
и флуоресценцию.
Список литературы
Makhlouf A.S.H. // Nanocoatings and Ultra-Thin Films. Woodhead Publishing Limited, 2011. P. 159.
Ohring M. // Materials Science of Thin Films. Deposition and Structure. Academic Press, 2002. P. 704.
Piegari A., Flory F. // Optical Thin Films and Coatings. Woodhead Publishing Series in Electronic and Optical Materials, 2013. 835 p.
Ерофеев Е.В., Федин И.В., Казимиров А.И. // Вестн. СибГУТИ. 2015. Т. 3. С. 29.
Афиногенов Ю.П., Гончаров Е.Г., Ховив В.Н. и др. // Вестн. Воронеж. гос. ун-та. Сер. Химия. Биология. Фармация. 2004. Т. 1. С. 11.
Tompkins H.G., Hilfiker J.N. // Spectroscopic Ellipsometry. Practical Application to Thin Film Characterization. Momentum Press, 2015. P. 178.
Goldstein J.I., Newbury D.E., Michael J.R. et al. // Scanning Electron Microscopy and X-Ray Microanalysis. Springer, 2017. P. 381.
Fitting H.J., Kuhr J.C., Goldberg M. et al. // Microchimica Acta. 1997. V. 125. P. 235.
Myint K., Barfels T., Kuhr J.C. et al. // Fresenius’ J. Anal. Chem. 1998. V. 361. P. 637.
Ng F.L., Wei J., Lai F.K. et al. // Appl. Surf. Sci. 2006. V. 252. P. 3972.
Yung L.C., Fei C.C. // Proceed. IEEE Regional Symp. “Micro and Nanoelectronics”. Kuala Terengganu, 2015. P. 1.
Prong K., Sirarat K. // Proceed. 13th Int. Symp. “Physical and Failure Analysis of Integrated Circuits”. Singapore, 2006. P. 200.
Zhuang L., Bao S., Wang R. et al. // Proceed. Appl. Superconductivity and Electromagnetic Devices Int. Conf. Chengdu, 2009. P. 142.
Popova T.B., Bakaleinikov L.A., Flegontova E.Y. et al. // Semiconductors. 2011. V. 45. P. 260.
Phung T.M., Jensen J.M., Johnson D.C. et al. // X-Ray Spectrometry. 2008. V. 37. P. 608.
Lulla M., Asari J., Aarik J. et al. // Microchim. Acta. 2006. V. 155. P. 195.
Бакалейников Л.А., Домрачева Я.В., Заморянская М.В. и др. // Физика и техника полупроводников. 2009. Т. 43. P. 568.
Rinaldi R., Llovet X. // Microscopy and Microanalysis. 2015. V. 21. P. 1053.
Lavrent'ev Y.G., Korolyuk V.N., Usova L.V. // J. Anal. Chem. 2004. V. 59. P. 600.
Newbury D.E. // Microscopy and Microanalysis. 1998. V. 4. P. 585.
Tsuji K., Nakano K.Y., Takahashi Y. et al. //Anal. Chemistry. 2011. V. 84. P. 636.
Goldstein J.I., Newbury D.E., Michael J R. et al. // Scanning Electron Microscopy and X-Ray microanalysis. Springer, 2017. P. 289.
Anderson C.A., Hasler M.F. // Proceed. 4th Int. Conf. on X-ray Optics and Microanalysis, 1966. P. 310.
Bastin G.F., Heijligers H.J.M. // X-Ray Spectrometry. 2000. V. 29. P. 212.
Bastin G.F., Heijligers H.J.M. // X-Ray Spectrometry. 2000. V. 29. P. 373.
Campos C.S., Coleoni E.A., Trincavelli J.C. et al. // X-Ray Spectrometry. 2001. V. 30. P. 253.
Yasuda M., Yamauchi S., Kawata H., Murata K. // J. Appl. Phys. 2002. V. 92. P. 3404.
Kühn J., Hodoroaba V.D., Linke S. et al. // Surf. Interface Analysis. 2012. V. 44. P. 1456.
Ortel E., Kraehnert R., Galbert F., Hodoroaba V.D. // Microscopy and Microanalysis. 2015. V. 21. P. 1707.
Рид С. // Электронно-зондовый микроанализ. М.: Мир, 1979. С. 337.
Bastin G.F., Heijligers H.J.M. // Electron Probe Quantitation. N.Y.: Plenum Press, 1991. P. 261.
Shimizu R., Nishigori N., Murata K. // Proceed. 6th Int. Conf. on X-Ray Optics and Microanalysis. Tokyo, 1972. P. 95.
Fitting H.J., Glaefeke H., Wild W. // Phys. Stat. Sol. A. 1977. V. 43. P. 185.
Михеев Н.Н., Степович М.А., Широкова Е.В. // Изв. Рос. акад. наук. Сер. физ. 2010. Т. 74. С. 1043.
Fitting H.J. // Phys. Stat. Sol. A. 1974. V. 26. P. 525.
Dupouy G., Perrier F., Verdier P., Arnal F. // Comptes Rendus Hebd. Seances de l’Academie des Sciences. 1965. V. 260. P. 6055.
Vyatskin A.Y., Trunev V.V. // Radiotekhnika i Elektronika. 1975. V. 9. P. 1899.
Gaber M., Fitting H.J. // Phys. Stat. Sol. A. 1984. V. 85. P. 195.
Pascual R., Cruz L.R., Ferreira C.L., Gomes D.T. // Thin Solid Films. 1990. V. 185. P. 279.
Procop M., Radtke M., Krumrey M. et al. // Anal. Bioanal. Chem. 2002. V. 374. P. 631.
Sewell D.A., Love G., Scott V.D. // J. Phys. D: Appl. Phys. 1985. V. 18. P. 1233.
Sewell D.A., Love G., Scott V.D. // J. Phys. D: Appl. Phys. 1985. V. 18. P. 1245.
Sewell D.A., Love G., Scott V.D. // J. Phys. D: Appl. Phys.1985. V. 18. P. 1269.
Sewell D.A., Love G., Scott V.D. // J. Phys. D: Appl. Phys. 1987. V. 20. P. 1567.
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования


