Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2020, № 11, стр. 3-11
Методы двухкристальной рентгеновской дифрактометрии и топографии в анализе реальной структуры кристаллов
Д. А. Романов a, b, *, И. А. Прохоров a, А. Э. Волошин a, В. Г. Косушкин b, А. П. Большаков c, В. Г. Ральченко c
a Институт кристаллографии им. А.В. Шубникова
ФНИЦ “Кристаллография и фотоника” РАН
119333 Москва, Россия
b Московский государственный технический университет имени Н.Э. Баумана,
Калужский филиал
248000 Калуга, Россия
c Институт общей физики им. А.М. Прохорова РАН
119991 Москва, Россия
* E-mail: oxly13@mail.ru
Поступила в редакцию 19.03.2020
После доработки 07.04.2020
Принята к публикации 10.04.2020
Аннотация
На примере исследования объемных кристаллов и пленок алмаза, полученных методами высокой температуры, высокого давления и осаждения из газовой фазы соответственно, продемонстрирована высокая эффективность применения методов двухкристальной рентгеновской дифрактометрии и топографии для характеризации кристаллов при совершенствовании технологии их выращивания. Описаны методики и приведены схемы изучения реальной структуры кристаллов, определения состава, периода кристаллической решетки, особенностей деформации и толщины тонких пленок. Выявлены основные дефекты структуры (дислокации, дефекты упаковки, включения второй фазы и другие) возникающие в синтетических кристаллах алмаза в процессе их получения.
ВВЕДЕНИЕ
Кристаллы – основа многочисленных приборов и устройств современной техники. Все реальные кристаллы содержат разнообразные несовершенства структуры, приводящие к нарушению трехмерной периодичности их строения. Поскольку многие параметры кристаллов являются “структурно-чувствительными”, дефекты сильно, иногда кардинально, изменяют свойства кристаллов и оказывают непосредственное, как правило, негативное влияние на эксплуатационные характеристики приборов, изготовленных на их основе. Поэтому знание реальной структуры необходимо как для объяснения поведения кристаллов, так и для контроля качества и модификации технологии их выращивания.
Среди методов, используемых для изучения и контроля реальной структуры кристаллов, особое место занимают рентгеноструктурные методы, в которых информацию о строении кристаллов получают из анализа интенсивности и пространственного распределения рассеянного излучения. Благодаря достаточно большой глубине проникновения рентгеновских лучей и чрезвычайно высокой чувствительности к малым (до 10–8 и менее) деформациям кристаллической решетки, рентгенодифракционные методы позволяют проводить неразрушающий контроль структурного состояния материала, что особенно важно при производстве дорогостоящих кристаллов и различных структур. Детальный анализ современного состояния рентгенодифракционных методов исследования – рентгеновской топографии и дифрактометрии высокого разрешения, их аппаратурного оформления, теории рассеяния рентгеновского излучения и различных подходов к математическому моделированию кривых дифракционного отражения и контраста топографического изображения дефектов – можно найти в ряде оригинальных работ и обзоров [1–5].
В настоящей работе обсуждаются вопросы, связанные с применением методов двухкристальной рентгеновской дифрактометрии и топографии, для получения информации о реальной структуре кристаллов и эпитаксиальных структур при совершенствовании технологии их производства. Они нашли широкое распространение в лабораторной практике как наиболее доступные и относительно простые в аппаратурном оформлении. Возможности этих методов анализируются на примере исследования, главным образом, монокристаллов и эпитаксиальных пленок синтетического алмаза.
ОБЪЕКТЫ ИССЛЕДОВАНИЯ
Монокристаллы синтетического алмаза благодаря уникальным свойствам – высокой твердости, химической и радиационной стойкости, малому коэффициенту теплового расширения и высокой теплопроводности (особенно изотопически модифицированных кристаллов) [6] – находят все более широкое применение в различных областях науки и техники. Технологические применения алмаза расширяются не только в традиционных областях, связанных с изготовлением обрабатывающих инструментов, но и в высокотехнологичных приложениях, таких как создание электронных приборов, детекторов излучений, рентгенооптических элементов для синхротронных источников с исключительно высокими потоками излучения [7, 8]. Особенно многообещающими являются кристаллы, получаемые методом осаждения из газовой фазы (chemical vapor deposition – CVD) [9, 10], так как этот ростовой процесс позволяет получать не только наиболее чистые кристаллы, но и прецизионно управлять содержанием примеси, что особенно важно в электронных и некоторых оптических применениях. Алмаз, как и любой углерод природного состава (natС), имеет два стабильных изотопа – 98.93% 12С и 1.07% 13С. Целенаправленное изменение изотопного состава позволяет улучшать уникальные свойства этого материала, включая твердость и теплопроводность [11, 12].
Для иллюстрации возможностей методов двухкристальной рентгеновской дифрактометрии и топографии при совершенствовании технологии роста кристаллов в работе использованы монокристаллические подложки и пленки алмаза, выращенные методом осаждения из газовой фазы (CVD-пленки) в специализированном реакторе ARDIS-100 в плазме СВЧ-разряда (частота 2.45 ГГц) в смесях метан–водород при температуре T ∼ 950°С [10]. В качестве подложек для осаждения CVD-слоев использовали пластины ориентации {001} размером ∼5 × 5 мм, изготовленные из монокристаллов алмаза типа Ib, выращиваемых в аппаратах высокого давления (метод HPHT – high pressure, high temperature). Использованы также подложки размером 3 × 3 мм, изготовленные из монокристалла алмаза типа IIb, легированного бором до концентрации CB ∼ 1.8 × 1019 см–3, выращенного по методике [13]. Синтез изотопически модифицированных пленок алмаза 13С был проведен с использованием обогащенного изотопом 13С до 99.96% метана (13CH4).
Некоторые аспекты применения двухкристальной рентгеновской дифрактометрии и топографии проиллюстрированы на примере исследования эпитаксиальных структур Y3Fe5O12/Gd3Ga5O12(111), полученных методом жидкофазной эпитаксии из оксидного раствора-расплава, и гомоэпитаксиальных структур Ge(B)/Ge, полученных газотранспортным методом в хлоридной системе при температуре T ∼ 930°C.
РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
Двухкристальная рентгеновская дифрактометрия
Угловая ширина брэгговских отражений в однокристальных дифракционных экспериментах лимитируется, главным образом, угловой расходимостью падающего пучка. Для уменьшения расходимости пучка используют двухкристальную схему, которая является базовой при проведении дифракционных исследований высокого разрешения. На рис. 1 представлена рентгенооптическая схема одного из вариантов двухкристального дифрактометра в параллельной (относительно отражающих плоскостей) бездисперсионной (n, –n) установке кристаллов. При дифрактометрических и топографических исследованиях использовали CuKα1-излучение (широкий пучок) и одинарную щель шириной ~0.5 см. Измерения с двойной щелью [14] позволяют определять радиус кривизны пластин с чувствительностью до R ∼ 500 м. Изображение фиксировали на фотопластинках для ядерных исследований типа МР-10. Однокристальные рентгенотопографические исследования в геометрии Лауэ (на просвет) для выявления особенностей распределения дефектов в объеме кристаллов проводили методом Ланга с использованием MoKα1-излучения.
Рис. 1.
Рентгенооптическая схема двухкристального рентгеновского дифрактометра в режиме определения радиуса кривизны пластин: F – источник излучения; М – кристалл-монохроматор; S – щель; C – исследуемый кристалл; D – детектор излучения.

При условии изготовления кристаллов монохроматора и образца из одного и того же материала, строгой параллельности кристаллов, использования идентичных отражений все лучи, удовлетворяющие условию Брэгга 2d sin θ = nλ для первого кристалла, будут удовлетворять брэгговским условиям и для образца (здесь d – межплоскостное расстояние, θ – угол Брэгга, λ – длина волны излучения, n – порядок отражения). Так как угловая область брэгговского отражения очень узкая (порядка одной угловой секунды), незначительное угловое смещение образца выводит его из отражающего положения. Деформации кристаллической решетки, вызывающие ее эффективную разориентацию, приведут к уширению кривой качания, которая служит своего рода паспортом исследуемого кристалла, а степень отклонения параметров экспериментальных кривых (высоты и полуширины пика) от расчетных теоретических значений характеризует уровень его структурного совершенства.
Высокая твердость алмаза затрудняет изготовление из этого материала прецизионно ориентированных сильно асимметричных кристаллов-монохроматоров. В этой связи в настоящей работе для расширения пучка и формирования почти плоской волны использовали сильно асимметричное отражение 511 от монохроматора из высокосовершенного бездислокационного германия (угол Брэгга θ ∼ 45.07°, фактор асимметрии отражения b ∼ 0.01, расходимость пучка после монохроматора составляет ∼0.5″). Для исследования кристаллов алмаза было выбрано отражение 113, хорошо согласующееся по брэгговскому углу θ ∼ ∼ 45.75° с отражением от монохроматора.
Анализ кривых качания позволяет определить структурное совершенство подложки и пленки по полуширине кривых качания, несоответствие Δd/d межплоскостных расстояний в кристаллических решетках подложки и пленки, а также их взаимную разориентацию Δφ по угловым расстояниям ΔωA и ΔωB между пиками, полученными с использованием двух геометрических схем дифракции, отличающихся поворотом образца на 180° вокруг нормали к поверхности [3, 15]:
(1)
${{\Delta d} \mathord{\left/ {\vphantom {{\Delta d} d}} \right. \kern-0em} d} = {{--(\Delta {{\omega }_{A}} + \Delta {{\omega }_{B}})} \mathord{\left/ {\vphantom {{--(\Delta {{\omega }_{A}} + \Delta {{\omega }_{B}})} {2{\text{tg}}\theta }}} \right. \kern-0em} {2{\text{tg}}\theta }},$(2)
$\Delta \varphi = {{(\Delta {{\omega }_{A}}--\Delta {{\omega }_{B}})} \mathord{\left/ {\vphantom {{(\Delta {{\omega }_{A}}--\Delta {{\omega }_{B}})} 2}} \right. \kern-0em} 2}.$Также можно определить толщину эпитаксиальной пленки t из соотношения интегральных интенсивностей отражений от подложки и пленки или по периоду δ осцилляции интенсивности (Pendellösung) [3, 15], когерентность сопряжения решеток из данных об эффективном несоответствии при исследовании различных асимметричных отражений [15], кривизну пластины и, соответственно, уровень упругих напряжений в системе по разделению дифракционных пиков при использовании специальных двулучевых схем [14], толщину пленки, изменение состава по толщине и структуру межфазной границы при обработке кривой качания с использованием методов математического моделирования [3].
На рис. 2 представлены кривые качания, полученные в двух геометрических схемах дифракции от изотопически модифицированной эпитаксиальной пленки 13С, выращенной на подложке алмаза природного изотопического состава группы Ib: CVD13C/HPHTnatС Ib, толщина пленки ~2 мкм. Обработка полученных кривых с использованием уравнений (1), (2) и известных соотношений [15]
(3)
${{\Delta d} \mathord{\left/ {\vphantom {{\Delta d} d}} \right. \kern-0em} d} = {{({{\Delta d} \mathord{\left/ {\vphantom {{\Delta d} d}} \right. \kern-0em} d})}_{ \bot }}{\text{co}}{{{\text{s}}}^{2}}\varphi ,$(4)
${{({{\Delta а} \mathord{\left/ {\vphantom {{\Delta а} а}} \right. \kern-0em} а})}_{{{\text{relax}}}}} = \gamma {{({{\Delta d} \mathord{\left/ {\vphantom {{\Delta d} d}} \right. \kern-0em} d})}_{ \bot }},$Рис. 2.
Кривые качания, полученные в двух геометрических схемах дифракции от изотопически модифицированной эпитаксиальной пленки 13С, выращенной на подложке алмаза природного изотопического состава группы Ib: CVD13C/HPHTnatС; толщина пленки ~2 мкм, ориентация подложки (001). CuKα1-излучение, отражение 113.
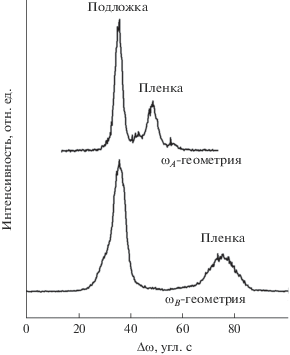
Отметим, что задача определения несоответствия периодов кристаллических решеток подложки и пленки (и, соответственно, состава пленки [15]) может быть решена с использованием лишь одной геометрической схемы дифракции: либо ωА с углом падения излучения на образец ωА = θ + φ, либо ωB с углом падения ωB = θ – φ. Из уравнений (1)–(4) следует, что:
(5)
$\Delta {{\omega }_{A}} = --{{({{\Delta d} \mathord{\left/ {\vphantom {{\Delta d} d}} \right. \kern-0em} d})}_{ \bot }}({\text{tg}}\theta {\text{co}}{{{\text{s}}}^{2}}\varphi --{\text{sin}}\varphi {\text{cos}}\varphi ),$(6)
$\Delta {{\omega }_{B}} = --{{({{\Delta d} \mathord{\left/ {\vphantom {{\Delta d} d}} \right. \kern-0em} d})}_{ \bot }}({\text{tg}}\theta {\text{co}}{{{\text{s}}}^{2}}\varphi + {\text{sin}}\varphi {\text{cos}}\varphi ).$Использование рентгеноструктурных методов исследования позволяет в отдельных случаях получать детальную информацию о таких важнейших параметрах, как величина несоответствия, уровень упругой деформации и скачки пластической деформации на границах раздела фаз даже в многослойных гетероструктурах [18]. Релаксационные процессы могут оказывать существенное влияние на дополнительную генерацию дислокаций и ухудшение структурных параметров CVD-пленок алмаза, особенно при выращивании толстых пленок [16]. Поэтому определение толщины эпитаксиальных пленок является одной из важных задач дифракционного анализа. Очень эффективный способ определения толщины пленок основан на анализе осцилляций интенсивности на кривых качания. В геометрии на отражение толщина пленки связана с периодом осцилляции интенсивности δ соотношением [3]:
(7)
$t = {{\lambda \sin (\theta \pm \varphi )} \mathord{\left/ {\vphantom {{\lambda \sin (\theta \pm \varphi )} {\delta \sin 2\theta ,}}} \right. \kern-0em} {\delta \sin 2\theta ,}}$Согласно уравнению (7) периоды осцилляции интенсивности на кривых качания эпитаксиальных структур алмаза с пленкой толщиной t = 2 мкм (рис. 2) должны составить δ ∼ 5.6″ для геометрической схемы дифракции ωA, и δ ∼ 15″ для ωB-схемы. Однако явно выраженных осцилляций толщины с такими периодами на кривых качания не наблюдается. По-видимому, это связано со структурной неоднородностью исследуемых эпитаксиальных структур [16] и, возможно, с размытостью межфазной границы из-за повышенной шероховатости поверхности подложки, обусловленной трудностью обработки алмаза. Поэтому в качестве примера на рис. 3 приведена кривая качания для отражения 880 в ωB-схеме дифракции (θ ∼ 44.8°, φ = 35.27°) для эпитаксиальной феррит-гранатовой пленки Y3Fe5O12, выращенной на ориентированной подложке Gd3Ga5O12(111) методом жидкофазной эпитаксии из оксидного раствора-расплава. Асимметрия пика отражения от подложки обусловлена проявлением эффекта грани [19]. Период осцилляции интенсивности составил δ ∼ 20.7″, что соответствует толщине пленки t ∼ ∼ 1.5 мкм.
Рис. 3.
Типичная двухкристальная кривая качания для эпитаксиальной структуры Y3Fe5O12/Gd3Ga5O12(111) с интерференционными максимумами. Отражение 880, геометрическая схема дифракции ωB.

Проведенные рентгенодифракционные исследования CVD-пленок алмаза высокого оптического качества (прозрачных, бесцветных), отделенных от подложек лазерной резкой с последующей механической полировкой, выявили ряд структурных особенностей образцов, сформировавшихся в процессе их получения. Прежде всего, следует отметить значительный изгиб ряда исследованных пластин с радиусом кривизны R ~ 4.6 м [20], зарегистрированный при измерениях с помощью двойной щели. Суть данного метода заключается в использовании сильно асимметричного монохроматора и формировании пучка с широким фронтом, из которого с помощью щелей вырезают два параллельных монохроматических луча, разнесенных на расстояние L (рис. 1). В случае неизогнутого кристалла оба луча выходят в отражающее положение одновременно. Если кристалл изогнут, то при его вращении в брэгговском направлении регистрируются два дифракционных пика (рис. 4), угловое расстояние между которыми связано с радиусом кривизны простым соотношением:
(8)
$R = {L \mathord{\left/ {\vphantom {L {\Delta \omega \sin \omega ,}}} \right. \kern-0em} {\Delta \omega \sin \omega ,}}$Остаточный изгиб эпитаксиальных CVD-пленок алмаза, отделенных от подложки лазерной резкой, с радиусом кривизны до R ~ 1.5 м наблюдался экспериментально в ряде работ [21, 22]. Его регистрировали по изменению углового положения образца при его линейном перемещении относительно падающего пучка. Поскольку следов эффективной пластической деформации эпитаксиальных структур алмаза не наблюдается из-за низкой температуры получения CVD-пленок по сравнению с температурой плавления алмаза, на данном этапе возможны лишь гипотетические объяснения наблюдаемого изгиба пленок, отделенных от подложки. Остаточный изгиб может быть обусловлен перераспределением точечных дефектов (легирующей и/или фоновой примеси) в знакопеременном поле упругих напряжений при выращивании толстых пленок [23], изменением дислокационной структуры пленок в процессе их роста [22], а также несимметричной (с различной шероховатостью) обработкой поверхностей пленки после лазерного отделения от подложки. При механической полировке алмаза возникает нарушенный слой, толщина которого по оценкам [24] составляет порядка 1 мкм. Однако для окончательного ответа на эти вопросы требуется проведение более детальных исследований.
Рис. 4.
Кривая качания пластины CVD-алмаза, отделенной от подложки лазерной резкой, полученная с использованием двойной щели, база L = 2 мм. Угловое расстояние между пиками соответствует радиусу кривизны 4.6 м, последовательность выхода пучков S1 и S2 в отражающее положение соответствует выпуклости со стороны исследуемой поверхности.
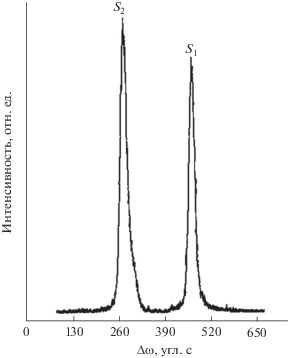
Рентгеновская топография
Наиболее обширную информацию о различных несовершенствах кристаллической решетки дают рентгеновские топографические методы. Сущность метода рентгеновской топографии (рентгеновской дифракционной микроскопии) состоит в получении изображения кристалла в результате фиксации на фотопластинке или двухкоординатном CCD-детекторе отдельного рефлекса и в возможности сопоставления отдельных деталей изображения с конкретными точками объекта. Детали изображения становятся доступными для наблюдения благодаря появлению при определенных условиях контраста на дефектах, который создается вследствие различной отражательной способности нарушенных и совершенных участков кристалла [3, 25].
На рис. 5 приведен пример двухкристальной рентгеновской топограммы пластины синтетического алмаза типа Ib с высоким содержанием азота [20]. Полуширина кривой качания асимметричного отражения 113 в топографическом режиме при полном “омывании” образца пучком составила Δω1/2 = 4.9″, пиковый коэффициент отражения ∼0.73. На топограмме ярко выражена макронеоднородность распределения периода кристаллической решетки по площади пластины, обусловленная неоднородностью распределения примесей (преимущественно азота) в различных секторах роста кристалла. Контраст изображения (с учетом обращения контраста при фотопечати) соответствует увеличению периода кристаллической решетки в этих областях кристалла (крестообразная фигура) и, соответственно, увеличению содержания азота [26–28]. Кроме того, выявляются дислокации (показаны белой стрелкой), дефекты упаковки (черная стрелка), границы между секторами роста, следы механических повреждений (пунктирная стрелка) и ряд других дефектов, возможно, некогерентных (без полей деформации) включений второй фазы.
Рис. 5.
Особенности реальной структуры сильно дефектного HPHT-кристалла алмаза типа Ib: двухкристальная рентгеновская топограмма алмазной пластины ориентации (001), CuKα1-излучение, отражение 113, геометрическая схема дифракции ωB, точкой отмечено угловое положение образца в процессе экспозиции.
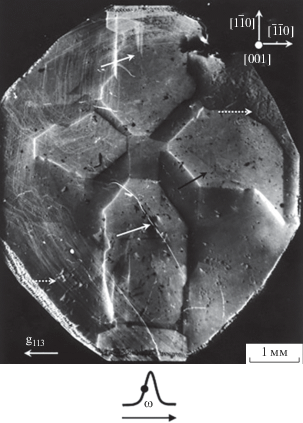
Наиболее универсальный топографический метод прямого наблюдения дефектов в объеме достаточно тонких кристаллов (μt ≤ 1, где μ – линейный коэффициент поглощения) – метод Ланга [29]. Особенностью метода является строгое коллимирование падающего пучка жесткого (обычно Mo или Ag) излучения, при котором только компонента Kα1 отражается кристаллом. Ширина пучка в методе Ланга составляет обычно ∼200 мкм, но благодаря синхронному перемещению (сканированию) кристалла и пластинки при неподвижном экране (рис. 6) можно получить “проекционную топограмму” большого по площади участка кристалла.
Рис. 6.
Рентгенооптическая схема топографического метода Ланга: F – источник излучения; КУ – коллимирующее устройство; К – исследуемый кристалл; Э – экран; ФП – фотопластинка; С – механизм сканирования.

Деформации кристаллической решетки в окрестности дефектов приводят к локальному уменьшению первичной экстинкции и появлению экстинкционного контраста за счет увеличения интенсивности рассеяния, который проявляется на топограмме в виде более темного относительно фона изображения дефектов. Обсуждение вопросов, связанных с механизмами формирования дифракционного изображения дефектов кристаллической решетки, получением количественной информации о параметрах дефектов и с практическим применением топографических методов для совершенствования технологии роста кристаллов и тонких пленок, можно найти в [3, 19, 30, 31].
На рис. 7 представлена рентгеновская топограмма по Лангу гомоэпитаксиальной структуры алмаза, состоящей из пленки природного изотопического состава natС, выращенной на подложке алмаза группы IIb, легированной бором: CVDnatС/HPHT-C(B) IIb, толщина пленки ~0.5 мкм, ориентация подложки {001}. Наблюдаются сектора роста со значительными нарушениями и полями деформации на границах сопряжения, индивидуальные дислокации (1) и их скопления (2), полосы роста, обусловленные микронеоднородным распределением легирующей примеси в объеме кристалла из-за изменения условий роста на фронте кристаллизации. Полосы роста выявляются в виде вертикальных (рис. 7а) и горизонтальных (рис. 7б) линий. При изменении направления вектора дифракции в тех секторах, где полосы были видны, они исчезают, а в одном из двух других секторов появляются. В таких полосах все смещения лежат в плоскости, перпендикулярной к ним (например, [32, 33]), поэтому если вектор дифракции направлен вдоль полос, то их изображение исчезает.
Рис. 7.
Рентгеновские топограммы эпитаксиальной структуры Сnat/HPHT-C(B) IIb, полученные при различных направлениях вектора дифракции (показаны стрелкой): а – горизонтально; б – вертикально; 1 – индивидуальные дислокации; 2 – скопление дислокаций. Метод Ланга, MoKα1-излучение, отражение 220, контраст обратный.
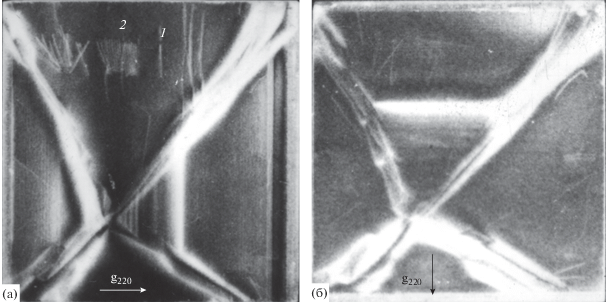
Скопление дислокаций (2) аналогично изображению декорированных оксидными включениями “необычных конусообразных дефектов”, выявленных в кристаллах алмаза в [34]. Следует отметить погасание изображений дислокаций 1 и 2 при изменении направления вектора дифракции (рис. 7б). Такая зависимость используется для определения векторов Бюргерса дислокаций, однако для этого необходимо добиться погасания изображения дислокаций при двух различных отражениях. Образование дислокаций несоответствия из-за низкой температуры эпитаксии и малой толщины пленки не наблюдается.
Релаксация упругих напряжений в эпитаксиальных структурах посредством пластической деформации начинается при толщинах пленок, превышающих критические [35, 36], и сопровождается образованием вблизи межфазной границы (в нейтралях системы) дислокаций несоответствия. Это приводит к значительному повышению плотности дислокаций в пленках. В изучении процессов релаксации напряженных пленок рентгеновская топография имеет определенные преимущества перед электронной микроскопией, поскольку позволяет исследовать наиболее ранние стадии процесса релаксации, когда плотность генерируемых дислокаций еще достаточно мала. На рис. 8 представлены рентгеновские топограммы гомоэпитаксиальной структуры Ge(B)/Ge, полученные методом аномального прохождения рентгеновских лучей на различных этапах роста пленки. При толщине пленки меньше критической $t_{{\text{c}}}^{{\text{I}}}$ [35, 36] ее дислокационная структура формируется в процессе прорастания дислокаций из подложки (рис. 8а). При превышении критической толщины активируется процесс скольжения дислокаций в пленке с образованием дислокаций несоответствия на межфазной границе (рис. 8б). При превышении второй критической толщины $t_{{\text{c}}}^{{{\text{II}}}}$ [37] начинается скольжение дислокаций в подложке, сопровождающееся формированием протяженных полупетель (рис. 8в) с прямолинейными сегментами на межфазной границе и в нейтрали системы. В результате в объеме эпитаксиальной структуры формируется достаточно сложное распределение дислокаций [38]. В эпитаксиальных структурах алмаза образование дислокаций несоответствия не наблюдается даже при толщинах пленок, почти на два порядка превышающих критическое значение [38], что, по-видимому, обусловлено низкой температурой получения CVD-пленок по сравнению с температурой плавления алмаза.
ЗАКЛЮЧЕНИЕ
Представленные результаты свидетельствуют о широких возможностях использования дифракционных методов для характеризации реальной структуры объемных кристаллов и эпитаксиальных структур: определения структурного совершенства кристаллов, несоответствия межплоскостных расстояний кристаллических решеток подложки и пленки, а также их взаимной разориентации, определения толщины и состава эпитаксиальных пленок, кривизны монокристаллических пластин и так далее. Новые возможности проведения исследований открываются при использовании синхротронного излучения (СИ), характеризующегося чрезвычайно высокой интенсивностью. Это позволяет существенно сократить время эксперимента, проводить исследования сильно поглощающих кристаллов, исследовать быстропротекающие процессы (стробоскопическая топография), визуализировать объемное распределение дефектов и обеспечивает ряд других преимуществ [3]. Сочетание высокой яркости СИ с возможностями современных цифровых CCD-детекторов существенно расширило информативность экспериментов, объединив преимущества рентгеновской топографии (визуализация дефектов кристаллической решетки) и рентгеновской дифрактометрии. В частности, использование двухкристальной топографии с угловой разверткой на базе СИ [5] позволяет наряду с топографическими изображениями регистрировать кривые качания, определять угловое положение рефлексов, строить карты распределения полуширины, интегральной и пиковой интенсивности отражений и некоторых других параметров [39, 40] в промышленных пластинах с микронным разрешением. Это позволяет установить прямую взаимно-однозначную корреляцию между дефектами и макроскопическими эффектами в кристаллах.
Развитие этих методов позволяет целенаправленно подходить к вопросам формирования требуемых структурных характеристик кристаллов и эпитаксиальных структур. Без их использования практически невозможно решать задачи фундаментального и прикладного характера, связанные с получением кристаллов и их практическим применением в микроэлектронике и других областях новой техники.
Список литературы
Authier A. Dynamical Theory of X-ray Diffraction. Oxford: Oxford University Press, 2001. 661 p.
Пинскер З.Г. Рентгеновская кристаллооптика. М.: Наука, 1982. 390 с.
Bowen D.K., Tanner B.K. High Resolution X-ray Diffractomentry and Topography. London: Taylor and Francis Publ, 1998. 256 p.
Шульпина И.Л. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2000. № 4. С. 3.
Lübbert D., Baumbach T., Härtwig J. et al. // Nucl. Instrum. Methods Phys. Res. B. 2000. V. 160. P. 521.
Sussmann R.S. CVD Diamond for Electronic Devices and Sensors. John Wiley & Sons, 2009. 571 p.
Shvyd’ko Yu., Stoupin S., Blank V., Terentyev S. // Nature Photonics. 2011. V. 5. P. 539.
Balmer R.S., Brandon J.R., Clewes S.L. et al. // J. Phys.: Condens. Matt. 2009. V. 21. P. 364211.
Tallaire A., Achar J., Silva F. et al. // Compt. Rendus Phys. 2013. V. 14. P. 169.
Ральченко В.Г., Большаков А.П. // Углеродная фотоника / Ред. Конов В.И. М.: Наука, 2017. С. 9.
Anthony T.R., Banholzer W.F. // Diamond Relat. Mater. 1992. V. 1. P. 717.
Wei L., Kuo P.K., Thomas R.L. et al. // Phys. Rev. Lett. 1993. V. 70. № 24. P. 3764.
Polyakov S.N., Denisov V.N., Mavrin B.N. et al. // Nanoscale Res. Lett. 2016. V. 11. P. 11. https://doi.org/10.1186/s11671-015-1215-6
Прохоров И.А., Захаров Б.Г. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 1999. № 2. С. 106.
Bartels W.J., Nijman W. // J. Cryst. Growth. 1978. V. 44. P. 518.
Прохоров И.А., Волошин А.Э., Ральченко В.Г. и др. // Кристаллография. 2016. Т. 61. № 6. С. 945.
Holloway H.A., Hess R.A., Tamor M.K. et al. // Phys. Rev. B. 1991. V. 44. P. 7123.
Хапачев Ю.П., Чуховский Ф.Н. // Кристаллография. 1989. Т. 34. Вып. 3. С. 776.
Шульпина И.Л., Прохоров И.А. // Кристаллография. 2012. Т. 57. № 5. С. 745.
Prokhorov I.A., Ralchenko V.G., Bolshakov A.P., et al. // Crystallogr. Rep. 2013. V. 58. № 7. P. 1010.
Bauer T., Schreck M., Härtwig J. et al. // Phys. Stat. Sol. A. 2006. V. 203. № 12. P. 3056.
Bauer Th., Schreck M., Stritzker B. // Diamond Relat. Mater. 2006. V. 15. P. 472.
Гегузин А.Е. // УФН. 1986. Т. 149. Вып. 1. С. 149.
Yurov V., Bushuev E., Bolshakov A. et al. // Phys. Stat. Sol. A. 2017. V. 214. № 11. P. 1 700 177. https://doi.org/10.1002/pssa.201700177
Шульпина И.Л. // Кристаллография. 1994. Т. 39. № 2. С. 270.
Lang A.R., Moore M., Makepeace A.P. et al. // Philos. Trans. R. Cos. London Ser. A. 1991. V. 337. P. 497.
Voronov O.A., Rakhmanina A.V., Khlybov E.P. // Inorg. Mater. 1995. V. 31. P. 851.
Brunet F., Deneuville A., Germi P. et al. // J. Appl. Phys. 1997. V. 81. № 3. P. 1120.
Lang A.R. // Acta Crystallogr. 1959. V. 12. 249.
Суворов Э.В., Смирнова И.А. // УФН. 2015. Т. 185. № 9. С. 897.
Волошин А.Э., Смольский И.Л. // Кристаллография. 1993. Т. 38. С. 12.
Prokhorov I.A., Serebryakov Yu.A., Zakharov B.G. et al. // J. Cryst. Growth. 2008. V. 310. № 24. P. 5477.
Прохоров И.А., Безбах И.Ж., Захаров Б.Г., Шульпина И.Л. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2007. № 5. С. 42.
Shiryaev A.A., Zolotov D.A., Suprun O.M. et al. // CrystEngComm. 2018. V. 20. P. 7700. https://doi.org/10.1039/C8CE01499J
Matthews J.W., Mader S., Light T.B. // J. Appl. Phys. 1970. V. 41. P. 3800.
Matthews J.W. // J. Vac. Sci. Technol. 1975. V. 12. № 1. P. 126.
Prokhorov I.A., Zakharov B.G., Man’shin V.S., Shul’pina I.L. // J. Phys. D: Appl. Phys. 1993. V. 26. P. A76.
Прохоров И.А., Волошин А.Э., Романов Д.А. и др. // Кристаллография. 2019. Т. 64. № 3. С. 369.
Stoupin S., Krawczyk T., Liu Z., Franck C. // Crystals. 2019. V. 9. P. 396. https://doi.org/10.3390/cryst9080396
Kaloyan A.A., Podurets K.M., Prokhorov I.A. et al. // Cryst. Res. Technol. 2018. V. 53. P. 1 800 154. https://doi.org/10.1002/crat.201800154
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования