Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2020, № 11, стр. 53-60
Влияние разупорядоченных областей на оптоэлектронные свойства облученных быстрыми нейтронами гетероструктур с наноостровками Ge/Si
А. В. Скупов a, *, С. В. Оболенский a, b
a Филиал РФЯЦ-ВНИИЭФ “Научно-исследовательский институт измерительных систем им. Ю.Е. Седакова”
603951 Нижний Новгород, Россия
b Нижегородский государственный университет им. Н.И. Лобачевского
603950 Нижний Новгород, Россия
* E-mail: skav10@mail.ru
Поступила в редакцию 15.01.2020
После доработки 17.02.2020
Принята к публикации 19.02.2020
Аннотация
Показано, что концентрация разупорядоченных областей (кластеров радиационных дефектов), возникающих при облучении полупроводников нейтронами с флюенсом 1013–1015 см–2, на порядок меньше, чем объемная концентрация наноостровков Ge/Si в современных многослойных гетероструктурах с их планарными массивами. Упругие деформации кристаллической решетки вокруг разупорядоченных областей в разы меньше, чем деформации вокруг наноостровков Ge/Si, определяющих их оптоэлектронные свойства. При облучении современных гетероструктур с массивами наноостровков Ge/Si нейтронами с флюенсом 1015 см–2 в область пространственного заряда множества разупорядоченных областей попадают до 40% наноостровков. Сделан вывод, что деградация оптоэлектронных свойств облученных нейтронами гетероструктур с наноостровками Ge/Si обусловлена преимущественно влиянием на кинетику носителей заряда вблизи наноостровков уровней энергии радиационных дефектов в запрещенной зоне и электрических полей разупорядоченных областей.
ВВЕДЕНИЕ
Для применения оптоэлектронных приборов на основе наноразмерных гетероструктур в условиях воздействия ионизирующих излучений необходимо обеспечить радиационную стойкость их электрических, оптических и других физических свойств. Поэтому является актуальным исследование радиационных эффектов, приводящих к деградации свойств гетероструктур при воздействии различных видов ионизирующих излучений [1, 2].
В настоящей работе анализируется влияние на физические свойства гетероструктур с наноостровками Ge/Si разупорядоченных областей (РО) – одного из видов радиационных дефектов, возникающих в полупроводниках при облучении нейтронами, протонами и электронами (с энергией более 10 МэВ) [3–5]. Характерный размер ядра РО составляет 10 нм, ядро образовано материалом с концентрацией дефектов кристаллической структуры порядка 1019–1020 см–3. РО окружена областью пространственного заряда, протяженность которой может превышать 100 нм.
Изучение свойств наноостровков Ge/Si представляет интерес, поскольку на основе их многослойных массивов в перспективе возможно создание светоизлучающих и фотоприемных устройств, совместимых с технологией кремниевой микроэлектроники, и работающих в диапазоне длин волн 1.3–1.5 мкм, характерном для современных оптоволоконных линий связи [6, 7]. Наноостровки Ge/Si формируются посредством самоорганизации по механизму Странского–Крастанова в процессе молекулярно-пучковой эпитаксии. В работах [6, 7] получены наноостровки в форме пирамид (hut-кластеры) высотой 1.5–1.7 нм и длиной основания 10–15 нм, имеющие выраженный дискретный спектр энергий электронов и дырок (квантовые точки). Поверхностная плотность таких наноостровков составляет 3 × 1011 см–2. В работах [8, 9] получены куполообразные наноостровки (dome-кластеры) Ge/Si высотой 10–12 нм, размером в плоскости основания 65–75 нм и поверхностной плотностью 1010 см–2. В зависимости от условий роста могут быть получены наноостровки высотой от 2 до 45 нм, диаметром от 30 до 250 нм и плотностью 4.0 × 108–1.5 × 1011 см–32 [10, 11]. На основе многослойных массивов наноостровков Ge/Si созданы оптоэлектронные приборы [6–9], их параметры исследуются, в том числе и после радиационных воздействий [8, 9].
Цель настоящей работы – теоретическое исследование влияния на оптоэлектронные свойства многослойных массивов наноостровков Ge/Si разупорядоченных областей, возникающих при облучении гетероструктур быстрыми нейтронами.
1. ОБЩИЕ ПОЛОЖЕНИЯ
Экспериментально установлено, что при облучении протонами (нейтронами, электронами) ряд физических свойств трехмерных нановключений в гетероструктурах на основе твердых растворов InAs/GaAs, Ge/Si подвержены деградации в меньшей степени, чем аналогичные свойства квантовых ям. В работах [8, 9, 12, 13] это установлено по изменениям спектров фото- и электролюминесценции (ФЛ и ЭЛ). Бóльшая по сравнению с квантовыми ямами радиационная стойкость свойств наноостровков обусловлена их малыми геометрическими размерами и трехмерной пространственной локализацией носителей заряда в них. Поэтому полезные для практического использования свойства наноостровков в меньшей степени, чем свойства квантовых ям, подвержены влиянию неизбежно возникающих при облучении радиационных дефектов. Тем не менее, интенсивность ФЛ и ЭЛ многослойных массивов наноостровков уменьшается с увеличением интегрального потока воздействующего излучения.
Влияние радиационных точечных дефектов кристаллической структуры (комплексов вакансий, междоузельных атомов, атомов примеси) на оптоэлектронные свойства наноостровков аналогично влиянию дефектов, возникающих в процессе выращивания гетероструктур. Такие дефекты создают в запрещенной зоне полупроводников уровни энергии, через которые происходит рекомбинация носителей заряда. Концентрация носителей в разрешенных зонах уменьшается, и, как следствие, уменьшается интенсивность их взаимодействия с наноостровками. В то же время происходит туннелирование носителей заряда с энергетических уровней в наноостровках на уровни дефектов в запрещенной зоне с их последующей безызлучательной рекомбинацией [12, 14].
Процессы, происходящие при образовании РО, и их влияние на электрофизические свойства полупроводников подробно изучались ранее [3–5]. Входящие в состав РО дефекты выступают как центры захвата и рекомбинации носителей заряда. При возникновении значительной концентрации РО в полупроводнике уменьшаются время жизни и концентрация носителей заряда. В отличие от радиационных точечных дефектов, РО представляют собой трехмерные включения, деформирующие кристаллическую решетку [15] и создающие в ней протяженное электрическое поле [5]. В то же время установлено, что свойства наноостровков определяются упругими напряжениями, модифицирующими зонную структуру вблизи них, и кулоновским взаимодействием носителей заряда [6]. В результате образования значительной концентрации РО происходит суперпозиция как упругих напряжений, так и электрических полей от нескольких РО. Наноостровки могут попасть в область действия этих полей, что может привести к изменениям оптоэлектронных свойств наноостровков и радиационной деградации параметров оптоэлектронных приборов на их основе. Этот аспект влияния РО на свойства гетероструктур с наноостровками в литературе не рассматривался. Ниже приведены численные оценки, характеризующие степень значимости эффектов, связанных с образованием РО в гетероструктурах с наноостровками.
В работе [9] рассматривалась вероятность попадания РО (кластера радиационных дефектов) в наноостровок в зависимости от флуенса нейтронов, воздействующего на гетероструктуру, при этом упругие напряжения и электрические поля РО не учитывались. В [13] высказано предположение, что экспериментально наблюдаемые изменения оптических свойств облученных нейтронами гетероструктур с квантовыми ямами InGaAs/AlGaAs связано с изменением амплитуды упругих напряжений в них. Таким образом, исследование влияния упругих и электрических напряжений, создаваемых РО, на свойства наноразмерных гетероструктур актуально для интерпретации экспериментальных данных. В [16] показано, что вероятность образования радиационных дефектов в наноостровках при облучении нейтронами спектра деления урана мала (дефекты образуются в 3–6% наноостровков от общего числа в многослойной гетероструктуре), однако РО рассматривались не как трехмерные кластеры радиационных дефектов, а как совокупность радиационных точечных дефектов. Настоящая работа является продолжением работы [16].
2. РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
Рассмотрим РО, возникающие при облучении быстрыми нейтронами, для определенности в дальнейшем. В разделе 2.1 приведены оценки концентрации наноостровков Ge/Si в гетероструктурах, описание которых приведено в литературе, и их соотношение с концентрацией РО, возникающих при имеющих место в экспериментах флюенсах нейтронов. В разделе 2.2 рассчитана амплитуда деформаций кристаллической решетки, создаваемых РО, и проведено сравнение ее с деформациями вблизи наноостровков Ge/Si. В разделе 2.3 рассчитан потенциал электрического поля РО и протяженность области пространственного заряда вокруг нее. В разделе 2.4 проанализированы некоторые механизмы влияния РО на оптоэлектронные свойства наноостровков Ge/Si.
2.1. Зависимость от флуенса нейтронов
Среднюю концентрацию РО можно оценить в приближении однократного упругого рассеяния нейтрона на ядрах атомов в объеме полупроводниковой структуры по формуле NDR = σ(En)NatFn, где σ(En) – сечение взаимодействия нейтрона с энергией En с веществом, Nat – концентрация атомов, Fn – флюенс нейтронов. Согласно [17], для кремния σ(En) варьируется от 1 до 10 барн в интервале энергий En от 0.1 до 10 МэВ, среднее сечение составляет 2 барна. Концентрация атомов кремния Nat = 5 × 1022 см–3. Среднее расстояние между РО можно вычислить по формуле LDR = = (3/(4πNDR))1/3. На рис. 1 приведены зависимости NDR и LDR от Fn для σ(En), равных 1, 2 и 10 барн. Дальнейшие расчеты проведены для среднего значения сечения σ(En) = 2 барн.
Рис. 1.
Зависимость средней концентрации РО (NDR) и среднее расстояние (LDR) между ними от флюенса нейтронов для сечений их взаимодействия с ядрами атомов кремния, барн: 1 – 1, 2 – 2, 3 – 10.
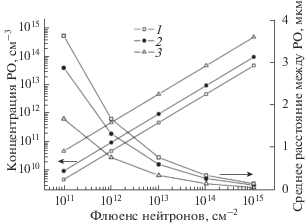
Концентрация наноостровков в многослойной гетероструктуре из их планарных массивов может быть оценена по формуле Nis = Nsn/d, где Ns – поверхностная плотность наноостровков, n – число слоев, d – толщина гетероструктуры с наноостровками. Среднее расстояние между наноостровками Lis ≈ (Nis)1/3. Результаты расчетов для гетероструктур, полученных в работах [7, 9], представлены в табл. 1.
Из приведенных на рис. 1 и в табл. 1 данных видно, что значения NDR и Nis имеют один и тот же порядок (≈1015 см–3) лишь при максимальном флюенсе нейтронов (Fn ≈ 1015 см–2). При таком флюенсе нейтронов LDR ≈ 0.1–0.2 мкм, с учетом радиуса РО (около 10 нм [5, 18]) в массивах наиболее крупных наноостровков (высотой до 12 нм, размером в плоскости основания до 75 нм [9]) возможно прямое попадание РО в наноостровки (Lis ≈ 0.15 мкм, табл. 1). Поскольку РО – устойчивый радиационный дефект, обладающий спектром уровней энергии в запрещенной зоне, это приведет к нарушению процессов генерации и рекомбинации носителей заряда в наноостровках, сопровождающихся поглощением и испусканием фотонов, и исключению вклада этих наноостровков в ФЛ и ЭЛ. При флюенсах нейтронов менее 1015 см–2 вследствие значительно меньшей средней концентрации возникающих РО (при Fn = 1014 см–2, NDR = 1013 см–3) деградация оптоэлектронных свойств массивов наноостровков (Nis ≥ 1014 см–3) в результате прямого попадания РО в наноостровки маловероятна. То же справедливо и для более плотных массивов наноостровков высотой 1.5 нм и размером в плоскости основания 15 нм [7]. Среднее расстояние между ними в разы меньше, чем среднее расстояние между РО, поэтому даже при максимальном флуенсе нейтронов (1015 см–2) бóльшая часть наноостровков в гетероструктуре не будет повреждена образованием РО.
2.2. Упругие деформации вблизи разупорядоченной области
Упругие деформации, создаваемые в кристаллической решетке РО, можно оценить, используя следующую модель. Предположим, что РО представляет собой сферу радиусом R1, равным 10 нм [5, 18]. По оценкам [15] в момент окончания динамической стадии развития каскада атомных смещений, в результате которого возникает РО, давление Р1 в окружающей его кристаллической решетке достигает значения109 Па. Компоненты тензора деформаций вокруг РО можно получить, используя решение задачи о распределении деформаций по толщине шарового слоя, внутри которого действует давление P1, а снаружи давление равно нулю [19]. В сферической системе координат, центр которой совпадает с центром РО, компоненты тензора деформации выражаются следующим образом:
Подставляя в эти формулы значения упругих постоянных для кремния (в приближении изотропного кристалла согласно справочным данным [20], коэффициент Пуассона ν = 0.21, модуль Юнга Е = 171.8 ГПа), получим, что величина εrr не превышает 0.7 × 10–2 вблизи поверхности РО (R ≈ ≈ R1). Полученные значения деформации – оценка сверху, поскольку на стадии аккомодации РО к окружающей кристаллической решетке давление Р1 внутри нее становится меньше принятого в расчетах значения.
Упругие деформации вокруг наноостровков обусловлены рассогласованием постоянных кристаллических решеток материала, из которого они состоят, и материала, в объем которого они встроены. Для гетероструктур Ge/Si это рассогласование равно (aSi – aGe)/аSi = 4.2 × 10–2, где aSi, aGe – постоянные решеток кремния (0.543 нм) и германия (0.566 нм) соответственно [20]. Пространственное распределение деформаций вокруг наноостровка Ge/Si в форме пирамиды высотой 1.5 нм и длиной основания 15 нм рассчитано в работе [21]: характерная величина тензора деформаций составляет (0.5–1.0) × 10–2 и уменьшается практически до нуля на расстоянии ≥ 5 нм от поверхности наноостровка. Амплитуда деформаций, создаваемых наноостровком Ge/Si в форме усеченной пирамиды, аппроксимирующей dome-кластер высотой 10 нм и длиной стороны основания 70 нм [8, 9], была рассчитана в прямоугольных координатах по формулам из работы [22]. Амплитуда деформаций составляет (2.5–6.5) × 10–2.
Из сравнения приведенных выше значений упругих деформаций от РО и наноостровков Ge/Si, полученных экспериментально гетероструктур, следует, что максимальная амплитуда деформаций от РО в разы меньше деформаций от наноостровка. Деформации от РО спадают по закону ~1/r 3 и на расстоянии ≥20 нм от воображаемой поверхности РО практически равны нулю. Следовательно, с учетом среднего расстояния между наноостровками (≥22 нм, табл. 1) и среднего расстояния между РО (≥200 нм при Fn = 1015 см–2, рис. 1), деформации от РО не могут существенно повлиять на распределение деформаций от большого числа наноостровков в гетероструктуре и модифицировать их зонную структуру, определяющую оптические и электронные свойства.
2.3. Электрическое поле разупорядоченной области
Концентрация радиационных дефектов (N2) в ядре РО (ди- и тетравакансий, комплексов точечный дефект–примесь и др.) по оценкам может достигать 1019–1020 см–3 [5, 15, 18]. На уровни энергии в запрещенной зоне этих дефектов захватываются носители заряда, РО заряжается, электрическое поле создает изгиб дна зоны проводимости и потолка валентной зоны. Величина потенциального барьера в кремнии n-типа проводимости при комнатной температуре может достигать φс = 0.24 эВ [18]. Следуя модели Госсика [5] можно получить выражение для потенциала электрического поля РО:
(1)
$\varphi \left( r \right) = \frac{{{{N}_{2}}e}}{{6\varepsilon {{\varepsilon }_{0}}}}\left( {3R_{2}^{2} - {{r}^{2}} - {{2R_{2}^{3}} \mathord{\left/ {\vphantom {{2R_{2}^{3}} r}} \right. \kern-0em} r}} \right),$В современных гетероструктурах размеры наноостровков Ge/Si и толщины разделяющих их планарные массивы слоев составляют единицы и десятки нм, следовательно, электрическое поле одной РО может влиять на свойства нескольких наноостровков внутри сферы радиусом R2. Число таких наноостровков в активной области приборных гетероструктур можно оценить по формуле nis = $4\pi R_{2}^{3}$Nsn/3d (обозначения введены выше). Для фотодетектора с наиболее плотным массивом наноостровков (табл. 1), описанного в работе [7], Ns = 3 × 1011 см–2, n = 36, d = 1.1 × 10–4 см и nis = = 1350 шт.
Как следует из рис. 1, при Fn = 1014 см–2, NDR = = 1013 см–3 среднее расстояние между РО LDR составляет 300–400 нм. Таким образом, протяженность области пространственного заряда (ОПЗ) вокруг соседних РО составляет 2R2 ≤ LDR, поэтому при флюенсах нейтронов Fn ≥ 1014 см–2 будет происходить суперпозиция электрических полей от нескольких РО. Была вычислена доля находящихся в ОПЗ РО наноостровков от их полного числа в гетероструктуре: w = NDR(Fn)n/Nis × 100%. Зависимость величины w от флюенса нейтронов представлена на рис. 2. Область действия электрического поля РО ограничивалась сферой радиусом 100 нм (как будет показано ниже, его влияние на зонную структуру наноостровков наиболее существенно в пределах этого расстояния от ее центра). Видно, что электрические поля множества РО оказывают влияние на 4% наноостровков в многослойной гетероструктуре при флюенсе нейтронов 1014 см–2, доля наноостровков возрастает до 40% при Fn = 1015 см–2.
Электрическое поле и рекомбинация носителей заряда на радиационных дефектах РО вызывает диффузионно-дрейфовое перераспределение носителей заряда в ОПЗ. В результате изменяются и абсолютная концентрация, и соотношение концентраций электронов и дырок вблизи наноостровков, находящихся в ОПЗ РО. Изменения концентрации носителей заряда вблизи РО повлекут за собой изменения интенсивности оптических переходов в наноостровках, попавших в их ОПЗ.
Рис. 2.
Зависимости концентрации наноостровков в многослойном массиве, находящихся в ОПЗ РО, от флюенса нейтронов. Расчет выполнен для различных поверхностных плотностей наноостровков и числа слоев в гетероструктуре (табл. 1): 1 – 3 × 1011 см–2, 36 слоев; 2 – 1010 см–2, 20 слоев; 3 – 109 см–2, 20 слоев.
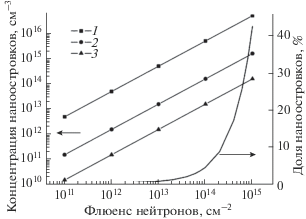
2.4. Влияние разупорядоченных областей на оптоэлектронные свойства наноостровков
Гетероструктуры Ge(Si)/Si(001) образуют гетеропереходы второго типа [6]. Если размеры наноостровка Ge/Si малы [6], то в них проявляются эффекты размерного квантования энергии носителей заряда. Наноостровок – потенциальная яма для дырок, поэтому спектр их энергии дискретен. Под действием упругих деформаций и кулоновского притяжения электронов дырками в наноостровке дно зоны проводимости кремния вблизи него образует треугольную потенциальную яму для электронов. Глубина ямы в вертикально упорядоченном массиве КТ составляет 0.1 эВ [23]. Установлено, что поглощение и испускание фотонов наноостровками Ge/Si, обладающими дискретным спектром энергии носителей заряда, определяется экситонами и экситонными комплексами. При фотогенерации электронно-дырочной пары дырка локализуется внутри наноостровка, а электрон локализован в потенциальной яме в зоне проводимости вблизи него.
В работе [24] исследования межзонных оптических переходов в наноостровках Ge/Si в электрическом поле проведены методом токовой спектроскопии. При малых величинах электрического поля на спектрах наблюдается пик фототока симметричной формы, связанный с непрямым экситонным переходом между основным состоянием дырки в Ge и электрона в Si. С возрастанием величины электрического поля ширина пика фототока увеличивается, и пик расщепляется на две составляющие. Полученные результаты объясняются тем, что дипольные моменты образовавшихся в наноостровке экситонов противоположным образом ориентируются по отношению к направлению приложенного электрического поля. Для одного из диполей внешнее поле способствует увеличению перекрытия волновых функций электрона и дырки, росту энергии связи экситона и смещению пика спектра фототока в область больших энергий оптических переходов. В диполе противоположного направления перекрытие волновых функций будет ослабляться, что приведет к уменьшению энергии связи и смещению пика в область меньших энергий. Напряженность электрического поля в эксперименте [24] достигала 100 кВ/см.
По формуле (1) можно оценить напряженность электрического поля от РО: E = −dU/dr ≈ ≈ ‒(φ(ra) − φ(rb))/|ra – rb|, где ra, rb – расстояния от центра РО до вершины и основания наноостровка Ge/Si. В качестве характерного расстояния изменения потенциала электрического поля примем высоту наноостровка Ge/Si h: |ra – rb| = h = 1.5 нм, тогда U = φ(ra) – φ(rb) ≈ 0.006 В. Напряженность электрического поля на расстоянии 20 нм от центра РО составит ~40 кВ/см. Но при этом наноостровки Ge/Si окажутся на разных расстояниях от РО, электрическое поле которой будет иметь различную напряженность и в разной степени изменять их экситонный спектр. Поэтому экспериментально может наблюдаться лишь увеличение ширины спектральных пиков фототока или фотолюминесценции от наноостровков Ge/Si облученных гетероструктур с РО.
В электрическом поле возможна также диссоциация экситонов, если энергия входящих в его состав носителей, превышает энергию связи экситона. Для наноостровков Ge/Si энергия связи экситона, образованного находящимися в основном состоянии электроном и дыркой, составляет 38 мэВ [6]. Энергия, приобретаемая электроном и дыркой в поле РО, равна qU, где U – разность потенциалов на расстоянии, равном радиусу экситона. Учитывая пространственное распределение волновых функций носителей в наноостровке Ge/Si [6], в качестве радиуса экситона можно принять высоту наноостровка h. Используя вычисленное ранее значение разности потенциалов электрического поля РО между вершиной и основанием наноостровка, U = φ(ra) – φ(rb), расположенной на расстоянии 20 нм от центра РО, получим, что энергия, приобретаемая электроном и дыркой экситона, составляет 6 мэВ. Таким образом, действие электрического поля РО не приводит к диссоциации экситонов вблизи наноостровка Ge/Si.
В наноостровках Ge/Si малых размеров проявляются свойства, характерные для квантовых точек. Положение уровней энергии основного состояния дырки (E111, Е131, Е133) в таких наноостровках может быть оценено по модели “квантового ящика” с бесконечными стенками [25]. Эта модель обеспечивает хорошее согласие результатов расчета с экспериментальными данными. Наноостровок пирамидальной формы заменялся эффективным параллелепипедом с размерами h (высота пирамиды) и а (длина основания) соответственно в направлении роста и в плоскости роста. Тогда положение уровней энергии может быть вычислено по формуле [25]:
(2)
${{E}_{{nmk}}} = \frac{{{{\pi }^{2}}{{\hbar }^{2}}}}{{2m{\text{*}}}}\left( {\frac{{{{n}^{2}}}}{{{{h}^{2}}}} + \frac{{{{m}^{2}}}}{{{{a}^{2}}}} + \frac{{{{k}^{2}}}}{{{{a}^{2}}}}} \right),$На рис. 3 представлена зонная диаграмма кремния с проводимостью, близкой к собственной с РО, и наноостровком Ge/Si для трех возможных конфигураций их расположения: расстояние между их геометрическими центрами составляет L1 ≥ R2, L2 = 20 нм, L3 = 40 нм. За ноль отсчета энергии принято положение потолка валентной зоны в кристалле без РО. Положение зон рассчитывалось по формуле: Ec(v)(x) = $E_{{{\text{c}}({v})}}^{0}$ – eφ(x), где $E_{{{\text{c}}({v})}}^{0}$ – положение зоны проводимости (валентной) кремния, φ(х) – потенциал электрического поля РО (рассчитан по формуле (1)). При L1 влияние электрического поля на наноостровок пренебрежимо мало. При L2 и L3 сдвиг уровней энергии основного состояния дырок в наноостровке равен сдвигу дня квантовой ямы. Поэтому уровни энергии Е111, Е131, Е133 при L2 и L3 смещаются относительно своего положения при L1 на ту же величину, что и дно “квантового ящика”. На рис. 3 показаны также уровни энергии дивакансий (V2) – основного дефекта в ядре РО [3, 4].
Рис. 3.
Зонная диаграмма кремния с наноостровком (НО) Ge/Si и РО при расстояниях 20, 40, 140 нм между их центрами. Е111, Е131, Е133 – энергии основного состояния дырок в квантовой яме НО, V2 – уровни дивакансий (Ec – 0.23, Ec – 0.39, Ev + 0.19 эВ), EF – уровень Ферми.
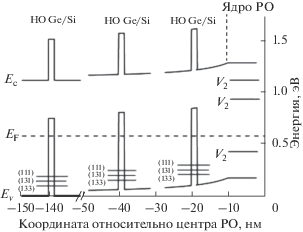
Радиационные дефекты в РО неоднородно распределены вокруг ее центра [5, 18]. Поэтому возможны такие пространственные конфигурации дефектов и наноостровка, при которых расстояние между ними будет меньше 10 нм, и будет возможно туннелирование носителей с уровня размерного квантования на уровни радиационных дефектов с последующей их безызлучательной рекомбинацией. Рекомбинация носителей заряда на радиационных дефектах разупорядоченных областей приведет также к возникновению диффузионного потока носителей к РО. Часть этих носителей может попадать в наноостровки, находящиеся вблизи РО, и рекомбинировать в них с испусканием фотонов. Возможно, этим объясняется возрастание интенсивности люминесценции от наноостровков при малых флуенсах, воздействующих на гетероструктуры корпускулярных излучений [13, 27]. При возрастании флюенса излучений и накоплении радиационных дефектов в объеме гетероструктур рекомбинация носителей через их уровни в запрещенной зоне становится доминирующим механизмом удаления носителей заряда.
Результаты выполненных теоретических исследований в настоящее время не имеют прямого экспериментального подтверждения, в том числе и известными из литературы данными. Однако, сделанные оценки согласуются с результатами экспериментальных исследований по облучению гетероструктур с наноостровками Ge/Si [8, 9]. В этих работах установлено, что интенсивность сигнала ФЛ- и ЭЛ-гетероструктур с наноостровками сохраняется даже при воздействии нейтронов с флуенсом 1015 см–2, поскольку сохраняется некоторая доля наноостровков без радиационных дефектов в объеме и с неискаженной электрическим полем РО (согласно приведенным выше оценкам до 60%) спектром энергии носителей заряда.
ЗАКЛЮЧЕНИЕ
По результатам анализа влияния упругих деформаций и электрического поля разупорядоченных областей, возникающих при облучении гетероструктур быстрыми нейтронами (протонами, электронами), на оптоэлектронные свойства наноостровков Ge/Si можно сделать следующие выводы.
1. Средняя концентрация разупорядоченных областей, возникающих в кремниевых гетероструктурах при облучении быстрыми нейтронами с флуенсом 1013–1015 см–2, более чем на порядок величины меньше, чем концентрация наноостровков в экспериментально полученных гетероструктурах Ge/Si. Поэтому возникновение разупорядоченных областей в объеме наноостровков, приводящее к деградации их оптоэлектронных свойств, маловероятно.
2. Упругие деформации кристаллической решетки, вызванные образованием РО, из-за малой величины (~0.7 × 10–2 вблизи РО) слабо влияют на деформации вокруг наноостровков Ge/Si (~4.2 × 10–2) и, как следствие, на определяемые ими оптоэлектронные свойства (спектр энергии носителей заряда и др.).
3. Концентрация возникших в каскадах атомных смещений РО при флюенсах нейтронов 1011–1015 см–2 составляет 1010–1014 см–3 соответственно. Электрические поля множества РО оказывают влияние на 4% наноостровков Ge/Si (от их полного числа в многослойной гетероструктуре) при флюенсе нейтронов 1014 см–2, доля наноостровков возрастает до 40% при возрастании флюенса до 1015 см–2.
4. Электрическое поле РО изменяет положение дна зоны проводимости и потолка валентной зоны в гетероструктурах с наноостровками Ge/Si. Вместе с уровнями разрешенных зон на величину разности потенциалов между РО и невозмущенным кристаллом смещаются и уровни размерного квантования энергии наноостровков, расположенных в радиусе 100–150 нм от РО. Это приведет к изменению энергии оптических переходов в наноостровках вблизи РО на величину до 0.17–0.24 эВ.
5. При образовании РО в запрещенной зоне кремния возникает спектр уровней радиационных дефектов (дивакансий, комплексов точечный дефект–атом примеси). Их положение таково, что возможен обмен носителями заряда посредством туннелирования между уровнями дефектов и разрешенными зонами энергии (или уровнями размерного квантования) наноостровков Ge/Si, находящихся в радиусе около 10 нм от РО. Этот процесс может сопровождаться безызлучательной рекомбинацией носителей заряда через уровни радиационных дефектов и деградацией оптоэлектронных свойств гетероструктур.
6. Электрическое поле РО создает в зоне проводимости барьер для электронов и “яму” для дырок в валентной зоне и, как следствие, области обеднения электронами и обогащения дырками. Поэтому вблизи наноостровков, находящихся в радиусе 100–150 нм от РО, изменяется концентрация носителей заряда в зонах и эффективность их захвата в наноостровки. Электрическое поле и рекомбинация носителей заряда на радиационных дефектах РО вызывает диффузионно-дрейфовое перераспределение носителей заряда в ОПЗ РО. В результате изменяются и абсолютная концентрация, и соотношение концентраций электронов и дырок вблизи наноостровков Ge/Si, находящихся в ОПЗ РО. Изменения концентрации носителей заряда вблизи РО повлекут за собой изменения интенсивности оптических переходов в наноостровках, попавших в их ОПЗ.
Для дальнейшего уточнения сделанных в работе теоретических оценок целесообразно рассмотреть диффузионное перераспределение радиационных точечных дефектов в объеме наноостровков и вокруг них с учетом действующих в гетероструктуре полей упругих напряжений. Следует учесть, что рост наноостровков Ge(Si)/ Si(001) происходит когерентно, без образования дефектов кристаллической структуры на границе раздела, поэтому притянутые к ней радиационные дефекты будут рекомбинировать только между собой или образовывать вблизи нее устойчивые комплексы дефектов.
Список литературы
Герасименко Н.Н., Смирнов Д.И. // Нано- и микросистемная техника. 2008. № 9. С. 2.
Sobolev N.A. // Физика и техника полупроводников. 2013. Т. 47. № 2. С. 182.
Козлов В.А., Козловский В.В. // Физика и техника полупроводников. 2001. Т. 35. № 7. С. 769.
Ермолов П., Карманов Д., Лефлат А., Мананков В., Меркин М., Шабалина Е. // Физика и техника полупроводников. 2002. Т. 36. № 10. С. 1194.
Новиков В.А., Пешев В.В.//Физика и техника полупроводников. 1998. Т. 32. № 4. С. 411.
Двуреченский А.В., Якимов А.И. // Физика и техника полупроводников. 2001. Т. 35. № 9. С. 1143.
Якимов А.И., Двуреченский А.В., Никифоров А.И., Чайковский С.В., Тийс С.А. // Физика и техника полупроводников. 2003. Т. 37. № 11.С. 1383.
Новиков А.В., Яблонский А.Н., Платонов В.В., Оболенский С.В., Лобанов Д.Н., Красильник З.Ф. // Физика и техника полупроводников. 2010. Т. 44. № 3. С. 346.
Красильник З.Ф., Кудрявцев К.Е., Качемцев А.Н., Лобанов Д.Н., Новиков А.В., Оболенский С.В., Шенгуров Д.В. // Физика и техника полупроводников. 2011. Т. 45. № 2.С. 230.
Larsson M., Elfving A., Ni W.X., Hansson G.V., Holtz P.O. // Phys. Rev. B. 2006. V. 73. P. 195319.https://doi.org/10.1103/PhysRevB.73.195319
Miesner C., Rothig O., Brunner K., Abstreiter G. // Physica E. 2000. V. 7. P. 146.
Marcinkevicius S., Sigert J., Leon R., Cechayicius B., Magness B., Taylor W., Lobo C. // Phys. Rev. B. 2002. V. 66. P. 235314.https://doi.org/10.1103/PhysRevB.66.235314
Байдусь Н.В., Вихрова О.В., Звонков Б.Н., Малышева Е.И., Труфанов А.Н. // Физика и техника полупроводников. 2015. Т. 49. № 3. С. 370.
Игнатьев И.В., Козин И.Э. Динамика носителей в полупроводниковых квантовых точках. СПб, 2005. 126 с.
Артемьев В.А., Михнович В.В. // Физика и техника полупроводников. 1986. Т. 20. № 1. С. 167.
Скупов А.В. // Физика и техника полупроводников. 2015. Т. 49. № 5. С. 634.
National Nuclear Data Center (NNDC). http:// www.nndc.bnl.gov
Васильев А.В., Изтелеулов М.И., Смагулова С.А., Смирнов Л.С. // Физика и техника полупроводников. 1985. Т. 19. № 11. С. 2073.
Ландау Л.Д., Теоретическая физика. В 10-ти томах. Т. VII. Теория упругости. 4-е изд. М.: Наука, 1987. 248 с.
Францевич И.Н. Упругие постоянные и модули упругости металлов и неметаллов. Справочник. Киев: Наукова Думка, 1982. 286 с.
Nenashev A.V., Dvurechenskii A.V. // JETP. 2000. V. 91. № 3. P. 497.
Pearson G.S., Faux D.A. // J. Appl. Phys. 2000. V. 88. № 2. P. 730.https://doi.org/10.1063/1.373729
Якимов А.И., Двуреченский А.В., Блошкин А.А., Ненашев А.В. // Письма в ЖЭТФ. 2006. Т. 83. № 4. С. 189.
Двуреченский А.В., Якимов А.И., Ненашев А.В., Зиновьева А.Ф. // ФТТ. 2004. Т. 46. № 1. С. 60.
Талочкин А.Б., Чистохин И.Б. // ЖЭТФ. 2011. Т. 140. № 3. С. 583.
El Kurdi M., Sauvage S., Fishman G., Boucaud P. // Phys. Rev. B. 2006. V. 73. P. 195 327.https://doi.org/10.1103/PhysRevB.73.195327
Leon R., Swift G.M., Magnesset B., Taylor W.A., Tang Y.S., Wang K.L., Dowd P., Zhang Y.H. // Appl. Phys. Lett. 2000. V. 76. P. 2074.https://doi.org/10.1063/1.126259
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования


