Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2020, № 11, стр. 61-67
Высокочувствительный термодатчик на основе монокристалла Si(111), имплантированного с разных сторон ионами Р+ и В+
А. С. Рысбаев a, *, М. Т. Нормурадов b, **, А. М. Рахимов a, З. А. Турсунметова c, А. К. Ташатов b
a Ташкентский государственный технический университет
им. И.А. Каримова
100095 Ташкент, Узбекистан
b Каршинский государственный университет
180103 Карши, Узбекистан
c Научно-исследовательский институт физики полупроводников и микроэлектроники Национального университетa Узбекистана
100057 Ташкент, Узбекистан
* E-mail: rysbaev@mail.ru
** E-mail: m.normurodov@mail.ru
Поступила в редакцию 11.01.2020
После доработки 04.02.2020
Принята к публикации 07.02.2020
Аннотация
Проанализированы характеристики существующих датчиков температуры на основе монокристаллов кремния, установлены причины ограничения верхнего предела измерения температуры. Для повышения чувствительности, расширения диапазона измеряемых температур и получения линейной выходной характеристики датчика температуры предложено провести поэтапную имплантацию ионов Р+ и В+ с понижением энергии в разные стороны кристалла Si(111) с последующим кратковременным термическим, лазерным отжигом и ИК-излучением после каждой стадии ионной имплантации. Изучены профили распределения атомов Р и В, имплантированных в Si с постепенным уменьшением энергии. Исследовано влияние последующего термического отжига и ИК-излучения на профили распределения атомов и характеристики термодатчика. В работе создан p–i–n-диод с высокой концентрацией электрически активных атомов (NP = 1021 см–3, NB = 2 × 1021 см–3), практически со ступенчатым распределением атомов Р и В и резкой границей p–i и i–n-областей, обладающий высокой термочувствительностью (2.3 мВ/К) в широком диапазоне температур 20–550 К.
ВВЕДЕНИЕ
Особая чувствительность свойств полупроводниковых материалов к наличию незначительных примесей, температуре, давлению, воздействию электромагнитного излучения и т.д. широко используется при создании различных типов датчиков [1–3]. Термочувствительные элементы на основе кремния были получены в ряде работ [3–6]. В частности, исследованиями электрофизических свойств кремния, диффузионно-легированного марганцем показана [6] возможность получения материала с высокой термочувствительностью. Однако, как в [6], так и в других известных нам работах [7–9], где получали и изучали датчики температуры на основе кремния, говорится о структурах, способных измерять температуру объектов лишь до 350–380 K. Это связано с тем, что при указанных температурах происходит ионизация примесных атомов и при более высоких температурах наступает собственная проводимость кремния. Другим недостатком термоэлементов на основе Si является нелинейность их температурной характеристики.
Целью данной работы является разработка высокочувствительного датчика температуры на основе монокристалла Si(111), с линейной выходной характеристикой в широкой области температур. Для создания такого датчика нами были выбраны p–i–n-структуры.
Для создания p–i–n-структур обычно используются следующие технологические методы: эпитаксиально-диффузионный, двухсторонне-эпитаксиальный и двухсторонне-диффузионный методы [10].
При изготовлении полупроводниковых приборов в зависимости от типа легирующей примеси и используемой технологии в структурах образуются различные дефекты, ухудшающие качество диодов и их пробойные характеристики. Кроме того, при использовании высокотемпературных технологий, какими являются эпитаксиальные и диффузионные технологии создания p–i–n-структур, возможна активация примесей исходного материала, например, атомов Na, которые могут создавать быстрые состояния, разнообразные ловушки [11], макроскопические флуктуации, ведущие к появлению хвостов плотности состояний [12], или же крупные неоднородности (при больших концентрациях порядка 1013 см–2) [13, 14]. Если волновые функции подобных состояний перекрываются, между ними становится возможным туннелирование. При высоких температурах возможно также тепловое возбуждение до края подвижности.
Поэтому для получения p–i–n-структуры мы выбрали метод ионной имплантации, не подвергающий образец высокотемпературному прогреву. Перед нами стояла задача создать термодатчик, удовлетворяющий следующим требованиям:
1) малые габариты;
2) высокая температурная чувствительность;
3) широкий диапазон измеряемых температур;
4) линейность температурной характеристики выходного сигнала датчика.
Последнее требование было связано с необходимостью использования датчика в качестве первичного прибора в составе системы для автоматического регулирования температуры технологических процессов. Выполнение этого требования обеспечивало универсальность датчика для использования в различных технологических процессах.
МЕТОДИКА
Для получения датчика, удовлетворяющего вышеуказанным требованиям, необходимо было обеспечить максимальную степень легирования р- и n-слоев и создать резкие границы p–i и i–n-переходов. Для получения таких резких границ переходов нами проводилась имплантация ионов Р+ и В+ в разные стороны очищенных монокристаллов Si(111). Эксперименты проводились с образцами Si(111) р-типа с удельным сопротивлением ρ = 3000 и 6000 Ом · см толщиной от 0.1 до 1 мм. При этом наиболее хорошие характеристики были получены при использовании образцов Si толщиной 0.1 мм.
Исходные образцы Si(111) перед проведением процесса ионной имплантации тщательно очищались термическим прогревом в два этапа: длительно при Т = 1200 K и кратковременно при Т = 1500 K, а также разработанным авторами [15] новым способом вакуумной очистки поверхности Si, который заключается в создании в приповерхностной области геттерирующего слоя имплантацией ионов Ва или щелочных элементов с низкой энергией (до 5 кэВ) и последующим удалением геттерного слоя кратковременным высокотемпературным прогревом. Эксперименты проводились в сверхвысоковакуумном приборе с трехсетчатым сферическим энергоанализатором с тормозящим полем, позволяющим исследовать состояние поверхности пленок методами: электронной оже-спектроскопии (ЭОС), спектроскопии характеристических потерь энергии (СХПЭЭ), фотоэлектронной спектроскопии (ФЭС) и дифракции быстрых электронов (ДБЭ), а также проводить различные технологические операции: термический прогрев, электронную бомбардировку, ионное травление поверхности, лазерный отжиг, ионную имплантацию. Экспериментальные измерения проводились в вакууме ~10–7 Pa, создаваемым системой безмасляной откачки. Разброс энергии электронов в режиме ЭОС, СХПЭЭ и ДМЭ не превышал 0.1 эВ. Плотность электронного тока варьировалась в пределах 10–8– 10–6 А · см–2. Чувствительность оже-спектрометра составляла ~1011 ат. ⋅ см–2. Спектры ФЭС получали при энергии фотонов 10.8 эВ. Имплантация ионов Р+ и В+ проводили на стандартной установке типа “Иона” в вакууме 10–5 Па при комнатной температуре мишени.
Для создания p и n-слоев в кремнии проводили имплантацию ионов Р+ и В+ и последующий отжиг. Профили распределения атомов Р и В по глубине рассчитывали методом количественной оже-электронной спектроскопии с учетом коэффициентов элементной оже-чувствительности с матричными поправками [16]. При этом послойное травление проводилось ионами Ar+ с энергией 1.5 кэВ, падающими под углом 15° к поверхности. Скорость травления составляла 3–4 Å/мин.
РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
На рис. 1 приведены профили распределения атомов бора, имплантированных в Si(111) с энергией Е0 = 1 кэВ, полученные после термического и лазерного отжига ионно-имплантированных образцов Si.
Рис. 1.
Концентрационные профили распределения атомов В, имплантированных в Si(111) с Е0 = 1 кэВ, полученные после термического отжига при различных Т, K: 300 (1); 900 (2) и 1200 (3) и лазерного отжига с плотностью энергии W, Дж ⋅ см–2: 1.0 (4) и 3.0 (5).
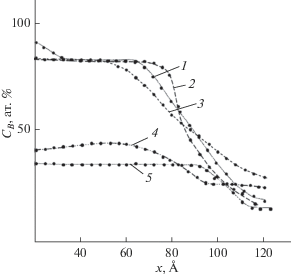
Термический отжиг при Т = 900 K образцов Si(111), имплантированных ионами B+ с Е0 = 1 кэВ позволяет отжечь дефекты и получить в приповерхностной области образца монокристаллическую пленку силицида бора SiB3 толщиной ~40 Å (рис. 1). Импульсный лазерный отжиг Si(111), имплантированного ионами B+ при W = 1.0 Дж · см–2 позволяет получить гетероструктурный переход SiB3–Si с более резкой границей раздела. Для разложения химического соединения SiB3 и полной электрической активации оставшихся атомов B+ необходим термический прогрев при Т = 1200 K или лазерный отжиг с плотностью энергии W = = 3 Дж ⋅ см–2. Отметим, что после лазерного отжига ионно-имплантированных образцов образуется переход n– ––p в случае P и p+ +–p в случае B. Кроме того, нами также были исследованы профили распределения атомов P и B, имплантированных в Si(111) с большей энергией 10, 20 и 80 кэВ. В этом случае отжиг ионно-имплантированных образцов проводили термическим прогревом и импульсным инфракрасным (ИК) излучением с длиной волны λ = 1 мкм и длительностью импульсов ~ единиц микросекунд.
На рис. 2 и 3 показано как трансформируются профили распределения имплантированных с разной энергией атомов P и B в результате термического и ИК-отжига. Как видно из приведенных рисунков, отжиг ИК-излучением также как и лазерный отжиг позволяет получить более резкие профили имплантированных атомов, чем термический отжиг.
Рис. 2.
Профили распределения атомов Р, имплантированных в Si(111) с Е0 = 20 кэВ (1): после ИК-отжига (2), термического отжига при Т = 1200 K (3) и с Е0 = 80 кэВ (4): после ИК-отжига (5) и термического отжига при Т = 1200 K (6).
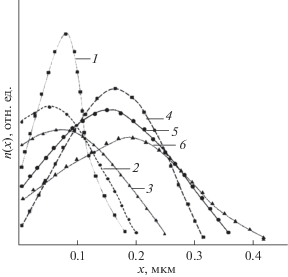
Рис. 3.
Профили распределения атомов В, имплантированных в Si (111) с Е0 = 20 кэВ (1): после ИК-отжига (2), термического отжига при Т = 1100 K (3) и с Е0 = 80 кэВ (4): после ИК-отжига (5), термического отжига при Т = 1100 K (6).
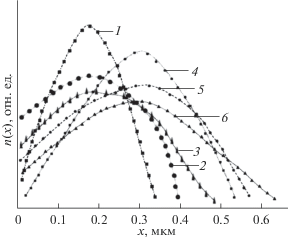
Проведенные нами ранее исследования поведения атомов Р и В, имплантированных в Si (111) с низкой энергией (<5 кэВ) и большой дозой (D ≥ 1017 см–2) показали, что бóльшая часть внедренных атомов вступает в химическое соединение с атомами кремния, а последующий кратковременный термический отжиг при Т = 900 К приводит к образованию фосфида кремния и силицида бора [17].
Очевидно, что при энергиях ионов порядка десятков кэВ и больших дозах облучения концентрация примесных атомов значительно меньше концентрации атомов Si. Однако это не означает, что химическое взаимодействие между атомами невозможно. На основе анализа профилей распределения атомов P и B, имплантированных с большой дозой облучения D ≈ 1017 см–2 с различной энергией до и после отжига ИК-излучением, нами были определены оптимальные энергии, дозы облучения и условия последующего отжига для получения максимально возможной концентрации электрически активных примесей P и B с равномерным их распределением по глубине образца. Было установлено, что для получения равномерного распределения атомов P в Si(111) необходимо провести последовательную имплантацию ионов P+ сначала с энергией Е0 = 80 кэВ и дозой D = 1.8 × 1016 см–2 (рис. 4), а затем с Е0 = = 20 кэВ и D = 1.8 × 1015 см–2. Отжиг ИК-излучением следует проводить после каждой стадии ионной имплантации.
Рис. 4.
Профили распределения атомов Р, имплантированных в Si(111) с Е0 = 80 кэВ и D = 1.8 × 1016 см–2 (1), Е0 = 20 кэВ и D = 1.8 × 1015 см–2 (2).
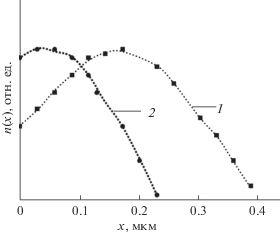
В случае же бора нами установлено, что оптимальными условиями имплантации и отжига являются следующие: сначала имплантация ионов B+ c Е0 = 80 кэВ и D = 0.9 × 1016 см–2, затем с Е0 = = 20 кэВ и D = 3 × 1015 см–2 и, наконец, с Е0 = 10 кэВ и D = 1.8 × 1015 см–2, отжиг ИК-излучением также следует проводить после каждого этапа ионной имплантации (рис. 5).
Рис. 5.
Профили распределения атомов В, имплантированных в Si(111) с Е0 = 80 кэВ и D = 0.9 × 1016 см–2 (1), Е0 = 25 кэВ и D = 3 × 1015 см–2 (2), Е0 = 10 кэВ и D = 1.8 × 1015 см–2.
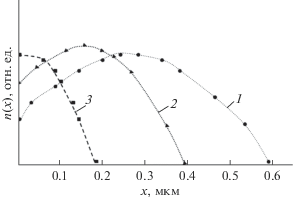
Как видно из приведенных рис. 4 и 5, проведение ионной имплантации и последующего отжига описанным выше способом позволяет получить практически равномерное распределение атомов P в слое толщиной x ≈ 0.4 мкм, а атомов B – в слое с x ≈ 0.6 мкм.
Очевидно, что отжиг дефектов (термическим прогревом или лазерным, или ИК-излучением) наряду с изменением профилей распределения атомов P и B должен приводить к изменению электронной структуры приповерхностной области ионно-имплантированного Si (111).
Выбранные режимы ионной имплантации и последующего отжига для электрической активации обеспечивали получение ступенчатого распределения атомов Р и В, а также резкую границу раздела между примесной и базовой областью Si. Оценка концентрации электрически активных атомов методом электронной оже-спектроскопии показывает, что NP = 1021 см–3, а NB = 2 × 1021 см–3. Аналогичные результаты получаются, если после каждого этапа ионного легирования проводить отжиг импульсным лазерным излучением с плотностью энергии W = 3 Дж ⋅ см–2 (длина волны λ = = 1.06 мкм, длительность импульсов ∼10 наносекунд). Таким образом, в результате подобной ионной имплантации удаeтся получить p–i–n-структуру с большой концентрацией электрически активных примесей и резкой границей между p–i и i–n-областями Si. Отметим, что большая концентрация носителей в p и n-областях Si необходима также для того, чтобы сгладить температурную зависимость контактной области приборов на основе p–i–n-перехода. Исследование методом дифракции быстрых электронов (ДБЭ) кристаллической структуры поверхностей Si (111) после проведения указанной выше ионной имплантации и последующего отжига показало, что обе поверхности p–i–n-перехода имеют монокристаллическую структуру. Следует указать, что для создания термочувствительных структур на основе p–n-перехода широко используется следующие методы: 1) диффузионный способ, заключающийся в проведении термической диффузии примесей акцепторного и донорного типа в монокристаллы Si [18]; 2) эпитаксиальное наращивание слоев кремния из газовой фазы в среде, обогащенной примесями акцепторного или донорного типа [19]; 3) эпитаксиально-диффузионный способ, заключающийся в сочетании термической диффузии примеси с эпитаксиальным наращиванием р- и n-областей [9].
Анализ возможностей этих методов получения p–n-структур показывает, что в первом способе процесс термической диффузии осуществляется при достаточно высоких температурах, что приводит к размытию p–i и i–n-областей, а также к загрязнению их чужеродными примесями. Это отражается на характеристиках термодатчика: снижается линейность температурной зависимости и сужается диапазон измеряемых температур.
Метод двухстороннего выращивания эпитаксиальных слоев p- и n-кремния позволяет получать p–i и i–n-переходы с минимальной концентрационной шириной, ровную границу фронта и сравнительно равномерное распределение примеси по всей поверхности высоколегированного слоя [19]. Однако возможна диффузия легирующих примесей из эпитаксиальных слоев в подложку. Толщина диффузионных слоев составляет ∼ 1 мкм.
При использовании эпитаксиально-диффузионного метода [20], сочетающего процессы эпитаксиального наращивания с термической диффузией примеси из газовой фазы, удается несколько улучшить характеристики приборов по сравнению с рассмотренными выше двумя способами. Однако данным методом не удается получить очень высокие концентрации активных примесей, границы переходов оказываются недостаточно резкими, что сказывается на чувствительности датчика и диапазоне измеряемых температур. Кроме того, данный способ требует использования дорогостоящего оборудования для проведения эпитаксии.
Таким образом, полученная нами p–i–n-структура, представляющая собой диод с дырочной проводимостью базовой i-области, лишена многих недостатков, присущих датчикам температуры, полученных вышеуказанными, традиционными способами.
Для изучения вольтамперных характеристик p–i–n-диода на обе поверхности кристалла наносились металлические контакты. Металлизация поверхности диода проводилась методом вакуумного осаждения атомов Ti и Ni в условиях высокого вакуума при температуре подложки Т = 600 K. Причем сначала осаждались атомы Ti, а затем Ni. Толщина пленок TiNi на поверхностях p–i–n-структуры составляла 100–200 Å.
Вольтамперные характеристики полученного нами p–i–n-диода, определенные при разных температурах, имеют традиционную форму, характерную для диодных структур, и прямое падение напряжения на p–i–n-структуре зависит от температуры диода (рис. 6).
Рис. 6.
Вольтамперные характеристики p–i–n-диода, полученные при различных Т, К: 100 (1), 200 (2), 300 (3).
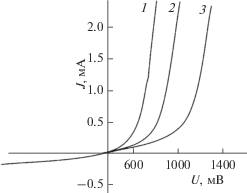
Изучение зависимости прямого падения напряжения Uпр от температуры в процессе формирования p–i–n-структуры имплантацией ионов Р и В в Si с постепенным уменьшением энергии и дозы ионов и проведением импульсного отжига показало, что после проведения первого этапа ионной имплантации зависимость Uпр= f(Т) является не линейной (кривая 1, рис. 7). В результате проведения второго этапа ионной имплантации и отжига зависимость Uпр= f(Т) становится линейной в области низких температур (≤250 K), а после проведения третьего этапа ионной имплантации и отжига эта зависимость становится линейной во всем диапазоне изменения температур (рис. 7).
Рис. 7.
Зависимости прямого падения напряжения на p–i–n-переходе от температуры прогрева для Si (111) с удельным сопротивлением ρ = 6000 Ом ⋅ см (2) и 3000 Ом ⋅ см (3), полученные после имплантации ионов и отжига. Кривая 1 получена без проведения отжига.
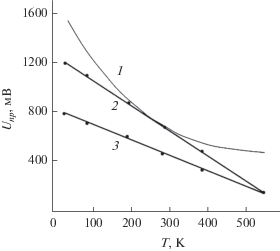
Uпр = f(T)-зависимости получены при пропускании через p–i–n-структуру тока Iп = 1 мA, причем Iп = const (режим стабилизации тока). Как видно из рис. 7, рабочая характеристика датчика также зависит от удельного сопротивления исходного кремния, т.е. определяется процессами в базовой области p–i–n-диода. С уменьшением ρ исходного кремния чувствительность датчика несколько понижается. Картина термочувствительного элемента показана на рис. 8.
ЗАКЛЮЧЕНИЕ
Показано, что имплантацией ионов Р и В в разные стороны монокристалла Si(111) с последовательным понижением энергии и дозы облучения и проведением после каждой стадии имплантации импульсного инфракрасного или лазерного отжига с длиной волны λ = 1 мкм возможно создание равномерного ступенчатого распределения атомов Р и В и формирование p–i–n-структуры с резкой границей раздела p–i и i–n-переходов с высокой концентрацией электрически активных атомов. Наилучшие результаты были получены при имплантации ионов Р+ сначала с энергией Е0 = 80 кэВ и дозой D = 1.8 × 1016 см–2, а затем с Е0 = 20 кэВ и D = 1.8 × 1015 см–2, ионов В+ – с Е0 = 80 кэВ и D = 0.9 × 1016 см–2, затем с Е0 = = 25 кэВ и D = 3 × 1015 см–2 и Е0 = 10 кэВ, D = 1.8 × × 1015 см–2.
Таким образом, приведенные выше технологические режимы ионной имплантации, импульсного инфракрасного и лазерного отжига являются оптимальными для получения термодатчика, обладающего следующими параметрами:
1) диапазон измеряемых температур – от 20 до 550 K. Во всем диапазоне зависимость Uпр= f(Т) – линейная;
2) температурная чувствительность составляет 2.3 мВ ⋅ K–1;
3) ток питания варьируется от 100 мкА до 1 мА.
4) инерционность не превышает 10 мсек.
Установлено, что наиболее хорошие характеристики получаются при использовании образцов Si толщиной 0.1 мм. С уменьшением удельного сопротивления исходного кремния температурная чувствительность p–i–n-структуры снижается.
Список литературы
Юлдашев Ю.Ю., Рысбаев А.С., Хужаниязов Ж.Б., Рахимов А.М., РУз Патент IAP 04779, 2013.
Абдурахманов Б.М., Алиев Р. // Гелиотехника. 1998. № 4. С. 74.
Абдурахманов Б.М., Олимов Л.О. // Гелиотехника. 1998. № 5. С. 78.
Abdurahmanov B.M., Drachuk I.V., Sopen V.I., Akbarov Sh.K. // Uzbek journal of Physics. 2000. V. 2. № 1. P. 73.
Абдурахманов К.П., Витман Р.Ф., Гусева Н.Б., Куликов Г.С., Мелих Б.Т., Юсупова М.А. // ФТП. 1996. № 3. С. 392.
Rysbaev A.S., Khujaniyozov J.B., Bekpulatov I.R., Rakhimov A.M., Pardaev O.R. // J. Surface Invest.: X-ray, Synchrotron and Neutron Techniques. 2017. V. 11. № 2. P. 474.
Орехов А.С. Структура пленок высшего силицида марганца по данным электронной микроскопии: Дис. ... канд. физ-мат. наук. Москва: Институт Кристаллографии, 2017. 176 с.
Orekhov A.S., Kamilov T.S., Ibragimova B.V., Ivakin G.I., Klechkovskaya V.V. // Semiconductors. 2017. V. 51. № 6. P. 706.
А.с. 762 253 (СССР) Способ получения p–n-переходов на основе полупроводниковых соединений А3В5/Физико-технический институт. Каримов А.В., Мирзабаев М. // БИ. 1980. № 4. С. 5.
Мирзабаев М.М., Расулов К., Комилов А., Юсупова Р.Д. // Гелиотехника, 2000. № 1. С. 91.
Di Maria D.J. // J. Appl. Phys. 1981. V. 52. P. 7251.
Harstein A., Fowler A.B. // J. Phys. 1975. V. 8. P. 249.
Bottoms W.R., Gurerman D. // J. Vac. Sci. and Technol. 1974. V.11. P. 965.
Ando T., Fowler A., Stern F. Electronic Properties of Two-Dimensional Systems. N.Y.: Tomas J. Watson Reseach Center, 1982. 415 p.
Rysbaev A.S., Khujaniyozov J.B., Rakhimov A.M., Bekpulatov I.R., РУз Патент IAP 05720, 2018.
Oura K., Lifshits V.G., Saranin A.A., Zotov A.V., Katayama M. // Surface Science an Introdiction. Berlin: Springer, 2003. P. 105.
Rysbaev A.S., Khujaniyazov J.B., Rakhimov A.M., Bekpulatov I.R. // Technical Physics. 2014. V. 59. № 10. P. 1526.
Orekhov A.S., Kamilov T.S., Orekhov Anton S., Arkharova N.A., Rakova E.V., Klechkovskaya V.V. // Nanotechnologies in Russia. 2016. V. 11. № 9–10. P. 610.
Сладков И.Б. Исследование процесса осаждения и свойств эпитаксиальных слоев кремния, легированных бором: Дис. ... канд. физ.-мат. наук. М., 1971. 298 с.
Мирзабаев М.М., Расулов К. Динамические характеристики неоднородных полупроводниковых структур. Ташкент: Изд. Фан, 1995. С. 101.
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования



