Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2020, № 6, стр. 19-30
Проекционный объектив для стенда ЭУФ-литографа
А. А. Егоров a, М. В. Зорина a, И. В. Малышев a, *, А. Е. Пестов a, В. Н. Полковников a, Н. Н. Салащенко a, М. Н. Торопов a, Н. Н. Цыбин a, Н. И. Чхало a
a Институт физики микроструктур РАН
603087 Нижний Новгород, Россия
* E-mail: ilya-malyshev@ipm.sci-nnov.ru
Поступила в редакцию 30.10.2019
После доработки 27.12.2019
Принята к публикации 29.12.2019
Аннотация
Представлен двухзеркальный проекционный объектив Шварцшильда (уменьшение ×5), образованный двумя асферическими зеркалами и разработанный в рамках модернизации стенда литографа с рабочей длиной волны 13.4 нм. Подробно описана методика измерений и результаты коррекции формы асферических зеркал и аберраций объектива в сборном варианте. В результате нескольких коррекций локальных ошибок с помощью ионного пучка было получено среднеквадратичное отклонение формы первичного зеркала 0.8 нм. Аберрации объектива составили 5.4 нм. Моделирование разрешающей способности объектива с учетом измеренных аберраций показало, что тестовые полосы шириной 200 нм разрешаются с контрастом 32%, 100 нм – 23% и 30 нм – 15%. Коэффициенты отражения многослойных зеркал Mo/Si с антистрессовым подслоем Cr/Y составили 63–65% в зависимости от координаты на зеркале. Обсуждаются причины, по которым не удалось скорректировать аберрации объектива до уровня 1 нм, необходимого для достижения дифракционного предела разрешения.
ВВЕДЕНИЕ
Литографию экстремального ультрафиолетового диапазона (ЭУФ) на длине волны 13.4 нм считают литографией будущего, так как за счет короткой длины волны по сравнению с традиционной литографией на длине волны 193 нм существенно упрощается процесс литографии. Он сводится к классической процедуре: нанесение резиста–засветка–проявление [1]. В России эта технология развивается, главным образом, только в ИС РАН (Троицк) в области источников ЭУФ-излучения [2] и коллективом авторов в области оптики и литографии. Исследования в ИФМ РАН ведутся на экспериментальном стенде нанолитографа, подробно описанном в [3]. В рамках первого этапа исследований был использован объектив с зеркалами, коррекция локальных ошибок которых проведена на ионно-пучковой установке [4]. Из-за ошибочных на тот момент времени научных представлениях о влиянии угла падения ионов на шероховатость оптических деталей установка была сконструирована таким образом, что позволяла проводить ионно-пучковое травление только при скользящих углах. Эксперименты на ЭУФ-литографе, проведенные с этим объективом, показали, что из-за сильных среднечастотных шероховатостей (шероховатости с латеральными размерами в диапазоне 1–1000 мкм) края изображаемых линий размывались, а разрешение составило около 1.3 мкм.
Для повышения разрешающей способности стенда ЭУФ-литографа было принято решение о модернизации установки. Модернизация включает в себя несколько направлений. Первое – проведение цикла исследований по изучению влияния энергии, углов падения, глубины съема материала, вида ионов и материала подложки на шероховатость поверхности после ионно-пучкового травления [5–7]. Основным результатом исследований стало то, что оптимальные углы травления 90°, причем диапазон ограничен отклонением углов от нормали примерно на ±40°, а энергия ионов должна лежать в диапазоне 400–1200 эВ, оптимальная в районе 800 эВ. Полученные результаты были подтверждены в работах других авторов [8–10]. С учетом этих данных была построена крупногабаритная установка [11], оснащенная источником с большой апертурой ионного пучка, предназначенного для ионной полировки и асферизации подложек, и малоразмерным ионным пучком для коррекции локальных ошибок. Обрабатываемый образец устанавливается на пятикоординатном столе, позволяющем проводить непрерывное сканирование. В каждой точке обеспечивается локальная нормаль к поверхности вдоль оси ионного пучка.
Второе – усовершенствование лазерно-плазменного источника ЭУФ-излучения. Третье – разработка усовершенствованной системы автофокуса, которая должна поддерживать положение пластины с резистом по отношению к проекционному объективу с точностью лучше ±30 нм. Четвертоe направление – это разработка и изготовление проекционного объектива с использованием усовершенствованных технологий ионно-пучковой коррекции локальных ошибок и метрологии формы поверхности зеркал.
В настоящей работе сообщается о результатах разработки проекционного объектива. Подробно описывается методика измерений и результаты коррекции формы асферических зеркал и аберраций объектива в сборном варианте.
МЕТОДЫ, ИСПОЛЬЗОВАННЫЕ ПРИ ИЗГОТОВЛЕНИИ ПОДЛОЖЕК
Подложки из плавленого кварца изготавливали методами глубокой шлифовки-полировки, химико-механической полировки и на финальной стадии – ионно-пучковой полировки. Методы химико-механической полировки подробно описаны в [12, 13], ионно-пучковой – например, в [6]. Шероховатость измеряли методом атомно-силовой микроскопии на специальном стенде, позволяющем изучать крупногабаритные и криволинейные поверхности [14]. На рис. 1 и 2 приведены функции спектральной плотности мощности шероховатости в зависимости от пространственной частоты шероховатости поверхностей кварцевых подложек для выпуклого и вогнутого зеркал после физико-химической и ионной полировки, рассчитанные по кадрам 2 × 2 и 40 × 40 мкм. Эффективная шероховатость σэф, полученная интегрированием функций спектральной плотности мощности в диапазоне пространственных частот 0.025–60 мкм–1, составила 0.28–0.56 нм для различных точек поверхностей, что является достаточным для литографических применений, так как не приводит к заметному размытию изображения [15].
Рис. 1.
Функция спектральной плотности мощности (PSD) шероховатости поверхности для первичного выпуклого зеркала М1 объектива. Сплошная кривая – измерения в первой точке на расстоянии r = 0 мм от оси зеркала (σeff = 0.39 нм). Точечная кривая – измерения во второй точке на расстоянии r = 15 мм от оси зеркала (σeff = 0.35 нм).
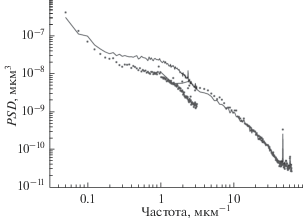
Рис. 2.
Функция спектральной плотности мощности (PSD) шероховатости поверхности для вторичного вогнутого зеркала М2 объектива. Сплошная кривая – измерения в первой точке на расстоянии r = 30 мм от оси зеркала (σeff = 0.28 нм). Точечная кривая – измерения во второй точке на расстоянии r = 50 мм от оси зеркала (σeff = 0.56 нм).

Форму подложек и аберрации объектива измеряли с помощью интерферометра с дифракционной волной сравнения на основе одномодового оптического волокна с субволновой выходной апертурой [16]. Так как в интерферометре в качестве эталонной формируется расходящаяся сферическая волна [17, 18], то напрямую для изучения асферических и выпуклых поверхностей такой интерферометр нельзя использовать, поэтому была выбрана следующая стратегия. Форма вогнутой подложки была измерена с помощью специально рассчитанного линзового корректора, который преобразовывал расходящийся сферический фронт точечного источника в асферический, совпадающий по форме с измеряемой асферической поверхностью [19]. В повторяющемся процессе “измерение формы–коррекция ионным пучком” форму зеркала доводили до субнанометрового уровня. После этого измеряли и корректировали форму поверхности выпуклого зеркала уже в составе проекционного объектива.
Конечно же, в измеряемой форме поверхности присутствуют ошибки, вносимые корректором, которые, как правило, сложно оценить, и в большинстве приложений ими пренебрегают. В настоящей работе для разделения аберраций волнового фронта, связанных с линзовым корректором и с подложкой, использован метод, предложенный в [20].
МЕТОДИКА ИЗМЕРЕНИЯ ОШИБКИ ФОРМЫ ПЕРВИЧНОГО АСФЕРИЧЕСКОГО ЗЕРКАЛА ОБЪЕКТИВА
Исследования проводили с использованием интерферометра с дифракционной волной сравнения [21]. Схема эксперимента приведена на рис. 3. Свет от точечного источника сферической волны проходит через корректор. Интерференционные полосы наблюдаются в режиме автоколлимации и регистрируются с помощью CCD-матрицы (CCD – charge-coupled device). Для установки в интерферометр и далее в объектив литографа к торцам зеркала М2 приклеены три расположенные под 120° “уха” со стальными шариками. Шарики встают на три площадки в виде кольца, плоскости и желоба. Такая конструкция позволяет однозначно устанавливать зеркало в объектив без смещений и дополнительных угловых наклонов, а также поворачивать зеркало в интерферометре на 120° и 240° относительно “нулевого” положения. Суть методики заключается в следующем. В измеренной карте аберрации волнового фронта присутствуют как ошибка формы поверхности зеркала, так и аберрации корректора. Для определения вкладов каждой ошибки необходимы как минимум два уравнения, потому что неизвестных два: ошибка формы поверхности зеркала и аберрации корректора. Это достигается поворотом исследуемого зеркала при неподвижном корректоре.
Рис. 3.
Оптическая схема интерферометра для измерений ошибок формы вогнутого асферического зеркала М2 с помощью корректора волнового фронта: 1 – He–Ne-лазер; 2 – поляризационный контроллер; 3 – источник сферической волны; 4 – наблюдательная система; 5 – CCD-камера, 6 – компьютер; 7 – плоское зеркало с острым краем; 8 – 3D стол; 9 – корректор волнового фронта; 10 – вогнутое асферическое зеркало М2 диаметром 220 мм (рабочий диаметр 200 мм).

Для удобства расчета удобно разбить зеркало, корректор и аберрации волнового фронта на три одинаковых сектора, в этом случае можно составить систему линейных уравнений (1) для трех положений исследуемого зеркала:
Неизвестное М – это ошибка формы поверхности зеркала (далее – карта зеркала), С – аберрации корректора, F – суммарные (измеряемые) аберрации волнового фронта. Индексы (i,j), (l,m), (r,p) соответствуют разным секторам по 120° на зеркале, корректоре и волновом фронте (рис. 4). Параметры F, F ', F " – измеряемые аберрации для различных положений зеркала: исходного и повернутого на 120° и на 240°. Корректор С неподвижен, поэтому во всех трех системах в (1) индексы С одинаковые. Расстановка индексов при М, С и F в первой системе соответствует рис. 4. Отличие индексов М во второй и третьей системах от индексов М первой системы связано с поворотом зеркала на 120° и 240° соответственно и определяется законом матрицы поворотов для координат точек на карте М:(2)
$\begin{gathered} {{\left( {\begin{array}{*{20}{c}} {{{x}_{M}}} \\ {{{y}_{M}}} \end{array}} \right)}_{{l,m}}} = {{\left( {\begin{array}{*{20}{c}} {{{x}_{M}}} \\ {{{y}_{M}}} \end{array}} \right)}_{{i,j}}}\left( {\begin{array}{*{20}{c}} {{\text{cos}}\left( {120^\circ } \right)}&{ - {\text{sin}}\left( {120^\circ } \right)} \\ {{\text{sin}}\left( {120^\circ } \right)}&{{\text{cos}}\left( {120^\circ } \right)} \end{array}} \right), \hfill \\ {{\left( {\begin{array}{*{20}{c}} {{{x}_{M}}} \\ {{{y}_{M}}} \end{array}} \right)}_{{r,p}}} = {{\left( {\begin{array}{*{20}{c}} {{{x}_{M}}} \\ {{{y}_{M}}} \end{array}} \right)}_{{i,j}}}\left( {\begin{array}{*{20}{c}} {{\text{cos}}\left( {240^\circ } \right)}&{ - {\text{sin}}\left( {240^\circ } \right)} \\ {{\text{sin}}\left( {240^\circ } \right)}&{{\text{cos}}\left( {240^\circ } \right)} \end{array}} \right). \hfill \\ \end{gathered} $Совместное решение систем уравнений для F и F ' позволяет найти карту ошибки формы поверхности М2 (карту М2) и аберрации корректора. Совместное решение систем уравнений для F и F ", а также F ' и F " и усреднение с результатом для F и F ' позволяет повысить точность метода. Решение было реализовано в программном пакете Matlab методом наименьших квадратов. Найденную карту М2 использовали для коррекции подложки М2 из плавленого кварца на установке ионно-пучкового травления. Для этого необходимо было установить точное соответствие координат на поверхности зеркала М2 и на найденной карте. Задача заключается в следующем: наблюдательная система проецирует объектную плоскость, совпадающую с кромкой зеркала М2, на плоскость CCD-матрицы. Однако из-за наличия кривизны на исследуемой поверхности расстояние от оптической оси до точки на зеркале больше расстояния от оптической оси до соответствующей точки в плоскости объекта. Эта разность зависит от радиус-вектора и кривизны зеркала. Чем больше кривизна поверхности, тем больше эта добавка, и ее необходимо учитывать. В рассматриваемом случае максимум составляет 2.5 мм, поэтому для коррекции формы найденную в результате решения системы (1) карту ошибки формы зеркала М2 “растягивали” по некоторому закону, приведенному в [20].
На рис. 5 приведены результаты измерений формы поверхности М2 до (максимальный перепад высот PV = 177 нм, среднеквадратичное отклонение (Root Mean Square) RMS = 21 нм) и после 19 коррекций ионным пучком (PV = 26 нм, RMS = 4.5 нм). После проведения 19 коррекций зеркала и решения системы (1) были получены карта зеркала (рис. 6a), аберрации корректора (рис. 6б) и ошибка вычислений (рис. 6в), которая была найдена как разность аберраций корректора, полученных из решения систем уравнений для F и F ' и для F и F ''. Параметры RMS и PV зеркала упали с 18.7 и 111.5 нм до 0.8 и 5.3 нм соответственно. Как видно из рис. 6, ошибка определения аберраций корректора по параметрам RMS и PV практически такая же, как и ошибки формы зеркала М2, поэтому дальнейшие попытки скорректировать (улучшить) поверхность зеркала не привели к положительному результату. Тем не менее, точность изготовления зеркала М2 на субнанометровом уровне достаточна для получения дифракционного качества изображения на длине волны 13.4 нм.
МЕТОДИКА ИЗМЕРЕНИЯ ОШИБКИ ФОРМЫ ВТОРИЧНОГО АСФЕРИЧЕСКОГО ЗЕРКАЛА И АБЕРРАЦИЙ ОБЪЕКТИВА
В ходе дальнейшей работы асферическое зеркало М2 было установлено в проекционный объектив Шварцшильда (рис. 7). Данный подход позволяет измерить форму как зеркала М1, так и волновые аберрации объектива. Оправа объектива была изготовлена из инвара – материала с низким температурным коэффициентом линейного расширения (~10–6 К–1). Верхняя часть оправы базовая, на ее три площадки (кольцо, плоскость и желоб), расположенные под 120° друг к другу, устанавливают зеркало М2 и жестко фиксируют специальными зажимами. Зеркало М1 диаметром 60 мм устанавливают в нижнюю части оправы, которая имеет пять степеней свободы по отношению к верхней части, что позволяет провести настройку объектива.
Рис. 7.
Измерения ошибок формы асферического зеркала М1 непосредственно в схеме проекционного объектива с помощью интерферометра с дифракционной волной сравнения: 1 – He–Ne-лазер; 2 – поляризационный контроллер; 3.1, 3.2, 3.3 – источники исферической волны; 4 – линза, строящая изображение поверхности зеркала М1 и формирующая квазипараллельный пучок; 5 – CCD-камера; 6 – компьютер; 7 – выпуклое асферическое зеркало М1; 8 – вогнутое асферическое зеркало М2.

На первом этапе настройку и измерение волновых аберраций проекционного объектива проводили в вакуумном интерферометре (рис. 7). Коррекцию волновых аберраций проекционного объектива осуществляли за счет коррекции локальных ошибок подложки для зеркала М1. Измерительная схема интерферометра работает следующим образом. Излучение He–Ne-лазера 1 после ввода в оптическое волокно в блоке с поляризационными контроллерами 2 делится на два канала. К первому каналу подключается первый источник эталонной сферической волны, который устанавливается в плоскости (внизу), перпендикулярной оси проекционного объектива. Сферическая волна после прохождения через объектив деформируется на неровностях поверхности зеркал (в большей части на зеркале М1). Для измерений этих аберраций ко второму каналу подключается второй источник эталонной сферической волны и устанавливается в предметной плоскости (вверху) объектива. Далее эти две волны интерферируют, а полученную интерференционную картину с помощью изображающей линзы 4 и CCD-камеры 5 регистрируют и обрабатывают на компьютере 6. Регистрацию и обработку интерферерограмм проводят как в амплитудном, так и в фазовом режимах. Для максимального контраста интерференционной картины с помощью поляризационного контроллера Thorlabs на выходе обоих источников обеспечивают одинаковую поляризацию. Дополнительно, за счет механического изгиба оптоволокна в одном из каналов интенсивность интерферирующих волн одинаковая. Деление пучков и контроль их поляризационного состояния осуществляют с помощью оптоволоконных компонентов.
На рис. 8 представлены результаты измерений волновых аберраций проекционного объектива до (PV = 534 нм, RMS = 49 нм) и после шести коррекций выпуклого асферического зеркала М1 (PV = 207 нм, RMS = 15 нм). На заключительном этапе измерение аберраций проекционного объектива проводили с использованием стенда ЭУФ-литографа (рис. 9). Последовательность действий при измерениях аберраций объектива следующая. Сначала по результатам обработки интерференционной картины от источников 3.1 и 3.2 проводят настройку (юстировку) положения зеркала М1 и источников 3.1 и 3.2, с тем чтобы минимизировать аберрации волнового фронта объектива. Путем наклона и перемещения зеркала М1 в перпендикулярном оптической оси объектива направлении минимизируют аберрацию “кома”, а перемещением в направлении оси – сферическую аберрацию. К сферической аберрации приводит также смещение источника 3.1 вдоль оптической оси. Поэтому процедуру настройки положения зеркала М1 повторяют для различных положений источника 3.1, добиваясь минимума сферической аберрации. Симметрию области засветки на М1 контролируют путем установки кольцевой диафрагмы на М2 с внутренним диаметром меньше диаметра рабочей области на М2. Осесимметричная засветка поверхности М1 приводит к осесимметричной тени от диафрагмы, и наоборот. Положение источника 3.2 в перпендикулярном оптической оси направлении юстируют по числу наблюдаемых интерференционных полос, а вдоль оси – путем минимизации аберрации “расфокусировка”. Таким образом, юстировку объектива проводят с использованием самого точного метода – интерференционного.
Рис. 8.
Результаты измерения волновых аберраций проекционного объектива с помощью интерферометра с дифракционной волной сравнения: а – до коррекции М1; б – после шести коррекций М1.
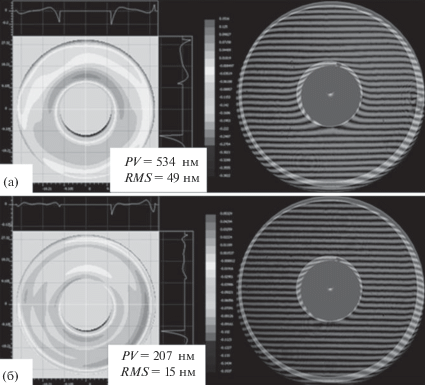
Рис. 9.
Фотография проекционного объектива после установки в стенд ЭУФ-нанолитографа со снятой вакуумной камерой: 1 – He–Ne-лазер; 2 – поляризационный контроллер; 3.1, 3.2, 3.3 – источники сферической волны; 4 – изображающая линза; 5 – CCD-камера; 6 – выпуклое асферическое зеркало М1; 7 – вогнутое асферическое зеркало М2.

На финальных этапах коррекции аберраций объектива необходимо учитывать вклад аберраций изображающей линзы 4 в измеряемую карту суммарных аберраций. Для измерения аберраций линзы используют дополнительный источник сферической волны 3.3, который устанавливают точно в месте изображения нижнего источника 3.1 рядом с источником сферической волны 3.2. Источник сферической волны 3.1 отключают и с помощью CCD-камеры регистрируют интерферограмму от источников 3.2 и 3.3, содержащую аберрации линзы.
На рис. 10 приведены результаты измерений волновых аберраций проекционного объектива без вычитания аберраций, вносимых изображающей линзой 4, после финишной 20-й коррекции поверхности зеркала М1 (PV = 54 нм, RMS = 6 нм). На рис. 11 показаны результаты измерений волновых аберраций изображающей линзы 4 (PV = 26 нм, RMS = 2.4 нм). После вычитания аберраций линзы из карты волновых аберраций проекционного объектива получаем истинную карту волновых аберраций проекционного объектива (рис. 12), параметры которой составили PV = 50 нм, RMS = = 5.4 нм. Дальнейшие коррекции формы М1 не привели к заметному улучшению поверхности. Основная причина в том, что латеральные размеры неровностей на поверхности М1 составили ~2 мм и стали сравнимы с размером ионного пучка, профиль которого имеет приближенный вид гауссиана с шириной 2.3 мм на полувысоте. В [22] показано, что частотный диапазон неровностей, которые могут быть “стравлены” ионным пучком, ограничен сверху размером ионного пучка.
НАПЫЛЕНИЕ МНОГОСЛОЙНЫХ ЗЕРКАЛ Mo/Si С ГРАДИЕНТНЫМ РАСПРЕДЕЛЕНИЕМ ПЕРИОДА И АНТИСТРЕССОВОГО ПОКРЫТИЯ Cr/Y
Многослойные зеркала Mo/Si осаждали методом магнетронного напыления. Процесс синтеза проводили на установке магнетронного напыления, описанной в [23]. Установка включает четыре магнетрона планарного типа. Такое количество магнетронов позволяет осаждать последовательно на одну подложку две различные двухкомпонентные структуры без разгерметизации вакуумного объема. Это может потребоваться, во-первых, для нанесения селективно стравливаемого подслоя, во-вторых, для компенсации упругих деформаций подложки, вызываемых осаждением многослойного зеркала. Как правило, материалы многослойной структуры подслоя выбирают так, чтобы одновременно выполнялись обе функции. В качестве подслоя в данном случае использована двухкомпонентная структура Cr/Y. Распыление мишеней проводили в среде высокочистого (99.998%) аргона. Рабочее давление газа в технологическом процессе составляло 0.2 Па. Давление остаточной атмосферы перед напылением около 10–4 Па. Скорость роста пленок ~0.2 нм/с.
Технологический маршрут создания многослойного зеркала включает процедуру обеспечения необходимого распределения по площади подложки толщины слоев напыляемых материалов. Период структуры отражающего многослойного покрытия должен иметь некоторое распределение, зависящее от расстояния между точкой отражения луча от поверхности и оптической осью, которое обеспечивает выполнение условия Вульфа–Брэгга в каждой точке зеркала:
где n – средний показатель преломления в структуре, d – ее период, θ – угол скольжения излучения, λ – длина волны излучения (13.4 нм). Условие записано для первого порядка отражения. Резонансная длина волны должна сохраняться, поэтому изменение угла скольжения (за счет кривизны подложки) компенсируется соответствующей коррекцией периода зеркала. Коррекцию периода по площади подложки проводят с помощью фигурных прецизионных диафрагм, расположенных между магнетронами с распыляемыми материалами и подложкой. Изменяя форму этих диафрагм, можно управлять распределением потока вещества, приходящего на подложку. Точность управления распределением периода по площади зеркала составила 0.5% от величины периода. Процедура создания заданного распределения толщины материалов носит итерационный характер. На первом этапе происходит напыление структуры на кремниевые сверхгладкие пластины, закрепленные на металлической поверхности с радиусом кривизны, приближенным к кривизне рабочей подложки. После напыления проводят измерения методом малоугловой рентгеновской дифракции на дифрактометре PANalytical X’Pert PRO. Измерения и последующая обработка результатов малоугловой рентгеновской дифракции позволяют определить большинство параметров многослойного зеркала (период, индивидуальные толщины материалов в периоде, шероховатость и другие). Полученное реальное распределение толщин по площади подложки сравнивают с расчетным. При необходимости проводят коррекцию формы прецизионных диафрагм и повторное напыление с последующими измерениями.Финальный этап изготовления объектива связан с напылением многослойных зеркал Mo/Si на скорректированные кварцевые подложки. При аттестации зеркала под углами скольжения излучения, соответствующими расчетным, снимают спектральную зависимость коэффициента отражения. Измерения в окрестности длины волны 13.4 нм проводили на рефлектометре со спектрометром-монохроматором РСМ-500. Подробную информацию об измерениях можно найти в [24].
На рис. 13 представлены расчетные значения углов падения (отсчитываются от нормали) излучения на первичное и вторичное зеркала объектива. Пиковое значение коэффициента отражения для первичного и вторичного зеркал в разных точках поверхности изменялось в пределах R = 63–65% при ширине пика на половине высоты Δλ = 0.51 нм. На рис. 14 приведена спектральная зависимость коэффициента отражения после отражения от обоих зеркал. Максимум отражения результирующей кривой приходится на 13.4 нм и составляет 38%. Спектральная ширина на половине высоты около 0.3 нм. Некоторое уменьшение коэффициента отражения и сужение кривой отражения связаны с небольшим, на уровне 1%, несовпадением положений максимумов резонансных кривых отражения зеркал М1 и М2.
Рис. 13.
Расчетные углы падения (отсчитываются от нормали) излучения (λ = 13.4 нм) на первичное М1 (а) и вторичное М2 (б) зеркала объектива в зависимости от расстояния от центров подложек.

Наличие внутренних напряжений в тонких пленках приводит к деформациям подложек, на которые наносятся пленки, что может отрицательно сказаться на изображающих свойствах оптической системы. Внутренние напряжения многослойных зеркал Mo/Si изучали, например, в [25, 26]. Показано, что внутренние напряжения в оптимизированном на максимум отражения в окрестности 13.4 нм многослойном зеркале Mo/Si около –400 МПа. Знак “минус” указывает на сжимающий характер напряжений (изначально плоская подложка становится выпуклой). Методика компенсации внутренних напряжений в многослойном зеркале базируется на подходе, изложенном в [25, 26]. Основная идея заключается в нанесении на подложку многослойной антистрессовой структуры, вызывающей противоположную по знаку и такую же по величине деформацию подложки, к которой приводит напыление многослойного зеркала. Таким образом, осаждение на компенсирующую структуру многослойного зеркала возвращает систему “подложка + многослойная антистрессовая структура + + многослойное зеркало” к исходной форме поверхности. В [27] в качестве такой компенсирующей структуры предложено использовать двухкомпонентную структуру Cr/Y. Ее выбор определяется также и тем фактом, что для Cr/Y существуют селективные химические травители, не взаимодействующие с самыми распространенными материалами подложек (кварцем, зеродуром, кремнием). Поэтому структура Cr/Y сочетает в себе свойства стресс-компенсирующих пленок и подслоев для реставрации подложек.
Для компенсации упругих деформаций подложек М1 и М2 отражательные покрытия Mo/Si наносили поверх стресс-компенсирующей структуры Cr/Y, в которой число периодов определялось соотношением:
(4)
${{S}_{{{\text{Cr}}/{\text{Y}}}}}{{d}_{{{\text{Cr}}/{\text{Y}}}}}{{N}_{{{\text{Cr}}/{\text{Y}}}}} = --{{S}_{{{\text{Mo}}/{\text{Si}}}}}{{d}_{{{\text{Mo}}/{\text{Si}}}}}{{N}_{{{\text{Mo}}/{\text{Si}}}}}.$Для структуры Mo/Si были выбраны параметры, обеспечивающие максимальный пиковый коэффициент отражения при заданном угле падения и длине волны излучения. Параметры многослойного зеркала Mo/Si следующие: dMo/Si = 6.95 нм, N = 50, s = –400 МПа. В соответствии с данными [27], в многослойной антистрессовой структуре Cr/Y при dCr/Y = 5 нм (толщина слоя иттрия 2 нм) величина внутренних напряжений составляет SCr/Y = +500 МПа. Знак “плюс” соответствует растягивающему напряжению. Из (4) следует, что в структуре Cr/Y количество слоев NCr/Y ≈ 56. При синтезе зеркал объектива напыляли 56 периодов многослойной антистрессовой структуры Cr/Y. Измерения показали, что без применения антистрессового покрытия поверхность первичного зеркала объектива астигматично искажается: RMS ухудшается на 4 нм, а PV – на 20 нм. При использовании покрытия Cr/Y поверхность как первичного, так и вторичного зеркала не деформируется под воздействием напряжений.
МОДЕЛИРОВАНИЕ ИЗОБРАЖЕНИЯ В СТЕНДЕ ЭУФ-ЛИТОГРАФА НА ОСНОВЕ ИЗМЕРЕННЫХ АБЕРРАЦИЙ
Финальные волновые аберрации проекционного объектива (рис. 12) были загружены в оптическую программу трассировки лучей Zemax в виде карты ошибки формы зеркала М1. Расчеты были проведены для центральной и крайней точек поля зрения на пластине (отклонения от оптической оси 0 и 0.35 мм соответственно). Как показывают расчеты, разрешение остается неизменным по полю зрения. На рис. 15 приведены рассчитанные изображения тестовых полос шириной 200, 100 и 30 нм. Как видно из рисунка, контраст изображения падает от 0.32 для полос шириной 200 нм до 0.15 для 30 нм. Полученный контраст сильно, более чем в два раза, уступает дифракционному пределу, однако позволяет начать эксперименты по ЭУФ-нанолитографии.
ЗАКЛЮЧЕНИЕ
В работе описан двухзеркальный проекционный объектив Шварцшильда, образованный двумя асферическими зеркалами и разработанный в рамках модернизации стенда литографа с рабочей длиной волны 13.4 нм. Объектив обеспечивает уменьшение ×5. Подробно описана методика измерений и результаты коррекции формы асферических зеркал и аберраций объектива в сборном варианте. В результате коррекции локальных ошибок формы первичного зеркала были получены следующие отклонения формы поверхности от расчетной: RMS = 0.8 нм, PV = 53 нм. Аберрации объектива в целом составили: RMS = 5.4 нм, PV = 54 нм. Ошибка по параметру RMS, выраженная в рабочей длине волны, составила около λ/2.5, что существенно хуже, чем требуемые λ/14. Причиной этого являются ограничения метода коррекции локальных ошибок формы зеркал, связанные с достаточно большим, около 2.3 мм, размером ионного пучка, который не позволяет корректировать неровности с латеральными размерами менее 2 мм.
Тем не менее моделирование разрешающей способности объектива с учетом измеренных аберраций показало, что тестовые полосы шириной 200 нм разрешаются с контрастом 32%, 100 нм – 23% и 30 нм – 15%. Иными словами, этот объектив позволяет проводить исследования по проекционной ЭУФ-нанолитографии, что является несомненным успехом, если принять во внимание сильное отставание российских исследований от мирового уровня в этом направлении. С учетом полученного опыта при разработке объектива будет повышена точность измерений формы поверхности за счет разработки новой регистрирующей системы, вклад аберраций которой в результаты измерений не превышает 0.6 нм, и фазового режима регистрации и обработки интерферограмм [28].
Также будет усовершенствована методика коррекции локальных ошибок формы подложек для зеркал. Методика будет включать два аспекта. Во-первых, следует уделять большее внимание высоком пространственным частотам неоднородностей на зеркале М2, с тем чтобы уменьшить их вклад в общую аберрацию объектива. Для этого необходимо завершать коррекцию локальных ошибок М2 пучком минимального размера, а не 4 мм, как было сделано в настоящей работе. Во-вторых, в дальнейшем нужно использовать ионный источник, описанный в [29]. Бóльшая, почти на порядок, плотность тока ионного пучка этого источника позволит на финальной стадии коррекции уменьшить в несколько раз диаметр ионного пучка и продвинуться в область бóльших частот пространственных неоднородностей поверхности, которые могут быть “стравлены”.
Список литературы
Wu B., Kumar A. // Appl. Phys. Rev. 2014. V. 1. P. 011 104.
Кошелев К.Н., Салащенко Н.Н., Банин В.Е. // УФН. 2007. Т. 177. Вып. 7. С. 777.
Волгунов Д.Г., Забродин И.Г., Закалов А.Б. и др. // Изв. РАН. Сер. физ. 2011. Т. 75. № 1. С. 54.
Chkhalo N.I., Kluenkov E.B., Pestov A.E. et al. // Nucl. Instrum. Methods Phys. Res. A. 2009. V. 603. 2009. Iss. 1–2. P. 62.
Барышева М.М., Вайнер Ю.А., Грибков Б.А. и др. // Изв. РАН. Сер. физ. 2012. Т. 76. № 2. С. 190.
Chkhalo N.I., Churin S.A., Pestov A.E. et al. // Opt. Express. 2014. V. 22. Iss. 17. P. 20 094.
Chkhalo N.I., Churin S.A., Mikhaylenko M.S. et al. // Appl. Optics. 2016. V. 55. № 6. P. 1249.
Keller A., Facsko S., Moller W. // J. Phys. 2009. V. 21. P. 495 305.
Liao W., Dai Y., Xie X., Zhou L. // Opt. Express. 2014. V. 22. P. 377.
Teo E.J., Toyoda N., Yang C. et al. // Appl. Phys. A. 2014. V. 117. P. 719.
Chkhalo N.I., Kaskov I.A., Malyshev I.V. et al. // Precision Engin. 2017. V. 48. P. 338.
Bo D., Jianwei Z., Yuling L. et al. // J. Semicond. 2014. V. 35. P. 116 001.
Вайнер Ю.А., Зорина М.В., Пестов А.Е. и др. // Поверхность. Рентген., синхротр., и нейтрон. исслед. 2015. № 8. С. 5.
Chkhalo N.I., Salashchenko N.N., Zorina M.V. // Rev. Sci. Instrum. 2015. V. 86. P. 016102.
Dinger U., Bisert F., Lasser H. et al. // Proc. SPIE. 2000. V. 4146. P. 35.
Chkhalo N.I., Klimov A.Yu., Rogov V.V. et al. // Rev. Sci. Instrum. 2008. V. 79. P. 033 107.
Naulleau P.P., Goldberg K.A., Lee S.H. et al. // Appl. Opt. 1999. V. 38. № 35. P. 7252.
Otaki K., Ota K., Nishiyama I. et al. // J. Vacuum Sci. Technol. B. 2002. V. 20. № 6. P. 2449.
Вознесенский Н.Б., Гаврилов Е.В., Жевлаков А.П. и др. // Ж. техн. физики. 2007. Т. 77. Вып. 2. С. 126.
Малышев И.В., Торопов М.Н., Чхало Н.И. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2015. № 7. С. 87.
Chkhalo N.I., Malyshev I.V., Pestov A.E. et al. // Appl. Optics. 2016. V. 55. Iss. 3. P. 619.
Чернышев А.К., Малышев И.В., Пестов А.Е., Чхало Н.И. Моделирование процесса коррекции локальных ошибок формы поверхности малоразмерным ионным пучком // Матер. XXIII Междунар. симп. “Нанофизика и наноэлектроника”. Т. 1. Нижний Новгород, 2019. С. 529.
Забродин И.Г., Закалов Б.А., Каськов И.А. и др. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2013. № 7. С. 1.
Bibishkin M.S., Chekhonadskih D.P., Chkhalo N.I. et al. // Proc. SPIE. 2004. V. 5401. P. 8.
Mirkarimi P.B. // Opt. Eng. 1999. V. 38. № 7. P. 1246.
Andreev S.S., Salashchenko N.N., Suslov L.A. et al. // Nucl. Instrum. Methods Phys. Res. A. 2001. V. 470. № 1–2. P. 162.
Bogachev S.A., Chkhalo N.I., Kuzin S.V. et al. // Appl. Optics. 2016. V. 55. № 9. P. 2126.
Ахсахалян А.А., Малышев И.В., Салащенко Н.Н. и др. Интерферометр с дифракционной волной сравнения с перестраиваемой числовой апертурой // Матер. XXIII Междунар. симп. “Нанофизика и наноэлектроника”. Т. 1. Нижний Новгород, 2019. С. 430.
Михайленко М.С., Пестов А.Е., Чхало Н.И., Гончаров Л.А. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2019. № 3. С. 19.
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования











