Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2020, № 8, стр. 20-25
Влияние висмута на структурное совершенство упруго-напряженных эпитаксиальных слоев AlGaInSbBi, выращенных на подложках InSb
Д. Л. Алфимова a, М. Л. Лунина a, Л. С. Лунин a, b, *, О. С. Пащенко a, А. С. Пащенко a, А. Н. Яценко b
a Федеральный исследовательский центр Южный научный центр Российской академии наук
344006 Ростов-на-Дону, Россия
b Южно-Российский государственный политехнический университет (НПИ)
им. М.И. Платова
346428 Новочеркасск, Россия
* E-mail: lunin_ls@mail.ru
Поступила в редакцию 12.12.2019
После доработки 20.01.2020
Принята к публикации 25.01.2020
Аннотация
Исследовано влияние висмута на структурное совершенство упруго-напряженных эпитаксиальных слоев AlGaInSbBi, выращенных на подложках InSb в поле температурного градиента. Выявлены оптимальные параметры процесса выращивания эпитаксиальных слоев AlGaInSbBi(InSb), при которых слои имели высокое структурное совершенство и минимальную шероховатость: 0.05 < $x_{{{\text{Bi}}}}^{s}$ < < 0.2 мол. дол., градиент температуры 10 ≤ G ≤ 30 К/см, толщины жидкой зоны 60 ≤ l ≤ 100 мкм, температурный интервал 623 ≤ Т ≤ 823 К.
ВВЕДЕНИЕ
Многокомпонентные твердые растворы на основе соединений А3В5, содержащие висмут, представляют интерес в качестве материалов для фотоприемных и излучательных устройств, работающих в видимом и ИК-диапазонах спектра [1, 2]. К таким материалам, в частности, относятся твердые растворы AlGaInSbBi. Применение гетероструктур на основе твердых растворов AlGaInSbBi для фотоприемников ИК-диапазона предъявляет повышенные требования к их структурному совершенству. Использование в гетероструктурах изовалентных компонентов, активно влияющих на зонную структуру эпитаксиальных слоев, таких как висмут, открывает широкие возможности в управлении спектром люминесценции, и структурным совершенством [3–5]. Введение висмута в кристаллическую решетку позволяет добиться частичного уменьшения рассогласования периодов решеток эпитаксиального слоя и подложки, а также уменьшить ширину запрещенной зоны [6–8]. С другой стороны, его введение способствует возрастанию внутренних напряжений, отвечающих за протяженность области существования твердых растворов [9].
Целью настоящей работы является исследование влияния висмута на структурное совершенство упруго-напряженных эпитаксиальных слоев AlGaInSbBi, выращенных на подложках InSb.
ЭКСПЕРИМЕНТАЛЬНАЯ ЧАСТЬ
Выращивание висмутосодержащих гетероструктур проводили методом зонной перекристаллизации градиентом температуры (ЗПГТ) в закрытой системе в потоке водорода, очищенного в процессе диффузии через палладий [1]. В качестве жидкой зоны использовали раствор-расплав из чистых элементов: Sb(СУ-000), In(ИН-000), Ga(ГЛ-000), Bi(ВИ-000), Al(АЛ-000). Расчет навесок проводился по методике, описанной нами ранее [2], с учетом молярных масс элементарных компонентов. Все материалы кроме галлия, подвергались химической обработке в смеси HNO3 : H2O (1 : 1), промывки в дистиллированной воде и сушке в термостате при температуре 333–343 К.
В качестве подложек для выращивания эпитаксиальных слоев AlInGaBiSb использовали монокристаллические пластины InSb, ориентированные в кристаллографических плоскостях (100) с точностью не хуже 10′. Плотность дислокаций в подложке не превышала 5 × 103 см–2. Перед процессом эпитаксии подложки InSb обрабатывали по следующей методике:
– обезжиривание этиловым спиртом (C2H5OH);
– обработка в травителе (смесь 20% водного раствора винной кислоты, перекиси водорода и плавиковой кислоты H2C4H4O5 : H2O2 : HF = = 25 : 12 : 1 в течение 1.5–3 мин);
– промывки в дистиллированной воде;
– сушки в термостате при температуре 333 К.
Определение несоответствия параметров решеток подложки и слоя и оценка кристаллического совершенства гетероструктур осуществлялась методом регистрации рентгеновской дифракции. Съемка кривых дифракционного отражения (КДО) рентгеновского излучения проводилась на высокоразрешающем рентгеновском дифрактометре ТРС-1 в двухкристальной геометрии с использованием CuKα-излучения. Помимо измерения Δa, определяли и анализировали полуширины КДО от эпитаксиального слоя и подложки. Учитывалась также форма дифракционных кривых и наличие (отсутствие) интерференционных максимумов, несущих информацию о качестве поверхности слоя и планарности границы раздела слой/подложка.
Составы полученных твердых растворов определяли на рентгеновском микрозондовом анализаторе Camebax при ускоряющем напряжении 20 кВ и токе первичного пучка 0.1–1.0 мкА. Погрешность измерений составляла ±0.01% для тяжелых элементов (с атомным номером более 25) и ±0.1% для легких элементов (P) и при содержании элемента в образце в количестве 0.1 мол. доли.
Оже-электронные спектры получены на спектрометре ЭСО-3 с энергоанализатором типа “цилиндрическое зеркало”. Энергетическое разрешение, измеренное по пику упруго отраженных электронов, составляло 0.25%. Измерения проводили при ускоряющем напряжении электронной пушки 3 кВ и токе пучка 3 мкА, при этом диаметр пучка составлял 5 мкм. Давление остаточных газов в камере спектрометра при измерениях 10–7 Па.
Исследования упругих напряжений в эпитаксиальных слоях AlInGaBiSb проводились на основе стандартного поляризационно-оптического метода. Использовался инфракрасный микроскоп МИК-11 с электронно-оптическим преобразователем ЭОП-4 в поляризованном свете.
Шероховатость измеряли в полуконтактном режиме в сканирующем зондовом микроскопе Solver HV. Для измерения использовали кантилевер с вольфрамовым зондом. Проводилось сканирование трех различных участков образца. Шероховатость поверхности характеризовали средним арифметическим отклонением профиля Ra и высотой неровностей Rz по десяти точкам.
РЕЗУЛЬТАТЫ И ОБСУЖДЕНИЯ
Результаты оже-анализа эпитаксиальных слоев AlGaInSbBi показали, что на поверхности присутствуют все компоненты (рис. 1). До глубины 500 нм наблюдается быстрое убывание концентрации алюминия по всему объему. Концентрации In и Ga постепенно возрастают, так как они замещают атомы Al. Аналогичное поведение висмута и сурьмы. Следовательно, подбором концентраций компонентов в жидкой фазе можно регулировать состав твердого раствора AlGaInSbBi.
Результаты исследования морфологии поверхности эпитаксиальных слоев AlGaInSbBi показали, что она имеет шероховатость, которая зависит от параметров процесса выращивания и концентрации висмута. Висмут образует твердый раствор замещения в подрешетке сурьмы, деформируя решетку по типу растяжения [1]. На рис. 2 представлена зависимость несоответствия параметров решеток между слоем и подложкой от концентрации висмута. При увеличении концентрации висмута растет несоответствие периодов решеток, что ведет к увеличению внутренних напряжений. Кроме того, атомы висмута могут внедряться в междоузлия, образуя антиструктурные дефекты BiIn и BiGa, что приводит к изгибу гетероструктуры AlGaInSbBi в сторону кристаллизующегося слоя. Поэтому с ростом концентрации висмута в эпитаксиальном слое также увеличиваются шероховатость поверхности слоя (рис. 3) и напряженное состояние гетероструктуры.
Рис. 2.
Зависимость рассогласования периодов решеток подложки и эпитаксиального слоя твердого раствора от концентрации висмута: 1 – AlInSbBi(InSb), 2 – AlGaInSbBi(InSb) и от величин начального переохлаждения раствора-расплава (кривая 3) при T = 713 K.
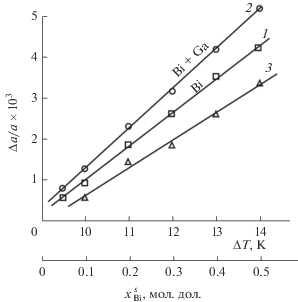
Рис. 3.
Трехмерная морфология поверхности (ACM-изображение) эпитаксиальных слоев AlGaInSbBi(InSb), полученных при T = 713 К и различных концентрациях Bi: а – 0.05; б – 0.2; с = 0.4 мол. дол.

Исследование структурного совершенства и полуширины КДО на половине высоты  для эпитаксиального слоя AlGaInSbBi сравнимы, только при малых концентрациях Bi (x < 0.2 мол. дол.) (рис. 4). С увеличением концентрации висмута уменьшается интенсивность и увеличивается полуширина
для эпитаксиального слоя AlGaInSbBi сравнимы, только при малых концентрациях Bi (x < 0.2 мол. дол.) (рис. 4). С увеличением концентрации висмута уменьшается интенсивность и увеличивается полуширина
 пиков КДО, что связано с ростом несоответствия периодов решеток слоя и подложки (рис. 2, кривые 1, 2). Ширина КДО на половине высоты подложки InSb, приготовленной стандартным образом
(полированной с обеих сторон и выдержанной в травителе) составляет ~20 угл. с. Помимо
изменения Δа/а, определялись и анализировались полуширины основных дифракционных пиков от эпитаксиального
слоя и подложки. Дифракционные кривые для гетероструктур AlGaInSbBi(InSb) показаны
на рис. 4. Узкий пик (кривая 1) КДО, угловое положение которого соответствует нулю на шкале (θ), отвечает отражению
от подложки InSb (100), более широких отраженных от эпитаксиальных слоев (кривые 2–4). Следует заметить, что интенсивность пиков КДО на половине высоты
пиков КДО, что связано с ростом несоответствия периодов решеток слоя и подложки (рис. 2, кривые 1, 2). Ширина КДО на половине высоты подложки InSb, приготовленной стандартным образом
(полированной с обеих сторон и выдержанной в травителе) составляет ~20 угл. с. Помимо
изменения Δа/а, определялись и анализировались полуширины основных дифракционных пиков от эпитаксиального
слоя и подложки. Дифракционные кривые для гетероструктур AlGaInSbBi(InSb) показаны
на рис. 4. Узкий пик (кривая 1) КДО, угловое положение которого соответствует нулю на шкале (θ), отвечает отражению
от подложки InSb (100), более широких отраженных от эпитаксиальных слоев (кривые 2–4). Следует заметить, что интенсивность пиков КДО на половине высоты  меньше подложки. По мере увеличения концентрации висмута в слое интенсивность уменьшается,
а
меньше подложки. По мере увеличения концентрации висмута в слое интенсивность уменьшается,
а  увеличивается.
увеличивается.
Рис. 4.
Дифракционные кривые отражения S: 1 – подложка InSb, гетероструктуры AlGaInSbBi/InSb при различных концентрациях Bi: 2 – xBi = 0.05 мол. дол.; 3 – xBi = 0.3 мол. дол.; 4 – xBi = 0.5 мол. дол.

Структурное совершенство гетероструктур AlGaInSbBi/InSb зависит от параметров процесса:
толщины “жидкой” зоны l, температуры T и ее градиента G. Результаты исследований зависимости  от толщины жидкой зоны (рис. 5, кривые 5, 6) показали, что для тонких зон (l < 40 мкм) наблюдается значительное ухудшение качества эпитаксиальных слоев AlGaInSbBi.
Это связано с тем, что для тонких зон не происходит однородное смачивание подложки
раствором, нарушается стабильность фронта кристаллизации из-за частичного разрыва
жидкой фазы. Для толщин зон l > 80 мкм наблюдается наименьшее значение
от толщины жидкой зоны (рис. 5, кривые 5, 6) показали, что для тонких зон (l < 40 мкм) наблюдается значительное ухудшение качества эпитаксиальных слоев AlGaInSbBi.
Это связано с тем, что для тонких зон не происходит однородное смачивание подложки
раствором, нарушается стабильность фронта кристаллизации из-за частичного разрыва
жидкой фазы. Для толщин зон l > 80 мкм наблюдается наименьшее значение  и шероховатостей Ra и Rz < 10 нм.
и шероховатостей Ra и Rz < 10 нм.
Рис. 5.
Зависимость ширины спектра КДО на половине высоты  для гетероструктур AlGaInSbBi/InSb от температуры (кривые 1, 2), градиента температуры (кривые 3, 4) и толщины в жидкой зоне (кривые 5, 6) для различных концентраций висмута: xBi = 0.1 мол. дол. (кривые 1, 3, 5) и xBi = 0.4 мол. дол. (кривые 2, 4, 6).
для гетероструктур AlGaInSbBi/InSb от температуры (кривые 1, 2), градиента температуры (кривые 3, 4) и толщины в жидкой зоне (кривые 5, 6) для различных концентраций висмута: xBi = 0.1 мол. дол. (кривые 1, 3, 5) и xBi = 0.4 мол. дол. (кривые 2, 4, 6).

Результаты измерений полуширины КДО эпитаксиальных слоев AlGaInSbBi, выращенных на подложках InSb при различных температурах и градиентах температуры, представлены на рис. 5 кривые 1–4. Видно, что с увеличением температуры и ее градиента совершенство слоев ухудшается. Полуширина КДО эпитаксиальных слоев достигает значительных величин: ∼60″ при G = = 100 K/см. Это обусловлено нарушением теплового и диффузионного равновесия, вследствие чего нарушается стабильность фронта кристаллизации и появляются микровключения на гетерогранице.
Важным фактором при выращивании качественных эпитаксиальных слоев AlGaInSbBi является величина начального пересыщения раствора-расплава (Al–Ga–In–Sb–Bi), для реализации стабильного режима планарного эпитаксиального роста. На рис. 2 кривая 3 представлена зависимость рассогласования периодов решетки подложки эпитаксиального слоя от величины начального переохлаждения раствора-расплава.
Морфология поверхности полученных при ΔT < 10 К слоев имела наименьшую шероховатость (рис. 6а), а граница раздела между слоями AlGaInSbBi и подложкой InSb ровной без различных включений. С увеличением начального пересыщения ΔT > 10 К растет рассогласование периодов решетки подложки и слоя. Кроме того, при сильном пересыщении в растворе-расплаве образовываются микрокристаллы AlGaSb, InSb, GaSb, которые осаждаются на поверхность подложки и нарушается планарность фронта кристаллизации и увеличивается шероховатость поверхности слоя (рис. 5б). С другой стороны, величина пересыщения также влияет на количество Al в твердой фазе по причине его большого коэффициента распределения KAl > 50 и минимального содержания в жидкой фазе. Необходимые потоки атомов алюминия к фронту кристаллизации могут возникнуть лишь при относительно большом пересыщении. Это обстоятельство необходимо учитывать при выборе оптимальных условий кристаллизации. Необходимый поток атомов компонентов к фронту кристаллизации при подпитке из перекристаллизуемого источника, например, поликристалла AlGaSb. Эти обстоятельства необходимо учитывать при выборе оптимальных условий кристаллизации AlGaInSbBi.
Рис. 6.
Трехмерная морфология поверхности (ACM-изображение) эпитаксиальных слоев AlGaInSbBi(InSb) постоянного состава, полученных при различных величинах начального переохлаждения: а – ΔT = 8 К; б – ΔT = 15 К.

Результаты исследований упругих напряжений от концентрации висмута в твердых растворах AlInSbBi(InSb) (кривые 1–3) и AlGaInSbBi(InSb) (кривые 4–6) рис. 7, показывают, что с увеличением концентрации висмута величина упругих напряжений возрастает, особенно при xBi > > 0.25 мол. дол. Добавление Ga в твердый раствор AlInSbBi делает его более напряженным (рис. 7, кривые 4–6). Результаты исследования σ по толщине выращенных пленок AlGaInSbBi(InSb) (рис. 7, кривые 7) показали значительное ухудшение структурного совершенства на границе гетероструктуры. Это связано с тем, что в приграничной области состав значительно изменяется, что ведет рассогласования периодов решетки слоя и подложки и возникновению дефектов и напряжений. Такая дефектная и напряженная область отсутствует в гетероструктурах AlGaInSbBi(InSb) постоянного состава (рис. 7, кривая 8).
Рис. 7.
Зависимость величины упругих напряжений от концентрации Bi в гетероструктурах: (1–3) – AlInSbBi/InSb; (4–6) – AlGaInSbBi/InSb (1, 4 – G = = 10 К/см; 2, 5 – G = 30 К/см; 3, 6 – G = 30 К/см); 7 – для варизонных гетероструктур; 8 – для гетероструктур постоянного состава.

Исследование фотолюминесценции гетероструктур AlGaInSbBi(InSb) показало монотонное смещение энергетического пика Eg в длинноволновую область с ростом содержания висмута в эпитаксиальных слоях AlGaInSbBi, обусловленное уменьшением ширины запрещенной области (рис. 8). Кроме того, по мере увеличения висмута в слоях AlGaInSbBi увеличивается интенсивность низкоэнергетического пика EV, связанного с появлением акцепторных комплексов (VInInSb). Такое перераспределение интенсивности люминесценции связано с увеличением концентрации комплексов VInInSb. Следует отметить, что ширина спектра фотолюминесценции увеличивается, а интенсивность пика уменьшается с ростом концентрации висмута. Это косвенно свидетельствует об ухудшении структурного совершенства гетероструктур AlGaInSbBi с увеличением концентрации висмута.
ЗАКЛЮЧЕНИЕ
Показано, что висмут, замещая в антимониде индия Sb в подрешетке сурьмы, увеличивает вероятность образования антиструктурных дефектов BiIn и BiGa, что ведет к увеличению внутренних напряжений в эпитаксиальных слоях AlGaInSbBi. В выращенных эпитаксиальных слоях AlGaInSbBi дополнительным источником упругих напряжений служит наличие градиента состава по толщине слоя.
Основными технологическими параметрами, определяющими качество поверхности, структурные и люминесцентные свойства гетероструктур AlGaInSbBi/InSb, являются состав, толщина жидкой зоны, температуры и ее градиент.
Интенсивность люминесценции уменьшается, а ширина спектра ФЛ увеличивается с ростом концентрации Bi в эпитаксиальных слоях AlGaInSbBi, что говорит об ухудшении структурного совершенства гетероструктур AlGaInSbBi/InSb.
Список литературы
Лозовский В.Н., Лунин Л.С., Благин А.В. Градиентная жидкофазная кристаллизация многокомпонентных материалов. Ростов-на-Дону: СКНЦ ВШ, 2003. 374 с.
Кузнецов В.В., Лунин Л.С., Ратушный В.И. Гетероструктуры на основе четверных и пятерных твердых растворов соединений АIIIBV. Ростов-на-Дону: СКНЦ ВШ, 2003. 376 с.
Seredin P.V., Glotov A.V., Lenshin A.S. et al. // Semiconductors. 2014. V. 48. P. 21. https://doi.org/10.21883/FTP.2018.01.45329.8565
Алфимова Д.Л., Лунина М.Л., Лунинн Л.С. и др. // ФТТ. 2018. Т. 60. Вып. 7. С. 1277.
Song H.Z., Hadi M., Zheng Y. et al. // Nanoscale Research Letters. 2017. V. 12. P. 128. https://doi.org/10.1186/s11671-017-1898-y
Kuznetsov V.V., Kognovitskaya E.A., Lunina M.L., Rubtsov E.R. // Russ. J. Phys. Chemistry A. 2011. V. 85. № 12. P. 2210. https://doi.org/10.1134/S003602441112020X
Gulebaglan S.E., Dogan E.K., Aycibin M. et al. // J. Phys. 2013. V. 11. P. 1680. https://doi.org/10.2478/s11534-013-0314-1
Sinel'Nikov B.M., Lunina M.L. // Inorganic Materials. 2012. V. 48. P. 877. https://doi.org/10.1134/S0020168512090154
Алфимова Д.Л., Лунин Л.С., Лунина М.Л. и др. // Неорган. материалы. 2017. Т. 53. № 1. С. 33. https://doi.org/10.7868/S0002337X17010018
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования