Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2020, № 8, стр. 34-41
Угловые зависимости распыления кремния фокусированным ионным пучком галлия
В. И. Бачурин a, *, И. В. Журавлев a, Д. Э. Пухов a, А. С. Рудый a, С. Г. Симакин a, М. А. Смирнова a, А. Б. Чурилов a
a Ярославский филиал Физико-технологического института им. К.А. Валиева РАН
150007 Ярославль, Россия
* E-mail: vibachurin@mail.ru
Поступила в редакцию 11.01.2020
После доработки 14.02.2020
Принята к публикации 17.02.2020
Аннотация
Получены угловые зависимости состава поверхностного слоя и коэффициента распыления кремния при облучении поверхности фокусированным пучком ионов галлия с энергией 30 кэВ. Анализ состава поверхности проводился методами растровой электронной оже-спектроскопии и вторично-ионной масс-спектрометрии. Коэффициенты распыления определялись по измерениям объемов распыленных кратеров и дозы облучения. Установлено, что содержание галлия в приповерхностном слое при углах падения, близких к нормали составляет около 30 ат. %. При углах падения, больших 30°, концентрация галлия достаточно резко уменьшается. Угловая зависимость коэффициента распыления кремния не коррелирует с содержанием галлия в приповерхностном слое и достаточно хорошо описывается каскадным механизмом распыления П. Зигмунда.
ВВЕДЕНИЕ
Распыление поверхности фокусированными ионными пучками (ФИП), ранее использовавшееся при подготовке образцов для просвечивающей электронной микроскопии и анализа отказов интегральных микросхем, в настоящее время ФИП широко применяется для формирования наноструктур на поверхности полупроводников [1, 2]. Распыление твердых тел ионной бомбардировкой исследуется достаточно давно, получен большой объем экспериментальных и теоретических результатов [3, 4]. Однако выяснилось, что бомбардировка образцов фокусированными пучками (диаметр от 10 нм) c высокими дозами облучения существенно влияет на развитие рельефа поверхности образцов, а также на образование слоя осажденного распыляемого материала на дне и стенках кратера травления, содержащего как материал образца, так и имплантированные ионы первичного пучка [5, 6]. В случае распыления кремния пучком ионов галлия осажденный слой содержит Si и Ga. Коэффициент распыления этого слоя может существенно отличаться от коэффициента распыления кремния, так как энергия связи галлия атомов на поверхности почти в два раза меньше, чем у кремния. Поэтому распыление осажденного слоя будет во многом определяться как концентрацией Ga, так и его химическим состоянием (существованием в виде отдельных преципитатов или образованием химических соединений с Si).
Как правило, формирование наноструктур с высоким отношением глубины к линейным плоскостным размерам с помощью ФИП сопровождается предварительным моделированием процесса [7–9], которое требует точных данных значений коэффициентов распыления и состава приповерхностного слоя при различных углах падения первичного ионного пучка. На сегодняшний день имеется всего лишь несколько экспериментальных работ, посвященных изучению угловой зависимости коэффициента распыления полупроводниковых материалов ФИП галлия [10–12]. Результаты по распылению Si фокусированным ионным пучком Ga наиболее полно представлены в [11], однако в работе не сообщаются детали проведения экспериментов (плотность тока, дозы облучения, методика измерения коэффициентов распыления). В то же время необходимость учета экспериментальных условий на распыления ФИП показана в работе [13].
В работах [11, 14–16] представлены экспериментальные результаты по распределению галлия в приповерхностном слое кремния в случае облучения ФИП галлия при нормальном падении пучка при различных дозах (1013–1018 ион/см2) Экспериментальных данных по составу поверхности при различных углах падения ионного пучка практически нет. Тем не менее, состав приповерхностного слоя может существенно влиять на поведение угловой зависимости коэффициента распыления из-за возможного изменения энергии связи атомов на поверхности. Кроме того, в последнее время появились работы [17, 18], посвященные изучению формирования волнообразного рельефа на поверхности кремния при его облучении ФИП галлия. Как отмечается в [18], понимание механизмов образования таких структур требует информации о составе приповерхностного слоя при различных углах падения пучка, которой к настоящему времени нет.
В данной работе представлены экспериментальные результаты по изучения состава поверхности и измерения коэффициентов распыления кремния фокусированным пучком ионов галлия при различных углах падения ионов.
МЕТОДИКА ПРОВЕДЕНИЯ ЭКСПЕРИМЕНТОВ
Измерение угловой зависимости состава поверхности
Образцы для исследования состава приповерхностного слоя Si, облученного фокусированным пучком Ga+ с энергией 30 кэВ, методами растровой электронной оже-спектрометрии (РЭОС) и вторичной ионной масс-спектрометрии (ВИМС) были приготовлены в виде кратеров распыления размером 200 × 200 мкм на установке Quanta 3D 200i. Диаметр пучка ионов Ga+ составлял 60 нм, ток – 30 нА, угол падения изменялся от 0° до 80°, доза облучения составляла 2 × 1017 ион/см2. Кроме того, были приготовлены образцы, облученные с дозами от 1015 до 5 × 1018 ион/см2 при нормальном падении ионного пучка Ga+ для исследования дозовой зависимости состава поверхности методом ВИМС.
Анализ элементного состава методом РЭОС проводился на установке PHI 660. Оже-спектры регистрировались с центральной части (50 × 50 мкм) подготовленных растров электронным зондом с энергией 10 кэВ, при значении тока 50 нА. Перед измерениями поверхность очищали от адсорбированных примесей бомбардировкой пучком ионов ${\text{N}}_{{\text{2}}}^{{\text{ + }}}$ с энергией 3 кэВ под углом 35° относительно нормали. Время облучения определялось выходом тока оже-электронов Ga на стационарный уровень. Концентрации Ga и Si на поверхности рассчитывались с использованием высокоэнергетичных пиков элементов Si (1610 эВ) и Ga (1070 эВ) с учетом коэффициентов относительной чувствительности: 0.14 для Ga (1070 эВ) и 0.042 – Si (1610 эВ).
Послойный анализ (ПА) методом ВИМС проводился на установке TOF.SIMS5. В качестве анализирующих использовали ионы ${\text{Bi}}_{{\text{3}}}^{{\text{ + }}}$, с энергией 25 кэВ, ток пучка составлял 1.0 пА. Распыление поверхности образца при ПА производилось ионами Cs+ с энергией 1 кэВ и током 75 нА. Распыляющий пучок разворачивался в растр на поверхности образца размером 250 × 250 мкм. Сканирование зондирующего пучка осуществлялось в центральной области кратера ионного травления, производимого ионами Cs+. Размер области сбора вторичных ионов составлял 50 × 50 мкм.
При регистрации вторичных положительных ионов реализована идеология катионного ВИМС анализа [20] достаточно подробно описанная в работе [21]. Регистрировались ионы, отвечающие масс-пикам: ${}^{{{\text{133}}}}{\text{Cs}}_{{\text{2}}}^{{\text{ + }}},$ 133Cs28Si+, 133Cs69Ga+. Концентрации Ga и Si в ат./см3 получены после нормировки интенсивностей вторичных ионов 133Cs69Ga+ и 133Cs28Si+ на интенсивность опорного сигнала ионов ${}^{{{\text{133}}}}{\text{Cs}}_{{\text{2}}}^{{\text{ + }}}$ в каждой точке профиля умножением на коэффициент относительной чувствительности (КОЧ). Для CsGa, и Cs2 КОЧ приготовлен в качестве эталонного образец с дозой облучения Si ионами Ga+ 1015 ат./см2. КОЧ (CsSi, Cs2) определяли на этом же образце по известной плотности атомов кремния 5 × 1022 ат./см3, соответствующей стационарному участку профиля.
После окончания ВИМС-анализа глубина кратеров распыления измерялась на профилометре Talystep. В предположении небольших изменений плотности образца в полученных зависимостях концентрации Ga в Si шкала абсцисс – время распыления (с) переводилась в глубину (нм) кратера распыления.
Измерение угловой зависимости коэффициента распыления
Эксперименты по измерению коэффициентов распыления Si ионами Ga+ с энергией 30 кэВ проводились на установке Quanta 3D 200i. Диаметр пучка составлял 60 нм, ток – 3 нА, угол падения изменялся от 0° до 80°. На поверхности формировались растры размером 30 × 13 мкм. Размеры кратеров распыления определяли с помощью электронного микроскопа, затем вычисляли их объемы и массы распыленного кремния. На рис. 1 представлены типичные электронно-микроскопические изображения растров распыления. Все эксперименты по облучению образцов Si выполнены при Т = 300 К.
Рис. 1.
Электронно-микроскопическое изображение растров распыления, полученных при различных углах падения ионного пучка: а – 0°, б – 30°, в – 70°.
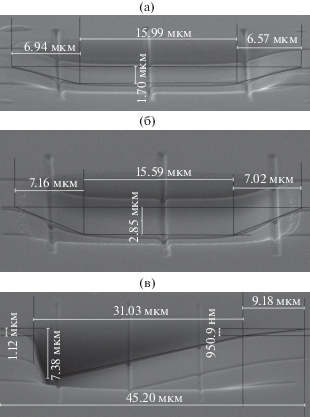
Поскольку на значения коэффициентов распыления могут влиять условия бомбардировки и доза облучения, были выполнены эксперименты по измерению коэффициентов распыления при различных дозах и различных условиях распыления.
Угловая зависимость коэффициента распыления Si ионами Ga+ с энергией 30 кэВ (помимо экспериментального измерения) была рассчитана с помощью программы TRIDYN [19].
РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
Состав приповерхностного слоя
На рис. 2 представлена угловая зависимость концентрации Ga на поверхности Si, полученная методом РЭОС. Установлено, что атомная концентрация СGa на поверхности составляет около 60% при нормальном падении пучка. В работе [16] аналогичные измерения проводились с помощью вторично-ионной масс-спектрометрии. Было показано, что СGa на поверхности составляет около 50%, но затем спадает до 20–30% на глубинах ~5 нм. Следует отметить, что выход оже-электронов происходит с глубин 0.5–2.5 нм, то есть из нескольких поверхностных слоев. Таким образом, полученные с помощью метода РЭОС значения концентрации Ga на поверхности находятся в согласии с данными работы [16].
При увеличении угла падения до 20° концентрация Ga незначительно уменьшается, а затем наблюдается резкое падение до нескольких процентов при значениях 60°–80°. Такое поведение, по-видимому, обусловлено увеличением отражения падающих ионов Ga+ с ростом угла бомбардировки и, следовательно, уменьшением числа внедренных в приповерхностный слой ионов Ga+.
Распределение Ga в приповерхностном слое Si было получено при послойном анализе методом ВИМС. На рис. 3 представлены профили плотности имплантированных ионов Ga в случае нормального падения пучка Ga+ при различных дозах облучения. Кривые 1 и 2 соответствуют дозам облучения 1015 и 1016 ион/см2 соответственно. Максимум распределения внедренных ионов лежит на глубине проективного пробега Rp ионов в Si, который, согласно расчетам, выполненным с помощью программы TRIM, составляет 26 нм.
Рис. 3.
Послойные профили плотности галлия, полученные методом ВИМС. Дозы облучения Si пучком ионов Ga+ с энергией 30 кэВ: 1 – 10152, 2 – 1016, 3 – 1017, 4 – 5 × 1017 ион/см2.

На начальном участке профиля 3 (доза облучения 1017 ион/см2) наблюдаются два локальных максимума для Ga и (соответственно) два локальных минимума для Si, после чего кривая плотности Ga выходит на ожидаемое плато и затем смещается к нулю (рис. 3). Наличие двух максимумов распределения концентрации Ga в Si наблюдалось в работе [5] в которой измерения проводились методом энергодисперсионного анализа поперечного среза образца Si, имплантированного ионами Ga, не связанного с ионной бомбардировкой поверхности. Поэтому можно исключить предположение о том, что наличие особенностей на полученном методом ВИМС профиле концентрации Ga связано с ионно-индуцированными процессами при ВИМС-анализе. Причиной наличия максимумов на начальном участке профиля 3, по-видимому, является характер распределения, имплантированного Ga в приповерхностном слое Si. В работах [11, 15] дефектность измененного ионной бомбардировкой приповерхностного слоя исследовалось методом просвечивающей электронной микроскопии. Установлено, что при дозах облучения, больших 1017 ион/см2, имплантированный Ga образует вблизи поверхности преципитаты размером 5–10 нм, расположенные в 2 или 3 ряда по глубине. Поэтому послойные профили Ga образцов, облученных с дозой 1017 ион/см2 (когда процесс распыления практически только начинается [11]), могут содержать наблюдаемые максимумы концентраций при прохождении во время анализа слоев, содержащих преципитаты Ga.
Начиная с дозы 2 × 1017 ион/см2, характер профилей практически не изменяется и имеет вид 4 (рис. 3). Вблизи поверхности содержание Ga сравнимо с концентрацией Si, после чего кривая выходит на плато, и, начиная с глубины 40 нм, резко снижается.
Следует отметить, что в ряде случаев при дозах облучения, больших 5 × 1017 ион/см2 (нормальное падение), наблюдается достаточно длинный хвост послойного профиля Ga. На рис. 4 представлен результат послойного анализа образца, облученного с дозой 1018 ион/см2. Кривые 1 и 2 соответствуют профилям распределения Si и Ga в приповерхностном слое. Видно, что при уменьшении плотности Ga на полтора порядка (глубина ∼60 нм) резкий спад изменяется на плавное уменьшение до глубины ∼150 нм, которая определяется чувствительностью используемого прибора ВИМС. Аналогичные зависимости были получены в работах [11, 15]. Одной из причин широких наблюдаемых хвостов распределения может быть каналирование ионов Ga+ при облучении вплоть до доз 1014 ион/см2, при которых начинается аморфизация приповерхностного слоя. Это предположение подтверждается тем, что такие хвосты распределения имплантированных ионов не наблюдались при отличных от нормали углах падения ионного пучка. Другой причиной могут являться ионно-индуцированная диффузия и вбивание внедренного Ga в виде отдельных преципитатов при распылении поверхности во время анализа пучком ионов Cs+. На вставке рис. 4 представлено интегральное по глубине ионно-микроскопическое изображение во вторичных ионах Ga+-кратера распыления в области проведения анализа. Более яркие пятна на изображении соответствуют более высокому содержанию Ga в анализируемом объеме. Это может свидетельствовать о неравномерном распределении имплантированного Ga в приповерхностном слое. После исключения этих областей при вычислении концентрации был получен исправленный профиль распределения Ga (кривая 3), который соответствует профилям, полученным моделированием процесса имплантации с помощью программы T-DYN [14, 16].
Рис. 4.
Послойные профили плотностей Si (1) и Ga (2). Доза облучения Si пучком ионов 30 кэВ Ga равна 1018 ион/см2. Исправленный профиль плотности Ga (3) (см. в тексте). На вставке микроскопическое изображение кратера анализируемой области во вторичных ионах Ga+.

На рис. 5 представлены профили распределения Ga вблизи поверхности Si, облученного при различных углах падения ионного пучка Ga+. Видно, что с ростом угла наблюдаются уменьшение содержания Ga в поверхностном слое и размер области в направлении нормали к поверхности, в которой находится имплантированный Ga.
Рис. 5.
Послойные профили плотностей Si – 1 и Ga в образцах, облученных при различных углах падения пучка ионов Ga+: 20° – 2, 40° – 3, 60° – 4, 80° – 5.

Из полученных профилей послойного анализа следует, что концентрация Ga на поверхности при углах падения пучка ионов Ga+ θ = 0°–30° превышает 50%, что согласуется с вышеприведенными данными работы [16]. Начальные участки профилей имеют максимумы на глубинах d ∼ 2 нм от поверхности. Далее кривые выходят на плато вплоть до d ∼ 30 нм. Затем наблюдается достаточно резкий спад концентрации Ga. При θ > 30° профили практически не содержат горизонтальных участков. Расчет относительных значений концентраций СGa на поверхности (d ∼ 2 нм) при различных углах падения по данным ВИМС-анализа дает значения, близкие к результатам, полученным с помощью РЭОС.
Концентрация имплантированного Ga в приповерхностном слое Si определялась по полученным профилям следующим образом. Производилось интегрирование плотностей Ga и Si (рис. 5) от поверхности до глубин, на которых плотность Ga уменьшается на порядок. Эти глубины соответствуют значениям Rp + 2ΔRp, где Rp – проективный пробег ионов и ΔRp – продольный разброс. При нормальном падении ионов 30 кэВ Ga+ эти величины составляют 26 и 9 нм соответственно. Тогда относительная концентрация Ga в указанном слое Si: CGa = NGa/(NGa+ NSi), где NGa и NSi интегральное содержание Ga и Si в слое.
На рис. 6 представлена угловая зависимость концентрации имплантированного галлия в приповерхностном слое кремния. Характер полученной кривой качественно совпадает с представленной на рис. 2 угловой зависимостью концентрации Ga на поверхности Si. Содержание Ga вблизи поверхности незначительно меняется до углов падения пучка θ = 20°–30°, после чего наблюдается более резкое уменьшение концентрации Ga. Однако значение CGa в приповерхностном слое почти в два раза меньше, чем на поверхности (при близких к нормали углах имплантации).
Рис. 6.
Зависимость концентрации Ga в приповерхностном слое Si, облученного при различных углах падения пучка ионов Ga+.
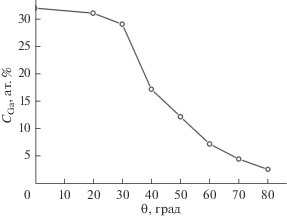
В работах [22, 23], где теоретически и экспериментально было показано, что плотность имплантированных первичных ионов вблизи поверхности после выхода распыления на стационарный режим (дозы облучения > 1017 ион/см2) можно оценить по формуле:
(1)
${{N}_{{\text{P}}}} = {{{{N}_{{\text{T}}}}} \mathord{\left/ {\vphantom {{{{N}_{{\text{T}}}}} Y}} \right. \kern-0em} Y},$(2)
${{С}_{{\text{P}}}} = {1 \mathord{\left/ {\vphantom {1 {\left( {1 + Y} \right)}}} \right. \kern-0em} {\left( {1 + Y} \right)}}.$Угловая зависимость коэффициента распыления
Поскольку на значения коэффициентов распыления могут влиять условия облучения (способ растрирования, время задержки пучка в точке, перекрытия) и доза облучения, были выполнены предварительные эксперименты по измерению $Y$ при различных дозах и условиях распыления при нормальном падении пучка. Серия экспериментов при растровом, серпантинном и произвольном типах сканирования, временах задержки 1 и 2 мкс, перекрытии пучка на 30 и 50% позволила получить значение коэффициента распыления и оценить погрешность измерений: $Y \approx 2.4 \pm $ ± 0.2 атом/ион. При изменении дозы облучения от 1017 до 5 × 1018 ион/см2 коэффициент распыления практически не изменяется. Кратеры распыления для измерения коэффициентов распыления (рис. 1) формировались при дозе облучения 2 × 1018 ион/см2.
Результаты измерений абсолютных значений коэффициентов распыления Si фокусированным ионным пучком Ga при различных углах падения первичных ионов представлены в табл. 1.
Таблица 1.
Результаты измерений и моделирования абсолютных значений коэффициентов распыления Si фокусированным ионным пучком Ga при различных углах падения ионного пучка
| Угол распыления θ, град | 0 | 20 | 30 | 40 | 50 | 60 | 70 | 80 | |
|---|---|---|---|---|---|---|---|---|---|
| Коэффициент распыления Y, атом/ион | Эксперимент | 2.44 | 2.42 | 3.53 | 4.01 | 5.67 | 8.09 | 12.08 | 12.80 |
| TRIDYN | 2.46 | 2.86 | 3.47 | 4.70 | 6.37 | 9.31 | 13.77 | 17.80 | |
На рис. 7 показана экспериментальная угловая зависимость коэффициентов распыления, нормированных на значение коэффициента распыления при нормальном падении ионного пучка. Видно, что при углах падения, больших 30°, наблюдается значительный рост коэффициентов распыления. При изменении угла падения до 80° его значение увеличивается практически в шесть раз. Аналогичное поведение угловой зависимости $Y\left( \theta \right)$ наблюдается в работе [11], где коэффициент распыления при 80° увеличивается в семь раз. Аналогичные зависимости получены для большинства материалов при распылении ионами инертных газов [3]. В этом случае ход кривой $Y\left( \theta \right)$ описывается каскадным механизмом П. Зигмунда [24], согласно которому $Y(\theta ) \sim {{\cos }^{{ - n}}}(\theta ),$ где обычно n = 1–2. На рис. 7 представлена зависимость ${{\cos }^{{ - 2.2}}}\left( \theta \right),$ которая вплоть до углов 50° хорошо совпадает с экспериментальной зависимостью.
Рис. 7.
Угловая зависимость коэффициента распыления Si пучком ионов 30 кэВ Ga+: ⚪ – данные экспериментов; – – – – аппроксимация ~${{\cos }^{{ - 2.2}}}\theta ;$ △ – результаты расчетов в программе TRIDYN.

Смоделированная с помощью программы TRIDYN угловая зависимость $Y\left( \theta \right)$ достаточно хорошо согласуется с экспериментальной зависимостью до значений углов 60°.
Сопоставляя характер угловых зависимостей состава поверхностного слоя и коэффициента распыления, можно сделать вывод о том, что имплантированный галлий не оказывает существенного влияния на процесс распыления кремния, которое наблюдается в случае использования в качестве первичных химически активных ионов азота [25] и кислорода [26].
ЗАКЛЮЧЕНИЕ
В данной работе были получены экспериментальные данные по угловым зависимостям состава поверхностного слоя и коэффициента распыления Si фокусированным ионным пучком Ga с энергией 30 кэВ.
Установлено, что при выходе распыления на стационарный режим (доза облучения >1017 ион/см2) состав приповерхностного слоя практически не меняется и содержит около 30 ат. % имплантированного галлия при нормальном падении пучка. Концентрация Ga незначительно уменьшается при изменении угла падения до θ ~ 30°. При дальнейшем росте θ наблюдается резкий спад содержания Ga до нескольких процентов при θ > 50°. Концентрация Ga на поверхности Si, определенная методами РЭОС и ВИМС более чем в два раза превышает содержание в приповерхностном слое, сравнимым с проективным пробегом ионов Ga+ (при углах падения, близких к нормали). Этот факт может быть обусловлен ионно-индуцированными процессами во время проведения анализа.
В результате проведенных экспериментов была получена зависимость коэффициента распыления Si от угла падения ионного пучка. Исходя из полученной зависимости, можно сделать вывод о том, при углах падения, больших 30°, наблюдается значительный рост коэффициентов распыления. При изменении угла падения до 80° его значение увеличивается практически в 6 раз. Поведение угловой зависимости коэффициента распыления хорошо описывается теорией П. Зигмунда.
Полученные результаты по определению состава поверхностного слоя при нормальном падении ионного пучка и угловой зависимости коэффициента распыления Si фокусированным ионным пучком Ga хорошо согласуются с немногочисленными экспериментальными данными, представленными в литературе. Угловая зависимость состава поверхностного Si, облученного фокусированным ионным пучком Ga, получена впервые.
Список литературы
Bruchhaus L., Mazarov P., Bischoff L. et al. // Appl. Phys. Rev. 2017. V. 4. № 1. P. 011302. https://doi.org/10.1063/1.4972262
Joshi-Imre A., Bauerdick S. // J. Nanotechnology. 2014. V. 2014. P.170415. https://doi.org/10.1155/2014/170415
Распыление твердых тел ионной бомбардировкой / Под ред. Бериша Р. Вып. 1. М.: Мир, 1984. 336 с.
Распыление твердых тел ионной бомбардировкой / Под ред. Бериша Р. Вып. 2. М.: Мир, 1986. 488 с.
Borgardt N.I., Rumyantsev A.V., Volkov R.L. et al. // Mater. Res. Express. 2018. V. 5. № 2. P. 025905. https://doi.org/10.1088/2053-1591/aaace1
Румянцев А.В., Боргардт Н.И., Волков Р.Л. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2018. №6. С. 102. https://doi.org/10.7868/S0207352818060197
Kim H-B., Hobler G., Steiger A. et al. // Nanotechnology. 2007. V. 18. P. 245303. https://doi.org/10.1088/0957-4484/18/24/245303
Borgardt N.I., Rumyantsev A.V. // J. Vac. Sci. Techn. B. 2016.V. 34. P. 061803-1. https://doi.org/10.1116/1.4967249
Borgardt N.I., Volkov R.L., Rumyantcev A.V. et al. // Tech. Phys. Lett. 2015. V. 41. P. 610. https://doi.org/10.1134/S106378501506019X
Xu X., Della Ratta A.D. et al. // J. Vac. Sci. Techn. B. 1992. V. 10. № 6. P. 2675. https://doi.org/10.1116/1.586024
Frey L., Lehrer C., Ryssel H. // Appl. Phys. A. 2003. V. 76. № 7. P. 1017. https://doi.org/10.1007/s00339-002-1943-1
Lindsey S., Hobler G. // Nucl. Instr. Meth. B. 2013. V. 303. P. 142. https://doi.org/10.1016/j.nimb.2012.12.087
Rommel M., Spolidi G., Yanev V. et al. // J. Vac. Sci. Technol. B. 2010. V. 28. № 3. P. 595. https://doi.org/10.1116/1.3431085
Gnaser H., Kallmayer C., Oechsner H. // J. Vac. Sci. Technol. B. 1995. V. 13 № 1. P. 19. https://doi.org/10.1116/1.587978
Lehrer C., Frey L., Petersen S. et al. // 2000 Int. Conf. on Ion Implantation Tech. Proc. 2000. P. 695. https://doi.org/10.1109/IIT.2000.924248
Gnaser H., Brodyanski A., Reuscher B. // Surf. Interface Anal. 2008. V. 40. № 11. P. 1415. https://doi.org/10.1002/sia.2915
Habenicht K.P., Leib J. Koch et al. // Phys. Rev. B. 2002. V. 65. № 11. P. 115327-1. https://doi.org/10.1103/PhysRevB.65.115327
Gnaser H., Reusher B., Zeuner A. // Nucl. Instrum. Methods Phys. Res. B. 2012. V. 285. P. 142. https://doi.org/10.1016/j.nimb.2012.05.028
Wolfhard M. TRIDYN. Version 7 – Dresden: Institute of Ion Beam Physics and Materials Research. Helmholtz-Zentrum Dresden-Rossendorf. 2017. 35 p.
Mootz T., Adriaens A., Adams F. // Int. J. Mass Spectr. and Ion Proc. 1996. V. 156. P. 1. https://doi.org/10.1016/S0168-1176(96)04410-2
Бачурин В.И., Мелесов Н.С., Мироненко А.А. и др. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2019. № 4. С. 38. https://doi.org/10.1134/S0207352819040024
Carter G., Colligon J.S., Leck J.H. // Proc. Phys. Soc. 1962. V. 79. № 2. P. 299. https://doi.org/10.1088/0370-1328/79/2/308
Krimmel E.F., Pfleiderer H. // Rad. Effects. 1973. V. 19. № 2. P. 83. https://doi.org/10.1080/00337577308232223
Sigmund P. // Phys. Rev. 1969. V. 184. № 2. P. 383. https://doi.org/10.1103/PhysRev.184.383
Bachurin V.I., Lepshin P.A., Smirnov V.K. // Vacuum. 2000. V. 56. № 4. P. 241. https://doi.org/10.1016/S0042-207X(99)00194-3
Wittmaack K. // Surf. Interface Anal. 2000. V. 29. № 10. P. 721. https://doi.org/10.1002/1096-9918(200010)29:10<721:: AID-SIA916>3.0.CO;2-Q
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования



