Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2020, № 8, стр. 108-112
Способ изготовления кремниевых рентгеношаблонов с использованием плазмохимического травления
А. Н. Генцелев a, *, Ф. Н. Дульцев b, c, Б. Г. Гольденберг a, К. Э. Купер a
a Институт ядерной физики им. Г.И. Будкера СО РАН
630090 Новосибирск, Россия
b Новосибирский государственный университет
630090 Новосибирск, Россия
c Институт физики полупроводников им. А.В. Ржанова СО РАН
630090 Новосибирск, Россия
* E-mail: ang1209@mail.ru
Поступила в редакцию 29.12.2019
После доработки 29.01.2020
Принята к публикации 31.01.2020
Аннотация
Описан простой способ изготовления кремниевых рентгеновских шаблонов (рентгеношаблонов) для глубокой рентгеновской литографии, проводимой с использованием экспонирующего излучения спектрального диапазона (0.5–7 Å). Данный способ базируется на операциях планарной кремниевой технологии, широко распространенной в производстве полупроводниковых приборов. Существенным отличием этого способа от ранее известных аналогов является то, что в нем при формировании несущей мембраны шаблона не применяется создание легированием стоп-слоя. В качестве исходной заготовки используется стандартная кремниевая пластина ориентации (100) и кремниевая несущая мембрана шаблона формируется на финишном этапе его изготовления посредством плазмохимического травления пластины с тыльной стороны на заданную глубину. Такой подход позволяет существенно упростить технологию изготовления несущей мембраны. Изготовленные таким способом кремниевые рентгеношаблоны характеризуются относительной простотой изготовления, радиационной и химической стойкостью, геометрической стабильностью, сравнительно высокими уровнями механической прочности и рентгенопрозрачности несущей мембраны, зависящими от ее толщины, которая может варьироваться в достаточно широких пределах ~2.5–50 мкм в зависимости от предназначения рентгеновских шаблонов, которые могут с успехом применяться и в LIGA-технологии.
ВВЕДЕНИЕ
Исторически рентгеновская литография развивалась как возможная альтернатива фотолитографии и используемый в ней диапазон длин волн экспонирующего излучения (λ ≈ 3–50 Å) условно разделили, главным образом с точки зрения достигаемой разрешающей способности, на поддиапазоны коротких (3–7 Å), средних (7–10 Å) и длинных (10–50 Å) волн [1]. В качестве экспонирующего излучения в экспериментах по рентгенолитографии в основном используется синхротронное излучение (СИ), по причине его малой расходимости и высокой интенсивности [2]. Рентгеношаблоны имеют следующую типичную конструкцию: рентгенопоглощающий топологический рисунок (формируемый, как правило, путем гальванического осаждения тяжелых металлов через резистивную маску) крепится силами адгезии к рабочей поверхности тонкой рентгенопрозрачной несущей мембраны (выполненной из материалов с малой величиной атомного номера), а та, в свою очередь, крепится своими краями к опорному кольцу [3].
Преимущества поддиапазона (3–7 Å) по сравнению с другими выражается в уменьшении влияния дифракционных эффектов на искажения топологического рисунка при его переносе и меньшем ослабление экспонирующего излучения несущей мембраны шаблона и разделительными окнами канала вывода СИ. Это позволяет изготавливать рентгеношаблоны с мембранами сравнительно большой толщины и, соответственно, приводит к увеличению их жесткости и прочности, что увеличивается срок службы шаблонов и минимизирует деформации металлического рентгенопоглощающего топологического рисунка, вызванные внутренними напряжениями при его формировании [4].
В 80-е годы прошлого века в Германии научными центрами Карлсруэ и Майнца была разработана LIGA-технология [5, 6], первым этапом которой является глубокая рентгеновская литография, ориентированная на формирование толстой резистивной маски (толщиной до 4 мм и более [7]), что достигается проведением экспонирования излучением поддиапазона ультракоротких длин волн (0.5–3 Å). Рентгеношаблоны, предназначенные для этого поддиапазона, именуются LIGA-шаблонами и, в зависимости от технологии их изготовления, они достаточно сильно отличаются друг от друга материалами и толщинами как несущих мембран, так и маскирующих слоев [5, 6, 8–13].
ПОСТАНОВКА ЗАДАЧИ
В проводившихся в Сибирском центре синхротронного и терагерцевого излучения (СЦСТИ) работах по глубокой рентгеновской литографии в основном использовались рентгеношаблоны с несущими мембранами в виде тонкой (~2–3 мкм) пленки кремния [8] и в виде шлифованных пластинок (~500 мкм) стеклоуглерода [9], причем первые применялись в коротком диапазоне длин волн экспонирующего СИ на станции рентгеновской литографии (спектр поглощаемого СИ ~3–10 Å) [14], а вторые – в ультракоротком (~0.5–3 Å), на “LIGA-станции”, установленной на канале вывода СИ из накопителя ВЭПП-3 [7, 15].
Основными достоинствами кремниевых рентгеношаблонов были высокая рентгенопрозрачность несущей мембраны, ее химическая и радиационная стойкость, а также, что несущая мембрана и опорное кольцо шаблона выполнены из одного материала – кремния, что минимизирует внутренние напряжения шаблона, вызванные температурными деформациями. Их недостатками являлись высокая себестоимость, хрупкость тонкой (~2.5 мкм) несущей мембраны и сложность многооперационной технологии изготовления. Формирование несущей мембраны производилось путем создания стоп-слоя путем легирования методом термической диффузии бором кремниевой пластины с обеих ее сторон на глубину ~2–3 мкм (т.е. на толщину будущей мембраны, объемная концентрация примеси бора при этом составляла ~1019–1020 см–3) и удаления центральной части пластины с тыльной ее стороны (до стоп-слоя) посредством жидкостного селективного травления на одном из последних этапов изготовления шаблона. Для проведения этой операции требовалось создание нескольких защитных слоев для топологического рисунка, расположенного на рабочей поверхности шаблона с последующим их удалением после формирования несущей мембраны, что существенно усложняло технологию изготовления шаблона.
Резистивная маска, для создания золотого маскирующего (рентгенопоглощающего) слоя шаблонов, формировалась методом трафаретной синхротронной сканирующей рентгенолитографии с применением переходного рентгеношаблона, но, вследствие параметров применявшихся тогда рентгенорезистов, толщина изготавливаемых рентгенопоглощающих элементов была менее 8 мкм [8], что было недостаточно для достижения требуемой величины контрастности шаблонов в случае их использования в поддиапазоне ультракоротких длин волны (0.5–3 Å), т.е. в качестве LIGA-шаблонов.
Рентгеношаблоны с несущей мембраной из стеклоуглерода марки СУ-1300 [9] хорошо зарекомендовали себя в силу замечательных свойств данного материала: высокой степени химической чистоты, рентгенопрозрачности, электропроводности и низкой флуоресценции. Однако, данный материал имеет некоторые недостатки, ограничивающие его использование в качестве несущих мембран, – это его дороговизна, наличие дефектов в виде каверн на рабочей поверхности (из-за вскрытия газовых микропузырьков при полировке) и хрупкость, задающая минимальную толщину пластинки на уровне ~450 мкм, вследствие чего данный вид шаблонов использовался только в поддиапазоне ультракоротких длин волн, т.е. в качестве LIGA-шаблонов.
Данная работа посвящена поиску исключающей вышеуказанные проблемы универсальной технологии изготовления кремниевых рентгеношаблонов, обеспечивающей их использование в поддиапазонах как коротких (3–7 Å), так и ультракоротких (0.5–3 Å) длин волн.
КОНСТРУКЦИЯ ШАБЛОНОВ И ТЕХНОЛОГИЯ ИХ ИЗГОТОВЛЕНИЯ
Для преодоления вышеуказанных проблем был разработан базирующийся на основе кремниевой технологии способ изготовления рентгеношаблонов. В качестве подложек использовались предварительно отобранные равнотолщинные стандартные кремниевые пластины ориентации (100), ∅76 мм с полированной планарной (рабочей) и механически геттерированой (8 класс чистоты, Ra ≈ 0.63 мкм) непланарной (тыльной) поверхностями.
Рентгеношаблон с преимущественно кремниевой несущей мембраной был получен в результате проведения следующих основных операций:
1. Последовательное магнетронное напыление на рабочую поверхность Si-пластины адгезивных проводящих подслоев титана (Тi, ~0.4 мкм) и никеля (Ni, ~0.02 мкм).
2. Формирование из негативного резиста SU-8 посредством рентгенолитографии с применением переходного рентгеношаблона [16] резистивной маски толщиной ~50 мкм (рис. 1). Экспонирование проводилось на LIGA-станции [15], для оптимизации спектра СИ использовались фильтр в виде титановой фольги (~10 мкм) и центральный поглотитель пучка шириной 16 мм [7].
Рис. 1.
СЭМ-фото (угол наблюдения 45°) фрагмента сформированной на кремниевой пластине методом рентгенолитографии при помощи переходного шаблона резистивной маски из SU-8 (элементы темного цвета), через которую на следующем этапе будет производиться гальваническое осаждение золота.
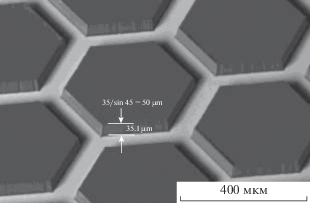
3. Гальваническое осаждение маскирующего слоя золота (средней толщиной ~30 мкм) на рабочую поверхность пластины через резистивную маску (рис. 2).
Рис. 2.
СЭМ-фото (угол наблюдения 45°) фрагмента резистивной маски из SU-8 и гальванически осажденного золотого маскирующего слоя, средней толщиной h ≈ 30 мкм.
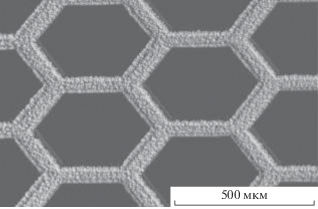
4. Удаление центральной части (~∅50 мм) кремниевой пластины путем плазмохимического ее травления с тыльной стороны через дюралюминиевую маску с остановкой травления, не доходя ~30 мкм до поверхности пластины (рис. 3). Эта операция производилось на установке плазмохимического травления Plasmalab 80 Plus с источником индуктивно-связанной плазмы (ICP) при давлении p = 30 мТорр, со скоростью подачи газов: SF6 – 50 см3/мин, Ar – 5 см3/мин, подводимые мощности составляли: RF = 70 Вт; ICP = 500 Вт.
Рис. 3.
Внешний вид LIGA-шаблона, изготовленного по планарной кремневой технологии: а – со стороны рабочей поверхности (полосы на периферии – следы от прижимных струбцин при напылении), б – с тыльной стороны. Несущая кремниевая мембрана диаметром ~∅50 мм сформирована путем удаления центральной части пластины плазмохимическим травлением.

Травление проводилось путем многократного (~160 раз) повторения двух стадий: травления ~48 секунд и охлаждения ~2 мин. Как и следовало ожидать, шероховатость тыльной стороны несущей мембраны обусловлена исходным классом чистоты непланарной поверхности кремниевой пластины и осталась на прежнем уровне (т.е. 8 класс чистоты).
Отвод тепла от образца (т.е. его охлаждение) происходил двумя путями: через теплоотвод к охлаждаемому столику (с которым образец имеет механический контакт) и через процессы теплопереноса в среде газа аргона (на стадии охлаждения поток активных газов перекрывается и существенно (в 10 раз) увеличивается поток аргона до 50 см3/мин). Температура столика контролируется датчиком, и исходная температура старта цикла равняется ~5°С. Поскольку во время травления к образцу подводится значительная мощность (~500 Вт), то он греется и соответственно поднимается температура столика, которая затем снижается на стадии охлаждения до ~Т = 5°С.
Установка, на которой производилась отработка режимов формирования несущей мембраны рентгеношаблона, не оснащена интерферометрическим датчиком, позволяющим отслеживать процесс травления в режиме “in-situ”, но такая опция для данного типа установок существует и в этом случае процесс может контролироваться по показаниям такого датчика. Экспериментально измеренная скорость травления кремния (т.е. толщина слоя, удаляемого за один цикл) составляет ~2 мкм/цикл. Поскольку исходная толщина пластины и скорость ее травления известны, а процесс может быть оставлен в любой момент (ориентируясь на расчеты или показания датчика), то это позволяет получать заданную толщину несущей мембраны шаблона без стоп-слоя с точностью ±0.5 мкм, при условии проведения предварительного отбора плоскопараллельных (равнотолщинных) кремниевых пластин.
Преимущество данного способа по сравнению с аналогичными заключается в том, что в нем исключены операции легирования кремния бором, жидкостного травления кремния, формирования и удаления защитных слоев и др., существенно усложнявшие процесс изготовления рентгеношаблона. А так как способ базируется на кремневой планарной технологии, то для его реализации на рынке имеется широкий ассортимент как кремниевых подложек с различными параметрами, так и специализированного оборудования, ориентированного на работу с такими подложками.
Изготовленный тестовый образец кремниевого LIGA-шаблона (с кремниевым опорным кольцом и с кремниевой несущей мембраной ~∅50 мм, толщиной ~30 мкм) иллюстрируется рис. 1–3. Данный LIGA-шаблон был протестирован на станции “Рентгеновская микроскопия и микротомография” [17] СЦСТИ по разработанной ранее методике, суть которой в измерении контраста рентгеновского изображения шаблона на ПЗС-матрице в монохроматическом излучении на двух спектральных линиях λ ≈ 0.5 Å и λ ≈ ≈ 1.37 Å. Из отношения яркости изображения под “светлыми” и “темными” полями исследуемого шаблона определялись его контрастности на данных длинах волн и затем средняя толщина золотого маскирующего покрытия. Было подтверждено, что средняя толщина золотого слоя составляет ~30 мкм. С использованием данного LIGA-шаблона на “LIGA-станции” СЦСТИ, применяя режим экспонирования: ширина центрального поглотителя пучка СИ ~16 мм, толщина титанового фильтра ~10 мкм [7] была получена резистивная маска толщиной ~550 мкм (рис. 4). Литографическое разрешение в поддиапазоне (0.5–3 Å) находится на уровне ~0.5–1 мкм из-за высокой кинетической энергии генерируемых СИ в резистивном слое электронов (~10 кэВ), пробег которых достигает ~0.2 мкм [18].
ЗАКЛЮЧЕНИЕ
Данная работа демонстрирует, что, базируясь на кремниевой планарной технологии, можно, используя вышеописанный способ, изготавливать кремниевые рентгеношаблоны со слоистыми несущими мембранами, совокупная толщина которых может меняться в достаточно широких пределах ~2.5–50 мкм в зависимости от предназначения шаблонов и задаваться с точностью ±0.5 мкм. Шаблоны преимущественно с кремниевыми мембранами характеризуется: низким уровнем флуоресценции; низким уровнем внутренних напряжений, обусловленных температурными деформациями (поскольку несущая мембрана и опорное кольцо выполнены из одного материала – кремния); высокой ренгенопрозрачностью; рентгено- и коррозионностойкостью; прочностью (так как несущая мембрана может быть выполнена достаточно толстой); простотой изготовления и т.д. Эти достоинства позволят таким шаблонам занять достойное место в производстве различных изделий с применением глубокой рентгеновской литографии, в том числе и посредством LIGA-технологии.
Список литературы
Yamasaki T. // J. Jap. Soc. Mech. Eng. 1986. V. 89. № 809. P. 376.
Валиев К.А. Физика субмикронной литографии. М.: Наука, 1990. 528 с.
Кириленко А.Г., Кривоспицкий А.Д., Семин Ю.Ф. // Зарубежная радиоэлектроника, 1980. V. 17. № 1. С. 36.
Muller K.H., Tisher P., Windbracke W. // J. Vac. Sci. Technol. 1986. V. B(4). P. 230.
Becker E.W., Ehrfeld W., Hagmann P. et al. // Microelectronic Engineering. 1986. V. 4. № 1. P. 35.
Ehrfeld W., Bley P., Gotz F., Mohr J. et al. // J. Vac. Sci. Technol. 1988. V. B6. № 1. P. 178.
Goldenberg B.G., Lemzyakov A.G., Nazmov V.P. et al. // Physics Procedia 2016. V. 84. P. 205. https://doi.org/10.1016/j.phpro.2016.11.036
Артамонова Л.Д., Гаврюшкина Н.И., Гаштольд В.Н. и др. // Отчет Сибирского международного центра синхротронного излучения за 1991–1992 гг. Новосибирск: Ин-т ядерной физики им. Будкера СО РАН, 1993. С. 229.
Петрова Е.В., Гольденберг Б.Г., Кондратьев В.И. и др. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2007. № 6. С. 14.
Генцелев А.Н., Голубцов С.К., Гольденберг Б.Г. и др. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2011. № 8. С. 19.
Генцелев А.Н., Зелинский А.Г., Кондратьев В.И. // Научный вестник Новосибирского гос. техн. ун-та. 2014. № 1(54). С. 78.
Генцелев А.Н., Гольденберг Б.Г., Зелинский А.Г. и др. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2015. № 1. С. 58.
Генцелев А.Н., Гольденберг Б.Г., Зелинский А.Г. и др. // Изв. РАН. Сер. Физ. 2013. № 9, С. 1351.
Artamonova L.D., Gentselev A.N., Deis G.A. et al. // Rev. Sci. Instrum. 1992. V. 63. № 1. Pt. 2A. P. 764.
Генцелев А.Н., Гольденберг Б.Г., Кондратьев В.И. и др. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2002. № 9. С. 30.
Патент RU №2704673 на изобретение: “Способ изготовления рентгенолитографического шаблона” / Генцелев А.Н., Дульцев Ф.Н. - Опубл. в Б.И., 2019, № 31
Kozyrev E.A., Kuper K.E., Lemzyakov A.G. et al. // Phys. Proced. 2016. V. 84. P. 245. https://doi.org/10.1016/j.phpro.2016.11.042
Мазуренко С.Н., Мануйлов В.В., Матвеев В.М. // Микроэлектроника, 1990. Т. 19. Вып. 3. С. 284.
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования



