Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2020, № 9, стр. 103-108
Исследование аморфизации кремния ионами галлия на основе сопоставления расчетных и экспериментальных электронно-микроскопических изображений
А. В. Румянцев a, *, А. С. Приходько a, Н. И. Боргардт a
a Национальный исследовательский университет “МИЭТ”
124498 Москва, Зеленоград, Россия
* E-mail: lemi@miee.ru
Поступила в редакцию 17.12.2019
После доработки 22.01.2020
Принята к публикации 24.01.2020
Аннотация
Для изучения особенностей атомарного строения кристаллического кремния после проведения ионной бомбардировки ионами галлия с энергией 5 кэВ проведены экспериментальные исследования образца поперечного сечения облученной области методом просвечивающей электронной микроскопии. Для интерпретации наблюдаемого контраста выполнено атомистическое моделирование процесса ионной имплантации методом молекулярной динамики и рассчитаны светлопольные электронно-микроскопические изображения, которые находятся в хорошем соответствии с экспериментально полученными микрофотографиями. Для идентификации структуры материала в переходной области между кристаллом и аморфным слоем использовался модуль суммы векторов, направленных от рассматриваемого атома к его ближайшим соседям. Показано, что его изменения, усредненные по большому числу атомов, непосредственно связаны с вариациями контраста на микрофотографиях.
ВВЕДЕНИЕ
Воздействие ионными пучками на поверхность твердотельных образцов является одним из ключевых технологических процессов современных нанотехнологий. Ионная бомбардировка используется как для изменения физических свойств материалов путем внедрения легирующих элементов [1], так и в задачах наноструктурирования поверхности при ионном распылении [2, 3]. Наряду с внесением примеси в образец ионная имплантация сопровождается нарушением кристаллической решетки и аморфизацией материала мишени. В отличие от концентрации имплантированных атомов, которую можно определить методами вторичной ионной масс-спектроскопии [4] или энергодисперсионного рентгеновского микроанализа [5], нахождение распределения дефектов в образце является более трудоемкой задачей. Хотя аморфизованную область можно визуализировать методом просвечивающей электронной микроскопии (ПЭМ) [6], для выявления связи наблюдаемого контраста с дефектами, возникающими при ионном воздействии, требуются дальнейшие исследования.
Наибольший интерес представляют предсказание толщины аморфизованной области и поиск адекватной атомистической модели границы аморфного и кристаллического материалов. В частности, оценка этой толщины необходима при использовании метода фокусированного ионного пучка (ФИП) [7], применяемого для изготовления наноструктур, в том числе приготовления образцов для проведения исследований методом ПЭМ [8].
Для оценки глубины проникновения ионов обычно используется метод Монте-Карло в приближении бинарных столкновений. Его применение в сочетании с моделью критической плотности дефектов [6] позволило определить ширины аморфизованного слоя при нормальном [6] и скользящем падении пучка [7] с равномерно распределенной дозой ионов. В [9] моделирование аморфизации проводилось при “точечном” воздействии фокусированного ионного пучка.
Расчет атомных конфигураций кремния после продолжительной ионной бомбардировки может быть выполнен методом молекулярной динамики (МД), в основе которого лежит интегрирование уравнений движения атомов, взаимодействующих посредством специально разработанных эмпирических потенциалов [10]. В частности, в [11] методом МД исследовалось влияние энергии и дозы ионов на форму аморфизованной области, в [12] моделировалось распыление атомов и повреждения образца при скользящих углах падения пучка, в [13] с использованием различных критериев изучался атомный порядок вблизи границы области аморфизации и кристаллического материала.
Важной процедурой является сравнение результатов моделирования с экспериментальными данными. Одним из наиболее информативных методов исследования образцов после проведения ионной бомбардировки является ПЭМ. С помощью ПЭМ можно выявлять область аморфизованного ионами материала, однако для детальной интерпретации экспериментальных данных требуются компьютерное моделирование атомных расположений и электронно-микроскопических изображений. Такой подход использовался в [14] для анализа отдельных каскадов столкновений.
В данной работе методом МД выполнено моделирование процесса аморфизации кремния при воздействии на него ионов галлия, найденные атомные конфигурации использованы для расчета электронно-микроскопических изображений, которые сопоставлены с экспериментально полученными микрофотографиями.
ЭКСПЕРИМЕНТАЛЬНЫЕ ИССЛЕДОВАНИЯ ТЕСТОВЫХ СТРУКТУР
Экспериментальные исследования проводились на электронно-ионном микроскопе Helios NanoLab 650, оборудованном системой с фокусированным пучком ионов галлия. Имплантация ионов с энергией 5 кэВ и дозой 9 × 1014 см–2 выполнялась в образец монокристаллического кремния с ориентацией (001), покрытый естественным оксидом. Для минимизации эффекта каналирования образец отклонялся на угол 7° от нормальной ориентации.
Для изучения внесенных при ионной бомбардировке повреждений были приготовлены образцы поперечного сечения с ориентацией (110), которые исследовались методом ПЭМ на микроскопе Titan Themis 200 при ускоряющем напряжении 200 кВ. Для получения светлопольной микрофотографии с дифракционным контрастом (рис. 1а) образец ориентировался так, чтобы падающий электронный пучок распространялся вдоль направления близкого к [110]. На ней отчетливо визуализируются кристаллический кремний (с-Si), имеющий темный контраст, аморфизованный материал (a-Si) с характерным светлым контрастом, переходная область между c-Si и a-Si, а также защитный слой платины и аморфного углерода (Pt + a-С) в правой части изображения. На поверхности a-Si выявляется слой естественного оксида кремния. Темный контраст в области с-Si обусловлен тем, что электроны, отклоненные на брэгговские углы благодаря дифракции на кристаллических плоскостях, задерживаются объективной диафрагмой и не принимают участие в формировании изображения. Области со светлым контрастом в кристаллическом материале соответствуют частично нарушенным областям в конце пробега ионов.
Рис. 1.
Экспериментальное (а) и расчетное (б) светлопольные ПЭМ-изображения аморфизованного слоя; усредненные экспериментальный и расчетный профили интенсивности с наложенным на них профилем величины $s$ (в). Пунктирными вертикальными линиями на (в) показаны границы переходной области. Вблизи правого края изображений (а), (б) находятся области защитного слоя Pt + a-C и вакуума соответственно.
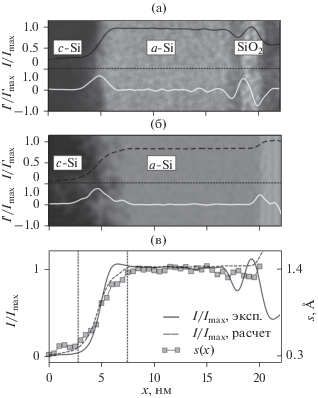
Для последующего сравнения экспериментальных данных и результатов моделирования распределение интенсивности на рис. 1а усреднялось вдоль направления, параллельного границе раздела между c-Si и a-Si. Нормированные усредненные профили интенсивности ${{I\left( x \right)} \mathord{\left/ {\vphantom {{I\left( x \right)} {{{I}_{{\max }}}}}} \right. \kern-0em} {{{I}_{{\max }}}}}$ вдоль перпендикулярной границе оси x и их производные ${{I{\kern 1pt} '\left( x \right)} \mathord{\left/ {\vphantom {{I{\kern 1pt} '\left( x \right)} {I_{{\max }}^{'}}}} \right. \kern-0em} {I_{{\max }}^{'}}}$ показаны на рис. 1а сплошной черной и белой линиями соответственно. Левый максимум производной ${{I{\kern 1pt} '\left( x \right)} \mathord{\left/ {\vphantom {{I{\kern 1pt} '\left( x \right)} {I_{{\max }}^{'}}}} \right. \kern-0em} {I_{{\max }}^{'}}}$ располагается в точке $x = 4.7$ нм вблизи середины переходной области на границе между c-Si и a-Si и, согласно [6], его положение соответствует 23%-концентрации вакансий в нарушенном кристаллическом кремнии. Правый минимум ${{I{\kern 1pt} '\left( x \right)} \mathord{\left/ {\vphantom {{I{\kern 1pt} '\left( x \right)} {I_{{\max }}^{'}}}} \right. \kern-0em} {I_{{\max }}^{'}}},$ находящийся в точке $x = 20$ нм, определяет положение границы a-Si–Pt + a-C. Толщина аморфизованного слоя кремния находилась как разность координат x этих двух границ и равнялась $h_{{im}}^{{\left( {{\text{exp}}} \right)}} = 15.3$ нм. Данная величина включала в себя толщину слоя SiO2, которая определялась как расстояние от минимума производной интенсивности при $x = 18$ нм (рис. 1а) до защитного слоя платины и равнялась 2 нм. Рассмотрение a-Si и SiO2 как единого слоя при сопоставлении результатов эксперимента и моделирования обосновывается тем, что ядерные тормозные способности этих материалов для ионов галлия практически совпадают друг с другом [6].
МОДЕЛИРОВАНИЕ ИОННОЙ БОМБАРДИРОВКИ И ЭЛЕКТРОННО-МИКРОСКОПИЧЕСКИХ ИЗОБРАЖЕНИЙ ПОВРЕЖДЕННОЙ ОБЛАСТИ
Для нахождения позиций атомов кремния после воздействия на образец ионами галлия с целью последующего моделирования электронно-микроскопических изображений применялся программный пакет LAMMPS [15]. Одним из его преимуществ является возможность проведения параллельных расчетов на графических процессорах для ряда потенциалов [16], в том числе используемых в данной работе потенциалов Терсоффа $\left( {{{V}_{{{\text{Ter}}}}}} \right)$ [17], адекватно описывающего тетраэдрическую структуру связей в кремнии, и Циглера–Бирзака–Литтмарка $\left( {{{V}_{{{\text{ZBL}}}}}} \right)$ [18], характеризующего взаимодействия атомов на близких расстояниях. Их соединение в единый потенциал $V$ осуществлялось с помощью функции Ферми:
(1)
$F\left( r \right) = \frac{1}{{1 + \exp \left[ { - {{\mu }_{{\text{F}}}}\left( {r - {{r}_{{\text{F}}}}} \right)} \right]}},$(2)
$V\left( r \right) = \left[ {1 - F\left( r \right)} \right]{{V}_{{{\text{ZBL}}}}}\left( r \right) + F\left( r \right){{V}_{{{\text{Ter}}}}}\left( r \right),$Для моделирования ионной бомбардировки создавалась ячейка монокристаллического кремния с ориентацией (001), которая имела размеры $21.72 \times 21.72 \times 35.29$ нм и содержала 835 200 атомов. Для создания реалистичных условий диссипации энергии, вносимой падающим ионом, вводились примыкающие к граням ячейки слой, находящийся при постоянной температуре 300 К и слой неподвижных атомов толщиной 1.1 нм и 2.2 нм соответственно. Так как скорости движения атомов в ходе каскада столкновений и на стадии термической релаксации существенно отличаются, при моделировании использовался варьируемый временнóй шаг. Его максимальное значение задавалось так, чтобы самый быстрый атом не сдвигался более, чем на 0.05 Å за один шаг по времени. Неупругие потери энергии эффективно учитывались с помощью вязкой силы, пропорциональной скорости частицы. Коэффициент пропорциональности, равный 0.00407 эВ · Å2 пс–1, находился на основе линейной аппроксимации табличных данных программного пакета SRIM [18] для электронных потерь энергии. Вязкая сила прикладывалась только к атомам с энергией более 10 эВ [21] для сохранения колебательных степеней свободы системы.
Область бомбардировки представляла собой квадрат с размерами 13 × 13 нм. Ионы с энергией 5 кэВ вводились в расчетную область над ячейкой на расстоянии примерно 10 нм каждые 15 000 временны́х шагов. Всего было имплантировано 1500 ионов, что соответствовало дозе 9 × 1014 см–2.
Для моделирования электронно-микроскопических изображений из ячейки вырезался образец с ориентацией $\left( {110} \right),$ поперечными размерами 10 × 20 нм и толщиной 10 нм, как схематично показано на рис. 2. Белым цветом показаны разупорядоченные атомы, идентифицированные с помощью программного пакета Ovito [22]. Вычисленные методом МД координаты атомов в пределах образца использовались для моделирования электронно-микроскопических изображений слоевым методом в программном пакете EMS [23]. Расчеты проводились при следующих параметрах: ускоряющее напряжение 200 кВ, разброс по фокусировке 2.9 нм, полуугол сходимости 0.1 мрад, дефокусировка объективной линзы 1.6 нм.
Рис. 2.
Изображение спроецированной вдоль направления [110] центральной части расчетной ячейки толщиной 2 нм после моделирования ионной бомбардировки методом молекулярной динамики. Штриховой линией выделена область образца, использованная для моделирования электронно-микроскопических изображений.
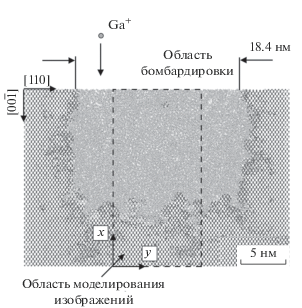
Светлопольное изображение для соответствующей эксперименту объективной диафрагмы, пропускающей электроны, которые рассеивались на углы менее 3.6 мрад, приведено на рис. 1б. Из сравнения рис. 1а и 1б следует, что данные эксперимента и результаты моделирования качественно согласуются друг с другом. Аналогично экспериментальной микрофотографии для расчетного изображения вычислялись средний профиль интенсивности и его производная вдоль оси x, которые показаны на рис. 1б. Позиции двух максимумов на зависимости ${{I{\kern 1pt} '\left( x \right)} \mathord{\left/ {\vphantom {{I{\kern 1pt} '\left( x \right)} {I_{{\max }}^{'}}}} \right. \kern-0em} {I_{{\max }}^{'}}}$ позволили определить толщину аморфизованного слоя, поскольку левый из них располагается вблизи середины переходной области на границе между c-Si и a-Si аналогично рис. 1а, а положение правого максимума соответствует границе a-Si–вакуум. Эта толщина составила $h_{{im}}^{{\left( {{\text{sim}}} \right)}} = 15.4$ нм и находится в хорошем соответствии с экспериментально найденным значением.
Для выявления взаимосвязи распределения интенсивности на электронно-микроскопическом изображении с атомным порядком выполнялся дальнейший анализ расположения атомов в образце. Для характеризации разупорядоченных атомов и идентификации дефектов при моделировании методом МД применялся ряд критериев, основанных на вычислении величины потенциальной энергии атома [24], значения локального параметра порядка [25], смещения атома из положения равновесия в узле кристаллической решетки [26], а также комбинации некоторых из перечисленных критериев [27].
В данной работе использовался критерий, характеризующий асимметрию в расположении ближайших соседей выбранного атома и примененный в [13] для описания границы между аморфным и кристаллическим материалом. Он основывается на вычислении модуля s(ri) = $ = \left| {\sum\nolimits_j {\left( {{{r}_{j}} - {{r}_{i}}} \right)} } \right|$ суммы векторов, направленных из данного атома, расположенного в точке ri, к его ближайшим соседям в точках rj. Такими соседями считались атомы, расположенные на расстоянии меньшем 2.83 Å, которое соответствовало положению минимума между первым и вторым пиком на функции радиального распределения атомов аморфного кремния.
Образец затем разбивался на интервалы вдоль оси $x$ шириной Vx = 0.5 нм, содержащие ${{N}_{x}}$ атомов, в каждом из которых среднее значение величины находилось как $s\left( x \right) = \left( {{1 \mathord{\left/ {\vphantom {1 {{{N}_{x}}}}} \right. \kern-0em} {{{N}_{x}}}}} \right)\sum\nolimits_i {s\left( {{{r}_{i}}} \right)} ,$ где суммирование проводится в пределах рассматриваемого интервала. В частности, для кристалла результат суммирования равнялся 0.3 Å, а для аморфизованной области – 1.4 Å. Полученная зависимость $s\left( x \right)$ вместе с экспериментальным и расчетным профилями интенсивности показаны на рис. 1в. Здесь $s\left( x \right)$ имеет вид ступенчатой функции, график которой при выборе подходящего масштаба качественно совпадает с профилями интенсивности. Среднее значение $s$ в аморфизованной области практически не зависит от $x,$ что указывает на однородность структуры материала. Преимущество выбранного критерия по сравнению с моделью критической плотности дефектов состоит в том, что в его рамках профили интенсивности на электронно-микроскопических изображениях непосредственно связаны с разупорядоченностью атомов после ионного воздействия по всей глубине образца. Отметим, что значению концентрации вакансий 23%, используемому для нахождения границы между c-Si и a-Si в модели критической плотности дефектов, соответствует величина $s,$ равная $s = 0.85$ Å.
Из рис. 1в также следует, что протяженность переходной области между c-Si и a-Si, определенная на основе экспериментальных данных и результатов моделирования, приблизительно одинакова и составляет около 5 нм.
ЗАКЛЮЧЕНИЕ
Для детального изучения повреждений, вносимых в монокристаллический кремний при ионной бомбардировке ионами галлия с энергией 5 кэВ, методом просвечивающей электронной микроскопии получены экспериментальные изображения образцов поперечных сечений аморфизованной области.
Для объяснения наблюдаемого на изображениях распределения интенсивности выполнено молекулярно-динамическое моделирование ионной имплантации в монокристаллический кремний. На основе полученных атомных конфигураций рассчитаны электронно-микроскопические изображения, которые сравнивались с экспериментально полученными микрофотографиями. С помощью метода, основанного на анализе усредненного профиля интенсивности изображений, найдены расчетное и экспериментальное значения толщины аморфизованной области, равные 15.4 и 15.3 нм соответственно.
Для выявления связи наблюдаемой интенсивности сигнала на изображении с атомарным строением образца вычислялся модуль суммы векторов, направленных из данного атома к его ближайшим соседям. Показано, что усредненное вдоль границы распределение этого модуля и профиль интенсивности изображений имеют близкую друг к другу форму, и поэтому такое распределение может использоваться для интерпретации наблюдаемого на микрофотографиях контраста. В частности, оно позволяет оценить ширину переходной области между аморфным и кристаллическим материалом, которая в рассматриваемом случае составила около 5 нм.
Список литературы
Li W., Zhan X., Song X. et al. // Small. 2019. P. 1 901 820. https://doi.org/10.1002/smll.201901820
Bruchhaus L., Mazarov P., Bischoff L. et al. // Appl. Phys. Rev. 2017. V. 4. № 1. P. 011302. https://doi.org/10.1063/1.4972262
Боргардт Н.И., Волков Р.Л., Румянцев А.В., Чаплыгин Ю.А. // Письма в ЖТФ. 2015. Т. 41. № 12. С. 97. https://doi.org/10.1134/S106378501506019X
Gnaser H., Brodyanski A., Reuscher B. // Surf. Interface Anal. 2008. V. 40. № 11. P. 1415. https://doi.org/10.1002/sia.2915
Румянцев А.В., Боргардт Н.И., Волков Р.Л. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2018. № 6. С. 102. https://doi.org/10.1134/S1027451018030345
Cerva H., Hobler G. // J. Electrochem. Soc. 1992. V. 139. № 12. P. 3631.
Huang J., Loeffler M., Muehle U. et al. // Ultramicroscopy. 2018. V. 184. P. 52. https://doi.org/10.1016/j.ultramic.2017.10.011
Волков Р.Л., Боргардт Н.И., Кукин В.Н. и др. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2011. № 9. С. 94. https://doi.org/10.1134/S1027451011090151
Greenzweig Y., Drezner Y., Tan S. et al. // Microelectron. Eng. 2016. V. 155. P. 19. https://doi.org/10.1016/j.mee.2016.01.016
Smith R. Atomic and Ion Collisions in Solids and at Surfaces: Theory, Simulation and Applications. Cambridge: Cambridge University Press, 1997. 320 p.
Xiao Y.J., Fang F.Z., Xu Z.W., Hu X.T. // Appl. Surf. Sci. 2015. V. 343. P. 56. https://doi.org/10.1016/j.apsusc.2015.03.059
Pastewka L., Salzer R., Graff A. et al. // Nucl. Instrum. Methods Phys. Res. Sect. B. 2009. V. 267. P. 3072. https://doi.org/10.1016/j.nimb.2009.06.094
Timonova M., Thijsse B.J. // Comput. Mater. Sci. 2011. V. 50. № 8. P. 2380. https://doi.org/j.commatsci.2011.03.016
Otto G., Hobler G., Palmetshofer L., Pongratz P. // Nucl. Instrum. Methods Phys. Res. Sect. B. 2007. V. 255. № 1. P. 105. https://doi.org/10.1016/j.nimb.2006.11.020
Plimpton S. // J. Comput. Phys. 1995. V. 117. P. 1. https://doi.org/10.1006/jcph.1995.1039
Nguyen T.D. // Comput. Phys. Comm. 2017. V. 212. P. 113. https://doi.org/10.1016/j.cpc.2016.10.020
Tersoff J. // Phys. Rev. B. 1989. V. 39. № 8. P. 5566. https://doi.org/10.1103/PhysRevB.39.5566
Ziegler J.F., Biersack J.P., Littmark U. The stopping and range of ions in solids. N.Y.: Pergamon, 1985. 321 p.
Hu X., Albe K., Averback R.S. // J. Appl. Phys. 2000. V. 88. № 1. P. 49. https://doi.org/10.1063/1.373622
Swaminathan-Gopalan K., Zhu T., Ertekin E., Stephani K.A. // Phys. Rev. B. 2017. V. 95. № 18. P. 184 109. https://doi.org/10.1103/PhysRevB.95.184109
Sand A.E., Nordlund K. // J. Nucl. Mat. 2015. V. 456. P. 99. https://doi.org/10.1016/j.jnucmat.2014.09.029
Stukowski A. // Modelling Simul. Mater. Sci. Eng. 2009. V. 18. № 1. P. 015012. https://doi.org/10.1088/0965-0393/18/1/015012
Stadelmann P.A. // Ultramicroscopy. 1987. V. 21. № 2. P. 131. https://doi.org/10.1016/0304-3991(87)90080-5
Ghaly M., Averback R.S. // Phys. Rev. Lett. 1994. V. 72. № 3. P. 364. DOI 10.1103 // PhysRevLett.72.364
Buta D., Asta M., Hoyt J.J. // Phys. Rev. E. 2008. V. 78. № 3. P. 031605. https://doi.org/10.1103/PhysRevE.78.031605
Nordlund K., Averback R.S. // Phys. Rev. B. 1997. V. 56. № 5. P. 2421. https://doi.org/10.1103/PhysRevB.56.2421
Pothier J.C., Schiettekatte F., Lewis L.J. // Phys. Rev. B. 2011. V. 83. № 23. P. 235 206. https://doi.org/10.1103/PhysRevB.83.235206
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования


