Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2020, № 9, стр. 80-88
Эволюция профиля Si наноструктур при распылении в аргоновой плазме ВЧИ разряда
А. С. Шумилов a, *, И. И. Амиров a
a Ярославский филиал Физико-технологического института
им. К.А. Валиева РАН
150007 Ярославль, Россия
* E-mail: AndShumilov@gmail.com
Поступила в редакцию 20.12.2019
После доработки 22.01.2020
Принята к публикации 22.01.2020
Аннотация
Представлены результаты экспериментального исследования и моделирования эволюции профиля Si гребенчатых наноструктур при низкоэнергетическом распылении (Ei ~ 100 эВ) в плазме Ar высокочастотного индукционного разряда. Моделирование проводили в зависимости от величины коэффициентов прилипания Si–Si с учетом угловой зависимости выхода распыленных атомов Si. Результаты численного моделирования находились в хорошем согласии с экспериментом при коэффициенте прилипания атомов Si равном 0.9–1 и функции углового выхода распыленных атомов Si близкой к распределению cos 0.1(x). Из данных моделирования тестовых структур была определена зависимость коэффициента выхода атомов Si от угла падения ионов Ar+. Максимум этой функции находился при угле равном ~65° относительно нормали поверхности. Экспериментально была определена зависимость коэффициента распыления Si ионами Ar+ от энергии ионов на плоской поверхности в диапазоне 50–200 эВ.
ВВЕДЕНИЕ
Ионно-плазменная обработка микро- и наноструктурированной (МН) поверхности материалов в плазме широко применяется в различных областях нанотехнологии. В технологии микро- и наноэлектроники она используется для уменьшения шероховатости поверхности Si, изготовления элементов магнитной памяти и формировании дорожек металлизации при ионно-плазменном осаждении меди на МН структуры [1–5]. В таких процессах важным фактором, влияющим на его характер, является переосаждение распыляемого материала на боковые стенки МН структур. Так исследования низкоэнергетического распыления в плазме Ar, микроструктурированной в виде микростолбиков, микростержней поверхности Мо и W показали, что скорости распыления структурированной и гладкой поверхностей отличаются [6, 7]. Это объяснялось влиянием переосажденных атомов металла на стенки. Механизм и модели развития морфологии поверхности при ионной бомбардировке рассматривались во многих работах [8–12]. Было показано, что в зависимости от материала и условий распыления коэффициент распыления материала структурированной поверхности может быть меньше или больше, чем при распылении его гладкой поверхности. Это связано с тем, что при распылении структурированной поверхности возникают два конкурирующих процесса. Первый процесс обусловлен увеличением коэффициента выхода за счет увеличения угла падения ионов, а второй – снижением выхода в результате прилипания распыленных частиц на стенки МН структур. Работ, посвященных моделированию распыления топологических МН структур c учетом этих факторов немного [13–15]. Вопросы моделирования формирования ямок травления возникают также при распылении поверхности фокусированным ионным пучком. В таких процессах необходимо учитывать эффект переосаждения атомов и влияния функции углового распределения (ФУР) распыленных атомов на получаемый профиль [16, 17]. Ранее нами был разработан метод моделирования распыления наноструктурированной поверхности Si [15]. Метод был применен для моделирования распыления ионами Ar+ микроканавочных структур в Si. Однако из экспериментальных данных эволюции профиля канавочных структур и моделирования такого процесса определение коэффициента прилипания Si–Si (коэффициент β) и ФУР распыленных атомов Si было затруднено ввиду сглаженности профилей. Целью данной работы являлось моделирование эволюции профиля Si высокоаспектных гребенчатых наноструктур при низкоэнергетической (Ei = 100 эВ) ионной бомбардировке в плазме Ar и определение на основе полученных данных коэффициента β и ФУР распыленных атомов Si. В работе моделировали экспериментально полученные профили распыления высокоаспектных гребенчатых наноструктур Si в виде решетки стенка/канавка нанометровых размеров с разным аспектным отношением (отношение ширины канавки к ее высоте) (рис. 1а). Изменяющийся профиль такой гребенчатой структуры в процессе ее распыления является наиболее удобным тестовым объектом моделирования эволюции профиля для определения на основе его β и ФУР. Они были подстроечными параметрами при моделировании. В работе экспериментально определена зависимость коэффициента распыления атомов Si от энергии ионов Ar+. Кроме этого на основании экспериментально полученных профилей распыления гребенчатых наноструктур была определена зависимость коэффициента распыления от угла падения ионов.
МЕТОДИКА ЭКСПЕРИМЕНТА
Эксперименты по распылению гребенчатых наноструктур Si проводили в реакторе плотной плазмы ВЧ-индукционного разряда, подробно описанном в [18]. В таком реакторе для управления энергией бомбардирующих поверхность образца ионов, на электрод через устройство согласования подавали высокочастотную (ВЧ) мощность cмещения Psb ( f = 13.56 МГц, W = 50–300 Вт). При этом ВЧ-электрод приобретал отрицательный потенциал самосмещения – Usb. В работе, как в [18] полагали, что средняя энергия падающих ионов Ei определялась как Ei ~ eUsb. Плотность ионного тока определяли из линейной зависимости –Usb от Psb [18]. Коэффициент распыления Y атомов Si от энергии ионов определялся по следующей формуле:
(1)
$Y\left[ {{{{\text{atom}}} \mathord{\left/ {\vphantom {{{\text{atom}}} {{\text{ion}}}}} \right. \kern-0em} {{\text{ion}}}}} \right] = \frac{{V\rho е{{N}_{{\text{A}}}}}}{{{{j}_{{\text{i}}}}M}},$Условия проведения эксперимента в плазме аргона были следующими: Р = 0.08 Па, W = 800 Вт. Расход Ar был равен 10 нсм3/мин (при нормальных условиях). Плотность ионного тока при таких условиях равнялась 10.4 мА/см2. Однородность ионного потока на электрод диаметром 100 мм была выше 95%.
Образцами служили пластинки Si КДБ 10 (100) размером 10 × 10 мм, на поверхности которых методом анизотропного плазмохимического травления были протравлены три вида гребенчатых наноструктур Si с разной шириной, высотой канавок и разным их аспектным отношением, указанными на рис. 1а. Начальный профиль гребенчатых наноструктур Si и после распыления в течение 80 с определяли с использованием растрового электронного микроскопа LEO 430. Скорость распыления Si на плоской поверхности определяли по глубине ступеньки, образующейся после распыления Si через маску фоторезиста за определенное время. Ступеньку травления измеряли с помощью профилометра TALYSTEP.
Методика определения ФУР и коэффициента β
После одновременного распыления трех видов гребенчатых наноструктур в плазме Ar при средней энергии ионов ~100 эВ в течение 80 с с помощью РЭМ определяли профиль их распыления (рис. 1б). С использованием разработанного метода моделировали профиль распыления гребенчатых наноструктур № 1 в зависимости от вида ФУР и коэффициента β и определяли, при каком ФУР и коэффициенте β смоделированный профиль был наиболее близким по форме с экспериментально полученным профилем. На следующем этапе, при полученной функции углового распределения и коэффициенте β, определяли насколько профили распыления гребенчатых наноструктур № 2 и № 3 совпадали с экспериментом. В случае их несоответствия проводили корректирование параметров до полного совпадения результата моделирования профиля всех трех гребенчатых наноструктур с экспериментальными данными. На основании этого определяли ФУР и коэффициент β.
В отличие от ионно-пучкового распыления особенностью ионно-плазменных процессов распыления, проводимых в реакторе плотной плазмы ВЧ-индукционного разряда, является широкая функция распределения ионов по энергиям (ФРИЭ). При подаче мощности ВЧ-смещения на подложку ФРИЭ является двугорбой [19, 20]. Вид ФРИЭ мог повлиять на характер распыления наноструктур. Одной из целей работы было также моделирование влияния вида ФРИЭ на эволюцию профиля исследуемой структуры при ее распылении.
КРАТКОЕ ОПИСАНИЕ МЕТОДА МОДЕЛИРОВАНИЯ
Метод моделирования эволюции профиля Si наноструктур при ионно-плазменном распылении основывался на методе ячеек и методе Монте-Карло представления потока ионов и модели взаимодействия ионов с поверхностью. Метод подробно описан в [15]. Модель включала следующие процессы: зависимое от энергии и угла падения физическое распыление Si ионами и отраженными от стенок атомами аргона; переосаждение распыленных атомов Si; поверхностная диффузия атомов материала. Основными параметрами моделирования являлись: функция распределения ионов по энергии (ФРИЭ), функция углового распределения падающих ионов σi, коэффициент распыления Si при заданной энергии ионов Ysp и функция угловой зависимости коэффициента распыления Si – gsp(φ). Последние два параметра определяли экспериментально.
Моделирование профиля распыления Si наноструктур в плазме Ar проводили как при моноэнергетическом ионном потоке с энергией 100 эВ, так и двугорбом ионном распределении ионов по энергиям с максимумами при 30 и 170 эВ. Измерения ФРИЭ ионов, падающих на поверхность ВЧ-электрода, показывали, что она является двугорбой [19]. Средняя энергия в последнем случае также равнялась 100 эВ. При kTi = 0.3 эВ и Ei = 100 эВ величина среднеквадратичного углового отклонения ионов σi равнялась 2.8° [15]. На первом этапе моделирования, ФРИЭ считали моноэнергетической. Плотность ионного потока при моделировании равнялась ГAr+ = 6.5 × 1016/см2 · c. что соответствовало условиям эксперимента.
Коэффициент выхода атомов материала на один ион Ysp на плоской поверхности определялся выражением (2):
(2)
${{Y}_{{{\text{sp}}}}}\left( {{{E}_{{\text{i}}}},\varphi } \right) = {{f}_{{{\text{sp}}}}}({{E}_{{\text{i}}}}){{g}_{{{\text{sp}}}}}(\varphi ),$Известно, что при низкоэнергетической ионной бомбардировке ФУР отличается от обычного косинусного распределения [11, 12, 21]. Она может быть представлена в общем виде (3) [11, 21]:
Однако ее вид может быть более сложным. Измерения ФУР ряда металлов при энергии бомбардирующих ионов Еi < 500 эВ [21] показали, что максимум эмиссии одних металлов совпадал с направлением нормали к поверхности, а других наблюдался при угле θ ≈ 30°. В этом случае угловые распределения описывались функцией вида (4): где θ – угол вылета распыленного атома, A, B, n, m – подгоночные параметры.В работе [15] при моделировании распыления ионами Ar+ микроканавок в кремнии наилучшие результаты были получены при угле максимального выхода распыленных частиц, равном ~50°–55° при энергии ионов ∼125 эВ. При моделировании профиля распыления структур Si ФУР задавали в виде (3) и (4). Коэффициент n в (3) изменяли в диапазоне 0.1–2.
Вероятность прилипания распыленных атомов зависит от их энергии [4, 11]. Расчеты показывают, что энергия распыленных атомов мишени при бомбардировке ее ионами Ar+ почти в 20 раз меньше энергии падающего иона [22]. Поэтому далее считали, что энергия переосаждаемых атомов Si составляла 5–6 эВ. При такой энергии вероятности прилипания, например, атомов меди к меди были близки к единице и составляли ~0.8 [4, 14]. В работе [15] наилучшие результаты численного моделирования были получены при значениях вероятности прилипания, равной 0.9. При моделировании вероятность β варьировали в диапазоне от 0 до 1.0.
Начальные профили распыления № 1–3 для модели создавались растрированием снимков начальных экспериментальных профилей (рис. 1а) в графический формат “*.BMP”. При этом сохранялись все пропорции и размеры начальной геометрии профилей микроструктур. Ширина профилей гребенчатых структур в численных экспериментах с учетом открытой поверхности равнялась 6.5 мкм, что соответствовало ~3600 ячейкам.
РЕЗУЛЬТАТЫ ЭКСПЕРИМЕНТОВ И ИХ ОБСУЖДЕНИЕ
Определение коэффициента распыления Si в плазме Ar от энергии ионов показало, что он изменялся в согласии нашими расчетными данными, полуэмпирическими формулами Matsunami [23] и с результатами моделирования методом молекулярной динамики [24] (рис. 2). Коэффициент распыления на плоской поверхности при Ei ≈ 100 эВ Ysp равнялся ~0.055 атомов Si на ион.
Рис. 2.
Зависимость коэффициента выхода атомов Si на один ион от энергии ионов Ar+, определенные экспериментально (◼), по данным Matsunami [23] (⚫), полученные моделированием (Δ).
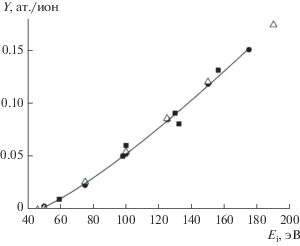
Распыление гребенчатых наноструктур Si при энергии ионов 100 эВ в течение 80 с показало, что их вид резко изменился. Первоначально прямоугольные гребенки № 1 и № 2 стали треугольными (рис. 1б). В результате распыления их высота уменьшилась на ~220–230 нм. Относительно ровной поверхности высота гребенчатых наноструктур уменьшились на ~250 и 275 нм, соответственно. Более сильное уменьшение высоты узких гребенок № 2 по сравнению с более широкими гребенками № 1 объясняется тем, что развитие треугольного профиля на них происходит быстрее. Гребенчатые наноструктуры № 3 с начальной высотой 230 нм оказались почти полностью сглаженными (рис. 1б, № 3). Это также объясняется более быстрым распылением узких гребенок. Относительно ровной поверхности их высота уменьшилась на ~245 нм. Это меньше, чем в случае более широких гребенок и объясняется, как будет показано далее, переосаждением атомов Si.
Возникновение треугольного профиля первоначально прямоугольных наностолбчатых структур объясняется быстрым распылением Si на их углах с образованием фасетки. Вследствие этого из-за угловой зависимости скорости распыления Si угол падения ионов на наклонную поверхность еще более увеличивался, достигая угла, при котором скорость распыления максимальна. По литературным данным с увеличением угла падения ионов до ~20°–40° скорость распыления Si сначала незначительно возрастала, а затем быстро увеличивалась, достигая максимума при угле падения около 60°–70° [24–26]. Отношение скорости распыления Si при нормальном падении и при угле максимального распыления было разным (рис. 3, кривые 1, 3, 4) [24–26]. По экспериментальным данным при распылении поликремния оно равнялось ~3 [25], а по расчетным данным методом молекулярной динамики и SRIM это отношение было около 6.5 или 14 (рис. 4, кривые 3 и 4) [24, 26]. Можно полагать, что в нашем случае максимум распыления также наблюдался при угле 65°, так как угол на вершине треугольного профиля равнялся приблизительно 30° (рис. 1б, № 1).
Рис. 4.
Моделирование распыления двух вертикальных структур с разными функциями распыления от угла падения ионов (gsp(φ)) с максимумом распыления: 16° (а), 32° (б), 45° (в), 59° (г), 70° (д). Ei = 170 эВ. Время – 40 с. ФУР – cos0.1(x), коэффициент прилипания Si–Si = 1.

Для подтверждения развития угла фасетки было проведено численное моделирование распыления двух вертикальных прямоугольных столбчатых структур при разной угловой функции распыления, в которых угол максимального распыления изменяли от 15° до 70°. При этом угол фасетирования действительно приблизительно равнялся углу максимальной скорости распыления (рис. 4). На рис. 4г угол фасетирования равнялся 56°–57°, что соответствовало углу максимальной скорости равному ~60°. Моделирование показало, что вид угловой функции распыления определял профиль распыления столбчатых структур. На профилях (а–в) при максимуме распыления в 15°–45° наблюдался эффект углубления у крайних боковых стенок и сужение центральной канавки. Эти эффекты можно объяснить влиянием отраженных от боковых стенок ионов, падающих под скользящими углами, и прилипанием распыленных атомов Si внутри канавки. При углах падения 60°–70° в соответствии с экспериментальными данными такого эффекта нет. Наоборот, наблюдается некоторое уширение крайних гребенок профиля, что связано с переосаждением атомов Si.
Определение коэффициента β проводили на основании наилучшего согласия результатов моделирования с экспериментальными данными. Моделирование эволюции профиля гребенчатых наноструктур № 1 (ширина гребенки 50 нм, расстояние между ними 150 нм, высота 372 нм) проводили при изменении параметра β от 0 до 1.0 (рис. 5). ФУР брали согласно работе [15] с максимумом в 55°. Один шаг линии профиля моделирования соответствовал 40 с времени распыления. Профили распыления структуры при разных β в первые 40 с стали одинаково заостренными. Моделирование проводили с помощью угловой функцией распределения, представленной на рис. 3, кривая 2. Максимум скорости распыления был при угле падения ионов равном ~65°. Скорость распыления при этом, приблизительно, в шесть раз выше скорости распыления на ровной поверхности. Она близка к зависимости, определенной из данных моделирования SRIM (кривая 4, рис. 3). Скорость распыления гребенчатых структур Si была почти в пять раз выше, чем скорость распыления Si на плоской поверхности. Уширение гребенок стало наблюдаться только при β = = 0.6 и 1.0. В последующие 40 с травления профиль стал треугольным, причем при больших β угол наклона стенок уменьшился из-за прилипания частиц в нижней части боковых стенок структур. Их высота и ширина при основании треугольных структур увеличивались также как в численных экспериментах на рис. 4. После 120 с распыления наблюдалось почти полное сглаживание гребенчатых наноструктур при β = 0, в то время как при β = 1 на поверхности оставались треугольные столбики. Таким образом, переосаждение атомов Si приводило к общему уменьшению скорости распыления. Эффект переосаждения наиболее сильно проявился на крайних структурах гребенок, высота и ширина которых была больше, чем в центре гребенчатых наноструктур. Очевидно, что это объясняется тем, что на них падают атомы Si распыленные с открытой поверхности. Из данных моделирования следовало, что профиль моделирования при β = 1 был наиболее близким к экспериментальному. Поэтому в дальнейшем моделирование проводили при β = 1. Моделирование при β = 0.9 не показало существенной разницы.
Для оценки влияния ФУР распыленных атомов на результирующий профиль было проведено множество численных экспериментов, где максимум вылета частиц варьировался в диапазоне от 0° до 60° относительно нормали к поверхности. Численные эксперименты распыления половины гребенчатых наноструктур № 1 с увеличенной открытой площадкой слева (до 6 мкм) при β = 1 показали, что варьирование степени n в функции углового вылета распыленных частиц (3) в пределах 0.1–1.5 слабо влияло на результирующий профиль. В случае же широкой ФУР (варианты 1 и 2) ширина треугольных структур при основании была больше, чем в случае более анизотропной функции распыленных атомов Si (варианты 3 и 4). Кроме того, осаждение материала на дне и на крайних боковых структурах гребенчатых наноструктур стало больше. Видно, что с увеличением открытой поверхности слева от гребенок (относительно экспериментов на рис. 5) утолщение крайних структур также увеличилось. Причем при широких ФУР (варианты 1 и 2) толщина переосажденного материала стала значительно больше, ввиду большего потока распыленных атомов Si с открытой поверхности слева. Моделирование распыления гребенчатых наноструктур при 0.8 < β < 1 показало, что в зависимости от вида ФУР профиль распыления изменялся незначительно. Таким образом, сравнение экспериментального и численного профилей распыления гребенчатых наноструктур № 1 показало, что наиболее близким по форме к эксперименту являлись профили, полученные при β = 0.9–1 и широкой ФУР (варианты 1 и 2), представленные на рис. 6. Моделирование при ФУР еще более близкой к равновероятной (n = 0.01) показало, что это не отразилось существенным образом на профиле распыления. Поэтому можно полагать, что при низкоэнергетической ионной бомбардировке угловое распределение распыленных атомов Si является широким.
Рис. 6.
Результаты моделирования распыления половины гребенчатой наноструктуры № 1 в плазме Ar в зависимости от вида ФУР распыленных частиц: 1 – cos0.1(x), 2 – угол вылета 55° – 4.6 cos1.2(x) – 4.15cos2(x) [15], 3 – диффузное – cos(x), 4 – угол вылета 30º – 4.6 cos3.7(x) + 4.04 cos6(x). Вероятность прилипания распыленных атомов – 1, gsp(φ) – 65° (рис. 3, 2). Временнóй интервал линий профиля равнялся 80 с. Ei = 100 эВ.

На следующем этапе проводили моделирование распыления гребенчатых наноструктур № 1–№ 3 при ранее установленных параметрах модели (угловая функция распределения с максимумом 65°, β = 1, ФУР вида (3) при n = 0.1). Профили фиксировали на временнóй отметке 80 с и накладывали на экспериментальные профили. Моделирование показало, что полученные результаты хорошо согласуются с экспериментальными данными (рис. 7).
Рис. 7.
Результаты моделирования распыления гребенчатых наноструктур № 1–3 Si в плазме Ar. В левой колонке моделирование с временны́м интервалом линий профиля в 40 с. В правой колонке промежуточный вид профиля для сравнения с экспериментом на временнóй отсечке 80 с.

Моделирование распыления гребенчатых наноструктур при симметричной двугорбой функции распределения ионов (низкоэнергетический пик при 30 эВ, а высокоэнергетический при 170 эВ) показало, что профили распыления были аналогичными тому, что наблюдалось при моноэнергетическом распылении. Это объясняется тем, что в данной модели угловая зависимость коэффициента распыления не зависела от энергии ионов. Хотя при двугорбом распределении часть ионов низкоэнергетического пика при 30 эВ оказывалась ниже порога распыления Si и не принимала участия в распылении, это не отразилось форме профиля. При этом скорость распыления при симметричном двугорбом распределении была несколько ниже, чем при моноэнергетической ФРИЭ.
ЗАКЛЮЧЕНИЕ
В работе на основе моделирования экспериментально полученных профилей распыления высокоаспектных гребенчатых структур при низкоэнергетической ионной бомбардировке (Ei ~ ~ 100 эВ) плазме Ar ВЧИ разряда низкого давления были определены коэффициент прилипания атомов Si–Si, а также функция углового распределения распыленных атомов кремния. Было показано, что профиль распыления определяется функцией зависимости коэффициента распыления от угла падения ионов. Максимальная скорость распыления Si наблюдалась при угле падения ионов ~65°. Она приблизительно ~6 раз превышала скорость распыления на ровной поверхности. В результате численного моделирования был определен коэффициент прилипания переосажденных атомов, равный ~0.9–1.0. Сравнение профилей моделирование распыления трех гребенчатых структур с экспериментально полученными профилями показало, что лучшее их согласие наблюдается при широкой функции углового распределения распыленных частиц, описываемых функцией вида cos 0.1(x) или лепестковой функцией с максимумом при ~55° при коэффициенте прилипания равном ~1. В соответствии с экспериментом моделирование показало, что с учетом процесса распыления и переосаждения атомов Si прямоугольный профиль гребенчатых структур становился треугольным. При дальнейшем распылении происходило его сглаживание. Можно полагать, что с использованием данных параметров можно будет удовлетворительно описывать распыление наноструктур при низких энергиях ионов (Ei < 500 эВ).
Список литературы
Frost F., Fechner R., Ziberi B., Vollner J., Flamm D., Schindler A. // J. Phys.: Condens. Matter. 2009. V. 21. P. 224 026.
Guo W., Sawin H. H. // J. Phys. D: Appl. Phys. 2009. V. 42. P. 194 014.
Persson A., Ericson F., Thornell G., Nguyen H. // J. Micromech. Microeng. 2011. V. 21. P. 045014.
Liu X.-Y., Daw M.S., Kress J.D., Hanson D.E., Arunachalam V., Coronellb D.G., Liud C.-L., Voter A.F. // Thin Solid Films. 2002. V. 422. P. 141.
Lu J., Kushner M. J. // J. Vac. Sci. Technol. A. 2001. V. 19. P. 2652.
Ghoniem N.M., Sehirlioglu A., Neff A.L., Allain J.-P., Williams B., Sharghi-Moshtaghin R. // Appl. Surf. Science. 2015. V. 331. P. 299.
Li G.Z., Matlock T.S., Goebel D.M., Dodson C.A., Matthes C.S.R., Ghoniem N.M., Wirz R.E. // Plasma Sources Sci. Technol. 2017. V. 26. P. 065002.
Littmark U., Hofer W.O. // J. Mater. Sci. 1978. V. 13. P. 2577.
Zier M., Hauffe W. // Nucl. Instrum. Methods Phys. Res. B. 2003. V. 202. P. 182.
Makeev M.A., Barabási A.-L. // Nucl. Instrum. Methods Phys. Res. B. 2004. V. 222. P. 335.
Распыление под действием бомбардировки частицами. Выпуск III / Под ред. Бериша Р., Виттмака К. М.: Мир, 1998. 488 с.
Фундаментальные и прикладные аспекты распыления твердых тел: Сб. статей / Сост. Машкова Е.С. М.: Мир, 1989. С. 349.
Hobler G., Kovac D. // Nucl. Instrum. Meth. B. 2011. V. 269. № 8−9. P. 1609.
Huerta C.E., Matlock T.S., Wirz R.E. // J. Appl. Physics. 2016. V. 119. P. 113303.
Shumilov A.S., Amirov I.I. // Technical Physics. 2015. V. 60. P. 1056.
Kim H.-B., Hobler G., Steiger A., Lugstein A., Bertagnolli E. // Nanotechnology. 2007. V. 18. P. 245303.
Боргардт Н.И., Волков Р.Л., Румянцев А.В., Чаплыгин Ю.А. // Письма в ЖТФ. 2015. Т. 41. Вып. 12. С. 97.
Амиров И.И., Изюмов М.О., Наумов В.В. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2016. № 8. С. 82.
Sobolewski M.A., Olthoff J.K., Wang Y.J. // J. Appl. Phys. 1999. V. 85. № 8. P. 3966.
Woodworth J.R., Abraham I.C., Riley M.E., Miller P.A., Hamilton T.W. et al. // J. Vac. Sci. Technol. A. 2002. V. 20. P. 873.
Мартыненко Ю.В., Рогов А.В., Шульга В.И. // Журн. технической физики. 2012. Т. 82. Вып. 4. С. 13.
Lu J., Gyu Lee C. // Vacuum 2012. V. 86. P. 1134.
Matsunami N., Yamamura Y., Hikawa Y., Itoh N., Kazumata Y., Miyagawa S., Morita K., Shimizu R., Tawara H. // Atomic Data Nucl. Data Tables. 1984. V. 31. P. 1.
Palov A.P., Balint-Kurti G.G., Voronina E.N., Rakhimova T.V. // J. Vac. Sci. Technol. A. 2018. V. 36. P. 041303-1.
Yin Y., Sawin H.H. // J. Vac. Sci. Technol. A. 2008. V. 26. P. 151.
Guo W., Sawin H.H. // J. Vac. Sci. Technol. A. 2009. V. 27. P. 1326.
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования