Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2021, № 10, стр. 50-54
Исследование влияния облучения низкоэнергетичным электронным пучком на вольт-фарадные характеристики SiO2
Ю. О. Куланчиков a, b, *, П. С. Вергелес a, Е. Б. Якимов a
a Институт проблем технологии микроэлектроники и особочистых материалов
Российской академии наук
142432 Черноголовка, Московская область, Россия
b Национальный исследовательский технологический университет “МИСиС”
119049 Москва, Россия
* E-mail: kul_ura@mail.ru
Поступила в редакцию 30.12.2020
После доработки 22.02.2021
Принята к публикации 28.02.2021
Аннотация
Методом измерения вольт-фарадных (C–V) характеристик исследовано влияние облучения электронным пучком на свойства структур металл–диэлектрик–полупроводник Al/SiO2/n-Si. Обнаружено, что эффекты зарядки и образование новых центров на границе раздела SiO2–Si в структурах на основе n-Si проявляются при значительно больших дозах облучения, чем в случае p-Si. Выявлено понижение эффективной концентрации доноров в результате облучения, которое объясняется пассивацией фосфора водородом. Отжиг в течение 10 мин при температуре 100°C приводил к восстановлению эффективной концентрации доноров, а после отжига при 250°C наблюдалось полное восстановление C–V-кривых до исходного состояния.
ВВЕДЕНИЕ
Широкое применение изолирующих и диэлектрических материалов в современной полупроводниковой технологии порождает интерес к исследованию процессов накопления электрического заряда и его релаксации в этих материалах при их облучении различными типами ионизирующего излучения (гамма и рентгеновские, нейтронные и другие пучки) [1, 2]. Исследования процессов накопления заряда в диэлектриках необходимы также для повышения радиационной стойкости полупроводниковых приборов, разработки изоляционных материалов для защиты спутников и космических аппаратов и т.д. Кроме того, понимание кинетики накопления электрического заряда играет важную роль для коррекции влияния эффектов зарядки при количественной характеризации изолирующих материалов методами растровой электронной микроскопии (РЭМ). В последнем случае основное влияние оказывает поверхностный потенциал, формирующийся в результате зарядки, и значительная часть работ была посвящена исследованию этого потенциала [3, 4]. Было показано [3], что он может достигать значений в несколько килоэлектронвольт, при этом, как следует из работы [4], формирование поверхностного потенциала не может быть объяснено без учета распределения в диэлектрическом слое неравновесных электрон-дырочных пар, рождаемых падающим пучком. В другой группе работ проводились исследования фиксированного заряда в оксидном слое и ловушек на границе раздела диэлектрик/полупроводник, формирующихся в тонком слое диэлектрической пленки при облучении ионизирующими пучками [1, 2, 5, 6].
Однако, несмотря на многочисленные исследования, динамика зарядки диэлектриков при облучении электронным пучком до сих пор не до конца понятна. В частности, формирование новых состояний на границе раздела SiO2/Si объяснялось в работах [1, 2] переносом рожденных при облучении дырок к границе раздела с последующим преобразованием захваченных дырок в ловушки на границе раздела. В [5] было показано, что формирование ловушек может происходить и с участием электронов. В ряде других работ (например, [7]) формирование ловушек на границе раздела объясняли реакциями с участием водорода. В случае исследования влияния облучения ионизирующего излучения на свойства металл–диэлектрик–полупроводник (МДП) структур на основе SiO2/Si подавляющее число работ было выполнено на образцах с подложкой p-типа и лишь малая часть – на структурах с кремниевой подложкой n-типа проводимости. В то же время электрическое поле в пленке SiO2 может зависеть от типа проводимости подложки. Поэтому представляло интерес сравнить влияние облучения ионизирующего облучения на накопление заряда в оксидном слое на подложках n- и p-типа проводимости при воздействии ионизирующего облучения.
В данной работе мы представляем результаты исследования накопления заряда в слое SiO2 при облучении низкоэнергетическим электронным пучком и релаксации этого заряда методом измерения вольт-фарадных профилей (C–V-характеристики), для структур на подложках Si n-типа. Для сравнения часть измерений проводилась на МДП-структурах на подложках с проводимостью p-типа.
МЕТОДИКА И ОБРАЗЦЫ
В исследовании использовались образцы на подложке Si n-типа с толщиной слоя SiO2 порядка 300 нм, легированные фосфором до концентрации 4.6 × 1014 см–3. Для сравнения часть измерений проводилась на структурах с подложкой Si p-типа проводимости, легированной бором до концентрации 3 × 1014 см–3, и толщиной диэлектрического слоя SiO2 200 нм. Оксидный слой получали термическим окислением кремния. Облучение проводилось в растровом электронном микроскопе JSM-840A в телевизионном режиме сквозь напыленные площадки металлизации при значении энергии первичных электронов 10 кэВ и максимальном токе пучка 3 × 10–9 А. Во всех экспериментах металлический контакт был заземлен либо на него подавалось напряжение. Доза облучения составляла от 6.25 × 10–2 до 100 мкКл/см2. Как было показано в [5], при используемой энергии падающего пучка первичные электроны достигают кремниевой подложки. Изучение релаксации эффектов облучения при термическом отжиге проводилось в интервале температур 395–483 К.
РЕЗУЛЬТАТЫ И ОБСУЖДЕНИЕ
Вольт-фарадные (C–V) характеристики структуры на n-Si, облученной электронами, представлены на рис. 1а. Для сравнения аналогичные характеристики на p-Si представлены на рис. 1б. Видно, что на n-Si даже при дозе 100 мкКл/см2 объемный заряд в оксиде, который проявляется в сдвиге C–V-характеристики по оси напряжений, небольшой, и основной эффект облучения заключается в изменении наклона характеристик и уменьшении емкости при отрицательном смещении в режиме инверсии. Изменение наклона характеристики свидетельствует об образовании новых состояний на границе раздела полупроводник/диэлектрик, а уменьшение емкости в режиме инверсии свидетельствует об увеличении ширины области объемного заряда в кремнии, т.е. о понижении эффективной концентрации доноров. Чувствительность структур на p-Si к облучению электронами была существенно выше (рис. 1б), что хорошо согласуется с результатами, полученными ранее в работах [5, 6, 8]. Заметный сдвиг характеристики в сторону отрицательных напряжений и изменение ее наклона на p-Si наблюдалось уже при дозах облучения, меньших 1 мкКл/см2. Кроме того, на структурах на p-Si даже облучение с дозой порядка 100 мкКл/см2 не приводило к заметному изменению емкости в режиме инверсии, т.е. уменьшения эффективной концентрации акцепторов не наблюдалось.
Рис. 1.
C–V-характеристики исследуемых структур до и после облучения: а – подложка Si n-типа, б – подложка Si p-типа (доза облучения 2.5 мкКл/см2). Энергия падающего пучка 10 кэВ.

В работе [5] было показано, что приложенное к исследуемой структуре во время ее облучения напряжение может существенным образом влиять на эффекты накопления заряда как в объеме оксидного слоя, так и на интерфейсе SiO2/Si. Поэтому представляло интерес сравнить влияние напряжения, приложенного во время облучения, на эффект накопления заряда в структурах с подложкой n-типа проводимости. На рис. 2 представлены C–V-характеристики, демонстрирующее влияние приложенного в процессе облучения напряжения для структур n- и p-типа проводимости. Прежде всего, следует отметить, что качественно влияние приложенного напряжения в обоих типах структур подобно. При приложении отрицательного напряжения к металлическому электроду кривые немного смещаются в сторону отрицательных напряжений, а при положительном напряжении они также смещаются в сторону отрицательных напряжений. Следует отметить, что, если на структуре n-Si приложенное положительное напряжение в основном изменяло наклон C–V-кривых, т.е. увеличивало плотность состояний на границе раздела, на структуре p-Si такое напряжение приводило к существенному сдвигу C–V-кривых в сторону отрицательных напряжений, т.е. к увеличению положительного заряда в оксиде. Повышение эффективности процесса генерации ловушек на границе раздела SiO2/n-Si можно объяснить инжекцией горячих электронов из подложки n-типа [9, 10]. Действительно, поскольку, согласно [11], пленка SiO2 при облучении становится проводящей, доля напряжения, приложенная к полупроводнику, увеличивается. А деградация полевых транзисторов наблюдалась уже при приложенных к затвору напряжениях порядка нескольких вольт [9, 10]. Генерация неравновесных носителей заряда электронным пучком и их последующая диффузия, и дрейф приводят к тому, что распределение электрических полей в SiO2 может отличаться от сформировавшегося после окончания облучения, что существенно усложняет анализ результатов, особенно результатов с приложенным внешним полем.
Рис. 2.
Изменение C–V-характеристик исследуемой структуры при облучении с напряжением смещения +10, 0, –10 В. а – подложка Si n-типа (доза облучения 100 мкКл/см2); б – подложка Si p-типа (доза облучения 6.25 × 10–2 мкКл/см2). Энергия падающего пучка Eb = 10 кэВ.
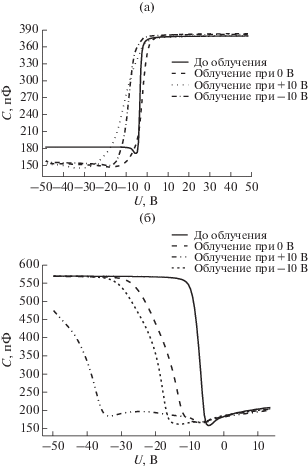
Для исследования стабильности изменения свойств структур в результате облучения низкоэнергетичным электронным пучком, была исследована релаксация C–V-кривых при термическом отжиге. C–V-кривые измерялись после 10 мин изохронного отжига структур, облученных электронами с энергией 10 кэВ дозой 90 мкКл/см2. Как и в случае МДП-структур с подложкой p-типа [5], при температуре 250°C происходило полное восстановление C–V-кривых до исходного состояния, и соответственно происходили как релаксация накопленного объемного заряда, так и отжиг или пассивация образованных при облучении состояний на границе раздела (рис. 3). Похожие температуры отжига наблюдались и в других работах [12, 13]. В то же время для восстановления емкости в режиме инверсии достаточно было отжига при 100°C.
Уменьшение эффективной концентрации доноров (фосфора) в кремнии при облучении электронным пучком можно было бы объяснить его пассивацией водородом. Водород может генерироваться как за счет стимулированной горячими электронами депассивации дефектов на интерфейсе SiO2/Si [14], так и стимулированной электронным пучком диссоциации молекул водорода или воды на границе раздела металл–SiO2 [15, 16]. Атомарный водород легко диффундирует в SiO2 [14] и в кремнии [17], поэтому он вполне может достичь границы раздела SiO2/Si даже при его образовании на поверхности SiO2. Температуры диссоциации пар фосфор–водород также близки к температуре восстановления эффективной концентрации доноров в настоящей работе [18]. Возникает вопрос, почему в наших экспериментах наблюдалась только пассивация водородом фосфора, хотя известно, что водород более эффективно взаимодействует с бором [19]. Одно из объяснений может быть связано с тем, что, как видно на рис. 1б, в структуре SiO2/p-Si в Si образуется инверсный слой, и при облучении концентрация электронов в этом слое возрастает. Поэтому при проникновении водорода в кремний он может заряжаться отрицательно, и тогда электрическое поле будет препятствовать его проникновению вглубь подложки и пассивации бора.
ЗАКЛЮЧЕНИЕ
В работе исследовано влияние облучения электронным пучком c энергией 10 кэВ на вольт-фарадные характеристики МДП-структур Al/SiO2/ n-Si. Показано, что для появления заметного объемного заряда и образования новых центров на границе раздела SiO2/Si доза облучения должна превышать несколько десятков мкКл/см2, в то время как в структурах на основе p-Si влияние облучение заметно уже при дозах порядка 10–2 мкКл/см2. Выявлено понижение эффективной концентрации доноров в результате облучения, которое может свидетельствовать о пассивации фосфора водородом, освободившимся в результате облучения. Отжиг в течение 10 мин при температуре 100°C приводил к восстановлению эффективной концентрации доноров, а после отжига при 250°C наблюдалось полное восстановление C–V-кривых до исходного состояния.
Список литературы
Oldham T.R., McLean F.B. // IEEE Trans. Nucl. Sci. 2003, V. 50. № 3. P. 483. https://doi.org/10.1109/tns.2003.812927
Schwank J.R., Shaneyfelt M.R., Fleetwood D.M., Felix J.A., Dodd P.E., Paillet P., Ferlet-Cavrois V. // IEEE Trans. Nucl. Sci. 2008. V. 55 № 4. P. 1833. https://doi.org/10.1109/tns.2008.2001040
Rau E.I., Fakhfakh S., Andrianov M.V., Evstafeva E.N., Jbara O., Rondot S., Mouze D. // Nucl. Instrum. Methods. Phys. Res. B. 2008. V. 266. P. 719. https://doi.org/10.1016/j.nimb.2007.12.093
Рау Э.И., Евстафьева Е.Н., Андрианов М.В. // ФТТ. 2008. Т. 50. № 4. С. 599.
Vergeles P.S., Kulanchikov Yu.O., Yakimov E.B. // J. Electron. Mater. 2020. V. 49. № 9. P. 5178. https://doi.org/10.1007/s11664-020-08080-3
Куланчиков Ю.О., Вергелес П.С., Якимов Е.Б. // Известия высших учебных заведений. Материалы электронной техники. 2019. Т. 22. № 2. С. 112. https://doi.org/10.17073/1609-3577-2019-2-111-116
Brown D.B., Saks N.S. // J. Appl. Phys. 1991. V. 70. P. 3734. https://doi.org/10.1063/1.349226
Sedlovets D.M., Knyazev M.A., Trofimov O.V., Koveshnikov S.V. // Fullerenes, Nanotubes and Carbon Nanostructures. 2020. V. 28. P. 309. https://doi.org/10.1080/1536383X.2019.1708731
Vuillaume D., Bravaix A., Goguenheim D. // Microel. Reliab. 1998. V. 38. P. 7. https://doi.org/10.1016/S0026-2714(97)00179-0
Cho M., Roussel P., Kaczer B., Degraeve R., Franco J., Aoulaiche M., Chiarella T., Kauerauf T., Horiguchi N., Groeseneken G. // IEEE Trans. Electron Dev. 2013. V. 60. P. 4002. https://doi.org/10.1109/TED.2013.2285245
Борисов С.С., Вергелес П.С., Якимов Е.Б. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2010. Т. 9. С. 62.
Lelis A.J., Oldham T.R., Boesch H.E. Jr, McLean F.B. // IEEE Trans. Nucl. Sci. 1989. V. 36. P. 1808. https://doi.org/10.1109/23.45373
Zhang J., Pintilie I., Fretwurst E., Klanner R., Perrey H., Schwandt J. // J. Synchrotron Rad. 2012. V. 19. P. 340. https://doi.org/10.1107/S0909049512002348
Tuttle B.R., Mcmahon W., Hess K. // Superlattices and Microstructures. 2000. V. 27. № 2/3. P. 229. https://doi.org/10.1006/spmi.1999.0804
Феклисова О.В., Якимов Е.Б., Ярыкин Н.А. // ФТП. 1994. Т. 28. С. 2179.
Feklisova O.V., Yakimov E.B., Yarykin N.A. // Mater. Science & Engineering B. 1996. V. 42. P. 274. https://doi.org/10.1016/S0921-5107(96)01953-8
Феклисова О.В., Якимов Е.Б., Ярыкин Н.А. // ФТП. 2002. Т. 36. № 3. С. 301.
Fukata N., Sasaki S., Fujimura S., Haneda H., Murakami K. // Jpn. J. Appl. Phys. 1996. V. 35. P. 3937. https://doi.org/10.1143/JJAP.35.3937
Weber J., Knack S., Feklisova O.V., Yarykin N.A. Yakimov E.B. // Microelectronic Engineering. 2003. V. 66. P. 320. https://doi.org/10.1016/S0167-9317(02)00926-7
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования