Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2021, № 12, стр. 40-46
Исследование гетероструктур GaInAsP/InP с массивом наноостровков InAs
Д. Л. Алфимова a, М. Л. Лунина a, Л. С. Лунин a, b, c, *, А. С. Пащенко a, b, c, О. С. Пащенко a, М. С. Столяров c
a Федеральный исследовательский центр Южный научный центр РАН
344006 Ростов-на-Дону, Россия
b Северо-Кавказский федеральный университет
355017 Ставрополь, Россия
c Южно-Российский государственный политехнический университет (НПИ)
им. М.И. Платова
346428 Новочеркасск, Россия
* E-mail: lunin_ls@mail.ru
Поступила в редакцию 17.04.2021
После доработки 25.06.2021
Принята к публикации 30.06.2021
Аннотация
Экспериментально показана возможность выращивания массивов наноостровков InAs на поверхности твердых растворов GaInAsP, изопериодных с подложкой InP, методом зонной перекристаллизации градиентом температуры с импульсным охлаждением и нагреванием. Исследована эволюция морфологии наноостровков InAs на поверхности GaInAsP в зависимости от температуры подложки и градиента температуры, а также от времени кристаллизации. Растровая электронная микроскопия и статистический анализ позволили установить, что наибольшая плотность в массиве наноостровков InAs с размерами 35–50 нм. Выполнены измерения фотолюминесценции и показано, что спектры имеют сложную структуру, а излучательная рекомбинация осуществляется через основные состояния в наностровках InAs. Большая ширина спектра на половине максимума излучения (∆E = 171 мэВ) обусловлена разбросом геометрических размеров наноостровков в массиве. Измерения спектров фоточувствительности показали расширение спектрального диапазона в сторону длинных волн для гетероструктур InAs/GaInAsP/InP по сравнению с GaInAsP/InP.
ВВЕДЕНИЕ
Полупроводниковые гетероструктуры с квантовыми точками привлекают все большее внимание исследователей перспективами создания на их основе новых поколений существующих приборов, например, солнечных батарей третьего поколения с эффективностью более 50%, высокоскоростных фотодетекторов, а также приборов наноэлектроники [1–7].
Для оптоэлектроники приборно-ориентированные гетероструктуры на основе фосфида индия интересны возможностью получения устройств с длиной волны в окнах прозрачности оптического волокна (1.5–1.6 мкм), с рекордным быстродействием и относительно большой шириной пропускания спектра. Следует отметить, что гетероструктуры на основе фосфида индия известны достаточно давно. В последние пять лет большой интерес исследователей в мире привлекают наногетероструктуры InAs/InP с квантовыми точками в активной области. Актуальность обусловлена возможностью получить лазеры с длиной волны 1.5–1.6 мкм с настройкой по спектру [8–12] и фотодетекторы [13–15] для телекоммуникационных сетей. Такие наногетероструктуры получают методами молекулярно-лучевой и МОС-гидридной эпитаксии (МОС – металлорганические соединения) [16–18]. На данный момент известно о выращивании указанными методами следующих структур в системе InAs/InP: квантовых точек (наноостровков) [8–16, 19], квантовых нитей [20–24] и квантовых штрихов [17, 25–28]. Как правило, рост осуществляется по механизму Странского–Крастанова, когда наноостровки образуются после формирования смачивающего слоя [8–16]. Теоретически исследован трехмерный рост наноостровков в гетеросистеме InAs/InP без смачивающего слоя [29]. Показано, что в реальных структурах это может подавить расщепление оптически активных экситонных состояний. Однако этот нетривиальный эффект, связанный с удлинением формы, сильно уменьшается из-за случайности сплава в результате смешивания материала квантовых точек InAs с окружающей матрицей InP. Отмечается тенденция к применению твердых растворов InAsSb [17], AlInAs [30], InGaAsP [31] в гетеросистеме InAs/InP. Основной причиной является поиск механизмов снижения упругих напряжений и способов изменения морфологии наноструктур InAs для контроля латерального размера, высоты и плотности массива, что на практике позволяет управлять спектром излучения или поглощения гетероструктур [8, 31].
В настоящей работе предлагается исследовать наноструктуры GaInAsP/InP, содержащие массив наноостровков InAs. Отличие этого исследования от [31] заключается в том, что предлагается выращивать наноостровки InAs на поверхности твердого раствора GaInAsP без выращивания переходных слоев GaP для согласования с подложкой InP, а синтез твердого раствора и наноостровков осуществлять из жидкой фазы. Преимущество многокомпонентных твердых растворов перед бинарными соединениями заключается в возможности управления параметром кристаллической решетки и шириной запрещенной зоны путем подбора изопериодного состава GaInAsP с подложкой InP. Главной проблемой МОС-гидридного метода выращивания является сложность поддержания соотношения компонентов групп V/III [30], выражающаяся в морфологической эволюции системы и появлении нежелательных капель на поверхности. В этой связи интерес может представлять жидкофазная эпитаксия, которая, в принципе, позволяет выращивать квантовые точки [32, 33]. Таким образом, цель настоящей работы заключалась в изучении особенностей формирования массивов наноостровков InAs методом зонной перекристаллизации градиентом температуры (ЗПГТ) на поверхности GaInAsP/InP и исследование эволюции морфологии и спектральных характеристик, выращенных наноструктур.
ЭКСПЕРИМЕНТАЛЬНАЯ ЧАСТЬ
Выращивание гетероструктур GaInAsP/InP с наноостровками InAs осуществлялось методом ЗПГТ с импульсным охлаждением и нагреванием композиции “подложка–(раствор-расплав)–источник” [34–36]. Данный способ является усовершенствованной разновидностью классической жидкофазной эпитаксии. Ниже будет описана суть используемого метода ЗПГТ с импульсным охлаждением и нагреванием. Рост проводили в закрытой системе в потоке очищенного водорода. В качестве жидкой зоны использовали раствор-расплав (In–Ga–As–P), подложки – InP(100), источника подпитки – InAs. Для контроля температуры применяли термопары Pt–Pt + Rh(10%). Термопары помещали между подложкой InP и твердотельным источником InAs. Расстояние между верхней и нижней термопарами, определяющими градиент температуры G, составляло 1 см. Температурный режим задавали с помощью блока управления, позволяющего поддерживать в рабочей зоне печи температуру с точностью ±0.2°С. Температурно-временнáя схема представлена на рис. 1.
За время t1 – t0 печь нагревалась до температуры гомогенизации T1 = 843 К, после чего в течение времени t2 – t1 (2 ч) раствор-расплав (In–Ga–As–P) гомогенизировался. Поскольку выращивание в режиме Странского–Крастанова осуществляется через смачивающий слой [1], то для его получения за время t3 – t2 раствор-расплав охлаждался до температуры T2 = 813 К путем подведения теплопоглотителя на тыльную сторону подложки [37]. Температуру поглотителя выбирали таким образом, чтобы переохлаждение на фронте кристаллизации ∆T не превышало 10 К во избежание гомогенного зародышеобразования в объеме жидкой фазы. Через время τ ≈ 10–2 с, определяющее длительность импульса охлаждения подложки, теплопоглотитель принимает температуру подложки T2. Эпитаксия наноостровков InAs осуществлялась при градиентах температуры от 10 до 50 К/см и при температурах подложки T3 = 853–903 К. Время проведения ЗПГТ t6 – t5 варьировалось в пределах от нуля до 35 мин. Эксперименты по исследованию эволюции наноостровков InAs проводили при фиксированной температуре подложки T = 893 К и градиенте температуры 10 К/см. Во всех экспериментах использовался одинаковый состав твердого раствора Ga0.10In0.90As0.24P0.76.
Исследование морфологии поверхности гетероструктур GaInAsP/InP после осаждения арсенида индия проводили в растровом электронном микроскопе Quanta 200. Высоту наноостровков InAs измеряли в атомно-силовом микроскопе Solver HV. Точность определения размеров наноостровков для зонда HA_NC c радиусом закругления менее 10 нм определяется величиной ${1 \mathord{\left/ {\vphantom {1 {\sqrt h }}} \right. \kern-0em} {\sqrt h }},$ где h – высота объекта. Статистический анализ проводили с использованием программного пакета Image analyses и инструмента Threshold. Фотолюминесценцию гетероструктур исследовали при температуре 300 К в спектральном диапазоне 0.7–1.5 эВ. Источником оптического излучения служил инжекционный лазер с длиной волны 402 нм и мощностью излучения 12.5 мВт. Регистрацию сигнала осуществляли с помощью монохроматора МДР-23 с германиевым фотодиодом ФДГ-3600, рабочий спектральный диапазон которого составляет 0.5–2 мкм. Фотолюминесценцию возбуждали со стороны наноостровков InAs. Защиту входной щели монохроматора от отраженных гармоник возбуждающего лазерного излучения осуществляли с помощью оптического фильтра ЖС-12.
РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
На рис. 2 приведены результаты анализа эволюции морфологии InAs на поверхности GaInAsP/InP. Видно, как изменяется морфология поверхности в зависимости от времени осаждения ростового материала InAs. Данные рис. 2а соответствуют температурно-временнóму режиму t6 – t2 ЗПГТ с импульсным охлаждением и нагреванием (рис. 1). За время импульсного охлаждения τ = = 2 мин на поверхности твердого раствора GaInAsP происходила вынужденная кристаллизация смачивающего слоя. Его осаждение осуществлялось в температурно-временнóм интервале t4 – t3. За промежуток времени t5 – t4 устанавливался градиент температуры, вызывающий процесс растворения источника InAs и его перенос к поверхности слоя GaInAsP (рис. 1, вставка). Во временнóм промежутке t6 – t5 происходил трехмерный островковый рост InAs в соответствии с механизмом Странского–Крастанова.
Рис. 2.
Эволюция морфологии наноостровков InAs в зависимости от времени Δt выращивания методом ЗПГТ с импульсным охлаждением и нагреванием на поверхности GaInAsP/InP: а – 10; б – 35 мин.
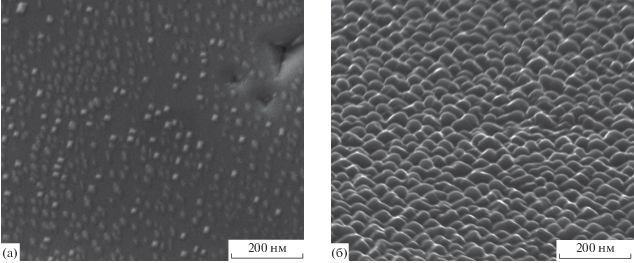
Если по истечении времени t6 – t5 не прекратить осаждение InAs, то процесс роста сопровождается эволюцией морфологии поверхности за счет изменения формы наноостровков и их превращения в крупные кластеры (рис. 2б). Анализ морфологии поверхности InAs показал, что их плотность в условиях выращивания (рис. 2а) достигает 1.26 × 1010 см–2. Статистическое распределение размеров наноостровков, соответствующее условиям выращивания (рис. 2а), приведено на рис. 3. Видно, что наибольшая плотность наноостровков находится в пределах 27–50 нм.
Рис. 3.
Гистограмма статистического распределения размеров наноостровков InAs на поверхности GaInAsP/InP.

На рис. 4 приведены временны́е зависимости формирования наноостровков. Следует отметить, что размер основания d (кривая 1) в течение 7.5 мин увеличивается незначительно, затем наблюдается резкий подъем и незначительный линейный рост после 20 мин. Высота наноостровков (кривая 2) растет линейно со временем. С практической точки зрения важно иметь временнýю зависимость размера наноостровков h/d (кривая 3).
Рис. 4.
Временны́е зависимости эволюции формы наноостровков InAs: d (1); h (2); h/d (3). Т = 893 К, G = 10 К/см.

Следующим этапом было исследование влияния температуры процесса и ее градиента на высоту наноостровков InAs. Исследование проводилось в температурном диапазоне 850–910 К. Результаты приведены на рис. 5. Повышение температуры приводит к нелинейному увеличению высоты наноостровков согласно теории ЗПГТ [34].
Скорость кристаллизации зависит от атомно-кинетических (µ) и диффузионных коэффициентов (D), которые подчиняются экспоненциальной температурной зависимости [33, 34]. Из ранее выполненных экспериментов по жидкофазной эпитаксии и ЗПГТ полупроводниковых соединений AIIIBV известно, что зависимость скорости кристаллизации от градиента температуры линейна аналогично зависимостям µ(G) и D(G). В результате этого на рис. 5б наблюдается линейная зависимость высоты наноостровков от градиента температуры G. При небольших температурах (T < 893 К) и малых градиентах (G < 20 К/см) скорость кристаллизации наноостровков составляет менее 1 мкм/ч. Следует отметить, что при малых скоростях кристаллизации наблюдается малый разброс по размерам и высоте, а также более равномерное расположение на поверхности гетероструктуры.
Для исследования спектральных характеристик гетероструктур GaInAsP/InP с массивом наноостровков InAs были измерены их фотолюминесценция (рис. 6) и спектры фоточувствительности (рис. 7). Спектр фотолюминесценции имеет многопиковую структуру с наиболее ярким максимумом излучения E ≈ 1.0 эВ. Анализ показывает, что этот пик обусловлен процессом рекомбинации через основные состояния в наноостровках InAs. Пик широкий (ширина на половине максимума излучения ∆E = 171 мэВ), его форма определяется в большей степени разбросом геометрических размеров наноостровков, их плотностью и температурой измерения фотолюминесценции. Низкоинтенсивный пик при 1.1 эВ определяется наличием смачивающего слоя.
Рис. 6.
Характерный спектр фотолюминесценции гетероструктур GaInAsP/InP с массивом наноостровков InAs.

Рис. 7.
Спектральные зависимости гетероструктуры: с наноостровками InAs на поверхности Ga0.10In0.90As0.24P0.76/InP (1); Ga0.10In0.90As0.24P0.76/InP (2).

Спектральная зависимость фоточувствительности выращенных гетероструктур GaInAsP/InP с массивом наноостровков InAs представлена на рис. 7 (кривая 1). Для сравнения приведена спектральная характеристика структуры GaInAsP/InP без наноостровков InAs (рис. 7, кривая 2). Видно, что наноостровки InAs поверхности твердого раствора GaInAsP приводят к расширению спектрального диапазона чувствительности за счет образования дополнительных энергетических подзон наноостровками InAs (рис. 7, заштрихованная область).
ЗАКЛЮЧЕНИЕ
Метод зонной перекристаллизации градиентом температуры с использованием импульсного охлаждения–нагревания позволяет получить массивы наноостровков InAs на поверхности твердого раствора GaInAsP, изопериодного с InP. В результате экспериментальных исследований выявлено влияние технологических условий (температуры, ее градиента и продолжительности ростового процесса ЗПГТ с импульсным охлаждением и нагреванием) на эволюцию кристаллизации наноостровков (морфологию поверхности, латеральные размеры, высоту). Установлено, что в гетероструктурах GaInAsP/InP с наноостровками InAs существенно расширяется спектральная чувствительность по сравнению с аналогичной структурой без наноразмерных островков.
Список литературы
Yoffe A.D. // Adv. Phys. 2001. V. 50. № 1. P. 1. https://doi.org/10.1080/00018730010006608
Cuadra L., Marti A., Lopez N., Luque A. Intermediate Band Photovoltaics Overview // 3rd World Conf. on Photovoltaic Energy Conversion. 2003. Osaka: Japan. P. 3.
Lunin L.S., Sysoev I.A., Bavizhev M.D., Kuleshov D.S., Malyavin F.F. // Crystallogr. Rep. 2013. V. 58. P. 509. https://doi.org/10.1134/S1063774513030127
Song H.Z., Hadi M., Zheng Y., Shen B., Zhang L., Ren Z., Gao R., Wang Z.M. // Nanoscale Res. Lett. 2017. V. 12. P. 128. https://doi.org/10.1186/s11671-017-1898-y
Schättiger F., Bauer D., Demsar J., Dekorsy T., Kleinbauer J., Sutter D.H., Puustinen J., Guina M. // Appl. Phys. B. 2012. V. 106. P. 605. https://doi.org/10.1007/s00340-011-4697-7
Nikhil J., Mantu K.H. // Energy Harvesting and Systems. 2014. V. 1. № 3–4. P. 121. https://doi.org/10.1515/ehs-2014-0012
Levin R.V., Marichev A.E., Shvarts M.Z., Marukhina E.P., Khvostikov V.P., Pushnyi B.V., Mizerov M.N., Andreev V.M. // Semiconductors. 2015. V. 49. № 5. P. 700.https://doi.org/10.1134/S1063782615050139
Nechay K., Mereuta A., Paranthoen C., Brévalle G., Levallois C., Alouini M., Chevalier N., Perrin M., Suruceanu G., Caliman A., Guina M., Kapon E. // Appl. Phys. Lett. 2019. V. 115. № 17. P. 171105. https://doi.org/10.1063/1.5125632
Khanonkin I., Mishra A.K., Karni O., Banyoudeh S., Schnabel F., Sichkovskyi V., Mikhelashvili V., Reithmaier J.P., Eisenstein G. // Phys. Rev. B. 2018. V. 97. P. 241117(R). https://doi.org/10.1103/PhysRevB.97.241117
Holewa P., Gawełczyk M., Ciostek C., Wyborski P., Kadkhodazadeh S., Semenova E., Syperek M. // Phys. Rev. B. 2020. V. 101. P. 195304.https://doi.org/10.1103/PhysRevB.101.195304
Mikhelashvili V., Eyal O., Khanonkin I., Banyoudeh S., Sichkovskyi V., Reithmaier J.P., Eisenstein G. // J. Appl. Phys. 2018. V. 124. P. 054501. https://doi.org/10.1063/1.5037961
Liu L., Liu Yg., Zhang Xm., Liu B., Zhang X. // Optoelectronics Lett. 2020. V. 16. P. 441. https://doi.org/10.1007/s11801-020-0016-z
Jiao Yu., Tilma B.W., Kotani J., Nötzel R., Smit M.K., He S., Bente E.A.J.M. // Opt. Express. 2012. V. 20. № 4. P. 3675. https://doi.org/10.1364/OE.20.003675
Tsao S., Myzaferi A., Razeghi M. // Proceed. SPIE. 2010. V. 7605. P. 76050J. https://doi.org/10.1117/12.846252
Alvarenga D.R., Parra-Murillo C.A., Kawabata R.M.S., Guimaraes P.S.S., Unterrainer K., Pires M.P., Vieira G.S., Villas-Boas J.M., Maialle M.Z., Degani M.H., Farinas P.F., Studart N., Souza P.L. // IEEE J. Quantum Electronics. 2012. V. 48. № 10. P. 1360. https://doi.org/10.1109/JQE.2012.2210539
Hasan S., Merckling C., Pantouvaki M., Meersschaut J., Van Campenhout J., Vandervorst W. // J. Cryst. Growth. 2019. V. 509. P. 133. https://doi.org/10.1016/j.jcrysgro.2018.11.014
Wang D.B., Zhuo N., Luo S., Zhang J.C., Zhai S.Q., Wang L.J., Liu F.Q., Liu J.Q., Liu S.M., Wang Z.G. // J. Nanosci. Nanotechnol. 2018. V. 18. № 11. P. 7387. https://doi.org/10.1166/jnn.2018.16068
ala E.M., Na Y.I., Godsland M., Trapalis A., Heffernan J. // Physica Stat. Solidi. 2020. V. 14. № 8. P. 2000173. 10.1002/pssr.20200017
Liu L., Zhang X.P., Xu T.F., Dai Z.X., Dai S.X., Liu T.J. // Opt. Lett. 2017. V. 42. № 6. P. 1173. https://doi.org/10.1364/OL.42.001173
Gamo H., Tomioka K. // IEEE Electron Device Lett. 2020. V. 41. № 8. P. 1169. https://doi.org/10.1109/LED.2020.3004157
Chen I.J., Limpert S., Metaferia W., Thelander C., Samuelson L., Capasso F., Burke A.M., Linke H. // Nano Lett. 2020. V. 20. № 6. P. 4064. https://doi.org/10.1021/acs.nanolett.9b04873
Zielinski M. // Phys. Rev. B. 2020. V. 101. № 19. P. 195 302. https://doi.org/10.1103/PhysRevB.101.195302
Arif O., Zannier V., Li A., Rossi F., Ercolani D., Beltram F., Sorba L. // Cryst. Growth Design. 2020. V. 20. № 2. P. 1088. https://doi.org/10.1021/acs.cgd.9b01421
Cygorek M., Korkusinski M., Hawrylak P. // Phys. Rev. B. 2020. V. 101. № 7. P. 075307. https://doi.org/10.1103/PhysRevB.101.075307
Dong B., Duan J., Shang C., Huang H., Sawadogo A.B., Jung D., Wan Y., Bowers J.E., Grillot F. // Appl. Phys. Lett. 2019. V. 115. № 9. P. 091101. https://doi.org/10.1063/1.5110768
Alkhazraji E., Alias M.S., Qureshi K.K., Khan M.Z.M. // Opt. Engin. 2020. V. 59. № 9. P. 096102. https://doi.org/10.1117/1.OE.59.9.096102
Mao Y.X., Lu Z.G., Liu J.R., Poole P.J., Liu G.C. // J. Lightwave Technol. 2020. V. 38. № 17. P. 4787. https://doi.org/10.1109/JLT.2020.2996424
Alkhazraji E., Ragheb A., Tareq Q., Esmail M.A., Fathallah H., Alshebeili S., Khan M.Z.M. // Opt. Commun. 2019. V. 452. P. 355. https://doi.org/10.1016/j.optcom.2019.07.062
Zielinski M. // Sci. Rep. 2020. V. 10. № 1. P. 13542. https://doi.org/10.1038/s41598-020-70156-1
Gocalinska A.M., Mura E.E., Manganaro M., Juska G., Dimastrodonato V., Thomas K., Zangwill A., Vvedensky D.D., Pelucchi E. // Phys. Rev. B. V. 101. № 16. P. 165310. https://doi.org/10.1103/PhysRevB.101.165310
Huang F.J., Xiong Y.L., Zhang X.P. // J. Appl. Phys. 2020. V. 127. № 12. P. 125702. https://doi.org/10.1063/1.5132965
Марончук И.Е., Кулюткина Т.Ф., Марончук И.И., Быковский С.Ю. // Nanosystems, Nanomater., Nanotechnol. 2012. V. 10. № 1. P. 77.
Sokura L.A., Parkhomenko Y.A., Moiseev K.D., Nevedomsky V.N., Bert N.A. // Semiconductors. 2017. V. 51. P. 1101. https://doi.org/10.1134/S1063782617080310
Лозовский В.Н., Лунин Л.С., Попов В.П. Зонная перекристаллизация градиентом температуры полупроводниковых материалов. М.: Металлургия, 1987. 232 с.
Lunina M.L., Lunin L.S., Alfimova D.L., Pashchenko A.S., Danilina E.M., Pashchenko O.S. // Thin Solid Films. 2020. V. 711. P. 138 295. https://doi.org/10.1016/j.tsf.2020.138295
Кулюткина Т.Ф., Марончук И.Е., Шорохов А.В. // Письма в журн. тех. физики. 1995. Т. 21. № 20. С. 1.
Blagin A.V., Barannik A.A., Lunin L.S., Lunina M.L., Maronchuk I.E., Kulyutkina T.F. // Inorg. Mater. 2009. V. 45. № 12. P. 1326. https://doi.org/10.1134/S0020168509120024
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования