Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2021, № 3, стр. 57-60
Энергетическая и температурная зависимость вторичной ионной эмиссии кластеров GaN/SiC при бомбардировке ионами цезия
Б. Г. Атабаев a, Р. Джаббарганов a, М. Х. Ахмаджонова b, К. У. Назаркулова b, *
a Институт ионно-плазменных и лазерных технологий академии наук Республики Узбекистан
100125 Ташкент, Республика Узбекистан
b Институт общей и неорганической химии академии наук Республики Узбекистан
100170 Ташкент, Республика Узбекистан
* E-mail: karamatn@mail.ru
Поступила в редакцию 10.04.2020
После доработки 27.07.2020
Принята к публикации 30.07.2020
Аннотация
Методом вторичной ионной масс-спектрометрии исследована эмиссия отрицательных ионов кластеров галлия, нитрида галлия и легирующих примесей GaN/SiC в зависимости от энергии бомбардирующих ионов цезия, а также от температуры подложки. Показано, что эмиссия отрицательных ионов кластеров экспоненциально зависит от энергии бомбардирующих ионов в пороговой области распыления, что подтверждает рекомбинационный механизм распыления кластеров в этой области энергии. Кластеризация галлия свидетельствует об образовании дивакансий в нитриде галлия в процессе легирования. Результаты исследования зависимости выхода атомарных и кластерных ионов от температуры нитрида галлия при бомбардировке ионами Cs+ показывают, что происходит совместная сегрегация примесей углерода и кислорода.
ВВЕДЕНИЕ
Экспериментальное исследование кластерного распыления широкозонного полупроводника нитрида галлия актуально для создания новых моделей эмиссии кластеров и разработки технологии диффузионного легирования. В литературе отсутствуют экспериментальные данные об изучении коэффициента распыления нитрида галлия в области пороговой энергии распыления, за исключением [1], где методом молекулярно-динамического моделирования изучены коэффициенты распыления поликристаллов BN, AlN и GaN со структурой вюрцита в зависимости от массы бомбардирующих ионов в области энергии 200–2000 эВ.
Фотоэлектронные спектры анионных кластеров галлия, в которых число атомов больше шести, указывают на изменения в структуре от плоской до трехмерной [2]. В [3] проведено экспериментальное и теоретическое исследование структуры и электронных свойств трехмерных, легированных азотом кластерных анионов галлия GaxNy, x = = 4–12, y = 1 и x = 7–12, y = 2. Это позволило авторам провести идентификацию изомеров, присутствующих в пучках, для конкретных кластерных анионов GaxN (x = 4–7). Отмечено также существование необычных, обогащенных галлием кластеров.
Положительные кластерные ионы цезия использовали для повышения чувствительности элементного анализа примесей методом вторичной ионной масс-спектрометрии в нитриде галлия [4, 5]. Разработанная модель [4] учитывает рекомбинацию независимо распыленных атомов Cs и М на очень малом расстоянии от поверхности в поле поверхностных диполей. Процесс формирования молекул, как предполагается в [3], протекает раньше, чем процесс их ионизации.
В [6] изучены структуры и стабильность малых (мономер, димер и тример) нейтральных и ионизированных кластеров AlN, GaN и InN. Избыток азота или металла трехатомных кластеров формирует минимальные энергетические, приблизительно линейные конфигурации. Наиболее стабильные изомеры Al2N2 и Ga2N2 представляют собой ромб с синглетным спиновым состоянием, хотя In2N2 по прогнозам не будет устойчив в отношении к диссоциации на In2 и N2. Сильное доминирование связей N–N на границе металл–азот и металл–металл управляет структурными скелетами и химическим составом этих кластеров.
В [7] показано, что плоские треугольные и прямоугольные структуры являются общими минимумами для Ga3 и Ga4, соответственно, в то время как общие минимумы для Ga5 и Ga6 представляют собой низкоспиновые и неплоские структуры. В работе определено сродство к электрону 1.51 (Ga2), 1.81 (Ga3), 2.14 (Ga4), 2.27 (Ga5) и 2.31 эВ (Ga6). Начальная энергия диссоциации нейтральных кластеров галлия составила 1.30 (Ga2), 1.58 (Ga3), 1.98 (Ga4), 1.80 (Ga5), 2.29 эВ (Ga6). На основе экспериментальных данных определена энергия диссоциации только для Ga2 (1.10 эВ). В [8] теоретически исследованы сродство к электрону и потенциал ионизации нанокластеров GaxNy, 6 < x ≈ y > 19.
Обзор экспериментальных и теоретических работ по исследованиям структурных и электронных свойств распыленных кластеров нитрида галлия показывает, что методом фотоэлектронной спектроскопии изучено только их сродство к электрону. Однако исследование энергетического распределения и стабильности распыленных кластеров нитрида галлия не проводилось. Данное обстоятельство обусловливает необходимость исследования энергетического распределения и стабильности распыленных кластеров нитрида галлия с применением метода вторичной ионной масс-спектрометрии.
МЕТОДИКА ЭКСПЕРИМЕНТА
В работе исследована эмиссия отрицательно заряженных кластерных ионов при распылении поверхности GaN ионами цезия, ток первичных ионов составлял 1 мкА/см2. Исследуемый образец GaN n-типа представлял собой эпитаксиальную пленку, нанесенную на подложку карбида кремния. Вакуум составлял ~10–8 мм рт. ст. (безмасляная откачка).
Экспериментальные исследования эмиссии распыленных кластеров проводили на специально разработанной масс-спектрометрической установке, позволяющей получить информацию об особенности вторичной эмиссии отрицательных ионов при бомбардировке мишеней из различных материалов положительными ионами. Выбранный метод дает возможность исследовать во время эксперимента характеристики как ионных, так и нейтральных составляющих распыления. Подробное описание методики вторичной ионной масс-спектрометрии приводится в [9].
РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
Проведен масс-спектрометрический анализ выхода отрицательных ионов в области 0–300 а. е. м. при бомбардировке GaN положительными ионами цезия с энергией 3 кэВ при токе 10–6 А. В масс-спектре обнаружены пики ионов Н, С, О, N, Ga, молекул и различных соединений. Пик ионов O–, соответствующий интенсивности выхода, был максимальный в спектре. После него наблюдался пик адсорбированной примеси CN–. Анализ полученных масс-спектров кластерного распыления нитрида галлия показал, что наблюдаются пики, соответствующие решеточным ионам, т.е. атомарным ионам Ga–, однокомпонентным кластерным ионам ${\text{Ga}}_{2}^{ - },$ ${\text{Ga}}_{3}^{ - },$ ${\text{Ga}}_{4}^{ - }$ двухкомпонентным кластерным ионам GaN–, Ga2N–, Ga3N–, ${\text{G}}{{{\text{a}}}_{3}}{\text{N}}_{2}^{ - },$ Ga4N– и оксидам GaO–, ${\text{GaO}}_{2}^{ - },$ Ga2O–, Ga2NO–, Ga3NO–.
Немалый интерес представляет появление в масс-спектре интенсивных пиков, соответствующих кластерным ионам ${\text{Ga}}_{4}^{ - },$ Ga4N–. Наряду с решеточными молекулярными анионными кластерами GaN–, Ga2N–, ${\text{G}}{{{\text{a}}}_{2}}{\text{N}}_{2}^{ - }$ наблюдаются интенсивные пики димеров, тримеров и тетрамеров галлия. Как известно [10], аномальный выход отрицательных многоатомных ионов при бомбардировке ионами цезия невозможно объяснить только изменением работы выхода поверхности. Особенности образования кластерных ионов при бомбардировке поверхности твердых тел ионами цезия объясняются тем, что при имплантации цезия образуются новые химические связи и увеличивается сродство к электрону кластера за счет поляризации. Обнаружено, что интенсивность выхода однокомпонентных кластерных ионов убывает по мере увеличения их атомной массы. Уменьшение интенсивности выхода ${\text{Ga}}_{3}^{ - }$ по отношению к ${\text{Ga}}_{2}^{ - }$ (разница составляет 2.4 раза) – видимо, проявление некой общей закономерности для однокомпонентных кластерных ионов. Высокая интенсивность распыления анионных кластеров галлия впервые объясняется кластеризацией ростовых дивакансий, декорируемых островками металла.
В работе также экспериментально исследована энергетическая зависимость выхода распыленных атомарных (Ga) и кластерных (GaN, GaN2) ионов при бомбардировке ионами цезия под углом 45° (рис. 1). Из рисунка видно, что порог распыления атомов галлия составляет 200 эВ. Это значение близко к теоретическому порогу согласно компьютерному моделированию распыления GaN ионами аргона [11]. Линейная зависимость распыления отрицательных ионов галлия от энергии бомбардирующих ионов указывает на механизм прямого выбивания (recoiling). Также показано, что пороги эмиссии кластеров GaN и GaN2 одинаковы и составляют 250 эВ. Это значение совпадает с теоретическим порогом распыления атомов галлия и подтверждает очень важный теоретический вывод о кластерном распылении атомов галлия совместно с атомами азота [11]. В работе предложена модель прямого кластерного распыления, согласно которой возрастание интенсивности пиков GaN и GaN2 связано с энергией связи этих кластеров, т.е. с их стабильностью. В связи с тем, что кластер GaN2 более стабилен по сравнению с GaN, интенсивность эмиссии GaN2 выше, чем GaN. Кроме того, из рис. 1 видно, что в диапазоне энергии выше 0.5 кэВ выход кластеров GaN, GaN2 слабо зависит от нее, а отношение GaN2/GaN не зависит от энергии бомбардирующих ионов. Этот экспериментальный факт указывает на механизм прямой эмиссии кластеров GaN и GaN2.
Рис. 1.
Энергетические зависимости выхода атомарного и кластерного распыления GaN при бомбардировке ионами Cs+: 1 – Ga–; 2 – ${\text{GaN}}_{2}^{ - };$ 3 – GaN–.
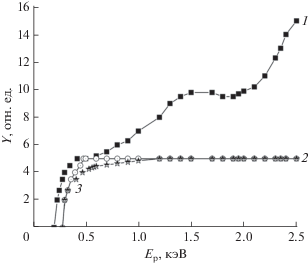
Таким образом, полученные экспериментальные результаты показывают, что в пороговой области энергии бомбардирующих ионов (Е0 < 500 эВ) распыление нитрида галлия в виде атомов происходит по механизму прямого выбивания, а кластерное распыление – по рекомбинационному механизму. При повышении энергии бомбардирующих ионов (Е0 > 500 эВ) кластеры распыляются по механизму прямой эмиссии.
В работе был экспериментально исследован выход ионов с поверхности GaN в зависимости от температуры образца. В спектре наблюдались пики адсорбированных примесей и решеточных ионов, содержащихся на поверхности. На рис. 2 изображены температурные зависимости состава адсорбированных примесей на поверхности GaN в диапазоне температур от 100 до 500°С. Из рисунка видно, что выходы отрицательных примесных ионов, таких как NH–, NO– и OH–, слабо зависят от температуры, и высоты пиков 5, 10 и 20 отн. ед. соответственно. Их график имеет вид прямой линии. Однако следует отметить, что выходы NH– постоянны во всем исследованном интервале температур 125–425°С, а выходы NO– и OH– сначала немного увеличиваются (125–225°С), а затем уже достигают насыщения. Выходы примесей H–, ${\text{C}}_{2}^{ - },$ C– и O– также схожи. Все они при повышении температуры немного увеличиваются, а затем достигают насыщения. Выходы H– увеличиваются от 30 отн. ед. при температуре 125°С и повышаются до 60 отн. ед. при 325°С, достигая при этом своего насыщения. И аналогично, ${\text{C}}_{2}^{ - }$ увеличивается от 40 до 50, C– от 50 до 100 отн. ед. соответственно. Выход O– при 125°С составляет 80 отн. ед., увеличивается от 120 отн. ед. при 225°С, а начиная с 325°С выход уменьшается до 100 отн. ед. Выход CN– носит другой характер – на графике температурной зависимости наблюдается минимум при 225°С с выходом на насыщение при 325°С. Выход CNO– уменьшается в два раза до 325°С и далее стабилизируется.
Рис. 2.
Температурные зависимости состава h адсорбированных примесей на поверхности GaN: 1 – O–; 2 – CN–; 3 – C–; 4 – ${\text{C}}_{2}^{ - };$ 5 – H–; 6 – SiN–; 7 – OH–; 8 – NO–; 9 – NH–.

Температурные зависимости основного состава поверхности GaN показали, что выход ${\text{G}}{{{\text{a}}}^{ - }}$ увеличивается до 30 отн. ед. при 225°С и достигает своего насыщения. Кривая выхода Si имеет два экстремума – максимум (50 ед.) при 225°С и минимум (30 ед.) при 325°С. Подобным образом ведет себя пик GaO–. Остальные решеточные N–, GaN–, ${\text{GaN}}_{2}^{ - }$ и примесные B–, ${\text{B}}_{2}^{ - }$ ионы слабо зависят от температуры. Сравнительный анализ температурных зависимостей адсорбированных, решеточных и примесных ионов показывает, что пик Ga– коррелирует с пиками кислорода и углерода. Пик GaO– коррелирует с пиком сегрегирующей примеси кремния. При максимуме кислорода наблюдается минимум CN– и уменьшение пика CNO–, который, в свою очередь, можно идентифицировать как пик SiN–.
Таким образом, на поверхности пленки GaN, выращенной на SiС, наблюдается сегрегация адсорбированных газовых примесей, а не растворенных в объеме примесей из подложки.
ЗАКЛЮЧЕНИЕ
Масс-спектр отрицательных ионов при бомбардировке GaN положительными ионами цезия характеризуется, кроме примесей адсорбированных частиц, наличием большого количества как атомарных ионов, так и однокомпонентных и двухкомпонентных ионных кластеров и оксидов. Особенности образования кластерных ионов при бомбардировке поверхности твердых тел ионами цезия объясняются тем, что при имплантации цезия образуются новые химические связи и увеличивается сродство к электрону кластера за счет поляризации. Образование как однокомпонентных, так и двухкомпонентных отрицательных ионных кластеров описывается механизмом прямой эмиссии. Сравнительный анализ температурных зависимостей выхода адсорбированных, решеточных и примесных ионов нитрида галлия показывает, что пики атомарных и кластерных ионов Ga коррелируют с пиками кислорода и углерода.
Список литературы
Elovikov S.S., Khrustacheva I.K., Mosunova A.S., Yurasova V.E. // Rad. Effects and Defects in Solids. 2003. V. 158. P. 573. https://doi.org/10.1080/1042015031000078297
Cha C.Y., Gantef U.G., Eberhardt W. // J. Chem. Phys. 1994. V. 100. P. 995. https://doi.org/10.1063/1.466582
Wang H., Ko Y.J., Bowen K.H., Sergeeva A.P., Averkiev B.B., Boldyrev A.I. // J. Phys. Chem. A. 2010. V. 114. P. 11 070. https://doi.org/10.1021/jp101419b
Kudriavtsev Yu., Villegas A., Godines A., Asomoza R. // Appl. Surf. Sci. 2003. V. 206. P. 187. https://doi.org/10.1016/S0169-4332(02)01212-6
Chu P.K., Gao Y., Erickson J.W. // J. Vac. Sci. Technol. B. 1998. V. 16. P. 197. https://doi.org/10.1116/1.589777
Kandalam A.K., Pande R., Blanco M.A., Costales A., Recio J.M., Newsam J.M.// J. Phys. Chem. B. 2000. V. 104. P. 4361. https://doi.org/10.1021/jp994308s
Zhao Y., Xu W., Li Q., Xie Y., Schaefer H.F. // J. Phys. Chem. A. 2004. V. 108. P. 7448.
Peres-Angel E.C., Seminario J.M. // J. Phys. Chem. C. 2011. V. 115. P. 6467. https://doi.org/10.1021/jp201004w
Джаббарганов Р., Атабаев Б.Г., Исаханов З.А., Шаропов У.Б. // Поверхность. Рентген., сихротр. и нейтрон. исслед. 2019. № 7. С. 87. https://doi.org/10.1134/S1027451019040049
Abdullaeva M.K., Atabaev B.G., Dzabbarganov R. // Nucl. Instrum. Methods Phys. Rev. B. 1991. V. 62. P. 43. https://doi.org/10.1016/0168-583X(91)95925-4
Harafuji K., Kawamura K. // Jpn. J. Appl. Phys. 2008. V. 47. P. 1536. https://doi.org/10.1143/JJAP.47.1536
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования


