Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2022, № 11, стр. 29-38
Диагностика тонких градиентных диэлектрических покрытий с помощью микроскопии поверхностного плазмонного резонанса и метода фантомных изображений
a Научно-технологический центр уникального приборостроения РАН
117342 Москва, Россия
* E-mail: khasanov@ntcup.ru
Поступила в редакцию 29.12.2021
После доработки 10.02.2022
Принята к публикации 10.02.2022
- EDN: JITFYE
- DOI: 10.31857/S1028096022090060
Аннотация
Рассмотрено применение метода микроскопии поверхностного плазмонного резонанса для непрерывного во времени неразрушающего контроля тонких диэлектрических покрытий в процессе их изготовления. Высокая, по сравнению с другими фотометрическими методами, чувствительность метода и непрерывный во времени оптический контроль позволяют однозначно восстанавливать профили оптических констант в зависимости от толщины для многослойных и градиентных диэлектрических покрытий. Адаптация метода фантомных изображений к микроскопии поверхностного плазмонного резонанса дает возможность измерять коэффициенты отражения локально для каждой точки поверхности, что позволяет восстанавливать пространственное распределение оптических констант для планарных оптических элементов. Работа метода описана на примере модели плазмонной линзы Люнеберга. Представлена одна из возможных схем внедрения в производство предложенного метода для магнетронного напыления. Продемонстрировано на примерах превосходство на два порядка в чувствительности метода поверхностного плазмонного резонанса над спектрорефлектометрией в случае оптической характеризации ультратонких диэлектрических пленок при их росте по толщине, а также в случае взаимной диффузии диэлектрических слоев. Исходные коды результатов моделирования на языке Python опубликованы в github-репозитарии автора. Описанный подход оптического контроля применим как в видимом, так и в ИК-диапазоне спектра электромагнитного излучения.
ВВЕДЕНИЕ
Общая тенденция к миниатюризации при производстве электроники стимулировала развитие нанотехнологий, то есть технологий производства компонентов размерами меньше длины волны видимого света. Возможность манипулировать структурой вещества (с параметрами d $ \ll $ λ) позволила создавать функциональные материалы, обладающие уникальными оптическими свойствами, не встречающимися в природе. Такие материалы, известные как метаматериалы, позволяют эффективно управлять светом на наномасштабах [1]. Это важно, так как по мере уменьшения электронных компонентов, например, транзисторов, согласно закону Мура [2], до достижения ими физических ограничений размерами атомов, потребуется совершить переход к оптическим вычислительным устройствам [3]. Учитывая, что для массового производства требуются технологии изготовления планарных оптических элементов, важное значение приобретают методы особого раздела фотоники – плазмоники, позволяющие управлять светом на поверхности границы раздела металл–диэлектрик [4, 5]. Для фотоники повышенный интерес представляет особый класс метаматериалов – градиентные материалы [6], оптические константы которых могут принимать различные значения в зависимости от области образца. В плазмонике градиентные метаматериалы представляют собой тонкие градиентные пленки на металлических подложках, что позволяет реализовать множество интересных физических эффектов, таких как невидимость [7], нелокальная дисперсия [8], резонансное туннелирование поверхностных электромагнитных волн для эффективной передачи энергии [9] и др. В связи с развитием градиентных метаматериалов особенно актуальными стали исследования в области трансформационной оптики [10, 11]. Также их можно использовать при осуществлении оптической маршрутизации в оптических и квантовых компьютерах нового поколения [12, 13]. Однако технологии изготовления градиентных пленок еще находятся на исследовательской стадии развития. Одним из способов их изготовления являются методы создания многослойных покрытий с пошаговым изменением эффективного показателя преломления, например, за счет изменений состава ионов газа при магнетронном напылении [14]. Этот процесс зависит от многих факторов и требует постоянного управления, поэтому на практике необходимо непрерывно контролировать процесс изготовления многослойных покрытий для достижения желаемых оптических свойств. Удобно оперировать не моделью непрерывного градиента, а ее кусочно-линейной аппроксимацией, рассматривая слои толщиной намного меньше длины волны [15] (здесь и далее имеются в виду λ ИК и видимого излучения). В таком случае численные результаты для модели многослойной пленки неотличимы от результатов аналитической модели градиентной пленки [16]. Таким образом, важными для развития как плазмоники, так и нанотехнологий в целом, становятся методы надежного определения оптических констант для многослойных покрытий как в процессе, так и после их изготовления.
ТЕОРЕТИЧЕСКИЙ АНАЛИЗ
В настоящий момент для неразрушающего контроля тонких пленок применяют рентгеновскую рефлектометрию [17] и спектрофотометрические методы [18]. Однако использование “жесткого” рентгеновского излучения достаточно трудно для внедрения в существующее производство, в том числе из-за небезопасности для здоровья человека. Тогда как стандартные оптические спектрофотометрические техники не применимы для ультратонких пленок, так как толщина отдельных переходных слоев много меньше длины волны, используемой в методе исследования. В таком случае измеренные методом рефлектометрии коэффициенты отражения R (либо пропускания T) тонкой градиентной пленки не отличаются от R однородной пленки [16]. То же относится и к интерференционным отражающим методам [19]. Так предпочтительным является использование поверхностных электромагнитных волн (ПЭВ). Амплитуда напряженности электрического поля ПЭВ на границе раздела металл–диэлектрик может быть на несколько порядков выше, чем в распространяющихся в объеме волнах [20]. А поскольку ПЭВ очень чувствительны к свойствам поверхности, зондирование методом поверхностного плазмонного резонанса (ППР) может быть эффективным методом неразрушающего контроля при изготовлении градиентных тонких пленок.
Для возбуждения ППР требуется p-поляризованный свет, падающий под углом, превышающим угол полного внутреннего отражения на границе раздела между полубесконечными (по сравнению с тонкой пленкой) средами. Самыми простыми и наиболее известными методами возбуждения ППР являются схемы призменного ввода в геометриях Кречмана [21, 22] или Отто [23, 24]. Существует несколько известных режимов сканирования для получения информации о коэффициенте отражения: по углу θ; по длине волны λ; а также, в случае схемы Отто, по размеру воздушного зазора [25]. Наиболее часто используют угловое сканирование. Этот режим позволяет определить резонансный угол, по которому, в случае однородного слоя, можно легко вычислить оптические константы диэлектрика.
Для расчета формы резонансной кривой многослойной структуры, используем вывод, основанный на матричном формализме [26]. На границе раздела каждого слоя световые потоки отражаются с коэффициентами ${{r}_{i}}$ согласно уравнениям Френеля:
(1)
${{r}_{i}} = \frac{{k_{z}^{i}{{\varepsilon }_{{i{\kern 1pt} + {\kern 1pt} 1}}} - k_{z}^{{i{\kern 1pt} + {\kern 1pt} 1}}{{\varepsilon }_{i}}}}{{k_{z}^{i}{{\varepsilon }_{{i{\kern 1pt} + {\kern 1pt} 1}}} + k_{z}^{{i{\kern 1pt} + {\kern 1pt} 1}}{{\varepsilon }_{i}}}},$Потоки излучения на границе между i-м слоем и (i + 1)-м слоем связаны с помощью характеристической матрицы Bi:
(2)
$\left( {\begin{array}{*{20}{c}} {{{v}_{i}}} \\ {{{w}_{i}}} \end{array}} \right) = {{B}_{i}}\left( {\begin{array}{*{20}{c}} {{{v}_{{i{\kern 1pt} + {\kern 1pt} 1}}}} \\ {{{w}_{{i{\kern 1pt} + {\kern 1pt} 1}}}} \end{array}} \right),$(3)
$~{{B}_{i}} = \left( {\begin{array}{*{20}{c}} {\frac{{{\text{exp}}\left( { - Ik_{z}^{i}{{d}_{i}}} \right)}}{{1 - {{r}_{i}}}}}&{\frac{{{{r}_{i}}{\text{exp}}\left( { - Ik_{z}^{i}{{d}_{i}}} \right)}}{{1 - {{r}_{i}}}}} \\ {\frac{{{{r}_{i}}{\text{exp}}\left( {Ik_{z}^{i}{{d}_{i}}} \right)}}{{1 - {{r}_{i}}}}}&{\frac{{{\text{exp}}\left( {Ik_{z}^{i}{{d}_{i}}} \right)}}{{1 - {{r}_{i}}}}} \end{array}} \right)~,$При i = 0
(4)
$~{{B}_{0}} = \left( {\begin{array}{*{20}{c}} {\frac{1}{{1 - {{r}_{0}}}}}&{\frac{{{{r}_{0}}}}{{1 - {{r}_{0}}}}} \\ {\frac{{{{r}_{0}}}}{{1 - {{r}_{0}}}}}&{\frac{1}{{1 - {{r}_{0}}}}} \end{array}} \right).$(5)
$\left( {\begin{array}{*{20}{c}} {{{v}_{0}}} \\ {{{w}_{0}}} \end{array}} \right) = \prod\limits_{i{\kern 1pt} = {\kern 1pt} 0}^N {{{B}_{i}}\left( {\begin{array}{*{20}{c}} {{{v}_{{N{\kern 1pt} + {\kern 1pt} 1}}}} \\ {{{w}_{{N{\kern 1pt} + {\kern 1pt} 1}}}} \end{array}} \right)} {\kern 1pt} .$(6)
$R = {{\left( {{{\left| {{{B}_{{21}}}} \right|} \mathord{\left/ {\vphantom {{\left| {{{B}_{{21}}}} \right|} {\left| {{{B}_{{11}}}} \right|}}} \right. \kern-0em} {\left| {{{B}_{{11}}}} \right|}}} \right)}^{2}},$Аналитическая форма полученных уравнений для R чрезвычайно громоздка для прямого математического анализа из-за нелинейного характера взаимодействия между слоями. Чтобы найти показатели преломления каждого слоя, используем метод нелинейной регрессии с целевой функцией $DF{\text{:}}$
(7)
$DF = \sum\limits_{i{\kern 1pt} = {\kern 1pt} 1}^{{{M}_{\theta }}} {\sum\limits_{j{\kern 1pt} = {\kern 1pt} 1}^{{{M}_{\lambda }}} {{{{\left( {R\left( {{{\theta }_{i}},~{{\lambda }_{j}}} \right) - \hat {R}\left( {X,{{\theta }_{i}},{{\lambda }_{j}}} \right)} \right)}}^{2}}} } ~,$Основной проблемой при минимизации многомерных функций является большее число переменных, что затрудняет и затягивает поиск решения [27]. Для снижения их числа можно использовать метод последовательных приближений от модели однослойной пленки к многослойной [28]. Однако для нахождения однозначного решения требуется проводить совместно как угловые, так и спектральные измерения. Это трудно реализуемо в реальном времени в процессе изготовления пленки. В таком случае более надежным способом является выбор правильных начальных приближений и сужение области возможных значений параметров градиентной пленки (например, таких как толщина и глубина взаимной диффузии) [29]. Тогда в процессе формирования пленки проводят непрерывные измерения, что вместе со знанием стадий процесса изготовления (например, изменения состава газа) позволяет отслеживать изменения в пленке, начиная от непокрытой металлической поверхности, последовательно учитывая напыление каждого следующего слоя.
Коэффициент отражения от границы раздела металл–диэлектрик в случае поверхностного резонанса, а также для тонких диэлектрических пленок, может быть описан в рамках уравнений Френеля. Хотя для пленок с градиентным коэффициентом преломления уравнения могут быть решены аналитически, однако подобрать решение для произвольной тонкой градиентной пленки не представляется возможным. Более общим подходом является численная аппроксимация градиентной пленки дискретной “многослойной” моделью.
Кроме того, можно сочетать детальные измерения спектральных и угловых распределений коэффициентов отражения, проводимые для одной точки поверхности, для нахождения корректного вида градиентного профиля. Затем для прилежащих точек проводить измерения только на некоторых выделенных значениях углов и длинах волн, используя в качестве начального приближения для алгоритма многомерной регрессии найденное решение для исходной точки (таким образом распространяя начальные приближения далее по аналогии с принципом Гюйгенса для распространения волны).
Для неразрушающего контроля всей поверхности необходимо прибегнуть к методу микроскопии ППР. Однако существующие методы ближнепольного сканирования не предназначены для применения в процессе производства. Для этого требуется широкопольная микроскопия ППР. Ее достаточно просто можно внедрить в существующее производство, например, как представлено на рис. 1. Но широкопольная микроскопия ППР обладает низким латеральным разрешением в области электромагнитных частот вдали от плазменной частоты металла на поверхности [30, 31]. Это является большим недостатком метода, особенно для диапазонов длинных волн, таких как инфракрасный и терагерцовый. Однако адаптация метода фантомных изображений к микроскопии ППР позволяет существенно повысить латеральное разрешение при сохранении общей чувствительности [32].
Рис. 1.
Оптическая схема двухплечевого фантомного плазмон-поляритонного микроскопа: 1 – транслятор; 2 – магнетронная установка; 3 – рассеиватель света, предназначенный для модуляции излучения с помощью шероховатой поверхности; 4 – поляризатор, пропускающий p-поляризованное (относительно поверхности призм) излучение; 5 – апертура; 6 – неполяризующий светоделитель пучка; 7 – направления напыления; 8 – лазер; 9 – входное окно; 10 – поле поверхностного плазмон-поляритона после возбуждения; 11 – равнобедренная призма, на основание которой напыляется тонкая пленка внутри магнетрона; 12 – выходное окно; 13 – линза; 14 – многопиксельная камера; 15 – вычислительное устройство для расчета корреляции между сигналами камеры 14 и приемника 16 – однопиксельного детектора.

При использовании метода фантомных изображений (ghost imaging, GI, фантомное видение, призрачная визуализация) изображение объекта формируется в результате интерференции второго порядка, т.е. из взаимной корреляционной функции интенсивностей излучения, взаимодействовавшего и не взаимодействовавшего с объектом. Это позволяет исключить фазовые искажения, которые возникают при формировании изображения в результате фазовой интерференции (первого порядка) [33]. В микроскопии ППР эти искажения обусловлены распространением вдоль границы раздела поверхностной волны от места ее возбуждения и ее последующим переизлучением (конверсией) в виде паразитной засветки внутри призмы (рис. 2).
Рис. 2.
Схема механизма возбуждения поверхностных плазмон-поляритонов (ППП) в геометрии Кречманна: поверхностный плазмон-поляритон распространяется из точки возбуждения ПЭВ в случайную точку, где происходит переизлучение (конверсия): ${{I}_{i}}$ – падающее излучение, ${{I}_{r}}$ – отраженное излучение, ${{I}_{s}}~$ – рассеянное (переизлученное) излучение от поверхностного плазмон-поляритона. Номерами обозначены различные среды: 0 – призма, 1 – металл, 2 – диэлектрик, 3 – воздух.
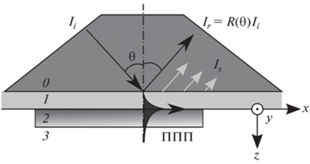
Кроме того, ПЭВ, возбуждаемые из различных точек поверхности, при распространении могут интерферировать между собой как на самой поверхности, так и в ближнем поле возле нее [34], тем самым значительно усложняя анализ изображения поверхности. В микроскопии ППР с использованием фантомных изображений исследуемую поверхность освещают серией пространственно-модулированных интерференционных картин. Например, это может быть так называемый псевдотепловой источник света, то есть серия спекл-картин – случайных картин интерференции рассеянного на неоднородностях когерентного света [35]. Микроскопия с использованием псевдослучайных источников в настоящий момент является областью активной разработки, которая в перспективе может позволить заменить сложные оптические микроскопы [36]. На практике в настоящее время часто используют спекл-картины, сформированные специальными устройствами – пространственными модуляторами света [37].
Для восстановления изображения методом фантомных изображений необходимо рассчитать функцию корреляции второго порядка g2. Рассмотрим самый простой способ получения фантомного изображения с помощью приближенной функции:
(8)
$GI\left( {x,y} \right) \propto \sum\limits_{i{\kern 1pt} = {\kern 1pt} 1}^N {\left( {{{S}_{i}} - \left\langle S \right\rangle } \right)\left( {P{{{\left( {x,y} \right)}}_{i}} - \left\langle {P\left( {x,y} \right)} \right\rangle } \right)} ,$Можно показать, что в случае микроскопии ППР фантомное изображение не зависит от паразитного сигнала. Из рис. 2 следует, что общий отраженный сигнал Si состоит из вкладов отраженного света в точке возбуждения ПЭВ ${{S}_{{{{o}_{i}}}}}~$ и переизлученного сигнала ПЭВ из соседних областей ${{S}_{{{{c}_{i}}}}}.$ Учитывая, что переизлученный сигнал ${{I}_{s}}{{\left( {x,y} \right)}_{i}}$ не коррелирует с картиной освещения $P{{\left( {x,y} \right)}_{i}},$ т.е. $\left\langle {P{{{\left( {x,y} \right)}}_{i}}{{I}_{s}}{{{\left( {x,y} \right)}}_{i}}} \right\rangle $ = $\left\langle {P\left( {x,y} \right)} \right\rangle \left\langle {{{I}_{s}}\left( {x,y} \right)} \right\rangle ,$ получим:
(9)
$\begin{gathered} GI\left( {x,y} \right) \propto \left\langle {P{{{\left( {x,y} \right)}}_{i}}\left( {S{{o}_{i}} + S{{c}_{i}}} \right)} \right\rangle - \\ - \,\,\left\langle {P{{{\left( {x,y} \right)}}_{i}}} \right\rangle \left\langle {S{{o}_{i}} + S{{c}_{i}}} \right\rangle = \\ = \left\langle {P{{{\left( {x,y} \right)}}_{i}}S{{o}_{i}}} \right\rangle - \left\langle {P\left( {x,y} \right)} \right\rangle \left\langle {So} \right\rangle . \\ \end{gathered} $МОДЕЛИРОВАНИЕ
Фантомная микроскопия поверхностного плазмонного резонанса
Для иллюстрации работы фантомной микроскопии ППР в качестве объекта исследования выберем линзу Люнеберга. Линза Люнеберга является примером элемента градиентной оптики, которому найдено важное применение в качестве основного компонента фазированных антенных решеток. Пространственное распределение показателя преломления nL для ее планарного аналога – плазмонной линзы Люнеберга – можно описать с помощью уравнения [44]:
где x, y – координаты на поверхности (в мм), ${{R}_{L}}$ – радиус линзы Люнеберга (1 мм).Для создания спеклов $P{{\left( {x,y} \right)}_{i}}$ необходим лазерный источник, например гелий-неоновый лазер с длиной волны излучения λ = 632.8 нм. Данная длина волны далее будет учтена при выборе оптических констант. Для наблюдения плазмонного резонанса по схеме на рис. 2 в качестве материала призмы выбрано стекло BK7 (n = 1.5151), в качестве металлической пленки был выбран слой золота толщиной 10 нм с комплексной диэлектрической проницаемостью ε = –12.033 + 1.1634I, модель диэлектрика описана, согласно формуле (10).
Наблюдаемой величиной в микроскопии ППР является интенсивность отраженного света ${{I}_{r}}.$ Зная интенсивность источника ${{I}_{i}},$ можно вычислить коэффициент отражения R = ${{{{I}_{r}}} \mathord{\left/ {\vphantom {{{{I}_{r}}} {{{I}_{i}}}}} \right. \kern-0em} {{{I}_{i}}}}.$ Резонансные кривые R для многослойных структур могут быть рассчитаны по формуле (6). Далее для пересчета значений коэффициента отражения R в показатель преломления n выбирают монотонный участок резонансной кривой в диапазоне допустимых значений n для линзы Люнеберга, т.е. от 1 до $\sqrt 2 .$ Для подбора монотонного участка резонансой кривой с наибольшим диапазоном значений по R, выбирают оптимальное значение угла падения излучения на основание призмы θ. В данном примере из анализа рис. 3 был выбран угол θ = 60°.
Рис. 3.
Примеры зависимостей коэффициента отражения R от показателя преломления n тонкой диэлектрической пленки в условиях ППР при разных углах падения θ излучения на основание призмы. Исходные коды, использованные при моделировании изображений, доступны в сети Интернет [55].

Для получения фантомного изображения согласно формуле (8) генерируется N спекл-картин в результате рассеивания излучения лазера на шероховатой поверхности (радиус корреляции 500 мкм, дисперсия высот 500 мкм). Получаемые спекл-картины $P{{\left( {x,y} \right)}_{i}}$ (пространственное распределение освещенности) рассчитаны с помощью Python-библиотеки Diffractio, позволяющей численно с помощью метода быстрого преобразования Фурье рассчитать распространение излучения согласно формуле Релея–Зоммерфельда для электрического поля дифрагирующего света.
Для моделирования сигнала однопиксельного приемника ${{S}_{i}}$ используем в качестве маски для спекл-картины $P{{\left( {x,y} \right)}_{i}}~$ коэффициенты отражения R(x, y) для плазмонной линзы Люнеберга (рис. 4а), считая суммарное (интегральное) значение ${{S}_{i}} = \sum (P{{\left( {x,y} \right)}_{i}}~ \circ R\left( {x,y} \right)),$ где знак “$ \circ $” – поэлементное умножение матриц. Далее полученное согласно формуле (8) фантомное изображение, представляющее собой двумерный массив значений интенсивности от координат, нужно поделить на среднее значение спекл-картин $\left\langle {P\left( {x,y} \right)} \right\rangle $ (средняя освещенность основания призмы) (рис. 4б) для вычисления коэффициента отражения R (рис. 5б). Найденным значениям R нужно сопоставить, используя резонансную кривую (рис. 3), показатели преломления n для диэлектрического покрытия (рис. 5г).
Рис. 4.
Примеры случайного распределения интенсивности света (спекл-картины), наблюдаемые на основании призмы, расположенной на расстоянии 1 м от рассеивателя света: (a) одно из измерений $P{{\left( {x,y} \right)}_{i}};$ (б) среднее значение $\left\langle {P\left( {x,y} \right)} \right\rangle .$ Справа расположена шкала интенсивности в отн. ед.

Рис. 5.
Сравнение модельных (а, в) и восстановленных методом фантомных изображений (б, г) коэффициентов отражения R (а, б) и распределений показателя преломления n (в, г) линзы Люнеберга, изученной методом ППР по схеме Кречмана (длина волны излучения λ = 632.8 нм, угол падения θ = 60°). Число измерений N = 105.

Сравнивая восстановленный профиль (рис. 5г) с моделью (рис. 5в), можно увидеть, что полученное изображение лишь приближенно восстанавливает форму линзы Люнеберга. Это происходит из-за выбранного низкого разрешения изображения по сравнению с размерами спеклов (рис. 4а). Низкое разрешение изображений обусловлено высокими вычислительными затратами на этапе численного моделирования спекл-картин. В реальном эксперименте разрешение изображений определяется используемой камерой. Расхождение в значениях между заданным и восстановленным профилем до 5% обусловлено невысоким контрастом используемых спеклов. Отметим, что чувствительность метода ограничена контрастом получаемых изображений, который в свою очередь зависит от контраста спекл-картин, чувствительности приемника и отсутствия фоновых засветок.
Метод поверхностного плазмонного резонанса
Для сравнительного анализа эффективности метода поверхностного плазмонного резонанса как метода оптического контроля тонких пленок в качестве референтного был выбран спектрорефлектометрический метод. Для исследования тонких пленок его применяют при нормальном угле падения излучения. В случае ультратонких пленок, т.е. когда поглощением в пленке можно пренебречь, можно считать R = 1 – T. Таким образом, как и в случае с методом поверхностного резонанса, измеряемой величиной будет только коэффициент отражения R, который для многослойной модели можно рассчитать по формуле (6). Несмотря на то, что ранее была показана эффективность метода ППР по сравнению с рефлектометрией [45–47], в настоящей работе проведен теоретический анализ некоторых важных для градиентных диэлектрических покрытий случаев: aдгезии первого диэлектрического слоя к металлической подложке, роста толщины пленки и диффузии между тонкими слоями. Так как в методе ППР для измерения коэффициента отражения используют как угловые, так и спектральные измерения, необходимо ввести условную меру, позволяющую сравнивать два этих метода:
(11)
${{R}^{\Delta }} = {\text{max}}\left( {\left| {{{\Delta }}R} \right|} \right) = {\text{max}}\left( {\left| {{{R}_{N}}\left( x \right) - {{R}_{{N{\kern 1pt} + {\kern 1pt} 1}}}\left( x \right)} \right|} \right){\kern 1pt} \left( {\frac{{\Delta {{r}_{y}}}}{{\Delta y}}} \right){\kern 1pt} ,$Мера $~{{R}^{\Delta }}~$ определяет максимальное абсолютное изменение коэффициента отражения R в случае приращения параметра пленки $\Delta y = {{y}_{{N{\kern 1pt} + {\kern 1pt} 1}}} - {{y}_{N}}$ на величину $\Delta {{r}_{y}}$ при измерениях, проводимых сканированием по величине x (которой соответствуют $\lambda $ при спектральном и θ при угловом сканировании). Эта величина показывает, какую минимальную чувствительность необходимо обеспечить при измерениях коэффициента отражения.
При моделировании в качестве вещества для диэлектрической призмы было выбрано стекло BK7, оптические постоянные которого рассчитаны по формуле Селлмейера [48]. Для металлической пленки из золота в видимом диапазоне используем экспериментальные данные [49], в которых учтено поглощение света кристаллической решеткой металлов. В ИК-диапазоне для описания оптических констант металлов хорошо работает приближением Друде [50, 51].
Для моделирования роста толщины диэлектрической пленки в качестве диэлектрического покрытия выбрана пленка оксида кремния [52]. В процессе напыления на чистую поверхность металла диэлектрической пленки толщиной 1 нм (т.е. от 0 до 1 нм), в случае метода ППР (рис. 6) максимальное изменение коэффициента отражения составило приблизительно 13%, тогда как методом рефлектометрии изменений R практически не зафиксировано. Таким образом, очевидна высокая эффективность метода ППР для контроля aдгезии диэлектрического слоя к металлической подложке. Однако, по мере роста толщины пленки, сравнительная эффективность метода ППР падает. Так, согласно результатам, представленным на рис. 6, при приращении толщины диэлектрической пленки с 40 до 41 нм, максимальное изменение коэффициента отражения будет приблизительно равно 1%. То есть в последнем случае потребуется на порядок большая чувствительность приемника или мощность источника излучения. На практике необходимо обеспечить чувствительность измерений R на 1–2 порядка лучше, чем предсказывает ${{R}^{\Delta }}~{\text{.}}$
Рис. 6.
Изменение чувствительности max(ΔR) методов ППР при угловом 1 (при λ = 632.8 нм) и спектральном 2 (при θ = 58°) сканировании и спектрорефлектометрии 3 в процессе увеличения толщины диэлектрического покрытия z.

В качестве примера для описания процесса взаимной диффузии диэлектрических слоев, выбрана модель [53], в которой учтен градиентный переход показателя преломления $n$ между стеклом марки BK7 и стеклом марки Pyrex 7740 [54]:
(12)
$n\left( {\bar {x}} \right) = {{n}_{b}} + \left( {{{n}_{s}} - {{n}_{b}}} \right)ERFC\left( {2\bar {x} - 1} \right),$Для контроля процесса диффузии (рис. 7) потребуется на порядки более высокая чувствительность приемников, чем в случае реализации контроля тонких пленок (рис. 6), так как детектируемые отличия в показателях составляют тысячные доли процента. Но и в этом случае, метод ППР теоретически оказывается эффективнее, чем рефлектометрия.
ЗАКЛЮЧЕНИЕ
Из результатов моделирования можно сделать вывод, что метод ППР является на два порядка более чувствительным по сравнению с традиционной рефлектометрией при характеризации ультратонких ($d \ll \lambda $) диэлектрических пленок. Благодаря крайне высокой чувствительности метода ППР к ультратонким покрытиям, возможно оперативно контролировать процесс адгезии слоeв многослойного покрытия, что может существенно повысить надежность процесса изготовления тонких пленок. Однако, несмотря на это, контроль тонких градиентных переходов, а особенно диффузии между диэлектрическими слоями, требует высокочувствительных приемников, так как мощность излучателя не может быть слишком высокой, чтобы не вызывать локальный перегрев и повреждение наносимой пленки.
Метод ППР особенно чувствителен к слоям, прилегающим к тонкой металлической пленке, что позволяет использовать его для контроля адгезии диэлектрических защитных покрытий. В целях однозначного восстановления многослойных тонких (в том числе градиентных) пленок в процессе их изготовления метод ППР возможно использовать по схеме Кречманна в производственной зоне (например, внутри вакуумной установки с магнетронным напылением) для непрерывного контроля изменений оптических свойств тонкой пленки. Для оперативного контроля за всей рабочей поверхностью возможно применить широкопольную микроскопию ППР. Для корректного восстановления положений тонких структур на двумерной поверхности необходимо использовать метод фантомных изображений. Он также применим для контроля процесса создания тонких градиентных покрытий, включая оптические элементы из градиентных метаматериалов. Это особенно важно для микроскопии ППР в ИК-области частот электромагнитного спектра, где большая длина распространения поверхностных плазмон-поляритонов, не позволяет точно локализовать место порождения поверхностной электромагнитной волны.
Список литературы
Pendry J.B., Schurig D., Smith D.R. // Science. 2006. V. 312. № 5781. P. 1780. https://doi.org./10.1126/science.1125907
Mack C.A. // IEEE Trans. Semicond. Manufact. 2011. V. 24. № 2. P. 202. https://doi.org./10.1109/TSM.2010.2096437
Ozbay E. // Science. 2006. https://doi.org./10.1126/science.1114849
Sarid D., Challener W.A. Modern Introduction to Surface Plasmons: Theory, Mathematica Modeling, and Applications. Cambridge, New York: Cambridge University Press, 2010. P. 371.
Barnes W.L., Dereux A., Ebbesen T.W. // Nature. 2003. V. 424. № 6950. P. 824. https://doi.org./10.1038/nature01937
Shvart︠s︡burg A.B., Maradudin A.A. Waves in Gradient Metamaterials. Singapore: World Scientific, 2013. P. 328.
Alù A., Engheta N. // Phys. Rev. E. 2005. V. 72. № 1. P. 016623. https://doi.org./10.1103/PhysRevE.72.016623
García de Abajo F.J. // J. Phys. Chem. C. 2008. V. 112. № 46. P. 17983. https://doi.org./10.1021/jp807345h
Keller O. // JOSAB. 2001. V. 18. № 2. P. 206. https://doi.org./10.1364/JOSAB.18.000206
Huidobro P.A., Nesterov M.L., Martín-Moreno L., García-Vidal F.J. // Nano Lett. 2010. V. 10. № 6. P. 1985. https://doi.org./10.1021/nl100800c
McCall M., Pendry J.B., Galdi V., Lai Y., Horsley S.A.R., Li J., Zhu J., Mitchell-Thomas R.C., Quevedo-Teruel O., Tassin P., Ginis V., Martini E., Minatti G., Maci S., Ebrahimpouri M., Hao Y., Kinsler P., Gratus J., Lukens J.M., Weiner A.M., Leonhardt U., Smolyaninov I.I., Smolyaninova V.N., Thompson R.T., Wegener M., Kadic M., Cummer S.A. // J. Opt. 2018. V. 20. № 6. P. 063001. https://doi.org./10.1088/2040-8986/aab976
Heeres R.W., Kouwenhoven L.P., Zwiller V. // Nature Nanotech. 2013. V. 8. № 10. P. 719. https://doi.org./10.1038/nnano.2013.150
de Leon N.P., Lukin M.D., Park H. // IEEE J. Select. Topics Quantum Electron. 2012. V. 18. № 6. P. 1781. https://doi.org./10.1109/JSTQE.2012.2197179
Kashkarov E.B., Sidelev D.V., Rombaeva M.R., Kudiiarov V.N., Lomygin A. // MATEC Web Conf. 2019. V. 298. P. 00088. https://doi.org./10.1051/matecconf/201929800088
Abelès F. // Ann. Phys. 1950. V. 12. № 5. P. 596. https://doi.org./10.1051/anphys/195012050596
Stenzel O. The Physics of Thin Film Optical Spectra: An Introduction. Switzerland, Cham: Springer International Publishing, 2016. P. 352. https://doi.org./10.1007/978-3-319-21602-7
Niggemeier U., Lischka K., Plotz W.M., Holy V. // J. Appl. Crystallogr. 1997. V. 30. № 6. P. 905. https://doi.org./10.1107/S0021889897002483
Stenzel O., Ohlídal M. Optical Characterization of Thin Solid Films. Switzerland, Cham: Springer International Publishing, 2018. P. 462.
del Pozo J.M., Díaz L. // Thin Solid Films. 1992. V. 209. № 1. P. 137. https://doi.org./10.1016/0040-6090(92)90023-5
Khasanov I.Sh. // J. Commun. Technol. Electron. 2021. V. 66. № 11. P. 1234. https://doi.org./10.1134/S1064226921100107
Kretschmann E., Raether H. // Z. Naturforschung A. 1968. B. 23. № 12. S. 2135. https://doi.org./10.1515/zna-1968-1247
Raether H. Surface Plasmons on Smooth and Rough Surfaces and on Gratings. Berlin, Heidelberg: Springer, 1988. https://doi.org./10.1007/BFb0048317
Otto A. // Z. Physik. 1968. B. 216. № 4. S. 398. https://doi.org./10.1007/BF01391532
Barchiesi D., Otto A. // Riv. del Nuovo Cim. 2013. V. 36. № 5. P. 173. https://doi.org./10.1393/ncr/i2013-10088-9
Dawson P., Cairns G.F., O’Prey S.M. // Rev. Sci. Instrum. 2000. V. 71. № 11. P. 4208. https://doi.org./10.1063/1.1313803
Byrnes S.J. // arXiv:1603.02720 [physics.comp-ph]. https://doi.org/10.48550/arXiv.1603.02720
Amotchkina T.V., Trubetskov M.K., Pervak V., Romanov B., Tikhonravov A.V. // Appl. Opt. 2012. V. 51. № 22. P. 5543. https://doi.org./10.1364/AO.51.005543
Anisimov A.V., Khasanov I.S. // J. Phys.: Conf. Ser. 2021. V. 2091. № 1. P. 012067. https://doi.org./10.1088/1742-6596/2091/1/012067
Bénédic F., Bruno P., Pigeat Ph. // Appl. Phys. Lett. 2007. V. 90. № 13. P. 134104. https://doi.org./10.1063/1.2717558
Yeatman E.M. // Biosens. Bioelectron. 1996. V. 11. № 6–7. P. 635. https://doi.org./10.1016/0956-5663(96)83298-2
Berger C.E.H., Kooyman R.P.H., Greve J. // Rev. Sci. Instrum. 1994. V. 65. № 9. P. 2829. https://doi.org./10.1063/1.1144623
Khasanov I.Sh., Zykova L.A. // J. Phys.: Conf. Ser. 2020. V. 1636. P. 012039. https://doi.org./10.1088/1742-6596/1636/1/012039
Shi Y. // An Introduction to Quantum Optics: Photon and Biphoton Physics. Boca Raton: CRC Press, Taylor & Francis Group, 2021. P. 1.
Novotny L., Hecht B., Pohl D.W. // J. Appl. Phys. 1997. V. 81. № 4. P. 1798. https://doi.org./10.1063/1.364036
Gatti A., Bache M., Magatti D., Brambilla E., Ferri F., Lugiato L.A. // J. Mod. Opt. 2006. V. 53. № 5–6. P. 739. https://doi.org./10.1080/09500340500147240
Sun Z., Tuitje F., Spielmann C. // J. Microsc. 2021. V. 284. № 1. P. 3. https://doi.org./10.1111/jmi.13048
Edgar M.P., Gibson G.M., Padgett M.J. // Nat. Photonics. 2019. V. 13. № 1. P. 13. https://doi.org./10.1038/s41566-018-0300-7
Katz O., Bromberg Y., Silberberg Y. // Appl. Phys. Lett. 2009. V. 95. № 13. P. 131110. https://doi.org./10.1063/1.3238296
Han S., Yu H., Shen X., Liu H., Gong W., Liu Z. // Appl. Sci. 2018. V. 8. № 8. P. 1379. https://doi.org./10.3390/app8081379
Stern A. Optical Compressive Imaging. Boca Raton: CRC Press, Taylor & Francis, 2017. P. 303.
Ferri F., Magatti D., Lugiato L.A., Gatti A. // Phys. Rev. Lett. 2010. V. 104. № 25. P. 253603. https://doi.org./10.1103/PhysRevLett.104.253603
Liu H.-C., Yang H., Xiong J., Zhang S. // Phys. Rev. Applied. 2019. V. 12. № 3. P. 034019. https://doi.org./10.1103/PhysRevApplied.12.034019
Yang Z., Zhang W.-X., Liu Y.-P., Ruan D., Li J.-L. // Opt. Express. 2020. V. 28. № 3. P. 3607. https://doi.org./10.1364/OE.379293
Zentgraf T., Liu Y., Mikkelsen M.H., Valentine J., Zhang X. // Nature Nanotechnol. 2011. V. 6. № 3. P. 151. https://doi.org./10.1038/nnano.2010.282
Lévesque L., Paton B.E., Payne S.H. // Appl. Opt., AO. 1994. V. 33. № 34. P. 8036. https://doi.org./10.1364/AO.33.008036
Jen Y.-J., Hsieh C.-H., Lo T.-S. // Opt. Commun. 2005. V. 244. № 1–6. P. 269. https://doi.org./10.1016/j.optcom.2004.09.054
Garcia-Ortiz C.E., Cortes R., Orejel R., Hernandez-Aranda R., Martínez-López I., Aguilar F., Coello V. // Opt. Lett. 2018. V. 43. № 4. P. 691. https://doi.org./10.1364/OL.43.000691
SCHOTT (2022) Optical glass data sheets. https://www.schott.com/
Olmon R.L., Slovick B., Johnson T.W., Shelton D., Oh S.-H., Boreman G.D., Raschke M.B. // Phys. Rev. B. 2012. V. 86. № 23. P. 235147. https://doi.org./10.1103/PhysRevB.86.235147
Drude P. // Ann. Phys. 1900. V. 306. № 3. P. 566. https://doi.org./10.1002/andp.19003060312
Li H.Y., Zhou S.M., Li J., Chen Y.L., Wang S.Y., Shen Z.C., Chen L.Y., Liu H., Zhang X.X. // Appl. Opt. 2001. V. 40. № 34. P. 6307. https://doi.org./10.1364/AO.40.006307
Marcos L.V.R., Larruquert J.I., Méndez J.A., Aznárez J.A. // Opt. Mater. Express. 2016. V. 6. № 11. P. 3622. https://doi.org./10.1364/OME.6.003622
Gortych J.E., Hall D.G. // Opt. Lett. 1986. V. 11. № 2. P. 100. https://doi.org./10.1364/OL.11.000100
Kotyczka T., Rogozinski R. Gradient LPWG Structures Based on Pyrex Glass // 15th Conference on Optical Fibers and Their Applications. Lipowy Most, Poland, 2014. P. 92280F. https://doi.org./10.1117/12.2065437
Хасанов И.Ш. Github: Исходные коды к рисункам в статье на языке Python. https://github.com/KhasanovISh/Public
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования