Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2022, № 9, стр. 37-47
Влияние содержания кремния на оптические свойства покрытий Al–Si–N, облученных ионами углерода в режиме короткоимпульсной имплантации
Ф. В. Конусов a, *, С. К. Павлов a, **, А. Л. Лаук a, В. А. Тарбоков a, Г. Е. Ремнев a, Р. М. Гадиров b
a Национальный исследовательский Томский политехнический университет
634050 Томск, Россия
b Томский государственный университет
634050 Томск, Россия
* E-mail: konusov@tpu.ru
** E-mail: lab.sergey@gmail.com
Поступила в редакцию 18.12.2021
После доработки 14.02.2022
Принята к публикации 14.02.2022
- EDN: RPFJRV
- DOI: 10.31857/S1028096022090084
Аннотация
Исследовано влияние короткоимпульсного облучения ионами углерода с энергией 200 кэВ на оптические и электрические свойства пленок нитрида алюминия и покрытий Al–Si–N с переменным атомным составом, осажденных реактивным магнетронным распылением на подложку из кремния. Центры поглощения и люминесценции ассоциированы с ростовыми и радиационными дефектами в нитридах и их простейших комплексах. Изменение свойств при облучении происходит вследствие накопления радиационных дефектов и объединения их в комплексы. Облучение ионами сопровождается интенсивным радиационным и термическим отжигом нестабильных дефектов. Дозовые зависимости характеристик покрытий свидетельствуют об их высокой радиационной стойкости, немного уступающей покрытиям на подложках из стали. Радиационная стойкость покрытий обусловлена ограничивающим влиянием ростовых дефектов на дефектообразование, широкой запрещенной зоной нитридов и взаимодействием дефектов.
ВВЕДЕНИЕ
Использование широкозонных материалов в устройствах твердотельной электроники стимулирует исследования их электронной структуры и изменений свойств до и после воздействия потоков заряженных частиц высокой энергии. Изучение радиационной стойкости материалов, осажденных ионно-плазменными методами, позволяет расширить диапазон их рабочих параметров. В таких исследованиях используют мощное лазерное излучение [1], потоки гамма-излучения и нейтронов [2–4], электронов [3–6], протонов и ионов [4, 7–15]. Для широкозонных оксидов и нитридов характерна высокая радиационная стойкость [2, 7–11, 13, 15]. Нанокомпозитные покрытия Al–Si–N, осажденные методом реактивного магнетронного распыления [16–20], также являются радиационно-стойкими материалами [21]. Особенности оптических свойств таких покрытий приведены в [18–20]. Многослойные покрытия, состоящие из чередующихся слоев нитридов, не уступают по радиационной стойкости Al–Si–N [22]. Оценка радиационной стойкости пленок на массивных подложках из металлов и полупроводников посредством изменения их физических характеристик требует очень высоких доз облучения (флуенс нейтронов и/или ионов не ниже 1017 см–2). Радиационная стойкость покрытий Al–Si–N, нанесенных на сталь, была оценена по радиационной чувствительности их свойств к короткоимпульсному ионному облучению при невысоких дозах (флуенс ионов не более 1016 см–2) [21].
Подобные исследования проведены в настоящей работе на аналогичных покрытиях, нанесенных на подложку из кремния, подробно изучена кинетика дефектообразования. Целью работы было исследование оптических свойств пленок c-AlN и покрытий Al–Si–N, осажденных методом реактивного магнетронного распыления на кремний, до и после короткоимпульсного облучения ионами углерода, а также характеристик энергетических состояний радиационных дефектов, кинетики их накопления и радиационной стойкости покрытий.
МЕТОДИКА ИССЛЕДОВАНИЙ
Пленки нитрида алюминия c-AlN и нанокомпозитные покрытия Al–Si–N осаждали на подложки из монокристаллического кремния методом реактивного магнетронного распыления. Подложки очищали в ультразвуковой ванне с ацетоном и изопропанолом. Пленки c-AlN по результатам растровой электронной микроскопии (РЭМ) имели столбчатую структуру (рис. 1). Концентрации алюминия NAl и кремния NSi в трех разных образцах покрытий по данным энергодисперсионной рентгеновской спектроскопии составили: NAl = 88–90 и NSi = 10–12 мас. % (Al–Si–N90/10); NAl = 70–73 и NSi = 27–30 мас. % (Al–Si–N70/30); NAl = 4–5 и NSi = 95–96 мас. % (Al–Si–N4/96). Покрытия Al–Si–N90/10 и Al–Si–N70/30 имели столбчатую поликристаллическую структуру, несколько отличную от пленок c-AlN, со средним размером областей когерентного рассеяния 75–80 нм, а покрытия Al–Si–N4/96 по данным рентгеноструктурного анализа были аморфными. Толщина пленок d = 1.3–3.2 мкм, рассчитанная по интерференционной картине, не менялась при облучении.
Рис. 1.
РЭМ-изображение поперечных сколов пленок c-AlN (а) и нанокомпозитных покрытий Al–Si–N90/10 (б), Al–Si–N70/30 (в) и Al–Si–N4/96 (г), осажденных методом реактивного магнетронного распыления на подложку из кремния.

Короткоимпульсное облучение покрытий ионами углерода проводили на ускорителе ТЕМП-4М при энергии ионов до 200 кэВ, длительности импульса ~100 нс, плотности тока ~15 А/см2, плотности энергии в импульсе Jp = 0.35 и 0.75 Дж/см2 и количестве импульсов p = 1–6, 60 и 180 [21–23]. Одному импульсу соответствовала доза облучения D = 3 МГр и флуенс ионов Φ = 8.8 × 1012 см–2 при Jp = 0.35 Дж/см2 и доза 7 МГр и Φ = 1.8 × 1013 см–2 при Jp = 0.75 Дж/см2. Расчетная глубина пробега ионов была ~0.3 мкм. Спектры отражения измеряли на спектрометре Avaspec 2048 с рефлектометрической интегрирующей сферой AvaSphere-50-REFL в интервале энергий hν = 1.3–3.6 эВ, наиболее чувствительном к облучению. Спектры коэффициента поглощения α(hν) были рассчитаны по спектрам коэффициента диффузного отражения R(hν) по формуле:
(1)
$\alpha \left( {h\nu } \right) = {{\left( {{1 \mathord{\left/ {\vphantom {1 d}} \right. \kern-0em} d}} \right){{{\left( {1 - R\left( {h\nu } \right)} \right)}}^{2}}} \mathord{\left/ {\vphantom {{\left( {{1 \mathord{\left/ {\vphantom {1 d}} \right. \kern-0em} d}} \right){{{\left( {1 - R\left( {h\nu } \right)} \right)}}^{2}}} {2R\left( {h\nu } \right)}}} \right. \kern-0em} {2R\left( {h\nu } \right)}}.$(2)
$\alpha \left( {h\nu } \right)\infty \,{\text{exp}}\left( {{{h\nu } \mathord{\left/ {\vphantom {{h\nu } {{{E}_{{\text{U}}}}}}} \right. \kern-0em} {{{E}_{{\text{U}}}}}}} \right),$(3)
$\left( {\alpha h\nu } \right)\infty \,{{(h\nu - E_{g}^{{\text{'}}}(E_{g}^{{{\text{''}}}}))}^{m}},$ соответственно. Величину наведенного поглощения оценивали по разностным спектрам
Δα(hν) = αi(hν) – α0(hν), где α0 и αi – коэффициенты поглощения до и после облучения дозой ионов D соответственно. Радиационную стойкость материалов оценивали по величине радиационной
чувствительности S = = Δα/α0, где величины Δα и α0 получены интегрированием спектров Δα(hν) и α0(hν) в интервале 1.3–3.6 эВ. Скорость введения радиационных дефектов определяли по формуле:
соответственно. Величину наведенного поглощения оценивали по разностным спектрам
Δα(hν) = αi(hν) – α0(hν), где α0 и αi – коэффициенты поглощения до и после облучения дозой ионов D соответственно. Радиационную стойкость материалов оценивали по величине радиационной
чувствительности S = = Δα/α0, где величины Δα и α0 получены интегрированием спектров Δα(hν) и α0(hν) в интервале 1.3–3.6 эВ. Скорость введения радиационных дефектов определяли по формуле:
(4)
${{\Delta {{N}_{i}}} \mathord{\left/ {\vphantom {{\Delta {{N}_{i}}} {\Delta \Phi = {{({{N}_{{i2}}} - {{N}_{{i1}}})} \mathord{\left/ {\vphantom {{({{N}_{{i2}}} - {{N}_{{i1}}})} {({{\Phi }_{2}} - {{\Phi }_{1}})}}} \right. \kern-0em} {({{\Phi }_{2}} - {{\Phi }_{1}})}},}}} \right. \kern-0em} {\Delta \Phi = {{({{N}_{{i2}}} - {{N}_{{i1}}})} \mathord{\left/ {\vphantom {{({{N}_{{i2}}} - {{N}_{{i1}}})} {({{\Phi }_{2}} - {{\Phi }_{1}})}}} \right. \kern-0em} {({{\Phi }_{2}} - {{\Phi }_{1}})}},}}$ EU(D) и электропроводности σ(D). Концентрацию ростовых и радиационных дефектов N рассчитывали из спектров поглощения по формуле:
EU(D) и электропроводности σ(D). Концентрацию ростовых и радиационных дефектов N рассчитывали из спектров поглощения по формуле:
(5)
$N = 0.87 \times {{10}^{{17}}}\frac{n}{{{{{\left( {n + 2} \right)}}^{2}}}}{\text{\;}}\frac{\gamma }{f}\alpha _{0}^{'},$РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
Короткоимпульсное ионное облучение материалов неизбежно сопровождается конкурирующими процессами накопления и аннигиляции дефектов, которая происходит за счет быстрого нагрева приповерхностных слоев до высоких температур 1300–1500 К в течение короткого времени 10–6–10–5 с и последующего охлаждения. Максимальная радиационная чувствительность материалов зафиксирована при первом импульсе облучения при Jp = 0.35 Дж/см2 (рис. 2а). Снижение ее величины в интервале доз D = 10–13 МГр указывает на преобладание процесса аннигиляции дефектов над накоплением их концентрации вследствие радиационного и термического отжига. С ростом плотности энергии ионного пучка влияние отжига дефектов усиливается (рис. 2б). Снижение радиационной чувствительности может быть обусловлено нарушением стехиометрии в пользу катионной составляющей соединений, а ее увеличение – формированием наноразмерных включений частиц алюминия и кремния. На второй стадии облучения накопление радиационных дефектов явно преобладает над их аннигиляцией (рис. 2а). Радиационная чувствительность уменьшается с увеличением содержания кремния в покрытиях. Неожиданный рост величины S в образце Al–Si–N4/96 при дозе ионов 200 МГр, наиболее вероятно, обусловлен объединением кремнийсодержащих дефектов в комплексы (рис. 2а, кривая 4).
Рис. 2.
Влияние дозы ионов D на радиационную чувствительность S пленок c-AlN (1) и нанокомпозитных покрытий Al–Si–N90/10 (2), Al–Si–N70/30 (3) и Al–Si–N4/96 (4), осажденных на подложку из кремния. Плотность энергии ионного пучка Jp = 0.35 (а) и 0.75 Дж/см2 (б).

Скорость введения дефектов при небольших дозах облучения (при количестве импульсов p ≤ 3) может иметь отрицательные значения ΔNi/ΔΦ < 0, что свидетельствует о преобладании аннигиляции дефектов над их накоплением. Однако ее величина достигает значительно бόльших значений уже при p > 3, что говорит о переходе от преобладающей аннигиляции дефектов к их накоплению (табл. 1). Влияние радиационного и/или термического отжига, который ограничивает скорость введения дефектов, возрастает с увеличением плотности энергии пучка от Jp = 0.35 до 0.75 Дж/см2. Рост концентрации кремния в покрытиях стимулирует увеличение скорости введения дефектов при небольших дозах облучения D < 20 МГр (рис. 3, кривые 1 и 2). Однако повышение дозы ионов приводит к резкому снижению величин ΔNi/ΔΦ с увеличением NSi, что отражает повышение радиационной стойкости покрытий (рис. 3, кривые 3 и 4; табл. 1).
Таблица 1.
Характеристики покрытий, осажденных методом реактивного магнетронного распыления на подложку из кремния, до и после короткоимпульсного облучения ионами углерода с энергией 200 кэВ
| Тип покрытия | d, мкм | Jp, Дж/см2 | D, МГр | hν0, эВ | N, ×1018, см–3 | ΔNi /ΔΦ см–1 | σ, См |
|---|---|---|---|---|---|---|---|
| c-AlN | 2.5 | 0.35 | 0 | 1.5 ± 0.03 | 4.1 | – | 6 × 10–16 |
| 10 | 1.6 ± 0.03 | 6.4 | 8.8 × 104 | – | |||
| 3.35 ± 0.01 | 1.1 | ||||||
| 20 | 1.85 ± 0.03 | 10 | 5.4 × 105 | 1.0 × 10–15 | |||
| 3.1 ± 0.01 | 3.1 | ||||||
| 600 | 1.9 ± 0.02 | 10 | 1.8 × 103 | 7 × 10–16 | |||
| 2.9 ± 0.01 | 4.2 | ||||||
| 0.75 | 21 | 1.65 ± 0.02 | 2.9 | 1.8 × 104 | – | ||
| 2.5 ± 0.01 | 5.6 | ||||||
| Al–Si–N90/10 | 1.9 | 0.35 | 0 | 1.6 ± 0.02 | 4.8 | – | 5 × 10–15 |
| 20 | 2.2 ± 0.02 | 6.9 | 3.9 × 104 | 6 × 10–15 | |||
| 2.9 ± 0.01 | 6.4 | ||||||
| 600 | 2.4 ± 0.05 | 8.5 | 3.8 × 103 | 2 × 10–14 | |||
| 2.9 ± 0.04 | 9.9 | ||||||
| 0.75 | 21 | 1.65 ± 0.03 | 3.1 | ≤0 | – | ||
| 3.4 ± 0.01 | 1.9 | ||||||
| Al–Si–N70/30 | 2.5 | 0.35 | 0 | 2.15 ± 0.03 | 6.4 | – | 3 × 10–14 |
| 13 | 1.6 ± 0.04 | 2.1 | 2.1 × 105 | 2 × 10–14 | |||
| 2.6 ± 0.02 | 1.9 | ||||||
| 3.4 ± 0.01 | 2.5 | ||||||
| 600 | 1.95 ± 0.02 | 6.0 | 2.2 × 103 | 4 × 10–15 | |||
| 2.95 ± 0.03 | 2.4 | ||||||
| 0.75 | 21 | 1.95 ± 0.05 | 2.9 | 6.1 × 104 | – | ||
| 3.2 ± 0.01 | 6.3 | ||||||
| Al–Si–N4/96 | 2.8 | 0.35 | 0 | 1.6 ± 0.04 | 2.7 | – | 2 × 10–14 |
| 2.5 ± 0.02 | 10 | ||||||
| 13 | 1.6 ± 0.04 | 3.4 | 2.3 × 105 | 3 × 10–14 | |||
| 2.4 ± 0.03 | 5.6 | ||||||
| 600 | 1.9 ± 0.05 | 4.8 | <0 | 1.5 × 10–8 | |||
| 2.9 ± 0.01 | 4.8 | ||||||
| 0.75 | 21 | 1.5 ± 0.04 | 7.4 | 1.7 × 105 | – | ||
| 2.6 ± 0.01 | 3.9 |
Рис. 3.
Влияние концентрации кремния NSi в покрытиях на скорость введения радиационных дефектов ΔNi/ΔΦ при короткоимпульсном облучении ионами углерода с параметрами: Jp = 0.35 Дж/см2 и D = = 10 МГр (1); 0.75 Дж/см2 и 21 МГр (2); 0.35 Дж/см2 и 20 МГр (3); 0.35 Дж/см2 и 600 МГр (4).

Радиационная чувствительность покрытий снижается с увеличением коэффициента поглощения необлученных пленок α0, обусловленного концентрацией ростовых дефектов, а их радиационная стойкость повышается (рис. 4). Значения S и α0 распределены в полосе, ограниченной линиями вида S = –Aα0 + B (A = 0.0006 и 0.00095 см и B = 1.65 и 3.05). Разброс данных обусловлен различием в концентрации ростовых дефектов. Подобная зависимость S(α0) обнаружена и в облученных ионами нанокомпозитных покрытиях Al–Si–N на подложке из стали [21]. Значение коэффициента A обусловлено ограничивающим влиянием ростовых дефектов на накопление радиационных дефектов, а величина B связана только с накоплением их концентрации. Величины A и B коррелируют друг с другом и уменьшаются в интервале доз D = 3–21 МГр, вследствие интенсивной аннигиляции радиационных дефектов.
Рис. 4.
Зависимость радиационной чувствительности S от коэффициента поглощения α0 необлученных пленок c-AlN и покрытий Al–Si–N при облучении их ионами в интервале доз D = 3–30 (◇) и 6–600 МГр (◆).

Стойкость покрытий к облучению повышается и за счет взаимодействия между дефектами посредством обмена электронами между локализованными состояниями в запрещенной зоне дефектов [21, 22]. Влияние непрерывного распределения уровней дефектов на свойства материалов связано с количеством наведенного дефектами квазидинамического структурного беспорядка, мерой которого является энергия Урбаха ЕU [19, 21, 24] и/или величина дисперсии в распределении ширины запрещенной зоны [20]. С увеличением содержания кремния в покрытиях количество наведенного беспорядка возрастает [20]. Это приводит к сужению ширины запрещенной зоны (на 2–3 эВ) вследствие расширения непрерывного распределения локализованных состояний дефектов. Зависимость S(EU) для покрытий Al–Si–N70/30 и Al–Si–N4/96 с преобладающим непрерывным спектром уровней дефектов показывает, что увеличение в степени перекрытия между уровнями сопровождается снижением радиационной чувствительности (рис. 5). Значения S и EU распределены в полосе, ограниченной линиями вида S = – A'EU + B ' (A' = 2.2 и 1.9 эВ–1 и B ' = 1.9 и 2.4). Подобная зависимость S(EU) была обнаружена и в облученных ионами покрытиях Al–Si–N, осажденных на сталь [21]. Однако сравнение показывает, что стойкость покрытий на стали несколько выше (рис. 4). Это можно связать с большей долей непрерывного спектра уровней в покрытиях на подложках из стали [20].
Рис. 5.
Зависимость радиационной чувствительности S от энергии Урбаха EU в покрытиях Al–Si–N70/30 и Al–Si–N4/96, облученных ионами углерода в короткоимпульсном режиме. Обозначения: Al–Si–N4/96 (◇, ◆, ⚪), Al–Si–N70/30 (△, ▲); Jp = 0.35 Дж/см2 (◇, △, ⚪) и 0.75 Дж/см2 (◆, ▲); подложки из кремния (◇, ◆, △, ▲) и стали (⚪).

Кинетика накопления и аннигиляции дефектов различается для покрытий с преобладающим дискретным и непрерывным спектром уровней дефектов. Центры поглощения и люминесценции в c-AlN обычно связывают с анионными VN и катионными вакансиями VAl, междоузельными ионами Ali, дефектами замещения ON, CN, SiAl и простейшими комплексами дефектов Ali⋅⋅⋅Ali, Ali⋅⋅⋅ON, VAl⋅⋅⋅VN, VAl–ON, SiAl⋅⋅⋅ON(CN) [6–9, 25–30]. На этом основании локальные полосы в спектрах поглощения и излучения рассмотренных в настоящей работе покрытий могут быть связаны с электронными переходами в локализованных состояниях подобных дефектов [20–22]. Локальная полоса поглощения при 1.5–1.6 эВ в пленках c-AlN возникает вследствие электронных переходов в локализованных состояниях кластеров Ali⋅⋅⋅Ali (рис. 6, кривая 1) [20, 21]. Полоса при 3.3–3.4 эВ соответствует переходам в уровнях донорно–акцепторных пар VAl–ON и VAl–2ON по аналогии с [6, 21, 22, 28–30]. Полоса поглощения при 3.0–3.1 эВ, зафиксированная при дозах облучения до 20 МГр, сформирована переходами в комплексах Ali⋅⋅⋅ON (рис. 6, кривая 2). Изменение концентрации дефектов в интервале доз D = = 10–30 МГр отражает диссоциацию кластеров Ali⋅⋅⋅Ali и пар VAl–ON(2ON), Ali⋅⋅⋅ON вследствие радиационного и термического отжига (рис. 6, кривые 3 и 4; рис. 7а, кривые 1 и 3). Диссоциация кластеров является источником одиночных Ali. Происходит накопление комплексов дефектов, ответственных за полосы в интервале 2.4–2.6 эВ (рис. 7а, кривая 2). На второй стадии облучения при D > 20–30 МГр преобладают процессы накопления дефектов, их объединения в комплексы и диссоциации вследствие рекомбинации с генерируемыми дефектами (рис. 7а, кривые 1 и 2).
Рис. 6.
Спектры поглощения α(hν) пленок c-AlN, осажденных методом реактивного магнетронного распыления на подложку из кремния, до (1) и после облучения ионами углерода в короткоимпульсном режиме (2–4) с параметрами: Jp = 0.35 Дж/см2 и D = 3 (2), 13 (3) и 600 МГр (4).

Рис. 7.
Зависимость концентрации радиационных дефектов Ni в пленках c-AlN (а) и в покрытиях Al–Si–N90/10 (1–3) и Al–Si–N70/30 (4) (б), осажденных методом реактивного магнетронного распыления на подложку из кремния, от дозы облучения ионами. Локальные уровни энергии дефектов распределены в интервалах 1.6–2.0 (1), 2.4–2.6 (2, 4) и 3.0–3.4 эВ (3).
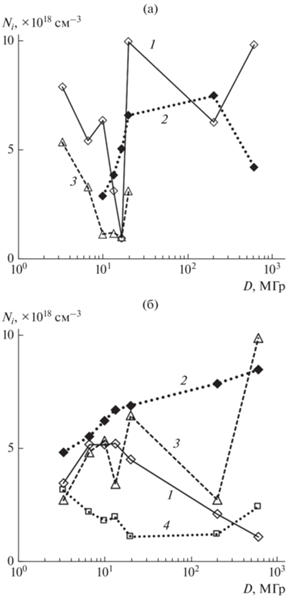
Локальные полосы поглощения, обусловленные ростовыми дефектами c-AlN, еще четко проявляются в Al–Si–N90/10. Наблюдаемое изменение дозовых зависимостей Ni(D) в интервалах 1.6–2.0, 2.4–2.6 и 3.0–3.4 эВ обусловлено влиянием ростовых кремнийсодержащих дефектов на кинетику дефектообразования (рис. 7б). С ростом плотности энергии ионного пучка от 0.35 до 0.75 Дж/см2 локальные уровни при 1.6, 2.5 и 3.3 эВ преобразуются в непрерывное распределение уровней в интервале 1.5–3.2 эВ вследствие диссоциации нестабильных комплексов дефектов под влиянием отжига. Максимальная концентрация центров, вызывающих полосы в интервале 1.6–2.0 эВ, достигается после доз облучения 7–13 МГр (рис. 7б, кривая 1). Корреляция между дозовыми зависимостями концентрации в интервалах 1.6–2.0 и 3.0–3.4 эВ свидетельствует о согласованности изменений в концентрации дефектов в комплексах Ali⋅⋅⋅Ali и VAl–ON, Ali⋅⋅⋅ON (рис. 7б, кривые 1 и 3). Устойчивое накопление концентрации комплексов дефектов зафиксировано в интервале 2.4– 2.6 эВ (рис. 7б, кривая 2).
С увеличением содержания кремния в покрытиях влияние дефектов, имеющих локальные уровни ослабевает [20, 21]. Межзонное поглощение в Al–Si–N70/30 реализуется непрямыми и прямыми переходами через “оптические” щели $E_{g}^{{{\text{''}}}}$ = 1.7–1.8 эВ и $E_{g}^{{\text{'}}}$ = 2.3–2.4 эВ. Эти изменения сопровождаются снижением радиационной чувствительности и скорости введения дефектов (рис. 2 и 3). Концентрация комплексов дефектов в интервалах 1.6–2.0 и 3.0–3.4 эВ в Al–Si–N70/30 меняется с дозой облучения в подобии с соответствующими кривыми c-AlN, приведенными на рис. 7а. Концентрация комплексов дефектов, проявляющихся в интервале 2.4–2.6 эВ, сильно подавляется, особенно, на второй стадии облучения (рис. 7б, кривая 4). Это обусловлено влиянием кремнийсодержащих ростовых дефектов на заселенность уровней комплексов.
Влияние непрерывного распределения уровней дефектов на оптические свойства аморфного покрытия Al–Si–N4/96 усиливается, хотя слабые полосы поглощения при 1.6 и 2.5 эВ, обусловленные ростовыми дефектами, еще проявляются [20]. Межзонное поглощение реализуется непрямыми и прямыми переходами в интервале Δ'(hν) = = 2.8–3.6 эВ через “оптические” щели $E_{g}^{{{\text{''}}}}$ = 2.1 эВ и $E_{g}^{{\text{'}}}$ = 2.7 эВ. Накопление дефектов на первой стадии облучения ограничено влиянием радиационного и термического отжига (рис. 2 и 3). Взаимодействие между дефектами смешанной природы является основной причиной нестабильной кинетики накопления дефектов в Al–Si–N4/96. Между дозовыми зависимостями энергетических параметров поглощения EU(D), $E_{g}^{{\text{'}}}$(D), $E_{g}^{{{\text{''}}}}$(D) и радиационной чувствительности S(D) обнаружена корреляция, что подтверждает приведенные выше выводы (рис. 2 и 8). Количество наведенного структурного беспорядка достигает максимума, а “оптические” щели – минимума при дозе D ~ 7 МГр. При D = 10–20 МГр “оптические” щели восстанавливаются до исходных значений вследствие ограничения накопления дефектов за счет их аннигиляции при отжиге. Увеличение энергии Урбаха и уменьшение “оптических” щелей на второй стадии облучения свидетельствует о формировании комплексов радиационных и ростовых дефектов. Дозовые зависимости энергетических параметров покрытий Al–Si–N4/96 на подложках из кремния и стали оказались близкими (рис. 8, кривые 1 '–3 '). Количественные различия обусловлены различными физическими свойствами подложек.
Рис. 8.
Дозовые зависимости энергии Урбаха EU (1, 1') и “оптических” щелей для непрямых $E_{g}^{{{\text{''}}}}$ (2, 2 ') и прямых разрешенных переходов $E_{g}^{{\text{'}}}$ (3, 3 ') в облученных ионами покрытиях Al–Si–N4/96, осажденных методом реактивного магнетронного распыления на подложку из кремния (1–3) и стали (1'–3 ').

Анализ спектров фотолюминесценции покрытий и их изменения при облучении подтверждает выводы, полученные из спектров поглощения. Полосы люминесценции при 2.3–2.6 и 3.3–3.6 эВ в c-AlN с учетом идентификации близких полос в [6, 7, 21, 22, 25–30] можно связать с электронными переходами в локализованных состояниях, отвечающих комплексам VAl–ON(2ON) (рис. 9а, кривая 1). Форма спектра IФЛ(hν) пленок c-AlN почти не меняется после облучения. Плавное снижение интенсивности люминесценции пленок c-AlN свидетельствует об их высокой радиационной стойкости (рис. 9б, кривая 1). Интенсивность люминесценции покрытий Al–Si–N несколько ниже (рис. 9). Вероятной причиной этого является влияние уровней кремнийсодержащих дефектов, играющих роль центров безызлучательной рекомбинации. Полосы излучения при 2.0–2.2, 3.0–3.1 и 3.6–3.8 эВ могут быть вызваны электронными переходами в уровнях дефектов, присущих как c-AlN, так и Si3N4 (рис. 9а, кривые 2–4) [14, 20]. Взаимодействие ростовых дефектов смешанной природы обуславливает преобладание непрерывного распределения уровней рекомбинации и неустойчивое поведение зависимостей IФЛ(D). Причиной роста интенсивности фотолюминесценции Al–Si–N90/10 при дозе D = 600 МГр может быть накопление кластеров Ali⋅⋅⋅Ali.
Рис. 9.
Спектры фотолюминесценции IФЛ(hν) (а) и дозовые зависимости интегральной интенсивности фотолюминесценции IФЛ(D) (б) пленок c-AlN (1) и покрытий Al–Si–N90/10 (2), Al–Si–N70/30 (3) и Al–Si–N4/96 (4), осажденных методом реактивного магнетронного распыления на подложку из кремния. Энергия возбуждающего излучения 4.5 эВ.

Низкая электропроводность σ ≤ 10–14 См пленок c-AlN и нанокомпозитных покрытий Al–Si–N обусловлена широкой запрещенной зоной нитридов и высокой плотностью локализованных состояний дефектов на границах кристаллитов и, соответственно, низкой подвижностью носителей заряда (табл. 1). Уровень Ферми зафиксирован вблизи середины запрещенной зоны, что подтверждается измерениями термостимулированных и фотостимулированных токов. Рост электропроводности с увеличением содержания кремния в покрытиях свидетельствует о том, что преобладающий вклад в перенос заряда вносят уровни кремнийсодержащих дефектов. Влияние ионного облучения на электропроводность пленок c-AlN и покрытий Al–Si–N90/10, Al–Si–N70/30 незначительно, что указывает на их радиационную стойкость. Глубокие уровни радиационных и ростовых дефектов играют роль центров локализации носителей заряда и не вносят существенного вклада в проводимость. Накопление мелких донорных уровней, наведенных комплексами кремнийсодержащих дефектов, обуславливают увеличение электропроводности Al–Si–N4/96 до 1.5 × × 10–8 См при дозе D = 600 МГр (табл. 1).
ЗАКЛЮЧЕНИЕ
Характеристики поглощения, люминесценции и электропроводности пленок c-AlN и покрытий Al–Si–N, осажденных реактивным магнетронным распылением на подложку из кремния, определяются их составом, микроструктурой и содержанием ростовых дефектов. Локальные оптические центры, которые проявляются в c-AlN и в Al–Si–N при концентрации кремния NSi ≤ ≤ 30 мас. %, обусловлены комплексами ростовых дефектов. С увеличением содержания кремния в покрытиях влияние непрерывного распределения уровней дефектов на свойства усиливается. Короткоимпульсное облучение покрытий ионами углерода сопровождается интенсивным радиационным и термическим отжигом дефектов при дозах 3–30 МГр и накоплением дефектов с последующим формированием комплексов на их основе при дозах 20–600 МГр. Влияние термического отжига на свойства возрастает с увеличением плотности энергии ионного пучка. Дозовые зависимости характеристик покрытий свидетельствуют об их высокой радиационной стойкости, немного уступающей покрытиям на подложках из стали. Радиационная стойкость материалов обусловлена ограничивающим влиянием ростовых дефектов на дефектообразование, широкой запрещенной зоной нитридов и взаимодействием дефектов посредством обмена носителями заряда. Радиационная стойкость покрытий возрастает с увеличением содержания кремния в них за счет стабилизирующего влияния кремнийсодержащих дефектов.
Список литературы
Arguirov T., Mchedlidze T., Akhmetov V.D., Kouteva-Arguirova S., Kittler M., Rӧlver R., Berghoff B., Fӧrst M., Bӓtzner D.L., Spangenberg B. // Appl. Surf. Sci. 2007. V. 254. P. 1083. https://doi.org./10.1016/j.apsusc.2007.07.150
Hoek M. // Nuclear Instrum. Meth. Phys. Res. A. 2011. V. 639. P. 227. https://doi.org./10.1016/j.nima.2010.09.177
Nava F., Vittone E., Vanni P., Fuochi P.G., Lanzieri C. // Nucl. Instrum. Meth. Phys. Res. A. 2003. V. 514. № 1–3. P. 126. https://doi.org/10.1016/j.nima.2003.08.09 4
Beyerlein I.J., Demkowicz M.J., Misra A., Uberuaga B.P. // Prog. Mater. Sci. 2015. V. 74. P. 125. https://doi.org./10/1016/j.pmatsci.2015.02.001
Novikov A.V., Yablonskiya A.N., Platonov V.V., Obolenskiy S.V., Lobanov D.N., Krasilnik Z.F. // Semiconductors. 2010. V. 44. № 3. P. 329. https://doi.org./10.1134/S1063782610030103
Vokhmintsev A.S., Weinstein I.A., Spiridonov D.M. // J. Luminesc. 2012. V. 132. P. 2109. https://doi.org./10.1016/j.jlumin.2012.03.066
Nappe J.C., Benabdesselam M., Grosseau Ph., Guilhot B. // Nucl. Instrum. Meth. Phys. Res. B. 2011. V. 269. P. 100. https://doi.org./10.1016/j.nimb.2010.10.025
Kozlovskiy A., Kenzhina I., Alyamova Z.A., Zdorovets M. // Opt. Mater. 2019. V.91. P. 130.https://doi.org/10.1016/j.optmat.2019.03.014
Gladkikh T., Kozlovskiy A., Dukenbayev K., Zdorovets M. // Mater. Charact. 2019. V. 150. P. 88. https://doi.org./10.1016/j.matchar.2019.02.013
Yang Y., Dickerson C.A., Allen Todd R.J. // Nucl. Mater. 2009. V. 392. № 2. P. 200. https://doi.org./10.1016/j.jnucmat.2009.03.040
Calcagno L., Ruggiero A., Musumeci P., Cuttone G., La Via F., Foti G. // Nucl. Instrum. Meth. Phys. Res. B. 2007. V. 257. P. 279. https://doi.org./10.1016/j.nimb.2007.01.035
Litrico G., Zimbone M., Baratta G., Marino A.D.M., Musumeci P., Calcagno L. // Nucl. Instrum. Meth. Phys. Res. B. 2010. V. 268. P. 2947. https://doi.org./10.1016/j.nimb.2010.05.015
Garrido F., Moll S., Sattonnay G., Thomé L., Vincent L. // Nucl. Instrum. Meth. Phys. Res. B. 2009. V. 267. № 8–9. P. 1451. https://doi.org./10.1016/j.nimb.2009.01.070
Demidov E.S., Dobychin N.A., Karzanov V.V., Marychev M.O., Sdobnyakov V.V. // Semiconductors. 2009. V. 43. № 7. P. 929. https://doi.org./10.1134/S1063782609070203
Kovivchak V.S., Panova T.V., Krivozubov O.V., Davletkildeev N.A., Knyazev E.V. // J. Surf. Invest.: X-Ray, Synchrotron Neutron Tech. 2012. V. 6. P. 244. https://doi.org./10.1134/S1027451012030123
Musil J. // Surf. Coat. Technol. 2012. V. 207. P. 50. https://doi.org/10.1016/j.surfcoat.2012.05.073
Musil J., Remnev G., Legostaev V., Uglov V., Lebedynskiy A., Lauk A., Procházka J., Haviar S., Smolyanskiy E. // Surf. Coat. Technol. 2016. V. 307. P. 1112. https://doi.org./10.1016/j.surfcoat.2016.05.054
Pélisson-Schecker A., Hug H.J., Patscheider J. // Surf. Coat. Technol. 2014. V. 257. P. 114. https://doi.org./10.1016/j.surfcoat.2014.08.053
Kabyshev A.V., Konusov F.V., Lauk A.L., Lebedynskiy A.M., Legostaev V.N., Smolyanskiy E.A. // Key Eng. Mater. Adv. Mater. Tech. Medical Purpose. 2016. V. 712. P. 3. https://doi.org./10.4028/www.scientific.net/KEM.712.3
Конусов Ф.В., Павлов С.К., Лаук А.Л., Кабышев А.В., Гадиров Р.М. // Поверхность. Рентген., синхротр, и нейтрон. исслед. 2021. № 2. С. 45. https://doi.org./10.31857/S1028096021020096
Konusov F., Pavlov S., Lauk A., Tarbokov V., Karpov S., Karpov V., Gadirov R., Kashkarov E., Remnev G. // Surf. Coat. Technol. 2020. V. 389. P. 125564. https://doi.org./10.1016/j.surfcoat.2020.125564
Konusov F., Pavlov S., Lauk A., Sokhoreva V., Gadirov R., Tarbokov V., Remnev G. // Radiat. Eff. Defects Solids. 2021. V. 176. P. 308. https://doi.org./10.1080/10420150.2020.1832489
Remnev G.E., Isakov I.F., Opekunov M.S., Matvienko V.M., Ryzhkov V.A., Struts V.K., Grushin I.I., Zakoutayev A.N., Potyomkin A.V., Tarbokov V.A., Pushkaryov A.N., Kutuzov V.L., Ovsyannikov M.Yu. // Surf. Coat. Technol. 1999. V. 114. P. 206. https://doi.org./10.1016/S0257-8972(99)00058-4
Weinstein I.A., Zatsepin A.F., Kortov V.S. // Phys. Solid State. 2001. V. 43. P. 246.
Lamprecht M., Grund C., Neuschl B., Thonke K., Bryan Z., Collazo R., Sitar Z. // J. Appl. Phys. 2016. V. 119. P. 155701. https://doi.org./10.1063/1.4946828
Trinkler L. Berzina B. // Radiation Measurements. 2014. V. 71. P. 232. https://doi.org./10.1016/j.radmeas.2014.02.016
Irmscher K., Hartmann C., Guguschev C., Pietsch M., Wollweber J., Bickermann M. // J. Appl. Phys. 2013. V. 114. P. 123505. https://doi.org./10.1063/1.4821848
Silvestri L., Dunn K., Prawer S., Ladouceur F. // Europhys. Lett. 2012. V. 98. P. 36003. https://doi.org./10.1209/0295-5075/98/36003
Schulz T., Albrecht M., Irmscher K., Hartmann C., Wollweber J., Fornari R. // Phys. Status Solidi B. 2011. V. 248. № 6. P. 1513. https://doi.org./10.1002/pssb.201046616
Koyama T., Sugawara M., Hoshi T., Uedono A., Kaeding J.F., Sharma R., Nakamura S., Chichibu S.F. // Appl. Phys. Lett. 2007. V. 90. P. 241914. https://doi.org./10.1063/1.2748315
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования


