Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2023, № 4, стр. 3-9
Тонкослойные гетероструктуры InAlPSbAs/InAs: кинетика роста, морфология и структура
Л. С. Лунин a, *, М. Л. Лунина a, Д. Л. Алфимова a, А. С. Пащенко a, О. С. Пащенко a, А. В. Донская a
a Южный Научный Центр РАН
344006 Ростов-на-Дону, Россия
* E-mail: lunin_ls@mail.ru
Поступила в редакцию 22.06.2022
После доработки 17.08.2022
Принята к публикации 17.08.2022
- EDN: KBYUSF
- DOI: 10.31857/S1028096023040118
Аннотация
Обсуждены результаты выращивания тонкослойных гетероструктур твердого раствора InPSbAs/InAs методом зонной перекристаллизации градиентом температуры. В рамках модели регулярных растворов проведен анализ гетерофазных равновесий в системе In-Al-P-Sb-As. Исследована кинетика роста в зависимости от толщины жидкой фазы (l), концентрации компонентов в ней, температуры подложки (T) и градиента температур (G). Исследованы режимы роста и проведен анализ на предмет спинодальных распадов твердых растворов. Показано, что существенное влияние на кинетику роста оказывают температура подложки и градиент температуры. Методом оже-спектроскопии изучены профили распределения компонентов твердого раствора InAlPSbAs по глубине и показаны преимущества использования подпитки жидкой фазы для получения слоев постоянного состава. Исследовано структурное совершенство твердых растворов InAlPSbAs на подложке InAs. Установлено, что наименьшее значение полной ширины на половине максимума линий качания дифракционного отражения слоев достигается при T < 873 К, G < 20 К/см, и толщине жидкой зоны 80 < l < < 120 мкм. Методами сканирующей зондовой микроскопии исследована морфология поверхности твердых растворов InAlPSbAs на InAs. Показано, что при T < 873 К, G < 20 К/см, и толщине жидкой зоны 80 < l < 120 мкм среднеквадратичная шероховатость поверхности не превышает 1 нм.
ВВЕДЕНИЕ
Интерес к гетероструктурам, полученным из многокомпонентных твердых растворов, выращенных на основе соединений типа AIIIBV, объясняется их перспективностью применения для приборов инфракрасной оптоэлектроники [1–14]. Использование таких гетероструктур для лазеров и фотоприемников видимого и ИК диапазонов предъявляет повышенные требования к их структурному совершенству и стабильности [15, 16]. По этой причине пятикомпонентные гетероструктуры соединений типа AIIIBV являются перспективными материалами для приборов ИК-оптоэлектроники, так как становится возможным независимо управлять шириной запрещенной зоны и периодом кристаллической решетки [17]. К таким гетероструктурам, в частности, относятся InAlPSbAs/InAs. Однако получение таких гетероструктур сопряжено с рядом трудностей: наличие обширных областей спинодального распада, узкий коридор значений переохлаждения, необходимого для эпитаксиального роста из жидкой фазы, вероятность формирования нестехиометрических составов и т.д. [15].
В связи с этим актуальной проблемой является применение новых методов выращивания многокомпонентных гетероструктур. Одним из таких методов получения полупроводниковых гетероструктур является зонная перекристаллизация градиентом температуры [15–17].
Целью настоящей работы являлось выращивание тонкослойных гетероструктур InAlPSbAs/InAs методом зонной перекристаллизации градиентом температуры и исследование кинетики роста, морфологии поверхности, структурного совершенства.
ТЕОРЕТИЧЕСКИЙ АНАЛИЗ
Для выращивания гетероструктур InAlPSbAs/ InAs необходимо провести теоретический анализ их устойчивости к спинодальному распаду, который проявляетя в распаде многокомпонентного твердого раствора на компоненты при кристаллизации. Расчет областей спинодального распада был проведен по методике, описанной нами ранее [15, 17]. На рис. 1 приведены области спинодального распада без учета влияния упругих напряжений на границе раздела между слоем InAlPSbAs и подложкой InAs. Область спинодального распада в данной гетероструктуре весьма обширная и существенно расширяется с увеличением концентрации фосфора в слое твердого раствора. Следует заметить, что линии спинодали, представленные на рис. 1, соответствуют изопериодному (подложке) составу твердого раствора InAlPSbAs.
Рис. 1.
Концентрационные зависимости области спинодального распада твердого раствора InAlPSbAs на подложке InAs. Цифрами на графике указана концентрация фосфора x, мол. доли.

Расчеты параметров пятикомпонентных твердых растворов InAlPSbAs таких составов, при которых слой твердого раствора согласован с подложкой InAs по постоянной решетки (a) проведены по уравнениям работы [17] и представлены в табл. 1.
Таблица 1.
Области согласования по a твердого раствора InzAl1 –zPxSbyAs1 –x–y с подложкой InAs (zmin = 0)
| x | zmax | x | zmax | ||
|---|---|---|---|---|---|
| 5% | 20% | 5% | 20% | ||
| 0.0 | 1.00 | 1.00 | 0.5 | 0.10 | 0.90 |
| 0.1 | 0.85 | 1.00 | 0.6 | 0.05 | 0.85 |
| 0.2 | 0.65 | 1.00 | 0.7 | 0.00 | 0.80 |
| 0.3 | 0.45 | 1.00 | 0.8 | 0.00 | 0.75 |
| 0.4 | 0.25 | 0.95 | 1.0 | 0.00 | 0.60 |
Из табл. 1 видно, что наилучшего согласования по a можно достичь при малых концентрациях фосфора. С увеличением концентрации фосфора в твердом растворе изопериодические линии смещаются в сторону уменьшения концентрации Sb (рис. 1). Анализ данных табл. 1 и рис. 1 показывает, что наиболее подходящими являются составы InzAl1 –zPxSbyAs1 –x–y с малым содержанием фосфора x < 0.3 и содержанием индия z > 0.7.
ЭКСПЕРИМЕНТАЛЬНАЯ ЧАСТЬ
Гетероструктуры InAlPSbAs/InAs получали методом зонной перекристаллизации градиентом температуры, суть которого заключается в последовательной перекристаллизации исходной матрицы (источника), диффузии компонентов в расплаве (жидкой зоне толщиной l) к подложке под действием градиента температуры и их кристаллизации на ней. Подложкой служили пластины из арсенида индия, ориентированные плоскостью (100), n-типа проводимости с концентрацией носителей 2 × 1018 см–3, жидкая зона представляла собой раствор-расплав (Al, In, P, Sb, As). В качестве источника применяли предварительно синтезированные поликристаллы.
Процесс зонной перекристаллизации градиентом температуры проводили на базе промышленной установки “Радуга” с помещенной в рабочей зоне графитовой кассетой для двенадцати образцов. С целью предотвращения окисления и разложения пластин соединений типа AIIIBV рабочую камеру, предварительно откачанную до 10–3 Па, заполняли водородом, очищенным пропусканием через палладиевый фильтр под давлением порядка 0.5 Па. Температуру контролировали с помощью автоматизированного комплекса управления температурными режимами с применением ЭВМ.
Для выращивания гетероструктур InAlPSbAs/ InAs выбран интервал температур 723–973 К. Выбор сделан в результате исследования температур ликвидуса для каждого отдельного состава с помощью установки визуально-термического анализа [15].
Исходя из предварительного анализа диаграмм фазовых равновесий системы InAlPSbAs–InAs определяли состав жидкой фазы, необходимый для получения эпитаксиальных слоев твердых растворов InzAl1 –zPxSbyAs1 –x–y с тем же периодом решетки, что и подложка InAs, были получены в области составов: 0.01 ≤ x ≤ 0.3, 0.01 ≤ y ≤ 0.35, 0.7 ≤ z ≤ 1.0 при температуре подложки около 873 К и дополнительном вертикальном градиенте температур G = 20 К/см.
Морфологию поверхности гетероструктур InAlPSbAs/InAs исследовали с помощью конфокального лазерного микроскопа Keyence VK-9700 (ЦКП ЮНЦ РАН (# 501,994)) сканирующего электронного микроскопа Quanta-200 и атомно-силовом микроскопа Ntegra academia. Оже-электронные спектры получены на спектрометре ЭСО-3 с электроанализатором типа “цилиндрическое зеркало” [15]. Энергетическое разрешение, измеренное по пику упруго-отраженных электронов, составляло 0.25%. Измерения проводили при ускоряющем напряжении электронной катушки 3 кВ и токе пучка 3 мкА, диаметр пучка составлял 5 мкм. Давление остаточных газов в камере спектрометра при измерениях было 10–7 Па. Определение несоответствия параметров решеток подложки и слоя и оценка структурного совершенства гетероструктур InAlPSbAs/InAs осуществляли методом рентгеновской дифракции. Измерение кривых дифракционного отражения рентгеновского излучения проводили на высокоразрешающем рентгеновском дифрактометре ТРС-1 в двухкристальной геометрии с использованием CuKα-излучения. Погрешность измерения составляла 10–4 Å. Помимо измерения Δa/a определяли и анализировали полуширины кривых дифракционного отражения от эпитаксиального слоя и подложки.
РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
Скорость роста эпитаксиальных слоев υ в процессе зонной перекристаллизации градиентом температуры зависит от состава и толщины жидкой зоны, от температуры и ее градиента. Результаты измерений скорости роста эпитаксиальных слоев твердого раствора InAlPSbAs на подложках InAs приведены на рис. 2.
Рис. 2.
Зависимости скорости роста слоев InAlPSbAs на подложке InAs от состава твердого раствора при T = 923 К: а) 1 – In0.9Al0.1P0.3Sb0.4As0.3; 2 – In0.9Al0.1P0.3Sb0.2As0.5; 3 – In0.7Al0.3P0.3Sb0.2As0.5; 4 – In0.8Al0.2P0.3Sb0.2As0.5; б) 1 – In0.9Al0.1P0.3Sb0.1As0.6; 2 – In0.9Al0.1P0.3Sb0.3As0.4; 3 – In0.9Al0.1P0.1Sb0.3As0.6; 4 – In0.9Al0.1P0.3Sb0.2As0.5.

Зависимость υ(l) была исследована в интервале 10–200 мкм. При очень малых толщинах (l < 10 мкм) стабильного движения жидкой зоны достичь не удалось, она распадалась на капли (вставки на рис. 2а, 2б). Возмущение зоны, вызываемое неровностями поверхности подложки, приводит к ее разрыву. Эксперименты по движению жидкой зоны (l > 250 мкм) не проводили, поскольку это усложняет формирование гетерокомпозиций (подложка–жидкая зона–источник). На полученных зависимостях υ(l) при l < 80 мкм наблюдали область повышения скорости, а затем происходит постепенное уменьшение υ при l > 120 мкм. В первом случае (l < 80 мкм) преобладает кинетический рост, во втором (l > 120 мкм) режим кристаллизации преимущественно диффузионный [17]. С увеличением температуры и ее градиента по всем интервалам толщин зон при одном составе твердого раствора наблюдали увеличение скорости роста (кривые 1–4, рис. 2а). Увеличение концентрации As (рис. 2а, кривые 1, 2) в жидкой зоне снижает скорость роста во всем диапазоне толщин зон. Однако вместе с этим уменьшается диффузионный и кинетические параметры [17]. С ростом концентрации In (рис. 2а кривые 3, 4) снижается скорость роста в диффузионном режиме и увеличивается в кинетическом. Увеличение концентрации Sb (рис. 2б, кривые 1, 2) и P (рис. 2б, кривые 3, 4) и приводит к небольшому уменьшению скорости движения зоны в диффузионном режиме (l > 100 мкм) и резкому сдвигу переходной области (80–100 мкм) в сторону тонких зон. Следовательно, имеет место некоторое уменьшение диффузионного параметра и значительное увеличение кинетических параметров.
На рис. 3а приведена зависимость скорости роста от толщины жидкой зоны l. Можно наблюдать, что наибольшая скорость роста достигается при 80 < l < 120 мкм и T = 973 К (рис. 3а, кривые 1, 2). Увеличение толщины l более 120 мкм приводит к снижению скорости роста. Повышение G c 10 до 40 К/см сопровождается увеличением υ (рис. 3а, кривые 3, 4).
Рис. 3.
Зависимости скорости роста слоев InAlPSbAs на подложке InAs: а – от толщины жидкой зоны при: 1 – Т = 873 К, G = 20 К/см; 2 – Т = 973 К, G = 20 К/см; 3 – Т = 923 К, G = 10 К/см; 4 – Т = 923 К, G = 40 К/см; б – от температуры T; в – от градиента температуры G.

Экспериментально показано, что значительный вклад в скорость роста эпитаксиальных слоев твердого раствора InAlPSbAs вносит температура (рис. 3б) и ее градиент (рис. 3в).
Результаты оже-анализа эпитаксиальных слоев InAlPSbAs представлены в виде концентрационных профилей по глубине (рис. 4).
Рис. 4.
Профили распределения компонентов твердого раствора InAlPSbAs по глубине слоя: без подпитки (а); с подпиткой из источника AlInP (б).

Характерной особенностью кристаллизации твердых растворов InAlPSbAs на подложке InAs является резкое убывание концентрации Al и P от границы с подложкой к поверхности из-за высоких значений коэффициентов распределения этих компонентов (KAl > 50, KP > 100). Остальные компоненты As, Sb, In изменяются незначительно. Для выращивания гетероструктур InAlPSbAs/InAs постоянного состава необходима подпитка из источника сильно диффундирующими компонентами P и Al. Концентрационные профили эпитаксиальных слоев InAlPSbAs, полученных с подпиткой из поликристалла AlInP, приведены на рис. 4б. Видно, что распределение концентрации компонентов по толщине за исключением переходной области однородно и соответствует составу источника подпитки AlInP. Величина переходной области зависит от толщины жидкой зоны и начальной добавки сильно сегрегирующих компонентов Al и P.
Экспериментальные исследования показали, что период решетки твердого раствора зависит от концентрации компонентов, что ведет к изменению рассогласования периодов решетки подложки и слоя твердого раствора. Результаты исследования структурных параметров твердых растворов InAlPAsSb приведены на рис. 5. На рис. 5а приведена зависимость относительного рассогласования периодов решеток от концентрации компонентов твердого раствора гетероструктуры InzAs1 –zPxSbyAs1 –x–y/InAs.
Рис. 5.
Зависимость рассогласования периодов решеток слоя InAlPSbAs и подложки InAs от концентрации компонентов в твердом растворе (а); зависимость BH/2 кривых дифракционного отражения от температуры подложки (T) (б); от градиента температуры (G) (в); от толщины жидкой зоны (l) (г).
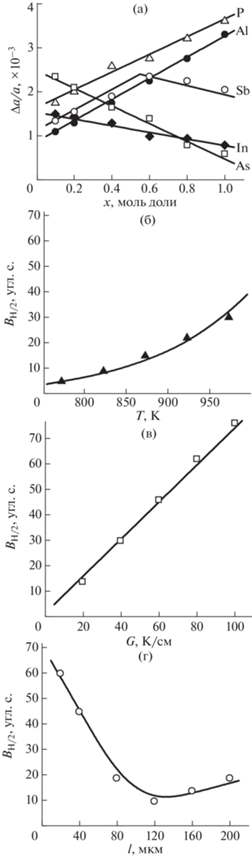
Видно, что с ростом концентраций Al и P разница периодов решетки возрастает, достигая максимального значения Δa/a = 3.8 × 10–3 (Δa = 2.2 × × 10–2 Å) при x = 1 и z = 0 моль доли. Увеличение концентрации In и As приводит к уменьшению разницы периодов решетки слоя и подложки. Следует заметить, что эпитаксиальный слой имеет постоянный состав по толщине. В случае повышения концентрации сурьмы Δa/a вначале возрастает, достигая максимума 2 × 10–3 при y = = 0.5 моль доли, а затем спадает. Это связано с усилением эффекта упорядочения [17].
Результаты измерений полной ширины на половине максимума BH/2 линий качания дифракционного отражения для изопериодных гетероструктур InzAl1 –zPxSbyAs1 –x–y/InAs, выращенных при различных значениях T, G и l представлены на рис. 5. Видно, что с увеличением T (рис. 5б) и G (рис. 5в), структурное совершенство эпитаксиальных слоев твердого раствора ухудшается и BH/2 достигает значительных величин BH/2 ~ 80″ при T > 873 К, G > 60 К/см. Этот результат обусловлен тем, что при таких значениях T и G нарушается тепловое и диффузионное равновесие, вследствие чего фронт кристаллизации становится нестабильным и возникают включения на границе с подложкой. Результаты измерений BH/2 в зависимости от толщины жидкой зоны (рис. 5г) показали, что для тонких зон (l < 80 мкм) значительно ухудшена степень кристалличности слоев InAlPSbAs, особенно это проявляется в случае нанослоев (~30–80 нм). При таких зонах не происходит полного растворения зерен при перекристаллизации источника – поликристалла AlInP с блоками до 40 мкм. В результате в нанослоях присутствуют включения и, соответственно, происходит нарушение планарности границы с подложкой и однородности по составу. Для толщин зон 80 < l < < 120 мкм наблюдали наименьшее значение BH/2.
Дальнейшее увеличение толщины зоны (l > > 120 мкм) приводит к увеличению градиента температуры, вследствие чего нарушается стабильность фронта кристаллизации и возникают отклонения от стехиометрического состава из-за несоответствия скоростей кристаллизации и растворения на границах зоны. Этим и объясняется ухудшение качества гетероструктур, выраженное в уширении BH/2 (рис. 5г).
На рис. 6 приведены результаты исследования выращенных гетероструктур методами сканирующей зондовой микроскопии.
Рис. 6.
РЭМ-изображение (а) и АСМ-изображение (б) морфологии поверхности твердого раствора Al0.1In0.9P0.3Sb0.2As0.5 на подложке InAs, выращенного при T = 873 К, G = 20 К/см, l = 80 мкм.
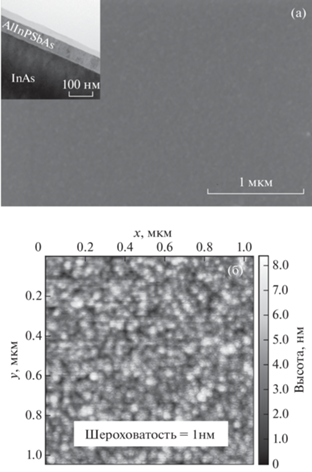
Исследование морфологии поверхности и структуры твердых растворов InAlPSbAs на подложках InAs показали, что поверхность эпитаксиального слоя имеет некоторый рельеф (рис. 6а). Для детального изучения была измерена шероховатость (рис. 6б) и изучена ее зависимость от параметров процесса выращивания. При оптимальных технологических параметрах T = 873 К, G = = 20 К/см и l = 80 мкм шероховатость минимальна и не превышает 1 нм (рис. 6б), при T > 873 К, G > 40 К/см и l < 80 мкм шероховатость увеличивалась и достигала ~30 нм, что связано с нестабильностью фронтов кристаллизации и растворения. При технологических параметрах T ~ 873 К, G ~ 40 К/см и l ~ 80 мкм граница гетероструктуры становится планарной (вставка на рис. 6а).
ЗАКЛЮЧЕНИЕ
Тонкослойные (~100 нм) гетероструктуры InAlPSbAs/InAs, контролируемые по толщине, составу и структурному совершенству, могут быть выращены методом зонной перекристаллизации градиентом температуры. Твердый раствор InAlPSbAs склонен к спинодальному распаду. Однако в пределах 0.01 ≤ x ≤ 0.3, 0.01 ≤ y ≤ 0.35, 0.7 ≤ z ≤ 1.0 можно выращивать твердые растворы InzAl1 –zPxSbyAs1 –x–y, не подверженные распаду.
Установлено, что скорость роста эпитаксиальных слоев InAlPSbAs на подложках InAs можно регулировать изменением состава, толщины зоны, температуры и ее градиента.
Показано, что рассогласование периодов решеток слоя InAlPSbAs и подложки InAs увеличивается с ростом концентрации Al и P, достигая максимального значения Δa/a = 3.8 × 10–3 (Δa = = 2.2 × 10–2 Å). Увеличение концентрации In и As приводит к уменьшению разницы периодов решетки слоя и подложки. В случае повышения концентрации сурьмы Δa/a вначале возрастает, достигая максимума 2 × 10–3 (Δa = 1.0 × 10–3 Å) при y = 0.5 мол. доли, а затем спадает до 0.5 × 10–3 (Δa = 0.25 × 10–3 Å).
Основными параметрами, определяющими качество поверхности и структурное совершенство слоев, являются состав раствора–расплава, толщина зоны, температура и ее градиент. При оптимальных параметрах роста шероховатость слоев InAlPSbAs составляет не более 1 нм с планарной гетерограницей без дефектов.
Список литературы
Watanabe K., Sakata A., Saijo Y., Baba T. // Opt. Lett. 2020. V. 45. P. 6202. https://www.doi.org/10.1364/OL.410122
Aarik J., Ovtchinnikov A., Asonen H. // Proc. of 8th Intern. Conf. on Indium Phosphide and Related Materials, Schwaebisch-Gmuend, Germany. 1996. P. 176. https://www.doi.org/10.1109/ICIPRM.1996.491965
Sugiyama H., Uchida K., Han X., Periyanayagam G.K., Aikawa M., Hayasaka N., Shimomura K. // J. Cryst. Growth. 2019. V. 507. P. 93. https://www.doi.org/10.1016/j.jcrysgro.2018.10.024
Khvostikov V.P., Sorokina S.V., Potapovich N.S., Levin R.V., Marichev A.E., Timoshina N.K., Pushnyi B.V. // Semicond. 2018. V. 52. № 13. P. 1748. https://www.doi.org/10.1134/S1063782618130079
Wu S., Xia H., Xu J., Sun X., Liu X. // Adv. Mater. 2018. P. 1803362. https://www.doi.org/10.1002/adma.201803362
Okumura T., Kondo D., Ito H., Lee S., Amemiya T., Nishiyama N., Arai S. // Jpn. J. Appl. Phys. 2011. V. 50. P. 020206. https://www.doi.org/10.1143/JJAP.50.020206
Young J.L., Steiner M.A., Döscher H., France R.M., Turner J.A., Deutsch T.G. // Nat. Energy. 2017. V. 2. P. 17028. https://www.doi.org/0.1038/nenergy.2017.28
Lang R., Schön J., Lefèvre J., Boizot B., Dimroth F., Lackner D. // Sol. En. Mat. & Sol. Cells. 2020. V. 211. P. 110551. https://www.doi.org/10.1016/j.solmat.2020.110551
Micha D.N., Silvares R.T. // Sci. Rep. 2019. V. 9. P. 20055. https://www.doi.org/10.1038/s41598-019-56457-0
Dimroth F., Grave M., Beutel P., Fiedeler U., Karcher C., Tibbits T.N.D., Oliva E., Siefer G., Schachtner M., Wekkeli A., Bett A.W., Krause R., Piccin M., Blanc N., Drazek C., Guiot E., Ghyselen B., Salvetat T., Tauzin A., Signamarcheix T., Dobrich A., Hannappel T., Schwarzburg K. // Prog. Photovolt: Res. Appl. 22. 2014. P. 277. https://www.doi.org/10.1002/pip.2475
Sugaya T., Nagato Y., Okano Y., Oshima R., Tayagaki T., Makita K., Matsubara K. // J. Vac. Sci. Tech. B. 2017. V. 35. 02B103. https://www.doi.org/10.1116/1.4975759
Adachi S., Properties of Semiconductor alloys: group-IV, III V and II VI Semiconductors, John Wiley & Sons, Chippenham, 2009.
Oshima R., France R.M., Geisz J.F., Norman A.G., Steiner M.A. // J. Cryst. Growth. 2017. V. 458. P. 1. https://www.doi.org/10.1016/j.jcrysgro.2016.10.025
Rechenberg I., Knauer A., Bugge F., Richter U., Erbert G., Vogel K., Klein A., Zeimer U., Weyers M. // Mat. Sci. and Eng. B. 1997. V. 44. P. 368. https://www.doi.org/10.1016/S0921-5107(96)01734-5
Кузнецов В.В., Лунин Л.С., Ратушный В.И. Гетероструктуры на основе четверных и пятерных твердых растворов соединений AIIIBV. Ростов-на-Дону: СКНЦВШ, 2003. 375 с.
Лозовский В.Н., Лунин Л.С. Пятикомпонентные твердые растворы соединений (новые материалы оптоэлектроники). Ростов-на-Дону: СКНЦВШ, 1992. 193 с.
Лозовский В.Н., Лунин Л.С., Попов В.П. Зонная перекристаллизация градиентом температуры полупроводниковых материалов. М.: Металлургия, 1987. 232 с.
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования


