Приборы и техника эксперимента, 2020, № 4, стр. 5-22
ДОСТИЖЕНИЯ В ОБЛАСТИ РАЗРАБОТКИ БЕТАВОЛЬТАИЧЕСКИХ ИСТОЧНИКОВ ПИТАНИЯ (обзор)
А. А. Краснов a, С. А. Леготин a, *
a Национальный исследовательский технологический университет “МИСиС”
119049 Москва, Ленинский просп., 4, Россия
* E-mail: serlego@mail.ru
Поступила в редакцию 03.02.2020
После доработки 27.02.2020
Принята к публикации 28.02.2020
Аннотация
Представлен детальный обзор литературы по бетавольтаическим источникам питания. Рассмотрены проблемы, существующие в рамках технологии их изготовления, результаты исследований и разработок, проводимых в настоящее время, обобщены конструкции и принципы работы бетавольтаических источников питания, а также приведены основные этапы их проектирования. Представленная в работе информация позволяет узнать и понять технологию и методы создания существующих конструкций, показать достигнутые параметры и имеющиеся ограничения, а также возможности по дальнейшему улучшению конструкций бетавольтаических источников питания.
1. ВВЕДЕНИЕ
Разработка новых источников питания с длительным сроком службы и без необходимости регулярного обслуживания является в настоящее время одной из наиболее актуальных проблем развития мобильных устройств, длительное время находящихся в удалении от стационарных источников питания. Бетавольтаические источники питания (б.в.и.п.) обладают хорошим потенциалом для решения таких задач. Их применение возможно в распределенных системах электропитания, автономных датчиках и сенсорах, системах безопасности и биомедицинском оборудовании.
Плотность энергии у б.в.и.п. выше, чем у химических батарей или топливных элементов, в 102–103 раз [1]. Такие источники питания обладают небольшой массой, крошечными размерами и могут быть интегрированы на кристалле полупроводниковых приборов без ущерба для окружающей среды. Срок службы б.в.и.п. может составлять от нескольких десятков до нескольких сотен лет [1].
Основное ограничение для таких источников питания заключается в низкой выходной мощности, которая пока способна обеспечить энергией только нановаттные приборы [2]. Бетавольтаические источники питания можно использовать в сочетании с химическими, в том числе аккумуляторными батареями и суперконденсаторами, для непрерывной подзарядки [3].
Данное направление эффективно для приборов, работающих в импульсном режиме, например для радиочастотных идентификационных датчиков. Они также могут быть интегрированы на кристалл микросхемы и обеспечить ее питанием без необходимости использования внешнего источника.
Первое сообщение об электрон-вольтаическом эффекте сделал Эйренберг с коллегами в 1951 году [4]. Группа исследовала эффект усиления тока в селеновых ячейках, подвергнутых бомбардировке электронным пучком. Первым, кто описал бетавольтаический эффект, был Раппапорт в 1953 году [5]. Он исследовал работу сплавного полупроводникового p–n-перехода, совмещенного с источником β-излучения 90Sr/90Y, активность которого составляла 50 мКи.
Каждая такая ячейка давала 0.8 мкВт мощности при средней эффективности порядка 0.2%. Спустя 3 года Раппапорт с коллегами опубликовал результаты дальнейших исследований воздействия того же источника β-излучения на кремниевые и германиевые сплавные переходы [6] и запатентовал первый радиоактивный аккумулятор [7] с использованием собственного полупроводника. Тогда же была сформулирована теория бетавольтаических приборов и отмечено влияние свойств источника и полупроводника на характеристики б.в.и.п.
Интерес к радиационно-стимулируемым источникам энергии возобновился в начале 21 века и длится до настоящего времени. Это обусловлено качественным технологическим развитием, позволяющим изготавливать планарные структуры, среди которых тонкопленочные 2D-структуры, а также объемные 3D-микро- и наноструктурированные полупроводниковые структуры с развитой поверхностью высокого качества и сложной геометрией p–n-переходов большой площади.
В большинстве современных работ в качестве источников β-частиц применяются в основном тритий (3H) и 63Ni в различных агрегатных состояниях. В качестве полупроводниковых преобразователей, кроме Si, также используются широкозонные полупроводники, такие как С, SiC, GaN.
Сегодня исследования, направленные на создание б.в.и.п., широко ведутся как за рубежом, так и в России. При этом разработчики вынуждены конкурировать с бурно развивающейся индустрией дешевых литиевых батарей, уже сегодня способных обеспечивать более чем 10-летний срок эксплуатации [1]. Тем не менее, б.в.и.п. обладают несомненными преимуществами перед литиевыми батареями в случае использования при экстремально низких температурах [8, 9].
Однако критерии проектирования и оптимизации б.в.и.п. недостаточно хорошо описаны в научной литературе. В связи с этим основная задача данной работы заключается в представлении детального обзора б.в.и.п., включая проблемы технологии изготовления, а также результаты исследований и разработок, проводимых в настоящее время.
Существующие конструкции б.в.и.п. требуют оптимизации как методов нанесения радиоизотопа и минимизации самопоглощения энергии β-частиц, так и технологии создания полупроводникового преобразователя. Конструкция последнего предусматривает оптимизацию таких параметров полупроводникового материала, как уровень легирования, время жизни неосновных носителей заряда, ширина области обеднения, геометрия поверхности и толщина. Выбор радиоизотопа определяется сферой применения таких источников питания, а его активность и геометрия оптимизируются для минимизации эффекта самопоглощения.
Также в статье обобщены и описаны основные принципы проектирования и эксплуатации б.в.и.п., приведена последовательность их сквозного проектирования, рассмотрены полупроводниковые материалы и радиоактивные источники β-частиц c энергетическими спектрами, пригодными для преобразования в полупроводниковых материалах (без внесения устойчивых радиационных дефектов на поверхность и в объем полупроводника).
2. ПРИНЦИП РАБОТЫ БЕТАВОЛЬТАИЧЕСКОГО ПРЕОБРАЗОВАТЕЛЯ
Работа бетавольтаического преобразователя основана на принципе конвертации энергии β‑излучения, возникающего в результате самопроизвольного радиоактивного распада нестабильных изотопов, в электрическую энергию внутри рабочего тела полупроводника. Подавляющее большинство б.в.и.п. состоит из β-эмитирующего материала, соединенного с p–n-переходом.
Сравнение с фотоэлементами является простым путем к объяснению принципа работы бетавольтаического преобразователя. В обоих случаях при работе элемента происходит генерация электрон-дырочных пар (э.д.п.) за счет взаимодействия ионизирующего излучения (фотонов в фотоэлементах и электронов в бетавольтаических элементах) с полупроводником, вблизи или внутри области пространственного заряда p–n-перехода. Дырки ускоряются внутренним полем p–n-перехода к p-контакту, электроны – к n-контакту, э.д.п. за пределами области пространственного заряда быстро рекомбинируют и практически не вносят вклада в общий электрический ток. Принципиальная разница заключается в механизме взаимодействия возбуждающего воздействия с материалом. Единичный фотон практически никогда не образует две э.д.п., даже если обладает достаточной для этого энергией. Фототок, возникающий в базовом элементе под действием фотонов с энергией, превышающей ширину запрещенной зоны полупроводника, пропорционален потоку фотонов и не зависит от их энергии.
При попадании в бетавольтаический преобразователь β-частицы с энергией в диапазоне 1–100 кэВ происходит ионизация атомов и образуется множество э.д.п. вдоль траектории движения β-частицы. В указанном диапазоне энергий (до 100 кэВ) ионизация с последующим образованием э.д.п. является доминирующим процессом, поэтому количество генерируемых э.д.п. можно с хорошей точностью считать пропорциональным энергии внешней β-частицы.
Под действием статического электрического поля полупроводниковой структуры эти пары образуют электрический ток, величина которого пропорциональна произведению потока β-частиц и их энергии; схематично этот процесс показан на рис. 1.
Рис. 1.
Процесс образования э.д.п. при взаимодействии с внешним электроном. e– – электрон; h+ – дырка; Dn и Dp – диффузионные длины электронов и дырок; Wопз – ширина области пространственного заряда; Ec – уровень зоны проводимости; Ev – уровень валентной зоны; Ef – уровень Ферми.
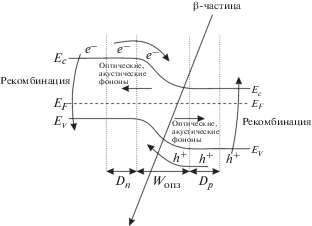
Однако не вся кинетическая энергия β-частиц способствует образованию э.д.п., часть энергии расходуется на генерацию фононов [10]. Это объясняет, почему минимально необходимая энергия создания одной э.д.п. выше, чем энергия запрещенной зоны. Теоретически наиболее эффективными материалами для изготовления бетавольтаического преобразователя являются полупроводники с большей шириной запрещенной зоны, такие как SiC, GaN и С (углерод в форме алмаза).
Общая эффективность преобразования энергии β-частиц зависит как от эффективности источника электронов, так и от эффективности преобразования приемника излучения. Эффективность преобразования растет с шириной запрещенной зоны и может достигать порядка 30% для таких широкозонных материалов, как AlN [11].
Широкозонные материалы имеют более низкие значения индуцированного тока, так как энергия, необходимая для рождения одной э.д.п., пропорциональна ширине запрещенной зоны полупроводника. Экспериментально было установлено [12, 13], что средняя энергия, затрачиваемая электроном на образование э.д.п., составляет порядка утроенной ширины запрещенной зоны полупроводника. Например, средняя энергия, необходимая для образования одной э.д.п., в Si составляет 3.64 эВ [12]. Однако за счет большей высоты потенциального барьера эти структуры позволяют достичь более низких значений токов утечки и более высоких значений напряжения и, следовательно, более высокого коэффициента преобразования энергии ионизирующего излучения.
Однако с практической точки зрения время жизни неосновных носителей заряда в доступных в настоящее время кристаллах SiC, GaN и С существенно меньше соответствующих значений в Si. Кроме того, обратный ток, который оказывает существенное влияние на индуцированное напряжение, в Si может достигать значений, близких к теоретическим.
В структурах на основе SiC и GaN такого пока не наблюдается, что связано со сравнительно большой концентрацией структурных дефектов. Дефекты структуры и энергетические состояния в середине запрещенной зоны существенно увеличивают скорость рекомбинации носителей заряда в объеме, что приводит к увеличению обратного тока.
Например, SiC должен как нельзя лучше подходить для применения в б.в.и.п., однако вырастить p–n-переход достаточно большой площади с малым количеством дефектов оказалось крайне трудной задачей [14]. Сегодня технология изготовления кремниевых структур находится на достаточно высоком уровне, что дает возможность создавать элементы большой площади, последовательное включение которых позволит поднять выходное напряжение. В связи с этим внимание ученых к этому материалу довольно высоко.
3. МАТЕРИАЛЫ ДЛЯ ИЗГОТОВЛЕНИЯ БЕТАВОЛЬТАИЧЕСКОГО ПРЕОБРАЗОВАТЕЛЯ
Вопрос использования определенного β-изотопа в конструкции б.в.и.п. является комплексным. Процесс выбора подходящего источника включает в себя одновременное рассмотрение таких факторов, как период полураспада, который определяет максимальную активность источника и эффективный срок эксплуатации б.в.и.п., максимальную энергию β-распада, которая, наряду с активностью, определяет эффективную плотность мощности источника и возможность дефектообразования в полупроводниковой структуре.
Еще один фактор состоит в способе получения радиоизотопа. Если радиоизотоп формируется естественным образом в ходе распада, то его стоимость будет относительно экономичной. При производстве радиоизотопа, например, путем облучения нейтронами в ядерных реакторах через нейтронный захват его цена существенно возрастает.
Эти факторы совместно с технологическими свойствами самого радиоизотопа определяют возможность использования того или иного материала в б.в.и.п.
С одной стороны, для создания работающих долгое время (более 10–15 лет) источников питания предпочтительно использовать радиоактивные материалы с как можно большим периодом полураспада, но, с другой стороны, чем больше время полураспада, тем меньше испускаемый материалом поток β-частиц. Следовательно, максимальный ток и пиковая мощность будут в обратной зависимости от периода полураспада.
Кроме того, нужно учитывать максимальную энергию β-частиц, испускаемых радиоизотопом, по отношению к энергии дефектообразования Eth для конкретного полупроводникового материала. Для полупроводников эта величина варьируется в диапазоне 150–400 кэВ. Поэтому при разработке б.в.и.п. следует использовать радиоизотоп, испускающий β-излучение с максимальной энергией, не превышающей Eth.
Выбор периода полураспада зависит от требований к сроку службы б.в.и.п., который может быть в два раза больше периода полураспада, например, в случае потребления нагрузкой только 25% от исходной мощности.
При всем разнообразии радиоактивных веществ выбор оптимального радиоизотопа для использования в б.в.и.п. является непростой задачей, так как абсолютное большинство изотопов испускает несколько видов излучений, включая вредное для здоровья человека γ-излучение. Поэтому к радиоактивному веществу предъявляются особые требования:
– радиоактивный материал должен быть чистым β-источником;
– период полураспада ≥10 лет;
– максимальная энергия ионизирующих частиц не должна превышать энергию дефектообразования в полупроводниковом материале.
Безопасное обращение с радиоактивными изотопами требуется при изготовлении и эксплуатации б.в.и.п. во избежание возможного проникновения через кожный покров. Как правило, энергия β-частиц, необходимая для проникновения через кожный покров, составляет от 70 до 150 кэВ [15]. Тем не менее, с осторожностью нужно следить за областью глаз и слизистых оболочек, так как они очень чувствительны к воздействию β-частиц.
Изотопы, которые могут быть применены в б.в.и.п., приведены в табл. 1.
Таблица 1.
Параметры β-радиоизотопов [16]
| Изотоп | Средняя энергия частиц, кэВ | Максимальная энергия частиц, кэВ | Период полураспада, год | Удельная мощность, Вт/г |
|---|---|---|---|---|
| 3Н | 5.5 | 18.6 | 12.3 | 0.361 |
| 42Ar | 310 | 600 | 32.9 | 0.306 |
| 63Ni | 17 | 66.7 | 100.1 | 0.0057 |
| 85Kr | 220 | 670 | 10.75 | 0.518 |
| 90Sr | 196 | 546 | 28.8 | 0.149 |
| 137Cs | 187.1 | 1175.63 | 30.08 | 0.0962 |
| 147Pm | 66 | 224.1 | 2.62 | 0.412 |
| 151Sm | 24 | 76 | 90 | 0.004 |
| 228Ra | 13 | 46 | 5.75 | 0.015 |
Радиоизотопы 3Н, 63Ni, 147Pm, 33P и 90Sr использовались при изготовлении прототипов б.в.и.п. 3Н и 228Ra имеют низкое значение энергии испускаемых частиц. 3Н с периодом полураспада 12.3 года имеет удельную мощность ~361 мВт · г–1, а 228Ra с периодом полураспада 5.75 года – 15 мВт · г–1. Тем не менее, 3H – газ, который крайне опасен в своем естественном состоянии и трудно обрабатывается, поэтому его целесообразно использовать в составе твердого вещества. Примером таких веществ являются тритиды титана или скандия (аналог гидридов). Титан и скандий известны своими свойствами абсорбировать и удерживать молекулы трития в требуемом состоянии [17]. Однако поток β-частиц из такого источника ограничивается собственным поглощением: β-частицы трития полностью поглощаются в титане или скандии толщиной меньше 1 мкм [18].
Наиболее исследованным и используемым в мире изотопом для радиоизотопных источников питания является 90Sr [19]. Он представляет собой чистый β-излучатель, который, распадаясь, превращается в 90Y – также β-излучатель с очень коротким периодом полураспада, 64 ч, и высокой средней энергией, 933.6 кэВ. Высокая энергия может вызвать значительные повреждения кристаллической решетки полупроводников.
Изотоп 90Sr используется для создания атомных батарей и для генераторов с тепловым циклом [20], однако высокая энергия частиц не позволяет создавать долговечные источники питания на основе β-преобразования. Также по этому критерию не подходят радиоизотопы 42Ar и 85Kr.
Другим вариантом β-источника является 147Pm, который обладает высокой удельной мощностью, 412 мВт · г–1, и максимальной энергией 224.1 кэВ, но его недостатком является побочное γ-излучение. Поскольку проникающая способность γ-лучей высока, вопрос безопасности для 147Pm выходит на первый план. Период полураспада (2.62 года) не позволит создавать источники питания с длительным сроком службы. Более того, пары прометия являются чрезвычайно ядовитыми, что сдерживает его применение.
Для применения в б.в.и.п. на основе полупроводниковых материалов наиболее интересными с технической точки зрения являются 63Ni и 151Sm. Невысокая максимальная энергия β-спектров этих радионуклидов не создает проблем с радиационной защитой, также β-частицы с такими энергиями не способны нанести радиационных повреждений полупроводниковой структуре, что полностью исключает деградацию p–n-переходов.
Кроме того, эти радионуклиды являются чистыми β-источниками, и период полураспада данных веществ достаточен для создания элементов питания с длительным сроком службы (более 25 лет). Также эти радиоизотопы являются металлами, что позволяет их интегрировать в полупроводниковую технологию, а проникающая способность составляет десятки микрометров, что обеспечивает свободу в выборе технологии изготовления б.в.и.п. [21].
К недостаткам данных изотопов, которые необходимо учитывать при разработке б.в.и.п., нужно отнести их низкую удельную мощность (5.7 мВт/г для 63Ni и 4 мВт/г для 151Sm) и чрезвычайно высокую стоимость (например, стоимость 1 Ки 63Ni составляет около 4000 $) [22]. Низкое значение удельной мощности 63Ni связано с его длительным периодом полураспада и низким значением средней энергии.
Необходимость использования β-изотопа 63Ni с максимальной активностью диктуется требованиями получения максимально возможной мощности элемента питания. По литературным данным [23], при использовании в качестве материала полупроводниковой структуры кремния и при невысоких активностях изотопа 63Ni (1–5 мКи/см2) выходная мощность элемента питания составляет единицы нановатт на квадратный сантиметр. Следовательно, для увеличения выходной мощности элемента питания необходимо, помимо конструкционных решений, использовать также β-источник с максимально допустимым значением активности.
Выбор материала полупроводникового преобразователя, его топологической конфигурации и толщины слоев будет обязательно зависеть от выбора определенного радиоизотопа. Кроме того, необходимо учитывать ограничения по стоимости, характеристикам материала, доступности и технологичности.
К полупроводниковым материалам предъявляются следующие основные требования:
– материал должен быть технологичным и массово использоваться в нано- и микроэлектронике;
– энергия дефектообразования должна быть выше, чем максимальная энергия β-источника;
– ширина области пространственного заряда должна быть сравнима по размерам с глубиной проникновения β-частиц;
В табл. 2 приведены основные свойства коммерчески доступных полупроводниковых материалов.
Таблица 2.
Свойства полупроводниковых материалов, применяемых для б.в.и.п. [24]
| Характеристика | Si | GaAs | SiC | GaN | C |
|---|---|---|---|---|---|
| Ширина запрещенной зоны Eg, эВ | 1.12 | 1.42 | 3.3 | 3.4 | 5.48 |
| Энергия смещения атома из узла кристаллической решетки Ed, эВ | 19 | 10 | 28 | 24 | 43 |
| Энергия ионизации W, эВ | 3.63 | 4.13 | 6.88 | 8.9 | 12.4 |
| Время жизни неосновных носителей τ, с: | |||||
| n | 10–3 | 5 · 10–9 | 5 · 10–7 | 7 · 10–9 | 10–9 |
| p | 10–3 | 3 · 10–6 | 5 · 10–8 | 4 · 10–9 | 10–9 |
| Подвижность µ, см2 · В–1 · с–1: | |||||
| n | 1400 | 8500 | 800 | 1000 | 2200 |
| p | 450 | 400 | 120 | 350 | 1800 |
| Плотность ρ, г · см–3 | 2.33 | 5.32 | 3.22 | 6.15 | 3.51 |
4. ОСНОВНЫЕ ПРИНЦИПЫ ПРОЕКТИРОВАНИЯ И ЭКСПЛУАТАЦИИ Б.В.И.П.
Конструкция самого простого б.в.и.п. состоит из полупроводникового преобразователя и источника β-частиц [21]. Основная задача бетавольтаического преобразователя состоит в генерации э.д.п. и их сборе на электродах. Для достижения максимальной выходной мощности важно максимизировать разделение э.д.п. и предельно снизить их рекомбинацию. Рекомбинация э.д.п. является основной причиной потери выходной мощности. Основная задача при разработке конструкции бетавольтаического преобразователя состоит в том, чтобы максимум генерации э.д.п. приходился на обедненную область. Следовательно, базовую область бетавольтаического преобразователя необходимо делать максимально тонкой.
Существуют различные типы переходов, доступных для бетавольтаического преобразователя: барьер Шоттки или р–n-переход. Конструкция базового элемента б.в.и.п. на основе р–n-перехода и радиоизотопа 63Ni показана на рис. 2. Радиоактивный изотоп в данной конструкции размещен над поверхностью полупроводникового преобразователя.
Конструкция электродов бетавольтаического преобразователя оказывает влияние на эффективность конверсии энергии β-частиц. Если металл электрода находится в промежутке между радиоизотопом и преобразователем, то он является мертвым слоем, в котором происходит поглощение энергии β-частиц. Кроме того, часть β-частиц будет отражена, в результате чего существенно снизится полная энергия, поглощенная в полупроводнике.
Количество обратно рассеянных электронов сильно зависит от зарядового числа Z. Чтобы снизить эти потери, необходимо исключить из конструкции металлы с высоким зарядовым числом Z, такие как Au или Pt, либо изготавливать их максимально тонкими. Другим путем снижения потерь является использование конструкции электрода по периферии кристалла преобразователя или в виде сетки. Такое решение приведет к увеличению тока короткого замыкания за счет снижения обратного рассеяния электронов.
Для повышения эффективности сбора неосновных носителей заряда одним из основных требований к конструкции бетавольтаического преобразователя является увеличение ширины области пространственного заряда. Кроме того, эффективность сбора также зависит от диффузионной длины, которая связана с подвижностью и временем жизни носителей заряда. Глубина проникновения β-частиц в полупроводнике определяет эффективную глубину залегания перехода. Расчет глубины проникновения β-частиц может быть выполнен различными методами, такими как код Монте-Карло (MCNP) [25], модель Канайи–Окаямы [26] или на основе эмпирических уравнений [27].
Код MCNP для переноса β-частиц может быть использован для точного расчета распределения энергии β-частиц и глубины их проникновения [25]. Скорость генерации э.д.п. на единицу толщины полупроводника можно вычислить с помощью MCNP:
где А – активность радиоизотопа; Е(х) – распределение энергии, оцениваемое методом MCNP в зависимости от расстояния до полупроводника и с учетом потерь во всех слоях; EEHP – средняя энергия, необходимая для генерации одной э.д.п.Тем не менее, скорость генерации э.д.п. может быть приближена без MCNP [28] с использованием выражения:
где Ebeta – энергия β-частиц; f – коэффициент обратного рассеяния.Поглощение энергии β-частицы в полупроводнике становится незначительным при прохождении частицей половины пути торможения. Это происходит потому, что траектория β-частицы случайным образом рассеивается, в результате средняя глубина проникновения β-частиц меньше, чем диапазон тормозного пути. Кроме того, большая часть энергии β-частиц при низкой энергии радиоизотопов, таких как 63Ni, накапливается вблизи поверхности полупроводникового материала [29].
Глубина проникновения изменяется в зависимости от энергии β-частиц. Следует отметить, что β-частицы генерируются в непрерывном спектре в процессе радиоактивного β-распада. Следовательно, глубина залегания p–n-перехода и ширина области пространственного заряда должны быть спроектированы и рассчитаны исходя из глубины проникновения β-частиц. Максимум энерговыделения β-частиц должен находиться в области пространственного заряда для достижения максимального сбора э.д.п. Ширину области пространственного заряда для р–n-перехода можно определить по следующим выражениям:
(3)
${{W}_{{{\text{опз}}}}} = \sqrt {{{\varphi }_{k}}\frac{{2\varepsilon {{\varepsilon }_{0}}\left( {{{N}_{a}} + {{N}_{d}}} \right)}}{{q{{N}_{a}}{{N}_{d}}}}} ;$Из выражений (3), (4) следует, что концентрация легирующей примеси является одним из важнейших параметров материала бетавольтаического преобразователя и влияет на ширину области пространственного заряда, ток короткого замыкания и напряжение холостого хода [30]. Снижение концентрации легирующей примеси приводит к увеличению ширины области пространственного заряда и диффузионной длины неосновных носителей заряда, что повышает эффективность сбора заряда и увеличивает ток короткого замыкания. Тем не менее, низкий уровень легирования приводит к увеличению токов утечки, встроенный потенциальный барьер уменьшается, что в свою очередь снижает напряжение холостого хода.
Изменение тока утечки на несколько наноампер оказывает большое влияние на эффективность б.в.и.п. Причина заключается в том, что ток, генерируемый во время облучения, находится в диапазоне от нескольких наноампер до микроампер. Увеличение тока утечки приводит к тому, что он становится сопоставимым с генерируемым током и значительно снижает выходную мощность. Таким образом, для достижения максимальной эффективности работы б.в.и.п. концентрация легирующей примеси должна быть оптимизирована.
Согласно анализу, проведенному в работе [30], уровни легирования 1018–1019 см–3 в области р-типа и 1016–1017 см–3 в области n-типа являются оптимальными значениями концентраций для бетавольтаического преобразователя на основе Si и 63Ni с глубиной залегания перехода ~0.3 мкм.
Другим способом снижения влияния тока утечки является введение дополнительных слоев в конструкцию кристалла преобразователя, а также использование дополнительных технологических операций. Так, например, ток утечки может быть снижен путем формирования изоляционного кольца на периферии кристалла и применения операции гетеррирования [31]. Максимальная выходная мощность и к.п.д. преобразования б.в.и.п. могут быть улучшены двумя способами: увеличением активности радиоизотопного источника и разработкой новых конструкций преобразователя.
Производительность б.в.и.п. также зависит от температуры окружающей среды. Исследования температурной зависимости основных параметров показали [32, 33], что напряжение холостого хода, максимальная выходная мощность и к.п.д. преобразования увеличиваются при снижении температуры из-за снижения тока утечки. И, наоборот, производительность б.в.и.п. снижается при повышении температуры, которое может возникнуть в результате работы конечного изделия.
Диффузионная длина неосновных носителей заряда, собственная концентрация носителей и подвижность зависят от температуры. Диффузионная длина и ток утечки непосредственно связаны с током короткого замыкания и напряжением холостого хода. Повышение температуры снижает производительность из-за уменьшения напряжения холостого хода, в то время как ток короткого замыкания почти не зависит от изменения температуры.
Радиационно-стимулированный ток структуры может быть определен как
где Iопз – дрейфовый ток области пространственного заряда; In и Ip – токи электронов и дырок соответственно, включающие дрейфовую и диффузионную составляющие.Токи из квазинейтральных областей определяются выражениями:
где S – площадь преобразователя; n(х) и р(х) – концентрации электронов и дырок в данной точке полупроводника; µn и µp – подвижности электронов и дырок соответственно; Dn и Dp – коэффициенты диффузии электронов и дырок соответственно; E – напряженность электрического поля.Дрейфовый ток области пространственного заряда определяется выражением:
Напряжение холостого хода определяется как
(9)
${{U}_{{{\text{xx}}}}} = \frac{{kT}}{q}\ln \left( {\frac{{{{I}_{L}}}}{{{{I}_{S}}}} + 1} \right),$При теоретических расчетах ток утечки IS включает в себя две составляющие: диффузионную ${{I}_{{dif}}}$ из квазинейтральных областей и генерационно-рекомбинационную ${{I}_{{g - r}}}$:
где(11)
${{I}_{{dif}}} = \frac{{q{{D}_{p}}{{p}_{{n0}}}}}{{{{L}_{p}}}} + \frac{{q{{D}_{n}}{{n}_{{p0}}}}}{{{{L}_{n}}}};$Максимальная мощность б.в.и.п. определяется выражением:
где Здесь Im, Vm – максимальные ток и напряжение; Iкз, Vхх – ток короткого замыкания и напряжение холостого хода, FF – коэффициент заполнения.Эффективность преобразования бетавольтаического преобразователя может быть определена по формуле
(15)
${\eta } = \frac{{{{P}_{{\max }}}}}{{{{P}_{{{\text{theory}}}}}}} = \frac{{FF{\text{ }}{{I}_{{{\text{кз}}}}}{{V}_{{{\text{хх}}}}}}}{{1.6 \cdot {{{10}}^{{ - 19}}} \cdot 3.7 \cdot {{{10}}^{7}}A{{E}_{{avg}}}}},$Общий коэффициент полезного действия б.в.и.п. также может быть найден как
где ηs и ηc – эффективности радиоизотопа и бетавольтаического преобразователя соответственно.Эффективность источника β-частиц определяется отношением энергии, падающей на бетавольтаический преобразователь, к фактической энергии радиоизотопа. Эта эффективность учитывает эффект самопоглощения радиоизотопа, все факторы геометрии и потерь, в том числе долю тех β-частиц, которые не направлены на полупроводник. Эффективность бетавольтаического преобразователя определяется максимальной выходной мощностью, выделяемой в полупроводнике. Она учитывает рекомбинацию и тепловые потери в структуре преобразователя.
В результате эффекта самопоглощения не все β-частицы достигают объема полупроводника. Следовательно, толщина слоя радиоизотопа должна быть оптимизирована так, чтобы свести к минимуму эффект самопоглощения. Количество β-частиц, доступных для преобразования в бетавольтаическом преобразователе, может быть представлено в виде фактической радиоактивности и видимой радиоактивности.
Фактическая радиоактивность – это радиоактивность изотопа с учетом его удельной активности и массы. Видимая радиоактивность характеризует излучение источника и может быть измерена с помощью детектора излучения. Видимая радиоактивность из-за самопоглощения β-частиц внутри источника всегда меньше, чем фактическая радиоактивность, и описывается выражениями [34]:
где С, мКи · мг–1 – удельная активность; µm, см2 · мг–1 – массовый коэффициент ослабления исходного радиоактивного материала; tm, мг · см–2 – массовая толщина радиоактивного источника; Emax, МэВ – максимальная энергия β-частиц.Масса радиоизотопа является важным параметром при конструировании бетавольтаического преобразователя, поскольку поверхностная активность радиоизотопа сначала возрастает с увеличением массовой толщины, после чего переходит в насыщение из-за эффекта самопоглощения. Оптимизация этого параметра является определяющей при проектировании б.в.и.п. с максимально низкой стоимостью.
Толщина, при которой эффект самопоглощения и видимая активность оптимизированы, для 63Ni составляет ~3 мкм [23]. Увеличение площади поверхности радиоизотопного источника и полупроводникового преобразователя является эффективным способом, позволяющим снизить эффект самопоглощения и повысить плотность мощности до нескольких милливатт на квадратный сантиметр. Для этого в первую очередь необходимо увеличивать активную площадь преобразователя, масштабируя ее горизонтально или вертикально.
Увеличение только горизонтальных размеров планарных структур не дает должного эффекта вследствие неполного использования объема подложки, поскольку активная глубина полупроводникового преобразователя составляет ≈30 мкм.
Увеличение площади преобразователя путем создания глубоких вертикальных микроканалов является наиболее привлекательным направлением для увеличения удельной выходной мощности. Такой шаг технологически сложнее из-за появления дополнительных процессов, однако он позволяет в разы увеличить рабочую площадь, максимально использовать поток β-частиц и создавать структуры с областью пространственного заряда, занимающей все пространство между микроканалами для наиболее эффективного сбора носителей заряда. Пример такой структуры представлен на рис. 3 [35].
Рис. 3.
Полученное с помощью растрового электронного микроскопа изображение микроканальной структуры бетавольтаического преобразователя.
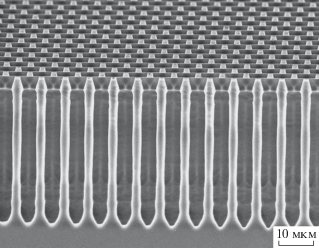
Последовательность технологических операций для создания структур данного типа включает в себя следующие основные процессы:
− фотолитография для задания размеров и расположения микроканалов в подложке;
− глубокое травление для получения микроканалов заданной глубины; расстояние между микроканалами должно быть равно удвоенному значению диффузионной длины неосновных носителей заряда, диаметр выбирается исходя из максимального увеличения площади лицевой поверхности и возможностей технологии нанесения на поверхность микроканалов β-изотопа;
− формирование на микроканальной поверхности p–n-перехода;
− нанесение на поверхность микроканалов β‑изотопа;
− формирование контактов к структуре.
На основе всех обсуждений установлено, что должны соблюдаться следующие принципы проектирования б.в.и.п.
1. Выбор радиоизотопа для б.в.и.п. зависит от конкретной сферы применения и ограничивается периодом полураспада, средней и максимальной энергией β-частиц, наличием побочных продуктов при распаде (γ-лучей). В первую очередь необходимо знать срок службы и требования к питанию в режиме эксплуатации.
2. Максимальная энергия β-частиц должна быть ниже пороговой энергии дефектообразования в полупроводниковом материале. Широкозонные материалы, такие как GaN и SiC, имеют наиболее высокую радиационную стойкость.
3. Для максимального использования энергии радиоизотопа необходимо учитывать эффект самопоглощения и знать геометрию его границ.
5. Увеличение активности радиоизотопа приводит к возрастанию тока короткого замыкания.
6. Контакты должны располагаться по периметру кристалла бетавольтаического преобразователя, необходимо использовать материалы контактных слоев с низким зарядовым числом Z, что снизит обратное рассеяние и поглощение энергии β-частиц.
7. Электроды должны иметь хороший омический контакт с низким контактным сопротивлением.
8. Необходимо определить глубину проникновения β-частиц в бетавольтаический преобразователь. Это имеет важное значение для определения глубины залегания p–n-перехода и области пространственного заряда. Методом Монте-Карло можно определить более точную глубину проникновения β-частиц и их распределение энергии.
9. Ширина области пространственного заряда должна быть такой, чтобы большая часть β-частиц выделяла свою энергию в ней. Большая ширина обедненной области является одним из главных требований при проектировании бетавольтаического преобразователя.
10. Низкая концентрация легирующей примеси подложки увеличивает диффузионную длину неосновных носителей заряда, которая в свою очередь повышает эффективность сбора заряда.
11. Ток утечки зависит от концентрации легирования: он возрастает с уменьшением этой концентрации. При этом напряжение холостого хода сильно зависит от тока утечки, в свою очередь зависящего от собственной концентрации носителей.
12. Бездефектные структуры и пассивация поверхности должны использоваться для снижения потерь, связанных с рекомбинацией носителей заряда.
13. Собственная концентрация носителей зависит от температуры (возрастает с повышением температуры), следовательно, напряжение холостого хода, коэффициент заполнения, эффективность преобразования и выходная мощность при этом уменьшаются. Тем не менее, влияние температуры на ток короткого замыкания незначительно.
14. Использование широкозонных полупроводников увеличивает эффективность преобразования, напряжение холостого хода и выходную мощность, но снижает ток короткого замыкания.
Многие из этих принципов являются взаимоисключающими, следовательно, необходима оптимизация структуры и параметров для каждого конкретного применения.
По принципам проектирования необходимо, чтобы ширина области пространственного заряда была выбрана так, чтобы большинство э.д.п. генерировалось в этой области. Однако подобные ограничения справедливы для полупроводниковых материалов с относительно невысоким временем жизни неосновных носителей заряда.
В случае Si время жизни неосновных носителей заряда составляет несколько десятков и даже сотен микросекунд, что позволяет эффективно разделять носители, генерируемые в квазинейтральной области. Это подтверждено экспериментами при облучении обратной стороны бетавольтаического преобразователя [31, 36].
В связи с этим предложена 3D-конструкция бетавольтаического преобразователя, отличительной особенностью которого является двухстороннее преобразование излучения. Схематично структура представлена на рис. 4.
В данной конструкции чувствительная структура с p–n-переходом, собирающая э.д.п., располагается на лицевой стороне кристалла, отдельно от радиоизотопа. Это позволяет создать p–n-переход высокого качества много меньшей площади и соответственно снизить обратный ток. При этом не возникает технологических проблем с формированием однородности глубины залегания p–n-перехода и его закорачивания при нанесении радиоизотопа. На обратной стороне пластины формируются микроканалы, которые заполняются радиоизотопом.
Выходная мощность бетавольтаического преобразователя повышается за счет генерации носителей в квазинейтральной области. При этом при последовательной сборке б.в.и.п. β-частицы, испускаемые с обратной стороны одного бетавольтаического преобразователя, будут поглощаться лицевой стороной другого бетавольтаического преобразователя, как это показано на рис. 5.
Высокий коэффициент отношения площади, принимающей излучение, к объему кремниевого материала позволяет получать большую мощность на единицу объема преобразователя. Технология изготовления многослойных б.в.и.п. предполагает принцип раздельного изготовления двух “независимых” элементов и последующего их соединения методом “флип-чип”.
Данный способ реализации конструкции имеет свои достоинства, которые заключаются в упрощении технологии изготовления, что позволяет сделать источник питания весьма компактным. Однако существенным недостатком такой технологии является необходимость соединения каждого соответствующего элемента, что технологически трудно осуществить для б.в.и.п. площадью менее 20 мм2.
Технология изготовления предлагаемой структуры состоит из следующей последовательности технологических операций:
− формирование охранного диффузионного кольца вокруг рабочей области для снижения уровня обратного тока и создание геттерного слоя с обратной стороны пластины;
− формирование чувствительного p–i–n-диода с p–n-переходом (0.3–0.4 мкм) на лицевой поверхности;
− формирование микроканалов на тыльной стороне пластины;
− резка пластины на отдельные кристаллы и их отбраковка;
− электрохимическое нанесение 63Ni толщиной 2–3 мкм на тыльную поверхность кристалла;
− сборка б.в.и.п.
5. ЭКСПЕРИМЕНТАЛЬНЫЕ РЕЗУЛЬТАТЫ
5.1. Бетавольтаические преобразователи на основе Si
Большая часть исследований бетавольтаических преобразователей проведена на Si, так как этот материал является доступным и хорошо изученным. Он широко используется в промышленности, его технология микрообработки хорошо развита. В качестве радиоизотопов при изготовлении б.в.и.п. использовались 63Ni, 147Pm и 3Н.
Для оптимизации электрофизических параметров полупроводниковых преобразователей исследовались различные диодные полупроводниковые структуры: с простым p–n-переходом, диоды Шоттки и p–i–n-структуры. Основной конструкцией является плоский р–n-переход.
В работе [3] использовалась простейшая конструкция бетавольтаического преобразователя, созданная по планарной технологии с одной “lift-off” литографией. На рабочую сторону преобразователя с помощью стандартной трехэлектродной установки на слои металлов Ti/Ni (50/20 нм) наносился слой радиоизотопа 63Ni активностью 4 мКи.
Полученный образец обладал следующими характеристиками: Uхх = 0.8 мВ, Iкз = 11 нА, Pmax = = 2.5 пВт. Следует отметить, что эта простая и дешевая технология достаточна для создания б.в.и.п., однако незащищенный p–n-переход, границы которого выходят на поверхность, приводит к большим обратным токам, что значительно снижает эффективность преобразования β-излучения.
Одной из основных причин низкой выходной мощности бетавольтаического преобразователя является изотропное излучение радиоизотопа, поэтому следующим шагом для увеличения эффективности сбора и преобразования энергии β-распада стало использование структур с развитой поверхностью, например инвертированных пирамид, которые хорошо зарекомендовали себя в солнечной энергетике [37].
Пирамидальные углубления, полученные анизотропным травлением, позволили увеличить эффективную площадь поверхности по сравнению с планарной поверхностью. Радиоизотоп 63Ni с различной активностью (2.4, 4, 7 и 10 мКи) гальванически наносился на алюминиевую подложку и служил в качестве источника β-частиц. Использование текстурированной конструкции позволило повысить плотность тока короткого замыкания элемента на 5% по сравнению с планарной конструкцией.
В работе [38] была исследована эффективность преобразования бетавольтаических преобразователей на основе диода Шоттки (Au-Si) и на основе планарного p–n-перехода при облучении β-частицами, испускаемыми радиоизотопами TiT2 и 63Ni, которые были нанесены на металлическую подложку диаметром 12 мм. Активность источников β-частиц составляла 1538 и 296 МБк соответственно.
При облучении тритиевым источником ток короткого замыкания для диода Шоттки более чем в два раза превышал величину тока для p‒n‑перехода, а при облучении радиоизотопом 63Ni токи оставались примерно одинаковыми. Однако бетавольтаический преобразователь на основе диода Шоттки имел повышенное значение обратного тока, что снижало напряжение холостого хода до 100 мВ по сравнению со 140 мВ для p–n-перехода.
В работе [39] были исследованы б.в.и.п. на основе p–i–n-диодов с различными уровнями легирования i-области. Основной задачей было отслеживание образования радиационно-индуцированных дефектов при длительном облучении β-частицами от источника 63Ni с активностью 2.2 мКи. Результаты исследования показали, что для б.в.и.п. с низкой концентрацией легирующей примеси в i-области эффективность преобразования энергии β-частиц не изменялась. При этом были получены следующие параметры: Uхх = 28 мВ, Iкз = 27.36 нА, Pmax = = 0.7 нВт.
Изотропия излучения β-частиц стала причиной появления сендвичных бетавольтаических преобразователей, в которых поглощение осуществляется в двух направлениях [40]. Была предложена и разработана конструкция, в которой источник 63Ni помещался между двумя последовательно соединенными бетавольтаическими преобразователями. Полученный образец при комнатной температуре обладал следующими характеристиками: Uхх = 0.2 мВ, Iкз = 10 нА, Pmax = 6 пВт.
Современная тенденция разработок бетавольтаических преобразователей направлена на создание трехмерных конструкций и технологий, позволяющих более эффективно осуществлять сбор β-частиц и генерируемых носителей заряда при одинаковом с планарной конструкцией занимаемом объеме. В одних из первых работ по 3D-конструкциям [41, 42] был предложен трехмерный кремниевый диод, сформированный глубоким (50–80 мкм) анодным травлением.
Используя разупорядоченную морфологию пор, исследователи добились максимальной площади поверхности, которая составила 116 см2, при размере кристалла 2.4 × 2.4 см. В качестве источника β‑частиц использовался газообразный 3H. В данной конструкции не только увеличена активная площадь структуры, но и отсутствует проблема изотропного излучения β-частиц, а также снижено обратное рассеяние.
В результате выходная мощность б.в.и.п. с пористой поверхностью значительно выросла в связи с увеличением напряжения холостого хода и тока короткого замыкания. Так как 3H является газом, то он полностью заполняет микроканалы, и в этом случае практически все излучение преобразуется в электрический ток, что выразилось в увеличении к.п.д. в 10 раз по сравнению с плоской конструкцией, однако его номинальное значение составило всего 0.22%.
В работе [43] 3D-структура также формировалась глубоким анодным травлением, в качестве источника β-излучения предполагалось использование изотопа 63Ni. Однако из-за его отсутствия исследователями в качестве источника электронов применялась электронная пушка с энергией падающих электронов 15 кэВ, что близко к средней энергии β-частиц 63Ni (17 кэВ).
Заполнение микроканалов никелем осуществлялось с использованием нерадиоактивной никелевой соли из электролита Уоттса. Исследовались преобразователи двух типов: планарный p–n-переход на кремнии p-типа и p–n-переход, сформированный в слое макропористого кремния. Установлено, что эффективность устройств на основе макропористого кремния значительно превосходит таковую для планарных конструкций. На электронно-лучевой имитации были получены удельные мощности 0.46 и 1.5 нВт/см2 соответственно для планарных и трехмерных p–n-переходов.
Технология изготовления и заполнения неупорядоченной пористой структуры изотопом 63Ni была предложена в работе [44]. Осаждение никелевого слоя на внутреннюю поверхность микроканальных структур происходило по реакции замещения кремния из водного электролита состава 154.76 г/л NiSO4 + 92.55 г/л NH4F + 0.88 г/л кумарина с добавлением лаурилсульфата натрия в качестве смачивающего агента при плотности тока 10 мА/см2 и температуре 60°С. Толщина стенки никелевого покрытия составляла 1 мкм, а внутренний диаметр никелевой трубки – 4 мкм.
Большое разнообразие исследований производительности б.в.и.п. на основе Si имеет место благодаря различным типам полупроводниковых переходов и конструкций, а также радиоизотопам с различной активностью. Увеличение площади поверхности кремниевых бетавольтаических преобразователей будет наилучшим направлением оптимизации конструкций из-за их более высокой выходной мощности при одинаковом с планарными конструкциями занимаемом объеме.
Трехмерные структуры, независимо от использования радиоизотопа, позволяют достигать более высокой эффективности преобразования. Однако создание элементов с такой конструкцией представляет собой ряд сложных и пока не до конца решенных технологических задач, прежде всего, из-за высоких значений тока утечки, а также отсутствия промышленной технологии заполнения щелей или микроканалов радиоизотопом.
При моделировании для Si и 63Ni с активностью 10 мКи/см2 были получены следующие параметры: напряжение холостого хода – 0.35 В, плотность тока короткого замыкания – 157 нА/см2, коэффициент полезного действия – 3.17% [45]. Однако экспериментальные результаты, даже для планарных конструкций, оказались значительно ниже, чем результаты моделирования: напряжение холостого хода – до 0.15 В, ток короткого замыкания – до 70 нА/см2, а эффективность преобразования около 1%. Максимальная экспериментальная плотность мощности для кремниевого б.в.и.п. на основе 63Ni составила 6 нВт/см2. Результаты разработок остальных б.в.и.п. на основе Si представлены в разделе Заключение.
5.2. Бетавольтаические преобразователи на основе SiC
4H-SiC является гексагональным политипом карбида кремния, который имеет ширину запрещенной зоны 3.3 эВ. Наличие высококачественных подложек и преимущество в эпитаксиальной технологии роста пленок делает 4H-SiC лучшим материалом для применения в бетавольтаике. Он имеет высокую теплопроводность, температурную стабильность, радиационную стойкость и высокую электронную подвижность.
Результаты моделирования и экспериментов по исследованию структур с барьером Шоттки и р–n-переходом на основе SiC и 4H-SiC были описаны в нескольких работах. В структурах в качестве радиоизотопного источника использовались 63Ni и T. При моделировании для SiC и 63Ni были получены следующие параметры: напряжение холостого хода – 2.53 В, плотность тока короткого замыкания – 152 нА/см2, коэффициент полезного действия – 11.8% [46].
Еще одной особенностью карбид-кремниевых бетавольтаических преобразователей является значительно пониженное влияние температуры [14]. В диапазоне 25–150°С изменение сопротивления составляет всего лишь 20%, что очень мало по сравнению с аналогичным показателем для кремниевых приборов (200%). Однако для достижения требуемых электронных свойств и большого времени жизни в SiC необходимо добиться высокой степени структурного совершенства получаемых кристаллов при достаточной для дальнейшей сборки площади.
В работе [10] в качестве преобразователя использовался p–n-переход на основе 4H-SiC, а в качестве источника β-излучения – 63Ni с активностью 1 мКи, эффективность преобразования при этом составила 6%. Однако следует отметить, что указанные параметры были получены на образцах площадью 500 × 500 мкм2, при этом напряжение холостого хода составило 0.72 В, а плотность тока короткого замыкания – 16.8 нА/см2.
Бетавольтаические преобразователи на основе диода Шоттки были исследованы в работах [47, 34 ]. В качестве полупроводникового материала использовалась подложка 4H-SiC, на которую в качестве контакта Шоттки наносился слой Ni в одном случае толщиной 200 нм [47], а в другом – 400 нм [34]. Разработанные образцы подвергались облучению β-частицами, испускаемыми радиоизотопом 63Ni с активностью 5 мКи/см2 [47] и 0.12 мКи [34], при этом эффективность преобразования составила 1.01 и 1.2% соответственно. Напряжение холостого хода, полученное на образцах, составило 0.49 В [34] и 0.27 В [47], а максимальная плотность тока короткого замыкания – 30 нА/см2 [34] и 25.5 нА/см2 [47] соответственно.
При изготовлении образцов б.в.и.п. на основе SiC используется подложка толщиной 300–500 мкм, однако активны только 20 мкм. Дальнейшие разработки с использованием технологии утонения подложки до 50 мкм значительно улучшили выходные параметры б.в.и.п. [48]. По сообщению исследователей, была достигнута рекордная эффективность преобразования, которая составила 22.3%.
Барьер Шоттки на 4H-SiC показал плотность мощности, аналогичную максимальной плотности мощности преобразователя на основе Si, а р–n-переход на основе 4H-SiC имел немного более высокую плотность выходной мощности. Экспериментальные результаты показали по сравнению с кремнием увеличение напряжения холостого хода в 4.6 раза и уменьшение тока короткого замыкания в 2.7. Следует также отметить, что активная площадь исследуемых структур не превышала 0.03 см2. Достигнутые параметры разработанных б.в.и.п. на основе карбида кремния представлены в разделе Заключение.
5.3. Бетавольтаические преобразователи на основе GaAs
В работах [49–51] представлены результаты исследования различных структур на основе GaAs, таких как p–n, p–i–n и p+–p–i–n–n+. В этих работах изучались конструктивно-технологические особенности бетавольтаических преобразователей на основе GaAs и радиоизотопа 63Ni. Тестовые структуры выращивались методом молекулярно-лучевой эпитаксии, на них формировались омические контакты и проводились исследования влияния концентрации легирующей примеси, толщин слоев и конфигурации электродов на выходные характеристики б.в.и.п.
При удельной активности радиоизотопа 63Ni 10 мКи/см2 напряжение холостого хода оптимизированных б.в.и.п. составило 0.3 В, а плотность тока короткого замыкания – 36 нА/см2. Эффективность преобразования и выходная мощность б.в.и.п. со структурой p+–p–i–n–n+ в 1.45 раза выше, чем у б.в.и.п. с p–i–n-структурой.
В работах [33, 52] проводилось исследование влияния температуры окружающей среды на выходные параметры бетавольтаических преобразователей. Результаты показали, что ток насыщения увеличивался с повышением температуры, а напряжение холостого хода, максимальная мощность и эффективность преобразования возрастали с понижением температуры. Основные параметры разработанных б.в.и.п. на основе арсенида галлия представлены в разделе Заключение.
5.4. Бетавольтаические преобразователи на основе GaN
Ширина запрещенной зоны GaN составляет 3.4 эВ. У исследователей этот материал является вторым по популярности после Si. Помимо радиоизотопа 63Ni, также использовался радиоизотоп 147Pm. Моделирование и экспериментальные работы по исследованию структур на основе GaN представлены в публикациях [53–55].
В работе [56] приведены результаты разработки б.в.и.п. с p–i–n-структурой на основе GaN и радиоизотопов 63Ni и 147Pm с активностью 5 мКи/см2 в качестве источников β-частиц. Структура бетавольтаических преобразователей изготавливалась металлоорганическим осаждением из газовой фазы (metalorganic chemical vapour deposition – MOCVD), толщина i-слоя составляла 8 мкм с концентрацией примеси 1.4 ⋅ 1015 см–3.
При облучении радиоизотопом 63Ni напряжение холостого хода составило 0.47 В, а ток короткого замыкания – 4.87 нА/см2, при облучении 147Pm соответствующие параметры составили 1.07 В и 6.68 нА/см2. Коэффициент заполнения в обоих случаях не превышал 25%.
В работе [57] описан б.в.и.п. на основе GaN с барьером Шоттки, в качестве источника β-частиц использовался 63Ni с активностью 3 мКи/см2. Структура бетавольтаического преобразователя изготавливалась металлоорганическим осаждением из газовой фазы (MOCVD), толщина i-слоя составляла 8 мкм с концентрацией примеси 1.4 ⋅ 1015 см–3. Напряжение холостого хода составило 0.1 В, а плотность тока короткого замыкания – 1.2 нА/см2. Низкая выходная мощность бетавольтаического преобразователя обусловлена в первую очередь низкой эффективностью полупроводникового слоя, толщина которого не превышает 200 нм, что не позволяет поглощать большую часть энергии β‑частиц. Другая часть β-частиц была поглощена и отражена в мертвом слое контакта Шоттки. Тем не менее, полученные значения напряжения холостого хода и эффективности преобразования сопоставимы с аналогичными параметрами планарных кремниевых б.в.и.п.
В работе [58] описан б.в.и.п. на основе GaN. Для создания высокоомного слоя осуществлялось дополнительное легирование Fe i-области, что привело к увеличению напряжения холостого хода до 1.62 В. Область i-типа представляет собой легированную область с высокой фоновой концентрацией электронных носителей (например, как в области n-типа) из-за примесей. Введение Fe позволило скомпенсировать фоновую примесь и увеличить ширину области пространственного заряда.
В эксперименте использовался внешний источник β-частиц – радиоизотоп 63Ni с активностью 2 мКи площадью 4 × 4 мм2, при этом ток короткого замыкания составил 640 пА, а эффективность преобразования – 1.13%.
Структуры на основе GaN показали более высокое напряжение холостого хода, чем кремниевые структуры, но плотность тока короткого замыкания была существенно ниже при эквивалентной активности. Тем не менее, плотность выходной мощности этих структур выше, чем максимальная плотность мощности для кремниевой структуры. Однако экспериментальные результаты оказались заметно ниже результатов, полученных при моделировании.
Таблица 3.
Экспериментальные результаты б.в.и.п. на основе 63Ni
| Материал (тип перехода) | Uxx, В | Jкз, нА · см–2 | Pmax, нВт · см–2 | η, % | FF, % | S, см2 | А, мКи · см–2 |
|---|---|---|---|---|---|---|---|
| Si (p–n) [3, 62] | 0.0008 | 11 (нА) | 2.5 (пВт) | – | 28.4 | – | 4 |
| Si (p–n) [37] | 0.082 | 54 | – | – | – | 1 | 10 |
| Si (p–n) [38] | 0.068 | 25 | 0.66 | 0.094 | 39 | 1.13 | 7.07 |
| Si (Шоттки) [38] | 0.041 | 21.85 | 0.3 | 0.043 | 33 | 1.13 | |
| Si (p–n) [40] | 0.002 | 40 | 0.01 | – | 33.7 | 0.25 | 5 |
| Si (p–i–n) [39] | 0.028 | 27.36 | 0.766 | 0.042 | – | 1 | 8 |
| Si (p–n) [33] | 0.05 | 17 | – | 0.045 | – | 0.25 | 5 |
| Si (p–i–n) [63] | 0.074 | 19.74 | 0.586 | – | 39.8 | 0.25 | 4.9 |
| 0.058 | 8.75 | 0.184 | – | 36.2 | 0.25 | 1.96 | |
| Si (p–i–n) [36] | 0.151 | 72.9 | 6.14 | 0.6 | 55.4 | 1 | 10 |
| Si (p–n) [14] | 0.15 | 133 | 11.6 | 2.5 | 58 | 1 | Электронный луч |
| Si (p–n) [64] | 0.16 | 133 | 12.3 | 2.65 | 58 | 0.64 | Электронный луч |
| Si (3D p–n) [43] | 0.125 | 25 | 1.56 | – | – | – | Электронный луч |
| 4H-SiC (p–n) [10] | 0.72 | 16.8 | 6.16 | 6 | 51 | 0.0025 | 4 |
| 4H-SiC (Шоттки) [34] | 0.49 | 29.44 | 4.85 | 1.2 | 34 | 0.0147 | 5 |
| 4H-SiC (Шоттки) [47] | 0.27 | 25.6 | 4.08 | 1.01 | 59 | 0.0314 | 0.12 (мКи) |
| 4H-SiC (Шоттки) [65] | 0.26 | 13.82 | 2.04 | 0.5 | 57 | 0.0314 | 4 |
| 4H-SiC (Шоттки) [64] | 0.7 | 47.8 | 15.1 | 3.12 | 45 | 0.03 | Электронный луч |
| GaAs (p–n) [33] | 0.05 | 4.5 | – | 0.07 | – | 1 | 5 |
| GaAs (p+–p–i–n–n+) [49] | 0.324 | 0.36 | 0.07 | – | 61 | 9 | 10 |
| GaAs (p–i–n) [66] | 0.295 | 29.72 | – | – | – | 0.25 | 10 |
| GaAs (p–i–n) [67] | 0.295 | 36 | – | – | – | 0.25 | 0 |
| GaAs (p–n) [51] | 0.3 | 23.32 | – | – | – | 0.25 | 16 |
| GaAs (p–i–n) [52] | 0.16 | 15.92 | 0.71 | – | 28 | 0.001 | 0.1 |
| GaN (p–i–n) [56] | 0.47 | 4.87 | 0.57 | – | 21.7 | 0.07 | 5 |
| GaN (Шоттки) [57] | 0.1 | 1.2 | – | 0.32 | – | 0.01 | 3 |
| GaN (p–i–n) [58] | 1.62 | 16 | 14.25 | 1.13 | 55 | 0.04 | 12.5 |
| GaN (p–i–n) [68] | 1.19 | 4.71 | 3.23 | 0.3 | 57.6 | 0.785 | 10.2 |
| GaN (p–i–n) [69] | 1.64 | 14.2 | 12.25 | 0.98 | 53 | 0.04 | 12.5 |
| GaN (p–i–n) [70] | 0.3 | 1.2 | 0.17 | 0.012 | 46 | 0.16 | 50 |
| GaN (p–i–n) [53] | 0.8 | 1.4 | 1.04 | 0.016 | 47 | 1 | 32.5 |
| C (Шоттки) [61] | 1.68 | 3.66 | 3 | 0.6 | 49 | 15 | 5 |
Структура p–i–n-типа на основе GaN показала максимальную эффективность по сравнению со структурами других типов на основе GaN. Максимальный к.п.д. б.в.и.п. составил 1.13% [58], что значительно ниже, чем теоретическая эффективность, связано это с технологическими ограничениями.
В настоящее время MOCVD является основным методом, используемым для выращивания GaN-структур, однако этим методом очень трудно формировать высококачественные, достаточно толстые пленки GaN с высоким удельным сопротивлением. Нелегированные слои GaN, выращенные на сапфировых подложках, из-за остаточных примесей имеют электронную удельную проводимость с концентрацией n > 5 ⋅ 1016 cм–3. Кроме того, концентрация дырок находится в ограниченном диапазоне, 1–5 ⋅ 1017 см–3 [59, 60]. Основные параметры разработанных б.в.и.п. на основе нитрида галлия представлены в разделе Заключение.
5.5. Бетавольтаические преобразователи на основе алмаза
С недавних пор в научной литературе стали появляться публикации, в которых оценивается применимость для бетавольтаических преобразователей такого материала, как синтетический алмаз. Его ширина запрещенной зоны составляет 5.5 эВ. В работе [61] рассматривается перспективность использования барьера Шоттки на основе полупроводникового алмаза в качестве преобразователя энергии ионизирующего излучения.
Алмазные подложки, легированные бором, формируются методом высоких статических давлений и температур (high pressure high temperature – HPHT), затем химическим осаждением из паровой фазы (chemical vapour deposition – CVD) осаждается p-слой низколегированного алмаза высокой степени чистоты. Для создания контакта с барьером Шоттки используется тонкий (10–20 нм) слой платины.
Для оценки работоспособности бетавольтаического преобразователя на основе алмаза использовалось несколько изотопов: 63Ni, 147Pm, 90Sr, 238Pu. Никелевый источник представлял собой диск диаметром 50 мм с нанесенным слоем радиоизотопа 63Ni с активностью 5 мКи/см2. Напряжение холостого хода при облучении этим источником составило 1.68 В, ток короткого замыкания – 55 нА, выходная мощность – 3 нВт/см2. Эффективность преобразования β-частиц, испускаемых радиоизотопом 63Ni, составила 0.6%. При использовании β-источника 147Pm с активностью 45 мКи/см2 выходная мощность достигала 167 нВт/см2, при этом эффективность преобразования составила 1%.
6. ЗАКЛЮЧЕНИЕ
Большая плотность энергии, длительный срок службы и возможность интеграции в полупроводниковую технологию являются преимуществами б.в.и.п. по сравнению с химическими батареями. Проектирование б.в.и.п. включает в себя оптимизацию как радиоизотопного, так и полупроводникового материала. Выбор радиоизотопа определяется максимальной энергией его β-частиц и сферой применения. Полезная энергия увеличивается путем снижения самопоглощения энергии в радиоизотопе и за счет геометрического масштабирования поверхности преобразователя. Моделирование методом MCNP позволяет с высокой точностью определить глубину проникновения и распределения энергии в полупроводнике с использованием полного спектра β-частиц.
Глубина p–n-перехода и ширина области пространственного заряда должны быть определены по результатам моделирования. Низкая концентрация легирующей примеси увеличивает обедненную область, что, в свою очередь, приводит к возрастанию тока короткого замыкания за счет увеличения сбора заряда. С другой стороны, низкая концентрация легирующей примеси приводит к увеличению тока утечки, который в свою очередь уменьшает напряжение холостого хода. Таким образом, для получения максимальной выходной мощности концентрация легирующей примеси также может быть оптимизирована по результатам приборно-технологического моделирования. Толщина полупроводникового материала определяется диффузионной длиной неосновных носителей заряда и шириной области пространственного заряда.
Бетавольтаические источники питания на основе барьера Шоттки используются в основном для широкозонных полупроводников (SiC и C), так как они проще в изготовлении, чем р–n-переход. Тем не менее, б.в.и.п. на основе p–n-перехода показали лучшие результаты. Обобщенные результаты исследований б.в.и.п. приведены в табл. 3.
Изложенный сравнительный анализ удельных характеристик, полученных в последнее время с применением 63Ni в качестве источника β-излучения, показывает перспективность исследований с использованием таких полупроводниковых материалов, как карбид кремния, нитрид галлия и синтетический алмаз.
С целью увеличения выходной мощности разрабатываются и исследуются сложные объемные микро- и наноструктурированные 2D- и 3D-полупроводниковые структуры, отрабатываются технологии изготовления качественных p–n-переходов сложных форм, омических контактов, а также методы микросборки элементарных б.в.и.п. в батарею с заданными электрофизическими и габаритными параметрами вертикальной или горизонтальной архитектуры.
Анализ экспериментальных данных показал, что диапазон напряжения холостого хода составляет 0.01–1.7 В, тока короткого замыкания – от 0.3 до 133 нА/см2, максимальной выходной мощности – от 0.01 до 15 нВт/см2 и эффективности преобразования – от 0.04 до 6%.
Максимальная плотность тока короткого замыкания 72.9 нА/см2 была получена для источников питания на основе Si, максимальная выходная мощность 14.25 нВ/см2 – для б.в.и.п. на основе GaN. Это лучшие экспериментальные результаты среди всех б.в.и.п. на основе 63Ni. Максимальное напряжение холостого хода 1.68 В получено для б.в.и.п. на основе C, а к.п.д. 6% – для б.в.и.п. на основе 4H-SiC. Широкозонные полупроводники, например GaN и SiC, обеспечивают более высокое напряжение холостого хода, выходную мощность и эффективность по сравнению с Si, однако токи короткого замыкания у Si выше.
Производительность б.в.и.п. зависит не только от типа полупроводникового материала, но и от типа перехода, изотопа и его активности. Также необходимо отметить, что ток короткого замыкания и максимальная выходная мощность представлены в наноамперах и нановаттах на квадратный сантиметр, однако габаритные размеры большинства б.в.и.п. выражаются в квадратных миллиметрах или квадратных микрометрах. Увеличение площади поверхности будет наилучшим направлением оптимизации конструкций из-за их более высокой выходной мощности.
Направлением будущих исследований является оптимизация структур бетавольтаических преобразователей по соотношению объема к выделяемой энергии. Утоненные до толщин 40–100 мкм пластины позволят создавать планарные “тонкие” конструкции с размерами квазинейтральных областей и областей пространственного заряда, близкими к оптимальным. Направление создания трехмерных структур, связанное со сборкой тонких планарных структур, перспективно для проведения технологических работ в этом направлении.
Исходя из экономических требований и все большей миниатюризации электронных приборов, материалы должны обладать высоким структурным совершенством и однородностью состава в объемах порядка микрометра и менее. Несмотря на множество исследований, к настоящему моменту в мире отсутствуют технологии создания миниатюрных радиоизотопных источников электроэнергии, выходная мощность которых была бы достаточна для электрического питания микроприборов. Однако на основе б.в.и.п. возможно создание функционально-интегрированных устройств, расположенных на одном кристалле, например: прецизионных датчиков температуры [71], гибридных солнечных элементов [72] или датчиков контроля угла поворота и скорости вращения оси [73].
Список литературы
Adams T.E., Revankar S.T. // 122nd ASEE Annual Conference & Exposition. Seattle, WA, 2015. Paper ID № 13983. P. 26.1334.1.
Revankar S.T., Adams T.E. // J. Energy Power Sources. 2014. V. 1. № 6. P. 321.
Ulmen B., Desai P.D., Moghaddam S., Miley G.H., Masel R.I. // J. Radioanal. Nucl. Chem. 2009. V. 282. P. 601. https://doi.org/10.1007/s10967-009-0320-3
Ehrenberg W. // Proc. Royal Society. 1951. V. 64. P. 424.
Rappaport P. // Phys. Rev. 1953. V. 93. P. 246.
Rappaport P., Loferski J.J., Linder E.G. // RCA Review. 1956. V. 17. P. 100.
Rappaport P. Google Patents US2745973A, 1956.
Nejad G.R.G., Rahmani F., Abaeiani G.R. // Applied Radiation and Isotopes. 2014. V. 86. P. 46. https://doi.org/10.1016/j.apradiso.2013.12.027
Liu Y., Tang X., Xu Z., Hong L., Chen D. // Applied Radiation and Isotopes. 2014. V. 94. P. 152. https://doi.org/10.1016/j.apradiso.2014.08.011
Chandrashekhar M.V.S., Thomas C.I., Hui Li, Spencer M.G., Lal A. // Applied Phys. Lett. 2006. V. 88. P. 033506. https://doi.org/10.1063/1.2166699
Olsen L.C. // Review of Betavoltaic Energy Conversion. NASA TECDOC 19940006935. 1973. P. 256. https://archive.org/details/nasa_techdoc_19940006935 (accessed August 23, 2014).
Klein C.A. // Journal of App. Phys. 1968. V. 39. № 4. P. 2029.
Yacobi B.G., Holt D.B. Cathodoluminescence Microscopy of Inorganic Solids. NY.: Plenum, 1990.
Поликарпов М.А., Якимов Е.Б. // Физика и техника полупроводников. 2015. Т. 49. Вып. 6. С. 763. https://doi.org/10.1134/S1063782615060202
Shapiro J. Radiation Protection: A Guide For Scientists, Regulators, and Physicians. La Editorial. UPR, 2002.
Prelas M.A., Weaver C.L., Watermanna M.L., Lukosi E.D., Schott R.J., Wisniewski D.A. // Progress in Nucl. Energy. 2014. V. 75. P. 117. https://doi.org/10.1016/j.pnucene.2014.04.007
Ellis B.L., Fritzsche H., Patel J., Lang J., Suppiah S. // Fusion Science and Technology. 2017. V. 71. P. 660. https:// dx.doi.org/https://doi.org/10.1080/15361055.2017.1290952
Hao Li, Yebing Liu, Rui Hu, Yuqing Yang, Guanquan Wang, Zhengkun Zhong, Shunzhong Luo // Applied Radiation and Isotopes. 2012. V. 70. P. 2559. https://doi.org/10.1016/j.apradiso.2012.07.012
Лазаренко Ю.В., Пустовалов А.А., Шаповалов В.П. // Малогабаритные ядерные источники электрической энергии. М.: Энергоатомиздат, 1992.
Марухин О.В., Пикулев А.А. // ВАНТ. Серия: Физика ядерных реакторов. 2000. № 2. С. 55.
Murashev V.N., Mordkovich V.N., Legotin S.A., Rabinovich O.I., Krasnov A.A. // Journal of Nano- and Electronic Physics. 2014. V. 6. № 4. P. 04012(2pp).
Olsen L.C., Cabauy P., Elkind B.J. // Physics Today. 2012. V. 65. № 12. P. 35. https://doi.org/10.1063/PT.3.1820
Yun-peng Liu, Xiao-bin Tang, Zhi-heng Xu, Liang Hong, Hao Wang, Min Liu, Da Chen // J. Radioanal. Nucl. Chem. 2015. V. 304. P. 517. https://doi.org/10.1007/s10967-014-3879-2
http://www.ioffe.ru/SVA/NSM/
Svintsov A.A., Krasnov A.A., Polikarpov M.A., Polyakov A.Y., Yakimov E.B. // Applied Radiation and Isotopes. 2018. V. 137. P. 184. https://doi.org/10.1016/j.apradiso.2018.04.010
Goldstein J.I., Newbury D.E., Joy D.C., Lyman C.E., Echlin P., Lifshin E., Sawyer L., Michael J.R. Scanning Electron Microscopy and X-Ray Microanalysis. NY.: Kluwer Academic/Plenum Publishers, 2003.
Phua P.C., Ong V.K.S. // IEEE Transactions on Electron Devices. 2002. V. 49. № 11. P. 2036. https://doi.org/10.1109/TED.2002.804703
Guoping Zuo, Jianliang Zhou, Guotu Ke // Applied Radiation and Isotopes. 2013. V. 82. P. 119. https://doi.org/10.1016/j.apradiso.2013.07.026
Alam T.R., Spencer M.G., Prelas M.A., Pierson M.A. // Int. J. Energy Res. 2018. V. 42. № 7. P. 2564. https://doi.org/10.1002/er.4053
Tang Xiao Bin, Ding Ding, Liu Yun Peng, Chen Da // Science China Technological Sciences. 2012. V. 55. № 4. P. 990. https://doi.org/10.1007/s11431-012-4752-6
Krasnov A.A., Legotin S.A., Omel’chenko Yu.K., Didenko S.I., Murashev V.N., Rabinovich O.I., Yurchuk S.Yu., Yaromsky V.P., Popkova A.V. // Journal of Nano- and Electronic Physics. 2015. V. 7. № 4. P. 04004(4pp).
Liu Yunpeng, Guo Xiao, Jin Zhangang, Tang Xiaobin // Applied Radiation and Isotopes. 2018. V. 135. P. 47. https://doi.org/10.1016/j.apradiso.2018.01.017
Hao Wang, Xiao-Bin Tang, Yun-Peng Liu, Zhi-Heng Xu, Min Liu, Da Chen // Nucl. Instrum. and Methods in Phys. Res. B. 2015. V. 359. P. 36. https://doi.org/10.1016/j.nimb.2015.07.046
Qiao D.Y., Zheng Y.W., Peng G., Wang Y.X., Bo Z., Lin Z., Guo H., Zhang H. // Chinese Physics Letters. 2008. V. 25. P. 3798. https://doi.org/10.1088/0256-307X/25/10/076
Starkov V.V., Legotin S.A., Krasnov A.A., Murashev V.N., Omel’chenko Yu.K., Rabinovich O.I., Laryushkin A.S. // Journal of Nano- and Electronic Physics. 2015. V. 7. № 4. P. 04047(2pp).
Krasnov A., Legotin S., Kuzmina K., Ershova N., Rogozev B. // Nucl. Engineering and Technology. 2019. V. 51. P. 1978. https://doi.org/10.1016/j.net.2019.06.003
Jinkui Chu, Xianggao Piao, Limin Jian, Hui Lin // J. of Micro/Nanolithography, MEMS, and MOEMS. 2009. V. 8. № 2. P. 021180. https://doi.org/10.1117/1.3152000
Liu Y., Hu R., Yang Y., Wang G., Luo S., Liu N. // Applied Radiation and Isotopes. 2012. V. 70. P. 438. https://doi.org/10.1016/j.apradiso.2011.10.013
Gao H., Luo S., Zhang H., Wang H., Fu Z. // Energy. 2013. V. 51. P. 116. https://doi.org/10.1016/j.energy.2012.12.042
Liu Yun Peng, Tang Xiao Bin, Xu Zhi Heng, Hong Liang, Wang Peng, Chen Da // Science China Technological Sciences. 2014. V. 57. № 1. P. 14. https://doi.org/10.1007/s11431-013-5413-0
Sun W., Kherani N.P., Hirschman K.D., Gadeken L.L., Fauchet P.M. // Advanced Materials. 2005. V. 17. № 10. P.1230. https://doi.org/10.1002/adma.200401723
Clarkson J.P., Sun W., Hirschman K.D., Gadeken L.L., Fauchet P.M. // Phys. Status Solidi A. 2007. V. 204. № 5. P. 1536. https://doi.org/10.1002/pssa.200674417
Dolgyi A., Redko S., Bandarenka H., Shapel A., Bondarenko V. // Beta-battery based on 63Ni/macroporous silicon. Abstract № 359. Honolulu PRiME. The Electrochemical Society, 2012.
Krasnov A.A., Starkov V.V., Legotin S.A., Rabinovich O.I., Didenko S.I., Murashev V.N., Cheverikin V.V., Yakimov E.B., Fedulova N.A., Rogozev B.I., Laryushkin A.S. // Applied Radiation and Isotopes. 2017. V. 121. P. 71. https://doi.org/10.1016/j.apradiso.2016.12.019
Rahmani F., Khosravinia H. // Radiation Physics and Chemistry. 2016. V. 125. P. 205. https://doi.org/10.1016/j.radphyschem.2016.04.012
Yu-Min Liu, Jing-Bin Lu, Xiao-Yi Li, Xu Xu, Rui He, Hui-Dong Wang // Nucl. Scie. Tech. 2018. V. 29. P. 168. https://doi.org/10.1007/s41365-018-0494-x
Xiao-Ying Li, Yong Ren, Xue-Jiao Chen, Da-Yong Qiao, Wei-Zheng Yuan // J. Radioanal. Nucl. Chem. 2011. V. 287. P.173. https://doi.org/10.1007/s10967-010-0746-7
Tin S., Lal A. // // Power MEMS 2009. Washington DC. USA. December 1–4, 2009. P. 189.
Li Da-Rang, Jiang Lan, Yin Jian-Hua, Tan Yuan-Yuan, Lin Nai // Chin. Phys. Lett. 2012. V. 29. № 7. P. 078102. https://doi.org/10.1088/0256-307X/29/7/078102
Haiyanag Chen, Lan Jiang, Xuyuan Chen // J. Phys. D: Appl. Phys. 2011. V. 44. P. 215303 (4pp). https://doi.org/10.1088/0022-3727/44/21/215303
Chen Hai-Yang, Jiang Lan, Li Da-Rang // Chin. Phys. Lett. 2011. V. 28. № 5. P. 058101. https://doi.org/10.1088/0256-307X/28/5/058101
Butera S., Lioliou G., Barnett A.M. // Applied Radiation and Isotopes. 2017. V. 125. P. 42. httpa://dx.doi.org/https://doi.org/10.1016/j.apradiso.2017.04.002
Munson C.E., Gaimard Q., Merghem K., Sundaram S., Rogers D.J., de Sanoit J., Voss P.L., Ramdane A., Salvestrini J.P., Ougazzaden A. // J. Phys. D: Appl. Phys. 2017. V. 5. № 3. P. 035101. https://doi.org/10.1088/1361-6463/aa9e41
Hogan K., Litz M., Shahedipour-Sandvik F. // Applied Radiation and Isotopes. 2019. V. 145. P. 154. https://doi.org/10.1016/j.apradiso.2018.12.032
Tang XiaoBin, Liu YunPeng, Ding Ding, Chen Da // Scie. China. Technol. Scie. 2012. V. 55. P. 659. https://doi.org/10.1007/s11431-011-4739-8
Li Feng Hua, Gao Xu, Yuan Yuan Lin, Yuan Jin She, Lu Min // Scie. China Technol. Scie. 2014. V. 57. № 1. P. 25. https://doi.org/10.1007/s11431-013-5422-z
Min Lu, Guo-guang Zhang, Kai Fu, Guo-hao Yu, Dan Su, Ji-Feng Hu // Energy Conversion and Management. 2011. V. 52. P. 1955. https://doi.org/10.1016/j.enconman.2010.10.048
Cheng Zai-Jun, San Hai-Sheng, Chen Xu-Yuan, Liu Bo, Feng Zhi-Hong // Chin. Phys. Lett. 2011. V. 28. № 7. P. 078401. https://doi.org/10.1088/0256-307X/28/7/078401
Look D.C., Molnar P.J. // Appl. Phys. Lett. 1997. V. 70. P. 3377.
Cheong M.G., Kim K.S., Oh C.S., Namgung N.W., Yang W.G.M., Lim K.Y., Suh E.K., Nahm K.S., Lee H.J., Lim D.H., Yoshikawa A. // Appl. Phys. Lett. 2000. V. 77. P. 2557.
Bormashov V., Troschiev S., Volkov A., Tarelkin S., Korostylev E., Golovanov A., Kuznetsov M., Teteruk D., Kornilov N., Terentiev S., Buga S., Blank V. // Phys. Status Solidi A. 2015. V. 212. № 11. P. 2539. https://doi.org/10.1002/pssa.201532214
Miley G.H., Ulmen B., Desai P.D., Moghaddam S., Masel R.I. // 7th International Energy Conversion Engineering Conference. 2–5 August 2009. Denver, Colorado, P. 25. https://doi.org/10.2514/6.2009-4601
Liu Yun Peng, Xu Zhi Heng, Wang Hao, Tang Xiao Bin // Scie. China. Technol. Scie. 2017. V. 60. P. 282. https://doi.org/10.1007/s11431-016-0505-x
Зайцев С.И., Павлов В.Н., Панченко В.Я., Поликарпов М.А., Свинцов А.А., Якимов Е.Б. // Поверхность. Рентгеновские, синхронные и нейтронные исследования. 2014. № 9. С. 9. https://doi.org/10.7868/S0207352814090248
Da-Yong Qiao, Xue-Jiao Chen, Yong Ren, Wei-Zheng Yuan // Journal of Microelectromechanical Systems. 2011. V. 20. № 3. P. 685. https://doi.org/10.1109/JMEMS.2011.2127448
Chen Haiyang, Li Darang, Yin Jianhua, Cai Shengguo // Chinese Institute of Electronics. 2011. V. 32. № 9. P. 17. https://doi.org/10.1088/1674-4926/32/9/094009
Chen Haiyang, Yin Jianhua, Li Darang // Chinese Institute of Electronics. 2011. V. 32. № 8. P. 084006. https://doi.org/10.1088/1674-4926/32/8/084006
Wang Guan-Quan, Li Hao, Lei Yi-Song // Nucl. Scie. and Techniques. 2014. V. 25. P. 020403. https://doi.org/10.13538/j.1001-8042/nst.25.020403
Zaijun Cheng, Xuyuan Chen, Haisheng San, Zhihong Feng, Bo Liu // J. Micromech. Microeng. 2012. V. 22. P. 074011 (6pp). https://doi.org/10.1088/0960-1317/22/7/074011
Kuruoğlu N.A., Özdemir O., Bozkurt K. // Thin Solid Films. 2017. V. 636. P. 746. https://doi.org/10.1016/j.tsf.2017.07.033
Chandrashekhar M.V.S., Duggirala R., Spencer M.G., Lal A. // Applied Physics Letters. 2007. V. 91. P. 053511. https://doi.org/10.1063/1.2767780
Мурашев В.Н., Леготин С.А., Леготин А.Н., Мордкович В.Н., Краснов А.А. // Патент на изобретение RU 2 539 109 C1. Опубл. 01.10.2015 г.
Nejad G.R.G., Rahmani F. // Applied Radiation and Isotopes. 2016. V. 107. P. 346. https://doi.org/10.1016/j.apradiso.2015.11.025
Дополнительные материалы отсутствуют.
Инструменты
Приборы и техника эксперимента