Радиотехника и электроника, 2019, T. 64, № 3, стр. 295-301
Автоэмиссионные свойства поверхностно модифицированных кристаллов кремния различных типов проводимости
Р. К. Яфаров 1, *, С. Ю. Суздальцев 1, В. Я. Шаныгин 1
1 Саратовский филиал Института радиотехники и электроники им. В.А. Котельникова РАН
410019 Саратов, ул. Зеленая, 38, Российская Федерация
* E-mail: pirpc@yandex.ru
Поступила в редакцию 23.03.2017
После доработки 03.10.2017
Принята к публикации 11.11.2017
Аннотация
Предложена новая технология наноструктурирования и модификации поверхностей кристаллов кремния различных типов проводимости с использованием самоорганизованных углеродных масковых покрытий и высокоанизотропного плазмохимического травления. Показано, что полученные структуры позволяют в разы уменьшить пороги возбуждения автоэмиссии и более чем на порядок увеличить плотности максимальных автоэмиссионных токов по сравнению с изготовленными по традиционным технологиям. Установлено, что взаимосвязь морфологических и автоэмиссионных характеристик полученных многоострийных катодных матриц определяется типом электропроводности полупроводника и суммарным дипольным моментом его поверхности. Показано, что интерпретация взаимосвязей между ними с использованием представлений теории Фаулера и Нордгейма не является достаточным.
ВВЕДЕНИЕ
Важнейшим направлением в развитии СВЧ-электроники является вакуумная микроэлектроника и вакуумные интегральные схемы (ВИС), создаваемые на основе полевых источников электронов. Основными их достоинствами – высокое быстродействие и возможность эксплуатации в экстремальных условиях. Перспективным материалом для полевых источников электронов в составе ВИС является кристаллический кремний, что обусловлено развитой технологической базой кремниевой микроэлектроники, обеспечивающей создание на кристаллах кремния высокоаспектных микроструктур с высокой поверхностной плотностью, а также обнаруженными люминесцентными свойствами нанокристаллического кремния, которые позволяют надеяться на создание в будущем сверхбыстродействующих радиационно стойких кремниевых интегральных схем с оптической связью [1].
Традиционно исследования туннельной эмиссии электронов из полупроводников при создании полевых источников электронов проводились для полупроводников n-типа, где электроны являются основными носителями, имеют высокую концентрацию в зоне проводимости, из которой и осуществляется автоэмиссия. В связи с разработкой новых типов быстродействующих приборов для микро- и наноэлектроники, а также различных оптоэлектронных устройств в настоящее время наметилась устойчивая тенденция к использованию полевой эмиссии электронов и из полупроводников с дырочным типом проводимости. Большой интерес вызывают, например, исследования, направленные на создание фотополевых детекторов со сверхвысокой квантовой эффективностью которые могут работать в ИК-области спектра, а также вакуумных транзисторов и светодиодов, которые по теоретическим оценкам могут работать на терагерцовых частотах [2, 3].
Недостатками полевых источников электронов на основе кремния являются высокая чувствительность к состоянию поверхности и низкие плотности автоэмиссионных токов, которые, как правило, находятся в интервале 50…150 мкА/см2. Так, в работе [4] для плотного массива эмиттеров в виде высокоаспектных пиков из кремния n-типа, созданных с помощью микротехнологии, получены значения максимальной плотности автоэмиссионного тока J = 145 мкA/см2 при напряженности поля анода E = 32 В/мкм. Такие плотности токов удовлетворяют требованиям использования чисто кремниевых автоэмиссионных катодов в области дисплеев с полевыми эмиттерами (field emission displays, FED) [5]. Однако этого недостаточно для создания, например, вакуумных полевых транзисторов с высокой выходной мощностью.
Так как автоэлектронная эмиссия осуществляется с эмиссионных выступов, где реализуется наибольшая напряженность электрического поля и выделяется максимальная мощность, то для повышения деградационной стойкости автокатодов необходимо снижение токовой нагрузки на каждый из них. Максимальное значение такой нагрузки зависит от свойств используемого многоострийного эмиттерного материала. Для острийных кремниевых автокатодов при максимальной плотности тока 150 мкА/см2 и типичном расстоянии между остриями 3…4 мкм [6] поверхностная плотность эмитирующих выступов находится в интервале (6…9) × 106 см–2. Очевидно, что для снижения токовой нагрузки на каждый эмитирующий выступ и/или увеличения максимальной плотности тока при той же токовой нагрузке на острие необходимо увеличивать поверхностную плотность эмиссионных центров.
При поверхностной плотности острий 107…109 см–2 период их расположения должен быть меньше 1 мкм. С использованием современных литографических микроэлектронных технологий создание таких многоострийных матриц представляется вполне реализуемой задачей. Однако это приведет к неоправданному их удорожанию. Эта проблема, как и в случае разработки промышленных технологий получения квантовых точек [7], может быть решена, если разработать новые технологии создания многоострийных кремниевых катодных материалов с использованием явлений самоорганизации.
В работе [8] с помощью сканирующих атомно-силовой и электронной микроскопии впервые было обнаружено явление самоорганизации 3D‑островков – доменов при осаждении субмонослойных углеродных покрытий на кремнии (100) в СВЧ-плазме низкого давления. Показано, что полученные кремний-углеродные домены являются результатом поверхностного фазового перехода при осаждении углерода на кремний и могут быть использованы в качестве масковых покрытий для получения пространственных низкоразмерных систем на монокристаллическом кремнии (100). Большой практический интерес представляет исследование возможности их использования для получения многоострийных катодных матриц.
Цель работы – исследование влияния модификации и нелитографического наноструктурирования поверхности кристаллов кремния различных типов проводимости на автоэмиссионные характеристики полевых источников электронов, изготовленных на их основе.
1. МЕТОДИКА И РЕЗУЛЬТАТЫ ЭКСПЕРИМЕНТОВ
Эксперименты, связанные с нелитографическим наноструктурированием поверхности кристаллов кремния при получении эмиссионных выступов многоострийных полевых источников электронов с повышенной поверхностной плотностью, проводили, как и в работе [9], в вакуумной установке с использованием ионно-плазменного СВЧ-источника на частоте 2.45 ГГц. В экспериментах были использованы пластины монокристаллического кремния Si(100) различных типов проводимости с удельным сопротивлением 0.01…0.02 Ом см. Наноструктурирование производилось с использованием гетерофазной вакуумно-плазменной самоорганизации при осаждении субмонослойных углеродных покрытий и атомной структуры кристаллов кремния (100) в качестве подложки. Процесс проходил в одном технологическом цикле и включал в себя плазмохимическое осаждение на кристаллы кремния островковых субнаноразмерных углеродных масочных покрытий с последующим высокоанизотропным травлением для получения наноразмерных столбчатых кремниевых выступов. Мощность СВЧ-излучения и индукция магнитного поля составляли 250 Вт и 875 Гс соответственно.
Углеродные покрытия осаждались в СВЧ-плазме, в качестве рабочего вещества были использованы пары этанола. Процесс проводился в условиях малой адсорбции при температуре подложки 250°С и давлении паров этанола около 0.05 Па. Потенциал смещения Uсм на подложкодержателе в процессе осаждения углеродного покрытия был равен 100 В. Высокоанизотропное травление матрицы кремния осуществлялось при положительном смещении на подложкодержателе с использованием хладона-14 при давлении 0.1 Па.
Наноморфологию наноструктурированных поверхностей кристаллов кремния изучали с помощью сканирующего атомно-силового микроскопа (АСМ) P4-SPM-MDT. В качестве зонда были использованы стандартные кремниевые кантилеверы CSG10 пирамидальной формы с радиусом закругления 10 нм и жесткостью 0.1 Н/м. Поле сканирования составляло 3 × 3 мкм. Латеральные размеры островковых образований и высоту кремниевых выступов после плазмохимического травления на сколе пластин измеряли с помощью сканирующего электронного микроскопа (СЭМ) Auriga. Результаты измерений обрабатывали с помощью программного обеспечения микроскопа.
Автоэмиссионные свойства исследовали в условиях высокого вакуума (10−5 Пa) на диодной структуре, способной изменять расстояние между электродами с точностью до 1 мкм. Диаметр рабочей поверхности анода, изготовленного из углеродного материала МПГ-6, составлял 3 мм.
На рис. 1 приведены кинетические зависимости параметров наноморфологии поверхностей кремниевых пластин после их высокоанизотропного травления с использованием в качестве масковых островковых углеродных покрытий, осажденных на пластины кремния с естественным оксидным покрытием. Значениям координат при t = 0 с соответствуют поверхностные плотности и высоты выступов на кремниевых пластинах до осаждения углеродных покрытий. Из анализа рис. 1 можно сделать вывод, что при кратковременных осаждениях углерода поверхностная плотность и высоты кремниевых микровыступов практически не изменяются по сравнению с характеристиками наноморфологии исходной поверхности кремния. При длительностях осаждений больше 5 с наблюдаются резкое увеличение высот выступов и одновременное уменьшение их поверхностной плотности. Экстремумы обоих параметров наноморфологии реализуются одновременно при длительностях осаждения 6 с. При бóльших длительностях осаждения наблюдается резкое уменьшение высот выступов с одновременным небольшим ростом их поверхностной плотности.
Рис. 1.
Зависимости поверхностных плотностей (1) и высот (2) микровыступов от длительностей осаждения углеродных пленок на кристаллы кремния (100) с естественным оксидным покрытием, полученные с помощью АСМ.

На рис. 2 приведены СЭМ-изображения нановыступов, которые образовались после высокоанизотропного плазмохимического СВЧ-травления в хладоне-14 в течение 30 мин пластин кремния с самоорганизованным углеродным масочным покрытием, осажденным при длительности 7 с. Глубина травления пластин кремния достигала 50 нм при диаметре выступов 30…50 нм.
Рис. 2.
СЭМ-изображения пространственных наноструктур после травления пластин кремния (100) в хладоне-14 с использованием самоорганизованных углеродных масочных покрытий: а – вид под углом 63°, б – изображение на сколе пластины.
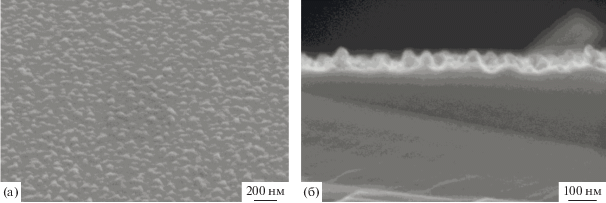
На рис. 3, 4 приведены зависимости параметров наноморфологий и автоэмиссионных характеристик от длительностей высокоанизотропного плазмохимического травления пластин кремния n- и р-типов проводимостей в атмосфере хладона-14 (значениям координат при t = 0 с соответствуют морфологические и автоэмиссионные характеристики кремниевых пластин до проведения высокоанизотропного травления). Видно, что изменения морфологических и автоэмиссионных характеристик поверхностно структурированных кристаллов кремния в зависимости от длительностей маскового травления определяются типом электропроводности полупроводников. Высоты выступов на пластинах обоих типов проводимости имеют экстремумы различного характера. Высоты выступов пластин кремния n-типа в интервале длительностей маскового травления от 10 до 20 мин имеют пологий максимум. При этом напряженности поля возбуждения автоэмиссии имеют минимальные значения, равные 37…39 В/мкм. Максимум плотностей автоэмиссионных токов реализуется при длительности масочного травления около 10 мин. Высоты выступов и расстояния между ними в экстремумах порогов возбуждения и плотностей максимальных автоэмиссионных токов составляют соответственно 11…12 и 100…120 нм. При длительностях масочного травления больше 20 мин наблюдается уменьшение высот выступов при одновременном ускоренном увеличении порогов возбуждения автоэмиссии и уменьшении максимальных плотностей автоэмиссионных токов.
Рис. 3.
Зависимости высот выступов (1) и порогов возбуждения автоэмиссии (2) от длительности масочного травления при осаждении углеродной пленки на пластины кремния n- (а) и р-типа (б) с естественным оксидным покрытием.
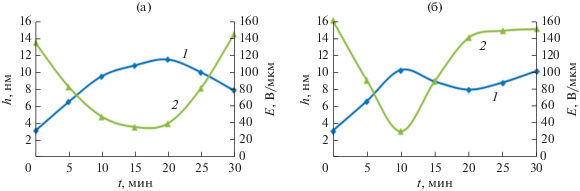
Рис. 4.
Зависимости поверхностных плотностей выступов (1) и плотностей максимальных токов автоэмиссии (2) от длительности масочного травления при осаждении углеродной пленки на пластины кремния n- (а) и р-типа (б) с естественным оксидным покрытием.

Для кристаллов кремния р-типа экстремумы высот выступов и порогов возбуждения автоэмиссии реализуются при меньших длительностях травления, чем для кремния n-типа, и являются более острыми. Другой особенностью является то, что минимум порогов возбуждения автоэмиссии и максимум плотностей автоэмиссионных токов не совпадают друг с другом. Более того, максимальные плотности автоэмиссионных токов реализуются при максимальных значениях порогов возбуждения автоэмиссии. В интервале длительностей травления от 10 до 20 мин одновременно с небольшим уменьшением высот выступов наблюдается быстрый рост порогов возбуждения автоэмиссии и максимальных плотностей автоэмиссионных токов. При длительностях травления больше 20 мин уменьшение максимальных плотностей автоэмиссионных токов происходит одновременно с небольшим увеличением высот выступов. Пороги возбуждения автоэмиссии при этом не изменяются и остаются на уровне 140 В/мкм.
Плотности автоэмиссионных токов для кристаллов кремния обоих типов проводимостей в интервале длительностей травления от 10 до 20 мин практически на два порядка превосходят плотности токов с эмиттерных решеток, полученных с использованием традиционных микроэлектронных технологий [5, 10].
2. ОБСУЖДЕНИЕ РЕЗУЛЬТАТОВ
Неизменность морфологических параметров при кратковременных осаждениях углерода из плазмы паров этанола на кремниевые пластины с естественным оксидным покрытием (см. рис. 1) свидетельствует о том, что конденсация углерода на кремнии при этом отсутствует. Это обусловлено тем, что атомарный углерод восстанавливает естественный оксид кремния. При этом сам углерод на кремнии не осаждается, а улетучивается в виде оксидов в результате его взаимодействия с кислородом оксидного покрытия:
Поэтому травление поверхностного слоя является практически конгруэнтным. Длительность этого процесса составляет около 5 с. После удаления оксидного покрытия следует резкое и синхронное уменьшение поверхностной плотности выступов и увеличение их высоты. Это свидетельствует о переходе процесса к темплатному механизму конденсации, при котором уменьшение свободной энергии поверхности осуществляется за счет хемосорбции углерода с образованием комплексов Si−C≡. На комплексах Si−C≡, благодаря большой разнице в энергиях химических связей С−С и Si−C, которая составляет 2.74 и 4.55 эВ/молекулу соответственно, сразу же осуществляется быстрое нарастание выступов из углеродных атомов.
Увеличение высоты углеродных выступов по схеме Si −C−С−…−С приводит к увеличению свободной энергии поверхности, которая после достижения некоторой критической величины вызывает фазовую перестройку поверхностного слоя по механизму прекурсорной релаксационной хемосорбции [8]. В результате осуществляется самоорганизация отдельных древовидных углеродных выступов в монослойные кремний-углеродные домены, а свободная энергия модифицированной поверхности кремния уменьшается. В основании доменов находится монослой карбида кремния. Из-за различного сродства к электрону атомов кремния и углерода карбид-кремниевые кластеры в доменах присутствуют в виде диполей. Непосредственно на границе кремния они ориентированы перпендикулярно поверхности раздела, что придает поверхности некоторый суммарный дипольный момент. С увеличением толщины слоя разориентация диполей увеличивается, а суммарный дипольный момент поверхности уменьшается [11].
Как видно из рис. 1, моментам фазовой перестройки предшествует экстремумы поверхностных плотностей и высот выступов, которые реализуются одновременно при длительностях осаждения углерода 6 с. При бóльших длительностях осаждения на кремний-углеродном подслое по классическому механизму образования зародышей и роста пленок формируется слой аморфного углерода, выполняющего роль маскирующего покрытия при последующем высокоанизотропном травлении пластин кремния.
При длительностях осаждения больше 8…10 с углеродное покрытие становится практически однородным по толщине. Небольшой перепад толщин пленочного покрытия не позволяет использовать его в качестве маскового для получения столбчатых наносистем на кремнии (100) с помощью высокоанизотропного плазмохимического травления.
Высокоанизотропное травление с использованием самоорганизованного кремний-углеродного масочного покрытия проводили в среде хладона-14 в условиях слабой адсорбции при положительном смещении на подложкодержателе. В этом случае за счет интенсивной электронной бомбардировки реализуются гетерогенные процессы диссоциации и активации адатомов CF4 с образованием атомарного фтора, который при взаимодействии с незащищенными островками углерода поверхностными атомами кремния образует летучие продукты реакции и вызывает его травление [9].
Согласно современным представлениям, базирующимся на теории Фаулера–Нордгейма, в основе которой лежит вычисление коэффициента прохождения туннелирующих электронов через потенциальный барьер на границе раздела эмиттер-вакуум, уменьшение порогов возбуждения автоэмиссии при увеличении высот эмитирующих выступов для пластин кремния n-типа в интервале длительностей масочного травления 0…20 мин (см. рис. 3а) и для пластин кремния р‑типа в интервале длительностей 0…10 мин (см. рис. 3б), обусловлено увеличением коэффициента усиления поля β на их вершинах. Благодаря увеличению прозрачности потенциальных барьеров увеличивается плотность максимального автоэмиссионного тока, которая для пластин n-типа при длительности масочного травления 10 мин достигает своего максимального значения. При длительностях травления больше 20 мин высоты выступов и плотности максимальных автоэмиссионных токов уменьшаются, а пороги возбуждения автоэмиссии увеличиваются. Такая взаимосвязь морфологии поверхности и автоэмиссиооных свойств пластин кремния n-типа может быть описана в рамках формулы Фаулера и Нордгейма (ФФН). Однако при практически одинаковых изменениях высот и поверхностных плотностей выступов в интервалах длительностей травления 10…20 мин и 20…30 мин изменения порогов возбуждения автоэмиссии и максимальных плотностей автоэмиссионных токов во втором интервале длительностей существенно больше. Такое различие в автоэмиссионных характеристиках пластин кремния при одинаковых изменениях их морфологических параметров не интерпретируется в рамках ФФН.
Аналогичная корреляция между высотами выступов и порогами возбуждения автоэмиссии наблюдается для пластин кремния р-типа в интервале длительностей травления 10…20 мин. Однако плотности максимальных автоэмиссионных токов при этом не уменьшаются, как в случае кремния n‑типа, а увеличиваются больше чем в два раза: от 2.7 до 6.5 мА/см2. При длительностях масочного травления больше 20 мин, несмотря на увеличение высот выступов, пороги возбуждения автоэмиссии для кремния р-типа остаются неизменно высокими, а плотности максимальных автоэмиссионных токов уменьшаются вместе с поверхностной плотностью кремниевых выступов. Различие между теоретическими представлениями с использованием ФФН и установленными взаимосвязями морфологии поверхностей и автоэмиссионными свойствами пластин кремния различных типов проводимостей обусловлено следующим.
За счет ограниченной селективности плазмохимического травления в среде хладона-14 гетероструктуры углеродосодержащая маска и кремний в процессе травления кремния происходит также постепенное уменьшение толщины островкового углеродного покрытия. После окончания высокоанизотропного травления любой длительности на поверхности кремниевых выступов за счет остаточной атмосферы плазмы формируются монослойные поверхностные фазы, состоящие из Si–С–F- и Si–F-кластеров. Для кремния n-типа при длительностях травления больше 20 мин уменьшение высот выступов свидетельствует об удалении с их поверхности углеродного масочного покрытия и начале ускоренного травления их вершин (см. рис. 3а, кривая 1). В этих случаях на кремниевых выступах преобладающими являются хемосорбированные Si–F-комплексы. Благодаря более высокой по отношению к кремнию и углероду электроотрицательности атомарного фтора на поверхности кремния индуцируется отрицательный заряд. Это приводит к увеличению суммарного дипольного момента поверхности выступов. В результате для пластин кремния n‑типа повышается работа выхода электронов, что выражается в увеличении напряженности электрического поля возбуждения автоэмиссии, и обедняется приповерхностный слой основными носителями. Одновременно с этим за счет увеличения пондеромоторных нагрузок и возрастающих мощностей тепловыделений в кристаллической решетке кремниевых выступов максимальные плотности автоэмиссионных токов уменьшаются (см. рис. 4а).
При длительностях масочного травления до 20 мин, соответствующих участкам увеличения высот кремниевых выступов и уменьшения их поверхностных плотностей (см. рис. 3а, 4а, кривые 1) также происходит постепенное уменьшение толщин углеродных масочных покрытий, но не происходит их полного удаления. В этих случаях после окончания процессов травления наиболее вероятным является преобладание на поверхности кремниевых выступов хемосорбированных Si–C-диполей. Из-за большей электроотрицательности атомов кремния они уменьшают суммарный дипольный момент поверхности, приводя к уменьшению работы выхода электронов и, соответственно, уменьшению порогов начала автоэмиссии и пондеромоторных нагрузок на кристаллическую решетку с одновременным увеличением максимальных плотностей автоэмиссионных токов. В интервале длительностей масочного травления от 10 до 20 мин, который характеризуется замедлением роста кремниевых выступов и слабого уменьшения порогов начала автоэмиссии с одновременным уменьшением максимальных плотностей автоэмиссионных токов, происходит постепенное изменение содержания поверхностных фаз на выступах от Si–C к Si–F с соответствующим изменением суммарного дипольного момента эмитирующих поверхностей и их автоэмиссионных характеристик.
При масочном травлении пластин кремния р‑типа происходят процессы аналогичные тем, что и при травлении пластин n-типа: в интервале длительностей масочного травления до 10 мин преобладающими адкомплексами на выступах являются Si–C-диполи. Ориентация их дипольных моментов на кремнии р-типа приводит к обогащению приповерхностной области эмиссионных выступов основными носителями. Вместе с тем положительный поверхностный потенциал Si–C-диполей уменьшает работу выхода и величину порогов начала автоэмиссии (см. рис. 3б). При длительностях масочного травления больше 10 мин происходит постепенное замещение Si–C-диполей на Si–F-диполи, имеющие противоположный дипольный момент, который увеличивает суммарный дипольный момент поверхности, работу выхода электронов и величину порогов начала автоэмиссии. При длительностях масочного травления около 20 мин концентрация Si-C-диполей достигает минимального значения, при котором их дипольные моменты и автоэмиссионный ток приобретают максимальные значения [11]. Дальнейшее уменьшение их концентрации с одновременным насыщением поверхности Si–F-диполями приводит к стабилизации работы выхода на неизменно высоком уровне и уменьшению максимальных плотностей автоэмиссионных токов (см. рис. 4б). Последнее происходит за счет обеднения приповерхностной области носителями, увеличения интервалов разброса высот эмитирующих выступов, уменьшения их поверхностной плотности и увеличения токовой нагрузки на каждый из них [12].
ЗАКЛЮЧЕНИЕ
С использованием атомно-силовой и электронной микроскопии исследована кинетика изменения морфологии поверхности кристаллов кремния различных типов электропроводности на начальных стадиях микроволнового плазмохимического осаждения углеродного покрытия. Выделены три стадии процесса, включающие в себя конгруэнтное травление естественного оксида кремния, темплатное осаждение атомарного углерода и фазовую перестройку поверхностного слоя по механизму прекурсорной релаксационной хемосорбции, результатом которой является самоорганизация углеродных выступов в наноразмерные кремний-углеродные домены. Их использование в качестве маскового покрытия при высокоанизотропном плазмохимическом травлении позволяет получать на кристаллах кремния многоострийные автоэмиссионные структуры с поверхностной плотностью эмитирующих выступов, на два-три порядка превышающей поверхностную плотность эмиттерных решеток, получаемых с применением традиционных микроэлектронных литографических технологий.
Взаимосвязь морфологических и автоэмиссионных характеристик поверхностно структурированных кристаллов кремния с субмонослойными углеродными масочными покрытиями определяется типом электропроводности полупроводника и суммарным дипольным моментом его поверхности. Изменения дипольного момента эмиттирующих выступов кристаллов кремния за счет фторуглеродной модификации их поверхности позволяет в широких пределах изменять работу выхода и порог начала автоэмиссии, а также условия транспорта электронов к эмиссионным центрам катодной структуры и максимальную плотность автоэмиссионного тока. Полученные результаты свидетельствуют, что интерпретация взаимосвязей между работой выхода и величиной туннельного тока в полупроводниковых автоэмиссионных структурах с использованием представлений теории Фаулера и Нордгейма не является достаточным.
Работа выполнена при финансовой поддержке Российского научного фонда (проект № 16-19-10033).
Список литературы
Герасименко Н.Н., Пархоменко Ю.Н. Кремний — материал наноэлектроники. М.: Техносфера, 2007.
Гуляев Ю.B., Абаньшин Н.П., Горфинкель Б.И. и др. // Письма в ЖТФ. 2013. Т. 39. № 11. С. 63.
Jin-Woo Han, Jae Sub Oh, Meyyappan M. // Appl. Phys. Lett. 2012. V. 100. P. 213505.
Velásquez-García L.F., Guerrera S., Niu Y., Akinwande A.I. // IEEE Trans. 2011. V. ED-58. P. 1783.
Fei Zhao, Jian-hua Deng, Dan-dan Zhao et al. // J. Nanosci. Nanotechnol. 2010. V. 10. P. 1.
Betsui K. // Vacuum Microelectronics Conf. Nagahama, Japan, 1991. Technical Digest. P. 26.
Леденцов Н.Н., Устинов В.М., Щукин В.А. и др. // ФТП. 1998. Т. 32. № 4. С. 385.
Яфаров Р.К., Шаныгин В.Я. // ФТП. 2017. Т. 51. № 4. С. 558.
Яфаров Р.К. Физика СВЧ вакуумно-плазменных нанотехнологий. М.: Физматлит, 2009.
Гиваргизов Е.И., Жирнов В.В., Степанова А.Н., Обеленская Л.Н. Матричный автоэлектронный катод и электронный прибор для оптического отображения информации // Патент РФ № 2074444. Опубл. 27.02.97.
Оура К., Лифшиц В.Г., Саранин А.А. и др. Введение в физику поверхности. М.: Наука, 2006.
Шаныгин В.Я., Яфаров Р.К. // ФТП. 2013. Т. 47. № 4. С. 447.
Дополнительные материалы отсутствуют.
Инструменты
Радиотехника и электроника


