Радиотехника и электроника, 2020, T. 65, № 3, стр. 303-307
Вольт-фарадные характеристики и исследование изменения высоты барьера Шоттки контакта IrSi–Si
Э. А. Керимов a, b, *, С. Н. Мусаева a, b
a Азербайджанский государственный университет нефти и промышленности
AZ-1010 Баку, просп. Азадлыг, 16/21, Азербайджанская Республика
b Азербайджанский технический университет
AZ-1073 Баку, просп. Г. Джавида, 25, Азербайджанская Республика
* E-mail: E_Kerimov.fizik@mail.ru
Поступила в редакцию 10.10.2018
После доработки 10.10.2018
Принята к публикации 15.11.2018
Аннотация
Проведены эксперименты по измерению вольт-фарадных характенистик. Показано, что обратные характеристики диода получаются деградированными, в результате чего снижается его качество.
ВВЕДЕНИЕ
Измерения вольт-фарадных характеристик (ВФХ) относятся к числу наиболее распространенных методик исследования полупроводниковых приборов. С помощью этих характеристик определяется ряд важных физических параметров, присущих как самим структурам IrSi–p-Si, так и материалам, из которых они изготовлены. Особый интерес представляет изучение ВФХ, зарегистрированных в динамическом режиме. Основным преимуществом данного метода является возможность прямого измерения характеристик C(U), ∂C(U)/∂U и ∂2С(U)/∂2U, что позволяет существенно повысить точность.
1. МЕТОДИКА ЭКПЕРИМЕНТА
Прибор собран по блок-схеме (рис. 1), предложенной в работе [1]. Исследуемая структура включается в мостовую схему, на которую подается синусоидальный тестовой сигнал Uт = U0 sin ωt с амплитудой Uт ≤ kT/q и напряжением пилообразной развертки U = αt + const. Величину сопротивления нагрузки выбирали из условия Rн$ \gg $ (ωCk)–1 для тестового и обратного сигналов для пилообразного напряжения. Сигнал, получаемый с нагрузки Rн1, равный Uн = const (γ + jωc), после предварительного усиления (У1), для выделения составляющих импеданса, подается на детектор Д1. Сигнал из второго плеча измерительной схемы, состоящий из эталонной емкости Сэт и сопротивления нагрузки Rн2, поступает на вход усилителя У2, усиливается и выпрямляется детектором Д2.
Рис. 1.
Блок-схема для измерения вольт-фарадных характеристик: У1, У2 – усилители, Д1, Д2 – детекторы, С, Сэт, Сх – емкости, У3 – компаратор, Z – осциллограф, Rн1, Rн2, R – нагрузки.
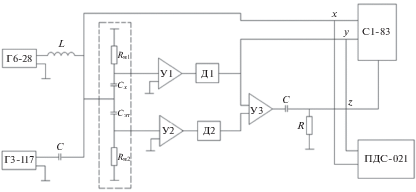
Детектированные сигналы подаются на входы компаратора У3 и сравниваются. Выход компаратора через дифференцирующие RC-цепочки подключен к входу Z осциллографа. При этом выходное напряжение компаратора остается постоянным, пока Сэт ≠ Сх, и сигнал на входе Z равен нулю. При некотором смещении напряжения эталонная емкость меняется: Сэт = Сх(U), и тогда на выходе компаратора появляется сигнал, который отпирает сетки электронно-лучевой трубки осциллографа. Яркость C–U-характеристики в этой точке резко возрастает, но позволяет производить градуировку показаний осциллографа по оси у в единицах емкости Сэт.
Ниже представлены характеристики установки:
| Частотный диапазон, Гц | 10…107 |
| Диапазон измерения емкости, пФ | 1…10 000 |
| Чувствительность, В/пФ | 0.02 |
| Относительная погрешность (∆С/С, %) | |
| при сопротивлении нагрузки 102…106 Ом | ≤5 |
| Амплитуда тестового сигнала, мВ | ≤30 |
На рис. 2 приведена осциллограмма ВФХ структур IrSi–p-Si при частоте 1 МГц.
Проведенные исследования зависимости емкости от напряжения показали, что в диапазоне 300…106 Гц емкость практически не зависит от частоты и изменяется по закону
Положение уровня Ферми ξ, а также высоту барьера можно рассчитать по значению Nа, полученному по наклону зависимости S/c2 от U, поскольку
В отсутствие напряжения смещения действия сил зеркального изображения снижают высоту барьера Шоттки (БШ):
а суперпозиции сил зеркального изображения, действующих на носители и электрическое поле обедненного слоя, приводят к смещению максимума барьера, вычисляемого по формуле
Зависимость отношения 1/С2 от приложенного напряжения для тех же диодов приведена на рис. 3.
Как видно из рисунка, экспериментальная зависимость 1/С 2 от U является линейной, что указывает на равномерное распределение ионизованных примесей в приповерхностной области полупроводника. Определенная из наклона ВФХ величина концентрации акцепторов (Nа = 1015 см–3) совпадает со значением, рассчитанным из удельного сопротивления кремния (ρ = 10 Ом см соответствует Nа = 1.5 × 1015 см–3), что свидетельствует об отсутствии подлегирования и образования электрически активных дефектов в приповерхностной области кремния в процессе формирования силицида.
2. ТЕОРЕТИЧЕСКИЙ АНАЛИЗ
Одним из важнейших параметров, характеризирующий эмиссию, является величина потенциального барьера (φб) на границе металл–полупроводник. Для определения величины φб можно воспользоваться методом полного тока [2–4]. Рассчитанная величина потенциального барьера на границе IrSi–p-Si и IrSi–n-Si равна соответственно 0.16 и 0.94 эВ.
Для получения контакта силицид иридия–кремний с заданной величиной барьера Шоттки необходимо определить характер зависимости высоты барьера от температуры отжига.
На рис. 4а, 4б представлены зависимости высоты БШ изготовленных структур от температуры отжига соответственно для IrSi–p-Si и IrSi–n-Si. Как видно из рисунка, высота для р-типа кремния (p-Si) слабо зависит от температуры отжига: значения уменьшаются от 0.24 до 0.16 эВ.
Рис. 4.
Зависимости высоты БШ изготовленных структур от температуры отжига соответственно для IrSi–p-Si (а) и IrSi–n-Si (б).

Высота же барьера для n-типа кремния имеет максимум при 500°С и равна 0.94 эВ. Предполагается, что увеличение φБШ вызвано замещением в контакте фазы с низким БШ (Ir2Si) фазой с высоким БШ (IrSi). Такой характер зависимости φБШ от температуры отжига показывает, что до 350…400°С образуются силициды, обогащенные металлом (иридий), а выше 450°С – обогащенные кремнием.
Уменьшение высоты барьера хорошо описывается мультиконтактной теорией [5–7], в которой изменение высоты БШ при изохронном отжиге объясняется тем, что не вся площадь контакта является силицидом IrSi и часть ее перекрывается участками межфазного окисла или кремния. Отсюда истинную высоту БШ следует вычислять по следующей формуле:
где S – полная площадь контакта, S ' – нерабочая площадь контакта. Следовательно, истинная высота барьера равна
На рис. 5 представлена зависимость высоты БШ от времени отжига. При длительности последнего выше 30 мин во всем исследуемом температурном диапазоне скорость изменения φБШ очень мала, что свидетельствует о стабилизации физико-химических реакций, происходящих на границе раздела силицид иридия–кремний.
3. ОБСУЖДЕНИЕ ПОЛУЧЕННЫХ РЕЗУЛЬТАТОВ
Исследованы электрофизические характеристики изготовляемых структур в зависимости от ориентации кремниевой подложки, результаты которых показаны в табл. 1. Как видно из табл. 1, наблюдается характерная закономерность, а именно: все измеряемые величины для ориентации 〈111〉 ниже соответствующих значений для ориентации 〈100〉. Наименьшие же значения коэффициента неидеальности и высоты БШ оказались равными соответственно 1.03 и 0.94 эВ для n-Si.
Таблица 1.
Значения высоты барьера и коэффициента неидеальности при различных температурах отжига и типах подложки
| Тип подложки | Тотж, °C | Высота барьера | Коэффициент неидеальности | |
|---|---|---|---|---|
| J–U | C–U | |||
| 〈100〉 | 250 350 400 500 600 |
0.94 0.93 0.91 0.88 0.86 |
0.91 0.90 0.93 0.91 0.91 |
1.05 1.04 1.08 1.07 1.18 |
| 〈111〉 | 250 350 400 500 600 |
0.93 0.92 0.91 0.90 0.88 |
0.92 0.93 0.87 0.91 0.86 |
1.06 1.09 1.10 1.03 1.14 |
Как показывают исследования, коэффициент неидеальности n, определенный из ВФХ, при отжиге в диапазоне 200…300°С равен 1.04 и не зависит от ориентации подложки. При температуре отжига выше 350°С n увеличивается, а для ориентации 〈111〉 при Тотж = 500°С значение n снижается до 1.04.
Высота потенциального барьера определена из измерений ВФХ. С увеличением температуры отжига для Si 〈100〉 φБШ слабо изменяется и составляет 0.93 эВ, а для структур, полученных на кремнии, с ориентацией 〈111〉 φБШ при увеличении Тотж уменьшается до значения 0.84 эВ.
Для снижения высоты потенциального БШ также использован метод ионного легирования.
Ионная имплантация, понижающая БШ, выполняется раньше, чем осаждается пленка иридия для образования силицида иридия. Процесс ионной имплантации проводился на установке “Везувий-3М” при дозе 51.42 мКл/см2. После ионного внедрения пластины отжигали при температуре 1150°С, чтобы устранить дефекты в кристаллической структуре.
Результаты электрических измерений показали, что обратные характеристики (рис. 6) получаются деградированными, в результате чего снижается качество диода.
Отметим, что понижение высоты потенциального барьера из-за сил зеркального изображения соответствует закону:
При na = 10 × 1012 см–2 ∆φ > 0.13 эВ, и именно по этой причине возникает проблема образования омического контакта.
Нами был изготовлен фототранзистор с БШ на основе контакта IrSi–Si n-типа (рис. 7). Канал был сформирован внедрением ионов бора с энергией 50 кэВ и дозой 2 × 1012 см–2. Истоки и стоки полевых транзисторов сформированы диффузией фарфора с поверхностным сопротивлением 8 Ом/◻ и диффузией бора 6 Ом/◻ на глубину 1.5 мкм.
При работе ПТШ подложку 1 и исток 2 заземляют, а сток 3 соединяют через нагрузочное сопротивление с положительным полюсом источника, между пленками IrSi и кремнием 5, канал становится обратносмещенным. Поэтому пленка IrSi удерживает положительный заряд так, что полевой транзистор находится в открытом состоянии. При этом течет канальный ток, величина которого определяется нагрузочным сопротивлением и сопротивлением канала.
Список литературы
Зи С. Физика полупроводниковых приборов. М.: Мир, 1984. С. 38.
Керимов Э.А. // Вестник КемГУ. 2013. № 3. Т. 1. С. 165.
Керимов Э.А. // Изв. НАНА. 2011. Т. 31. № 2. С. 166.
Керимов Э.А. // Матер. VII Междун. научно-практич. конф., Москва, 29 июня 2013. С. 7.
Zhu Sliyang, Qu Xin-Ping, Van Meirhaeghe R.L. // Solid State Electron. 2000. V. 44. № 12. P. 2217.
Qu Xin-ping, Guo-ping, Xu Bei-lei, Li Bing-zong // Chin. J. Semiconductor. 2000. V. 21. № 5. P. 473.
Hudait M.K., Venkateswerlu P., Krupanidhi S.B. // Solid State Electron. 2001. V. 45. № 1. P. 133.
Дополнительные материалы отсутствуют.
Инструменты
Радиотехника и электроника