Радиотехника и электроника, 2022, T. 67, № 1, стр. 44-50
Интерферометр для контроля формы выпуклых зеркал оптических и радиотелескопов, построенный по схеме ортогональных лучей
В. И. Батшев a, b, *, Д. А. Новиков c, А. Е. Гавлина b, И. А. Баландин b
a Московский государственный технический университет им. Н.Э. Баумана
105005 Москва, 2-я Бауманская ул., 5, стр. 1, Российская Федерация
b Научно-технологический центр уникального приборостроения РАН
117342 Москва, ул. Бутлерова, 15, Российская Федерация
c Всероссийский научно-исследовательский институт метрологической службы
119361 Москва, ул. Озерная, 46, Российская Федерация
* E-mail: batshev@bmstu.ru
Поступила в редакцию 21.04.2021
После доработки 22.08.2021
Принята к публикации 02.09.2021
- EDN: PWLLIZ
- DOI: 10.31857/S0033849422010028
Аннотация
Разработан и изготовлен интерферометр для контроля качества выпуклых сферических и асферических зеркал, работающий по схеме ортогональных лучей, согласно которой контролируемая поверхность освещается параллельным пучком лучей, направленным по нормали к ее оси симметрии. В отличие от применяемых в настоящее время устройств интерферометр не содержит вспомогательных оптических элементов большого диаметра и подходит для контроля крупногабаритных выпуклых зеркал. Приведены результаты экспериментальных исследований интерферометра. Точность контроля достаточна для аттестации зеркал, работающих в оптическом и радио-диапазонах длин волн.
ВВЕДЕНИЕ
Оптические системы современных телескопов, как правило, состоят из нескольких зеркал. Наибольший размер всегда имеет главное вогнутое зеркало, после которого в большинстве случаев располагается выпуклое вторичное зеркало. Диаметры главных зеркал могут превышать 10 м, диаметры вторичных – часто более 500 мм, а в некоторых случаях превышают 1 м [1–5]. Данная статья посвящена проблеме контроля формы таких зеркал.
Большинство существующих методов аттестационного контроля формы отражающей поверхности выпуклых зеркал большого диаметра подразумевают использование вспомогательных оптических элементов, размеры которых превышают размеры контролируемого зеркала [6]. Таковы, например, все интерференционные методы, в частности методы анаберрационных точек [6] (классический метод Хиндла [7, 8] и его модификации [8, 9]), компенсационный [6] и голографический [10, 11]. Этот факт существенно увеличивает сложность и стоимость изготовления крупногабаритных оптических зеркал, например используемых в астрономических приборах.
Существуют различные альтернативные методы контроля, но для контроля выпуклых зеркал подходит только дефлектометрия [12], которая, однако, не обладает достаточной точностью. В этой связи на практике применяются методы переналожений [13], согласно которым зеркало контролируется тем или иным интерференционным методом по частям с последующей сшивкой участков в единую топографическую карту отклонений. Сшивка неминуемо приводит к увеличению погрешности контроля.
Второй фактор, также увеличивающий сложность и стоимость изготовления выпуклых зеркал, заключается в том, что при контроле асферических зеркал высших порядков неизбежно применение компенсатора (линзового или голографического). Рассчитанный и изготовленный специально для контроля конкретного зеркала компенсатор не может использоваться для контроля зеркал с другими параметрами формы.
1. СХЕМА ОРТОГОНАЛЬНЫХ ЛУЧЕЙ
Возможным решением этих проблем является использование схемы ортогональных лучей [14], согласно которой контролируемая поверхность (КП) зеркала освещается параллельным пучком лучей, направленным по нормали к ее оси симметрии (рис. 1). Плоский волновой фронт, созданный коллиматором 1, направляется на КП 2. Большая часть лучей проходит над КП и формирует опорный пучок 3; объектный пучок 4 отражается от КП. Опорный и объектный пучки интерферируют в плоскости регистрации 5. Интерференционная картина представляет собой систему полос (рис. 1б), ширина которых уменьшается от вершины КП к ее краю.
Рис. 1.
Схема ортогональных лучей (а), интерферограмма (б) и график зависимости ширины интерференционной полосы b от высоты h (в): 1 – оптической устройство, формирующее плоскую волну (коллиматор); 2 – деталь с контролируемой выпуклой поверхностью; 3 – опорный пучок; 4 – объектный пучок; 5 – плоскость регистрации интерферограммы.

Для исследования меридионального профиля КП, лежащего в плоскости рис. 1а, авторами предложено измерять зависимость ширины полосы b от ее координаты h в плоскости регистрации в меридиональном сечении (рис. 1в), так как эта зависимость b(h) однозначно определяется формой меридионального профиля КП [15]. Для анализа формы КП предложено вращать ее относительно оси симметрии и исследовать множество профилей.
Размеры анализируемого отраженного пучка в предлагаемой схеме меньше диаметра КП, поэтому данный метод можно применять и для контроля зеркал большого диаметра.
2. РЕАЛИЗАЦИЯ СХЕМЫ
Описанная выше схема ортогональных лучей реализована в виде интерферометра [16, 17] (рис. 2). В работе использован базовый интерферометр Тваймана–Грина 1 с He–Ne-лазером в качестве источника излучения. Длина волны излучения 633 нм, мощность 5 мВт. В рабочей ветви интерферометра формируется сферический волновой фронт с апертурой 1 : 4, который попадает на безаберрационную плоско-гиперболическую линзу 2 диаметром 300 мм, преобразующую волновой фронт в плоский. Он направляется на КП зеркала 3, расположенного на поворотном столе 4 (Taylor Hobson Rotation Stage V), причем ось вращения стола и ось симметрии КП совмещены. Максимальный диаметр КП в данном интерферометре ограничен креплением поворотного стола и составляет 280 мм; при замене стола или его доработке можно контролировать и более крупные зеркала.
Рис. 2.
Функциональная оптическая схема (а) и общий вид (б) интерферометра: 1 – интерферометр Физо, формирующий сферическую волну; 2 – коллимирующая безаберрационная линза; 3 – деталь с контролируемой выпуклой поверхностью; 4 – поворотный стол; 5 и 6 – микрообъективы; 7 и 8 – матричные приемники излучения; 9 – устройство перемещения системы регистрации интерферограммы; 10 – персональный компьютер.

Поскольку интерферограмма насчитывает большое количество (порядка ста тысяч) интерференционных полос, а ширина самых узких полос может составлять единицы микрометров, то зарегистрировать интерферограмму с достаточным разрешением с помощью одного приемника излучения за один кадр не представляется возможным. В этой связи в интерферометре реализована подвижная система регистрации, состоящая из микрообъективов (МО) 5 и 6 и матричных приемников излучения (МПИ) 7 и 8, смонтированных на линейном трансляторе 9. Каждый МО формирует увеличенный фрагмент интерферограммы на соответствующем МПИ. В качестве МО 5 используется Edmund Optics 10X DIN Semi-plan, а в качестве МО 6 – Edmund Optics 40X DIN Semi-plan. Они обладают различными увеличениями, что обеспечивает достаточно большое поле зрения для крупных полос, соответствующих вершине КП, и достаточное разрешение мелких полос на краю интерферограммы. Числовая апертура МО 6 составляет 0.6; это значит, что тангенс максимального угла наклона луча, отраженного от КП, не должен превышать 0.3, в противном случае он не будет пропущен МО 6 на МПИ 8. Это соответствует максимальному углу наклона крайней нормали к КП 8°.
В качестве МПИ использованы видеокамеры с КМОП-сенсором Aptina MT9P031. Формат сенсора 1/2.5”; разрешение 2592 × 1944 пикселя, размер пикселя 2.2 × 2.2 мкм2. Моторизованный линейный транслятор Standa 8MT175-200 позволяет в автоматическом режиме перемещать систему регистрации вдоль вертикальной оси в диапазоне 200 мм с минимальным шагом 2.5 мкм и считывать ее текущие координаты.
Таким образом, с помощью интерферометра можно получить и зарегистрировать интерферограммы от зеркал со следующими параметрами: форма КП – осесимметричная сферическая или асферическая второго или высших порядков, диаметр до 280 мм, угол наклона крайней нормали до 8°.
3. ОБРАБОТКА РЕЗУЛЬТАТОВ ИЗМЕРЕНИЙ
В начале обработки происходит фильтрация зарегистрированных фрагментов интерферограмм и вычисление координат интерференционных максимумов. На рис. 3а–3г представлен пример зарегистрированного фрагмента интерференционной картины, результат пространственного преобразования Фурье этого изображения до и после фильтрации, а также отфильтрованное изображение фрагмента интерферограммы, полученное обратным преобразованием Фурье от рис. 3в. Далее, в отфильтрованном изображении максимумы интерференционных полос без труда определяются стандартными алгоритмами, например, реализованными в программе Matlab.
Рис. 3.
Этапы фильтрации изображения интерферограммы: фрагмент интерференционной картины (а), результат пространственного преобразования Фурье этого изображения до фильтрации (б) и после нее (в), и отфильтрованное изображение фрагмента интерферограммы (г).
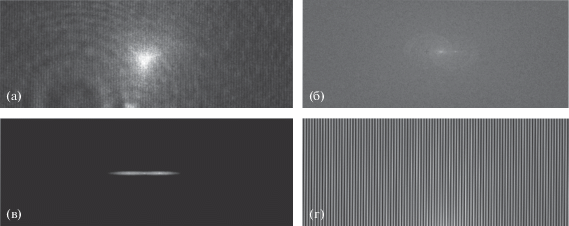
Зависимость ширины интерференционной полосы от высоты центра максимума интерференционной полосы b(h) содержит информацию о меридиональном профиле КП. Таким образом, процедура контроля сводится к измерению координат интерференционных максимумов, построением на основании измеренных данных зависимости b(h) и сравнением ее с теоретической зависимостью.
Обратимся вновь к рис. 1. Ширина интерференционной полосы b на произвольной высоте h определяется углом между интерферирующими пучками по формуле:
(1)
$b = {\lambda \mathord{\left/ {\vphantom {\lambda {\sin 2\varphi }}} \right. \kern-0em} {\sin 2\varphi }},$Погрешность формы КП приводит к погрешности угла наклона нормали Δφ, что вызывает отклонение ширины полосы b. Сравнивая теоретическое значение ширины полосы b0 с измеренным b, можно получить Δφ, преобразовав и продифференцировав формулу (1):
(2)
$\Delta \varphi = \frac{\lambda }{{2{{b}_{0}}}}\frac{{{{b}_{0}} - b}}{{\sqrt {b_{0}^{2} - {{\lambda }^{2}}} }}.$Угол наклона нормали к кривой z(y) определяется из выражения ${\text{tg }}\varphi = {{\delta z} \mathord{\left/ {\vphantom {{\delta z} {\delta y}}} \right. \kern-0em} {\delta y}}$, поэтому, учитывая малость величины δφ, отклонение реального профиля КП от теоретического, можно найти по формуле
Использование поворотного стола, на который устанавливается контролируемая деталь, позволяет получить информацию о множестве профилей и построить топографическую карту отклонений, а также рассчитать максимальное и среднеквадратическое отклонение формы КП.
Управление всеми компонентами интерферометра, а также математическая обработка результатов измерений и построение карты отклонений КП выполняется с помощью разработанного авторами программного обеспечения. Внешний вид окна с результатами измерений показан на рис. 4.
4. РЕЗУЛЬТАТЫ МОДЕЛИРОВАНИЯ И ЭКСПЕРИМЕНТАЛЬНЫХ ИССЛЕДОВАНИЙ
Для экспериментального исследования разработанного интерферометра исследованы выпуклые сферическое и гиперболическое зеркала. Диаметры зеркал 180 мм. Радиус сферического зеркала 400 мм; радиус кривизны при вершине гиперболического зеркала 450 мм, а его эксцентриситет 1.457. Результаты исследований показаны на рис. 5. В начале выполнен контроль зеркал с помощью контактного профилометра Taylor Hobson Form Talysurf, погрешность измерения которого составляет 0.1 мкм. Результаты измерения профилометром погрешности одного профиля сферического зеркала показаны на рис. 5а. Погрешность этого профиля была смоделирована в виде кривой 1 на рис. 5б, представляющей собой сумму гауссоид, модулированную гармонической функцией, параметры которых подобраны эмпирически. Затем был выполнен численный эксперимент, в котором эта погрешность добавлена к профилю сферического зеркала, рассчитаны координаты b и h, а затем погрешность была вычислена из этих координат. В результате получилась кривая 2 на рис. 5б. Разница между кривыми 1 и 2 на этом рисунке обусловлена погрешностью математического алгоритма; как видно, она несущественна.
Рис. 5.
Отклонение профиля сферического зеркала: а – измеренная профилометром, б – численно смоделированная (1) и восстановленная (2), в – измеренная разработанным интерферометром.

Наконец, рис. 5в иллюстрирует результаты исследования этого же профиля сферического зеркала с использованием разработанной установки. Видно, что представленные на рис. 5а и 5в профили различаются незначительно.
Для обоих исследуемых сферического и гиперболического зеркал измерялось по 10 профилей с помощью профилометра и с помощью разработанного интерферометра. Максимальное отклонение профиля, измеренное на профилометре, составило 0.25 мкм для сферического зеркала и 0.4 мкм для гиперболического. Эти же величины, измеренные разработанным методом, составили 0.16 мкм для сферического и 0.33 мкм для гиперболического зеркал. Из этого предварительно можно заключить, что предлагаемый метод имеет тот же порядок погрешности, что и профилометр, это позволяет использовать интерферометр для контроля зеркал, предназначенных для работы в дальнем инфракрасном, субмиллиметровом и радиодиапазонах длин волн.
ЗАКЛЮЧЕНИЕ
Разработанный интерферометр предназначен для контроля выпуклых сферических и асферических зеркал диаметром до 280 мм, однако несложная модификация конструкции интерферометра – замена поворотного стола – позволит контролировать зеркала существенно больших размеров. Важно, что при этом контролируемое зеркало является самым большим элементом интерферометра, что выгодно отличает предлагаемый метод от существующих. В настоящее время для повышения точности контроля совершенствуется методика юстировки интерферометра, а для более достоверной оценки погрешности измерения запланированы измерения нескольких зеркал различной формы (сферических и асферических) с последующим сравнением их результатов с результатами измерений на высокоточном аттестованном интерференционном оборудовании.
Достигнутая на данном этапе погрешность контроля порядка 0.1 мкм позволяет применять данный интерферометр для контроля зеркал, работающих в инфракрасном, субмиллиметровом и радиодиапазонах длин волн.
Список литературы
Martinez O.M., Martinez A.D., Perez N.B., Abellan M.A. // Proc. SPIE. 2012. V. 8444. P. 84443W.
Cho M.K., Liang M., Neill D.R. // Proc. SPIE. 2009. V. 7424. P. 742407.
Crampton D., Simard L. // Proc. SPIE. 2006. V. 6269. P. 62691T.
Lightsey P.A., Atkinson C., Clampin M., Feinberg L.D. // Optical Engineering. 2012. V. 51. № 1. P. 011003.
Wild W., Kardashev N.S., Likhachev S.F. et al. // Experimental Astronomy. 2009. V. 23. № 1. P. 221.
Пуряев Д.Т. Методы контроля оптических асферических поверхностей. М.: Машиностроение, 1976.
Hindle J. // Monthly Notices Royal Astronomical Soc. 1931. V. 91. № 5. P. 592.
Malacara D. Optical Shop Testing. N.Y.: Wiley, 1978.
Percino-Zacarias M.E., Cordero-Davila A. // Appl. Optics. 1999. V. 38. № 28. P. 6050.
Burge J.H. // Proc. SPIE. 1995. V. 2576. P. 258.
Лукин А.В., Мустафин К.С. // Оптико-механическая пром-сть. 1979. № 4. С. 53.
Trumper I., Choi H., Kim D.W. // Optics Express. 2016. V. 24. № 24. P. 27993.
Burge J.H., Su P., Zhao C. // Proc. SPIE. 2008. V. 7018. P. 701818.
Пуряев Д.Т. Способ измерения профиля оптических поверхностей. А.с. CCCH № 1044969. Опубл. Б.И. № 36 от 30.09.1983.
Новиков Д.А., Иванникова Н.В., Батшев В.И. и др. Метод контроля формы выпуклых асферических поверхностей и устройство для его осуществления. Патент РФ № 2706388. Опубл. офиц. бюл. “Изобретения. Полезные модели” № 32 от 18.11.2019.
Gavlina A.E., Batshev V.I., Novikov D.A., Sergeeva M.V. // Proc. SPIE. 2019. V. 11056. P. 110563T.
Новиков Д.А., Батшев В.И. // Законодательная и прикладная метрология. 2017. № 2. С. 33.
Дополнительные материалы отсутствуют.
Инструменты
Радиотехника и электроника



