Радиотехника и электроника, 2023, T. 68, № 10, стр. 998-1002
Структура пленок алюминия для создания туннельных переходов
М. В. Стрелков a, b, *, А. М. Чекушкин a, А. А. Ломов c, С. В. Краевский d, М. Ю. Фоминский a, М. А. Тарасов a
a Институт радиотехники и электроники им. В.А. Котельникова РАН
125009 Москва, ул. Моховая, 11, стр. 7, Российская Федерация
b Московский физико-технический институт (национальный исследовательский университет)
141701 Долгопрудный, Московской обл., Институтский пер., 9, Российская Федерация
c Физико-технологический институт им. К.А. Валиева РАН
117218 Москва, Нахимовский просп. 36, корп. 1, Российская Федерация
d Научно-исследовательский институт биомедицинской химии им. В.Н. Ореховича
119121 Москва, ул. Погодинская, 10, стр. 8, Российская Федерация
* E-mail: strelkov.mv@phystech.edu
Поступила в редакцию 17.05.2023
После доработки 01.08.2023
Принята к публикации 03.08.2023
- EDN: YZIYOK
- DOI: 10.31857/S0033849423100157
Аннотация
Проведен цикл исследований структуры пленок алюминия, напыленных на монокристаллические подложки кремния в разных температурных режимах. Микроскопом атомных сил исследована шероховатость и размер зерна пленок зародышей толщиной 20 нм, напыленных при повышенных температурах, а также допыленных поверх слоя зародыша при комнатной температуре до толщины 150 нм. Измерен профиль пленок в электронном микроскопе. Найдено, что пленки на горячем подслое оказываются более гладкими, более жесткими (менее рыхлыми) и позволяют рассчитывать на создание переходов сверхпроводник–изолятор–сверхпроводник и сверхпроводник–изолятор–нормальный металл соответственно с более высокой плотностью тока и меньшей емкостью.
ВВЕДЕНИЕ
Реально достигнутые параметры джозефсоновских туннельных переходов оказываются значительно хуже теоретических оценок, так для ниобиевых сквидов с туннельным барьером из оксида алюминия характерное напряжение Vc = IcRn в лучшем случае достигает 200 мкВ, а по теории должно быть до 2 мВ. Для терагерцовых смесителей и генераторов на переходах сверхпроводник–изолятор–сверхпроводник (СИС) главные проблемы – это большая удельная емкость, гистерезис и появление токов утечки. И та и другая проблема могут быть связаны с морфологией и кристаллической структурой пленок туннельного барьера и сверхпроводящих электродов. На практике пленки получаются гранулированные, туннельные барьеры неравномерные, эффективная площадь на уровне 10%, отсюда – утечки, паразитные емкости. Кристаллическая структура определяет принципиально разные свойства одних и тех же элементов, как, например, алмаз, графит, фуллерены, нанотрубки для углерода. Ключевыми элементами перспективной сверхпроводниковой технологии являются: применение монокристаллических подложек, согласованных по значению постоянной решетки и ориентации с выращиваемыми пленками, оптимизация температурных режимов роста, контролируемое формирование оксидного или нитридного туннельного барьера.
1. ИЗГОТОВЛЕНИЕ И АНАЛИЗ СТРУКТУРЫ
В данной работе пленки алюминия выращены методом магнетронного распыления на подложке Si(111) с квази-эпитаксиальным слоем-зародышем. Пленки осаждались в две стадии, по аналогии с [1]. Вначале в течение 100 с на подложке формировали островковый слой 10…20 нм монокристаллических зародышей при температуре 400°С, скорости осаждения частиц Al не более 0.2 нм/с, давлении в камере 1.5 × 10–3 мбар и мощности магнетрона 300 Вт. Процесс остывания образца до 19°С проходил в условиях остаточного давления в течение 12 ч. Осаждение пленки на второй стадии выполнялось в условиях стационарной температуры образца. Процесс осаждения пленки проходил в атмосфере аргона (давление 4 × 10–3 мбар) со скоростью 1.45 нм/с в течение 138 с. Температура кремниевой подложки фиксировалась при 19°С за счет контролируемого охлаждения столика подложки от водоохлаждающего аппарата (чиллера). Изображение слоев-зародышей и пленок, напыленных поверх зародышей, полученные на атомно-силовом микроскопе (АСМ) приведены на рис. 1 и 2 соответственно. Данные измерений зернистости слоев-зародышей и пленок, напыленных поверх зародышей, приведены в табл. 1 и 2 соответственно.
Отдельно исследованы подготовленные пленки-зародыши, толщиной до 20 нм, и пленки с двухстадийным напылением алюминия. Поперечное сечение пленки с квази-эпитаксиальным подслоем приведено на рис. 3.
По измерениям рентгеновской дифракции можно определить кристаллографическую структуру пленок и ориентацию кристаллической решетки, ориентация преимущественно (111), дифрактограммы приведены на рис. 4.
Рис. 1.
АСМ-изображения пленки зародыша 20 нм, напыленной на горячую подложку (а) и подложку при комнатной температуре (б), полученные на АСМ-микроскопе профили пленки зародыша, напыленной на горячую подложку (в) и на подложку при комнатной температуре (г).

Рис. 2.
Пленки 150 нм, напыленные поверх “горячего” зародыша толщиной 20 нм (а, в) и на подложку при комнатной температуре (б, г), профили пленок напыленных поверх “горячего” зародыша (д) и поверх подложки при комнатной температуре (е).

Таблица 1.
Характеристики пленок в зависимости от температуры подложки, при которой напылялся слой – зародыш
| Тз, °С | Размер зерна, нм | Шероховатость, нм | |
|---|---|---|---|
| от пика до пика | среднеквадратичная | ||
| 200 | 160 | 25 | 6.6 |
| 400 | 60 | 10 | 1.6 |
| 500 | 70 | 5 | 0.8 |
Таблица 2.
Параметры 150-нанометровой пленки в зависимости от температуры напыления зародыша Тнап
| Тнап, °С | Размер зерна, нм | Шероховатость, нм | |
|---|---|---|---|
| от пика до пика | среднеквадратичная | ||
| 400 | 200 | 20 | 7 |
| Комнатная | 300…400 | 25…40 | 8…25 |
Рис. 3.
Изображение скола в электронном микроскопе: снизу четко просматривается зернистый слой-зародыш толщиной порядка 20 нм (скриншот).
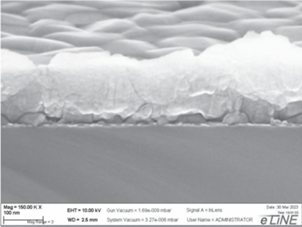
Рис. 4.
Рентгеновские дифрактограммы пленок толщиной 200 (а), 20 (б, в) и 10 нм (г), напыленных с высокой (а, б) и низкой (в, г) скоростью; на всех пленках наблюдается пик, соответствующий ориентации подложки (111): а – 200 нм, высокая скорость напыления, б – 20 нм, высокая скорость, в – 20 нм, низкая скорость, г – 10 нм, низкая скорость.

Таблица 3.
Твердость пленок в зависимости от условий роста
| Условия | Твердость, ГПа | Модуль Юнга, ГПа |
|---|---|---|
| Холодный подслой | 5.5 | 40 |
| Горячий подслой | 16 | 95 |
| Контрольный 200 нм | 5 | 35 |
Было проведено также измерение механических свойств выращенных пленок Al/Si (111) на установке CB-500 Nanovea (USA) с помощью наноиндентора, в качестве которого использована трехгранная алмазная пирамида Берковича с радиусом 50 нм. Получены прямые и обратные зависимости приложенной нагрузки от глубины проникновения индентора (режим непрерывного измерения жесткости). Усредненные результаты приведены в табл. 3.
2. ИЗМЕРЕНИЕ ПАРАМЕТРОВ
Были измерены образцы из алюминия, идентичные по размерам и выполненные в виде полосок шириной 0.2 мм и длиной 10 мм. При толщине пленок 2 нм и меньше измерено электрическое сопротивление порядка 1 МОм, т.е. пленка, по всей видимости, была островковой: состояла из слабосвязанных участков. При толщине 6 нм удельное сопротивление составило ρ = 2 × 10–6 Ом м, при толщине 20 нм ρ = 2.9 × 10–7 Ом м. Сопротивление пленок толщиной более 300 нм приближалось к табличному значению для массивного алюминия ρ = 2.6 × 10–8 Ом м. При малых толщинах пленка состоит из проводящих островков, разделенных слабо проводящими промежутками, а при увеличении толщины проводящие области сливаются. Малая проводимость аморфных тонких пленок может быть обусловлена локализацией носителей зарядов на слабосвязанных кластерах и рассеянием электронов на дефектах. Критическая температура сверхпроводящего перехода пленок толщиной 18 и 3 нм составляет 1.5 и 2.4 К соответственно.
Параметры туннельных СИС-переходов в значительной степени определяются структурой области барьера из оксида или нитрида алюминия. Для практических туннельных переходов сопротивлением от 1 до 2 кОм/мкм2 измеренная по резонансам удельная емкость составляет от 70 до 50 фФ/мкм2. По формуле для плоского конденсатора C = = εε0S/d, где ε0 = 8.85 × 10–12 Ф/м и ε = 3, это соответствует толщине оксидного барьера d = εε0S/C = = 0.38…0.5 нм. Для туннельного перехода при таких сопротивлениях оценка толщины барьера составляет приблизительно 1.8 нм, для идеального плоского конденсатора это соответствовало бы удельной емкости 15 фФ/мкм2, т.е. разница в оценке толщины в теории составляет 4.7…3.6 раз, таким образом, емкость сформирована на большей площади, чем эффективная площадь туннельного барьера. В реальности относительная диэлектрическая проницаемость даже идеального аморфного барьера оказывается меньше двух, эффективная толщина емкостного барьера будет на уровне 0.25 нм. Можно предположить, что шероховатая поверхность имеет значительно большую площадь при меньшей прозрачности. По данным работы [2] эффективная площадь туннелирования составляет и вовсе 0.13. Это значит, что лишь малая (более тонкая) часть площади перехода отвечает за туннельную проводимость, а остальная (более толстая часть) и определяет эффективную паразитную емкость. Однако рассчитывать на идеальный туннельный барьер достаточно сложно, поскольку для AlOx реальная измеренная постоянная решетки составляет 0.47 нм, т.е. идеальный переход будет представлять собой туннельный барьер толщиной, примерно равной постоянной решетки диэлектрика. Для этого требуется сформировать атомарно гладкую кристаллическую поверхность без дефектов и двойников. При этом площадь переходов будет на порядок меньше стандартных переходов на гранулированных пленках при тех же значениях туннельной проводимости.
В табл. 4 приведены теоретические оценки для туннельных переходов площадью 1 мкм2 с толщиной диэлектрика 1 и 2 нм в СИС-переходах на основе пленок алюминия.
ЗАКЛЮЧЕНИЕ
Создание эпитаксиальных атомарно-гладких сверхпроводниковых туннельных переходов даст возможность избавиться от гистерезиса и необходимости резистивного шунтирования переходов (или уменьшить их влияние), что означает существенное улучшение всех предельных характеристик для устройств сверхпроводниковой аналоговой и цифровой электроники.
Авторы заявляют об отсутствии конфликта интересов.
Список литературы
Rodionov I., Baburin A., Gabidullin A., et al. // Sci. Rep. 2019. V. 9. Article No. 12232.
Greibe T., Stenberg M., Wilson C. et al. // Phys. Rev. Lett. 2011. V. 106. № 9. Article No. 097001.
Дополнительные материалы отсутствуют.
Инструменты
Радиотехника и электроника


