Химия высоких энергий, 2019, T. 53, № 2, стр. 127-134
Формирование высокоаспектных микроструктур на тетраакрилат/акриламидных мономерах под действием синхротронного излучения
Д. И. Деревянко a, *, Н. А. Орлова a, В. В. Шелковников a, b, И. К. Шундрина a, Б. Г. Гольденберг c, В. П. Корольков d
a Новосибирский институт органической химии им. Н.Н. Ворожцова СО РАН
630090 г. Новосибирск, просп. Академика Лаврентьева, 9, Россия
b Новосибирский государственный технический университет
630073 г. Новосибирск, просп. К. Маркса, 20, Россия
c Институт ядерной физики им. Г.И. Будкера СО РАН
630090 г. Новосибирск, просп. Академика Лаврентьева, 11, Россия
d Институт автоматики и электрометрии СО РАН
630090 г. Новосибирск, просп. Академика Коптюга, 1, Россия
* E-mail: Derevyanko@nioch.nsc.ru
Поступила в редакцию 09.04.2018
После доработки 02.11.2018
Принята к публикации 30.10.2018
Аннотация
В работе получены фотополимерные материалы на основе новых полиакрильных мономеров акрилатного и смешанного акрилатно-акриламидного типов. Путем фотополимеризации получены сшитые пленки на основе синтезированных мономеров и проведено исследование термомеханических свойств сшитых пленок. Определены модули упругости фотополимерных пленок при комнатной температуре (1.3 и 1.5 ГПа) и температуре стеклования (82–93°С). Запись высокоаспектных микроструктур проведена с помощью синхротронного излучения на накопителе ВЭПП-3 (энергия электронов 2 ГэВ) станции LIGA в ИЯФ СО РАН. Выявлено, что под действием СИ с дозами 1–15 Дж/см3 происходит полимеризация мономеров. Получена зависимость толщины заданной микроструктуры от поглощенной дозы СИ и построена соответствующая характеристическая кривая. Получены микроструктуры с аспектным соотношением 1 : 25.
ВВЕДЕНИЕ
В настоящее время актуальным является создание структур с высоким аспектным соотношением. Такие микроструктуры могут быть использованы для изготовления микрофлюидных чипов, коллиматоров, дифракционных и поглощающих (отсеивающих) решеток с глубоким профилем в качестве компонентов микроэлектромеханических и микрооптических систем, элементов управления терагерцевым излучением [1, 2]. Особенностью глубокой рентгенолитографии является возможность формирования микроструктур с топологией, прецизионно повторяющей рисунок рентгеношаблона с высоким аспектным отношением, а также боковыми стенками с высокой степенью вертикальности [3].
Наиболее распространенным материалом для записи микроструктур, в том числе при действии рентгеновского синхротронного излучения (СИ), является фоторезист SU-8 [4]. Продукт SU-8 является негативным резистом на эпоксидной основе, производимый компанией MicroChem Corp. [5]. Недостатками резистов на эпоксидной основе является, во-первых, относительно низкая чувствительность к рентгеновскому излучению; так, формирование сложных топологий методом векторного рисования на площади в несколько квадратных сантиметров может потребовать несколько десятков часов работы на пучке СИ. Во-вторых, необходим процесс пред- и пост-экспозиционной термообработки с точным контролем температуры перед облучением и проявлением фотополимера.
Формирование нерастворимого полимера можно осуществить путем свободно-радикальной полимеризации полиакрилатных мономеров с образованием сетки сшитого полимера [6]. При использовании свободно-радикальной полимеризации этап пост-термообработки необязателен. Кроме того, можно ожидать повышения чувствительности материала при инициировании свободно-радикальной полимеризации по сравнению с катионной полимеризацией [7, 8].
В фотополимерных материалах широко применяются полиэфир-акрилатные мономеры. Известно [9], что карбоцепные полиамидные гомо- и сополимеры превосходят соответствующие сложноэфирные аналоги по прочностным свойствам, имеют более высокие температуры стеклования, труднее гидролизуются. Можно ожидать, что использование полиакрилатных мономеров смешанного акрилатно-акриламидного типа приведет к сшитым материалам с улучшенными термомеханическими характеристиками.
Целью данной работы является исследование термомеханических свойств сшитых полимеров и формирование микроструктур с высоким аспектным соотношением при действии синхротронного излучения в тетраакрилатных и смешанных акрилатно-акриламидных мономерах-производных дигидроксидифенилсульфида.
ЭКСПЕРИМЕНТАЛЬНАЯ ЧАСТЬ
Получение композиций и экспериментальных образцов
Для проведения экспериментов был получен ряд фотополимерных композиций (ФК), представляющих собой растворы в хлороформе мономеров – производных дигидроксидифенилсульфида тетраакрилатного (ТА) либо тетраакрилат-акриламидного типа, полученного через пиперазиновый линкер (ТААП). Структурные формулы ТА и ТА-АП мономеров приведены на рис. 1, 2 соответственно.
Синтез ТА мономера – 3-[4-({4-[2,3-бис(проп-2-еноилокси)пропокси]-фенил}сульфанил)фенокси]-3-(проп-2-еноилокси)пропан-2-ил-проп-2-еноата – описан нами в работе [10]. Акрилат-акриламидный мономер – 3,3'-{4,4'-тиобис(4,1-фенилен)бис(окси)бис[1-(4-акрилоилпиперазин-1-ил)] пропан-3,2-диил} диакрилат (ТААП), содержащий две акрилатные и две акриламидные функциональные группы, получен впервые. Синтез ТААП мономера осуществляли следующим образом: коммерчески доступный бис(4-гидроксифенил)сульфид вводили в реакцию с эпихлоргидрином, получая бис(эпокси)производное III [11], в котором далее раскрывали эпоксидные циклы взаимодействием с пиперазином с образованием соединения IV и затем подвергали акрилоилированию две гидроксильные группы и две аминогруппы в пиперазиновом фрагменте, получая разветвленный акрильный мономер ТААП смешанного акрилатно-акриламидного типа (рис. 3).
Синтез 3,3'-{4,4'-тиобис(4,1-фенилен)бис(окси)бис[1-(пиперазин-1-ил)]-пропан-2-ола} IV. Раствор 22.1 г (0.25 моль) пиперазина в 140 мл метанола нагревали до 40°С, к нему прибавляли небольшими порциями 12.5 г (0.04 моль) 2-{[4-(4-оксиран-2-илметокси)фенил]сульфанилфеноксиметил}-оксирана III [11]. Смесь кипятили 2 ч, удаляли метанол в вакууме водоструйного насоса, остаток растворяли в хлористом метилене, раствор промывали водой, сушили CaCl2, растворитель отгоняли. Получили 17.5 г соединения IV, которое использовали в следующей стадии без дополнительной очистки. Спектр ПМР (CDCl3), δ, м.д.: 7.23 д (4Н аром, J 7.5 Гц), 6.82 д (4Наром, J 7.5 Гц), 4.01–4.08 м (2Н, СН), 3.89–3.94 м (4Н, 2OСН2), 2.83–2.89 м (8Н, протоны пиперазиногруппы), 2.55–2.64 м (4Н, протоны пиперазиногруппы), 2.44–2.49 м (4Н, 2NCH2), 2.35–2.42 м (4Н, протоны пиперазиногруппы).
Синтез (3,3'-{4,4'-тиобис(4,1-фенилен)бис(окси)бис[1-(4-акрилоил-пиперазин-1-ил)]пропан-3,2-диил}диакрилата (II) (мономер ТААП). К суспензии 8.0 г (0.016 моль) соединения IV, 9.3 г (0.067 моль) свежепрокаленного карбоната калия и гидрохинона на конце шпателя в 80 мл сухого хлористого метилена прибавляли по каплям при комнатной температуре и перемешивании раствор 6.7 мл (7.5 г, 0.083 моль) хлористого акрилоила в 20 мл сухого хлористого метилена. Смесь кипятили 1 ч, затем охлаждали до комнатной температуры, добавляли ~50 мл дистиллированной воды и экстрагировали хлористым метиленом. Экстракт промывали Н2О, сушили CaCl2, растворитель отгоняли в вакууме без нагрева. Остаток (масло, 6.3 г) растворяли в хлороформе и очищали хроматографированием на колонке с оксидом алюминия (элюент CHCl3), собирали вторую светло-желтую фракцию. После удаления элюента в вакууме без нагрева получали 4.1 г (36%) соединения II (мономер ТААП), которое хранили в виде раствора в хлороформе (4 г мономера растворяли в 20 мл хлороформа). Вязкая масса, при высыхании образует стеклообразный тонкий слой. Структура соединения II подтверждена методами спектроскопии ЯМР 1H и масс-спектрометрии. Спектр ПМР (СDСl3), δ, м.д.: 7.23 д (4Наром,J 7.5 Гц), 6.82 д (4Наром,J 7.5 Гц), 6.51, 6.24, 5.66 (все д.д, по 2Н, АВС-система, протоны акриламидной группы, J1 17.5, J2 11.2, J3 1.8 Гц), 6.39, 6.10, 5.83 (все д.д, по 2Н, АВС-система, протоны акрилатной группы, J1 18.0, J2 10.5, J3 1.3 Гц), 5.29–5.38 м (2Н, СН), 4.07–4.16 м (4Н, ОСН2), 3.58–3.65 м (4Н, протоны пиперазиногруппы), 3.46–3.52 м (4Н, протоны пиперазиногруппы), 2.62–2.72 м (4Н, NCH2), 2.48–2.53 м (8Н, протоны пиперазиногруппы). Масс-спектр высокого разрешения: Найдено [М]+ 718.3036. C38H46O8N4S. Вычислено М 718.3031.
Зависимости модулей упругости и тангенса угла механических потерь пленок от температуры определяли методом динамического механического анализа с использованием анализатора ДМА 242С фирмы NETZSCH в режиме растяжения при частоте 1 Гц и скорости нагрева 3°С/мин. Толщина пленок составляла 120–140 мкм.
Спектральные данные синтезированных в работе соединений получены в Химическом сервисном центре коллективного пользования СО РАН. Спектры ЯМР 1Н зарегистрированы на приборе Bruker AC-300 (300.13 МГц) в дейтерохлороформе; в качестве внутреннего стандарта использовали остаточные протоны СНCl3 (δH = 7.24 м.д.).
Масс-спектры образцов получены на времяпролетном масс-спектрометре Autoflex II (Bruker Daltonics). В эксперименте использована стандартная стальная мишень (Bruker Daltonics). 0.5 мкл растворов образцов смешивали с 0.5 мкл 2,5-дигидроксибензойной кислоты (насыщенный раствор в тетрагидрофуране), наносили на мишень и высушивали при комнатной температуре. Масс-спектры записаны в диапазоне 20–4000 m/z с регистрацией как положительных, так и отрицательных ионов в линейном и отражательном режимах. Масс-спектр высокого разрешения соединения (I) записан на приборе DFS (Thermo Scientific) при прямом вводе, температуре источника 280°C и энергии электронов 70 эВ. Молекулярную массу и состав определяли по точным значениям массовых чисел молекулярных ионов.
Для исследования термомеханических свойств сшитых полимерных пленок на основе синтезированных тетраакрилатных мономеров были получены две фотополимерные композиции (ФПК), представляющие собой раствор в хлороформе тетраакрилатных мономеров и фотоинициатора трифлата – (4-фенилтиофенил)-дифенилсульфония [12] (2% по весу к мономеру). Композицию наносили на стеклянную подложку, высушивали до полного улетучивания растворителя, далее для предотвращения кислородного ингибирования наносили лавсановую пленку, после чего проводили экспонирование под УФ светом в облучателе ELC-500 UV (Electro-light Corporation) в течение 10 мин до получения твердой пленки сшитого полимера. Далее пленку отслаивали от подложки и проводили измерения.
Приготовление образцов для облучения синхротронным излучением осуществляли следующим образом: ФПК наносили на стеклянную пластинку размером 2.5 × 2.5 см2 и высушивали до улетучивания растворителя на горизонтальном столике при комнатной температуре в течение 1 ч. В результате экспериментальные образцы представляли собой аморфный мономер на стеклянной пластине, с различной толщиной слоя, в зависимости от количества нанесенного раствора.
Запись микроструктур была осуществлена на станции “LIGA” ИЯФ СО РАН, схема экспериментальной установки, детально описанной в [13], показана на рис. 4. Синхротронное излучение из накопителя ВЭПП-3 имеет широкий спектральный диапазон (примерно 0.2–30 А). Высокоэнергичные коротковолновые фотоны слабо поглощаются в материале резиста, а длинноволновые фотоны эффективно можно подавлять фильтрами (например, алюминиевая фольга). Таким образом, спектр поглощаемый в резисте определяется используемыми фильтрами и поглощением в материале резиста. При этом нужно обеспечить однородное обеспечение по глубине резиста, и не допустить его перегрева. Для оценок поглощенной дозы спектральное поглощение в материале резиста рассматривалось как совокупное поглощение в последовательности слоев, соответствующих набору элементов в брутто-формуле резиста. С учетом поглощения в фильтрах и материале резиста основная мощность поглощенного излучения лежит в диапазоне от 0.6 до 1.7 Å. Образцы фотополимерных материалов облучали синхротронным излучением из накопительного кольца ВЭПП-3 ИЯФ СО РАН при энергии электронов 2 ГэВ и электронных токах 50–100 мА через рентгеношаблоны с тестовыми структурами. Поглощенные дозы в образцах были в диапазоне от 3 до 100 Дж/см3.
Рис. 4.
Схема экспериментальной литографической установки. 1 – точка излучения СИ; 2 – окно выпуска СИ из ВЭПП-3; 3 – бериллиевые окна; 4 – спектральный фильтр; 5 – рентгеношаблон; 6 – резист; 7 – моторизированный столик.
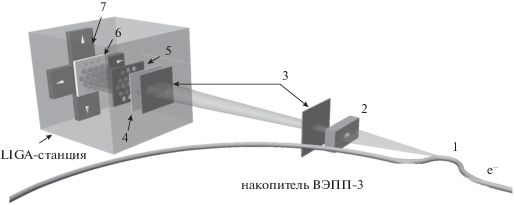
Для минимизации дифференциальной поглощенной дозы по глубине образцов было осуществлено подавление длинноволновой части спектра за счет установки дополнительного фильтра из алюминиевой фольги толщиной 150 мкм. Пучок СИ проходит через рентгеновскую маску, проникая в слой фотополимерного материала, где формируется скрытое изображение микроструктуры из сшитого полимера. После облучения неполимеризованные области в образцах были проявлены в эфире левулиновой кислоты при температуре 25°С. Определение геометрии записанных структур и измерение глубины проявленных зон образцов проводили с помощью интерферометра белого света WLI (фирма “Breitmeier GmbH”) и электронного микроскопа Hitachi S-3400N.
РЕЗУЛЬТАТЫ И ОБСУЖДЕНИЕ
Термомеханические свойства УФ-отвержденных пленок
Термомеханические характеристики УФ-отвержденных пленок приведены в табл. 1, температурные зависимости модуля упругости и тангенса угла механических потерь – на рис. 5. Пленки отвержденных композиций ТА и ТААП при комнатной температуре твердые и характеризуются высокими значениями модуля упругости 1.3 и 1.5 ГПа соответственно. В процессе нагревания пленок при достижении температуры стеклования наблюдается переход из стеклообразного в вязкоэластичное состояние, модули упругости при этом уменьшаются на несколько порядков. Температура стеклования, определенная как максимум тангенса угла механических потерь, для пленок ТА равна 82°С, для пленок ТААП 93°С. Однако значения модуля упругости Е' при температурах выше температуры стеклования остаются высокими для высокоэластичного состояния – 103 МПа для пленок ТА и 157 МПа для пленок ТААП, что указывает на формирование сетчатых структур в полученных пленках.
Рис. 5.
Температурные зависимости модуля упругости Е' (a) и тангенса механических потерь (б) для пленок ТААП (1) и ТА (2).
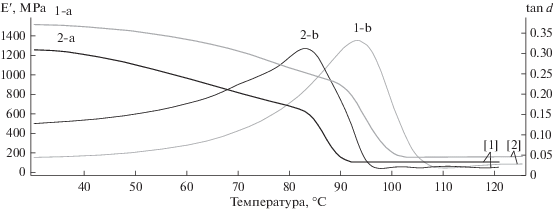
Согласно [14] модуль упругости и температура стеклования промышленного фоторезиста SU-8 изменяются в широком диапазоне 50–200°C в зависимости от дозы УФ облучения и условий последующей термообработки. Максимальных значений Е' и tgσ достигают только при повышении температуры обработки пленок SU-8 до 200°С. Из рис. 5 видно отчетливое повышение в полимерных пленках температуры стеклования и модуля упругости ниже и выше температуры стеклования при введении полимеризующихся акриламидных групп вместо акрилатных групп.
Изучение чувствительности фотополимерных композиций и запись микроструктур под действием СИ
Для определения чувствительности мономеров к рентгеновскому излучению была получена характеристическая кривая – зависимость толщины образца, после облучения и промывки в растворителе, от поглощенной дозы. Построение характеристической кривой позволяет планировать условия процессов экспонирования и проявления при изготовлении микроструктур.
По результатам измерений были получены характеристические кривые ТА и ТААП мономеров. Результаты графической аппроксимации с помощью ассоциативной экспонициальной функции представлены на рис. 6а. Полученные характеристические кривые ТА и ТААП мономеров, близки между собой. Профилограмма границ облученных различными дозами участков после проявления ТААП мономера приведена на рис. 6б.
Рис. 6.
(а) Зависимость толщины микроструктуры ТА и ТААП мономеров от величины поглощенной дозы СИ. (б) Профилограмма границ облученных различными дозами участков после проявления ТААП мономера (изменение дозы облучения от 2 до 6 Дж/см3 с шагом 1 Дж/см3).
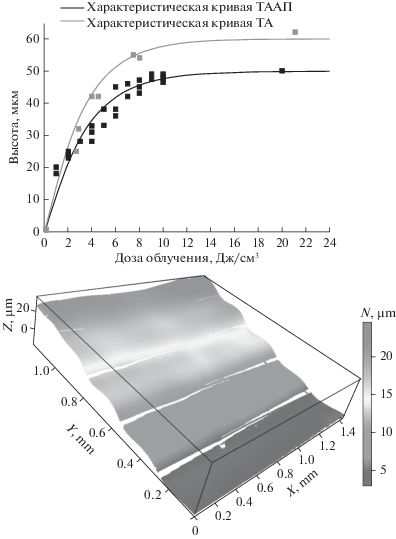
Из характеристических кривых видно, что формирование рельефа начинается при дозе облучения 1 Дж/см3; при меньших дозах фотополимеризация происходит, однако большая часть структур смывается при проявлении. При значении дозы 15 Дж/см3 наблюдается выход характеристической кривой на насыщение, т.е. облучения мономеров с дозой 15 Дж/см3 достаточно для формирования однородно заполимеризованных микроструктур. Для негативного резиста SU-8 выход характеристической кривой на насыщение достигается при дозе облучения 30 Дж/см3 [15]. Таким образом, чувствительность ТА и ТААП мономеров одинакова и в два раза выше по сравнению с эпоксидным мономером SU-8. Основное отличие образцов на основе мономера ТА по сравнению с ТААП является то, что пленки ТА мономера до экспонирования являются липкими и обладают медленной текучестью при записи микроструктур в вертикальном положении, в то время как образцы на основе ТААП мономера являются твердыми пленками и не перемещаются при записи микроструктур в вертикальном положении подложки. Это дает возможность формировать на данном мономере микроструктуры на вертикально расположенной подложке, что является неотъемлемым требованием для векторного рисования больших структур с использованием СИ станции LIGA ВЭПП-3, при меньшей дозе облучения по сравнению с резистом SU-8. Это позволяет ускорить процесс экспонирования на станции СИ.
Для проверки возможности получения высокоаспектных микроструктур образцы пленок ТА и ТААП мономеров были облучены дозой 30 Дж/см3 через рентгеновскую маску с цифровой топологией (рис. 7).
Из рис. 7 видно, что ТА и ТААП позволяют получить микроструктуры, имеющие следующие параметры: ширина 8 и высота 196 мкм (аспектное соотношение 1 : 25). Необлученные части мономеров удалены в проявителе полностью, следов резиста между структурами не наблюдается.
Таким образом, исследуемые полифункциональные мономеры могут быть использованы для создания высокоаспектных микроструктур под действием СИ. Следует отметить, что в ходе получения микроструктур на обоих мономерах не требуется этап термообработки до облучения и отжиг после облучения, что упрощает технологию создания микроструктур по сравнению с использованием резиста SU-8.
ЗАКЛЮЧЕНИЕ
Исследованы термомеханические свойства пленок, полученных путем фотополимеризациии синтезированных тетраакрилатных мономеров как акрилатного, так и смешанного акрилатно-акриламидного типа. Показано образование в результате УФ облучения сшитых структур, устойчивых при температурах выше температур стеклования полимеров. На обоих типах мономеров действием СИ излучения были сформированы высокоаспектные микроструктуры (1 : 25) в слоях толщиной до 200 мкм. Выявлено, что мономеры обладают чувствительностью 15 Дж/см3, что в два раза выше, чем у эпоксидного резиста SU-8. Отсутствие этапа пред- и пост-термообработки позволяeт упростить и ускорить процесс формирования высокоаспектных микроструктур методом прямой записи микропучком СИ.
Мономер ТААП формирует твердые пленки и позволяет проводить длительную равномерную запись микроструктур в вертикальном положении образца относительно пучка СИ. Разрабатываемые мономеры перспективны для применения в технологиях изготовления рентгеношаблонов и прототипов (оригиналов) микроструктурированных элементов с высоким аспектным отношением для последующего тиражирования с применением гальванопластики и репликации на основе термо- или фотопроцессов.
Благодарности. Работа выполнена при частичной финансовой поддержке РНФ (проект № 18-73-00226, № 16-13-10156).
Облучение образцов в ходе выполнения работы выполнено с использованием оборудования ЦКП “СЦСТИ” на базе ВЭПП-3/ВЭПП-4М/НЛСЭ ИЯФ СО РАН, поддержанного Минобрнауки России (уникальный идентификатор проекта RFMEFI62117X0012).
Авторы выражают благодарность Химическому исследовательскому центру коллективного пользования СО РАН за проведение спектральных и аналитических измерений.
Профилометрия образцов осуществлялась на оборудовании ЦКП “Высокоразрешающая спектроскопия газов и конденсированных сред” в ИАиЭ СО РАН.
Список литературы
Гольденберг Б.Г. // Создание LIGA-технологического комплекса на источнике синхротронного излучения ВЭПП-3: дис. канд. тех. наук: 01.04.01 / Гольденбер Борис Григорьевич. Новосибирск, 2011. 146 с.
Резникова Е.Ф., Гольденберг Б.Г., Кондратьев В.И., Кулипанов Г.Н., Корольков В.П., Насыров Р.К. // Известия РАН. Серия физическая. 2013. Т. 77. № 2. С. 131.
Гольденберг Б.Г., Абрамский А.Ю., Зелинский А.Г., Маслий А.И., Максимовский Е.А., Кондратьев В.И., Корольков В.П., Купер К.Э., Петрова Е.В., Пиндюрин В.Ф. // Поверхность. Рентгеновские, синхротронные и нейтронные исследования. 2011. № 2. С. 61.
Lorenz H., Despont M., Fahrni N., LaBianca N., Renaud P., Vettiger P. // J. Micromech. Microeng. 1997. V. 7. P. 121.
Microсhem corp.: [сайт]: URL: http://www.microchem.com/Prod-SU8_KMPR.htm (дата обращения: 19.02.2017)
Миронников Н.Г., Корольков В.П., Деревянко Д.И., Шелковников В.В. // Автометрия. 2017. Т. 53. № 5. С. 57.
Trentler T.J., Boyd J.E., Colvin V.L. // Chem. Mater. 2000. V. 12. P. 1431.
Белевский В.Н., Белопушкин С.И., Нуждин К.Б. // Химия высоких энергий. 2007. Т. 41. № 1. С. 13.
Жанситов А.А. // Синтез и радикальная полимеризация новых гуанидинсодержащих виниловых мономеров: дис. канд. хим. наук: 02.00.06 / Жанситов Азамат Асланович. Нальчик, 2011. 105 с.
Shelkovnikov V.V., Ektova L.V., Orlova N.A., Ogneva L.N., Derevyanko D.I., Shundrina I.K., Salnikov G.E., Yanshole L.V. // J. Mater. Sci. 2015. V. 50. № 23. P. 7544.
Podkoscielna B., Worzakowska M. // J. Therm. Anal. Calorim. 2010. V. 101. № 1. P. 235.
Лоскутов В.А., Шелковников В.В // Журн. орган. химии. 2006. V. 42. № 2. P. 313.
Goldenberg B.G., Lemzyakov A.G., Nazmov V.P., Pindyurin V.F. // Physics Procedia. 2016. V. 84. P. 205.
Feng R., Farris R.J. // Micromech. Microeng. 2003. V. 13. P. 80.
Гольденберг Б.Г., Резникова Е.Ф., Лемзяков А.Г., Пиндюрин В.Ф. // Автометрия. 2013. Т. 49. № 1. С. 96.
Дополнительные материалы отсутствуют.
Инструменты
Химия высоких энергий