Журнал физической химии, 2020, T. 94, № 5, стр. 754-759
Молекулярно-динамическое моделирование напыления тонких пленок, состоящих из слоев с чередующейся плотностью
Ф. В. Григорьев a, *, В. Б. Сулимов a, А.В. Тихонравов a
a Научно-исследовательский вычислительный центр МГУ им. М.В. Ломоносова
Москва, Россия
* E-mail: fedor.grigoriev@gmail.com
Поступила в редакцию 18.07.2019
После доработки 18.07.2019
Принята к публикации 17.09.2019
Аннотация
Проведено классическое молекулярно-динамическое моделирование напыления тонкой пленки, состоящей из чередующихся плотных и пористых слоев. Рассчитаны структурные параметры пленки. При моделировании отжига напыленной пленки найдено, что концентрация основных точечных дефектов заметно уменьшается во всех слоях пленки. На основе корреляций между плотностью и показателем преломления получено, что величина показателя преломления варьируется от 1.3 до 1.49, достигая минимального значения в слоях с максимальной пористостью. Такие слои могут быть использованы при конструировании многослойных оптических покрытий, обеспечивающих пропускание и отражение света в заданных диапазонах длин волн.
Оптические покрытия представляют собой совокупность плоскопараллельных слоев, состоящих из пленок с чередующимися значениями показателя преломления. Такое чередование можно обеспечить за счет использования различных материалов при напылении оптических покрытий. Также вариация показателя преломления может быть достигнута путем изменения плотности напыляемых пленок. Напыление потоком осаждаемых атомов, направленных к подложке под большим углом между скоростью и нормалью к поверхности (GLAD-напыление, [1, 2]), приводит к формированию высокопористых пленок, показатель преломления которых существенно ниже показателя преломления пленок, полученных напылением перпендикулярно к поверхности подложки (нормальное напыление). Таким образом, чередуя GLAD-напыление и нормальное напыление, можно получить многослойное покрытие, используя один тонкопленочный материал.
В представленной работе проведено моделирование процесса напыления чередующихся слоев тонких пленок диоксида кремния, а также рассчитаны структурные параметры растущей пленки. Моделирование атомистического уровня в настоящее время широко применяется для изучения структурных свойств GLAD пленок [3–6]. Нами использован разработанный ранее метод [7–11], основанный на классической молекулярной динамике (МД). Максимальные размеры напыленных кластеров близки к технологическим – порядка четверти длины волны видимого света в материале. Исследовано влияния отжига на структурные свойства напыленной пленки. Рассчитан показатель преломления пленки на основе корреляций между плотностью и показателем преломления.
МЕТОД МОДЕЛИРОВАНИЯ
Моделирование напыления осуществляется с использованием циклической процедуры, описанной в [7]. Потенциальная энергия межатомного взаимодействия рассчитывается в рамках силового поля DESIL [7–9]. В каждом цикле используются периодические граничные условия с NVT ансамблем (постоянные число атомов, объем и температура) со следующими параметрами: температура подложки 300 K, продолжительность одного цикла осаждения 6 пс, полное число циклов 8000. Электростатическая составляющая энергии межатомного взаимодействия рассчитывается методом PME (Particle Mesh Ewald) [12]. Для поддержания постоянной температуры в области моделирования использовался термостат Берендсена [13].
Атомистический кластер подложки был получен отжигом структуры α-кварца, как описано в [11]. Горизонтальные размеры подложки составляют 20 и 60 нм, вертикальная толщина подложки равна 6 нм. Максимальное значение толщины нанесенной пленки составляет около 85 нм. Число инжектированных групп SiO2 за один цикл составляет 240, что обеспечивает ту же плотность потока напыляемых атомов, что и в предыдущих работах [7–11]. МД-моделирование выполняется с использованием пакета GROMACS [14]. Визуальный анализ выполняется с использованием программного пакета Visual Molecular Dynamic (VMD) [15].
Угол между направлением скорости потока напыляемых атомов и перпендикуляром к поверхности при GLAD напылении α = 80°, при нормальном напылении α = 0°. Энергия напыляемых атомов кремния E = 10 эВ.
Расчеты проведены с использованием ресурсов суперкомпьютерного центра МГУ им. М.В. Ломоносова [16].
СТРУКТУРНЫЕ СВОЙСТВА НАПЫЛЕННОЙ ПЛЕНКИ
Покрытие, состоящее из слоев с чередующейся плотностью, было получено следующим образом. После того, как толщина первого, GLAD-слоя, достигла 40 нм, дальнейшее напыление осуществлялось потоком атомов, направленным перпендикулярно подложке, вплоть до толщины пленки, равной примерно 70 нм. После этого поток напыляемых атомов вновь был направлен под углом 80°.
Профиль плотности напыленной пленки показан на рис. 1. В соответствии с полученными ранее результатами моделирования [7] и экспериментальными данными [1, 2], плотность GLAD-пленки существенно ниже плотности пленки, полученной нормальным напылением. Толщина переходного слоя между фазами с различной плотностью составляет около 10 нм, что существенно превышает толщину переходного слоя между пленкой и подложкой и пленкой и газовой фазой в вакуумной камере. Плотность пленки, полученной нормальным напылением на GLAD-пленку, совпадает с плотностью пленки, полученной нормальным напылением на подложку из стеклообразного диоксида кремния.
Атомистическая структура чередующихся слоев показана на рис. 2. При переходе от GLAD-напыления к нормальному напылению осаждаемые атомы не заполняют пустот, разделяющих наклонные колонны, сформированные на подложке при GLAD-напылении. Таким образом, при смене режима напыления структура ранее напыленных слоев в целом сохраняется. При обратном переходе от нормального к GLAD-напылению снова формируются наклонные колонны толщиной 10–20 нм. Отметим, что углы наклона колонн в верхнем и нижнем GLAD-слое при прочих равных параметрах моделирования несколько отличаются.
Рис. 2.
Атомистическая структура растущей пленки диоксида кремния, состоящей из чередующихся слоев GLAD-пленок и пленок, полученных нормальным напылением.
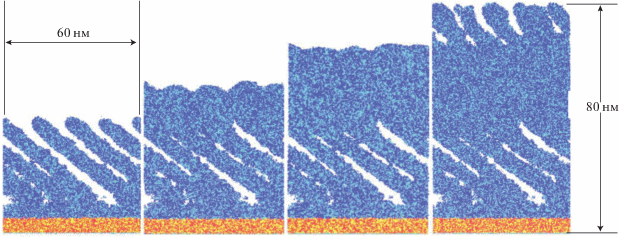
Экспериментально показано, что термический отжиг пленок, проведенный после завершения напыления, влияет на их свойства [17–20]. Эффекты отжига в пленках SiO2, нанесенных на различные подложки методом ионно-лучевого распыления (IBS), были исследованы в [18]. Выявлено, что толщина переходного слоя между пленкой SiO2 и подложкой из кремния существенно уменьшалась при отжиге с температурой 900 K [18].
В настоящей работе процедура моделирования отжига состояла из следующих этапов:
1. Нагрев напыленной пленки от начальной температуры Ti = 300 K до выбранного значения температуры отжига Ta со скоростью нагрева 1 K/пс при постоянном объеме.
2. МД-моделирование пленки в ансамбле NVT (постоянное число атомов, объем и температура, T = Ta). Время отжига менялось от 1 до 4 нс.
3. Охлаждение напыленной пленки от Ta до начальной температуры Ti = 300 K со скоростью охлаждения 1 K/пс.
4. Релаксация отожженной структуры при температуре Ti = 300 K в течение 100 пс.
Скорости нагрева и охлаждения соответствуют значениям, использованным ранее в МД-методике получения стеклообразных структур SiO2 из кристаллических [11] и являются типичными при МД-моделировании [21].
Профили пленки сразу после напыления и после отжига при различных температурах показаны на рис. 3.
Рис. 3.
Профили плотности пленок сразу после напыления (1) и после отжига при температуре Ta: 900 (2), 1300 (3), 1600 K (4). Энергия осаждаемых атомов кремния E(Si) = 10 эВ, температура подложки 300 K.
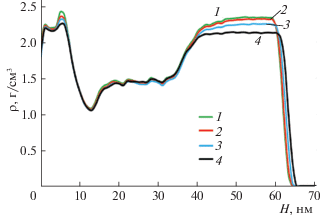
Видно, что наибольшее влияние отжиг оказывает на слой пленки с высокой плотностью. Рост температуры отжига сопровождается уменьшением плотности, максимальная величина |Δρ| составляет приблизительно 0.3 г/см3. Уменьшение плотности пленки, вероятно, связано с изменениями ее структуры во второй и последующих координационных сферах атомов кислорода и кремния, так как отжиг практически не влияет на среднюю длину связи Si–O, тетраэдрический угол O–Si–O и угол Si–O–Si (см. табл. 1 и структурные данные, приведенные в [11]). Из графиков на рис. 3 видно, что скачок плотности в переходном слое между подложкой и пленкой сглаживается при отжиге.
Таблица 1.
Структурные свойства осажденных пленок, γ – углы Si–O–Si (град.), с – концентрация (%), нижний индекс указывает координационное число атома, H1:H2 – нижняя и верхняя границы горизонтальных слоев пленки (рис. 4)
| H1 : H2,нм | c(O1) | c(Si3) | γ | c(O1) | c(Si3) | γ |
|---|---|---|---|---|---|---|
| Напыленная пленка | Отожженная пленка | |||||
| 10 : 20 | 2.2 | 1.0 | 145 | 0.9 | 0.7 | 146 |
| 20 : 30 | 1.9 | 1.0 | 145 | 0.8 | 0.7 | 147 |
| 30 : 40 | 1.1 | 0.5 | 146 | 0.6 | 0.4 | 148 |
| 40 : 50 | 0.8 | 0.2 | 145 | 0.4 | 0.2 | 148 |
| 50 : 60 | 0.9 | 0.2 | 145 | 0.4 | 0.2 | 148 |
Атомистическая структура чередующихся слоев до и после отжига показана на рис. 4. Визуальный анализ не обнаруживает существенных различий в структуре. Таким образом, отжиг, даже при высокой температуре качественно не изменяет структуру слоев.
Рис. 4.
Атомистическая структура растущей пленки диоксида кремния, состоящей из чередующихся слоев GLAD-пленок и пленок, полученных нормальным напылением. Угол осаждения при GLAD напылении α = 80°. Энергия осаждаемых атомов кремния E = 10 эВ, температура подложки 300 K.
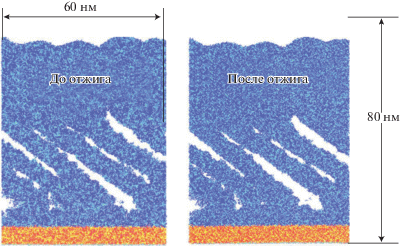
Структурные свойства слоев пленки до и после отжига при температуре 1600 K приведены в табл. 1. В результате отжига концентрация основных точечных дефектов существенно уменьшается во всех слоях, причем концентрация немостиковых атомов кислорода падает сильнее, чем концентрация трехкоординированных атомов кремния. В то же время угол Si–O–Si, определяющий взаимную ориентацию структурных тетраэдров, практически не меняется при отжиге.
ПОКАЗАТЕЛЬ ПРЕЛОМЛЕНИЯ ПЕРЕХОДНОГО СЛОЯ
Результаты атомистического моделирования процесса напыления тонких пленок содержит полную информацию (в рамках классического приближения) о пространственном распределении плотности. Показатель преломления покрытий, образованных чередующимися слоями с низкой и высокой плотностью может быть рассчитан в рамках приближения эффективной среды, характеризуемой усредненным показателем диэлектрической проницаемости. Пористую пленку можно рассматривать как совокупность двух фракций – пор с диэлектрической постоянной, равной ε1 = 1, и плотной пленкой с показателем преломления ε2, величина которого определяется соотношением Максвелла n2 = ε2, где n = = 1.49 [22] – показатель преломления плотной пленки диоксида кремния, полученной нормальным напылением. Эффективный показатель преломления покрытия может быть рассчитан с использованием соотношения Бруггимана (Bruggeman effective medium theory) [23]:
(1)
$\sum\limits_{i = 1}^n {{{f}_{i}}\frac{{({{\varepsilon }_{i}} - \varepsilon )}}{{({{\varepsilon }_{i}} + 2\varepsilon )}}} = 0,$Объемную долю пор в высокопористой пленке можно рассчитать с использованием метода определения пористости, описанного в [25]. Зависимости относительного объема пор от радиуса пробной сферы для пленок, полученных напылением при различных условиях, показаны на рис. 5. По разности f(R) пористой и плотной пленок можно рассчитать объемную долю пор в пористой пленке.
Рис. 5.
Зависимости относительного объема пор f(R) от радиуса пробной сферы, R, для пленки SiO2, полученной нормальным напылением (голубая линия) и слоя GLAD-пленки (черная линия) толщиной 10–20 нм (структура показана на рис. 2) E(Si) = 10 эВ.
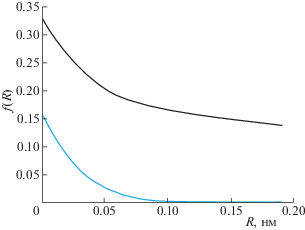
Для определения зависимости эффективной диэлектрической проницаемости от толщины пористой пленки, показанной на рис. 5, пленка была разделена на горизонтальные слои толщиной 10 нм. Для каждого слоя были рассчитаны функции f(R) и определены значения ε из уравнения, следующего из (1):
(2)
${{f}_{1}}\frac{{(1 - \varepsilon )}}{{(1 + 2\varepsilon )}} + (1 - {{f}_{1}})\frac{{({{\varepsilon }_{2}} - \varepsilon )}}{{({{\varepsilon }_{2}} + 2\varepsilon )}} = 0,$Показатель преломления пористой пленки также может быть рассчитан с использованием линейного соотношения между плотностью и показателем преломления [26] Δn = 0.2Δρ, где Δn – изменение показателя преломления при изменении плотности, рассчитанной в г/см3. Для показателя преломления слоя получаем:
где ρ2 – плотность плотной пленки.Результаты расчетов приведены в табл. 2. Показатель преломления варьируется от 1.3 до 1.49, достигая минимального значения в слоях с максимальной пористостью. Во всех случаях показатель преломления, определенный с использованием соотношения Бруггимана (1, 2) несколько больше показателя преломления, определенного по изменению плотности (3). Разность значений n и n' растет с уменьшением плотности пленки и достигает максимального значения 0.03 в слое между 20 и 30 нм.
Таблица 2.
Нижняя и верхняя границы горизонтальных слоев H1 : H2 пленки (правая структура на рис. 4), эффективная диэлектрическая проницаемость ε, показатели преломления n и n', рассчитанные по формулам (2) и (3) соответственно, плотность слоя ρ. Остальные обозначения см. текст
| H1 : H2,нм | f0(0) | f(0) | ε2; n2; ρ2 (г/см3) | Ε | n | ρ, г/см3 | n' |
|---|---|---|---|---|---|---|---|
| 10 : 20 | 0.158 | 0.330 | 2.22; 1.49; 2.40 | 1.97 | 1.40 | 1.87 | 1.384 |
| 20 : 30 | 0.480 | 1.77 | 1.33 | 1.46 | 1.302 | ||
| 30 : 40 | 0.388 | 1.89 | 1.37 | 1.71 | 1.352 | ||
| 40 : 50 | 0.195 | 2.17 | 1.47 | 2.27 | 1.464 | ||
| 50 : 60 | 0.171 | 2.20 | 1.48 | 2.35 | 1.480 | ||
| 60 : 70 | 0.185 | 2.18 | 1.48 | 2.26 | 1.462 | ||
| 70 : 80 | 0.497 | 1.74 | 1.32 | 1.39 | 1.288 |
Отметим, что при расчете объемной доли свободного объема f1 (см. пояснение после уравнения (1)) можно брать разность функции относительного объема не только при R = 0, но и при больших значениях R вплоть до 0.1 нм, так как разность f(R) – f0(R) остается постоянной (см. рис. 5).
Таким образом, исследована структура пленки, полученной чередованием GLAD-напыления (угол между нормалью к поверхности подложки и потоком осаждаемых атомов α = 80°) и нормального напыления (α = 0°). Плотность пленки в режиме GLAD-напыления приблизительно вдвое меньше плотности пленки при нормальном напылении. Толщина переходного слоя между областями с высокой и низкой плотностями составляет порядка 10 нм.
В результате отжига концентрация основных точечных дефектов существенно уменьшается во всех слоях пленки, причем концентрация немостиковых атомов кислорода падает сильнее, чем концентрация трехкоординированных атомов кремния. В то же время угол Si–O–Si, определяющий взаимную ориентацию структурных тетраэдров, практически не меняется при отжиге. Отжиг уменьшает показатель преломления плотного слоя больше, чем слоев с низкой плотностью.
На основе корреляций между плотностью и показателем преломления n получено, что величина n варьируется от 1.3 до 1.49, достигая минимального значения в слоях с максимальной пористостью (GLAD-напыление).
Работа выполнена при финансовой поддержке РНФ, грант 19-11-00053.
Список литературы
Robbie K., Brett M.J., Lakhtakia A. // Nature. 1996. V. 384. P. 616.
Trottier-Lapointe W., Zabeida O., Schmitt T., Martinu L. // Appl. Opt. 2016. V. 55. P. 8796.
Zhang J., Cao Y., Gao Q., Wu C., Yu F., Liang Y. // Nanoscale Res Lett. 2013. V. 8. P. 312.
Backholm M., Foss M., Nordlund K. // Nanotechnology. 2012. V. 23. P. 385708.
Rossnagel S. (Ed.) Thin Films: Modeling of Film Deposition for Microelectronic Applications, Academic, New York, 1996.
Smy T., Vick D., Brett M.J. et al. // J. Vac. Sci. Technol. A. 2000. V. 18. P. 2507.
Grigoriev F.V., Sulimov V.B., Tikhonravov A.V. // J. Non.-Cryst. Solids. 2019. V. 512. P. 98.
Grigoriev F.V., Sulimov A.V., Kochikov I.V. et al. // Int. J. High Perform. Comp. Appl. 2015. V. 29. P. 184.
Grigoriev F.V., Sulimov A.V., Katkova E.V. et al. // J. Non.-Cryst. Solids. 2015. V. 448. P. 1.
Grigoriev F.V., Katkova E.V., Sulimov A.V. et al. // Opt. Mat. Exp. 2016. V. 6. P. 3960.
Grigoriev F., Sulimov A., Kochikov I. et al. // Appl. Opt. 2017. V. 56. C87.
Darden T., York D., Pedersen L. // J. Chem. Phys. 1993. V. 98. P. 10089.
Berendsen H.J.C., Postma J. P. M., van Gunsteren W.F. et al. // J. Chem. Phys. 1984. V. 81 (8). P. 3684.
Abraham M.J., Murtola T., Schulz R. et al. // SoftwareX. 2015. V. 1–2. P. 19.
Humphrey W., Dalke A., Schulten K. // J. Molec. Graphics. 1996. V. 14. P. 33.
Sadovnichy V., Tikhonravov A., Voevodin Vl., Opanasenko V. // ”Lomonosov”: Supercomputing at Moscow State University. In: Contemporary High Performance Computing: From Petascale toward Exascale. pp. 283–307. Chapman & Hall/CRC Computational Science, CRC Press, Boca Raton, United States (2013).
Jiang Y., Ji Y., Liu H., Liu D. et al. // Proc. of SPIE. 2012. V. 8416. P. 84160F.
Jiang Y., Liu H., Wang L. et al. // Appl. Opt. 2014. V. 53. P. A83.
Taniguchi K., Tanaka M., Hamaguchi C., Imai K. // J. Appl. Phys. 1990. V. 67. P. 2195.
Viana C.E., Morimoto N.I., Bonnaud O. // Microelectron. Reliab. 2000. V. 40. P. 613.
Kirova E.M., Norman G.E., Pisarev V.V. // Russ. J. Phys. Chem. 2018. V. A92. P. 1865.
Hummel R.E., Guenther K.H. Handbook of Optical Properties: Thin Films for Optical Coatings, Volume 1. CRC Press, Feb 24, 1995, Science, 384 p.
Schmidt D., Schubert M. // Appl. Phys. 2013. V. 114. P. 083510.
Hofmann T., Schmidt D., Boosalis A. et al. // Appl. Phys. Lett. 2011. V. 99. P. 081903.
Grigoriev F.V., Sulimov V.B., Tikhonravov A.V. // Proc. SPIE 10691, Advances in Optical Thin Films VI, 1069109 (5 June 2018).
Vedam K., Limsuwan P. // J. Chem. Phys. 1978. V. 69. P. 4772.
Дополнительные материалы отсутствуют.
Инструменты
Журнал физической химии



