Известия РАН. Серия физическая, 2020, T. 84, № 9, стр. 1331-1334
Напряжения несоответствия эпитаксиальных нанопленок Ge на Si(111), содержащих поверхностные фазы пониженной плотности
С. А. Тийс 1, Е. М. Труханов 1, *, А. В. Колесников 1
1 Федеральное государственное бюджетное учреждение науки
Институт физики полупроводников имени А.В. Ржанова Сибирского отделения Российской академии наук
Новосибирск, Россия
* E-mail: trukh@isp.nsc.ru
Поступила в редакцию 19.03.2020
После доработки 10.04.2020
Принята к публикации 27.05.2020
Аннотация
Для физики конденсированного кристаллического состояния впервые установлено, что переходы сверхструктурных фаз на поверхности эпитаксиальной нанопленки могут сопровождаться релаксацией напряжений несоответствия σН. В случае зарегистрированного в работе фазового перехода 7 × 7 → 5 × 5 это явление протекает при толщине пленки Ge равной 1 нм на подложке Si(111), когда отсутствует образование дислокаций несоответствия. Введено понятие эффективного параметра несоответствия, что позволило определить изменения σН, сопровождающие протекание перехода.
ВВЕДЕНИЕ
В полупроводниковой наноэлектронике широкое распространение получили гетеросистемы, содержащие эпитаксиальные пленки. Под действием напряжений несоответствия σН они подвергаются упругой, а также (при достижении критической толщины пленки) пластической деформации, протекание которой в значительной мере определяется параметром несоответствия f. Согласно литературным данным, при докритической толщине уменьшение σН возможно только в рамках упругих взаимодействий. Процесс молекулярно-лучевой эпитаксии напряженных пленок часто сопровождается изменением сверхструктурных фаз на поверхности пленки. В предлагаемой работе на примере поведения нанослоев Ge при эпитаксии на Si(111) [1] исследован необычный механизм релаксации σН, который может сопровождать протекание поверхностных фазовых переходов при любой толщине пленки.
СВЯЗЬ НАПРЯЖЕНИЯ С УПРУГОЙ ДЕФОРМАЦИЕЙ И ПАРАМЕТРОМ НЕСООТВЕТСТВИЯ В ОДНОРОДНО НАПРЯЖЕННОЙ ПЛЕНКЕ
Если Декартовые координаты обозначить как х1, х2 и х3, то в общем виде основное уравнение теории упругости, связывающее нормальные компоненты тензоров деформаций εхi и напряжений σхi, запишется как [2]
(1)
${{\varepsilon }_{{хi}}} = {{[{{\sigma }_{{хi}}}--\nu ({{\sigma }_{х}}_{{(i + 1)}} + {{\sigma }_{х}}_{{(i + {\text{ }}2)}})]} \mathord{\left/ {\vphantom {{[{{\sigma }_{{хi}}}--\nu ({{\sigma }_{х}}_{{(i + 1)}} + {{\sigma }_{х}}_{{(i + {\text{ }}2)}})]} [}} \right. \kern-0em} [}2G(1{\text{ }} + \nu )],$(2)
${{\sigma }_{х}}_{1} = {{\varepsilon }_{х}}_{1}2G{{(1{\text{ }} + \nu )} \mathord{\left/ {\vphantom {{(1{\text{ }} + \nu )} {(1{\text{ }}--\nu )}}} \right. \kern-0em} {(1{\text{ }}--\nu )}},$которое только множителем εх1 отличается от выражения
(3)
$\sigma = f2G{{(1{\text{ }} + \nu )} \mathord{\left/ {\vphantom {{(1{\text{ }} + \nu )} {(1{\text{ }}--\nu )}}} \right. \kern-0em} {(1{\text{ }}--\nu )}}.$Последнее выражение в течение ряда десятилетий используется в расчетных моделях дислокаций несоответствия [3, 4]. Здесь, как и в (2), σ – нормальная компонента тензора напряжений.
Формула (2) получена в строго теоретических рамках, а формула (3) является полуэмпирической, и условия ее корректности в литературе недостаточно проанализированы. В (2) деформация ε является переменной величиной, которая зависит от целого ряда характеристик кристалла, в частности, от его упругих постоянных и от геометрии гетеросистемы. В (3) параметр f, заменяющий упругую деформацию ε, представляет собой постоянную величину. Поскольку все остальные члены выражений (2) и (3) равны между собой, то следует установить, в каких случаях имеет место тождественное совпадение величин ε и f.
В литературе известны различные варианты определения f [5, 6]. Покажем, что для совпадения обсуждаемых величин в качестве параметра несоответствия следует принять f = ${{\left( {а_{s}^{{\text{о}}}--а_{f}^{{\text{о}}}} \right)} \mathord{\left/ {\vphantom {{\left( {а_{s}^{{\text{о}}}--а_{f}^{{\text{о}}}} \right)} {а_{f}^{{\text{о}}}}}} \right. \kern-0em} {а_{f}^{{\text{о}}}}},$ где $а_{s}^{{\text{о}}}$ и $а_{f}^{{\text{о}}}$ – постоянные кристаллических решеток подложки (s – substrate) и пленки (f – film). Надстрочный индекс “о” означает, что подложка и пленка приведены в неискаженное (релаксированное) состояние. Такой вариант формулы для f в литературе известен (см., например, [6–8]). Примем пленку полностью упруго напряженной, т.е. псевдоморфной, а подложку неискаженной, когда в любой ее точке выполняется аs = $а_{s}^{{\text{о}}}.$ Тогда латеральные координаты атомов пленки совпадут с постоянными координатами узлов решетки подложки аf = $а_{s}^{{\text{о}}}.$ В теории упругости деформацию обозначают как ε = (аf – $а_{f}^{{\text{о}}}$)/$а_{f}^{{\text{о}}}.$ В нашем случае эта запись трансформируется в ε = ($а_{s}^{{\text{о}}}$ – $а_{f}^{{\text{о}}}$)/$а_{f}^{{\text{о}}}.$ Последнее выражение совпадает с использованной нами формулой для f.
Тождественное равенство величин ε и f возможно в двух случаях. Обозначим толщины пленки и подложки через h и Н, соответственно. Первый случай равенства имеет место, если Н $ \gg $ h, а второй – если Gs $ \gg $ Gf [6]. В обоих случаях подложку можно считать абсолютно жесткой, когда любые деформации пленки не приводят к возникновению деформаций подложки.
Отметим, что определенное по формуле (3) значение σ в общем случае характеризует перепад нормальных напряжений между контактирующими кристаллическими слоями. Если один из слоев находится в ненапряженном состоянии (например, толстая подложка гетеросистемы, содержащей тонкую пленку), то по (3) вычисляется не только перепад напряжений, но их величина в напряженном слое. В данной статье мы вычислим σ для двух границ раздела. Величина σ1 будет определена для основной границы кремний-германий, ее значение будет характеризовать как перепад напряжений, так и их уровень в пленке. Величина σ2 будет равна перепаду напряжений в границе между псевдоморфной прослойкой Ge и сверхструктурной фазой на поверхности пленки.
НАЧАЛЬНАЯ СТАДИЯ РОСТА Ge НА Si(111)
На начальном этапе эпитаксии Ge формируются треугольные островки высотой h около 1 нм, ограниченные вдоль направлений типа 〈110〉. Вблизи границы раздела Ge–Si они содержат два бислоя псевдоморфной фазы Ge, а вблизи свободной поверхности пленки – три неполных атомных слоя сверхструктурной фазы 7 × 7. В квазиравновесных условиях эпитаксиального роста высота h не изменяется, а происходит только латеральное разрастание островков [1]. Когда площадь островка приблизительно в 100 раз превышают площадь элементарной ячейки 7 × 7, на его поверхности начинается фазовый переход 7 × 7 → 5 × 5. На рис. 1 приведены изображения сканирующего туннельного микроскопа (СТМ) поверхностных фаз 7 × 7, 5 × 5 и с2 × 8. Последняя фаза наблюдается только на (111) поверхности объемных монокристаллов Ge(111). На эпитаксиальных пленках Ge она зарегистрирована лишь на горизонтальных площадках 3D островков, причем, как правило, в сочетании с фазами 2 × 2, $2 \times \sqrt 3 $ и 7 × 7. На рис. 1 контуры элементарных ячеек изображены ромбами и параллелограммом. На всех СТМ-изображениях темные области соответствуют углублениям, а светлые – выступающим элементам рельефа. По углам ромбовидных элементарных ячеек хорошо видно расположение темных угловых вакансий, пронизывающих три верхних слоя поверхностных фаз (ПФ; англ. вариант: SP – surface phase). Эти три слоя имеют пониженный процент заполнения атомных плоскостей по сравнению со 100% заполнением в объеме кристалла. Процент заполнения указан для каждого слоя ПФ в правой части рисунка. Средний процент для трех слоев приведен после фигурной скобки. Наглядно атомное заполнение в каждом из слоев изображено в центральной части рисунка. Четыре нижних слоя пленки Ge представляют собой кристалл, аналогичный объемному. Он является напряженной псевдоморфной прослойкой (ПП; англ. вариант: PI – pseudomorphic interlayer) между подложкой кремния и ПФ пленки.
Рис. 1.
СТМ изображения поверхностных структур и схематичные сечения псевдоморфных слоев Ge с указанием процентного заполнения атомами трех верхних перестроенных слоев относительно объемных слоев кристалла. После фигурной скобки указан средний процент заполнения атомами трех верхних слоев.
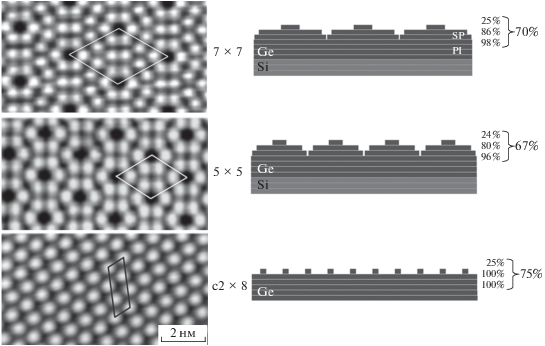
На начальной стадии эпитаксии на поверхности пленки возникает фаза Ge-7 × 7. Аналогичная фаза Si-7 × 7 регистрируется на поверхности подложки перед эпитаксией. Поскольку пленка псевдоморфная, то для фазы 7 × 7 размеры элементарных ячеек ПФ Si и Ge одинаковы. В процессе латерального разрастания островков происходит обсуждавшийся выше фазовый переход 7 × 7 → 5 × 5. При этом изменяется перепад σ2 и происходит дополнительная релаксация напряжений несоответствия. Для количественного анализа этого явления необходимо рассмотреть структуру нижних (третьих) атомных слоев поверхностных фаз 7 × 7 и 5 × 5. Эти слои содержат в каждой элементарной ячейке на один атом меньше (т.е. 48 и 24 атома, соответственно) по сравнению с кристаллическими ячейками в объеме кристалла, имеющими те же размеры. Это обусловливает значения приведенных на рис. 1 заполнений атомных плоскостей, равные 98 и 96% для обсуждаемых фаз. Атомные плотности нижних слоев ПФ, приходящиеся на единицу площади, равны ρ7 × 7 = 7.67 и ρ5 × 5 = 7.52 ат./нм2, что меньше объемной плотности ρ1 × 1 = 7.83 ат./нм2.
Поскольку поверхностная фаза 5 × 5 наименее плотная, то происходит переход 7 × 7 → 5 × 5, способствующий снижению сжимающих напряжений пленки Ge на Si(111). В данном случае процесс фазового перехода является механизмом релаксации напряжений несоответствия. Ниже представлены количественные результаты, демонстрирующие явление уменьшения σН при фазовом переходе.
РЕЛАКСАЦИЯ НАПРЯЖЕНИЙ И ЭФФЕКТИВНЫЙ ПАРАМЕТР НЕСООТВЕТСТВИЯ
Определенная по формуле (3) величина σ1 составляет –6.9 ⋅ 109 Н/м2. Вычисления выполнены при G = 5.64 ⋅ 1010 Н/м2, ν = 0.200 [9] и f = –4%. Толщина подложки в исследованной гетеросистеме составляет около 350 мкм, а толщина эпитаксиальной пленки Ge – 1 нм. Поэтому напряжения в подложке пренебрежимо малы, и σ1 показывает как перепад напряжений, так и их величину в пленке. Отрицательный знак демонстрирует сжимающий характер напряжений.
С целью вычисления по формуле (3) перепада напряжений σ2 между слоями ПП и ПФ воспользуемся понятием эффективного параметра несоответствия fЭФ. Для этого в верхнем атомном слое ПП выберем площадку S7×7, которая по размеру совпадает с размером элементарной ячейки 7 × 7. Внутри площадки возьмем произвольный участок площадью (48/49) ⋅ S7 × 7 и приложим к нему такое поле однородно растягивающих напряжений σ2, чтобы площадь участка возросла до величины S7 × 7. Величина относительного увеличения площади равна ΔS/S = 1/49, что приблизительно в два раза больше, чем ΔL/L – относительное линейное увеличение латеральных размеров расширяющегося участка. Величина ΔL/L ≈ 1/98 (или 1.02%) и является эффективным параметром несоответствия $f_{{{\text{ЭФ}}}}^{{{\text{7}} \times {\text{7}}}}.$ Подобным образом для ПФ 5 × 5 получим $f_{{{\text{ЭФ}}}}^{{{\text{5}} \times {\text{5}}}}$ ≈ 2.0%. На основе полученных величин fЭФ по формуле (3) вычисляем значения σ2 для обсуждаемых поверхностных фаз: 7 × 7σ2= 1.7 ⋅ 109 и 5 × 5σ2 = = 3.4 ⋅ 109 Н/м2. Если рассматривать σ2 не как перепады, а как дополнительные напряжения, суммируемые с σ1, то их следует считать положительными, т. к. слой ПФ менее сжат, чем слой ПП. Результирующие значения σ в слое любой из поверхностных фаз остаются сжимающими. Они составляют: 7 × 7σ = (–6.9 + 1.7) ⋅ 109 = –5.2 Н/м2 и 5 × 5σ = –3.5 ⋅ 109 Н/м2.
Аналогичная картина понижения атомной плотности растущей пленки Ge зарегистрирована в случае ориентации (001) [10]. При эпитаксии первого монослоя германия на поверхности подложки Si(001), содержащей реконструированную фазу 1 × 2, формируется фаза 2 × n, где параметр “n” постепенно изменяется от 12 до 8. При дальнейшем росте на верхнем атомном слое начинает возникать фаза mхn. Стороны элементарных ячеек поверхностных фаз параллельны направлениям типа 〈110〉. Все ячейки окружены димерными вакансионными рядами, суммарная площадь которых монотонно увеличивается. Как следствие, атомная плотность слоя Ge понижается, в результате чего уменьшается и уровень напряжений несоответствия σН.
ЗАКЛЮЧЕНИЕ
В эпитаксиальной гетеросистеме Ge/Si(111) для двух границ раздела определены перепады напряжений несоответствия σН. Для границы Si подложка–Ge пленка установлено, что перепад σН равен уровню нормальных напряжений в пленке (–6.9 ⋅ 109 Н/м2). Для поверхностных фаз 7 × 7 и 5 × 5 уровни напряжений составляют 7 × 7σ = = –5.2 ⋅ 109 и 5 × 5σ = –3.5 ⋅ 109 Н/м2, что по модулю заметно превышает перепады напряжений на границе поверхностная фаза – псевдоморфная прослойка германия. Исследование выполнено с привлечением понятия эффективного параметра несоответствия сопрягаемых слоев.
Работа выполнена при поддержке РФФИ (проект № 18-52-41006).
Список литературы
Teys S.A. // Appl. Surf. Sci. 2017. V. 392. P. 1017.
Тимошенко С.П., Гудьер Дж. Теория упругости. М.: Наука, 1975. С. 28.
Тхорик Ю.А., Хазан Л.С. Пластическая деформация и дислокации несоответствия в гетероэпитаксиальных системах. Киев: Наукова Думка, 1983. 135 с.
Skiba N.V. // Mater. Phys. Mech. 2014. V. 19. P. 68.
Matthews J.W. // J. Vac. Sci. Technol. 1975. V. 12. P. 126.
Romanov A.E, Wagner T. // Scr. Mater. 2001. V. 45. № 3. P. 325.
Ayers J.E., Kujofsa T., Rago P., Raphael J.E. Heteroepitaxy of semiconductors: theory, growth and characterization. Boca Raton: Taylor & Francis Group, 2017. P. 181.
Труханов Е.М., Тийс С.А. // Изв. РАН. Сер. физ. 2016. Т. 80. № 6. С. 708; Trukhanov E.M., Teys S.A. // Bull. Russ. Acad. Sci. Phys. 2016. V. 80. № 6. P. 641.
Хирт Дж., Лоте И. Теория дислокаций. М.: Атомиздат, 1972. С. 563.
Voigtlander B. // Surf. Sci. Rep. 2001. V. 43. P. 127.
Дополнительные материалы отсутствуют.
Инструменты
Известия РАН. Серия физическая


