Известия РАН. Серия физическая, 2021, T. 85, № 1, стр. 78-84
Снижение контраста фоточувствительности неоднородных n+–p(n)–p+ структур кремния, измеряемого при освещении всей поверхности p–n перехода
О. Г. Кошелев *
Федеральное государственное бюджетное образовательное учреждение высшего образования
“Московский государственный университет имени М.В. Ломоносова”, физический факультет
Москва, Россия
* E-mail: scon282@phys.msu.ru
Поступила в редакцию 20.07.2020
После доработки 28.08.2020
Принята к публикации 28.09.2020
Аннотация
Проведены исследования снижения контраста фоточувствительности равномерно освещаемой n+‒p(n)–p+ структуры кремния из-за фототоков между ее неоднородностями вдоль n+ и p+ слоев. Измерения и расчеты проводились на модели, состоящей из двух кремниевых солнечных элементов различной фоточувствительности, соединенных резистором. Получено согласие результатов измерений и вычислений.
ВВЕДЕНИЕ
Кремниевые солнечные элементы (СЭ) широко используются для преобразования солнечной энергии в электрическую. Такой СЭ представляет собой пластину кремния (база) p или n типа, на поверхностях которой создаются тонкие сильно легированные слои кремния (p+ на одной стороне и n+ на другой). Качество этих СЭ и их заготовок зависит от их фото-чувствительности. Ее обычно характеризуют параметром, называемым эффективным временем жизни (τeff) неравновесных носителей заряда (ННЗ). В ряде работ для этого используют также параметр эффективная диффузионная длина (Leff) ННЗ, связанная с τeff соотношением Leff = (Dτeff)0.5, где D – коэффициент диффузии ННЗ. Значения τeff и Leff зависят прежде всего от времени жизни (τ) ННЗ в базе СЭ, скорости их рекомбинации на тыльной стороне базы, а при измерениях по поглощению света и коэффициента его поглощения в кремнии (α). Для пластин толщиной d без n+ и p+ слоев при поперечных размерах много больше Leff и αd $ \ll $ 1 $\tau _{{eff}}^{{--1}}$ = τ–1 + (Sf + Sr)/d, где Sf и Sr – скорости рекомбинации ННЗ на освещаемой (лицевой) и тыльной поверхностях пластин [1]. Если же эти скорости бесконечно велики, то для пластин τeff = = d2/(12D), а для слитков, размеры которых много больше Leff, τeff = τ/(αL + 1), где L = (Dτ)0.5– диффузионная длина ННЗ [2]. На значения τeff влияет также характер изменений интенсивности освещения в течение измерений. При стационарных условиях τeff = Δn/G, где Δn и G – усредненные по толщине пластины значения концентрации ННЗ и скорости их генерации. При квазистационарных условиях, когда изменения освещенности за время t = τ приводят к пренебрежимо малому изменению Δn, то [3, 4]
Значения τeff для ряда других частных случаев приведены в [5]. При импульсном освещении значения τeff обычно определяют по времени спада фотопроводимости после выключения света. Выражения для τeff дополнительно усложняются при наличии ловушек [6], при этом значения τeff могут изменяться в несколько раз [7].
Для получения максимального КПД фоточувствительность и соответственно значения τeff должны быть максимальными и практически одинаковыми по всей площади СЭ [8], т.е. контраст фоточувствительности должен быть минимальным. Таким же условиям должны удовлетворять исходные слитки и пластины кремния [9], поэтому фоточувствительность контролируют как у исходного кремния, так и у готовых СЭ.
Для определения значений τeff и их разброса по площади исходных слитков и пластин кремния чаще всего используют СВЧ методы измерений фотопроводимости. Эти методы основаны на сканировании поверхности кремния лучом модулированного по интенсивности света с энергией квантов (hν) более ширины запрещенной зоны (Eg) [10–12]. В этом случае измеряют изменения интенсивности СВЧ волны, отражающейся от исследуемой структуры, или проходящей через нее (в случае пластин). Часто измеряют также времена спада СВЧ фотопроводимости после окончания импульсов света. Разрешающая способность определяется диаметром освещаемой области. Например, в [11] она была около 1 мм. Для снижения стоимости СЭ в последнее время были начаты работы по замене кристаллического кремния (c-Si) микрокристаллическим (mc-Si), в котором значения τeff существенно ниже. Ввиду этого появилась необходимость существенно повысить разрешающую способность методов измерения контраста τeff заготовок СЭ. Для этого в [12] был разработан СВЧ метод, в котором диаметр светового пятна был уменьшен до 50–100 мкм. Освещение производилось лазером при hν > Eg через световод с лицевой стороны пластины. СВЧ зондирование на частоте 9.4 ГГц осуществлялось с тыльной стороны через коаксиальный кабель диаметром 1 мм. Значения τeff определялось по сдвигу фазы модуляции СВЧ волны относительно фазы модуляции света.
Для измерения фотоэлектрических параметров заготовок СЭ в работе [13] был предложен метод, названный QSSPC (quasi-steady-state photoconductance) методом. Генерация ННЗ в этом случае производится импульсом белого или инфракрасного света, интенсивность которого медленно меняется по сравнению с τeff. Величина фотопроводимости измеряется на частоте 10 МГц с помощью катушки, индуктивно связанной с исследуемой структурой. На основе этого метода была разработана широко используемая установка WCT-120 [14]. Однако ее разрешающая способность, определяемая размером светового пятна и диаметром катушки, была невысокой (4 см).
Возможности контроля неоднородностей в кремнии существенно возросли с развитием новых методов, основанных на измерениях электролюминесцентных (EL, electroluminescence) и фотолюминесцентных (PL, photoluminescence) изображений поверхностей исследуемых структур [9, 15]. Эти методы основаны на том, что в кремнии незначительная часть рекомбинации неравновесных электронов с дырками происходит путем спонтанной межзонной излучательной рекомбинации. В случае EL метода инжекция ННЗ производится электрическим током через p–n переход, а в случае PL метода – светом при hν > Eg. EL метод применим лишь для готовых СЭ, тогда как PL метод применим на всех этапах изготовления СЭ. Регистрация таких изображений производится фотокамерой на основе матриц фотоприемников (главным образом кремниевых), подключаемых к матрицам приборов с зарядовой связью. В настоящее время используются методы, основанные на обработке отношений двух изображений фотокамеры, соответствующих различным профилям люминесцентных центров по толщине СЭ. В случае EL метода для этого используются различные оптические фильтры перед фотокамерой. Например, в [15] для этого использовались фильтры, не пропускающие волны длиннее 900 и 1000 нм. В первом случае время регистрации одного изображения из 1024 × 1024 пикселя составляло 100 с, а во втором – 1 с. В случае PL метода изменения таких профилей достигается сменой либо фильтра, либо длины волны источника света. Например, в работе [9] для генерации ННЗ применялись лазеры с длинами волн λ = 915 и 1030 нм, а перед фотокамерой в обоих случаях помещали фильтр, не пропускающий излучения этих лазеров. Такой метод сокращенно называют PLIR (photo luminescence intensity ratio) методом.
Последующий контроль после измерений на пластинах обычно проводят на готовых СЭ [16]. Этот контроль проводят по току короткого замыкания (Jsc), возникающего при сканировании поверхности p–n перехода лучом ИК лазера (LBIC – light beam induced current) при hν > Eg [17]. Измеряют значения коэффициента собирания (Q), определяемого как отношение количества электронов, проходящих через p-n переход, к количеству поглощаемых квантов света за единицу времени. На основании таких измерений производят картирование Leff или τeff, т.е. определяют распределение значений этих параметров по площади СЭ. Недостатком этого метода, как и других методов, основанных на сканировании поверхности исследуемой структуры, является большая длительность таких измерений. Например, для получения изображения Leff размером 200 × 200 пикселей методом LBIC, согласно [15], требуется около нескольких часов.
Для оптимизации процессов изготовления СЭ представляет интерес проведение контроля и на промежуточных этапах. В частности, появление участков с низкими значениями τ возможно в процессе нанесения сильно легированных слоев n+ и p+ типа. В этом случае снижение τ можно обнаружить по уменьшению фото-ЭДС. По расчетам, снижение фото-ЭДС всего на 10% участка с большим значением τ (порядка 1000 мкс) может привести к снижению измеряемого времени релаксации ННЗ такого участка в несколько раз [18]. Попытка обнаружить контраст фотопроводимости CЭ из кремния была предпринята в [19]. Зондирование производилось с помощью СВЧ микроскопа ближнего поля на частоте 4.1 ГГц с разрешающей способностью около 10 мкм. Хотя контраст СВЧ проводимости в отсутствие света четко регистрировался, контраст СВЧ фотопроводимости практически не наблюдался. Это можно объяснить тем, что ННЗ экстрагируются из участков с высокими значениями τ и благодаря токам по n+ и p+ слоям инжектируются в окружающие участки с низкими значениями τ. Некоторое снижение контраста в неоднородных структурах возможно и благодаря диффузии ННЗ между участками с различными значениями τ. Но этот механизм не может быть главным, т.к. в исходных пластинах без n+ и p+ слоев контраст наблюдается четко. Контроль заготовок, поврежденных при нанесении n+ и p+ слоев, и своевременная их отбраковка позволяет избежать ненужных затрат на последующие операции по изготовлению из них СЭ и, тем самым, снизить стоимость производства.
Для подавления рассматриваемого шунтирующего действия n+ и p+ слоев было разработано устройство, описание и блок-схема которого приведены в [20]. Оно основано на компенсационном методе, разработанном ранее для определения усредненных по площади значений τeff в пластинах кремния с n+–p или p+–n переходом [21, 22]. Сущность метода состоит в том, что исследуемая пластина кремния, помещаемая между обкладками конденсатора, освещается со стороны p–n перехода одновременно двумя потоками света с различными длинами волн λ1 и λ2. Их интенсивности модулированы синусоидально с частотой f. Один из потоков (λ = λ1) создает ННЗ в объеме базовой области, а другой (λ = λ2) – в ее тонком слое вблизи освещаемой поверхности. При этом чувствительность метода максимальна, когда коэффициенты поглощения (α1, 2) этих потоков света удовлетворяют соотношениям α1d ≤ 1, α2d $ \gg $ 1, где d – толщина пластины. Амплитуды их модуляций (∆P1, 2) и сдвиг фаз между ними подбираются так, чтобы индуцированная на конденсаторе суммарная переменная фото-ЭДС обращалась в 0. В результате обращаются в 0 переменный ток в зазорах между этой пластиной и обкладками конденсатора, а также переменное напряжение на самой пластине. При этом переменный ток вдоль n+ и p+ слоев также обращается в 0. При низких частотах (2πfτeff$ \ll $ 1) модуляция производится в противофазе. В этом случае коэффициенты собирания Q1, 2 удовлетворяют соотношению
(2)
$\frac{{{{Q}_{1}}}}{{{{Q}_{2}}}} = \frac{{{{\lambda }_{2}}\Delta {{P}_{2}}}}{{{{\lambda }_{1}}\Delta {{P}_{1}}}}.$Если при измерениях тока короткого замыкания значения τeff определяют по значениям Q с помощью формул, приведенных в [23, 24], то в данном случае они определяются по измеренным таким образом отношениям Q1/Q2 и тем же формулам этих работ. В разработанном устройстве использовались лазеры с λ1 = 1064 нм и λ2 = 808 нм ($\alpha _{{\text{1}}}^{{ - {\text{1}}}}$ ≈ 1 мм и $\alpha _{{\text{2}}}^{{ - {\text{1}}}}$ ≈ 13 мкм). Освещение производилось по световодам сквозь щель в одной из пластин конденсатора площадью 10 × 2 мм2. При этом значения Q2 были близки к 1, так что различия между значениями Q1 и Q1/Q2 составляли около 6%. Контрольные измерения контраста фоточувствительности на этом устройстве проводились при локальном освещении на одном из промышленных СЭ этим методом и стандартным, по току короткого замыкания. В последнем случае для областей максимально отличавшихся по фоточувствительности различие в значениях Q1 было равно 1.7, тогда как в случае компенсационного метода для этих областей различие в значениях Q1/Q2 было примерно на 5% меньше, что согласуется с расчетами. Ошибки в измерениях составляли около 4%.
Для сравнения этого компенсационного метода со стандартными, применяемыми для определения контраста фоточувствительности, представляет интерес оценка величины его сглаживания этими методами из-за токов по n+ и p+ слоям. В [25] показано, что при локальном освещении снижение контраста может быть в несколько раз.
Цель настоящей работы – экспериментально и путем численных расчетов рассмотреть другой случай – влияние токов по n+ и p+ слоям неоднородной кремниевой n+–p(n)–p+ структуры на распределение фотоэдс по площади при равномерном освещении p–n перехода.
РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
Измерения проводились на модели неоднородной n+–p–p+ структуры, состоящей из двух СЭ (1 и 2), соединенных резистором R. Предварительно измеренные по спектрам токов короткого замыкания значения τeff были равны 26 мкс у СЭ1 и 1 мкс у СЭ2 (облученного быстрыми электронами). Оба СЭ освещались одновременно с одинаковой интенсивностью от лампы накаливания мощностью 60 Вт с расстояний (H) от 0.25 до 1 м. Анализ изменений контраста фоточувствительности проводился по изменениям напряжений на обоих СЭ. При этом напряжения холостого хода (Voc1, 2) менялись в пределах 450–247 мВ для СЭ1 и 260–43 мВ для СЭ2. Под действием тока через резистор, моделирующего сопротивление n+ и p+ слоев, разница напряжений между этими СЭ снижалась.
Расчеты проводились для определения напряжений V+ на СЭ1 и V– на СЭ2, соединенных резистором R и освещаемых одновременно. Эти расчеты проводились на основании формулы вольт-амперной характеристики освещаемого СЭ [23, 24]
(3)
${{J}_{{1,2}}} = {{S}_{{1,2}}}{{j}_{{s1,2}}}\left( {\exp \frac{{q{{V}_{{1,2}}}}}{{{{A}_{{1,2}}}kT}} - 1} \right) - {{J}_{{sc1,2}}}.$Здесь J1, 2 – токи во внешних цепях СЭ1 и СЭ2, V1, 2 и Jsc1, 2 – напряжения и токи короткого замыкания этих СЭ, S1, 2 и js1, 2 – их площади и плотности токов насыщения, А1, 2 – численные коэффициенты, q – заряд электрона, k и Т – постоянная Больцмана и температура. Значения js1, 2 и A1, 2 определялись предварительно по вольт-амперным зависимостям этих СЭ (не соединенных резистором) при таких же условиях освещения. Расчеты проводились графическим методом, который поясняется на рис. 1 в случае R = 1000 Ом, H = 1 м. Кривая 1 соответствует зависимости –J1(V1), а кривая 2 – зависимости J2(V2). Кривая 3 соответствует зависимости –J1(V1 + $J_{1}^{\centerdot }R$), а кривая 4 – зависимости J2(V2 + $J_{{\text{2}}}^{\centerdot }R$). Значение напряжения V+ на СЭ1 определялось по точке пересечения кривых 1 и 4 (точка А), а напряжения V– на СЭ2 – по точке пересечения кривых 2 и 3 (точка В). Ординаты точек А и В одинаковы и равны значению тока JR через резистор R, т.е. |J1| = |J2| = JR = (V+ – V–)/R.
Рис. 1.
Пояснение метода определения напряжений V+ и V– на освещаемых СЭ1 и СЭ2 с различной фоточувствительностью, соединенных резистором R = = 1 кОм.
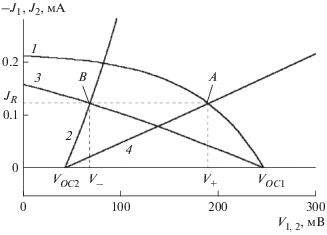
На рис. 2 приведены измеренные (точки 1т–4т) и расчетные (кривые 1к–4к) зависимости напряжений V+ на СЭ1 и V– на СЭ2 от величины соединяющего их резистора R. Сплошные кривые (1к, 3к) и зачерненные точки (1т, 3т) относятся к СЭ1, а штриховые кривые (2к, 4к) и светлые точки (2т, 4т) – к СЭ2. Семейство верхних кривых (с индексами 1, 2) соответствует максимальной интенсивности освещения (H = 0.25 м), а семейство нижних кривых (с индексами 3, 4) – минимальной (H = 1 м), в 16 раз меньшей. Как видно, расчетные данные согласуются с экспериментальными результатами в пределах ошибок измерений (менее 4%). Напряжения на обоих СЭ практически постоянны при изменении величины R от 100 до 10 кОм. С повышением освещенности от минимальной до максимальной отношение напряжений СЭ1 к СЭ2 снижается почти в 4 раза (от 5.7 до 1.5). При дальнейшем уменьшении R до 10 Ом напряжения на CЭ1 и СЭ2 практически сравниваются. Максимальное уменьшение напряжения (в 3 раза) происходит на СЭ1 при минимальной освещенности. (В этом случае значение V+ снижается от 247 мВ при R → ∞, до 84 мВ при R = 10 Ом). Тогда как на СЭ2 напряжение, наоборот, возрастает почти в 2 раза. Наблюдаемые зависимости от интенсивности освещения можно объяснить нелинейностью вольт-амперных характеристик СЭ. На рис. 3 приведены вычисленные зависимости отношений напряжений (V–/V+) тех же СЭ2 и СЭ1 от соотношения их площадей (S2/S1). Кривые 1 и 2 соответствуют максимальной интенсивности освещения, а кривые 3, 4 – минимальной. Штриховые кривые (1 и 3) вычислены при R = 3 кОм, а сплошные (2, 4) – при R = 30 кОм. Как видно, снижение контраста фото чувствительности происходит не только с увеличением шунтирования и ростом интенсивности освещения, но и с уменьшением отношения S2/S1. Среди кривых, приведенных на рис. 3 сильнее всего влияние снижения отношения S2/S1 выражено для кривой 3. В этом случае снижение отношения S2/S1 в 100 раз приводит к уменьшению контраста фото чувствительности в 3.4 раза. С ростом интенсивности освещения влияние соотношения площадей СЭ1 и СЭ2 заметно снижается.
Рис. 2.
Данные измерений (точки) и расчетные (кривые) зависимости напряжений V+ на СЭ1 (1к, 1т, 3к, 3т) и V– на СЭ2 (2к, 2т, 4к, 4т) от величины сопротивления, соединяющего их резистора R при максимальной (1к, 1т, 2к, 2т) и минимальной (3к, 3т, 4к, 4т) интенсивностях освещения. Пояснения в тексте.

Рис. 3.
Рассчитанные зависимости отношений напряжений (V–/V+) на СЭ2 и СЭ1 от соотношения их площадей (S2/S1) при R = 3 кОм (штриховые кривые 1, 3) и 30 кОм (сплошные кривые 2, 4). Кривые вычислены при таких же фотоэлектрических параметрах СЭ, как для рис. 2.
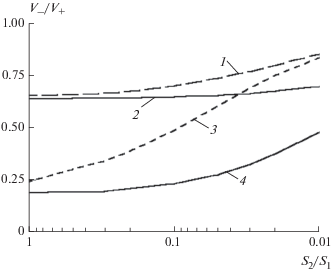
Таким образом, если напряжения холостого хода неодинаковы у различных участков базовой области n+–p(n)–p+ структуры кремния, то при одновременном освещении всей поверхности p–n перехода измеряемый контраст фоточувствительности может быть существенно меньше истинного. Это сглаживание контраста связанно с шунтированием базовой области n+ и p+ слоями. На величину этого снижения влияют интенсивность освещения, сопротивления n+ и p+ слоев и соотношения площадей этих участков структуры.
ЗАКЛЮЧЕНИЕ
Проведены оценки искажений контраста фоточувствительности неоднородных n+–p(n)–p+ структур кремния возможных при контроле их качества методами, основанными на освещении всей поверхности p–n перехода. Измерения проводились на модели, состоящей из двух соединенных резистором кремниевых СЭ, которые одинаково освещались со стороны p–n перехода. Эти СЭ обладали различной фоточувствительностью благодаря предварительному облучению одного из них быстрыми электронами. Путем расчетов показано, что токи по n+ и p+ слоям между участками структуры с различными значениями фотоэдс могут привести к снижению измеряемого контраста фоточувствительности. Величина этого эффекта зависит от освещенности структуры, величины шунтирующего сопротивления и соотношения площадей участков с различными значениями фотоэдс. Результаты измерений и вычислений согласуются между собой.
Автор признателен Генеральному директору ООО ИТР М.А. Региневичу, по совету которого была проведена эта работа.
Список литературы
Зеегер K. Физика полупроводников. М.: Мир, 1977. 615 с.
Bowden S., Sinton R.A. // J. Appl. Phys. 2007. V. 102. Art. No 124501.
Roller J.F., Li Y.-T., Dagenais M., Hamadani B.H. // J. Appl. Phys. 2016. V. 120. Art No 233108.
Kerr M.J., Cuevas A., Sinton R.A. // J. Appl. Phys. 2002. V. 91. No 1. P. 399.
Cuevas A., Sinton R. // Prog. Photovolt. 1997. V. 5. P. 79.
Mackdonald D., Sinton R., Cuevas A. // J. Appl. Phys. 2001. V. 89. No 5. P. 2722.
Schuler N., Hahn T., Schmerler S. et al. // J. Appl. Phys. 2010. V. 107. Art. No 064901.
van Wezep D.A., van der Velden M.H.L., Bosra D.M., Bosh R.C.M. // Proc. 26th EU PVSEC (Hamburg, 2011). P. 1423.
Chung D., Mitchell B., Juhl M.K. et al. // IEEE J. Photovolt. 2018. V. 8. No 4. P. 943.
Schmidt J., Aberle A.G. // J. Appl. Phys. 1997. V. 81. No 9. P. 6186.
Gaubas E., Kaniava A. // Rev. Sci. Instrum. 1996. V. 67. No 6. P. 2339.
Palais O., Gervais J., Clere L., Martinuzzi S. // Mater. Sci. Engin. 2000. V. 71. P. 47.
Sinton R.A. // Proc. 25th Photovolt. Spec. Conf. (Washington, 1996). P. 457.
http://www.sintoninstruments.com/Sinton-instruments-WCT-120.html.
Wurfel P., Trupke T., Puzzel T. et al. // J. Appl. Phys. 2007. V. 101. No 12. Art. No 123110.
http://solar-front.livejournal.com/11644.html.
https://www.czl.ru/applications/light-beam-induced-current-lbic/.
Koshelev O.G. Untila G.G. // Phys. Wave Phenom. 2016. V. 24. No 3. P. 214.
Hovsepyan A., Babajanyan A., Sargsyan T. et al. // J. Appl. Phys. 2009. V. 106. Art. No 114901.
Кошелев О.Г. // ПТЭ. 2020. № 4. С. 149; Koshelev O.G. // Instrum. Exp. Tech. 2020. V. 63. No 4. P. 604.
Кошелев О.Г., Морозова В.А. Способ определения электрофизических параметров неравновесных носителей заряда в подложках диодных структур. Патент РФ № 2019890. 1994.
Koshelev O.G., Morozova V.A. // Sol. St. Electron. 1996. V. 39. No 9. P. 1379.
Зи С. Физика полупроводниковых приборов. Москва: Мир, 1984. 455 с.
Васильев А.М., Ландсман А.П. Полупроводниковые фотопреобразователи. М.: Сов. радио, 1971.
Кошелев О.Г. // Изв. РАН. Сер. физ. 2020. Т. 84. № 1. С. 52; Koshelev O.G. // Bull. Rus. Acad. Sci. Phys. 2020. V. 84. No 1. P. 44.
Дополнительные материалы отсутствуют.
Инструменты
Известия РАН. Серия физическая


