Известия РАН. Серия физическая, 2021, T. 85, № 2, стр. 294-301
Квантово-размерные объекты в виде ловушек экситонов и трионов и их роль при экситонном частичном блокировании мемристорных свойств тонких пленок оксида цинка
И. И. Попов 1, *, А. В. Мороз 1, Д. В. Минеев 1, А. А. Гладышева 1, Н. И. Сушенцов 1
1 Федеральное государственное бюджетное образовательное учреждение высшего образования
“Поволжский государственный технологический университет”
Йошкар-Ола, Россия
* E-mail: popov@volgatech.net
Поступила в редакцию 28.08.2020
После доработки 25.09.2020
Принята к публикации 28.10.2020
Аннотация
На основе анализа результатов экспериментов по фотонному эху в тонких пленках оксида цинка и легированного кремния обсуждаются возможные механизмы возникновения при комнатной температуре ловушек экситонов и трионов и динамика протекающих в них релаксационных процессов. Изучены вольтамперные характеристики, снятые для таких пленок с ловушками, обладающих мемристорным эффектом, и установлено влияние ловушек на параметры вольтамперных характеристик.
ВВЕДЕНИЕ
Новые материалы с квантоворазмерными структурами привлекают все большее внимание с точки зрения перспектив их использования в новых приложениях электроники и фотоники. Создание новых материалов с полезными функциональным свойствами невозможно без фундаментального исследования их микроскопической структуры и внутренней динамики. Особый интерес представляет изучение релаксационных процессов, протекающих в квантовых точках при разных температурах, включая комнатные. В области лазерной спектроскопии одним из наиболее эффективных направлений экспериментального исследования указанных свойств является селективная спектроскопия примесного центра, включая методы фотонного эха (ФЭ) [1–6] и люминесцентной спектроскопии [7–11]. Необходимо также отметить важность развития теоретических подходов к описанию быстропротекающих процессов в твердотельных нанокомпозитах [12, 13], в особенности, методов, описывающих эволюцию экситонной когерентности [14, 15].
В данной работе на основе анализа экспериментов по ФЭ в примесных тонких пленках полупроводников предлагаются возможные механизмы возникновения при комнатной температуре ловушек экситонов и трионов и исследуется динамика протекающих в них релаксационных процессов. Указанные ловушки локализованы на наноразмерных зонах поверхностных дефектов кристаллической структуры волокон текстурированных тонких пленок полупроводника. Актуальность исследования связана с совершенствованием возможностей активно разрабатываемой в настоящее время мемристорной памяти, которая может быть использована при создании биоиндуцированных вычислительных систем и нейрокомпьютеров [16]. В этом случае мемристор можно рассматривать в качестве искусственного аналога синапса, необходимого для создания цепей, позволяющих реализовать обучение по правилу Хебба [17]. Исследование механизмов функционирования подобной памяти не только с точки зрения записи, но и обработки информации, является важной научно-исследовательской задачей.
В [18] нами были показаны возможности анализа временных спадов интенсивности эхо-сигналов для исследования релаксационных процессов суперпозиционных состояний, формируемых при возбуждении экситонов и трионов, локализуемых в ловушках. Было показано, что релаксационные процессы затухания сигналов ФЭ связаны с глубиной энергетического залегания в запрещенной зоне дефектных участков кристаллической решетки, составляющих на поверхности кристаллической структуры зоны локализации экситонов и трионов. При этом отметим, что мемристорные свойства тонких полупроводниковых пленок связаны с изменением толщины запрещенной зоны за счет переключения основной симметрии анионов относительно катионов на зеркальную и, наоборот, под воздействием напряжения определенной полярности, прикладываемого к пленке, достигающего значения, критического для переключения между различными типами симметрии. В результате сопоставления этих двух факторов, зависящих от толщины запрещенной зоны, может быть установлен механизм их взаимного влияния друг на друга. Суть развиваемого подхода заключается в использовании режима измерения вольтамперной характеристики (ВАХ) полупроводниковой пленки для возбуждения экситонного состояния в ловушках пленки с целью коррекции характерной для мемристора толщины запрещенной зоны, а вместе с тем и сопротивления электрическому току. В [19] было продемонстрировано наличие мемристорных свойств у пленок оксида цинка, полученных методом химического осаждения. Такие пленки, по-видимому, характеризуются малым количеством ловушек экситонов из-за отсутствия поверхностных дефектов кристаллической решетки, характерного для волокнисто-кристаллической структуры пленок, полученных методом магнетронного распыления. Тем не менее в [19] была показана возможность изменения симметрии анионов относительно катионов с основной на зеркальную и наоборот в зависимости от полярности прикладываемого напряжения, достигающего критического значения, необходимого для этого переключения. За счет изменения толщины запрещенной зоны во время переключения этих симметрий изменяется сопротивление пленки, что проявляется в возникновении петли гистерезиса на ВАХ. Причем в случае приложения положительного напряжения значение перепада тока при одном и том же напряжении на петле гистерезиса значительно больше, чем перепад тока при таком же напряжении обратной полярности. Таким образом, была показана пригодность тонких пленок оксида цинка и легированного кремния для построения мемристорной памяти. Целью исследования является установление механизмов, обуславливающих изменение сопротивления тонкой пленки оксида цинка за счет включения различных экситонных механизмов релаксации, протекающих внутри ловушек, связанных с дефектами структуры пленки. Дополнительной задачей было установление оптимальной концентрации кислорода и толщины пленки, необходимых для проявления мемристорных свойств.
МАТЕРИАЛЫ И МЕТОДЫ ИССЛЕДОВАНИЯ
Были исследованы однослойные и многослойные пленки, состоящие из оксида цинка (ZnO) и кремния, легированного бором (Si(B)) или фосфором (Si(P)), или имеющих в своем составе слои этих материалов (Si(P)/Si(B)/ZnO). Пленки были получены методом магнетронного распыления, описанным в [20]. Толщина пленок варьировалась в интервале от 100 до 800 нм. Изучали пленки оксида цинка с различными концентрациями кислорода и толщинами, как одиночных, так и в составе трехслойной пленки Si(P)/Si(B)/ZnO. Ранее в этом материале наблюдали сигналы фотонного эха [18, 20].
Особенностью тонких пленок, полученных методом магнетронного распыления, является их волоконно-кристаллическая текстура. Пленки состоят из кристаллических волокон, вертикально ориентированных относительно подложки пленки. Волокна имеют винтообразную форму с убывающей по мере удаления от подложки площадью горизонтального сечения, с диаметром, меняющимся от нескольких сотен нанометров до десятков нанометров. Пространство между волокнами заполнено ренгеноаморфной фазой распыляемого вещества, не обладающей кристаллической структурой. В силу большой кривизны поверхности волокон на границе, отделяющей кристаллическую фазу от ренгеноаморфной, в структуре волокон возникает множество дефектов кристаллической решетки. Как будет показано ниже, участки на этой поверхности, где скапливаются дефекты кристаллической решетки, расположенные внутри замкнутой кривой линии дислокации, могут образовывать ловушки экситонных и трионных состояний, возбуждаемых в этих пленках, за счет глубокого залегания этих дефектов в запрещенной зоне.
Наиболее важным параметром, характеризующим строение тонких пленок, является степень их кристалличности, поэтому возникавшая задача контроля, вычисления и оптимизации этого параметра при напылении пленок [20] была решена путем построения математической модели, связывающей условия формирования тонкой пленки со степенью кристалличности. Дополнительно в [20] были описаны способы контроля качества тонких пленок, включая методы рентгеноструктурного анализа, зондовой микроскопии и регистрации микротвердости.
Для экспериментального поиска и исследования мемристорных свойств оксида цинка нами были изготовлены два вида пленок. Первый (тип I) – десятислойная пленка с увеличением на 10% концентрации кислорода в каждом слое (от 0 до 90%) по мере приближения к внешней поверхности пленки. Второй (тип II) представлял собой двухслойную пленку оксида цинка. Нижний проводниковый слой имел концентрацию кислорода 20%, а верхний полупроводниковый – 30%. Таким образом, в первом варианте роль внутреннего проводящего электрода выполнял слой с концентрацией кислорода в 20%, во втором случае – слой с концентрацией кислорода 0%. В качестве внешнего проводящего электрода использовался платиновый щуп зондового микроскопа, с помощью которого измеряли ВАХ пленок, показанные на рис. 3б, 3в. Режим измерения ВАХ на зондовом микроскопе имел аппаратные ограничения по регистрации максимального тока в диапазоне от –50 до +50 нА. Поэтому некоторые случаи переключения сопротивления пленки в наших экспериментах соответствовали режиму токового насыщения.
ФЕМТОСЕКУНДНОЕ ФОТОННОЕ ЭХО В ТОНКИХ ПЛЕНКАХ ОКСИДА ЦИНКА И ЛЕГИРОВАННОГО КРЕМНИЯ
Первичное фотонное эхо в однослойных и многослойных пленках
На рис. 1 приведены кривые спада интенсивности первичного фотонного эха (ПФЭ), измеренные в пленках оксида цинка толщиной 600 и 800 нм. Условия пространственного синхронизма соответствовали режиму однофотонного возбуждения эхо-сигналов. На кривых спада можно выделить три участка с различной динамикой. Первый участок быстрого спада интенсивности ПФЭ обязан упругим столкновениям экситонов и фононному крылу однородного уширения резонансной спектральной линии (сбой фазы из-за взаимодействия резонансных частиц с фононами кристаллической решетки). Для пленки 600 нм время релаксации Т2 составило 235 ± 51 фс, а для пленки толщиной 800 нм – 140 ± 11 фс. Второй участок более медленного спада интенсивности сигнала ПФЭ обязан упругим столкновениям экситонов в условиях значительного снижения влияния фононов кристаллической решетки. Для пленки толщиной 600 нм время релаксации Т2 составило 307 ± 27 фс, а для пленки толщиной 800 нм – 188 ± 15 фс. Третий (пологий) спад интенсивности ПФЭ указывает на то, что эхо-сигнал формируется на экситонном конденсате. Можно предположить, что конденсат возникает благодаря глубокому залеганию дефектов кристаллической решетки пленки ZnO в широкой запрещенной зоне при интенсивности возбуждающего излучения, достаточной для формирования в экситонной ловушке предельной концентрации экситонов. Экситонный конденсат возникает в результате упорядоченного взаимодействия экситонного газа с фононами кристаллической решетки в отсутствии влияния возбужденных частиц. Для пленки 600 нм время необратимой поперечной релаксации Т2 составило 1126 ± 155 фс, а для пленки толщиной 800 нм – 230 ± 69 фс. При меньшей толщине пленки средняя кривизна кристаллических волокон, составляющих пленку, больше. Это приводит к уменьшению квантово-размерного объекта, соответственно к увеличению времени релаксации, и к более глубокому залеганию в запрещенной зоне дефектов, составляющих эту ловушку.
Стимулированное фотонное эхо в однослойных и многослойных пленках
На рис. 2 показаны кривые спада интенсивности сигналов стимулированного фотонного эха (СФЭ) при временном интервале между первым и вторым возбуждающими импульсами равным нулю. Условия пространственного синхронизма соответствовали условиям однофотонного возбуждения. Сигналы СФЭ регистрировали в однослойных пленках ZnO, Si(B) и Si(P) (каждая пленка толщиной 100 нм) и в трехслойной пленке Si(P)/Si(B)/ZnO с толщиной всей пленки 300 нм, а каждого отдельного слоя – 100 нм. Мы предполагаем, что в однослойных пленках сигналы СФЭ формируются в экситонных ловушках, а в трехслойной пленке – в трионных ловушках. Трионы образуются при возбуждении в оксиде цинка экситона, к которому притягивается донорная дырка, возникающая благодаря наличию двух слоев легированного кремния. Трион имеет электрон, связанный с двумя дырками кулоновскими связями с противоположным по знаку спином. В процессе миграции по поверхности кристаллического волокна трион попадает в ловушку, в которой аналогично экситонным состояниям локализуется за счет потери части своей энергии при взаимодействии с фононами кристаллической решетки. Концентрация трионов зависит от глубины залегания дефектов кристаллической решетки в запрещенной зоне оксида цинка и от интенсивности импульсов возбуждающего лазерного излучения.
Рис. 2.
Кривые спада сигналов СФЭ при постоянном значении временного интервала τ12: 1 – для трехслойной пленки Si(P)/Si(B)/ZnO; 2 – для пленки ZnO толщиной 100 нм; 3 – для пленки Si(P) толщиной 100 нм; 4 – для пленки Si(B) толщиной 100 нм.
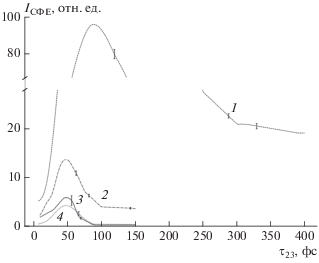
На рис. 2 на кривой 1 (для трионов в оксиде цинка трехслойной пленки) и кривой 2 (для экситонов в оксиде цинка) можно выделить три характерных участка спада сигнала СФЭ. Первый быстрый спад обязан затуханию эхо-сигнала из-за неупругих столкновений трионов и наличию фононного крыла в столкновительном уширении резонансной спектральной линии из-за взаимодействия трионов с фононами кристаллической решетки. Для трехслойной пленки время релаксации Т1 составило 690 ± 40 фс, а для пленки оксида цинка толщиной 100 нм – 920 ± 20 фс. Быстрый спад, обусловленный взаимодействием с фононами кристаллической решетки, наблюдался также для пленки Si(P) (кривая 3) и Si(B) (кривая 4). При этом время релаксации Т1 составило, соответственно, 980 ± 200 и 5360 ± 970 фс. Большие значения времени релаксации Т1 на пленках легированного кремния объясняются меньшими размерами квантово-размерного объекта (ловушек экситонов) из-за меньшего диаметра волокон и большей кривизны их поверхности. Второй более медленный спад интенсивности сигнала СФЭ связан со столкновительным уширением резонансной спектральной линии из-за неупругих столкновений возбужденных трионов при значительном снижении влияния фононов кристаллической решетки. Для трехслойной пленки при возбуждении трионных состояний время релаксации Т1 составило 3100 ± 3 фс, а для пленки оксида цинка толщиной 100 нм при возбуждении экситонных состояний – 3800 ± 3 фс. Для кремния, легированного фосфором (кривая 3), время релаксации Т1 на участке медленного спада составило 3490 ± 65 фс. Для кремния, легированного фтором, время спада СФЭ обусловленное столкновениями экситонов, по-видимому, близко к характерному времени взаимодействия с фононами кристаллической решетки, потому участка медленного спада эхо-сигнала не наблюдается.
Третий участок самого пологого спада интенсивности сигнала СФЭ обязан релаксации трионного (кривая 1) или экситонного (кривая 2, для однослойных пленок) конденсата. Наличие такого спада указывает на то, что глубина залегания дефектов кристаллической решетки в запрещенной зоне и интенсивность возбуждающего излучения достаточны для формирования при комнатной температуре экситонного и трионного конденсата в ловушках экситонов и трионов, сформированных на поверхностных дефектах кристаллической решетки полупроводниковых тонких пленок. Регистрируемое время необратимой продольной релаксации Т1 зависит от концентрации локализованных экситонных и трионных состояний. Для реализованных параметров эксперимента для трехслойной пленки Т1 составило 17200 ± 300 фс, а для пленки оксида цинка толщиной 100 нм – 36500 ± 15 фс. В пленках легированного кремния не наблюдается формирования сигналов СФЭ на экситонном конденсате, по-видимому, из-за отсутствия последнего в силу узкой запрещенной зоны у пленок, не обеспечивающей необходимую глубину залегания дефектов кристаллической решетки. Концентрация экситонов в ловушках снижается в силу захвата большого числа электронов акцепторными и донорными примесями полупроводниковой пленки кремния.
Нефарадеевский поворот плоскости поляризации сигналов СФЭ в трехслойной пленке
Авторами [21, 22] было показано, что спектры трионов имеют сверхтонкую структуру с компонентами, имеющими противоположный спин. Под действием однородного магнитного поля происходит снятие вырождения спектральных уровней этих компонент, сопровождающееся зеемановским расщеплением. Возникает ларморовская прецессия псевдоэлектрического дипольного момента возбужденного квантового перехода, благодаря чему в газовых средах (и только в них) возникает специфический поворот плоскости поляризации сигналов СФЭ при воздействии продольного однородного магнитного поля [23]. Мы предполагаем, что при возбуждении сигналов СФЭ на квантовых уровнях трионов в трехслойной пленке (Si(P)/Si(B)/ZnO) при наличии продольного однородного магнитного поля происходит зеемановское расщепление экситонных связей электрона разными дырками с учетом знака спина. При этом величины зеемановского расщепления для разных уровней резонансного трионного перехода отличаются, что согласно [23] может привести к возникновению эффекта нефарадевского поворота плоскости поляризации СФЭ в наших экспериментах. Таким образом, в [24] нами было экспериментально продемонстрировано наличие в трехслойной пленке трионных состояний, возбуждаемых мощным лазерным излучением. Это утверждение справедливо благодаря регистрации в трехслойной пленке нефарадеевского поворота плоскости поляризации СФЭ, не наблюдающегося в однослойных пленках (в экситонных ловушках). В активной среде под воздействием однородного магнитного поля имеет место зеемановское расщепление сверхтонкой структуры на компоненты, отличающейся знаком спина, характерной для трионного состояния. Тот факт, что этот эффект наблюдался ранее только в газовой среде, можно интерпретировать как наличие в ловушках активной среды в виде трионного газа. Наличие тождественных признаков в релаксационных кривых спада для трехслойной и однослойной пленок позволяет утверждать, что природа формирования сигналов ФЭ в этих пленках одна и та же, т.е. характерна для резонансной среды, находящейся в газовой фазе: в экситонном газе – в случае исследования однослойных пленок, в трионном газе – для трехслойной пленки. Развитый подход позволяет описать механизмы появления пологого участка в кривой спада интенсивности эхо-сигналов, приведенных на рис. 1 и 2. Однако высказанные предположения нуждаются в проверке другими спектроскопическими методами.
Дополнительно стоит отметить возможность использования наблюдаемых эффектов для прецизионного измерения очень коротких промежутков времени. Угол поворота плоскости поляризации сигналов СФЭ зависит от гиромагнитного соотношения резонансного квантового перехода, величины напряженности приложенного магнитного поля, дискретно меняющегося временного интервала между первыми двумя возбуждающими импульсами (t12 = 0–50 фс) и временного интервала между вторым и третьим возбуждающими импульсами (t23). При этом кривые спада сигналов СФЭ при различных дискретных значениях t12 отличаются по форме и степени проявления периодического возрастания интенсивности эхо-сигнала [25]. Путем регистрации угла поворота плоскости поляризации сигнала СФЭ при фиксированных остальных параметрах эксперимента (включая t12), используя теорию, развитую в [23], вычисляется величина t23. Минимальное зарегистрированное в наших экспериментах значение составило 27 фс. Это более, чем на 3 порядка меньше существующих на сегодня эталонов [26]. Данное обстоятельство подтверждает практическую значимость рассматриваемых в данной работе эффектов, связанных с квантоворазмерными объектами в виде ловушек трионов, сформированных в тонких полупроводниковых пленках при комнатной температуре.
МЕМРИСТОРНЫЕ СВОЙСТВА ТОНКИХ ПЛЕНОК
Объемные полупроводники характеризуются постоянным значением ширины запрещенной зоны, потому на их ВАХ отсутствует петля гистерезиса и, соответственно, отсутствует возможность создания на них мемристорной памяти. В тонких полупроводниковых пленках существует зависимость принимаемой пленкой симметрии анионов относительно катионов от величины и полярности приложенного к пленке напряжения. Меняющаяся при этом толщина запрещенной зоны приводит к появлению петли гистерезиса на графике ее ВАХ.
В наших измерениях ВАХ тонких пленок оксида цинка регистрируемый ток зависел от толщины запрещенной зоны, значение которой определялось тем, какое из двух устойчивых состояний (основное или зеркальное) принимали анионы кислорода относительно узлов кристаллической решетки катионов цинка. Смена этих состояний, соответственно, появление одного из двух значений сопротивления электрическому току, происходило под действием прикладываемого значения напряжения, необходимого для выбора типа симметрии анионов относительно катионов. На основе данного эффекта возможно создание мемристорной (резистивной) памяти. Экспериментально нами было установлено, что для оксида цинка значения напряжений в зависимости от концентрации кислорода находятся в диапазоне от –4 до +4 В.
В работе [19] приведены результаты измерения ВАХ пленки оксида цинка (рис. 3в), полученной методом химического осаждения. Переключение сопротивления происходило при напряжениях, равных –2.5 и 4 В. При измерении ВАХ в момент изменения напряжения от –2.5 до +4 В ширина запрещенной зоны пленки была максимально возможной для нее, то есть сопротивление пленки было максимальным. Это соответствовало наименьшим значениям регистрируемого электрического тока. При измерении ВАХ в момент изменения напряжения от + 4 до –2.5 В ширина запрещенной зоны пленки была минимально возможной для нее, то есть сопротивление пленки было минимальным. Это соответствовало наибольшим значениям регистрируемого электрического тока. При этом перепад тока в прямом направлении для двух ветвей ВАХ, лежащих в области положительных значений напряжения, равному +2 В, соответствовал более значимому изменению сопротивления пленки и наибольшему перепаду тока, равному 18 нА (с 3 до 21 нА). Для значений, лежащих в области отрицательного напряжения, составляющего – 2 В, перепад тока составлял всего 2 нА (от –23 до –25 нА).
Рис. 3.
Вольтамперные характеристики оксида цинка, полученного методом магнетронного распыления (а и б) и методом химического осаждения [19] (в): при послойном изменении концентрации кислорода через 10% от 0 до 90% (три слоя проводники, один полупроводник и 6 верхних слоев изолятор) (а); двухслойная пленка (первый слой 20% кислорода – проводник; верхний слой 30% кислорода – полупроводник) (б).

В то же время, при измерении ВАХ пленок, полученных методом магнетронного распыления, перепад тока при значении напряжения, равном +0.8 В, в верхней части ВАХ для пленки типа I (рис. 3а) составил 6 нА (с 8 до 14 нА), а для типа II (рис. 3б) – 15 нА (с 8 до 23 нА). При этом для значений напряжения –0.8 В в нижней части ВАХ для пленки типа I составил 30 нА (с – 8 до –38 нА), а для типа II – 23 нА (с –8 до –31 нА). Таким образом, для 10-слойной пленки оксида цинка, полученной методом магнетронного распыления, с концентрацией кислорода в верхних слоях пленки, обеспечивающей оксиду цинка свойства диэлектрика, перепад тока вверху по сравнению с нижней частью ВАХ был на 15 нА меньше и на пленке без изолирующего слоя оксида цинка сверху пленки – на 8 нА меньше. Это уменьшение перепада тока между верхними ветвями ВАХ связано с тем, что при подаче прямого напряжения часть электронов кислородных анионов участвует в создании экситонных состояний, которые в дальнейшем локализуются в ловушках экситонов. По этой причине количество анионов, влияющих на ток ВАХ уменьшается, что приводит к значительному снижению перепада тока по сравнению с ВАХ, снимаемой при напряжении, приложенном в обратном направлении, когда не создаются экситонные состояния. Наибольшее проявление блокирования мемристорных свойств оксида цинка в верхней половине ВАХ для пленки, имеющей снаружи изолирующий слой, связано с большим количеством поверхностных дефектов в запрещенной зоне, а значит и с большим количеством ловушек экситонов и локализованных в них экситонов.
Таким образом, регулируя напряжением интенсивность возбуждения экситонных и трионных состояний, локализуемых в их ловушках, мы получаем возможность изменять величину перепада значений тока в верхней части петли гистерезиса на ВАХ тонкой полупроводниковой пленки, то есть влиять на запоминаемые в мемристорной памяти значения сопротивления.
ЗАКЛЮЧЕНИЕ
В результате комплексного изучения тонких пленок оксида цинка и легированного кремния, полученных методом магнетронного распыления, предложены и обоснованы возможные механизмы возникновения при комнатной температуре ловушек экситонов и трионов и описана их релаксационная динамика. Установлено значение концентрация кислорода в оксиде цинка, при которой в тонкой пленке проявляются свойства мемристорной памяти, составляющее от 20 до 30 процентов. Определены характерные времена поперечной и продольной необратимых релаксаций для ловушек экситонов и трионов при комнатной температуре. Установлены характеристики пленок, необходимые для обеспечения в них мемристорного эффекта.
Список литературы
Karimullin K.R., Arzhanov A.I., Eremchev I.Yu. et al. // Laser Phys. 2019. V. 29. No 12. Art. No 124009.
Karimullin K.R., Knyazev M.V., Arzhanov A.I. et al. // J. Phys. Conf. Ser. 2017. V. 859. Art. No 012010.
Аржанов А.И., Каримуллин К.Р., Наумов А.В // Кр. cообщ. по физ. ФИАН. 2018. Т. 45. № 3. С. 39; Arzhanov A.I., Karimullin K.R., Naumov A.V. // Bull. Lebedev Phys. Inst. 2018. V. 45. No 3. P. 91.
Каримуллин К.Р., Аржанов А.И., Наумов А.В. // Изв. РАН. Сер. физ. 2018. Т. 82. № 11. С. 1620; Karimullin K.R., Arzhanov A.I., Naumov A.V. // Bull. Russ. Acad. Sci. Phys. 2018. V. 82. No 11. P. 1478.
Каримуллин K.Р., Аржанов А.И., Наумов А.В. // Изв. РАН. Сер. физ. 2017. Т. 81. № 12. С. 1581; Karimullin K.R., Arzhanov A.I., Naumov A.V. // Bull. Russ. Acad. Sci. Phys. 2017. V. 81. No 12. P. 1396.
Каримуллин К.Р., Князев М.В., Вайнер Ю.Г., Наумов А.В. // Опт. и спектроск. 2013. Т. 114. № 6. С. 943; Karimullin K.R., Knyazev M.V., Vainer Y.G., Naumov A.V. // Opt. Spectrosс. 2013. V. 114. No 6. P. 859.
Магарян К.А., Каримуллин К.Р., Васильева И.А., Наумов А.В. // Опт. и спектроск. 2019. Т. 126. № 1. С. 50; Magaryan K.A., Karimullin K.R., Vasil’eva I.A., Naumov A.V. // Opt. Spectrosс. 2019. V. 126. No 1. P. 41.
Karimullin K.R., Mikhailov M.A., Georgieva M.G. et al. // J. Phys. Conf. Ser. 2018. V. 951. Art. No 012011.
Магарян К.А., Михайлов М.А., Каримуллин К.Р. и др. // Изв. РАН. Сер. физ. 2014. Т. 78. № 12. С. 1629; Magaryan K.A., Mikhailov M.A., Karimullin K.R. et al. // Bull. Russ. Acad. Sci. Phys. 2014. V. 78. No 12. P. 1336.
Каримуллин К.Р., Князев М.В., Наумов А.В. // Изв. РАН. Сер. физ. 2014. Т. 78. № 12. С. 1539; Karimullin K.R., Knyazev M.V., Naumov A.V. // Bull. Russ. Acad. Sci. Phys. 2014. V. 78. No 12. P. 1254.
Еськова А.Е., Аржанов А.И., Магарян К.А. и др. // Изв. РАН. Сер. физ. 2020. Т. 84. № 1. С. 48; Eskova A.E., Arzhanov A.I., Magaryan K.A. et al. // Bull. Russ. Acad. Sci. Phys. 2020. V. 84. No 1. P. 40.
Fedyanin V.V., Karimullin K.R. // Laser Phys. 2019. V. 29. No 12. Art. No 124008.
Федянин В.В., Каримуллин К.Р. // Изв. РАН. Сер. физ. 2020. Т. 84. № 3. С. 361.
Самарцев В.В., Митрофанова Т.Г., Хасанов О.Х. // Изв. РАН. Сер. физ. 2019. Т. 83. № 12. С. 1609. Samartsev V.V., Mitrofanova T.G., Khasanov O.K. // Bull. Russ. Acad. Sci. Phys. 2019. V. 83. No 12. P. 1450.
Самарцев В.В., Камалова Д.И., Митрофанова Т.Г. // Изв. РАН. Сер. физ. 2018. Т. 82. № 12. С. 1738; Samartsev V.V., Kamalova D.I., Mitrofanova T.G. // Bull. Russ. Acad. Sci. Phys. 2018. V. 82. No 12. P. 1574.
Erokhin V., Fontana M.P. // J. Comput. Theor. Nanosci. 2011. V. 8. No 3. P. 1.
Hebb D.O. The organization of behavior. N.Y.: Wiley, 1949. 335 p.
Попов И.И., Архиреев И.А., Вашурин Н.С. и др. // Изв. РАН. Сер. физ. 2020. Т. 84. № 3. С. 398; Popov I.I., Arkhireev I.A., Vashurin N.S. et al. // Bull. Russ. Acad. Sci. Phys. 2020. V. 84. No 3. P. 308.
Смирнов В.А., Томинов Р.В., Авилов В.И. и др. // ФТП. 2019. Т. 53. № 1. С. 77; Smirnov V.A., Tominov R.V., Avilov V.I. et al. // Semiconductors. 2019. V. 53. No 1. P. 72.
Сушенцов Н.И., Мороз А.В., Степанов С.А. и др. // Изв. РАН. Сер. физ. 2014. Т. 78. № 3. С. 313.
Langer L., Poltavtsev S.V., Yugova I.A. et al. // Phys. Rev. Lett. 2012. V. 109. Art. No 157403.
Langer L., Poltavtsev S.V., Yugova I.A. et al. // Nat. Photon. 2014. V. 8. P. 851.
Евсеев И.В., Ермаченко В.М., Решетов В.А. // Опт. и спектроск. 1982. Т. 52. № 3. С. 444.
Попов И.И., Вашурин Н.С., Путилин С.Э., Баходуров А.У. // Изв. РАН. Сер. физ. 2017. Т. 81. № 5. С. 594; Popov I.I., Vashurin N.S., Bahodurov A.U., Putilin S.E. // Bull. Russ. Acad. Sci. Phys. 2017. V. 81. No 5. P. 551.
Попов И.И., Вашурин Н.С., Виноградов Е.А. и др.// Изв. РАН. Сер. физ. 2018. Т. 82. № 8. С. 1113; Popov I.I., Vashurin N.S., Vinogradov E.A. et al. // Bull. Russ. Acad. Sci. Phys. 2018. V. 82. No 12. P. 1008.
ГЭТ 1-98. Государственный первичный эталон времени и частоты и шкал времени в составе Единого эталона единиц времени, частоты и длины.
Дополнительные материалы отсутствуют.
Инструменты
Известия РАН. Серия физическая