Кристаллография, 2021, T. 66, № 4, стр. 560-567
Особенности атомной структуры нанокристаллов силицидов железа в матрице кремния
А. К. Гутаковский 1, *, А. В. Латышев 1
1 Институт физики полупроводников им. А.В. Ржанова СО РАН
Новосибирск, Россия
* E-mail: gut@isp.nsc.ru
Поступила в редакцию 17.02.2021
После доработки 21.02.2021
Принята к публикации 21.02.2021
Аннотация
Методом высокоразрешающей электронной микроскопии детально изучены все стадии трансформации кристаллической структуры нанокристаллов (НК) силицида железа на атомарно-чистой поверхности Si(111) при варьировании условий синтеза. Установлены основные структурно-морфологические параметры НК дисилицида железа в матрице кремния и эпитаксиальные соотношения кристаллических решеток НК и матрицы. Выполнены оценки упругих деформаций НК β-FeSi2 в матрице кремния.
ВВЕДЕНИЕ
Одной из важнейших задач кремниевой технологии является увеличение быстродействия межэлементных соединений сверхбольших интегральных схем. В связи с этим перспективным направлением является использование оптоволоконных соединений вместо традиционных электрических, что требует интеграции оптоэлектронных устройств (светоизлучающих и светоприемных) с кремниевыми интегральными схемами. Поскольку кремний сам по себе является непрямозонным полупроводником, ведутся активные поиски прямозонных материалов, которые могли бы быть встроены в Si-матрицу в едином технологическом процессе, не нарушая кристаллического совершенства такой гетеросистемы и обеспечивая требуемые оптические свойства.
В настоящее время задачу интеграции оптоэлектронных устройств с кремниевыми интегральными схемами пытаются решить различными способами, включая создание тонкопленочных гетероструктур, квантовых ям или квантовых точек на основе прямозонных полупроводниковых соединений, в частности соединений A3B5. Основная фундаментальная проблема при этом связана со значительным структурно-химическим несоответствием Si и соединений A3B5, в результате которого либо невозможно избежать генерации дефектов структуры, либо синтезировать активные элементы с заданной стехиометрией и морфологией. Поэтому ведутся поиски прямозонных материалов, которые могли бы быть встроены в Si-матрицу в едином технологическом процессе. К таким материалам относятся силициды железа. Среди известных силицидов железа α-, β- и γ-фазы [1] полупроводниковыми свойствами и прямозонной структурой может обладать только кристаллическая фаза β-FeSi2. Этот дисилицид железа является квазипрямозонным полупроводником с шириной запрещенной зоны 0.86 эВ [2] (что близко к минимуму поглощения в кварцевом оптоволокне), который в случае упругого сжатия кристаллической решетки становится прямозонным полупроводником [3].
В первых экспериментах для построения в интегральном исполнении свето- и фотодиодов, работающих в диапазоне длин волн 1.3–1.6 мкм, были синтезированы тонкопленочные гетеросистемы β-FeSi2–подложка Si(001) [4] и тройные гетеросистемы со встроенным в активную область p–n-перехода тонким слоем (∼1 мкм) дисилицида железа p-Si–β-FeSi2–n-Si [5]. Однако из-за высокой плотности дефектов структуры и, как следствие, высокой плотности центров безызлучательной рекомбинации достичь требуемых приборных параметров не удалось. Решить эту проблему пытались путем встраивания в активную область кремниевого p–n-перехода не сплошных тонких слоев, а квазипрямозонных нанокристаллов (НК) β-FeSi2 [6, 7]. Было показано, что электролюминесценция в этих гетеросистемах связана с излучательной рекомбинацией электронов, инжектированных из кремния n-типа, с дырками, находящимися в нанокристаллах β-FeSi2, и локализованных в области кремниевого p–n перехода. Однако эффективность светоизлучения полученных приборов с НК была недостаточна для использования в оптоволоконных системах по причине малой объемной доли НК и высокой плотности центров безызлучательной рекомбинации, связанных с дефектами структуры. Кроме того, она уменьшалась при комнатной температуре в несколько сот и даже тысяч раз [8] из-за высокой концентрации точечных и линейных дефектов структуры, избавиться от которых можно только отжигом при температуре 900°C, что несовместимо с интегральной технологией.
Для создания высокоэффективных оптоэлектронных устройств на основе НК β-FeSi2, встроенных в матрицу Si, должны быть решены следующие научно-технологические задачи, касающиеся структурно-морфологических особенностей таких гетеросистем:
– создание однородного распределения НК по размерам при максимально высокой концентрации их в матрице Si. При этом необходимо обеспечить высокое кристаллическое качество как НК β-FeSi2, так и матрицы Si;
– реализация условий прямого межзонного перехода, так как β-FeSi2 по своей природе является непрямозонным полупроводником. При этом размер НК β-FeSi2 должен быть минимально возможным для увеличения силы оптического осциллятора межзонного перехода за счет квантово-размерного ограничения.
Мировой опыт в решении обозначенных задач связан в основном с реализацией механизма самоорганизации, которая является мощным инструментом для получения нанообъектов с заданной дисперсией по размерам. Однако это оказалось применимым только в случае незарощенных НК β-FeSi2 [9]. Закрытие НК β-FeSi2 покрывающим слоем Si (т.е. внедрение НК β-FeSi2 в объем матрицы Si) вызывает ряд негативных последствий: фазовый переход из полупроводникового в металлический силицид железа, коалесценцию НК β-FeSi2, приводящую к увеличению их размера и к релаксации упругих напряжений, “всплытие” НК к поверхности покрывающего слоя Si [10, 11].
Наиболее полные комплексные исследования, направленные на решение указанных научно-технологических проблем при создании высокоэффективных оптоэлектронных устройств на основе НК β-FeSi2, встроенных в матрицу Si, выполнены в тесном сотрудничестве Института автоматики и проблем управления ДВО РАН (ИАиПУ ДВО РАН) с Институтом физики полупроводников им. А.В. Ржанова СО РАН (ИФП СО РАН) в период с 2007 по 2019 годы [11–20, 25–27]. В настоящей работе систематизирована часть структурных данных, полученных в ИФП СО РАН с помощью аналитической высокоразрешающей электронной микроскопии (ВРЭМ) и касающихся особенностей атомной структуры, морфологии и пространственного распределения НК силицидов железа на поверхности и в кристаллической матрице Si.
ЭКСПЕРИМЕНТАЛЬНАЯ ЧАСТЬ
Гетеросистемы с НК β-FeSi2 выращивали на подложках, вырезанных из Si-пластин n-проводимости с ориентацией (001) и (111), в сверхвысоковакуумной камере фирмы VARIAN [12, 13]. Для получения атомарно-чистой поверхности подложку несколько раз кратковременно (около 1 с) прогревали при температуре 1250°C, вакуум в камере был не хуже 10–9 Торр. Слои с НК формировали двумя методами: комбинацией реактивной и твердофазной эпитаксии (РЭ + ТФЭ) (M1) и методом твердофазной эпитаксии (ТФЭ) (M2). Выращивали и анализировали трехслойные (Si-силицид–Si-подложка) и многослойные ((Si–силицид) × N–Si-подложка) гетеросистемы, где N – количество циклов формирования НК и последующего эпитаксиального заращивания их слоями кремния p-проводимости. Рост покрывающих слоев Si р-проводимости выполнялся методом молекулярно-лучевой эпитаксии (МЛЭ) при температуре подложки от 600 до 800°C. Толщины этих слоев во всех экспериментах составляли ~100 нм. Железо осаждалось из вольфрамовой спирали на атомарно-чистую поверхность. Скорость осаждения железа составляла 0.0033–0.02 нм/с (0.1 нм Fe соответствует покрытию 1.25 монослоя на поверхности Si(111) или плотности атомов 9.75 × 1014 см–2). Эксперименты по росту были выполнены сотрудниками лаборатории Оптики и электрофизики ИАиПУ ДВО РАН.
Исследования структуры и морфологии НК β-FeSi2 проводили методом ВРЭМ на микроскопах JEOL-4000EX и FEI-TITAN 80–300 при ускоряющих напряжениях 400 и 300 кВ соответственно. Поперечные срезы по плоскостям (110) для ВРЭМ-исследований препарировали по стандартной методике, включающей в себя шлифовку, полировку и ионное травление на заключительной стадии утонения, а планарные фольги (001) или (111) (plan-view) – методом химического струйного травления со стороны подложки. Цифровую обработку экспериментальных ВРЭМ-изображений проводили с использованием коммерческого пакета программ GMS-2.3.2 (Gatan) и разработанных в [14] скриптов для количественного анализа ВРЭМ-изображений. Эпитаксиальные соотношения и параметры решетки НК определяли на основе анализа спектров быстрого преобразования Фурье (БПФ) от отдельных частей ВРЭМ-изображений.
РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
Начальные стадии формирования дисилицида железа на Si(111). Согласно [15, 16] островки дисилицида железа β-FeSi2 размером 30–80 нм формируются на атомарно-чистой поверхности Si(111) в процессе реактивной эпитаксии (М1) при толщинах железа 0.2–0.5 нм и скорости осаждения ~0.01 нм/c. В [11, 17] синтез НК силицида железа проводили на атомарно-чистой поверхности Si(111) в процессе ТФЭ (М2) и последующей МЛЭ кремния. Технологическая схема этих экспериментов состояла из следующих операций:
1) высокотемпературная очистка поверхности подложки при Т = 1250°С;
2) МЛЭ кремния для формирования буферного слоя толщиной 100 нм при Т = 750°С, оптимальной для гомоэпитаксии Si на поверхности (111) [17];
3) осаждение пленки Fe толщиной 0.4 нм при Т = 25°С;
4) отжиг при Т = 630°С в течение 20 мин для активации ТФЭ β-FeSi2 [18];
5) отжиг при Т = 750°С в течение 90 мин;
6) МЛЭ кремния для формирования покрывающего слоя толщиной 25–300 нм при Т = 750°С.
В настоящей работе систематизированы данные ВРЭМ о структуре НК силицидов железа на начальных стадиях их синтеза. Впервые обнаружено, что после осаждения Fe (0.4 нм) на подложку Si при комнатной температуре и последующего отжига при Т = 630°С формируются две фазы: β-FeSi2, примыкающая к подложке Si, и ε-FeSi поверх нее. То есть обе фазы могут присутствовать в одном НК (рис. 1). Фаза ε-FeSi имеет кубическую кристаллическую решетку с параметром ячейки a = 0.4479 нм (пр. гр. P21/3). Фаза β-FeSi2 имеет орторомбическую кристаллическую решетку с параметрами ячейки: a = 0.9879, b = 0.7799, c = 0.7838 нм (пр. гр. Cmca).
Рис. 1.
ВРЭМ-изображение поперечного среза (11$\bar {2}$), на вставке – соответствующий фурье-спектр НК ε-FeSi (1) и β-FeSi2 на поверхности Si(111) (2). На БПФ большие окружности соответствуют рефлексам Si для полюса [11$\bar {2}$]; маленькие – ε-FeSi для полюса [01$\bar {1}$]; кресты – β-FeSi2 для полюса [0$\bar {1}$4].

Отсутствие Si в необходимом количестве затрудняет переход ε-FeSi в β-FeSi2 во время ТФЭ тонкого слоя железа при сравнительно низкой температуре Т = 630°С. Увеличение температуры до 750°C без осаждения Si приводит к образованию фазы α-FeSi2 (рис. 2):
Рис. 2.
ВРЭМ-изображение поперечного среза Si(1$\bar {1}$0), на вставке – соответствующий фурье-спектр НК α-FeSi2 на сингулярной поверхности Si(111). На БПФ окружности соответствуют рефлексам Si для полюса [1$\bar {1}$0]; треугольники – α-FeSi2 для полюса [0$\bar {2}$1].

Фаза α-FeSi2 имеет тетрагональную кристаллическую решетку с параметрами ячейки: а = b = = 0.2684, с = 0.5128 нм (пр. гр. P4mmm).
Измерения межплоскостных расстояний на картах БПФ (рис. 2, вставка) обнаруживают деформацию растяжения кристаллической решетки НК α-FeSi2, величина которой в направлении параметра с составляет ∼13%. Этот факт существенно повышает внутреннюю энергию гетеросистемы и делает эту фазу энергетически невыгодной. Поэтому при увеличении температуры до 750°C в присутствии молекулярного потока кремния все НК трансформируются в структуру β-FeSi2 даже после осаждения всего 25 нм кремния (рис. 3a):
Рис. 3.
ВРЭМ-изображения поперечных срезов Si(1$\bar {1}$0) НК β-FeSi2, заглубленных в Si-матрицу после напыления покрывающего слоя толщиной 25 (a) и 300 нм (б) и соответствующий фурье-спектр (на вставке). На БПФ большие окружности соответствуют рефлексам Si для полюса [1$\bar {1}$0]; маленькие – β-FeSi2 для полюса [11$\bar {1}$].
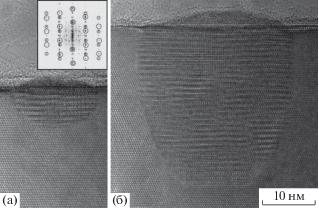
Формирование фазы β-FeSi2 более предпочтительно с энергетической точки зрения, так как возникают гораздо меньшие деформации кристаллических решеток сопрягаемых материалов. Более подробно деформации НК β-FeSi2 рассмотрим ниже.
После осаждения 300 нм кремния почти все НК β-FeSi2 практически полностью замурованы в матрицу Si (рис. 3б).
Отметим, что представленные выше результаты касаются формирования НК на сингулярной поверхности Si(111). Если проводить синтез на вицинальной поверхности Si(111), отклоненной на 3°–4° вокруг оси 〈110〉, то в аналогичных условиях синтеза методом ТФЭ при Т = 630°С и эффективной толщине пленки Fe около 1 нм, первоначально нанесенной при Т = 25°С на вицинальную поверхность Si (111), первой и единственной фазой силицида железа является фаза α-FeSi2 [19, 20]. Структурно-морфологические особенности НК α-FeSi2 на вицинальной поверхности Si представлены на рис. 4.
Рис. 4.
Нанокристаллы α-FeSi2 на вицинальной поверхности Si(111): темнопольное plan-view (111) изображение в рефлексе (112) (а); ВРЭМ-изображения поперечных срезов (1$\bar {1}$0) (б, в).

По данным электронной микроскопии plan-view фольг на вицинальной поверхности подложки Si(111) формируются квазиодномерные НК (наностержни) с анизотропной формой, покрывающие примерно 54–65% площади подложки (рис. 4а). Размер НК в направлении [1$\bar {1}$0], параллельном оси отклонения подложки от сингулярной поверхности, варьируется от 30 до 230 нм, а в перпендикулярном направлении [112] – от 8 до 30 нм. Линейная плотность вдоль направления [110] варьируется в диапазоне 10–15 мкм–1.
Исследования поперечных срезов показали, что предпочтительными местами зарождения НК являются ступени на поверхности Si-подложки (рис. 4б, 4в). При размере гладкой террасы ∼20–50 нм формируются НК с поперечным размером 8–12 нм (рис. 4б), а при относительно большом размере террасы размер НК составляет ∼30 нм (рис. 4в). В первом случае форма НК в поперечном сечении близка к треугольной с высотой от 3 до 6 нм, во втором случае НК имеют форму вытянутой трапеции высотой ∼2.5 нм.
Анализ атомной структуры НК подтвердил, что формируются НК α-FeSi2 с тетрагональной кристаллической решеткой, сопряженной с решеткой Si таким образом, что направления [0$\bar {2}$1]α-FeSi2 || [1$\bar {1}$0]Si и плоскости (112) α-FeSi2 || (111) Si (рис. 5). При этом тетрагональная кристаллическая решетка НК сжата примерно на 1.19% в направлении параметров решетки а, b и растянута на ∼13% в направлении параметра с. Это приводит к увеличению объема элементарной ячейки на ∼10.3%.
Рис. 5.
ВРЭМ-изображение (a), соответствующий фурье-спектр (б) и схема распределения пространственных частот (аналог дифракционных рефлексов) (в) для кристаллических решеток Si (кружки) и α-FeSi2 (треугольники).

Важной особенностью гетеросистемы, синтезированной методом ТФЭ, является отсутствие каких-либо переходных слоев между НК и подложкой и следов проникновения Fe в Si-решетку, что ранее обычно наблюдалось для наноразмерных силицидов железа различного состава [21, 22]. Следовательно, образование НК α-FeSi2 анизотропной формы на вицинальной поверхности Si(111) обусловлено анизотропией поверхностной диффузии атомов Si вдоль и поперек эшелонов ступеней.
Структурно-морфологические особенности многослойных гетеросистем (Si–β-FeSi2–Si) × N-Si(111). Одним из способов повышения эффективности светоизлучения оптоэлектронных устройств на основе НК β-FeSi2 является увеличение объемной доли НК в матрице кремния путем синтеза многослойных систем без внесения каких-либо дефектов структуры, создающих дополнительные центры безызлучательной рекомбинации.
Выше приведена последовательность шести технологических операций для формирования одного слоя НК β-FeSi2, покрытого кремнием. Для формирования многослойной гетеросистемы операции 3–6 повторяются необходимое количество раз.
Отметим различия гетеросистем с НК β-FeSi2, синтезированных на подложках Si(001) и Si(111). Кристаллическое строение НК в обеих системах одинаково (рис. 6a, 7a), а морфология и их расположение в матрице различны.
Рис. 6.
ВРЭМ (a) и ПЭМ (б) изображения поперечных срезов Si(1$\bar {1}$0) НК β-FeSi2 в Si-матрице, синтезированных методом ТФЭ на подложке Si(001).

Рис. 7.
ВРЭМ (a) и ПЭМ (б) изображения поперечных срезов Si(1$\bar {1}$0) НК β-FeSi2 в Si-матрице, синтезированных методом ТФЭ на подложке Si(111).

При росте на поверхности Si(001) большинство НК имеет вытянутую форму и сопряжено с матрицей кремния по наклонным плоскостям Si{111} (рис. 6). При синтезе на поверхности Si(111) габитус всех НК ориентирован перпендикулярно ростовой поверхности, а боковые грани НК сопрягаются с плоскостями Si{110} (рис. 7). Более подробно сопряжение кристаллических решеток Si и β-FeSi2 рассмотрим ниже. Отметим, что некоторые НК в матрице Si(111) являются центрами зарождения микродвойниковых ламелей, распространяющихся в матрице Si по наклонным плоскостям {111} и прорастающих на поверхность гетероструктуры (рис. 7б, 8a). При этом образование микродвойниковых ламелей происходит в системах, выращенных как методом ТФЭ, так и МЛЭ. Пример четырехслойной гетеросистемы с НК β-FeSi2 показан на рис. 8.
Рис. 8.
ПЭМ- (а) и ВРЭМ-изображения (б) поперечных срезов Si(1$\bar {1}$0) четырехслойной гетеросистемы с НК β-FeSi2 в Si-матрице, синтезированными методом МЛЭ на подложке Si(111).
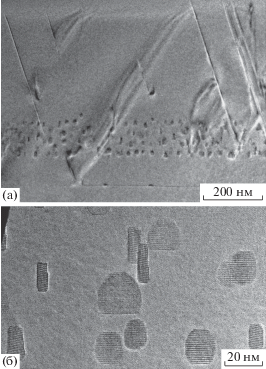
На рис. 8а отчетливо видно, что местами зарождения микродвойниковых ламелей являются некоторые НК.
Еще одна особенность пространственного распределения НК в матрице, визуализируемая на ВРЭМ-изображениях поперечных срезов многослойных гетеросистем, заключается в так называемом эффекте “всплытия” НК. Не все НК локализуются в планарных слоях, в которых они зарождались. Часть из них по мере напыления покрывающих слоев Si проникает (“всплывает”) в эти слои. На рис. 8б видно, что НК не формируют четырех четко разделенных слев. Напротив, слои перемешаны, что указывает на перемещение НК в процессе формирования гетеросистемы. Величина “всплытия” зависит от температуры эпитаксии покрывающих слоев Si. Ранее подобное явление наблюдалось только для системы Si/НК–CrSi2/Si [23]. Процесс “всплытия” НК β-FeSi2 происходит за счет ускоренной диффузии атомов Si по ростовой поверхности и гетерограницам НК–Si. Вследствие этого Si начинает расти под НК β-FeSi2, продвигая его к поверхности. Установлено, что процесс “всплытия” зависит от ориентации подложки, концентрации дефектов и температуры роста Si.
Наблюдаемые на рис. 8б НК можно поделить на два типа. Нанокристаллы типа 1 – большие широкие НК (рис. 9а). Характерное для них расположение рефлексов на картине БФП представлено на рис. 9б.
Рис. 9.
ВРЭМ-изображение НК β-FeSi2 типа 1 (а) и соответствующий фурье-спектр пространственных частот (б). Подчеркнутым курсивом выделены рефлексы, соответствующие β-FeSi2, без подчеркивания – Si.

Из рисунка видно, что для НК типа 1 выполняются следующие эпитаксиальные соотношения: β-FeSi2[$\bar {1}$$\bar {1}$$\bar {1}$] || Si[$\bar {1}$10] и β-FeSi2(2$\bar {2}$0) || Si(111). Такие эпитаксиальные соотношения обычно наблюдаются только для НК β-FeSi2, встроенных в Si(111) при ТФЭ [11]. Для НК β-FeSi2, растущих на поверхности Si(111) при МЛЭ, характерны иные эпитаксиальные соотношения [24]. Из анализа межплоскостных расстояний, указанных на картине БФП на рис. 9б, получены постоянные кристаллической решетки НК типа 1: a = 10.458, b = 7.799, c = 7.643 Å. Поскольку для релаксированного кристалла β-FeSi2 постоянные решетки a = 9.863, b = 7.791, c = 7.833 Å, можно констатировать, что рассматриваемый НК β-FeSi2 в направлении β-FeSi2[100] растянут на 6.03%, в направлении β-FeSi2[010] растянут на 0.1% и сжат на 2.42% в направлении β-FeSi2[001].
Нанокристаллы типа 2 – длинные узкие НК, размер которых в направлении роста в несколько раз больше их ширины. Типичное ВРЭМ-изображение такого НК представлено на рис. 10а, соответствующий спектр пространственных частот БПФ – на рис. 10б.
Рис. 10.
ВРЭМ-изображение НК β-FeSi2 типа 2 (а) и соответствующий фурье-спектр пространственных частот (б).

Из анализа картины БПФ установлены эпитаксиальные соотношения между НК β-FeSi2 типа 2 и матрицей кремния: β-FeSi2[001] || Si[$\bar {1}$10] и β-FeSi2(2$\bar {2}$0) || Si(111). Согласно [24] такие эпитаксиальные соотношения наблюдаются для НК β-FeSi2, растущих на поверхности Si(111). Для НК β-FeSi2, встроенных в Si(111), они наблюдаются впервые. По-видимому, такой НК β-FeSi2 при встраивании в Si-матрицу сохранил ориентацию, которая была у него на поверхности Si(111).
Для НК β-FeSi2 типа 2 (рис. 10а) из картины БФП определены межплоскостные расстояния и вычислены постоянные решетки: a = 10.597, b = = 7.667 Å. Третью постоянную решетки для оси зоны β-FeSi2[001] определить невозможно, так как в этом случае она перпендикулярна плоскости ВРЭМ-изображения. Поэтому можно установить деформацию рассматриваемого НК β-FeSi2 для двух направлений. В направлении β-FeSi2[100] рассматриваемый НК растянут на 7.44% и сжат на 1.59% в направлении β-FeSi2[010].
С помощью данных ВРЭМ и фотолюминесценции в [25, 26] были выполнены расчеты электронной структуры НК β-FeSi2. Установлено, что фундаментальный переход из непрямозонного в прямозонное электронное состояние связан с упругой деформацией кристаллической решетки НК β-FeSi2 диаметром более ∼10 нм.
ЗАКЛЮЧЕНИЕ И ВЫВОДЫ
Методом ВРЭМ детально изучены все стадии трансформации кристаллической структуры нанокристаллов силицида железа на атомарно-чистой сингулярной поверхности Si(111) при варьировании условий синтеза. Установлено, что в результате твердофазной эпитаксии тонких слоев железа (0.4 нм при 630°C) образуются НК со структурой ε-FeSi и β-FeSi2. Эти фазы часто сосуществуют в одних и тех же НК. Дополнительный отжиг при 750°C в течение 90 мин приводит к превращению НК ε-FeSi и β-FeSi2 в НК α-FeSi2. Если проводить такой отжиг в потоке атомов Si, то все НК трансформируются в НК со структурой β-FeSi2.
Показано, что при синтезе на вицинальной поверхности Si(111), отклоненной на 3°–4° вокруг оси 〈110〉 методом ТФЭ при Т = 630°С и эффективной толщине пленки Fe около 1 нм, первоначально нанесенной при Т = 25°С на вицинальную поверхность Si(111), первой и единственной фазой силицида железа является фаза α-FeSi2 [19, 20]. Установлены структурно-морфологические особенности НК α-FeSi2 на этой вицинальной поверхности.
Исследованы морфология и пространственное распределение НК β-FeSi2 в многослойных гетеросистемах, сформированных на Si(001) и Si(111). Обнаружены два типа НК β-FeSi2, различающихся анизотропией формы и характером сопряжения с матрицей кремния. Средний размер НК типа 1 в зависимости от условий синтеза варьируется примерно от 15 до 25 нм во всех направлениях, а НК типа 2 имеют размер в направлении роста ∼20 нм, а ширину ∼5 нм. Выполнены оценки упругих деформаций НК β-FeSi2 обоих типов. Установлено, что кристаллическая решетка НК типа 1 растянута в направлениях [100] и [010] примерно на 3% и сжата в направлении [001] на 1%. Для НК типа 2 характерно растяжение кристаллической решетки в направлении [100] примерно на 7.0% и сжатие в направлении [010] на 1.6%.
Результаты ВРЭМ-исследований были использованы в ИАиПУ ДВО РАН при разработке и создании тестовых диодных структур на основе многослойных гетеросистем p-Si–НК β-FeSi2–n-Si [27]. Квантовая эффективность этих диодов при нулевом смещении составила ∼0.2%, а удельная обнаружительная способность 1.2 × 109 смГц1/2/Вт на длине волны 1300 нм при комнатной температуре. В режиме лавинного пробоя чувствительность доходила до 20 мА/Вт за счет пятикратного лавинного усиления. Кроме этого, анализ спектральных данных показал, что встроенные в обедненную область р–n-перехода НК β-FeSi2 расширяют спектральную чувствительность диодов вплоть до 1700 нм и увеличивают ток фотопроводимости более чем на 2 порядка величины по сравнению с обычными кремниевыми p–n-переходами, что является мировым достижением в области Si-фотодетекторов на данную область спектра.
Авторы выражают благодарность сотрудникам ИАиПУ ДВО РАН Н.Г. Галкину, Д.Л. Горошко, Е.А. Чусовитину, А.В. Шевлягину за актуальную постановку задач, обеспечение уникальными объектами исследований и плодотворное обсуждение полученных результатов.
Работа выполнена при поддержке Российского научного фонда (проект 19-72-30023).
Список литературы
Smith R.A. // Semiconductors. Cambridge: Cambridge University, 1978. 170 p.
Bost M.C., Mahan J. // J. Appl. Phys. 1988. V. 64. P. 2034. https://doi.org/10.1063/1.341735
Miglio L., Malegori G. // Phys. Rev. B. 1995. V. 52. № 3. P. 1448. https://doi.org/10.1103/PhysRevB.52.1448
Izumi S., Shaban M., Promos N. et al. // Appl. Phys. Lett. 2013. V. 102. P. 032107. https://doi.org/10.1063/1.4789391
Suzuno M., Koizumi T., Suemasu T. // Appl. Phys. Lett. 2009. V. 94. P. 213509. https://doi.org/10.1063/1.4789391
Suemasu T., Ugajin Y., Murase S. et al. // J. Appl. Phys. 2007. V. 101. P. 124506. https://doi.org/10.1063/1.2749200
Spinella C., Coffa S., Bongiorno C. et al. // Appl. Phys. Lett. 2000. V. 76. P. 173. https://doi.org/10.1063/1.125693
Ishimaru M., Omae K., Bae I.-T. et al. // J. Appl. Phys. 2006. V. 99. P. 113. https://doi.org/10.1063/1.2201729
Lal C., Dhunna R., Dhaka R.S. et al. // J. Optoelectron. Adv. Mater. 2010. V. 12. № 2. P. 17710.
Sakane S., Isogawa M., Watanabe K. et al. // J. Vac. Sci. Technol. A. 2017. V. 35. № 4. P. 041402. https://doi.org/10.1116/1.4984107
Chusovitin E.A., Goroshko D.L., Dotsenko S.A. et al. // JJAP Conf. Proc. 2017. V. 5. P. 011401. https://doi.org/10.7567/JJAPCP.5.011401.
Галкин Н.Г., Горошко Д.Л., Полярный В.О. и др. // Физика и техника полупроводников. 2007. Т. 41. № 9. С. 1085.
Galkin N.G., Goroshko D.L., Polyarnyi V.O. et al. // Thin Solid Films. 2007. V. 515. P. 7805. https://doi.org/10.1016/j.tsf.2007.04.019
Гутаковский А.К., Чувилин А.Л., Song S. A. // Изв. РАН. Сер. физ. 2007. Т. 71. № 10. С. 1464. https://doi.org/10.3103/S1062873807100267
Dotsenko S.A., Galkin N.G., Koval’ L.V. et al. // J. Surf. Sci. Nanotech. 2006. V. 4. P. 319. https://doi.org/10.1142/9789812701947_0070
Wang L., Lin C., Shen Q. et al. // Appl. Phys. Lett. 1995. V. 66. P. 3453. https://doi.org/10.1063/1.113385
Zeindl H.P., FuenzalidaV., Messarosch J. et al. // J. Cryst. Growth. 1987. V. 81. P. 231. https://doi.org/10.1016/0022-0248(87)90397-6
Raunau W., Niehus H., Comsa G. // Surf. Sci. Lett. 1993 V. 284. P. L375. https://doi.org/10.1016/0167-2584(93)90960-Q
Galkin K.N., Goroshko D.L., Chusovitin E.A. et al. // Proseedings of ASCO-NANOMAT 2018, FEFU, Vladivostok, Russia, 2018. P. 140.
Galkin N.G., Galkin K.N. Dotsenko S.A. et al. // Key Engineering Materials, 2019806 KEM, P. 30. https://doi.org/10.4028/www.scientific.net/KEM.806.30.
Das D., Mahato J.C., Bisi B. et al. // Appl. Phys. Lett. 2014. V. 105 P. 191606. https://doi.org/10.1063/1.4901815
Peng Zu-Lin, Liang S., Deng Luo-Genv // Chin. Phys. Lett. 2009 V. 26. P. 127301. https://doi.org/10.1088/0256-307X/26/12/127301
Galkin N.G., Chusovitin E.A., Dozsa L. et al. // Appl. Surf. Sci. 2010. V. 256. P. 7331. .https://doi.org/10.1016/j.apsusc.2010.05.025
Migas D.B., Miglio L. // Phys. Rev. B. 2000. V. 62. P. 11063. V. 62. P. 11063.https://doi.org/10.1103/PhysRevB
Shevlyagin A.V., Goroshko D. L., Chusovitin E. A et al. // J. Appl. Phys. 2017. V. 121. P. 113101. https://doi.org/10.1063/1.4978372
Shevlyagin A.V., Goroshko D.L., Chusovitin E.A. et al. // Proceedings of International Conference on Metamaterials and Nanophotonics (METANANO-2017), AIP Conf. Proc. 1874, 030007-1–030007-5.https://doi.org/10.1063/1.4998036.
Shevlyagin A.V., GoroshkoD.L., Chusovitin E.A. et al. // Sci. Rep. 2015. V. 10. V. 5. P. 14795. https://doi.org/10.1038/srep14795
Дополнительные материалы отсутствуют.
Инструменты
Кристаллография


