Кристаллография, 2021, T. 66, № 4, стр. 528-539
In situ отражательная электронная микроскопия для анализа процессов на поверхности кремния: сублимации, электромиграции, адсорбции примесных атомов
Д. И. Рогило 1, *, С. В. Ситников 1, Е. Е. Родякина 1, А. С. Петров 1, С. А. Пономарев 1, Д. В. Щеглов 1, Л. И. Федина 1, А. В. Латышев 1
1 Институт физики полупроводников им. А.В. Ржанова СО РАН
Новосибирск, Россия
* E-mail: rogilo@isp.nsc.ru
Поступила в редакцию 28.05.2020
После доработки 28.05.2020
Принята к публикации 15.06.2020
Аннотация
Представлены результаты недавних исследований структурно-морфологических трансформаций поверхностей Si(111) и Si(100) методом in situ сверхвысоковакуумной отражательной электронной микроскопии. Обнаружено, что высокотемпературная сублимация с экстремально широких террас Si(111) происходит с меньшей энергией активации (3.77 эВ), чем с вицинальной поверхности (4.04 эВ). Зарегистрировано немонотонное изменение кинетики эшелонирования атомных ступеней в условиях плавного перехода от сублимации к росту на поверхности Si(100). Продемонстрированы структурные трансформации, вызванные электромиграцией положительно заряженных адатомов олова на реконструированной поверхности Si(111). Показано, что при воздействии молекулярного пучка селена травление поверхности Si(111) происходит в послойном режиме за счет десорбции молекул SiSe2 с энергией активации 2.65 эВ.
ОГЛАВЛЕНИЕ
Введение
1. Метод и подходы
2. Экстремально широкие террасы на поверхностях Si(111) и Si(100) при сублимации
3. Эшелонирование атомных ступеней на поверхностях Si(111) и Si(100)
4. Адсорбция и электромиграция олова на поверхности Si(111)
5. Травление поверхности Si(111) молекулярным пучком селена
Заключение
ВВЕДЕНИЕ
Одним из основных методов создания низкоразмерных полупроводниковых структур для современной электроники и фотоники является молекулярно-лучевая эпитаксия [1]. Ключевую роль в обеспечении предельных характеристик рабочих структур играет прецизионный контроль атомных процессов, происходящих на поверхности кристалла и в приповерхностном слое на всех стадиях создания структуры [2]. При этом значительное влияние на структурно-морфологическое совершенство эпитаксиальных слоев оказывают процедуры подготовки подложки, поскольку даже отдельные атомные ступени могут способствовать формированию протяженных дефектов в пленке [3], а концентрация, ориентация и распределение ступеней оказывают значительное влияние на шероховатость поверхности при гомоэпитаксии [4] и равномерность зарождения пленки при гетероэпитаксии [5]. В связи с этим востребованы методы, способные диагностировать трансформации структуры и морфологии поверхности непосредственно в процессе подготовки подложки и разнообразных обработок (роста, травления, адсорбции примесных атомов и других) в широком диапазоне температур. Методом in situ просвечивающей электронной микроскопии высокого разрешения показана возможность получения важной информации о движении атомных ступеней в процессе эпитаксиального роста нановискеров GaAs и о структурных переходах на границе с каталитической каплей Au [6]. Для изучения в реальном времени атомных процессов на пространственных масштабах, сопоставимых с размерами подложки, эффективным методом является in situ сверхвысоковакуумная отражательная электронная микроскопия [7]. Данный метод обладает достаточной чувствительностью для анализа структуры поверхности подложки и визуализации ее морфологии на уровне моноатомных ступеней и в то же время является универсальным, позволяя проводить in situ экспериментальные исследования широкого спектра процессов на поверхности кристалла, обеспечивая их наблюдение в реальном времени. В данной работе представлены результаты недавних исследований процессов на поверхности Si(111) и Si(100) при сублимации, гомоэпитаксиальном росте, осаждении Au, Sn и Se.
1. МЕТОД И ПОДХОДЫ
Метод отражательной электронной микроскопии (ОЭМ) был предложен в одно время с просвечивающей электронной микроскопией изобретателем и нобелевским лауреатом Эрнстом Руска [8]. Основным ограничением развития ОЭМ в то время стали вакуумные условия вблизи образца (∼10–4 Па), при которых поверхность под диагностирующим электронным пучком зарастала пленкой углеродсодержащих соединений, не позволявшей исследовать процессы на поверхности. Первоначально в ОЭМ использовался теневой контраст диффузно рассеянных электронов от рельефа поверхности, что не позволяло достичь высокого пространственного разрешения. Развитие сверхвысоковакуумных (СВВ) технологий [9] позволило использовать брэгговские пучки для получения изображения [10], что значительно улучшило разрешение метода.
Метод СВВ ОЭМ, входящий в состав ЦКП “Наноструктуры” (г. Новосибирск, Россия), рассчитан на проведение in situ-исследований процессов морфологических трансформаций поверхности кристаллов при сублимации (вплоть до температуры плавления подложки), гомо- и гетероэпитаксиальном росте, осаждении металлов (Au, Sn и других), взаимодействии с газовой атмосферой [7]. Метод позволяет получать как картины дифракции быстрых электронов на отражение (100 кэВ), так и электронно-микроскопические изображения в брэгговском контрасте, что обеспечивает высокую чувствительность к структуре поверхности, позволяет визуализировать атомные ступени на поверхности кристаллов [11] и области с разной сверхструктурной реконструкцией [12]. Особенностью изображения, получаемого методом СВВ ОЭМ, является сильное сжатие (∼50 раз) в направлении падения электронного пучка при латеральном разрешении в перпендикулярном направлении ∼30 нм. На рис. 1а и 1б представлены ОЭМ-изображения вицинальных поверхностей Si(111) и Si(100) соответственно, содержащих регулярные атомные ступени. На поверхности Si(111) атомная ступень является би-слойной и обладает высотой 0.31 нм, при этом край ступени имеет достаточно сильный деформационный потенциал, что позволяет визуализировать отдельные атомные ступени, используя основные брэгговские рефлексы. На рис. 1а тонкие линии темного контраста являются атомными ступенями. На поверхности Si(100) атомная ступень является монослойной с высотой 0.14 нм, а деформация на краю ступени крайне мала из-за наличия сверхструктурной реконструкции 1 × 2. Для визуализации атомных ступеней использовали сверхструктурный рефлекс, а так как смежные террасы Si(100), разделенные атомной ступенью, характеризуются наличием сверхструктур 1 × 2 и 2 × 1 [13], то атомной ступенью на ОЭМ-изображении (рис. 1б) является граница между светлым и темным контрастом.
Рис. 1.
ОЭМ-изображения вицинальной поверхности Si(111) (а) и Si(100) (б) с регулярными атомными ступенями. Изображение б получено в сверхструктурном рефлексе.

Для проведения in situ экспериментальных исследований методом СВВ ОЭМ использовали образцы размером 8 × 1.1 × 0.3 мм, вырезанные из пластин кремния с отклонением поверхности от грани (111) или (100) на угол <0.1°. Перед экспериментом образцы очищали химически. Осаждение материалов (Si, Sn и других) осуществляли из специально разработанных заменяемых испарителей. Нагрев образца осуществляли посредством пропускания через него постоянного или переменного электрического тока. Для очистки образца от естественного оксида перед началом экспериментов проводили кратковременный отжиг (<10 мин) при температурах выше 1300°С. После окончания экспериментов образцы быстро охлаждали до комнатной температуры и проводили детальный анализ морфологии их поверхности методом ex situ атомно-силовой микроскопии (АСМ).
2. ЭКСТРЕМАЛЬНО ШИРОКИЕ ТЕРРАСЫ НА ПОВЕРХНОСТЯХ Si(111) И Si(100) ПРИ СУБЛИМАЦИИ
Термический отжиг при высоких температурах является неотъемлемой частью процесса подготовки Si-подложек для последующей эпитаксии и сопровождается сублимацией атомов с поверхности. Как и гомоэпитаксиальный рост, процесс сублимации на поверхности кремния может происходить по двум механизмам: ступенчато-слоевому и двумерно-островковому. Первый хорошо изучен в начале 1990-х годов с применением метода СВВ ОЭМ [7, 14]. Второй механизм практически не реализовывается на поверхностях Si(111) и Si(100), так как длина миграции адатомов по террасе на данных поверхностях значительно больше, чем характерное расстояние между регулярными ступенями на вицинальной поверхности. Для увеличения расстояния между террасами и реализации двумерно-островкового механизма сублимации использовали метод формирования экстремально широких террас (диаметром 10–100 мкм), описанный в [15]. В процессе высокотемпературного отжига образца с углублением формируется система концентрических атомных ступеней, разделенных широкими террасами, по своей морфологии напоминающая древнегреческий амфитеатр. На рис. 2 представлены ОЭМ-изображения широких террас и атомных ступеней на поверхности Si(111) (рис. 2а) и Si(100) (рис. 2б, 2в) в момент сублимации, когда диаметр нижней террасы превышает критическое значение Dcrit и в центре зарождается вакансионный двумерный (2D) островок, а также температурные зависимости D$_{{crit}}^{2}$t(T) для обеих ориентаций (рис. 2г). Из-за сжатия ОЭМ-изображений широкие круглые террасы визуализируются в виде сильно сжатых эллипсов, выходящих за пределы изображения.
Рис. 2.
ОЭМ-изображения единичного вакансионного 2D-островка (короткие темные и белые отрезки) в центре экстремально широких террас Si(111) при 1150°C (a) и Si(100) при 1025°C (б, в). Временной интервал между б и в – 200 с. Температурные зависимости критического диаметра террас Si(111) и Si(100) для зарождения нового вакансионного 2D-островка в центре террасы (г). Температурные зависимости частоты сублимации ν на широких террасах Si(111) и Si(100) (д) и вицинальной поверхности Si(111) (е).
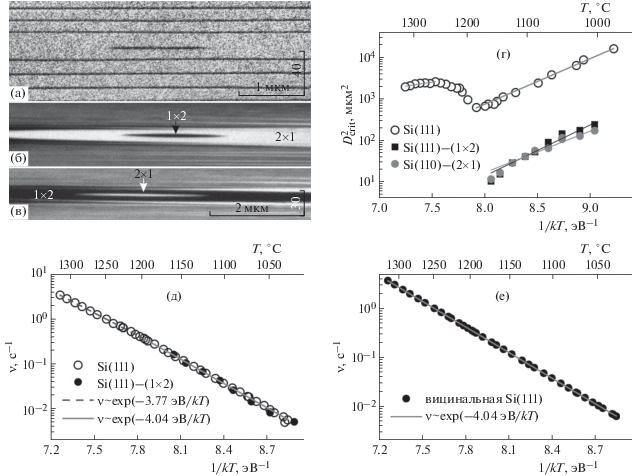
С использованием in situ СВВ ОЭМ и детального анализа АСМ-изображений впервые экспериментально получено распределение концентрации адатомов на круглой атомно-гладкой террасе диаметром 58 мкм [16]. Показано, что при T = 1000°С концентрация адатомов в центральной части террас имеет существенно меньшие значения (около 0.23 МС), чем равновесная концентрация вблизи ступеней (около 0.28 МС). На основе этих экспериментальных данных получено значение длины диффузии адатомов xs = 31 ± ± 2 мкм. В процессе сублимации диаметр террасы увеличивается, а концентрация адатомов в центре – уменьшается, что приводит к зарождению вакансионного 2D-островка по достижении критического диаметра террасы Dcrit, значения которого могут достигать ∼100 мкм (рис. 2г), чего достаточно для реализации двумерно-островкового зарождения в условиях эпитаксиального роста [17].
Температурные зависимости критических диаметров террас Si(111) и Si(100) D$_{{crit}}^{2}$t(T) (рис. 2г), при превышении которых в их центре происходит зарождение вакансионного островка, показывают, что в обоих случаях эти зависимости характеризуются одинаковым наклоном с эффективной энергией активации 2.6 ± 0.2 эВ вплоть до критических значений температур Тcrit ∼ 1130°C для Si(100) и Тcrit ∼ 1180°C для Si(111), выше которых появляются сильные неаррениусовские нелинейности. Можно видеть, что небольшие различия в активационной энергии наблюдаются для террас Si(100) со сверхструктурой 2 × 1 и 1 × 2. Для объяснения этого различия необходимо учитывать не только ориентацию димерных рядов относительно ступени и связанную с ней анизотропию диффузии адатомов, но и их поток на выше и ниже лежащую террасы, пропорциональный градиенту концентрации адатомов от ступени. Причем, как предсказывает расширенная теория Бартона–Кабреры–Франка (БКФ) [18], чем шире терраса, тем больше градиент концентрации и, соответственно, больше поток адатомов от ступени. В начальный момент времени, когда вакансионный 2D-островок мал, поток адатомов из ступени на верхнюю террасу будет больше, чем на нижнюю, и ускоренная диффузия вдоль димерных рядов на этой террасе обеспечит островку эллиптическую форму [19]. С увеличением размеров островка поток на нижнюю террасу начнет расти и обеспечит повышение скорости движения ступени в направлении, перпендикулярном димерным рядам. В результате вытянутый в начальный момент вакансионный островок будет уменьшать свою эллиптичность до тех пор, пока в центре не зародится новый вакансионный островок. Важно отметить, что с момента образования вакансионного островка концентрация адатомов в его центре будет определяться процессом их диффузии вдоль направления быстрой диффузии (вдоль димерных рядов). Поэтому Dcrit для зарождения нового островка на поверхности Si(100) определяется размером террасы 1 × 2 вдоль димерных рядов с энергией активации 2.6 ± 0.2 эВ.
Измерение Dcrit для Si(100) выше Т ≈ 1180°C становится невозможным из-за исчезновения контраста ступеней вследствие разупорядочения поверхности, чему предшествует множественное формирование вакансионных островков начиная с Тcrit ≈ 1130°C [19–22], и Dcrit, построенная в аррениусовских координатах, начинает отклоняться от линейной зависимости. В то же время при T > > 1180°C появляется сильная нелинейность D$_{{crit}}^{2}$(T) для поверхности Si(111). Появление участков нелинейности D$_{{crit}}^{2}$(T) на обеих террасах Si(111) и Si(100) с разницей всего 50°C указывает на общий характер их появления, связанный с началом интенсивной генерации вакансий. Оценка энергии активации в области нелинейности D$_{{crit}}^{2}$(T) для Si(100) имеет значение ∼10 эВ, тогда как по измерениям зависимости скорости движения ступени от ширины террасы [23] показывает ∼21 эВ. Для поверхности Si(111) нелинейность D$_{{crit}}^{2}$(Т) при Т > > 1180°C характеризуется энергией ∼6.2 эВ. Очевидно, что в обоих случаях в переходной области сублимация осуществляется за счет вклада десорбции адатомов, эмитируемых ступенью, и прямой десорбции атомов с террасы, при которой возникают поверхностные вакансии. На поверхности Si(111) сдвиг начала нелинейности на 50°C в область более высоких температур указывает на затрудненную генерацию вакансий (либо их повышенную рекомбинацию) по сравнению с поверхностью Si(100), однако количественные параметры генерации вакансий из этих нелинейностей вряд ли можно получить, используя современные теоретические подходы.
Как видно из рис. 2г, после резкого неаррениусовского роста в интервале Т = 1180–1250°C зависимость $D_{{crit}}^{2}$(Т) для террасы Si(111) начинает спадать пропорционально exp(–0.9 эВ/kT). Для анализа зависимости $D_{{crit}}^{2}$(Т) в интервале Т = 1250–1330°C воспользуемся модифицированной теоретической моделью скоростей зародышеобразования [24]:
С высокой точностью измерены температурные зависимости частоты сублимации для широких террас Si(111) и Si(100) (рис. 2д) и вицинальной поверхности Si(111) (рис. 2е). Можно видеть, что вплоть до Тcrit ∼ 1180°C скорости сублимации на обеих ориентациях совпадают и характеризуются энергией активации Esub = 4.04 эВ, а при T > > Tcrit, когда для поверхности Si(100) наступает разупорядочение, сублимация с поверхности Si(111) описывается энергией активации 3.77 эВ. В то же время, как следует из рис. 2е, на вицинальной поверхности Si(111) частота сублимации во всем интервале температур характеризуется Esub = 4.04 эВ. Таким образом, несмотря на многолетние экспериментальные исследования процесса сублимации с поверхности кристаллов, впервые показано, что при высоких температурах скорость сублимации зависит от локальной морфологии поверхности и на экстремально широких террасах данный процесс происходит медленнее.
3. ЭШЕЛОНИРОВАНИЕ АТОМНЫХ СТУПЕНЕЙ НА ПОВЕРХНОСТЯХ Si(111) И Si(100)
В процессе сублимации распределение атомных ступеней на вицинальных поверхностях кристалла не всегда остается регулярным. В частности при in situ-исследованиях поверхностей Si(111) и Si(100) при нагреве образца пропусканием постоянного электрического тока было обнаружено, что система регулярных атомных ступеней (рис. 3а) нестабильна и ступени перераспределяются в эшелоны близко расположенных ступеней, разделенных участками с пониженной плотностью атомных ступеней (рис. 3б) [27–30]. Эшелонирование происходит под действием электрического тока вследствие эффекта электромиграции – дрейфа адатомов, приобретающих эффективный электрический заряд в электрическом поле, вдоль тока [30–32]. В [30] показано, что для поверхности Si(111) существуют четыре температурных интервала, в которых распределение атомных ступеней различно. Два интервала, где эшелонирование ступеней вызывает ток, направленный в сторону лежащих ниже террас (830–1050 и 1250–1350°C), и два – где эшелонирование ступеней вызывается током, пропускаемым в противоположном направлении (1050–1250°C и > 1350°C) (рис. 3в). При этом эшелонирование ступеней является обратимым: при смене направления электрического тока либо пропускании переменного тока происходит развал эшелонов ступеней до системы регулярных ступеней. Опубликованная в 1989 г. А.В. Латышевым и соавторами работа вызвала огромный интерес в области исследования процессов на поверхности и была названа одной из ключевых для развития теории БКФ [33]. Несмотря на это, полного признанного теоретического описания сложной температурной зависимости процесса эшелонирования атомных ступеней до сих пор не представлено.
Рис. 3.
ОЭМ-изображения поверхности Si(111) при 1250°С с регулярным распределением ступеней (а) и эшелонами ступеней (б). Температурные интервалы эшелонирования ступеней в зависимости от направления нагревающего электрического тока (в). ОЭМ-изображения участка поверхности Si(100) при 1100°С при различных направлениях электрического тока: г – переменный, д – в сторону лежащих выше террас, е – в сторону лежащих ниже террас.

Эшелонирование атомных ступеней на поверхности Si(100) значительно отличается от процесса на поверхности Si(111) в силу наличия сверхструктуры 2 × 1, за счет которой на поверхности наблюдается анизотропия диффузии адатомов и свойств атомных ступеней. В [34] показано, что при направлении электрического тока поперек атомных ступеней существует критическое расстояние между ступенями lcrit = 75–92 нм, при котором изменяется зависимость распределения ступеней от направления электрического тока, нагревающего кристалл. Если l > lcrit, то эшелонирование ступеней происходит при любом из направлений постоянного электрического тока, но при одном направлении тока преобладают 1 × 2-террасы (ряды димеров сверхструктуры параллельны электрическому току) (рис. 3д), а при другом – 2 × 1 (рис. 3е). Размеры преобладающих террас зависят от времени и температуры отжига исследуемого кристалла. Если l < lcrit, то преобладают террасы с реконструкцией 2 × 1, разделенные эшелонами ступеней, которые сформировались при направлении тока в сторону более высоких террас. При противоположном направлении тока распределение ступеней является почти однородным [35]. Подробные исследования кинетики эшелонирования атомных ступеней на поверхности Si(100) в интервале температур 950–1150°С показали, что распределение ступеней между эшелонами и форма эшелонов зависят от температуры отжига. Обнаружена их крайне слабая зависимость от температуры при электрическом токе, направленном вниз по ступеням, а при противоположном направлении тока зависимость более выражена с эффективной энергией активации ∼0.24 эВ [36, 37].
Осаждение Si также может оказывать нетривиальное влияние на процесс эшелонирования ступеней на поверхности Si(111) в условиях, когда сублимационный отток Si с поверхности очень мал и создает значительное недосыщение адсорбционного слоя. Изменение недосыщения на поверхности за счет осаждения Si из внешнего источника приводит к увеличению скорости формирования эшелонов при приближении недосыщения к нулевому значению [36]. Важно заметить, что скорость формирования эшелонов ступеней в условиях эпитаксиального роста также возрастает вблизи нулевых значений пересыщения адсорбционного слоя. В соответствии с теорией БКФ [18] скорость движения ступени уменьшается с уменьшением пересыщения, следовательно, смещение атомных ступеней является стабилизирующим фактором для процесса их эшелонирования. Однако было обнаружено, что с увеличением пересыщения в процессе роста на поверхности Si(100) при температуре 1100°С кинетика эшелонирования ступеней имеет немонотонную зависимость с максимумом при скорости роста ∼0.3 МС/с (1 МС для поверхности Si(100) равен 6.78 × 1014 см–2). Это указывает на наличие дополнительного дестабилизирующего фактора, конкурирующего со смещением ступени. Вероятно, этим фактором является сильное отклонение условий на поверхности от равновесных, при которых локальные изменения концентрации адатомов вдали от ступеней запаздывают из-за быстрого движения атомных ступеней и распределение концентрации становится несимметричным относительно центра террасы. Отметим, что вицинальная поверхность Si(111)–7 × 7 в условиях гомоэпитаксиального роста при температурах ∼650°C устойчива только при малых углах разориентации относительно сингулярной грани [38]. Однако если при больших углах разориентации среднее расстояние между ступенями становится меньше ∼30 нм (зависит от температуры подложки), наблюдается эшелонирование атомных ступеней, причем в температурном интервале 650–800°C обнаружены три режима кинетики с различающимися параметрами масштабирования. Если среднее расстояние между ступенями превышает 100 нм, в данном температурном диапазоне наблюдается формирование пирамидальных морфологических структур как на ступенчато-эшелонированной поверхности [39], так и на сингулярных террасах, исходно не содержавших ступени [40].
Эффект эшелонирования атомных ступеней в результате электромиграции адатомов наблюдался и в процессе осаждения атомов Au [41]. Обнаружено, что в первом температурном интервале всего 0.008 МС Au (1 МС для поверхности Si(111) равен 7.8 × 1014 см–2) приводят к инверсии интервала эшелонирования ступеней 830–1050°C, осаждение бóльших покрытий Au приводит к инверсии остальных интервалов эшелонирования [42, 43]. Показано также, что кроме температурных интервалов эшелонирования ступеней существуют интервалы по концентрации Au, при переходе между которыми наблюдается смена режима эшелонирования на регулярные ступени или наоборот (в зависимости от направления электрического тока). Только с применением in situ СВВ ОЭМ было показано, что золото активно диффундирует в объем и по механизму kick-out формирует в объеме кристалла избыточную концентрацию межузельных атомов, которые взаимодействуют с поверхностью как с активным стоком [44]. Такая совокупность многочисленных атомных процессов приводит к экспериментально наблюдаемым многочисленным явлениям. В [45] предложена общая модель, описывающая эффект эшелонирования ступеней на поверхности Si(111) при сублимации, эпитаксиальном росте и адсорбции золота и учитывающая многочисленные атомные процессы на поверхности, в объеме и приповерхностном слое. Из-за большого количества включенных в данную модель процессов она требует тщательной теоретической и экспериментальной проверки.
4. АДСОРБЦИЯ И ЭЛЕКТРОМИГРАЦИЯ ОЛОВА НА ПОВЕРХНОСТИ Si(111)
Осаждение примесных атомов на поверхность Si обычно приводит к значительным трансформациям ее структуры и морфологии [46, 47]. Изменения в процессах, происходящих на поверхности Si, наблюдаются даже при адсорбции элементов четвертой группы (Ge, Sn), структурные свойства твердых растворов которых во многом аналогичны Si, а электрофизические – представляют интерес для приложений микро- и фотоэлектроники [48, 49]. В частности, с применением СВВ ОЭМ обнаружены нетривиальные особенности массопереноса атомов Sn на ступенчатой поверхности Si(111) в условиях нагрева подложки пропусканием постоянного электрического тока. При температуре 700°С и скорости осаждения Sn 0.01 МС/с на ОЭМ-изображениях вблизи ступеней и на террасах появляются области более темного контраста (обозначены белыми стрелками на рис. 4), соответствующие доменам сверхструктуры $\sqrt 3 $ × $\sqrt 3 $–Sn. Аналогичное зарождение доменов примесно-индуцированных структур вблизи атомных ступеней наблюдается при осаждении Ge [50], Au [51], Cu [52] и других материалов. Равномерно расширяясь во все стороны, домены сверхструктуры $\sqrt 3 $ × $\sqrt 3 $–Sn заполняют всю площадь террас в течение 21 с (рис. 4г), что соответствует покрытию Sn около 0.2 МС. Поскольку для формирования структуры $\sqrt 3 $ × $\sqrt 3 $–Sn требуется покрытие 1/3 МС [53], осажденного количества атомов Sn достаточно для заполнения лишь 60% площади поверхности. Возникает вопрос – откуда берутся дополнительные 0.13 МС атомов? Полученные методом in situ ОЭМ-изображения показывают, что моноатомная ступень, обозначенная на рис. 4а черной стрелкой, сдвигается на 5–7% от первоначальной ширины лежащей выше террасы по завершении сверхструктурного перехода, что соответствует выходу из ступени 0.10–0.14 МС атомов Si. Данный факт указывает на то, что именно ступень является источником дополнительных 0.13 МС атомов, требуемых для формирования сверхструктуры $\sqrt 3 $ × $\sqrt 3 $, а сама сверхструктура формируется из смеси атомов Si и Sn. Подобный сдвиг ступеней и формирование сверхструктуры $\sqrt 3 $ × $\sqrt 3 $ при покрытиях Sn менее 0.33 МС наблюдались только при T > 650°С. Данный вывод подтверждается результатами [53, 54], согласно которым отжиг при T ≥ 630°С поверхности Si(111) с покрытием Sn 1.5 МС, осажденным при комнатной температуре, приводит к образованию мозаичной структуры $\sqrt 3 $ × $\sqrt 3 $–Sn, состоящей из адатомов Sn и Si в соотношении 1 : 1.
Рис. 4.
ОЭМ-изображения поверхности Si(111) на начальных стадиях осаждения Sn при 700°С и скорости осаждения 0.01 МС/с. Пунктирная линия указывает на начальное положение моноатомной ступени, обозначенной черной стрелкой. Белыми стрелками обозначены зарождающиеся домены сверхструктуры $\sqrt 3 $ × $\sqrt 3 $–Sn.

В процессе осаждения покрытий олова более 0.33 МС на ОЭМ-изображениях поверхности Si(111) вблизи моноатомных ступеней и эшелонов ступеней начинают зарождаться домены более темного контраста (обозначены черными стрелками на рис. 5), которые, разрастаясь, заполняют всю площадь террас (рис. 5в–5д, 5к–5м). На дифракционной картине разрастание этих доменов соответствует уменьшению интенсивности рефлексов сверхструктуры $\sqrt 3 $ × $\sqrt 3 $–Sn вплоть до полного исчезновения при покрытии >1 МС, что соответствует формированию разупорядоченной (аморфной) фазы “1 × 1”–Sn [55]. Направление разрастания доменов фазы “1 × 1”–Sn относительно ступеней поверхности Si(111) зависит от направления пропускания электрического тока. При пропускании электрического тока в направлении лежащих выше террас домены фазы “1 × 1”–Sn зарождаются вблизи одиночных ступеней и эшелонов ступеней исключительно со стороны лежащих ниже террас (рис. 5в). Это указывает на преимущественный дрейф адатомов Sn на поверхности Si(111)–$\sqrt 3 $ × $\sqrt 3 $–Sn в сторону лежащих выше террас (по направлению электрического поля) в условиях, когда восходящие ступени и эшелоны ступеней выступают эффективными барьерами на пути дрейфа адатомов Sn. Такие барьеры способствуют увеличению концентрации адатомов Sn вблизи ступеней со стороны лежащих ниже террас, что в итоге приводит к образованию доменов фазы “1 × 1”–Sn (рис. 5в). По мере увеличения суммарного покрытия олова домены разрастаются в нисходящем направлении (обозначено заштрихованной стрелкой на рис. 5в, 5г) и заполняют всю площадь террас. Момент времени t = = 27 с (рис. 5д), когда все террасы полностью покрыты фазой “1 × 1”–Sn, соответствует покрытию 1 МС.
Рис. 5.
ОЭМ-изображения поверхности Si(111) в процессе осаждении Sn при температуре 700°С и скорости осаждения 0.037 МС/с. На верхних изображениях показано направление пропускаемого через подложку электрического тока. Белыми стрелками обозначены домены структуры $\sqrt 3 $ × $\sqrt 3 $, черными – домены аморфной фазы “1 × 1”–Sn. Заштрихованная стрелка указывает направление распространения границы области полного покрытия поверхности фазой “1 × 1”–Sn.

При противоположном направлении электрического тока домены фазы “1 × 1”–Sn зарождаются вблизи эшелонов ступеней и некоторых ступеней со стороны лежащих выше террас (рис. 5к). Однако домены разрастаются медленнее, чем в предыдущем случае: в момент времени t = 27 с, соответствующий покрытию 1 МС, на террасах все еще присутствуют области со структурой $\sqrt 3 $ × × $\sqrt 3 $–Sn. Данный факт свидетельствует о том, что значительная часть атомов Sn дрейфует в направлении электрического поля не только по террасам поверхности Si(111)–$\sqrt 3 $ × $\sqrt 3 $–Sn, но и через атомные ступени за пределы поля зрения. После 31 с осаждения оставшиеся участки поверхности со структурой $\sqrt 3 $ × $\sqrt 3 $–Sn замещаются фазой “1 × × 1”–Sn. Из-за нестрогой перпендикулярности вектора электрического поля атомным ступеням на ОЭМ-изображении (рис. 5л) этот процесс начинается снизу (фронт распространения обозначен заштрихованной стрелкой). В итоге только после 34 с осаждения в момент, соответствующий покрытию 1.2 МС Sn (рис. 5м), на поверхности не остается областей со структурой $\sqrt 3 $ × $\sqrt 3 $–Sn. Поскольку адатомы Sn дрейфуют в направлении электрического поля, эффективный заряд адатомов Sn на реконструированной поверхности Si(111)–$\sqrt 3 $ × $\sqrt 3 $–Sn положительный, что согласуется с результатами, полученными с использованием оже-спектроскопии в [56].
Несмотря на заметные трансформации структуры поверхности Si(111) в присутствии покрытий Sn и значительную электромиграцию атомов Sn по поверхности, существенного перераспределения атомных ступеней, сопоставимого, например, с трансформациями, индуцированными осаждением Au, не наблюдалось ни в процессе осаждения Sn на поверхность, ни после отключения потока Sn. Однако в отсутствие внешнего притока атомов Sn отжиг образцов пропусканием постоянного электрического тока приводит к перераспределению самого покрытия Sn. На поверхности образуются области с локальной концентрацией Sn < 1 МС, где появляются домены сверхструктуры $\sqrt 3 $ × $\sqrt 3 $–Sn, соответствующей покрытию 1/3 МС, и постепенно исчезают домены фазы “1 × 1”–Sn (заштрихованные стрелки на рис. 5е, 5ж, 5н, 5о), что соответствует сверхструктурному переходу “1 × 1”–Sn ⇒ $\sqrt 3 $ × $\sqrt 3 $–Sn. Изменение направления протекания постоянного электрического тока в ходе данного структурного перехода приводит к повторному заполнению всей поверхности фазой “1 × 1”–Sn, что указывает на сохранение суммарного покрытия Sn на поверхности образцов (≥1 МС) и демонстрирует малость потока десорбции Sn при температурах ∼700°С. В частности, при протекании постоянного тока в направлении лежащих выше террас (рис. 5е, 5ж) домены фазы “1 × 1”–Sn, перемещаясь в направлении электрического поля, задерживаются восходящими ступенями в полном соответствии с аналогичными процессами, наблюдавшимися при осаждении Sn (рис. 5в, 5г). При противоположном направлении электрического поля (рис. 5н, 5о) структурный переход “1 × 1”–Sn ⇒ $\sqrt 3 $ × $\sqrt 3 $–Sn начинается раньше по времени, а фронт исчезновения фазы “1 × 1”–Sn сонаправлен с электрическим полем на поверхности образца. В случае нагрева образца пропусканием переменного электрического тока (т.е. в отсутствие дрейфа адатомов) переход “1 × 1”–Sn ⇒ ⇒ $\sqrt 3 $ × $\sqrt 3 $–Sn начинается только после продолжительного (более 400 с) отжига. Это подтверждает, что наблюдаемый при пропускании постоянного электрического тока структурный переход “1 × 1”–Sn ⇒ $\sqrt 3 $ × $\sqrt 3 $–Sn связан исключительно с эффектом электромиграции.
5. ТРАВЛЕНИЕ ПОВЕРХНОСТИ Si(111) МОЛЕКУЛЯРНЫМ ПУЧКОМ СЕЛЕНА
Изучение физических свойств, способов синтеза и потенциала применения углеродных наноматериалов, сформировавшееся как одно из крупнейших направлений физики конденсированного состояния в 2000-е годы, в 2010-е расширилось на другие низкоразмерные материалы, в частности на слоистые халькогениды металлов. Однако синтез высококачественных эпитаксиальных слоев данных материалов на подложках Si является проблемой, которая препятствует их применению в полупроводниковой электронике [57]. Структурное совершенство и электронные свойства слоистых материалов сильно зависят от морфологии поверхности полупроводниковой подложки [58]. В целях расширения возможностей подготовки Si-подложек в атмосфере халькогенов (S, Se, Te) методом in situ ОЭМ исследованы морфологические трансформации, происходящие на поверхности Si(111) при взаимодействии с молекулярным пучком селена [59].
На вицинальной или ступенчато-эшелонированной поверхности Si(111) при температурах выше 830°C осаждение Se увеличивает скорость движения ступеней в направлении лежащих выше террас, что соответствует травлению поверхности по ступенчато-слоевому механизму. Это согласуется с результатами [60], где методом термодесорбционной спектроскопии при 600–800°C наблюдалась десорбция Si-содержащих молекул SiSe2 с поверхности Si(111), покрытой тонкой пленкой Se. Согласно in situ ОЭМ-изображениям, полученным в процессе постепенного охлаждения образцов Si(111), травление молекулярным пучком Se переходит в двумерно-островковый режим при использовании подложек с большой шириной террас (более 10 мкм) либо на реконструированной поверхности Si(111)–7 × 7 с террасами шириной ∼1 мкм в температурном диапазоне 600–830°C. В таких условиях на террасах происходят периодическое зарождение, рост и коалесценция вакансионных островков.
В процессе длительного травления поверхности Si(111) ($ \gg $10 МС) вблизи эшелонов ступеней травление происходило с меньшей (до 5%) скоростью по сравнению с сингулярными и вицинальными участками поверхности вдали от эшелонов ступеней. Такая неоднородность травления приводит к постепенному углублению областей между эшелонами ступеней и самоорганизованному формированию многослойных террасированных углублений (рис. 6а–6в). На поверхности с регулярным распределением ступеней формирования таких многослойных морфологических структур не наблюдалось.
Рис. 6.
ОЭМ-изображение (а), АСМ-изображение (б) и схема (в) террасированного углубления, сформированного в процессе травления эшелонированной поверхности Si(111) молекулярным пучком селена. Диаграмма структур поверхности Si(111) в координатах скорости травления J и температуры T (г).

На основе данных, полученных методами СВВ ОЭМ и дифракции быстрых электронов на отражение в интервале 600–770°C, изучена температурная зависимость критической скорости травления J*, при которой на поверхности Si(111) разрушается сверхструктура 7 × 7 и соответствующие дробные рефлексы исчезают с дифракционной картины (рис. 6г). Согласно данным [59, 60] присутствие на поверхности Si(111) покрытия Se с концентрацией около 0.5 МС приводит к удалению сверхструктуры Si(111)–7 × 7 и формированию разупорядоченного поверхностного селенида кремния “1 × 1”–Se. При скоростях травления ниже J*(T) кинетика травления лимитируется скоростью осаждения селена на поверхность, а при скоростях травления выше J*(T) – скоростью формирования и десорбции молекул SiSe2. Анализ экспериментальной зависимости J*(T) позволил определить энергию формирования и десорбции молекул SiSe2 на поверхности Si(111) – 2.65 эВ [59].
ЗАКЛЮЧЕНИЕ
Методом in situ сверхвысоковакуумной отражательной электронной микроскопии (СВВ ОЭМ) исследованы структурные и морфологические трансформации поверхности монокристаллических подложек Si(111) и Si(100) в условиях высокотемпературной сублимации, эпитаксиального роста, адсорбции олова и травления молекулярным пучком селена. Изучены физические закономерности формирования самоорганизованных структур за счет эффектов электромиграции, неравномерного движения ступеней, неоднородностей зарождения двумерных островков. Это позволило получить новую информацию об атомных процессах на поверхностях кремния, развить фундаментальные основы и практические возможности управления структурой и морфологией поверхности кремния для последующего роста эпитаксиальных полупроводниковых покрытий и гетероструктур.
Отсутствие принципиальных ограничений рабочего диапазона температур подложки (вплоть до температуры плавления) во время in situ-эксперимента позволяет применять метод СВВ ОЭМ для изучения процессов и на других полупроводниковых подложках. В то же время метод СВВ ОЭМ применим для изучения процессов на поверхности в разнообразных условиях: гомо- и гетероэпитаксиального роста из молекулярного пучка, взаимодействия с газовой атмосферой (в частности, травления кислородом или селеном), осаждения (суб-)монослойных покрытий металлов (Au, Sn и других) для изменения структурных свойств подложки и кинетики поверхностной диффузии, что обеспечивает возможности для разработки сложных технологических процессов. Широкий спектр материалов, взаимодействие которых с кремниевыми подложками исследовано к настоящему моменту методом СВВ ОЭМ (Si, Ge, Sn, Se, O2, Au, Ag, Pt, Bi, In, Cu, Ca и других), открывает перспективы для поиска решений современных проблем роста многокомпонентных эпитаксиальных слоев, в частности твердых растворов в системе SiGeSn и ван-дер-ваальсовой эпитаксии на полупроводниковых подложках.
Исследования процессов сублимации на поверхностях с широкими террасами выполнены при финансовой поддержке Российского научного фонда (РНФ) (грант № 14-22-00143), процессов эшелонирования атомных ступеней на поверхности Si (100) – при поддержке Российского фонда фундаментальных исследований (грант № 16-32-60199), процессов при осаждении германия – при поддержке РНФ (грант № 19-72-30023), травления поверхности кремния молекулярным пучком селена – при поддержке РНФ (грант № 18-72-10063). Эксперименты проводились на оборудовании ЦКП “Наноструктуры”.
Список литературы
Feigelson R. 50 Years Progress in Crystal Growth: A Reprint Collection. Elsevier Science, 2004. 268 p. https://books.google.ru/books?id=0lEcYdpLlB0C.
Nakamura H., Kohmoto S., Ishikawa T. et al. // Physica. E. 2000. V. 7. P. 331. https://doi.org/10.1016/S1386-9477(99)00335-5
Tanaka S., Kern R.S., Davis R.F. // Appl. Phys. Lett. 1995. V. 66. P. 37. https://doi.org/10.1063/1.114173
Oshima T., Arai N., Suzuki N. et al. // Thin Solid Films. 2008. V. 516. P. 5768. https://doi.org/10.1016/j.tsf.2007.10.045
Aqua J.-N., Berbezier I., Favre L. et al. // Phys. Rep. 2013. V. 522. P. 59. https://doi.org/10.1016/j.physrep.2012.09.006
Harmand J.-C., Patriarche G., Glas F. et al. // Phys. Rev. Lett. 2018. V. 121. P. 166101. https://doi.org/10.1103/PhysRevLett.121.166101
Latyshev A.V., Fedina L.I., Kosolobov S.S. et al. // Advances in Semiconductor Nanostructures. 2017. P. 189. https://doi.org/10.1016/B978-0-12-810512-2.00008-1
Ruska E. // Rev. Mod. Phys. 1987. V. 59. P. 627. https://doi.org/10.1103/RevModPhys.59.627
Nobuyuki O., Yasumasa T., Katsumichi Y. et al. // Surf. Sci. 1981. V. 102. P. 424. https://doi.org/10.1016/0039-6028(81)90038-8
Nielsen P.E.H., Cowley J.M. // Surf. Sci. 1976. V. 54. P. 340. https://doi.org/10.1016/0039-6028(76)90230-2
Latyshev A.V., Krasilnikov A.B., Aseev A.L. // Ultramicroscopy. 1993. V. 48. P. 377. https://doi.org/10.1016/0304-3991(93)90115-E
Латышев А.В., Асеев А.Л., Стенин С.И. // Письма в ЖЭТФ. 1988. Т. 47. С. 448.
Zandvliet H.J.W., Wormeester H., Wentink D.J. et al. // Phys. Rev. Lett. 1993. V. 70. P. 2122. https://doi.org/10.1103/PhysRevLett.70.2122
Latyshev A.V., Fedina L.I., Rogilo D.I. et al. Atomically Controlled Silicon Surface. Novosibirsk: Parallel, 2016. 222 p.
Ситников С.В., Косолобов С.С., Щеглов Д.В. и др. Пат. RU 2453874. 2011.
Рогило Д.И., Рыбин Н.Е., Федина Л.И. и др. // Автометрия. 2016. Т. 52. С. 103. https://doi.org/10.15372/AUT20160512
Rogilo D.I., Fedina L.I., Kosolobov S.S. et al. // Surf. Sci. 2018. V. 667. P. 1. https://doi.org/10.1016/j.susc.2017.09.009
Burton W.K., Cabrera N., Frank F.C. // Phil. Trans. Royal Soc. A. 1951. V. 243. P. 299. https://doi.org/10.1098/rsta.1951.0006
Bartelt N.C., Tromp R.M., Williams E.D. // Phys. Rev. Lett. 1994. V. 73. P. 1656. https://doi.org/10.1103/PhysRevLett.73.1656
Metois J.J., Wolf D.E. // Surf. Sci. 1993. V. 298. P. 71. https://doi.org/10.1016/0039-6028(93)90081-T
Tromp R.M., Reuter M.C. // Phys. Rev. Lett. 1992. V. 68. P. 820. https://doi.org/10.1103/PhysRevLett.68.820
Tromp R.M., Reuter M.C. // Phys. Rev. B. 1993. V. 47. P. 7598. https://doi.org/10.1103/PhysRevB.47.7598
Pimpinelli A., Métois J.-J. // Phys. Rev. Lett. 1994. V. 72. P. 3566. https://doi.org/10.1103/PhysRevLett.72.3566
Sitnikov S., Kosolobov S., Latyshev A. // Surf. Sci. 2015. V. 633. P. L1. https://doi.org/10.1016/j.susc.2014.12.004
Sitnikov S.V., Latyshev A.V., Kosolobov S.S. // J. Cryst. Growth. 2017. V. 457. P. 196. https://doi.org/10.1016/j.jcrysgro.2016.05.048
Farid B., Godby R.W. // Phys. Rev. B. 1991. V. 43. P. 14248. https://doi.org/10.1103/PhysRevB.43.14248
Латышев А.В., Асеев А.Л. Моноатомные ступени на поверхности кремния. Новосибирск, Изд-во СО РАН, 2006. 241 с.
Латышев А.В., Асеев А.Л. // Успехи физ. наук. 1998. Т. 168. С. 1117.
Латышев А.В. Дис. “Атомные ступени на поверхности кремния в процессах сублимации, эпитаксии и фазовых переходов” … д-ра физ.-мат. наук: 01.04.10. 1996.
Latyshev A.V., Aseev A.L., Krasilnikov A.B. et al. // Surf. Sci. 1989. V. 213. P. 157. https://doi.org/10.1016/0039-6028(89)90256-2
Stoyanov S. // Jpn. J. Appl. Phys. 1990. V. 29. P. L659. https://doi.org/10.1143/JJAP.29.L659
Kandel D., Kaxiras E. // Phys. Rev. Lett. 1996. V. 76. P. 1114. https://doi.org/10.1103/PhysRevLett.76.1114
Uwaha M. // Prog. Cryst. Growth. 2016. V. 62. P. 58. https://doi.org/10.1016/j.pcrysgrow.2016.04.002
Litvin L.V., Krasilnikov A.B., Latyshev A.V. // Surf. Sci. 1991. V. 244. P. L121. https://doi.org/10.1016/0039-6028(91)90483-9
Latyshev A.V., Litvin L.V., Aseev A.L. // Appl. Surf. Sci. 1998. V. 130–132. P. 139. https://doi.org/10.1016/S0169-4332(98)00040-3
Rodyakina E.E., Sitnikov S.V., Rogilo D.I. et al. // J. Cryst. Growth. 2019. V. 520. P. 85. https://doi.org/10.1016/j.jcrysgro.2019.05.026
Родякина Е.Е., Ситников С.В., Рогило Д.И. и др. // Сиб. физ. журн. 2018. Т. 13. С. 60. https://doi.org/10.25205/2541-9447-2018-13-4-60-66
Omi H., Homma Y., Tonchev V. et al. // Phys. Rev. Lett. 2005. V. 95. P. 216101. https://doi.org/10.1103/PhysRevLett.95.216101
Rogilo D.I., Fedina L.I., Kosolobov S.S. et al. // Phys. Rev. Lett. 2013. V. 111. P. 036105. https://doi.org/10.1103/PhysRevLett.111.036105
Rogilo D.I., Fedina L.I., Kosolobov S.S. et al. // J. Cryst. Growth. 2017. V. 457. P. 188. https://doi.org/10.1016/j.jcrysgro.2016.06.028
Latyshev A.V., Minoda H., Tanishiro Y. et al. // Surf. Sci. 1998. V. 401. P. 22. https://doi.org/10.1016/S0039-6028(97)00901-1
Kosolobov S.S., Song S.A., Fedina L.I. et al. // JETP Lett. 2005. V. 81. P. 117. https://doi.org/10.1134/1.1898002
Kosolobov S.S., Song S.A., Rodyakina E.E. et al. // Semiconductors. 2007. V. 41. P. 448. https://doi.org/10.1134/S1063782607040173
Kosolobov S., Nazarikov G., Sitnikov S. et al. // Surf. Sci. 2019. V. 687. P. 25. https://doi.org/10.1016/j.susc.2019.04.008
Kosolobov S. // Sci. Rep. 2019. V. 9. P. 13428. https://doi.org/10.1038/s41598-019-49681-1
Minoda H., Sakamoto S., Yagi K. // Surf. Sci. 1997. V. 372. P. 1. https://doi.org/10.1016/S0039-6028(96)01138-7
Voigtländer B., Zinner A., Weber T. et al. // Phys. Rev. B. 1995. V. 51. P. 7583. https://doi.org/10.1103/PhysRevB.51.7583
Wirths S., Buca D., Mantl S. // Prog. Cryst. Growth. 2016. V. 62. P. 1. https://doi.org/10.1016/j.pcrysgrow.2015.11.001
Maeda T., Jevasuwan W., Hattori H. et al. // Jpn. J. Appl. Phys. 2015. V. 54. P. 04DA07. https://doi.org/10.7567/JJAP.54.04DA07
Petrov A.S., Rogilo D.I., Sheglov D.V. et al. // J. Cryst. Growth. 2020. V. 531. P. 125347. https://doi.org/10.1016/j.jcrysgro.2019.125347
Latyshev A.V., Krasilnikov A.B., Aseev A.L. // Appl. Surf. Sci. 1992. V. 60–61. P. 397. https://doi.org/10.1016/0169-4332(92)90450-C
Rogilo D.I., Kosolobov S.S., Fedina L.I. et al. // International Workshop and Tutorials on Electron Devices and Materials, EDM – Proceedings. 2009. P. 48. https://doi.org/10.1109/EDM.2009.5173926
Törnevik C., Göthelid M., Hammar M. et al. // Surf. Sci. 1994. V. 314. P. 179. https://doi.org/10.1016/0039-6028(94)90005-1
Charrier A., Pérez R., Thibaudau F. et al. // Phys. Rev. B. 2001. V. 64. P. 115407. https://doi.org/10.1103/PhysRevB.64.115407
Ichikawa T. // Surf. Sci. 1984. V. 140. P. 37. https://doi.org/10.1016/0039-6028(84)90380-7
Yasunaga H., Natori A. // Surf. Sci. Rep. 1992. V. 15. P. 205. https://doi.org/10.1016/0167-5729(92)90007-X
Fiori G., Bonaccorso F., Iannaccone G. et al. // Nat. Nanotechnol. 2014. V. 9. P. 768. https://doi.org/10.1038/nnano.2014.207
Vishwanath S., Liu X., Rouvimov S. et al. // J. Mater. Res. 2016. V. 31. P. 900. https://doi.org/10.1557/jmr.2015.374
Rogilo D.I., Fedina L.I., Ponomarev S.A. et al. // J. Cryst. Growth. 2020. V. 529. P. 125273. https://doi.org/10.1016/j.jcrysgro.2019.125273
Papageorgopoulos A.C., Kamaratos M. // Surf. Sci. 2002. V. 504. P. L191. https://doi.org/10.1016/S0039-6028(02)01096-8
Дополнительные материалы отсутствуют.
Инструменты
Кристаллография


