Микроэлектроника, 2019, T. 48, № 6, стр. 421-429
Параметры плазмы и механизмы травления кремния в смеси CF4 + CHF3 + O2
А. М. Ефремов 1, *, Д. Б. Мурин 1, K.-H. Kwon 2
1 Федеральное государственное бюджетное образовательное учреждение высшего образования “Ивановский государственный химико-технологический университет”
153000 Иваново, Шереметевский просп., 7, Россия
2 Korea University
339-700 Sejong, South Korea
* E-mail: efremov@isuct.ru
Поступила в редакцию 28.01.2019
После доработки 28.01.2019
Принята к публикации 25.04.2019
Аннотация
Проведено исследование влияния соотношения CF4/CHF3 в смеси CF4 + CHF3 + 9% O2 на параметры газовой фазы и кинетику травления кремния в условиях индуктивно-связанной плазмы низкого давления. Установлено, что замещение CF4 на CHF3 при неизменных внешних параметрах плазмы: 1) приводит к изменению температуры (средней энергии) и концентрации электронов; 2) вызывает снижение концентрации атомов фтора с последующим доминированием молекул HF; и 3) способствует увеличению скорости осаждения и толщины фторуглеродной полимерной пленки. При анализе механизма травления кремния с использование расчетных данных по потокам активных частиц было найдено, что наблюдаемое изменение скорости травления может быть объяснено гетерогенными реакциями с участием O, H и HF. Предположено, что процесс травления кремнияпротекает в режиме лимитирования потоком химически активных частиц F + HF и характеризуется эффективной вероятностью, зависящей от толщины фторуглеродной полимерной пленки.
1. ВВЕДЕНИЕ
Фторуглеродные газы семейства CxFy нашли широкое применение в технологии микро- и наноэлектроники при проведении “сухого” травления кремния и его соединений [1–3]. Известно, что в плазметаких газов параллельно протекают процессыудаления (газификации) атомов обрабатываемого материала и поверхностной полимеризации, баланс которых зависит от числа атомов фтора, приходящихся на один атом углерода в исходной молекуле (F/C) [2–4]. Величина F/C характеризует соотношение концентраций атомов F и ненасыщенных радикалов CFx в газовой фазе и, в значительной степени, определяет выходные параметры процесса травления (скорость, селективность, анизотропия). Так, в газах с высоким F/C (${{n}_{{\text{F}}}} > {{n}_{{{\text{C}}{{{\text{F}}}_{x}}}}}$) имеет место доминирование травления над полимеризацией, что обеспечивает высокую скорость травления и чистоту обрабатываемой поверхности. В то же время, характерные значения анизотропии травления и селективности в системе SiO2/Si далеки от оптимальных. Напротив, газы с низким F/C (${{n}_{{\text{F}}}} < {{n}_{{{\text{C}}{{{\text{F}}}_{x}}}}}$) способны обеспечить анизотропное травление (за счет маскирования фторуглеродным полимером боковых стенок формируемого рельефа [1, 4]) и высокую селективность в системе SiO2/Si (за счет различной толщины фторуглеродной полимерной пленки на кислородсодержащих и бескислородных поверхностях) [5]. Однако эти же механизмы обуславливают низкие скорости травления и высокие степени загрязнения обработанных поверхностей фторуглеродным полимером.
Для регулирования эффекта полимеризации на выходные параметры процесса травления обычно используют бинарные смеси фторуглеродного газа с аргоном или кислородом [4, 5]. В первом случае происходит интенсификация деструкции полимерной пленки за счEт распыления ионами Ar+, во втором – связывание фторуглеродных радикалов в соединения вида CFxOy и травление пленки атомами кислорода. Еще одним подходом к оптимизации выходных параметров может служить использование плазмообразующих смесей с двумя фторуглеродными компонентами, например – CF4 + CHF3. По нашему мнению, перспективы CHF3 в качестве добавки к тетрафторметану обусловлены двумя свойствами принципиальными свойствами данного газа. Во-первых, плазма CHF3 отличается значительно более высокой, по сравнению с CF4, полимеризационной способностью [6] в силу низкого F/C и наличия водорода в составе исходной молекулы. И, во-вторых, плазмохимические процессы вида
обеспечивают высокие концентрации молекул HF в газовой фазе [7, 8]. Наряду с атомами фтора, эти частицы также могут давать вклад в химическую составляющую процесса травления. Таким образом, соотношение CF4/CHF3 в исходной смеси будет являться эффективным инструментом воздействия наконцентрации частиц, определяющих скорости процессов травления и полимеризации.
Предшествующие исследования плазменных систем на основе CF4 [9–11] и CHF3 [12–14] содержат надежные данные по электрофизическим параметрам плазмы и концентрациям активных частиц, а также представляют наборы реакций и констант скоростей, обеспечивающие корректное описание кинетики и понимание механизмов плазмохимических процессов в этих газах. В то же время, совокупность имеющихся данных не достаточна для анализа эффектов, возникающих при комбинировании CF4 и CHF3 в рамках одной смеси. Это обусловлено тем, что результат смешения не определяется простым “усреднением” свойств компонентов смеси и/или “суммированием” их кинетических схем. Очевидно, что при анализе смесей первостепенную важность приобретают вопросы изменения электрофизических параметров плазмы (температуры и концентрации электронов), определяющих кинетику процессов при электронном ударе, а также появления перекрeстных каналов взаимодействия продуктов диссоциации исходных газов. С учетом вышесказанного, целью настоящей работы являлось:
1) исследование влияния соотношения концентраций CF4/CHF3 в смеси CF4 + CHF3 + 9% O2 на электрофизические параметры плазмы, кинетику и концентрации активных частиц;
2) установление взаимосвязей между характеристиками газовой фазы и гетерогенными процессами, определяющими кинетику и механизм травления кремния.
2. МЕТОДИЧЕСКАЯ ЧАСТЬ
2.1. Экспериментальные методики и оборудование
Эксперименты проводились при возбуждении индукционного ВЧ (13.56 МГц) разряда в смеси CF4 + CHF3 + O2 в реакторе планарного типа с цилиндрической ($r$ = 13 см, $l$ = 16 см) рабочей камерой из анодированного алюминия [15]. В качестве постоянных условий процесса выступали вкладываемая мощность $W$ = 500 Вт, общее давление плазмообразующего газа $p$ = 10 мтор и его расход $q$ = 44 станд. см3/мин. В качестве варьируемого параметра использовалось соотношение начальных концентраций CF4/CHF3, которое устанавливалось изменением индивидуальных расходов этих компонентов при постоянном значении ${{q}_{{{{{\text{O}}}_{2}}}}}$ = 4 станд. см3/мин. Таким образом, содержание кислорода в смеси всегда составляло 9% (${{y}_{{{{{\text{O}}}_{2}}}}} = {{{{q}_{{{{{\text{O}}}_{2}}}}}} \mathord{\left/ {\vphantom {{{{q}_{{{{{\text{O}}}_{2}}}}}} q}} \right. \kern-0em} q}$ = 0.09), при этом изменение ${{q}_{{{\text{CH}}{{{\text{F}}}_{3}}}}}$ = 0–40 станд. см3/мин (${{y}_{{{\text{CH}}{{{\text{F}}}_{3}}}}}$ = 0–0.91) соответствовало полному замещению CF4 на СHF3.
Диагностика плазмы осуществлялась двойным зондом Лангмюра DLP2000 (Plasmart Inc., Korea). Для минимизации погрешности измерений зондовых вольт-амперных характеристик (ВАХ) из-за полимер-образования на зондах применялась система импульсной очистки зондов ионной бомбардировкой. Предварительные эксперименты показали отсутствие существенных искажений ВАХ, последовательно измеряемых в чистых CF4 и CHF3 в течение ~5 мин после зажигания разряда. Обработка ВАХ базировалась на известных положениях теории двойного зонда [16] с использованием максвелловской функции распределения электронов по энергиям (ФРЭЭ). Результатом обработки выступали данные по температуре электронов (${{T}_{e}}$) и плотности ионного тока (${{J}_{ + }}$). Суммарная концентрация положительных ионов (${{n}_{ + }}$) определялась из соотношения ${{J}_{ + }} \approx 0.61e{{n}_{ + }}{{v}_{B}}$ [17], где ${{v}_{B}} \approx \sqrt {e{{{{T}_{e}}} \mathord{\left/ {\vphantom {{{{T}_{e}}} {{{m}_{i}}}}} \right. \kern-0em} {{{m}_{i}}}}} $ – скорость ионов на внешней границе двойного электрического слоя у поверхности зонда без учета отрицательных ионов. Допустимость такого подхода показана в наших работах [11, 18]. Эффективная масса ионов (${{m}_{i}}$) оценивалась по закону Бланка в предположении, что доля ионов данного сорта пропорциональна скорости ионизации соответствующей нейтральной частицы.
В качестве объектов травления использовались фрагменты не окисленных пластин Si(100) размером ~4 см2, которые располагались на подложкодержателе из анодированного алюминия в нижней части рабочей камеры реактора. Температура образца ${{T}_{S}}$ стабилизировалась на уровне 17 ± 3°С с помощью системы проточного водяного охлаждения. Отрицательное смещение на подложкодержателе ($ - {{U}_{{dc}}}$) задавалось независимым ВЧ (12.56 МГц) генератором с постоянной мощностью смещения ${{W}_{{dc}}}$ = 100 Вт. Измерение параметра $ - {{U}_{{dc}}}$ проводилось с помощью высоковольтного зонда AMN-CTR (Youngsin Eng, Korea). В предварительных экспериментах было найдено, что варьирование ${{W}_{{dc}}}$ в пределах 0–200 Вт оказывает пренебрежимо малое влияние на вид зондовых ВАХ и, следовательно, на параметры газовой фазы разряда. Подвергаемые травлению образцы были частично маскированы фоторезистом AZ1512, при этом высота ступеньки ($\Delta h$) на границе маскированной и немаскированной областей после окончания процесса травления измерялась профилометром Alpha-step D-500 (KLA-Tencor, USA). Скорость травления определяли как $R = {{\Delta h} \mathord{\left/ {\vphantom {{\Delta h} \tau }} \right. \kern-0em} \tau },$ где $~\tau $ – время травления. Величина $\tau $ выбиралась в пределах стационарного режима травления, обеспечивающего квазилинейную форму зависимости $\Delta h = f\left( \tau \right).$
2.2. Моделирование плазмы
Для получения данных по составу плазмы и анализа кинетики плазмохимических процессов, протекающих в газовой фазе, использовалась 0-мерная кинетическая модель. Набор реакций и их кинетических характеристик (констант скоростей объемных процессов, вероятностей гетерогенной рекомбинации атомов и радикалов) в плазме CF4 + CHF3 + O2 был сформирован на основе имеющихся данных для систем CF4 + O2 + + Ar [11, 19, 20] и CHF3 + Ar + O2 [12, 19, 21]. Корректность используемых кинетических схем в этих системах подтверждается удовлетворительным согласием расчетных и измеренных параметров плазмы и концентраций частиц [11, 12, 20].
Алгоритм моделирования базировался на типовых предпосылках, использованных в наших предшествующих работах по моделированию разрядов низкого давления в фторуглеродных газах [11, 12, 18, 19]. В частности, предполагалось, что:
1) максвелловская ФРЭЭ обеспечивает адекватное описание кинетики процессов под действием электронного удара;
2) температура газа в условиях $p,~W$ = const не зависит от начального состава смеси;
3) гетерогенная рекомбинация атомов и радикалов подчиняется механизму Или–Ридила;
4) низкая электроотрицательность чистых CF4 и CHF3 в области $p$ < 20 мторр дает возможность полагать ${{{{n}_{ - }}} \mathord{\left/ {\vphantom {{{{n}_{ - }}} {{{n}_{e}}}}} \right. \kern-0em} {{{n}_{e}}}} \ll 1$ и ${{n}_{e}}$ ≈ ${{n}_{ + }}.$ В качестве входных параметров модели использовались ${{T}_{e}}$ и ${{n}_{ + }}.$ Выходными параметрами служили средние по объему реактора скорости процессов образования и гибели нейтральных частиц, их концентрации и плотности потоков на поверхность, контактирующую с плазмой.
3. РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
3.1. Параметры плазмы и концентрации активных частиц
Кинетика и механизмы плазмохимических процессов в системах CF4 + O2 + Ar и CHF3 + O2 + + Ar подробно обсуждались в наших предшествующих работах [11, 19, 21]. Поэтому ниже мы ограничимся краткой актуализацией имеющихся данных для исследуемого диапазона условий с подробным рассмотрение эффектов, возникающих при смешении CF4 и CHF3.
Из данных рис. 1a можно видеть, что замещение CF4 на CHF3 приводит к одновременному снижению средней энергии (температуры) электронов (${{T}_{e}}$ = 4.3–3.5 эВ при 0–91% CHF3) и концентраций заряженных частиц (${{n}_{ + }}$ ≈ ${{n}_{e}}$ = 1.5 × 1010–1.3 × 1010 см–3 при 0–91% CHF3). Причиной снижения ${{T}_{e}}$ являются более высокие потери энергии электронами наколебательное и электронное возбуждение CHF3 и HF по сравнению с такими процессами для CF4. Это подтверждается, например, сравнением сечений колебательного возбуждения [22]. Аналогичный характер изменения ${{n}_{ + }}$ и ${{n}_{e}}$ обусловлен уменьшением эффективных скоростей образования электронов и положительных ионов. Действительно, сравнение констант скоростей для
Рис. 1.
Электрофизические параметры плазмы в смеси CF4 + CHF3 + O2 в зависимости от соотношения CF4/CHF3: 1 – температура электронов (${{T}_{{\text{e}}}}$); 2 – концентрация электронов (${{n}_{{\text{e}}}}$) и суммарная концентрация положительных ионов (${{n}_{ + }}$); 3 – отрицательное смещение на подложкодержателе ($ - {{U}_{{dc}}}$); 4 – плотность потока энергии ионов ($\sqrt {{{\varepsilon }_{i}}} {{{\Gamma }}_{ + }}$). Условия процесса: $p$ = 10 мтор, $W$ = 500 Вт, ${{W}_{{dc}}}$ = 100 W, ${{y}_{{{{{\text{O}}}_{2}}}}}$ = 0.09.

показывает, что замещение CF4 на CHF3 обогащает газовую фазу трудно ионизуемыми частицами. Кроме этого, снижение ${{T}_{e}}$ вызывает аналогичные изменения констант скоростей ионизации всех нейтральных частиц. Все это закономерно приводит к снижению эффективной частоты ионизации. Противоположный характер изменения ${{n}_{ + }}$ и плотности ионного тока (${{j}_{ + }}$ = 0.36–0.40 мА/см2 при 0–91% CHF3) обусловлен уменьшение эффективной массы ионов (${{M}_{i}}$ = 62–36 при 0–91% CHF3) в соответствии с изменением типов доминирующих нейтральных частиц.
Расчеты показали, что концентрации фторуглеродных компонентов в плазме чистого тетрафторметана снижаются в ряду CF4 – CF3 – CF2 – CF. Такая ситуация обусловлена ступенчатым механизмом образования менее насыщенных радикалов в процессах под действием электронного удара, а также более высокими вероятностями их гетерогенной рекомбинации. Диссоциация CF4 и CF3 по механизмам R1,
обеспечивает ~85% общей скорости образования атомов фтора, при этом суммарный вклад от
Более заметный вклад ~10% вносит диссоциация молекул фтора
высокая концентрация которых поддерживается гетерогенной рекомбинацией 2F → F2. Соответственно, последний процесс представляет основной канал гибели атомов фтора. Переход к системе 91% CF4 + 9% O2 существенно снижает скорости генерации атомов фтора по механизмам R1, R4 и R5 из-за одновременного снижения ${{n}_{e}},$ ${{n}_{{{\text{C}}{{{\text{F}}}_{{\text{4}}}}}}}$ и ${{n}_{{{\text{C}}{{{\text{F}}}_{{\text{3}}}}}}}.$ В частности, более чем двукратное снижение ${{n}_{{{\text{C}}{{{\text{F}}}_{{\text{3}}}}}}}$ обусловлено протеканием атомно-молекулярных процессов
которые характеризуются высокими (~10–10–10–11 см3/с [23]) значениями констант скоростей. Аналогичное поведение ${{n}_{{{\text{C}}{{{\text{F}}}_{4}}}}}$ ожидаемо следует из снижения эффективности образования этих частиц в объемных и гетерогенных процессах вида CF3 + F → CF4. В то же время, добавка кислорода приводит к появлению дополнительных каналов образования атомов фтора по реакциям R9, R10 и
а также обеспечивает увеличение скорости R8. Эффективность R13 обусловлена высокими скоростями генерации CF2O в объемных процессах R9, R10,
и
Причиной второго эффекта является увеличение ${{n}_{{{{{\text{F}}}_{{\text{2}}}}}}}$ из-за образования молекул фтора по реакции
В результате, соотношение концентраций основных компонентов в плазме смеси 91% CF4 + + 9% O2 характеризуется условием ${{n}_{{\text{F}}}}$ ≈ ${{n}_{{{{{\text{F}}}_{{\text{2}}}}}}}$ ≈ ≈ ${{n}_{{{\text{C}}{{{\text{F}}}_{{\text{2}}}}{\text{O}}}}}$ > ${{n}_{{{\text{C}}{{{\text{F}}}_{x}}}}}$ (x = 1–3) (рис. 2а).
Рис. 2.
Стационарные концентрации нейтральных компонентов газовой фазы (а) и отношения плотностей потоков частиц (б) в смеси CF4 + CHF3 + O2 в зависимости от соотношения CF4/CHF3. Обозначения кривых на рис. (б)): “pol/F” – ${{{{{\Gamma }}_{{{\text{pol}}}}}} \mathord{\left/ {\vphantom {{{{{\Gamma }}_{{{\text{pol}}}}}} {{{{\Gamma }}_{{\text{F}}}}}}} \right. \kern-0em} {{{{\Gamma }}_{{\text{F}}}}}};$ “pol/F+” – ${{{{{\Gamma }}_{{{\text{pol}}}}}} \mathord{\left/ {\vphantom {{{{{\Gamma }}_{{{\text{pol}}}}}} {\sqrt {{{\varepsilon }_{i}}} {{{\Gamma }}_{ + }}}}} \right. \kern-0em} {\sqrt {{{\varepsilon }_{i}}} {{{\Gamma }}_{ + }}}}{{{\Gamma }}_{{\text{F}}}},$ 10–17; “pol/F+” – ${{{{{\Gamma }}_{{{\text{pol}}}}}} \mathord{\left/ {\vphantom {{{{{\Gamma }}_{{{\text{pol}}}}}} {{{{\Gamma }}_{{\text{F}}}}{{{\Gamma }}_{{\text{O}}}},}}} \right. \kern-0em} {{{{\Gamma }}_{{\text{F}}}}{{{\Gamma }}_{{\text{O}}}},}}$ 10–14; “F/+” – ${{{{{\Gamma }}_{{\text{F}}}}} \mathord{\left/ {\vphantom {{{{{\Gamma }}_{{\text{F}}}}} {\sqrt {{{\varepsilon }_{i}}} }}} \right. \kern-0em} {\sqrt {{{\varepsilon }_{i}}} }}{{{\Gamma }}_{ + }}.$ Условия процесса соответствуют рис. 1.
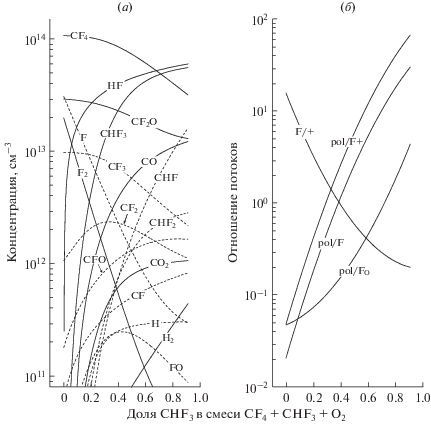
Увеличение доли CHF3 в плазмообразующей смеси (фактически – замещение CF4 на CHF3 при ${{y}_{{{{{\text{O}}}_{{\text{2}}}}}}}$ = const) вызывает два принципиальных изменения в кинетике атомов фтора. Во-первых, это появление эффективных механизмов конверсии F → HF в объемных процессах
и
Высокая концентрация молекул HF в плазме CHF3 отмечалась ранее в работах [7, 8, 21]. И, во-вторых, имеет место снижение скорости образования атомов фтора в процессах под действием электронного удара. Причина этого – низкая эффективность диссоциации
и
по сравнению с CF4 (${{k}_{1}} + {{k}_{4}}$ = 8.3 × 10–10 см3/c при ${{T}_{e}}$ = 4 эВ). Совместное действие обоих факторов обеспечивает быстрое снижение концентрации атомов фтора (${{n}_{{\text{F}}}}$ = 3.1 × 1013–4.5 × 1011 см–3 при 0–91% CHF3, см. рис. 2а).
Основными источниками атомов водорода в плазме CF4 + CHF3 + O2 являются реакции R21 and
Увеличение суммарной скорости образования атомов водорода с ростом ${{y}_{{{\text{CH}}{{{\text{F}}}_{{\text{3}}}}}}}$ частично компенсируется аналогичным имением частот их гибели по механизму R18 из-за роста ${{n}_{{{\text{CH}}{{{\text{F}}}_{x}}}}}.$ Поэтому величина ${{n}_{{\text{H}}}}$ достигает насыщения ~3.1 × 1011 см–3 уже при ${{y}_{{{\text{CH}}{{{\text{F}}}_{{\text{3}}}}}}}$ > 20%. Образование атомов кислорода обеспечивается, в основном, реакциями
Суммарная скорость этих процессов остается практически неизменной, что определяется поведением скоростей
в условиях ${{y}_{{{{{\text{O}}}_{2}}}}}$ = const. В то же время, гибель атомов кислорода в реакциях вида CHFx + O → CFxO + + H ($k$ ~ 1.0 × 10–11 см3/с) менее эффективна по сравнению с CFx + O → CFx –1O + F ($k$ ~ 3.2 × × 10–11 см3/с). Поэтому рост параметра ${{y}_{{{\text{CH}}{{{\text{F}}}_{{\text{3}}}}}}}$ сопровождается увеличением концентрации атомов кислорода в газовой фазе (${{n}_{{\text{O}}}}$ = 1.9 × 109–3.3 × 1010 см–3 при 0–91% CHF3, см. рис. 2а). Доминирующими фторуглеродными радикалами в условиях ${{y}_{{{\text{CH}}{{{\text{F}}}_{{\text{3}}}}}}}$ < < 60% являются CFx (x = 2, 3), при этом дальнейшее увеличение доли CHF3 в плазмообразующей смеси изменяет ситуацию на ${{n}_{{{\text{CHF}}}}}$ > ${{n}_{{{\text{C}}{{{\text{F}}}_{x}}}}}.$ Это обусловлено ростом суммарной скорости образования CHFпо R18 и
а также увеличением скорости гибели CFx (x = 2, 3) в R19.
3.2. Кинетика и механизм травления Si
Известно, что механизм травления кремния в плазме CF4 представляет комбинацию спонтанной и ионно-стимулированной химической реакции
(R29)
${\text{S}}{{{\text{i}}}_{{\left( s \right)}}} + x{{{\text{F}}}_{{\left( s \right)}}} \to {\text{Si}}{{{\text{F}}}_{{x\left( s \right)}}},$(R31)
${\text{Si}}{{{\text{F}}}_{{x = 1,2,3\left( s \right)}}}\xrightarrow{{{\text{ионы}}}}{\text{Si}}{{{\text{F}}}_{{x = 1,2,3}}},$Рис. 3.
Кинетика травления кремния в смеси CF4 + CHF3 + O2 в зависимости от соотношения CF4/CHF3: 1 – скорость травления; 2 – вероятность взаимодействия для F; 3 – вероятность взаимодействия для F + HF. Условия процесса соответствуют рис. 1.
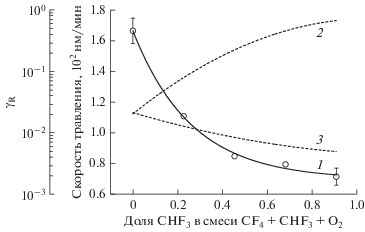
По данным работ [5, 24–26] можно заключить, что характер изменения ${{\gamma }_{R}}$ при ${{T}_{S}}$ = const зависит от:
1) интенсивности ионной бомбардировки, определяющей скорость ионно-стимулированной десорбции продуктов реакции;
2) толщины фторуглеродной полимерной пленки hpol, ограничивающей доступ атомов фтора к обрабатываемой поверхности.
Первый фактор количественно характеризуется параметром $\sqrt {{{\varepsilon }_{i}}} {{{\Gamma }}_{ + }}$ [27, 28], где ${{{\Gamma }}_{ + }} \approx {{{{j}_{ + }}} \mathord{\left/ {\vphantom {{{{j}_{ + }}} e}} \right. \kern-0em} e}$ – поток ионов, а ${{\varepsilon }_{i}} \approx e\left| { - {{U}_{f}} - {{U}_{{dc}}}} \right|$ – их энергия, определяемая суммой плавающего потенциала ($ - {{U}_{f}}$) и отрицательного смещения на подложке ($ - {{U}_{{dc}}}$). Величина ${{h}_{{{\text{pol}}}}}$формируется совокупностью скоростей осаждения и разрушения полимерной пленки. Ранее в работах [29, 30] было показано, что скорость осаждения полимера во фторуглеродной плазме характеризуется параметром ${{{{{\Gamma }}_{{{\text{pol}}}}}} \mathord{\left/ {\vphantom {{{{{\Gamma }}_{{{\text{pol}}}}}} {{{{\Gamma }}_{{\text{F}}}}}}} \right. \kern-0em} {{{{\Gamma }}_{{\text{F}}}}}},$ где ${{{\Gamma }}_{{{\text{pol}}}}} = {{{\Gamma }}_{{{\text{C}}{{{\text{F}}}_{2}}}}} + {{{\Gamma }}_{{{\text{CF}}}}} + {{{\Gamma }}_{{{\text{CHF}}}}}$ – суммарный поток полимеробразующих радикалов. Соответственно, изменение баланса полимеризация/травления за счет разрушения полимерной пленки по физическому (ионная бомбардировка) и химическому (травление атомами кислорода) механизмам может быть отслежено отношениями ${{{{{\Gamma }}_{{{\text{pol}}}}}} \mathord{\left/ {\vphantom {{{{{\Gamma }}_{{{\text{pol}}}}}} {\sqrt {{{\varepsilon }_{i}}} }}} \right. \kern-0em} {\sqrt {{{\varepsilon }_{i}}} }}{{{\Gamma }}_{ + }}{{{\Gamma }}_{{\text{F}}}}$ и ${{{{{\Gamma }}_{{{\text{pol}}}}}} \mathord{\left/ {\vphantom {{{{{\Gamma }}_{{{\text{pol}}}}}} {{{{\Gamma }}_{{\text{O}}}}{{{\Gamma }}_{{\text{F}}}}}}} \right. \kern-0em} {{{{\Gamma }}_{{\text{O}}}}{{{\Gamma }}_{{\text{F}}}}}},$ соответственно. Из рис. 1б можно видеть, что параметр $\sqrt {{{\varepsilon }_{i}}} {{{\Gamma }}_{ + }}$ сохраняет близкое к постоянному значение ~4.5 × 1016 эВ1/2см–2 с–1 во всем исследованном диапазоне состава смеси. Причиной этого является то, что слабое увеличение потока ионов (${{{\Gamma }}_{ + }}$ = 2.3 × 1015–2.5 × 1015 см–2 с–1 при 0–91% CHF3) компенсируется снижением энергии ионов (${{\varepsilon }_{i}}$ = 358–319 эВ при 0–91% CHF3) из-за аналогичного изменения $ - {{U}_{{dc}}}.$ Таким образом, трудно ожидать, что увеличение ${{y}_{{{\text{CH}}{{{\text{F}}}_{{\text{3}}}}}}}$ приводит к интенсификации ионно-стимулированной десорбции продуктов травления (R31). Кроме того, данные рис. 2б показывают, что имеет место значительный рост параметров ${{{{{\Gamma }}_{{{\text{pol}}}}}} \mathord{\left/ {\vphantom {{{{{\Gamma }}_{{{\text{pol}}}}}} {\sqrt {{{\varepsilon }_{i}}} }}} \right. \kern-0em} {\sqrt {{{\varepsilon }_{i}}} }}{{{\Gamma }}_{ + }}{{{\Gamma }}_{{\text{F}}}}$ (в ~1400 раз при 0–91% CHF3) and ${{{{{\Gamma }}_{{{\text{pol}}}}}} \mathord{\left/ {\vphantom {{{{{\Gamma }}_{{{\text{pol}}}}}} {{{{\Gamma }}_{{\text{O}}}}{{{\Gamma }}_{{\text{F}}}}}}} \right. \kern-0em} {{{{\Gamma }}_{{\text{O}}}}{{{\Gamma }}_{{\text{F}}}}}}$ (в ~85 раз при 0–91% CHF3). Это обусловлено резким увеличением скорости осаждения полимерной пленки
которое с избытком компенсирует изменение $\sqrt {{{\varepsilon }_{i}}} {{{\Gamma }}_{ + }}$ и ${{{\Gamma }}_{{\text{O}}}}.$ Очевидно, что такая ситуация отвечает росту ${{h}_{{{\text{pol}}}}}$ и снижению скорости R28. Таким образом, реакционный механизм R28–R31 не может объяснить увеличение эффективной вероятности взаимодействия атомов фтора с ростом доли CHF3 в плазмообразующей смеси.
Отмеченное выше противоречие позволяет предположить, что атомы фтора не являются единственным типом активных частиц, обеспечивающих травление кремния в данной газовой системе. В частности, ранее было показано, что молекулы HF эффективно реагируют с поверхностью Si, SiO2 и Si3N4 в газовом (без возбуждения плазмы) процессе в присутствии воды или метанола [31–34]. В работе [32] была предложена простая реакционная схема, обеспечивающая хорошее согласие измеренных и расчетных скоростей травления в системе HF + SiO2. Применительно к плазменному процессу в смеси CF4 + CHF3 + O2, данный механизм может быть интерпретирован в виде двух положений:
1) совместное действие атомов O и H приводит к образованию на поверхности гидроксисоединений вида Si(OH)x;
2) взаимодействие высокополярных OH групп с адсорбированными молекулами HF вызывает диссоциацию последних. Таким образом, “стандартный” механизм травления R28–R31 может быть дополнен следующими процессами:
(R35)
${\text{S}}{{{\text{i}}}_{{\left( s \right)}}} + x{{{\text{O}}}_{{\left( s \right)}}} + x{{{\text{H}}}_{{\left( s \right)}}} \to {\text{Si}}{{\left( {{\text{OH}}} \right)}_{{x\left( s \right)}}},$(R36)
${\text{Si}}{{\left( {{\text{OH}}} \right)}_{{x\left( s \right)}}} + x{\text{H}}{{{\text{F}}}_{{\left( s \right)}}} \to ~x{{{\text{H}}}_{{\text{2}}}}{\text{O}} + {\text{Si}}{{{\text{F}}}_{{x\left( s \right)}}}.$Из данных рис. 2а можно заключить, что увеличение концентрации HF с ростом ${{y}_{{{\text{CH}}{{{\text{F}}}_{{\text{3}}}}}}},$ а также выполнение условия ${{n}_{{{\text{HF}}}}}$ > ${{n}_{{\text{F}}}}$ начиная с ${{y}_{{{\text{CH}}{{{\text{F}}}_{{\text{3}}}}}}}$ > 10% обеспечивают монотонный рост суммарного потока химически активных частиц на обрабатываемую поверхность (${{{\Gamma }}_{{\text{F}}}} + {{{\Gamma }}_{{{\text{HF}}}}}$ = 6.3 × 1017–1.3 × × 1018 см–2с–1, или в ∼2 раза при 0–91% CHF3). Предполагая, что индивидуальные вероятности взаимодействия F и HF с поверхностью кремния являются величинами одного порядка, эффективная вероятность химического взаимодействия для процесса в целом может быть охарактеризована отношением ${{{{R}_{{{\text{Si}}}}}} \mathord{\left/ {\vphantom {{{{R}_{{{\text{Si}}}}}} {\left( {{{{\Gamma }}_{{\text{F}}}} + {{{\Gamma }}_{{{\text{HF}}}}}} \right)}}} \right. \kern-0em} {\left( {{{{\Gamma }}_{{\text{F}}}} + {{{\Gamma }}_{{{\text{HF}}}}}} \right)}}.$ Из рис. 3 можно видеть, что данный параметр монотонно снижается в диапазоне 2.2 × 10–2–4.8 × 10–3, или в ~4.6 раз при 0–91% CHF3. По нашему мнению, такое поведение хорошо согласуется с увеличением ${{h}_{{{\text{pol}}}}},$ вызывающим, в свою очередь, снижение скоростей R29 иR32–R34. Снижение эффективной вероятности взаимодействия и выхода травления кремния и его соединений с ростом толщины фторуглеродной полимерной пленки неоднократно отмечалось ранее в экспериментальных работах [24, 26, 35, 36]. Поэтому можно с достаточной степенью уверенности полагать, что набор процессов R28–R36 адекватно отражает механизм травления кремния в смеси CF4 + CHF3 + O2.
В заключении отметим, что предложенный механизм травления кремния в плазме смеси CF4 + + CHF3 + O2 обеспечивает лишь качественное описание этого процесса в силу очевидных упрощений в исходных предпосылках. В то же время, он не противоречит эксперименту, имеет хорошее согласие с литературными данными, а также обеспечивает понимание взаимосвязей между объемной и гетерогенной подсистемами. Последнее является особенно важным для оптимизации режимов проведения процессов плазменного травления в многокомпонентных газовых смесях.
ЗАКЛЮЧЕНИЕ
Проведено исследование влияния соотношения фторуглеродных компонентов в смеси CF4 + + CHF3 + O2 на электрофизические параметры плазмы, стационарные концентрации активных частиц и кинетику их взаимодействия с кремнием. Установлено, что замещение CF4 на C4F8 при постоянном содержании O2 и неизменных внешних параметрах плазмы:
1) оказывает влияние на кинетику процессов под действием электронного удара через изменение температуры (средней энергии) и концентрации электронов;
2) приводит к снижению концентрации атомов фтора, но к росту концентраций атомов водорода и кислорода;
3) смещает баланс процессов осаждения/деструкции фторуглеродной полимерной пленки в сторону осаждения из-за увеличения концентрации полимеробразующих радикалов.
Показано, что наблюдаемое поведение скорости травления кремния и эффективной вероятности химического взаимодействия в гетерогенной подсистеме может быть объяснено реакциями с участием молекул HF. Предположено, что в исследованном диапазоне условий процесс травления протекает в режиме лимитирования потоком химически активных частиц (F + HF) и характеризуется эффективной вероятностью, зависящей от толщины фторуглеродной полимерной пленки.
Исследование выполнено при финансовой поддержке РФФИ в рамках научного проекта № 18-37-00064 мол_а.
Список литературы
Rossnagel S.M., Cuomo J.J., Westwood W.D. (Eds.). Handbook of plasma processing technology. Noyes Publications, Park Ridge, 1990. 338 p.
Rooth J.R. Industrial Plasma Engineering // IOP Publishing LTD, Philadelphia, 1995. 620 p.
Roosmalen A.J., Baggerman J.A.G., Brader S.J.H. Dry etching for VLSI // Plenum Press, New-York, 1991. 490 p.
Wolf S., Tauber R.N. Silicon Processing for the VLSI Era. Volume 1. Process Technology. Lattice Press, New-York, 2000. 416 p.
Lieberman M.A., Lichtenberg A.J. Principles of plasma discharges and materials processing. John Wiley & Sons Inc. New York, 1994. 757 p.
Jansen H., Gardeniers H., de Boer M., Elwenspoek M., Fluitman J. A survey on the reactive ion etching of silicon in microtechnology // J. Micromech. Microeng. 1996. V. 6. P. 14–28.
Turban G., Grolleau B., Launay P., Briaud P. A mass spectrometric diagnostic of C2F6 and CHF3 plasmas during etching of SiO2 and Si // Revue Phys. Appl. 1985. V. 20. P. 609–620.
Takahashi K., Hori M., Goto T. Characteristics of fluorocarbon radicals and CHF3 molecule in CHF3 electron cyclotron resonance downstream plasma // Jpn. J. Appl. Phys. 1994. V. 33. P. 4745–4758.
Kimura T., Ohe K. Model and probe measurements of inductively coupled CF4 discharges // J. Appl. Phys. 2002. V. 92. P. 1780–1787.
Kimura T., Ohe K. Probe measurements and global model of inductively coupled Ar/CF4 discharges // Plasma Sources Sci. Technol. 1999. V. 8. P. 553–560.
Chun I., Efremov A., Yeom G.Y., Kwon K.-H. A comparative study of CF4/O2/Ar and C4F8/O2/Ar plasmas for dry etching applications // Thin Solid Films. 2015. V. 579. P. 136–143.
Ho P., Johannes J.E., Buss R.J. Modeling the plasma chemistry of C2F6 and CHF3 etching of silicon dioxide, with comparisons to etch rate and diagnostic data // J. Vac. Sci. Technol. A. 2001. V. 19. P. 2344–2367.
Bose D., Rao M.V.V.S., Govindan T.R., Meyyappan M. Uncertainty and sensitivity analysis of gas-phase chemistry in a CHF3 plasma // Plasma Sources Sci. Technol. 2003. V. 12. P. 225–234.
Proshina O., Rakhimova T.V., Zotovich A., Lopaev D.V., Zyryanov S.M., Rakhimov A.T. Multifold study of volume plasma chemistry in Ar/CF4 and Ar/CHF3 CCP discharges // Plasma Sources Sci. Technol. 2017. V. 26. P. 075005.
Son J., Efremov A., Yun S.J., Yeom G.Y., Kwon K.-H. Etching characteristics and mechanism of SiNx films for Nano-Devices in CH2F2/O2/Ar inductively coupled plasma: Effect of O2 mixing ratio // J. Nanosci. Nanotech. 2014. V. 14. P. 9534–9540.
Johnson E.O., Malter L. A floating double probe method for measurements in gas discharges // Phys. Rev. 1950. V. 80. P. 58–70.
Sugavara M. Plasma etching: Fundamentals and applications. Oxford University Press, New-York, 1998. 469 p.
Efremov A., Lee J., Kwon K.-H. A comparative study of CF4, Cl2 and HBr + Ar inductively coupled plasmas for dry etching applications // Thin Solid Films. 2017. V. 629. P. 39–48.
Lim N., Efremov A., Yeom G.Y., Kwon K.-H. On the etching characteristics and mechanisms of HfO2 thin films in CF4/O2/Ar and CHF3/O2/Ar plasma for nano-devices // J. Nanosci. Nanotechnol. 2014. V. 14. P. 9670–9679.
Son J., Efremov A., Chun I., Yeom G.Y., Kwon K.-H. On the LPCVD-Formed SiO2 Etching Mechanism in CF4/Ar/O2 Inductively Coupled Plasmas: Effects of Gas Mixing Ratios and Gas Pressure // Plasma Chem. Plasma Proc. 2014. V. 34. P. 239–257.
Efremov A., Kwon K.-H., Morgunov A., Shabadarova D. Comparative study of CF4- and CHF3-based plasmas for dry etching applications. Proc. SPIE 10224, International Conference on Micro- and Nano-Electronics 2016, 102241W (30 December 2016).
Chistophorou L.G., Olthoff J.K. Fundamental electron interactions with plasma processing gases. Springer Science + Business Media, LLC. New-York. 2004. 780 p.
NIST Chemical Kinetics Database. http://kinetics.nist.gov/ kinetics/.
Standaert T.E.F.M., Hedlund C., Joseph E.A., Oehrlein G.S. Role of fluorocarbon film formation in the etching of silicon, silicon dioxide, silicon nitride, and amorphous hydrogenated silicon carbide // J. Vac. Sci. Technol. A. 2004. V. 22. P. 53–60.
Stoffels W.W., Stoffels E., Tachibana K. Polymerization of fluorocarbons in reactive ion etching plasmas // J. Vac. Sci. Tech. A. 1998. V. 16. P. 87–95.
Matsui M., Tatsumi T., Sekine M. Relationship of etch reaction and reactive species flux in C4F8–Ar–O2 plasma for SiO2 selective etching over Si and Si3N4 // J. Vac. Sci. Technol. A. 2001. V. 19. P. 2089–2096.
Gray D.C., Tepermeister I., Sawin H.H. Phenomenological modeling of ion enhanced surface kinetics in fluorine-based plasma etching // J. Vac. Sci. Technol. B. 1993. V. 11. P. 1243–1257.
Lee C., Graves D.B., Lieberman M.A. Role of etch products in polysilicon etching in a high-density chlorine discharge // Plasma Chem. Plasma Proc. 1996. V. 16. P. 99–118.
Efremov A.M., Murin D.B., Kwon K.H. On the effect of the ratio of concentrations of fluorocarbon components in a CF4 + C4F8 + Ar mixture on the parameters of plasma and SiO2/Si etching selectivity // Russian Microelectronics. 2018. V. 47. № 4. P. 239–246.
Efremov A.M., Murin D.B., Kwon K.H. Parameters of plasma and kinetics of active particles in CF4(CHF3) + + Ar mixtures of a variable initial composition // Russian Microelectronics. 2018. V. 47. № 6. P. 371–380.
Jang W.I., Choi C.A., Lee M.L., Jun C.H., Kim Y.T. Fabrication of MEMS devices by using anhydrous HF gas-phase etching with alcoholic vapor // J. Micromech. Microeng. 2002. V. 12. P. 297–306.
Clements L.D., Busse J.E., Mehta J. Reaction mechanisms and rate limitations in dry etching of silicon dioxide with hydrous hydrogen fluoride // Semiconductor Fabrication; Technology and Metrology. 1989. ASTM STP 990. P. 182–201.
Hoshino T., Nishioka Y. Etching process of SiO2 by HF molecules // J. Chem. Phys. 1999. V. 111. P. 2109–2114.
Jang W.I., Choi C.A., Lee C.S., Hong Y.S., Lee J.H., Kim B.W., Kim D.Y. Optimal gas-phase etching for the dry release of polysilicon and SOI microstructures // J. Korean Phys. Soc. 1999. V. 34. P. 69–74.
Kastenmeier B.E.E., Matsuo P.J., Beulens J.J., Oehrlein G.S. Chemical dry etching of silicon nitride and silicon dioxide using CF4/O2/N2 gas mixtures // J. Vac. Sci. Technol. A. 1996. V. 14. P. 2802–2813.
Kastenmeier B.E.E., Matsuo P.J., Oehrlein G.S. Highly selective etching of silicon nitride over silicon and silicon dioxide // J. Vac. Sci. Technol. A. 1999. V. 17. P. 3179–3184.
Дополнительные материалы отсутствуют.
Инструменты
Микроэлектроника


