Микроэлектроника, 2021, T. 50, № 1, стр. 36-42
Модификация пленок диазохинон-новолачного фоторезиста имплантацией ионов сурьмы
С. Д. Бринкевич a, Д. И. Бринкевич a, *, В. С. Просолович a, **
a Белорусский государственный университет
220013 г. Минск, ул. П. Бровки, 6, Беларусь
* E-mail: Brinkevich@bsu.by
** E-mail: prosolovich@bsu.by
Поступила в редакцию 20.05.2020
После доработки 20.05.2020
Принята к публикации 26.05.2020
Аннотация
Методом ИК-Фурье спектроскопии нарушенного полного внутреннего отражения (НПВО) исследованы радиационно-индуцированные процессы, протекающие при имплантации ионов сурьмы в пленки позитивного диазохинон-новолачного фоторезиста ФП9120 на кремнии. Установлено, что ионная имплантация приводит к появлению в спектре НПВО полосы при 2331 см–1, обусловленной валентными колебаниями О=С=О. Нарушение адгезии на границе раздела фоторезист/кремний проявляется в появлении полосы 610 см–1, связанной с решеточным поглощением Si. Обнаружено образование новых С–О–С связей в результате эфирных сшивок кетена с ОН-группой новолачной смолы.
ВВЕДЕНИЕ
В настоящее время литография является одним из основных процессов в общем цикле изготовления широкого класса полупроводниковых приборов и интегральных микросхем. В качестве масок в процессах субмикронной и нанолитографии широко используются диазохинон-новолачные (ДХН) резисты [1–4]. Одним из основных методов формирования легированных областей в современной электронике является ионная имплантация (ИИ). Она позволяет с высокой точностью управлять концентрацией легирующей примеси, характеризуется универсальностью и гибкостью процесса. Взаимодействие ДХН-резистов с ультрафиолетовым, рентгеновским и видимым излучением исследовано достаточно подробно, в то время как процессы, индуцированные ионным облучением, плохо изучены, несмотря на то, что они могут оказывать существенное влияние на качество создаваемых приборов [4–6].
Ранее показано, что при ионной имплантации полимеров радиационно-индуцированные процессы протекают не только в области пробега ионов, но и за его пределами [5, 7–9]. Так в [5] было обнаружено радиационное упрочнение пленок диазохинон-новолачного резиста за слоем внедрения ионов сурьмы. Однако механизм радиационно-индуцированных процессов, ответственных за изменение физико-механических свойств ДХН-резистов за слоем внедрения ионов, не был установлен.
Для исследования тонких пленок широко применяется метод ИК-Фурье спектроскопии нарушенного полного внутреннего отражения (НПВО), позволяющий получать качественную и количественную информацию о составе и структуре сложных органических соединений и их смесей в твердом агрегатном состоянии [10]. Отметим, что ранее метод НПВО для исследования пленок ДХН-фоторезистов на поверхности пластин монокристаллического кремния, не применялся. В настоящей работе с целью установления механизмов радиационно-индуцированной модификации физико-механических свойств пленок ДХН фоторезистов (ФР) при имплантации ионов сурьмы был использован метод ИК-Фурье спектрометрии НПВО.
МЕТОДИКА ЭКСПЕРИМЕНТА
Позитивный фоторезист ФП9120 представляет собой композит из светочувствительного o-нафтохинондиазида и фенол-формальдегидной смолы. Пленки ФР толщиной 1.8 мкм наносились на поверхность пластин кремния р-типа (ρ = 10 Ом ∙ см) с ориентацией (111) методом центрифугирования при скорости вращения v = = 2900 об./мин [11]. Перед формированием пленки фоторезиста пластины кремния подвергали стандартному циклу очистки поверхности в органических и неорганических растворителях и отмывке в деионизованной воде. После нанесения фоторезиста на рабочую сторону пластины проводилась ее сушка в течение 50–55 мин при температуре 88°С. Толщина пленок фоторезиста контролировалась с помощью профилометра “Dectak”.
Имплантация ионами сурьмы Sb+ проводилась с энергией 60 кэВ в интервале доз Ф = 1 × 1015–5 × 1016 см–2 при плотности ионного тока j = = 4 мкA/cм2 в остаточном вакууме не хуже 10‒5 мм рт. ст. на ионно-лучевом ускорителе “Везувий-6”. Спектры НПВО структур фоторезист-кремний в диапазоне волновых чисел ν = 400–4000 см–1 регистрировались при комнатной температуре ИК-Фурье спектрофотометром ALPHA (Bruker Optik GmbH). Разрешение было не хуже 2 см–1, количество сканов – 24. Коррекция фона проводилась перед каждым измерением.
ЭКСПЕРИМЕНТАЛЬНЫЕ РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
Спектры НПВО исходных и имплантированных пленок диазохинон-новолачного фоторезиста ФП9120 на кремнии представлены на рис. 1. При анализе экспериментальных данных необходимо учитывать, что в процессе записи ИК-спектров НПВО глубина проникновения dэф светового луча в образец зависит от длины волны λ, показателей преломления призмы n2 и образца n1, угла падения α и рассчитывается по формуле [10]:
(1)
${{d}_{{'{\text{эф}}}}} = \frac{{{{{\left( {{{{{n}_{1}}} \mathord{\left/ {\vphantom {{{{n}_{1}}} {{{n}_{2}}}}} \right. \kern-0em} {{{n}_{2}}}}} \right)}}^{2}}\frac{\lambda }{{{{n}_{1}}}}\cos \alpha }}{{\pi \left[ {1 - {{{\left( {\frac{{{{n}_{1}}}}{{{{n}_{2}}}}} \right)}}^{2}}} \right]{{{\left[ {{{{\sin }}^{2}}\alpha - {{{\left( {\frac{{{{n}_{1}}}}{{{{n}_{2}}}}} \right)}}^{2}}} \right]}}^{{{1 \mathord{\left/ {\vphantom {1 2}} \right. \kern-0em} 2}}}}}}.$Рис. 1.
Спектры НПВО исходных (1) и имплантированных Sb+ дозой 5 × 1016 см–2 (2) пленок ФП9120 на кремнии.
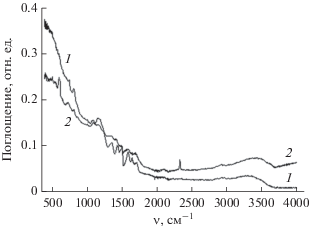
В условиях нашего эксперимента – материал призмы – алмаз (n2 = 2.42) [12], угол падения – 40°, показатель преломления фоторезиста n1 = 1.52 [11]. Следовательно, согласно формуле (1) глубина проникновения излучения в фоторезистивную пленку составляет dэф ~ 0.45 λ. Таким образом, эффективная глубина проникновения луча при волновых числах менее 2000 см–1 превышает геометрическую толщину исследуемых пленок. При этом излучение частично отражается от кремниевой подложки; это отражение от границы раздела резист/кремний необходимо учитывать при анализе экспериментальных результатов.
Было установлено, что ионная имплантация приводит к увеличению фонового поглощения в диапазоне волновых чисел свыше 1800 см–1 (рис. 1). Это обусловлено, вероятнее всего, поглощением/рассеянием излучения на нарушениях, созданных ионной имплантацией в области пробега ионов. Кроме того, имплантация фоторезиста приводит к уменьшению коэффициента преломления n1 [11], что согласно формуле (1) должно приводить к увеличению dэф и, соответственно, к росту интенсивности как фонового поглощения, так и полос поглощения.
После имплантации Sb+ дозой свыше 5 × × 1015 см–2 в спектрах НПВО появляется узкая симметричная полоса с максимумом при 2331 см–1. Ее интенсивность растет пропорционально увеличению дозы имплантации (рис. 2). Этот диапазон волновых чисел характерен для валентных колебаний кумулятивных двойных связей [13, 14]. Вероятнее всего, указанная полоса обусловлена ассиметричными валентными колебаниями О=С=О. Так, колебания СО2 в газах дают очень сильную полосу поглощения с максимумом при 2349 см–1, используемую для градуировки спектрофотометров [13]. В жидких растворителях газообразный СО2 согласно [14] обуславливает поглощение в диапазоне волновых чисел 2325–2335 см–1.
Рис. 2.
Спектры НПВО исходной (1) и имплантированных Sb+ дозами 1 × 1016 см–2 (2) и 5 × 1016 см–2 (3) пленок ФП9120 в области двойных кумулятивных связей.

Основной причиной появления в спектре имплантированных пленок резиста полосы 2331 см–1, вероятнее всего, является радиационно-индуцированное разложение остаточных растворителей, которые содержат ацетатный фрагмент, например, бутилацетата, 2-метоксиэтилацетата. Эти вещества входят в состав рецептур растворов ДХН-резистов. Поскольку их температуры кипения составляют 126 и 145°С соответственно, они полностью не удаляются из тонких пленок при сушке. Жесткая структура сетки фенол-формальдегидной смолы может удерживать небольшие количества растворителей даже при глубоком вакууме в процессе ионной имплантации.
Ранее было показано [8], что радиационно-индуцированные превращения в объеме ДХН-резиста происходят вследствие переноса энергии (в форме электронного возбуждения частиц) по макромолекулам полимера из области термализации ионов. Растворители, будучи алифатическими соединениями, обладают значительно меньшей стойкостью к процессам деструкции по сравнению с фенол-формальдегидной смолой. Одним из механизмов распада этих ацетатов будет деструкция связи –C–O– с последующим быстрым отщеплением CO2 по следующей схеме:
При облучении органических сложных эфиров, в том числе и ацетатов, СО2 является одним из основных продуктов радиолиза [15]. Тот факт, что мы регистрируем СО2 в качестве продукта радиолиза ДХН-резиста может быть связан как с малой скоростью диффузии этого газообразного соединения в объеме полимера, так и с формированием у поверхности пленки в области пробега ионов (вследствие термализации ионов Sb+) своеобразной “корки” из плотно сшитого полимерного компаунда, снижающего унос СО2 и других летучих продуктов из пленки в условиях глубокого вакуума при ИИ.
В низкоэнергетичной области после имплантации Sb+ в диапазоне волновых чисел 590–610 см–1 появляется широкая структурированная полоса с несколькими слабо выраженными максимумами, а также низко интенсивная полоса при ~510 см–1 (рис. 3). Интенсивность этих полос с увеличением дозы имплантации существенным образом не изменялась (кривые 2, 3 рис. 3). Аналогичные полосы с существенно большей интенсивностью наблюдаются в спектре НПВО кремниевой подложки (кривая 4 рис. 3) и связаны с решеточным поглощением Si [16].
Рис. 3.
Спектры НПВО исходной (1) и имплантированных Sb+ дозами 1 × 1015 см–2 (2) и 5 × 1016 см–2 (3) пленок ФП9120 и кремниевой подложки (4).
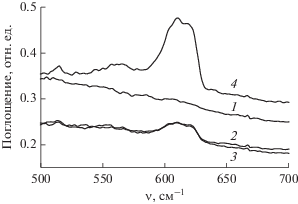
Появление в спектре НПВО полосы в диапазоне волновых чисел 590–610 см–1 и низкоинтенсивной полосы при ~510 см–1 обусловлено следующими обстоятельствами. Как отмечалось выше, эффективная глубина проникновения излучения в фоторезистивную пленку составляет dэф ~ 0.45 λ. В диапазоне волновых чисел 500–700 см–1dэф ~ ~ 16 мкм, что почти на порядок величины превосходит толщину фоторезистивной пленки. Таким образом, в указанном диапазоне имеет место отражение излучения от границы раздела резист/кремний, что и обуславливает появление в спектре НПВО фоторезистивной пленки полосы в диапазоне волновых чисел 590–610 см–1. Ее проявление после внедрения ионов Sb+ связано с ухудшением адгезии фоторезистивной пленки к кремнию. Резкое снижение адгезии (вплоть до отслоения) после имплантации Sb+ в фоторезистивную пленку ФП9120 на кремнии отмечалось ранее в работе [5]. С другой стороны, в работе [17] обнаружено усиление отражения в имплантированных сурьмой пленках диазохинон-новолачного резиста на кремнии. Эти экспериментальные данные подтверждают высказанное выше предположение, что полосы в диапазоне волновых чисел 590–610 см–1 и при ~510 см–1 обусловлены отражением излучения от кремния. Отметим, что усиление отражения от границы раздела резист/кремний при имплантации Sb+ обуславливает также снижение фонового поглощения на 15–20% по сравнению с необлученной пленкой в диапазоне волновых чисел 400–1200 см–1 (рис. 1).
Об ухудшении адгезии пленки ФР к кремнию свидетельствует также исчезновение после имплантации максимума полосы НПВО при ~1070 см–1, наблюдавшегося в исходных образцах на низкоэнергетичном крыле полосы с максимумом при 1100 см–1 (рис. 4). При дозе 1 × 1015 см–1 его интенсивность снижается, а при Ф ≥ 5 × 1015 см–1 он не проявляется вообще. Отметим, что полоса с максимумом при 1070 см–1 является наиболее интенсивной полосой ИК поглощения в тетраэтоксисилане и обусловлена валентными ассиметричными колебаниями Si–O–C группы [18]. Согласно [8] эта группа обеспечивает адгезию пленки ФП9120 к кремнию.
Рис. 4.
Спектры НПВО исходной (1) и имплантированных Sb+ дозами 1 × 1015 см–2 (2) и 5 × 1016 см–2 (3) пленок ФП9120 в области валентных колебаний Si–O–C и С–О связей.

По нашему мнению, к снижению адгезии ДХН-резиста к кремниевой пластине может приводить целый ряд факторов, включая изменение плотности полимера вследствие сшивания макромолекул в объеме, деформация пленки из-за формирования компаунда в зоне термализации ионов Sb+, а также накопление газообразных и легколетучих продуктов радиолиза на границе раздела фаз полимер-кремний.
Интенсивность полосы в диапазоне волновых чисел 1150–1230 см–1, обусловленной валентными колебаниями С–О связей в феноксильной группе (СОН) снижается при имплантации ионов Sb+ (рис. 4). В исходных образцах это широкая структурированная полоса с 3-мя выраженными максимумами: при ~1150 см–1; ~1170 см–1 и ~1200 см–1. Ее интенсивность выше интенсивности полосы 1100 см–1. В процессе имплантации сначала при Ф = 1 × × 1015 см–2 пропадает максимум при ~1150 см–1, а затем при – 1200 см–1. Интенсивность полосы в диапазоне волновых чисел 1150–1200 см–1 становится ниже интенсивности полосы при 1100 см–1 (кривая 2 рис. 4). Полоса теряет структуру и при Ф = 5 × 1016 см–2 проявляется в спектрах как перегиб на высокоэнергетичном плече полосы при 1100 см–1.
Такое поведение полос НПВО в диапазоне волновых чисел 1050–1230 см–1 свидетельствует о взаимодействии в процессе имплантации кетена с ОН-группой смолы с образованием эфирных сшивок по реакции (3). С другой стороны, аналогичный эффект может давать также окисление фенолов до хинонов, в результате которого группа C–OH превращается в С=О. Однако последний механизм маловероятен, поскольку после имплантации существенного усиления поглощения в области ~1715–1730 см–1, обусловленного колебаниями С=О в ароматических соединениях [13, 14], не наблюдалось (рис. 1).
Отметим, что кетен образуется при ионной имплантации из фоточувствительного компонента резиста – орто-нафтохинондиазида [8]. Образование эфирных сшивок по реакции (3) должно приводить к увеличению микротвердости и хрупкости резистивной пленки, что и наблюдалось в работе [5]. В результате эфирных сшивок образуются С–О–С связи, валентные колебания которых обуславливают полосу с максимумом при 1100 см–1. Кроме того, С–О–С связи могут образоваться и при рекомбинации радикалов на фенолформальдегидном полимере [8]. Все это приводит к доминированию полосы 1100 см–1 по отношению к обусловленной колебаниями С–О связей полосе ~1170 см–1.
О протекании реакции (3) свидетельствует также снижение при имплантации Sb+ интенсивности полосы в диапазоне волновых чисел 3000–3700 см–1, обусловленной валентными колебаниями связанных О–Н групп, смещение ее максимума в высокоэнергетичную область и появление на ее высокоэнергетичном плече перегиба при ~3600 см–1 (рис. 5).
Рис. 5.
Спектры НПВО исходной (1) и имплантированной Sb+ дозой 5 × 1015 см–2 (2) пленок ФП9120 в области валентных колебаний связанных О–Н групп.

При имплантации наблюдалось удаление из пленки формальдегида CH2=O, не прореагировавшего с фенолом при синтезе полимерной основы резиста, что проявлялось как исчезновение полосы с максимумом ~1650 см–1 (рис. 6), обусловленной валентными колебаниями С=О связей, и слабой полосы при ~1130 см–1 (рис. 4), связанной с деформационными плоскостными колебаниями. Обе эти полосы наблюдаются в спектрах формальдегида [13, 19]. Удаление CH2=O обусловлено его высокой реакционной способностью по отношению к электронам, атомам водорода и большинству органических радикалов, образующихся при ИИ в полимере.
Рис. 6.
Спектры НПВО исходной (1) и имплантированных Sb+ дозами 1 × 1015 см–2 (2) и 5 × 1016 см–2 (3) пленок ФП9120 в области валентных колебаний С=О связей.

В спектрах НПВО полимеров в диапазоне волновых чисел 1475–1650 см–1 наблюдаются полосы поглощения, обусловленные колебаниями углеродного скелета ароматического кольца [13, 14]. На них накладываются валентные симметричные (1475–1525 см–1 [13]) и ассиметричные (1620–1760 см–1 [13, 20]) колебания С=О связей. В этой же области наблюдаются колебания двойных С=С связей [14]. На положение полос С=С и С=О влияют ряд факторов, среди которых основными являются: электронные эффекты ближайших заместителей; сопряжение с кратными связями и ароматическими кольцами; наличие меж- и внутримолекулярных связей [13, 21, 22].
Имплантация ионов Sb+ приводит к увеличению интенсивности интегрального поглощения в рассматриваемом диапазоне волновых чисел при одновременном уширении полос поглощения и сглаживании (вплоть до исчезновения) локальных максимумов (рис. 6). Это может быть обусловлено несколькими процессами, протекающими при взаимодействии компонентов фоторезиста во время имплантации ионов Sb+. В частности, могут наблюдаться трансформация (изменение состава) ближайших заместителей ароматических колец и связей С=О, усиление меж- и внутримолекулярных связей (сшивка) [5], увеличение количества сопряженных кратных связей [23]. Как отмечалось выше, каждый из этих факторов приводит к изменению частоты колебаний скелета ароматического кольца и двойных связей. Так полоса валентных колебаний С=О связей в ароматических соединениях, в частности в бензальдегиде [20, 21] и о-нафтхинондиазиде, наблюдается при 1700–1715 см–1. При сопряжении с С=С связями максимум полосы этих колебаний смещается в диапазон волновых чисел 1600–1650 см–1 [14]. Участие С=О группы в межмолекулярных водородных связях также приводит к снижению частоты ее валентных колебаний на 40–60 см–1 [20, 22]. В сложных ароматических эфирах напротив максимум полосы валентных колебаний С=О группы смещается к 1715–1735 см–1 [14]. Согласно [23] при имплантации фоторезиста ФП9120 формируются хиноидные структуры, для которых максимум полосы поглощения должен находиться в диапазоне 1645–1690 см–1 [14] в зависимости от наличия сопряженных связей. Суммарное действие перечисленных факторов должно приводить к уширению полос колебаний и сглаживанию их максимумов, что и наблюдалось экспериментально.
Аналогичные заключения можно сделать и относительно полос с максимумами при ~1500 и 1600 см–1, обусловленных колебаниями углеродного скелета ароматического кольца.
Отметим, что в процессе имплантации наблюдается перераспределение интенсивности полос при 2960 см–1 (метильная –СН3 группа) и 2930 см–1 (метиленовая –СН2– группа) в пользу последней. Причем полоса 2930 см–1 становится доминирующей. Такое перераспределение интенсивности полос, вероятнее всего, связано с отщеплением атома водорода от концевых метильных групп фенол-фомальдегидной смолы в процессе радиолиза с образованием термодинамически устойчивых углерод-центрированных радикалов толуильного типа ${\text{Ar}}--{\text{C}}{{{\text{H}}}_{2}}\centerdot .$ Их последующая рекомбинация с образованием новых С–С и С–О связей приводит к увеличению интенсивности полосы, ответственной за колебания метиленовых групп.
ЗАКЛЮЧЕНИЕ
Таким образом, установлено, что имплантация Sb+ приводит к появлению в спектре НПВО пленок позитивного диазохинон-новолачного фоторезиста ФП9120 полосы при 2331 см–1, обусловленной валентными колебаниями О=С=О. Нарушение адгезии на границе раздела фоторезист/кремний способствует появлению полосы при 610 см–1, связанной с решеточным поглощением Si. Обнаружено образование С–О–С связей в результате эфирных сшивок кетена с ОН-группой новолачной смолы. При имплантации наблюдалось также удаление непрореагировавшего формальдегида. Взаимодействие компонентов фоторезиста при имплантации Sb+ приводит к изменению частот колебаний скелета ароматического кольца и двойных (С=О, С=С) связей, которое в спектре НПВО проявляется как увеличение интенсивности интегрального поглощения в диапазоне волновых чисел 1475–1700 см–1 при одновременном уширении и сглаживании локальных максимумов в этом диапазоне.
Список литературы
Martins J.S., Borges D.G.A.L., Machado R.C., Carpanez A.G., Grazul R.M., Zappa F., Melo W.S., Rocco M.L.M., Pinho R.R., Lima C.R.A. Evaluation of chemical kinetics in positive photoresists using laser desorption ionization // European Polymer J. 2014. V. 59. P. 1–7.
Debmalya Roy, Gandhi A., Basu P.K., Eswaran S.V., Raghunathan P. Optimization of monomer content and degree of linearity in lithographically interesting novolac copolymers using NMR spectroscopy // Microelectronic Engineering. 2003. V. 70. № 1. P. 58–72.
Лебедев В.И., Котомина В.Е., Зеленцов С.В., Леонов Е.С., Сидоренко К.В. Влияние межмолекулярных водородных связей на качество фоторезистивных масок // Вестник Нижегородского университета. Химия. 2014. № 4(1). С. 178–182.
Моро У. Микролитография. Принципы, методы, материалы. В 2-х ч. Ч. 2. М.: Мир, 1990. 632 с. (Moreau W.M. Semiconductor lithography. Principles, practices and materials. N.Y., London: Plenum Press.)
Бринкевич Д.И., Бринкевич С.Д., Вабищевич Н.В., Оджаев В.Б., Просолович В.С. Ионная имплантация позитивных фоторезистов // Микроэлектроника. 2014. Т. 43. № 3. С. 193–199.
Василевич В.П., Кисель А.М., Медведева А.Б., Плебанович В.И., Родионов Ю.А. Химическая обработка в технологии ИМС. Полоцк: Изд. ПГУ, 2001. 259 с.
Харченко А.А., Бринкевич Д.И., Бринкевич С.Д., Лукашевич М.Г., Оджаев В.Б. Модификация приповерхностной области пленки полиимида имплантацией ионов бора // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2015. № 1. С. 94–99.
Вабищевич С.А., Бринкевич С.Д., Бринкевич Д.И., Просолович В.С. Адгезия к монокристаллическому кремнию пленок диазохинон-новолачного фоторезиста, имплантированных ионами бора и фосфора // Химия высоких энергий. 2020. Т. 54. № 1. С. 54–59.
Бринкевич Д.И., Харченко А.А., Бринкевич С.Д., Лукашевич М.Г., Оджаев В.Б., Валеев В.Ф., Нуждин В.И., Хайбуллин Р.И. Радиационно-стимулированная модификация спектров отражения за областью пробега ионов в пленках полиимида // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2017. № 8. С. 25–30.
Беккер Ю. Спектроскопия. М.: Техносфера, 2009. (Bocker J. Spektroskopie. Vogel Industrie Medien GmbH & Co KG. Wurzburg (Germany). 1997.)
Бринкевич Д.И., Харченко А.А., Просолович В.С., Оджаев В.Б., Бринкевич С.Д., Янковский Ю.Н. Модификация спектров отражения пленок диазохинон-новолачного фоторезиста при имплантации ионами бора и фосфора // Микроэлектроника. 2019. Т. 48. № 3. С. 235–239.
Физико-химические свойства полупроводниковых веществ. Справочник. М.: Наука; 1979. С. 13.
Тарасевич Б.Н. ИК спектры основных классов органических соединений. Справочные материалы. М.: МГУ, 2012.
Преч Э., Бюльманн Ф., Аффольтер К. Определение строения органических соединений. Таблицы спектральных данных. М.: Мир, Бином, 2006.
Пикаев А.К. Современная радиационная химия: Радиолиз газов и жидкостей. М.: Наука, 1986. 360 с.
Панков Ж. Оптические процессы в полупроводниках. М.: Мир, 1973. 458 с.
Харченко А.А., Бринкевич Д.И., Просолович В.С., Бринкевич С.Д., Оджаев В.Б., Янковский Ю.Н. Радиационно-стимулированная трансформация спектров отражения пленок диазохинон-новолачного фоторезиста при имплантации ионов сурьмы // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2020. № 6. С. 14–18.
Бринкевич С.Д., Гринюк Е.В., Бринкевич Д.И., Свердлов Р.Л., Просолович В.С. Петлицкий А.Н. Механизм адгезионного взаимодействия пленок диазохинон-новолачного фоторезиста с монокристаллическим кремнием // Журнал прикладной спектроскопии. 2020. Т. 87. № 4. С. 589–594.
Poljansek I., Sebenik U., Krajnc M. Characterization of Phenol–Urea–Formaldehyde Resin by Inline FTIR Spectroscopy // J. Applied Polymer Science. 2006. V. 99. P. 2016–2028.
Бельков М.В., Бринкевич С.Д., Самович С.Н., Скорняков И.В., Толсторожев Г.Б., Шадыро О.И. Инфракрасные спектры и структура молекулярных комплексов ароматических кислот // Журн. прикладной спектроскопии. 2011. Т. 78. № 6. С. 851–858.
Толсторожев Г.Б., Скорняков И.В., Бельков М.В., Шадыро О.И., Бринкевич С.Д., Самович С.Н. Инфракрасные спектры бензальдегида и его производных в разных агрегатных состояниях // Оптика и спектроскопия. 2012. Т. 113. № 2. С. 202–207.
Толсторожев Г.Б., Скорняков И.В., Бельков М.В., Шадыро О.И., Бринкевич С.Д., Самович С.Н. Водородные связи и противовирусная активность производных бензальдегида // Журн. прикладной спектроскопии. 2011. Т. 79. № 4. С. 658–663.
Олешкевич А.Н., Лапчук Н.М., Оджаев В.Б., Карпович И.А., Просолович В.С., Бринкевич Д.И., Бринкевич С.Д. Электронная проводимость в имплантированном ионами Р+ позитивном фоторезисте // Микроэлектроника. 2020. Т. 49. № 1. С. 58–65.
Дополнительные материалы отсутствуют.
Инструменты
Микроэлектроника




